Diodo Schottky de alta tensão β-Ga2O3 com terminação de borda implantada com argônio
Resumo
O Au / Ni / β-Ga com terminação de borda 2 O 3 Os diodos de barreira Schottky foram fabricados usando implantação de argônio para formar as camadas de alta resistividade na periferia dos contatos anódicos. Com a energia de implantação de 50 keV e dose de 5 × 10 14 cm −2 e 1 × 10 16 cm −2 , a tensão de ruptura reversa aumenta de 209 para 252 e 451 V (o máximo até 550 V) e a figura de mérito Baliga (V BR 2 / R em ) também aumenta de 25,7 para 30,2 e 61,6 MW cm −2 , aumento de cerca de 17,5% e 140%, respectivamente. De acordo com a simulação 2D, os campos elétricos no canto da junção são suavizados após a implantação de argônio e a posição do campo elétrico de ruptura máxima, 5,05 MV / cm, muda do canto do ânodo na interface para o canto de sobreposição logo abaixo da implantação região. A dependência das características dianteiras com a temperatura também foi investigada.
Histórico
Desenvolvimento de dispositivos de alta potência usando materiais semicondutores de bandgap ultralargo, como Ga 2 O 3 , AlN, diamante, etc. está se acelerando nos últimos anos. O bandgap de β-Ga 2 O 3 é tão grande quanto 4,8-4,9 eV e o campo de decomposição de β-Ga 2 O 3 é estimado em 8 MV / cm, cerca de três vezes maior do que 4H-SiC e GaN. A figura de mérito do Baliga, 3400, é pelo menos dez vezes maior do que a do 4H-SiC e quatro vezes maior do que a do GaN [1]. Além disso, o grande cristal único e β-Ga 2 de baixo custo O 3 o substrato pode ser fabricado com métodos de crescimento por fusão, como zona flutuante (FZ) [2] e crescimento alimentado por filme definido pela borda (EFG) [3, 4]. A densidade do elétron pode ser controlada em uma ampla faixa de 10 16 a 10 19 cm −3 por dopagem com Sn, Si ou Ge [5,6,7]. Estas excelentes propriedades tornam β-Ga 2 O 3 ideal para baixa perda, comutação de alta tensão e aplicações de alta potência, incluindo o diodo de barreira Schottky de alta tensão de ruptura (SBD) e o transistor de efeito de campo semicondutor de óxido metálico (MOSFET) [8,9,10,11,12] . Os diodos de barreira Schottky possuem as vantagens de velocidade de comutação rápida e baixa queda de tensão direta em comparação com o diodo de junção p-n, o que pode diminuir a perda de energia e melhorar a eficiência das fontes de alimentação.
Embora grandes tensões de ruptura de 1016 V, 2300 V e 1600 V tenham sido obtidas em β-Ga 2 O 3 Diodos de barreira Schottky sem terminação de borda, eles são todos cerca de 34%, 8% e 10% do valor ideal [10, 13, 14]. Para aliviar o efeito de aglomeração do campo elétrico e perceber totalmente o potencial de tensão de β-Ga 2 O 3 , terminações de borda adequadas devem ser projetadas. Existem várias técnicas de terminação de borda para aumentar a tensão de ruptura do dispositivo, como placas de campo, anéis de metal flutuantes, estrutura de trincheira MOS, anéis de proteção implantados e extensão de terminação de junção (JTE) [12, 15,16,17]. No entanto, os anéis de proteção implantados e a estrutura JTE não são aplicáveis ao Ga 2 O 3 Diodo Schottky devido à falta de dopagem do tipo p. H. Matsunami e BJ Baliga propuseram uma estrutura de terminação de borda, usando implantação de argônio para formar uma camada amorfa de alta resistividade nas bordas do ânodo, para reduzir o aglomerado de campo elétrico [18,19,20,21,22], que é uma técnica simples sem multi-fotolitografia ou etapas profundas de corrosão de trincheiras necessárias, e é amplamente utilizado em retificadores de SiC e GaN para suavizar a distribuição do campo elétrico em torno da periferia do contato de retificação [15, 23, 24].
Neste artigo, o β-Ga 2 terminado pela aresta vertical O 3 Os diodos Schottky foram fabricados com implantação de argônio nas bordas dos contatos Schottky. As características de capacitância-tensão (C-V) e densidade-tensão de corrente dependente da temperatura (J-V) foram registradas usando o sistema de caracterização de semicondutor Keithley 4200 e a distribuição do campo elétrico também foi analisada.
Métodos / Experimental
A camada de deriva com a espessura de 10 μm foi obtida a partir de β-Ga 2 dopado com Sn dopado (100) de alta qualidade O 3 substrato a granel por esfoliação mecânica. O β-Ga 2 O 3 bulk foi cultivado pela técnica EFG com 4 N puro Ga 2 O 3 pó como material de partida. Excelente qualidade de cristal e superfície lisa foram confirmadas por difração de raios-X de alta resolução (HRXRD) e medições de microscópio de força atômica (AFM), conforme apresentado na Fig. 1a, b. A largura total na metade do máximo (FWHM) e o quadrado médio da raiz (RMS) foram estimados em 37,4 segundos de arco e 0,203 nm, respectivamente. A Figura 1c mostra a distribuição de β-Ga 2 O 3 resistência da folha de substrato com a espessura de 10 μm por uma medição de sonda de quatro pontos. Usando concentração de portador de (1,3 ± 0,04) × 10 17 cm −3 e resistência da folha de (563 ± 18,5) Ω / □, a mobilidade do elétron é calculada em 85,3 ~ 95,2 cm 2 / Vs por μ n =1 / (R Folha × n × q × t ), onde μ n, Folha R , n , q , e t são a mobilidade do elétron, a resistência da folha, a concentração do elétron, a carga do elétron e a espessura do β-Ga 2 O 3 substrato, semelhante aos resultados relatados [25]. Implantação de íons de argônio com energia de 50 keV, dose de 2,5 × 10 14 cm −2 , e recozimento de alta temperatura a 950 ° C por 60 min em N 2 atmosfera foram realizadas primeiro no lado posterior, seguido por evaporação de feixe E de uma pilha de metal ôhmica Ti / Au (20 nm / 100 nm) e recozimento térmico rápido a 600 ° C por 60 s em N 2 ambiente. Em seguida, o fotorresiste de 2 μm de espessura foi usado como máscara para implantação de argônio em temperatura ambiente com energia de 50 keV e dose de 5 × 10 14 cm −2 (amostra B) e 1 × 10 16 cm −2 (amostra C), respectivamente. A fim de reparar o dano de implantação e reduzir a corrente de fuga sob polarização reversa, as amostras implantadas foram submetidas a um recozimento térmico rápido a 400 ° C por 60 s sob N 2 ambiente [13, 26]. Finalmente, os eletrodos de ânodo Schottky circular com diâmetro de 100 μm foram fabricados na parte frontal por padronização fotolitográfica padrão, evaporação de Ni / Au (30 nm / 200 nm) pilha e lift-off. O dispositivo de referência sem implantação de argônio também foi fabricado (amostra A). A Figura 2a representa a seção transversal TEM de fabricado-Ga 2 O 3 Díodo Schottky com terminação de borda implantada com argônio. Um amorfo quase superficial β-Ga 2 O 3 camada foi criada na região de implantação. A fotografia real do β-Ga 2 terminado O 3 O diodo Schottky é mostrado na Fig. 2b. A Figura 2c representa a configuração da medição da corrente-tensão direta ( I - V ) características do β-Ga 2 O 3 SBD, enquanto a tensão de medição varia entre 0 e 3 V e o degrau é de 10 mV. A Figura 2d descreve a configuração de medição de tensão de corrente reversa ( I - V ) características de β-Ga 2 O 3 Retificadores Schottky para obter a tensão de ruptura, enquanto a tensão de medição varia entre 0 e - 500 V e a etapa é - 1 V.

a Curva de balanço de XRD e b Imagem AFM do β-Ga 2 O 3 camada de deriva mecanicamente esfoliada de (100) β-Ga 2 O 3 substrato c resistência da folha medida de 10 mm × 10 mm β-Ga 2 O 3 substrato
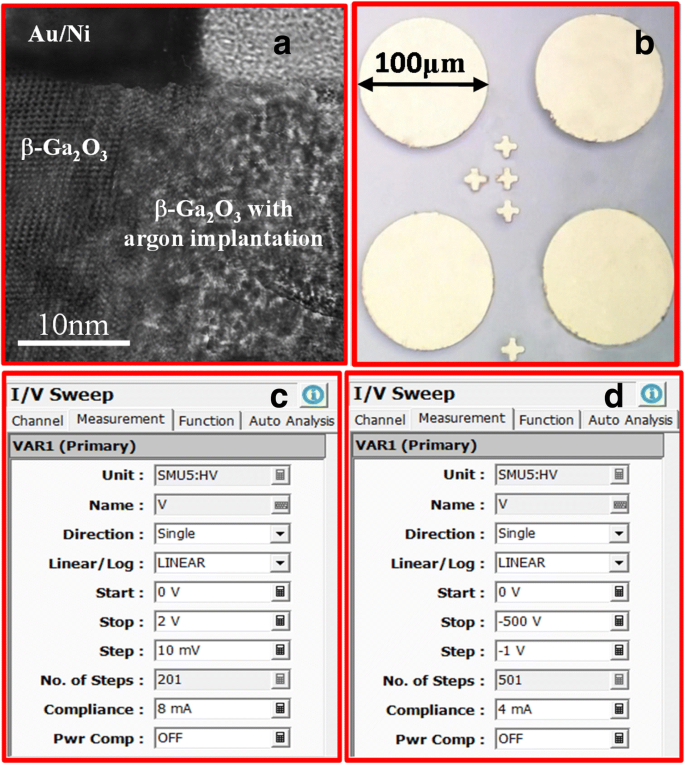
a Imagem TEM da amostra C e b fotografia do β-Ga 2 terminado O 3 Diodo Schottky c a configuração da medição de corrente direta e d características de corrente-tensão reversa (I-V) do β-Ga 2 O 3 SBD para obter a tensão de ruptura
Resultados e discussão
A Figura 3 mostra o experimental 1 / C 2 versus V características de três amostras de SBD à temperatura ambiente. A concentração efetiva de portadores N d - N a de β-Ga 2 O 3 camada de deriva e potencial integrado ( eV bi ) são extraídos para serem (1,3 ± 0,04) × 10 17 cm −3 e (1,30 ± 0,08) eV, respectivamente. De acordo com as seguintes equações, a altura da barreira Schottky φ b_CV é calculado como (1,32 ± 0,08) eV.
$$ \ frac {1} {C ^ 2} =\ frac {2} {q \ varepsilon {A} ^ 2 \ left ({N} _d- {N} _ {\ mathrm {a}} \ right)} \ left ({V} _ {bi} -V \ right) $$ (1) $$ e {\ varphi} _b ={eV} _ {bi} + \ left ({E} _c- {E} _f \ direita) -e \ Delta \ varphi $$ (2) $$ {E} _c- {E} _f =kT \ ln \ left (\ frac {N_c} {N_d- {N} _a} \ right) $$ ( 3) $$ e \ Delta \ varphi ={\ left \ {\ frac {e} {4 \ pi \ varejpsilon} {\ left [\ frac {2 {eV} _ {bi} \ left ({N} _d- {N} _a \ right)} {\ varepsilon} \ right]} ^ {1/2} \ right \}} ^ {1/2} $$ (4)
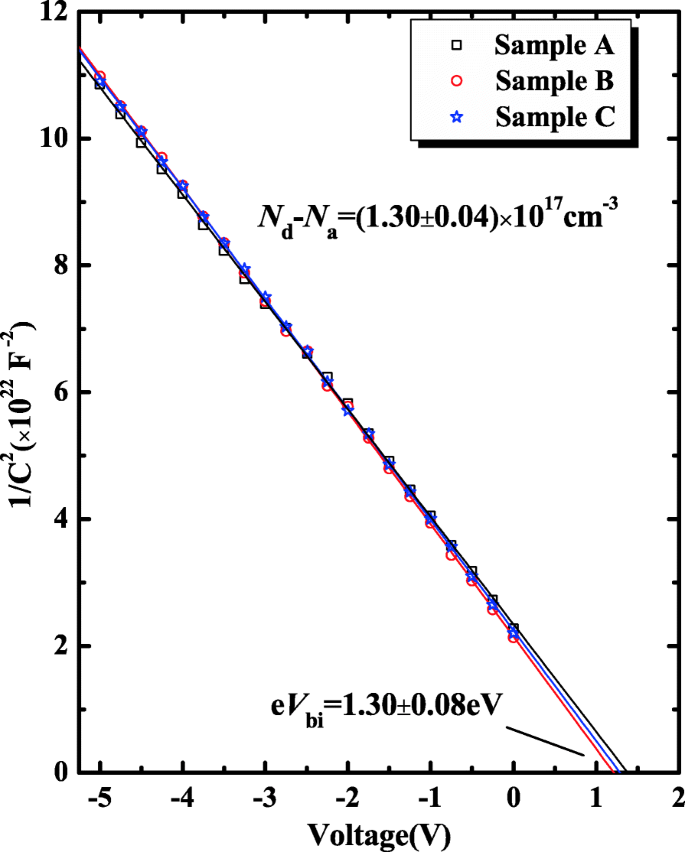
1 / C 2 - V gráficos de três β-Ga 2 O 3 Amostras SBD
onde A , q e ε são a área de contato de Schottky, a carga do elétron e a permissividade de β-Ga 2 O 3 . E c , E f , eΔφ , k , T , e N c são o mínimo da banda de condução, o nível de Fermi, a redução da barreira potencial causada pela força da imagem, a constante de Boltzmann, a temperatura absoluta em K e a densidade efetiva dos estados da banda de condução, respectivamente.
A Figura 4a representa a tensão-densidade de corrente direta ( J - V ) características do β-Ga 2 O 3 SBD. Sob a tendência direta, a implantação de argônio não tem efeito significativo nas características elétricas. A tensão limite é determinada como sendo 0,91 V, 0,92 V e 0,95 V para três amostras, o I em / eu desligado as proporções são todas maiores que 10 9 à temperatura ambiente e pelo ajuste da região linear, as resistências ativas específicas ( R em ) são 1,7,2,1 e 3,3 mΩ cm 2 , e as densidades de corrente direta a 2 V são 857, 699 e 621 A / cm 2 para três amostras, respectivamente, como mostrado na inserção da Fig. 4a. As densidades de corrente são maiores e as resistências ligadas são menores ou comparáveis aos valores relatados para a maior condutividade e densidade de portadores na camada de deriva [12, 13, 26,27,28,29,30].
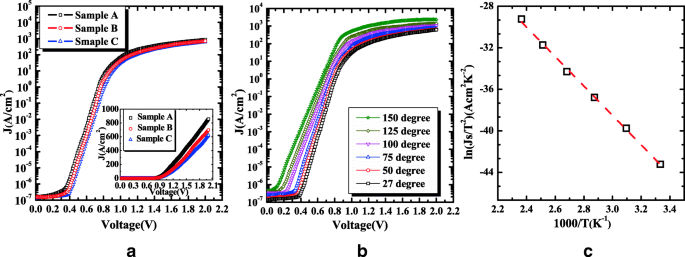
a O avançado J - V características da terminada e não terminada β-Ga 2 O 3 à temperatura ambiente e b a frente dependente da temperatura J - V características da amostra C de 300 a 423 K. c O enredo de Richardson de ln ( J s / T 2 ) vs 1000 / T da amostra C
A fim de investigar os efeitos da implantação de argônio na dependência das características diretas com a temperatura, o J - V as medições da amostra C são conduzidas de 300 a 423 K, conforme mostrado na Fig. 4b. O fator ideal n e altura da barreira Schottky φ b_JV são determinados como sendo 1,06 e 1,22 eV à temperatura ambiente, inferior a φ b_CV de (1,32 ± 0,08) eV, conforme modelo de emissão termiônica (TE) [31, 32]. Com o aumento da temperatura, o n diminui de 1,06 para 1,02 e a altura da barreira reduz ligeiramente, mas é quase constante em 1,21 ± 0,01 eV na faixa de temperatura, o que é contrário à diminuição da altura da barreira de um diodo Schottky ideal com aumento de temperatura, mas foi observado em β-Ga fabricado 2 O 3 SBD [26]. Usando a equação ln ( J s / T 2 ) =Ln (A *) - q ϕ b / kT , a altura da barreira ϕ b e a constante efetiva de Richardson A * são determinadas como 1,22 eV e 48,5 A / cm 2 K 2 para a amostra C da inclinação e o y - interceptação do eixo da região linear do gráfico, conforme mostrado na Fig. 4c. Além disso, os valores A * extraídos para dezenas de dispositivos nas três amostras estão entre 24 e 58 A / cm 2 K 2 , consistente com os resultados do experimento anterior e valor teórico, 24-58 A / cm 2 K 2 , com a massa efetiva do elétron m * =0,23–0,34 m 0 de β-Ga 2 O 3 [33,34,35,36,37].
A Figura 5a mostra o reverso J - V características das amostras. Após a implantação de argônio, a tensão de ruptura aumenta de 209 para 252 e 451 V e a figura de mérito Baliga (V BR 2 / R em ) para três amostras são aproximadamente 25,7, 30,2 e 61,6 MW cm −2 , respectivamente. Durante a implantação, alguns defeitos podem ser introduzidos e levar ao aumento significativo e indesejável da corrente de fuga, o que também foi relatado em dispositivos de diodo Schottky SiC e GaN [18,19,20]. Embora o recozimento térmico tenha sido conduzido após a implantação de argônio, ainda existem correntes de fuga ligeiramente maiores para as amostras B e C. Portanto, o detalhe da investigação da temperatura pós-recozimento e da duração nas características elétricas diretas e reversas deve ser abordado no artigo a seguir.

a O reverso J - V características do β-Ga 2 O 3 amostras à temperatura ambiente. b e c Distribuição das tensões de ruptura de β-Ga 2 O 3 SBDs com e sem implantação de argônio
A Figura 5b, c apresenta a distribuição das tensões de ruptura de β-Ga 2 O 3 Retificadores Schottky com e sem implantação de argônio. As tensões de ruptura paralelas planas ideais desses dispositivos são determinadas como 553 ~ 598 V, usando o campo elétrico crítico de 5,1 ~ 5,3 MV / cm [11, 39]. A tensão de ruptura sem implantação de argônio é cerca de 110 ~ 310 V, que está em torno de 50% dos valores ideais. No entanto, com dose de implantação de argônio de 5 × 10 14 cm −2 , a tensão de ruptura aumenta para 150 ~ 350 V, não muito maior do que o dispositivo de referência, enquanto com a dose de 1 × 10 16 cm −2 , a tensão de ruptura está se aproximando dos valores ideais. Neste trabalho, pode-se obter a tensão de ruptura máxima de 550 V. Além disso, a distribuição do campo elétrico na tensão de ruptura foi simulada. Para simplificação, um único nível de aceitador de midgap foi adicionado com a profundidade de implantação de 50 nm determinada pela simulação TRIM e o modelo de ionização incompleto também foi considerado [38], como mostrado na Fig. 6. Obviamente, a camada de alta resistividade efetivamente suaviza campo elétrico nos cantos da junção e aumenta a tensão de ruptura muito em comparação com a amostra de referência. Os campos elétricos máximos na tensão de ruptura são todos cerca de 5,05 MV / cm, semelhantes aos resultados relatados [11, 39], enquanto a posição muda do canto do ânodo na interface para o canto de sobreposição logo abaixo da região de implantação, conforme indicado em Fig. 6d, e.
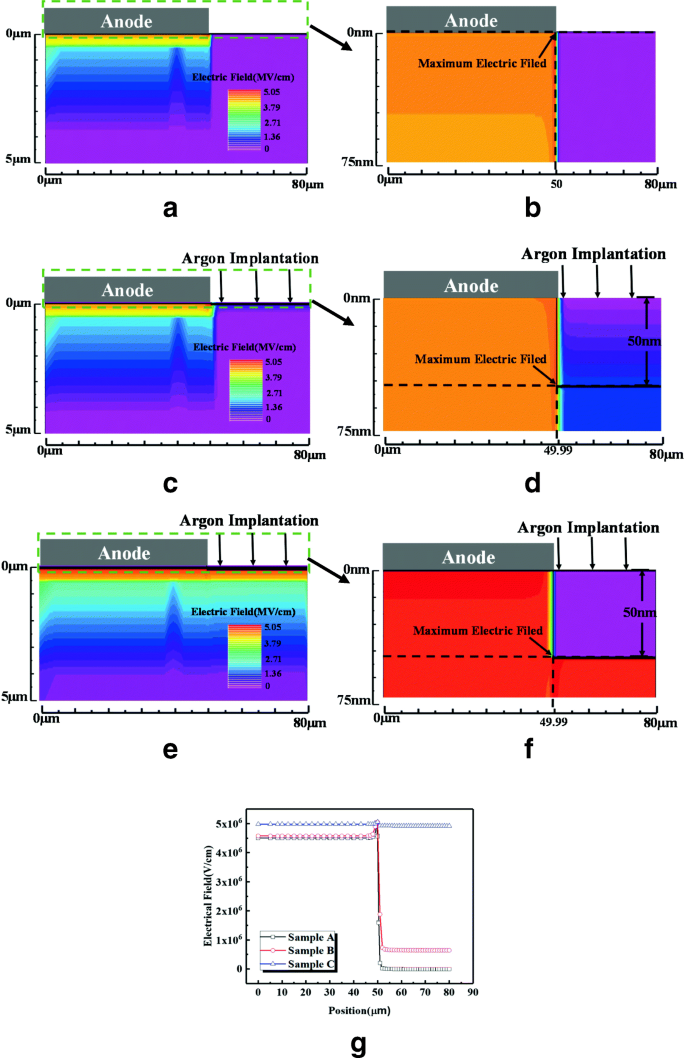
Simulação da distribuição do campo elétrico na tensão de ruptura das amostras A – C ( a , c , e ), a imagem ampliada das regiões selecionadas na caixa tracejada ( b , d , f , g ), o campo elétrico simulado vs a posição ao longo da linha tracejada em ( b , d , f ) para três amostras, Au / Ni / β-Ga 2 O 3 interface para a amostra A, 50 nm abaixo da interface para as amostras B e C, respectivamente. O campo máximo é 5,05 MV / cm
Conclusões
Au / Ni / β-Ga vertical 2 O 3 Os diodos de barreira Schottky com terminação de borda formada por implantação de argônio foram fabricados em β-Ga 2 O 3 camada de deriva mecanicamente esfoliada de β-Ga 2 de alta qualidade (100) O 3 substrato a granel. Comparado com o dispositivo de controle, as resistências on específicas ( R em ) aumenta de 1,7 para 2,1 e 3,3 mΩ cm 2 e a tensão de ruptura aumenta de 209 para 252 e 451 V para a dose de implantação de 5 × 10 14 cm −2 e 1 × 10 16 cm −2 , respectivamente, com uma corrente de fuga reversa maior. O campo elétrico máximo na tensão de ruptura é cerca de 5,05 MV / cm, muito maior do que o de SiC e GaN.
Abreviações
- AFM:
-
Microscópio de força atômica
- EFG:
-
Crescimento alimentado por filme definido pela borda
- FWHM:
-
A largura total na metade do máximo
- FZ:
-
Zona Flutuante
- HRXRD:
-
Difração de raios-x de alta resolução
- JTE:
-
Extensão de terminação de junção
- MOSFET:
-
Transistor de efeito de campo semicondutor de óxido metálico
- RMS:
-
Raiz quadrada média
- SBD:
-
Diodo barreira Schottky
- TE:
-
Emissão termionica
Nanomateriais
- ST conduz AI para dispositivos embarcados de borda e nó com caixa de ferramentas de desenvolvedor de rede neural STM32
- ept:Conector de placa de borda SMT de alta velocidade com passo de 0,8 mm
- Eletrônica do futuro:Microfone MEMS da CUI com qualidade de áudio aprimorada
- A Advantech leva a computação acelerada da nuvem para o limite com a NVIDIA
- ADLINK:implante AI da borda para a nuvem com Edge AI Solutions e a plataforma NVIDIA EGX
- ADLINK estreando uma logística mais rápida e precisa com o Edge IoT Smart Pallet Experience
- Cisco une vantagem corporativa e industrial com novos roteadores
- Atualizando Indústria 4.0 com análise de borda
- Advancing Edge Computing, IIC se junta ao OpenFog
- Robôs inteligentes de patrulha 5G equipados com o computador de ponta da Advantech empregado para combater o coronavírus



