Análise da distribuição de Bi em GaAsBi epitaxial por HAADF-STEM com correção de aberração
Resumo
O conteúdo Bi em GaAs / GaAs 1 - x Bi x / As heteroestruturas de GaAs crescidas por epitaxia de feixe molecular em uma temperatura de substrato próxima a 340 ° C são investigadas por técnicas de campo escuro anulares de alto ângulo corrigidas por aberração. A análise em baixa ampliação de imagens de microscopia eletrônica de transmissão de varredura de campo escuro anular de alto ângulo, corroborada pela análise de EDX, revelou camadas planas livres de defeitos e uma distribuição Bi não homogênea nas interfaces e dentro da camada GaAsBi. Em alta ampliação, a análise de qHAADF confirmou a distribuição não homogênea e a segregação de Bi na interface GaAsBi / GaAs em baixo fluxo de Bi e formato de haltere distorcido em áreas com maior conteúdo de Bi. Em um fluxo Bi mais alto, o tamanho do agrupamento Bi aumenta levando a partículas ricas em Bi quase equiaxiais facetadas ao longo da mistura de zinco {111} e uniformemente dispersas em torno da matriz e das interfaces. A análise de FFT verifica a coexistência de duas fases em alguns clusters:um Bi (rh-Bi) puro romboédrico cercado por GaAs de zinco blende 1 - x Bi x matriz. Os aglomerados podem estar afetando o relaxamento da rede local e levando a um sistema GaAsBi / GaAs parcialmente relaxado, em bom acordo com a análise de XRD.
Histórico
Atualmente, semicondutores baseados em GaAsBi estão atraindo interesse como dispositivos estáveis à temperatura e infravermelho médio [1]. Adicionar uma pequena quantidade de Bi na rede GaAs leva a uma grande redução do bandgap, sendo um dos efeitos optoeletrônicos mais interessantes [2, 3]. No entanto, incorporar até mesmo uma pequena quantidade de Bi em GaAs é um desafio devido à fraca energia de ligação Ga-Bi, a grande lacuna de miscibilidade e a grande diferença na constante de rede entre GaBi e GaAs. Consequentemente, GaAsBi deve ser cultivado sob um processo dinâmico de não equilíbrio para uma incorporação eficiente de Bi. Embora seja sintetizado com sucesso, a distribuição de Bi às vezes é não uniforme, aumentando a densidade dos centros de recombinação não radiativos e, portanto, afetando sua eficiência na operação do laser. O grande tamanho e baixa eletronegatividade de Bi tendem a produzir separação de fases [4], gotículas de superfície [5, 6], ordenação atômica [7,8,9], gotículas de líquido em nanoescala [10] ou aglomerados de Bi durante o crescimento epitaxial. A presença de clusters Bi foi previamente detectada por Ciatto et al. através de uma combinação de técnicas de espectroscopia de absorção de raios X (XAS), microscopia de força atômica e difração de raios X (XRD) [11]. Em seguida, vários autores relataram a presença de clusters Bi em amostras de GaAsBi recozidas usando diferentes técnicas de microscopia eletrônica de transmissão [4, 12, 13]. Além disso, Kunzer et al. [14] confirmaram por ressonância de spin eletrônico convencional (ESR) que cerca de 10% do Bi incorporado ocupou os sítios Ga nas camadas de GaAsBi. Portanto, compreender e controlar a incorporação de Bi e a formação de defeitos é fundamental para o sucesso da aplicação de GaAsBi a dispositivos. Vale ressaltar que o desenvolvimento de novos materiais de base Bi está atrelado ao avanço das ferramentas de caracterização. Nesse sentido, técnicas de microscopia eletrônica de transmissão de varredura de campo escuro anular de alto ângulo (HAADF-STEM) em microscópios corrigidos de aberração desempenham um papel importante na obtenção de informações em nível de sub-angstrom [15, 16]. Nesta técnica, a intensidade nas imagens é aproximadamente proporcional ao número atômico médio ( Z ) na coluna atômica projetada, para que possa ser aplicado com sucesso em heteroestruturas Ga diluídas (AsBi) devido à grande diferença no número atômico de Bi em relação a As e Ga. Além disso, há recursos brilhantes em imagens HAADF, ao contrário do microscopia eletrônica de transmissão de alta resolução (HRTEM), pode ser associada a colunas atômicas em um cristal alinhado devido à falta de reversões de contraste e deslocalização. Além disso, imagens HAADF com correção de aberração de amostras de GaAsBi mostram uma baixa dependência da espessura do espécime e uma dependência quase linear da composição As / Bi [12]. Além disso, aplicando o algoritmo de análise de imagem quantitativa HAADF (qHAADF), desenvolvido por Molina et al. [17], é possível correlacionar efetivamente a intensidade HAADF e a composição da coluna atômica em materiais semicondutores ternários III-V [12, 16, 18] e, conseqüentemente, em compostos GaAsBi. Além disso, imagens HAADF-STEM de alta resolução oferecem informações sobre a qualidade cristalina [19,20,21,22].
Neste trabalho, investigamos por meio de imagens HAADF-STEM com correção de aberração e raios-X de dispersão de energia complementar (EDX) a distribuição de Bi em GaAs / GaAs 1 - x Bi x / Heteroestruturas de GaAs crescidas por epitaxia de feixe molecular (MBE) em uma temperatura de substrato próxima a 340 ° C. Também estudamos o efeito do agrupamento de Bi em nano e micro escalas. Para tanto, utilizamos a abordagem qHAADF, a análise por transformada rápida de Fourier (FFT) de imagens de alta resolução e as técnicas de XRD.
Métodos
Estudamos uma série de duas amostras consistindo em GaAs / GaAs 1 - x Bi x / Heteroestruturas de GaAs crescidas por MBE de fonte sólida em 2 ″ n + GaAs:wafers de Si (001) com diferentes fluxos Bi fornecidos pelas temperaturas da célula Bi S1 (460 ° C) e S2 (505 ° C). O sistema usado foi uma máquina VG V80 MBE com uma pressão de fundo média em repouso de ~ 5 × 10 - 10 mbar. As estruturas consistem nominalmente em um tampão de GaAs de 130 nm, camada de GaAsBi de 130 nm, camada espaçadora de GaAs de 5 nm e, em seguida, um tampão de GaAs de 130 nm. Antes do crescimento, o substrato foi liberado com gases a 400 ° C durante 20 min e, em seguida, o óxido de superfície foi removido a 600 ° C. O tampão e tampão de GaAs foram cultivados a ~ 580 ° C sob um As 2 fluxo, enquanto a camada GaAsBi e a camada espaçadora GaAs cresceram a ~ 340 ° C sob um As 4 quase estequiométrico fluxo. A camada de GaAsBi foi, portanto, recozida in situ a ~ 580 ° C por ~ 20 min durante o crescimento da capa de GaAs. Nessas condições de crescimento, não foram observadas gotas metálicas na superfície. As temperaturas do substrato foram estimadas usando termometria óptica, com os resultados sendo calibrados contra transições de reconstrução de superfície em temperaturas conhecidas. Antes do crescimento do GaAsBi, a superfície da amostra foi exposta a um fluxo de Bi por 20 s; o objetivo desta etapa era estabelecer uma camada superficial de Bi e aumentar a incorporação de Bi no início do crescimento de GaAsBi.
As amostras para HAADF-STEM foram preparadas em seção transversal por moagem mecânica e Ar + moagem iônica com sistema de polimento iônico de precisão (PIPS), com inclinações do feixe de - 3 ° e + 4 ° e energia do feixe entre 2,8 e 3,0 kV. Na etapa final de moagem, a energia iônica foi diminuída para 1,5 kV para melhorar a qualidade da superfície. As amostras antes de serem estudadas foram limpas com plasma para reduzir o efeito da deposição do feixe de elétrons na superfície da amostra [23]. Imagens HAADF-STEM, espectro de perda de energia de elétron com perda zero (EELS) e varreduras de linha de espectro de raios-X dispersiva de energia foram conduzidas a 200 kV, usando um Titan 3 Themis em 60–300 kV. O Titã 3 Themis está equipado com uma pistola de emissão de campo frio (FEG), corretor de sonda Cs e monocromador de elétrons, permitindo resolução atômica em imagens HAADF. Este microscópio também inclui um detector Super-X quad EDX para análise elementar, fornecendo informações sobre a posição e composição do átomo simultaneamente. As imagens do elétron secundário (SE) para o estudo da topografia do espécime TEM foram realizadas usando um microscópio FEI NOVA NANOSEM 450 a 2 kV.
A linha Bi-M a 2,42 keV foi utilizada para a determinação quantitativa da composição Bi por meio do software Bruker Espirit. A espessura do corpo de prova foi determinada a partir da análise do sinal EELS de perda zero espacialmente resolvido, por meio do software Digital Micrograph (GATAN ™) [23]. A distribuição Bi coluna por coluna foi estudada usando o software qHAADF disponível para execução na Micrografia Digital. Este software permite medir e mapear a intensidade integrada de áreas selecionadas em torno das colunas atômicas, detectando picos de intensidade na imagem HAADF-STEM [17]. Os espectros de XRD ω-2θ (0 0 4) foram medidos com um difratômetro de raios-X Bruker D8 Discover usando Cu-Kα 1 radiação. As varreduras foram simuladas usando o software Bede Rads Mercury.
Resultados e discussão
A Figura 1 mostra imagens HAADF-STEM de baixa ampliação tomadas no eixo da zona [110] das amostras S1 (a) e S2 (b), juntamente com os perfis de intensidade corrigida por gradiente de espessura tomadas ao longo da direção [001] das regiões marcadas em as imagens HAADF-STEM (retângulos verdes). Não foram detectados deslocamentos de rosqueamento ou falhas de empilhamento nas regiões estudadas de ambas as amostras. No HAADF, a intensidade obtida é proporcional ao número atômico médio. Assim, para uma espessura de amostra constante, o contraste mais claro na imagem está relacionado a um conteúdo Bi mais alto ( Z Bi =83, Z Ga =31 e Z Como =33). Isso possibilita o estudo da distribuição de Bi em heteroestruturas GaAsBi / GaAs. Como pode ser observado na Fig. 1a, nenhuma variação clara de contraste é detectada na camada GaAsBi na amostra S1 - com um conteúdo de Bi inferior - não mostrando evidências claras de agrupamento, nem mesmo em outras áreas com maior espessura de amostra. No entanto, clusters Bi e As têm sido relatados na literatura, mesmo para amostras de GaAsBi com conteúdo de Bi tão baixo quanto 1,44%, embora crescido em temperaturas mais baixas [11]. No que diz respeito à amostra S2, com maior teor de Bi, a Fig. 1b mostra algumas áreas com maior contraste na camada, com tamanho e distribuição relativamente homogêneos. Essas regiões, regularmente distribuídas ao longo da camada GaAsBi e interfaces, podem ser interpretadas diretamente como clusters contendo Bi por causa de sua maior intensidade HAADF. Para uma melhor visualização, a imagem filtrada passa-baixo correspondente é mostrada como um inset na mesma imagem, onde a cor amarela corresponde às áreas de maior conteúdo de Bi e a preta às menores (escala de temperatura). A formação de clusters Bi em GaAsBi sem provocar defeitos estruturais foi relatada anteriormente por outros autores [7, 24, 25]. A integração do Bi (1,6 vezes o volume atômico do As) na matriz de GaAs pode causar um aumento da energia substitucional devido à deformação, reduzindo a solubilidade dos átomos de As e permitindo o acúmulo dos Bi. Um estudo da amostra usando um microscópio eletrônico de varredura por emissão de campo (FEG-SEM) foi realizado para garantir que os aglomerados Bi sejam incorporados na camada. Para tanto, imagens topográficas de elétrons secundários adquiridos em baixa voltagem (não mostrados aqui) foram comparadas com imagens STEM obtidas na mesma área.

a Imagens de corte transversal HAADF-STEM da amostra S1 mostrando interfaces GaAs / GaAsBi / GaAs. b Imagem HAADF-STEM transversal da amostra S2, na camada GaAsBi, pontos brilhantes distribuídos ao longo da camada GaAsBi relacionados a áreas Bi-ricas são observados. O detalhe usando a escala de cores de temperatura de uma área após a aplicação de um filtro passa-baixa é incluído como uma inserção na mesma imagem para uma melhor visualização. c Perfis de intensidade corrigidos por gradiente de espessura tomados ao longo da direção [001] das regiões marcadas com retângulos verdes nas imagens HAADF-STEM, linha azul para a amostra S1 e linha preta para a amostra S2, mostrando um comportamento ligeiramente diferente nas interfaces
Para obter mais informações sobre a distribuição de Bi nas amostras, perfis de intensidade ao longo da direção de crescimento com gradiente de espessura corrigido são mostrados na Fig. 1c. Perfis, retirados das imagens HAADF-STEM na Fig. 1a, b, apontam um comportamento semelhante em ambas as amostras:interfaces aproximadamente abruptas, camadas GaAsBi de comprimento semelhante (~ 140 nm). Em relação à interface GaAsBi / GaAs, a intensidade HAADF cai de seu valor máximo para ~ 0 em cerca de 10 nm (veja o retângulo cinza tracejado no perfil), sugerindo alguma incorporação de Bi em toda a camada de cobertura de GaAs, mesmo sem fluxo de Bi. Os perfis também representam informações sobre o tempo de equilíbrio. Como pode ser observado nos perfis, na amostra de menor conteúdo de Bi (S1), a interface GaAs / GaAsBi é mais abrupta do que na amostra de maior conteúdo de Bi (S2). Isso pode ser explicado pelos diferentes coeficientes de incorporação de Bi das duas amostras. S1, embora crescido à mesma temperatura que S2, tem um conteúdo de Bi muito menor. S1 é, portanto, provavelmente cultivado sob condições cineticamente limitadas com incorporação de Bi próxima à unidade [26], o que significa que a camada de superfície Bi irá se equilibrar em um período de tempo menor do que o tempo de vida de superfície de um átomo de Bi nesta temperatura. Por outro lado, S2 provavelmente possui um menor coeficiente de incorporação de Bi [27]. A camada de superfície Bi, neste caso, levaria mais do que o tempo de vida de um átomo de Bi para se equilibrar, levando a uma estabilização mais lenta da incorporação de Bi.
Para confirmar a correlação feita entre os perfis de intensidade HAADF-STEM e a distribuição Bi na heteroestrutura, mapas composicionais STEM-EDX Bi das amostras foram tirados simultaneamente. Eles são mostrados na Fig. 2 para amostra em fluxo de Bi baixo (a) e alto (b). Os perfis de composição Bi correspondentes ao longo da direção de crescimento, determinados pela integração dos espectros EDX pontuais de uma área de cerca de 130 nm, são mostrados na Fig. 2c como linhas azuis e pretas, respectivamente. Esses perfis de composição exibem a mesma tendência detectada nas interfaces GaAs / GaAsBi / GaAs por análise HAADF de baixa ampliação. A fração atômica Bi média nas camadas GaAsBi foi quantificada a partir dos espectros EDX correspondentes sendo 1,2 ± 0,4% e 5,3 ± 0,4% nas amostras S1 e S2, respectivamente, mostrando uma distribuição não homogênea de Bi na camada GaAsBi em ambas as amostras .

Mapas elementares STEM / EDX que representam a distribuição Bi nas amostras S1 ( a ) e S2 ( b ) Detalhes dos mapas elementares Bi, Ga e As correspondentes ao aglomerado marcado com um retângulo branco na Fig. 1b revelam uma queda nos sinais As e Ga onde há uma região Bi alta. c Perfis de conteúdo Bi ao longo da direção [001] extraídos após integração de uma área de cerca de 130 nm do mapa EDX das amostras S1 (linha azul) e S2 (linha preta). Características semelhantes foram observadas nos perfis de intensidade em baixa ampliação mostrada na Fig. 1c
A presença de aglomerados de Bi seria devido a um efeito de impedimento estérico. Neste caso, a tensão superficial pode aumentar devido ao maior tamanho atômico dos átomos Bi, portanto, para reduzir a tensão na estrutura, os átomos Bi podem estar bloqueando a incorporação de Ga e, conseqüentemente, causando vacâncias de Ga na rede. Os mapas de composição Ga e As do cluster rodeado por um quadrado branco na Fig. 2b são incluídos para mostrar como ambos os sinais caem onde há um sinal Bi alto. Isso sugere que, neste cluster específico, Bi poderia estar ocupando as sub-redes do grupo III e do grupo V. Isso também evidencia que os aglomerados não são superficiais formados durante a preparação da amostra de TEM.
Para realizar um estudo profundo da distribuição Bi no nível atômico, imagens HAADF-STEM com correção de aberração de alta ampliação foram obtidas na projeção [110]. Nesta liga semicondutora III-V, os dois picos de intensidade máxima de um haltere correspondem às colunas atômicas do grupo III e do grupo V. Para correlacionar adequadamente a intensidade nas colunas atômicas com sua composição, o nível de fundo foi removido das imagens experimentais HAADF-STEM. Em seguida, uma localização automática dos picos de intensidade foi realizada e as áreas de integração em torno das colunas atômicas do grupo V são cuidadosamente selecionadas. Intensidades integradas são medidas e mapeadas para cada halter usando a abordagem qHAADF. O procedimento de quantificação do conteúdo de Bi foi semelhante ao publicado na Ref. [28]. Neste trabalho, os quocientes de intensidade integrados de cada haltere ( R ) foi calculado como uma razão entre a intensidade integrada nas colunas do grupo V ( I As - Bi ) em toda a imagem e a intensidade média integrada nas colunas do grupo V na camada GaAs ( I Como ), como R =( eu (As - Bi) ) / eu Como .
A Figura 3a mostra uma imagem HAADF-STEM de alta ampliação da interface GaAs / GaAsBi retirada da amostra com baixo conteúdo de Bi (S1). O mapa de intensidade integrado normalizado colorido da imagem HAADF é mostrado na Fig. 3b. Pontos coloridos variando de 1 (azul profundo) a 1,27 (vermelho) representam o conteúdo Bi nas colunas do grupo V. Como pode ser observado, pequenas flutuações em R os valores do valor médio são encontrados em ambas as camadas. Para comparar a dispersão dos resultados obtidos, calculamos o coeficiente de correlação Cv (definido como a razão entre o desvio padrão e a média R valor) no GaAs (substrato), a camada de GaAsBi e a camada de cobertura de GaAs. O Cv os valores foram 1,3, 2,6 e 2,6%, respectivamente, pois as flutuações observadas na interface GaAsBi / GaAs são maiores do que as encontradas no substrato GaAs tomado como referência; podemos considerar que essas variações em R os valores estão relacionados às mudanças na composição da coluna Bi. A causa do diferente de zero Cv O fator no substrato pode ser devido a flutuações de espessura local, ruído do detector (medido em uma região sem material como 0,6%) ou hidrocarbonetos sendo depositados na amostra de superfície durante a caracterização por microscopia.

a Transversal [110] HAADF-STEM imagem da interface GaAsBi / GaAs da amostra S1. O detalhe de uma região não distorcida na camada de GaAs e halteres de ânion-cátions distorcidos em uma área Bi-rica em maior ampliação são incluídos como uma inserção na mesma imagem. b Mapa colorido representando R valores em torno das colunas do grupo V da imagem HAADF na Fig. 3a. A cor verde corresponde à composição média de Bi na camada GaAsBi medida por EDX. Apesar da distribuição homogênea de Bi na imagem HAADF-STEM, o mapa de intensidade mostra áreas com alta probabilidade de nanoclustering (pontos vermelhos) e colunas com conteúdo relativamente pobre de Bi (pontos azuis) na camada de GaAsBi. c Perfil ao longo da direção de crescimento de todo o R mapa de intensidade, mostrando uma interface GaAsBi / GaAs borrada em cerca de 10 nm
Esta análise qHAADF confirma uma interface GaAsBi / GaAs superior não abrupta ao longo de cerca de 10 nm percebida em baixa ampliação, principalmente devido à segregação da superfície Bi durante o crescimento, como pode ser observado a partir do perfil obtido ao longo da direção de crescimento em toda a intensidade R mapa, mostrado na Fig. 3c. Além disso, colunas Bi-ricas dispersas dentro da camada GaAsBi (pontos vermelhos), juntamente com áreas com um conteúdo Bi pobre (pontos azuis) na camada GaAsBi, são detectadas também com este software, confirmando as flutuações de conteúdo Bi na camada GaAsBi . A presença de colunas Bi-ricas parece estar produzindo distorção distinta na forma de haltere, como pode ser apreciado na inserção em maior ampliação na Fig. 3a. A substituição de átomos de As por Bi maiores durante o crescimento epitaxial teria alargado localmente a rede da matriz, causando uma distorção no formato do haltere enquanto a estrutura é mantida.
As técnicas HAADF-STEM também permitem a análise estrutural e composicional dos aglomerados detectados em baixa ampliação na amostra S2. Esses aglomerados, quase homogeneamente distribuídos, ocupam cerca de 20-30% da superfície da camada GaAsBi. Para saber a composição Bi, a forma e o tamanho dos clusters encontrados, imagens HAADF-STEM com correção de aberração foram obtidas na projeção [110] e mapas elementares EDX e relações de mapa de intensidade em torno das colunas do grupo V foram realizados. Para identificar diferentes fases cristalinas, um estudo de transformada rápida de Fourier (FFT) foi realizado nas imagens de alta resolução em diferentes áreas dentro e nas proximidades dos aglomerados.
A Figura 4a mostra uma imagem HAADF-STEM de alta resolução [110] da interface GaAsBi / GaAs com um cluster Bi claro de cerca de 12 nm de diâmetro. Retângulos vermelhos na imagem representam as áreas onde o estudo FFT foi realizado. É bem sabido que a filtragem passa-baixa não apenas reduz a quantidade de ruído nos dados, mas também remove as características periódicas observadas na imagem bruta, enfatizando as bordas do cluster Bi. A imagem HAADF-STEM filtrada, seguindo o procedimento descrito por Werner et al. [29], é mostrado na Fig. 4b. Como pode ser apreciado, as facetas {111} e (001) na área mais brilhante são claramente observáveis. No entanto, a distribuição de intensidade sugere a presença de dois volumes composicionais diferentes na partícula:um Bi-rico com formato trapezoidal circundado por uma área menos Bi-rica. Uma forma de cluster semelhante foi observada por Wood et al. em um GaAs de cinco períodos 1 - x Bi x / GaAs 1 - y Bi y estrutura [10].
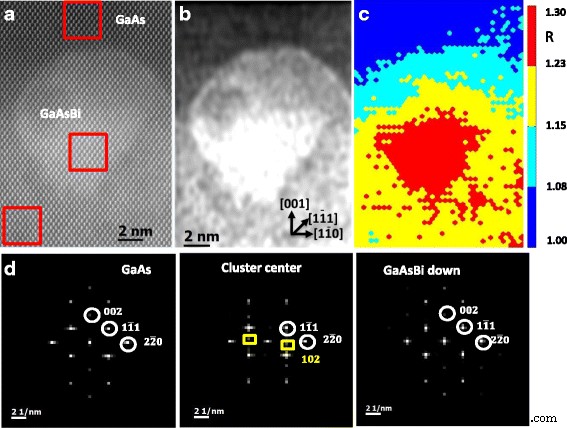
a Cross-sectional [110] HAADF-STEM imagem da interface GaAsBi / GaAs da amostra S2, capturando um cluster Bi de cerca de 12 nm de tamanho, próximo à interface GaAsBi / GaAs. b A imagem com filtro baixo da imagem HAADF-STEM mostra duas áreas com contraste diferente na camada GaAsBi, uma zona Bi-rica é facetada ao longo dos planos {111} e (001), cercada por uma zona Bi-rica inferior. c Mapa colorido representando o R valores em torno das colunas do grupo V que representam uma distribuição Bi graduada em torno do cluster. d A transformação de Fourier correspondente das áreas selecionadas marcadas com retângulos vermelhos na Fig. 1a. Pontos adicionais correspondentes a planos {102} relacionados à fase rh-Bi são detectados na região de cluster de maior contraste
A análise qHAADF através da intensidade R o mapa mostrado na Fig. 4c representa uma forma de partícula aproximadamente equiaxial e um gradiente de concentração de Bi com pico no centro do aglomerado.
Wu et al. [4] relataram a presença de diferentes estruturas cristalográficas em camadas de GaAsBi estudando micrografias HRTEM e modelando a formação e a transformação de fase de zinco blenda Bi-rico em romboédrico Bi (rh-Bi) nucleado em planos de zinco blenda {111}. Nesse sentido, vale ressaltar que os pontos brilhantes no FFT de imagens HAADF-STEM de alta resolução podem ser interpretados como pontos de difração de planos cristalográficos. Então, pontos extras no padrão convencional para a estrutura da mistura de zinco de GaAs devem ser interpretados como fases adicionais. Para estudar a presença de diferentes estruturas cristalinas no cluster, a Fig. 4d mostra os FFTs correspondentes a três áreas diferentes marcadas como quadrados vermelhos na Fig. 1a. Da direita para a esquerda mostra uma região homogênea na camada de cobertura de GaAs, a zona mais brilhante na camada de GaAsBi e outra região com menor contraste na mesma camada de GaAsBi. Círculos brancos denotam a posição do pico de difração com índices de Miller 002, \ (1 \ overline {1} 1 \) e \ (2 \ overline {2} 0 \). Como pode ser observado, apenas no centro do aglomerado aparecem pontos claros, marcados com um quadrado amarelo, relacionados a planos {102} aproximadamente paralelos aos planos de zinco blende {220}, sugerindo que uma nova fase rh-Bi foi nucleada em a camada de blenda de zinco GaAsBi. FFTs também representam uma ampliação dos picos de difração relacionados aos planos {111}. Este pico assimétrico observado pode ser devido às causas de micro-tensão por cisalhamento {111} planos entre rh-Bi e fases de blenda de zinco no cluster.
Para um estudo aprofundado da composição do cluster, vale mencionar que quando os elétrons passam por um espécime transparente de elétrons com clusters embutidos, eles carregam informações não apenas sobre o cluster, mas também da matriz. Assim, para estimar a composição real do cluster, seguimos o mesmo procedimento descrito na Ref. [25]. Os resultados também apontaram que os clusters próximos à interface GaAsBi / GaAs tendem a ser menores em tamanho (12 nm) com um maior conteúdo de Bi (≈ 30%), provavelmente devido à presença de Bi na superfície quando a camada de cobertura começa a ser crescido. No entanto, a maioria dos clusters localizados dentro das camadas de GaAsBi têm um tamanho maior (16 nm), mas seu conteúdo de Bi é inferior (≈ 22%). Além disso, na camada GaAsBi, foram detectados aglomerados com conteúdo Bi superior (35%) e tamanho maior (23 nm). Além disso, como foi mencionado antes, o núcleo de alguns clusters consiste em rh-Bi puro.
A fim de investigar o estado de deformação do filme epitaxial, curvas de alta resolução de raios-X ω-2θ foram registradas. A Figura 5 mostra as (004) varreduras de XRD das camadas GaAsBi / GaAs em azul e ajustes simulados em laranja para as amostras S1 (a) e S2 (b). Em ambas as amostras, o pico de intensidade mais nítido e mais alto localizado em segundos de arco de 0 ° corresponde ao substrato GaAs, enquanto o pico de baixa intensidade mais amplo localizado em segundos de arco negativo corresponde à camada GaAsBi esticada. O ângulo entre os picos está relacionado à quantidade de incompatibilidade de rede entre as duas camadas. O ombro à direita do pico de GaAs no espectro de S2 indica uma camada de GaAs sob tensão de tração; isso implica relaxamento de deformação na camada S2 GaAsBi. O espectro de XRD da amostra S1 foi bem ajustado usando a fração Bi e as espessuras fornecidas pelas medições de EDX e HAADF. Não há indicação de qualquer relaxamento de deformação no espectro de XRD da amostra S1. O espectro de XRD da amostra S2 foi mais problemático para se ajustar. A Figura 5b mostra os dados modelados por uma camada GaAsBi uniforme de 5,8%, conforme determinado pela análise HAADF-STEM, ignorando os clusters ricos em Bi e um relaxamento da camada GaAsBi de 6%, conforme determinado pelo ajuste da curva de XRD; isso seria razoável se os clusters não fossem coerentes com o resto da matriz GaAsBi. Este modelo não representa com precisão a camada; embora a divisão substrato-GaAsBi seja suficiente para dar conta dos dados, nenhum pico de tração de GaAs em ~ 250 ° arco segundos é visível. O pico de tração de GaAs sugere que o relaxamento ocorreu dentro da camada. O relaxamento de uma camada compressiva reduzirá a constante de rede fora do plano, o que implica que o conteúdo médio de Bi modelado de 5,8% é uma subestimativa da média real; isso é consistente com a observação de clusters Bi-ricos na camada. Nenhum pico (s) correspondendo a ~ 22–35% GaAsBi foi observado por mapeamento de espaço recíproco (não mostrado), o que sugere que os clusters podem não ser coerentes com a matriz GaAsBi. Nenhuma modelagem adicional do espectro S2 XRD foi tentada.

Dados de difração de raios-X (linhas azuis) e ajustes simulados (linhas laranja) da amostra S1 ( a ) e amostra S2 ( b ) Linhas tracejadas verticais destacando o pico de GaAs em segundos de arco de 0 ° e o pico do filme GaAsBi localizado em segundos de arco negativo. O ombro no pico de GaAs direito na Fig. 5b é indicativo de uma camada de cobertura de GaAs sob tensão de tração
Conclusões
As análises ac-HAADF-STEM oferecem informações úteis sobre a estrutura e composição de heteroestruturas GaAs / GaAsBi / GaAs, os resultados estando em boa concordância com as investigações de EDX, FFT e XRD. A análise de imagens HAADF-STEM de baixa ampliação permitiu detectar distribuição Bi não homogênea e interfaces GaAsBi / GaAs não abruptas. Em alta ampliação, a análise de qHAADF revelou segregação Bi clara na interface GaAsBi / GaAs em fluxo de baixo Bi (S1) e formato de haltere distorcido em áreas com fração Bi superior, devido às posições de substituição de átomos Bi na sub-rede do grupo V . No fluxo Bi mais alto (S2), o tamanho do agrupamento Bi aumenta levando a aglomerados quase equiaxiais uniformemente dispersos em torno de toda a matriz e interfaces. O estudo revelou a coexistência de duas fases cristalinas diferentes nos clusters estudados rh-Bi e planos de cisalhamento de blenda de zinco {111}, afetando o relaxamento da rede local e levando a um sistema GaAsBi / GaAs parcialmente relaxado, em bom acordo com a análise de XRD.
Abreviações
- Ac-HAADF-STEM:
-
Microscopia eletrônica de transmissão de varredura de campo escuro de alto ângulo com correção de aberração
- EDX:
-
Raio-X de dispersão de energia
- EELS:
-
Espectro de perda de energia de elétrons
- ESR:
-
Ressonância de spin de elétron convencional
- FEG:
-
Pistola de emissão de campo frio
- FFT:
-
Fourier fast transform
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- IMEYMAT:
-
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE:
-
Epitaxia de feixe molecular
- qHAADF:
-
Algoritmo de análise de imagem HAADF quantitativa
- SEM:
-
Microscópio eletrônico de varredura
- XAS:
-
Espectroscopia de absorção de raios-x
- XRD:
-
Difração de raios X
Nanomateriais
- Análise da forma de onda
- Opções de análise
- Análise de falha de componente
- Análise de falha de componente (continuação)
- O que é análise de rede?
- Mais sobre análise de espectro
- Manutenção Industrial do Centro de Distribuição
- DISTRIBUIÇÃO DA CASA DE ESTANQUEIDADE
- O que é distribuição de energia?
- O que é planejamento de distribuição?



