Uma Visão Geral do Diodo de Barreira Schottky Baseado em Semicondutor Ga2O3 Ultrawide para Aplicação de Eletrônica de Potência
Resumo
Óxido de gálio (Ga 2 O 3 ) é um novo material semicondutor que tem a vantagem de largura de banda ultralarga, campo elétrico de alta degradação e grande figura de mérito de Baliga (BFOM), por isso é um candidato promissor para dispositivos de alta potência de próxima geração, incluindo diodo de barreira Schottky (SBD ) Neste artigo, as propriedades físicas básicas de Ga 2 O 3 semicondutores foram analisados. E as recentes investigações sobre o Ga 2 O 3 com base em SBD foram revistos. Enquanto isso, vários métodos para melhorar o desempenho, incluindo tensão de ruptura e resistência ligada, foram resumidos e comparados. Finalmente, a perspectiva de Ga 2 O 3 com base em SBD para aplicação de eletrônica de potência foi analisado.
Histórico
Com o rápido desenvolvimento das indústrias de energia elétrica, controle industrial, eletrônica automotiva e eletrônica de consumo, há uma enorme demanda por dispositivos semicondutores de potência de alto desempenho. Materiais semicondutores de bandgap largo e ultralargo podem satisfazer essa demanda [1, 2]. Entre as cinco estruturas de Ga 2 O 3 cristal único, monoclínico β -Ga 2 O 3 é o mais estável e tem um bandgap ultra amplo ( E g ~ 4,8 eV) e campo elétrico de colapso muito alto ( E br ~ 8 MV cm −1 ), em comparação com o Si tradicional e posteriormente desenvolvido com material de SiC e GaN. Em conseqüência, β -Ga 2 O 3 mostra uma figura de mérito de Baliga muito grande (BFOM =\ (\ varepsilon \ mu {E} _ {\ mathrm {b}} ^ 3 \); ε é a constante dielétrica relativa, e μ é a mobilidade do elétron). O BFOM é um critério importante para avaliar a adequação de um material para aplicação de dispositivo de potência [3,4,5,6,7,8,9,10,11]. A Tabela 1 compara as propriedades físicas básicas de Si, bandgap largo (GaN, SiC) e bandgap ultralargo ( β -Ga 2 O 3 ) material semicondutor. Além disso, para o crescimento de cristal único β -Ga 2 O 3 substrato, existem métodos de crescimento fundido fáceis, de baixo custo e produzidos em massa à pressão atmosférica, como a zona flutuante (FZ) [12, 13] e o crescimento alimentado por filme definido pela borda (EFG) [14,15 , 16,17]. Esta é outra superioridade de Ga 2 O 3 no aspecto de crescimento de cristal único de alta qualidade, em comparação com SiC e GaN. Portanto, β -Ga 2 O 3 é um candidato promissor para dispositivos semicondutores de alta potência de próxima geração, como o diodo de barreira Schottky (SBD) [18,19,20,21,22,23,24] e o transistor de efeito de campo semicondutor de óxido metálico (MOSFET) [ 25,26,27,28,29]. É importante notar que muitos estudos sobre o Ga 2 O 3 o crescimento do material e a fabricação e caracterização do dispositivo de energia foram realizados nos últimos anos, portanto, neste artigo, revisamos as propriedades do material do bandgap ultra amplo Ga 2 O 3 semicondutor e as investigações do Ga 2 O 3 com base em SBD para aplicação em eletrônica de potência. No SBD, os parâmetros de desempenho mais importantes são a tensão de ruptura ( V br ) e na resistência ( R em ), resumindo e comparando os vários métodos para melhorar o V br e R em performances, desejamos que nosso trabalho de revisão seja benéfico para o desenvolvimento de Ga 2 O 3 dispositivos de energia baseados em
Propriedades físicas do semicondutor de óxido de gálio
Óxido de gálio (Ga 2 O 3 ) é um novo material semicondutor de óxido, mas tem uma longa história de pesquisa. A investigação sobre os equilíbrios de fase no Al 2 O 3 -Ga 2 O 3 -H 2 O sistema pode ser rastreado até 1952 e R. Roy et al. determinou a existência de polimorfos de Ga 2 O 3 e suas relações de estabilidade [30]. Em 1965, H. H. Tippins et al. estudaram a absorção óptica e fotocondutividade na borda da banda de β -Ga 2 O 3 e confirmou seu bandgap com um valor de 4,7 eV [6]. Na década de 1990, vários métodos de crescimento por fusão de Ga 2 O 3 crescimento epitaxial e de cristal único em massa de Ga 2 O 3 filme tinha sido revelado. Nos últimos 5 anos, devido às suas propriedades especiais e ao crescimento bem-sucedido de substrato de cristal único de alta qualidade e tamanho grande, Ga 2 O 3 o material atraiu muito interesse de pesquisa.
Até agora, as pessoas encontraram cinco fases cristalinas de Ga 2 O 3 , ou seja, α , β , γ , δ e ε fases. As relações de transformação entre essas cinco fases são mostradas na Fig. 1 [30]. A fase monoclínica β- Ga 2 O 3 tem a melhor estabilidade térmica, enquanto as outras quatro fases são metaestáveis e podem se transformar em β- Ga 2 O 3 em altas temperaturas. Portanto, no momento, a maioria dos estudos se concentra em β- Ga 2 O 3 . Algumas investigações recentes também descobriram que outras fases apresentavam algumas propriedades especiais do material que β fase não tinha. Por exemplo, α- Ga 2 O 3 tem uma estrutura de cristal de corindo semelhante à da safira (Al 2 O 3 ), por isso é comparativamente fácil cultivar epitaxialmente α- de alta qualidade Ga 2 O 3 filme de cristal único no Al 2 atualmente existente O 3 substrato de cristal único. Fase hexagonal ε- Ga 2 O 3 é a segunda fase estável e apresenta forte efeito de polarização espontânea que é benéfico para formar gás de elétron 2D de alta densidade na interface de heterojunção [31], semelhante à condição na junção AlGaN / GaN. Nos últimos anos, devido ao crescimento bem-sucedido de β- de grande porte Ga 2 O 3 substrato monocristalino e sua melhor estabilidade, até agora, os estudos sobre β- Ga 2 O 3 são muito mais do que nas outras quatro fases. Portanto, neste artigo, revisamos principalmente os trabalhos de pesquisa sobre β- Ga 2 O 3 .
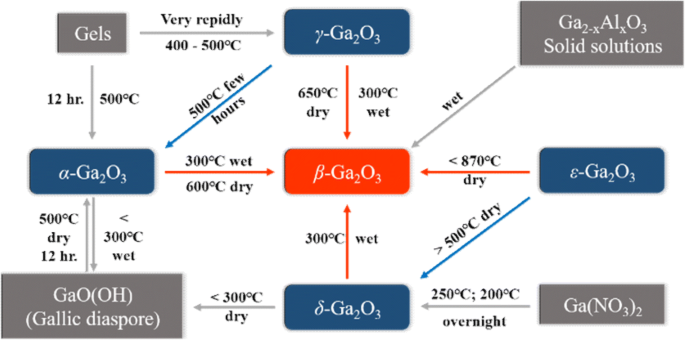
Relações de transformação entre as fases cristalinas do Ga2O3 e seus hidratos [30]
β- Ga 2 O 3 pertence ao sistema monoclínico e é termicamente estável. Suas constantes de rede são a =1,22 nm, b =0,30 nm, e c =0,58 nm, como mostrado na Fig. 2. A estrutura cristalina de β- Ga 2 O 3 determina que ele tem uma certa condutividade, mas que é limitada por seu bandgap ultralargo (4,7–4,9 eV), o mais largo de todos os materiais semicondutores transparentes conhecidos. Somente se alguns níveis de energia de defeito existirem no bandgap e os elétrons livres forem gerados, o material terá uma condutividade comparativamente forte. Para a maioria dos semicondutores de bandgap largo, a condutividade é formada apenas por causa da existência de níveis de defeito no bandgap, como o semicondutor ZnO [32]. A condução elétrica intrínseca de β- Ga 2 O 3 origina-se dos elétrons livres liderados pelos defeitos pontuais formados na maior parte do cristal. A maioria dos estudos tem demonstrado que as lacunas de oxigênio são os principais defeitos para a condução elétrica [33,34,35].

A estrutura de rede de β-Ga 2 O 3 cristal. Reproduzido da ref. [5]
É interessante que devido à existência de abundância de vagas de oxigênio em policristalino β- Ga 2 O 3 , é fácil absorver algum tipo de gás para fazer a mudança de resistividade, então há muitos relatos sobre o uso de β- Ga 2 O 3 para fabricar sensores de gás para a detecção de H 2 , CH 4 , CO e O 2 [36,37,38,39]. Além disso, porque a constante de rede de β- Ga 2 O 3 na direção [100] é muito maior do que nas direções [001] e [010], é fácil descascar o filme ultrafino ao longo da direção [100] para a fabricação do dispositivo [27, 40,41,42,43]. Ao mesmo tempo, devido a esta característica de estrutura cristalina, na fabricação de β- Ga 2 O 3 wafers, cortando o volume ao longo da direção [100] pode adquirir uma superfície plana com rugosidade muito baixa.
Comparado com SiC e GaN, β- Ga 2 O 3 possui características elétricas particulares, entre as quais o bandgap ultralargo (4,7–4,9 eV) é o mais proeminente. Isso faz com que tenha um campo elétrico de colapso crítico muito alto ( E br ≈8 MV / cm), cerca de duas vezes aqueles de SiC e GaN. O campo elétrico de decomposição do material é um parâmetro muito importante para dispositivos de energia unipolar. Se um material tiver maior E br , no material de espessura unitária, o campo elétrico mais alto pode ser mantido, o que é vantajoso para a redução do tamanho do dispositivo e aumento do nível de integração dos módulos de potência. A Figura 3 mostra os limites fundamentais da resistência on ( R em ) em função da tensão de ruptura ( V br ) para vários semicondutores importantes, incluindo Si, GaAs, SiC, GaN, Ga 2 O 3 e diamante [5]. A partir desta figura, podemos descobrir que a perda de condução de Ga 2 O 3 dispositivos é uma ordem de magnitude menor do que os dispositivos SiC e GaN no mesmo V br . Assim, Ga 2 O 3 mostra seu grande potencial em dispositivos unipolares. Como a mobilidade de elétrons de saturação de β- Ga 2 O 3 é comparativamente baixo (~ 200 cm 2 V - 1 s - 1 ), β- Ga 2 O 3 não é adequado para dispositivos de alta frequência em comparação com GaN. No entanto, sua largura de banda larga pode compensar esta desvantagem, uma vez que a camada de deriva mais fina tem largura de depleção menor; assim, a capacitância parasita pode ser diminuída para atender aos requisitos de aplicações de alta frequência. Além disso, o bandgap de cerca de 4,8 eV torna Ga 2 O 3 possuem banda de onda de absorção especial (250-280 nm) que está localizada na faixa dos raios ultravioleta cego solar (UV), então Ga 2 O 3 é um bom material natural para a fabricação de detectores de UV [44,45,46,47].
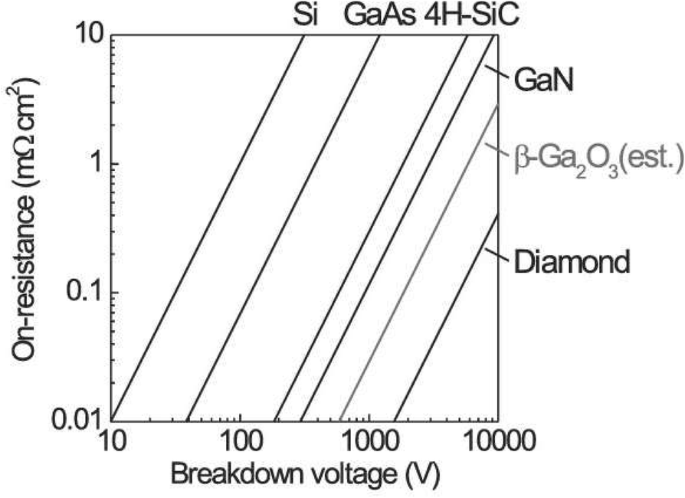
Limites teóricos de resistência ( R em ) em função da tensão de ruptura ( V br ) para β-Ga 2 O 3 e semicondutores representativos. Reproduzido da ref. [26]
Nos últimos anos, o doping do tipo n de β- Ga 2 O 3 foi basicamente realizado. Os elementos Si e Sn, como suas impurezas doadoras com baixo nível de energia, têm baixa energia de ativação. A concentração de dopagem pode ser bem modulada para ficar na faixa de 10 15 –10 19 cm −3 [47], com o maior valor de 10 20 cm −3 alcançado. Ao mesmo tempo, com a mudança da concentração de dopagem, as propriedades ópticas e elétricas também mudarão. Por exemplo, a resistividade do tipo n β- Ga 2 O 3 mudanças na faixa de 10 −3 - 10 12 Ω cm com a alteração da concentração de dopagem [48, 49]. O bandgap também muda com diferentes concentrações de dopagem, portanto, as características de absorção de luz de Ga 2 O 3 são influenciados [50].
Do desenvolvimento de Ga 2 O 3 , este material ainda tem algumas desvantagens como segue. (1) Dopagem tipo P é um grande desafio de Ga 2 O 3 material. Porque os níveis aceitadores estão longe da banda de valência de β- Ga 2 O 3 , a energia de ativação das impurezas aceitadoras é muito alta. Enquanto isso, as impurezas de fundo do tipo n em Ga 2 O 3 o cristal também produzirá efeito de autocompensação nas impurezas aceitadoras, resultando no auto-isolamento do material. Portanto, ainda não houve uma execução eficaz do tipo p. (2) A condutividade térmica de Ga 2 O 3 é muito baixo. Investigações experimentais e teóricas provaram que a condutividade térmica de β- Ga 2 O 3 tem apenas 0,1–0,3 W cm −1 K −1 [51,52,53]. Isso é adverso para o dispositivo de energia usado em circunstâncias de alta tensão e alta corrente. O acúmulo excessivo de calor afetará seriamente o desempenho e a confiabilidade do dispositivo. (3) A mobilidade da operadora é baixa. A mobilidade teórica de Ga 2 O 3 é limitado a cerca de 200 cm 2 / V s devido à influência do espalhamento [54]. A baixa mobilidade tem um impacto negativo nas características de frequência e corrente.
O conceito básico do diodo de barreira Schottky
O contato Schottky, o contato ôhmico e a distribuição do campo elétrico são os fatores-chave no SBD para atingir altos desempenhos, incluindo na resistência ( R em ) e tensão de ruptura ( V br ), portanto, vários métodos para melhorá-los são especialmente importantes.
De acordo com o conceito de barreira Schottky, a altura da barreira está relacionada à função de trabalho do metal Schottky e à afinidade eletrônica do semicondutor. A função de trabalho de diferentes metais muda periodicamente, e o metal precisa ter uma função de trabalho maior do que o semicondutor para formar a barreira de Schottky. Níquel (Ni) e platina (Pt) são os metais Schottky comuns para β- Ga 2 O 3 , e suas alturas de barreira são derivadas com diversos métodos [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 , 75,76,77]. A região de depleção sob a superfície do semicondutor precisa da espessura necessária para evitar o tunelamento do portador, e isso requer a concentração de dopagem limitada do semicondutor. Os valores comuns de concentração de doping são 10 16 –10 17 cm −3 no β- Ga 2 O 3 substrato ou camada de epitaxi [56,57,58,59,60,61,62]. A altura da barreira é realmente afetada pelos estados da interface e se desvia de uma relação simples com a função de trabalho. O pré-tratamento de superfície visa reduzir os estados de interface, incluindo os vazios de oxigênio próximos à superfície e ligações pendentes [78].
O contato ôhmico é o elo básico entre o metal e o semicondutor. Uma baixa resistência específica de contato ôhmico é útil para os dispositivos para diminuir a resistência de contato ( R s ) e na resistência ( R em ) Os métodos tradicionais para obter resistência de baixo contato são a escolha de metal de baixa função de trabalho e dopagem pesada. Na verdade, a função de trabalho do metal de contato é sempre pouco influente para a formação do contato ôhmico devido à fixação dos estados da interface. A dopagem pesada do semicondutor torna-se a técnica primária para o contato ôhmico. Os principais objetivos são melhorar a concentração de portadores e diminuir a barreira da interface. O RTA (recozimento térmico rápido) melhora as características interfaciais e redunda na redução da resistência de contato. Y. Yao et al. testou nove metais como metais de contato ôhmico para o β- Ga 2 O 3 e descobriram que o titânio (Ti) e o índio (In) mostram um bom comportamento ôhmico sob condições específicas [79]. Após o recozimento em altas temperaturas, apenas o titânio pode manter a morfologia contínua. Semelhante a isso, a maioria dos estudos aplicou titânio como o metal ôhmico de contato com β- Ga 2 O 3 e obteve desempenhos de dispositivo favoráveis [60,61,62,63,64,65,66,67,68,69,70].
O comportamento de quebra está relacionado à distribuição do campo elétrico no interior dos dispositivos, sendo que a junção cilíndrica e a junção esférica apresentam maior campo elétrico do que a junção de plano paralelo na mesma condição [1]. Portanto, alguns métodos de proteção de terminação de borda são necessários, como placa de campo para aumentar a tensão de ruptura [19, 23, 68]. Os estados de interface referidos como cargas de interface normalmente impactam o campo elétrico próximo à superfície do semicondutor e causam a quebra prematura. A corrente de fuga é o indicador do comportamento de ruptura e é comumente afetada pelos defeitos internos do semicondutor, incluindo deslocamentos. Ambas as situações causam a instabilidade dos dispositivos e podem diminuir a tensão de ruptura que deve ser evitada. A prática comum para reduzir o impacto dos estados da interface é a passivação da superfície, e substrato de alta qualidade também é necessário para aumentar a tensão de ruptura.
Diodo de barreira Schottky baseado em β- Ga 2 O 3
As dificuldades no crescimento de substratos monocristalinos de alta qualidade e baixo custo afetaram a comercialização de dispositivos de SiC e GaN. Enquanto Ga 2 O 3 substratos de cristal único podem ser cultivados por método de fusão de baixo custo, os dispositivos de energia baseados em Ga 2 O 3 o único cristal tem atraído muita atenção nos últimos anos. Atualmente, a tecnologia de dopagem tipo n de Ga 2 O 3 é bastante maduro, mas a falta de doping do tipo p torna Ga 2 O 3 incapaz de ser aplicado em dispositivos bipolares. O bandgap ultra grande o torna uma grande vantagem na aplicação de dispositivos unipolares. Portanto, o desenvolvimento do Ga 2 O 3 dispositivos de energia é dominado por dois tipos de dispositivos unipolares, ou seja, o diodo de barreira Schottky (SBD) e o transistor de efeito de campo semicondutor de óxido metálico (MOSFET) [23, 55, 56].
Com o desenvolvimento da tecnologia de material semicondutor de largura de banda (WBG), o dispositivo SBD baseado no semicondutor WBG começa a substituir o diodo de junção p-n para aplicar no sistema eletrônico de potência porque nenhum efeito de armazenamento de portadora minoritária existe no SBD e sua perda de comutação é muito baixa. Em teoria, em comparação com SiC e GaN SBD, Ga 2 O 3 O SBD pode atingir a mesma tensão de ruptura com uma camada de deriva muito mais fina. Ao mesmo tempo, uma camada de deriva mais fina diminui a capacitância parasitária, encurtando o tempo de recuperação reversa do dispositivo. O principal progresso de desenvolvimento do Ga 2 O 3 O SBD é mostrado na Fig. 4. Com o desenvolvimento da tecnologia epitaxial, a estrutura do SBD se desenvolveu a partir da estrutura simples baseada em substrato inicial para o substrato e estrutura complexa baseada em filme epitaxial. Posteriormente, por meio da exploração gradual dos processos de fabricação do dispositivo, surgiram estruturas terminais avançadas, incluindo placa e trincheira, melhorando ainda mais o desempenho do dispositivo. Ga 2 O 3 SBD começa a apresentar seu potencial em aplicações de eletrônica de potência.
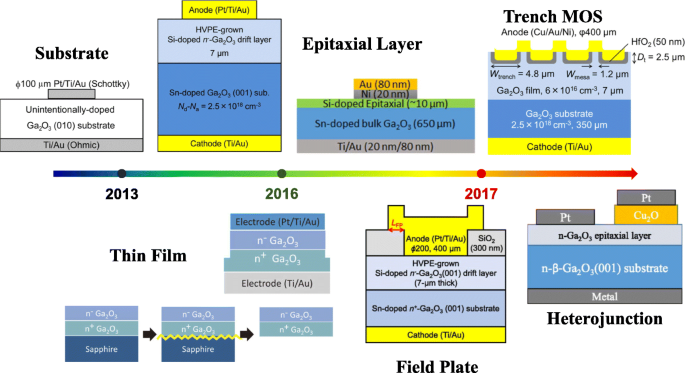
O desenvolvimento de Ga 2 O 3 SBD nos últimos anos [16, 18, 62, 68-71]
Como um novo material semicondutor de gap largo, as pessoas enfrentaram muitos problemas básicos no estágio inicial de desenvolvimento do Ga 2 O 3 , então o progresso de desenvolvimento de Ga 2 O 3 O SBD reflete muito bem a evolução do SBD de potência. A parte mais importante no SBD é a junção Schottky, portanto, nos primeiros trabalhos de pesquisa em Ga 2 O 3 SBD, há um número substancial de pessoas focadas no estudo da junção Schottky, principalmente incluindo o contato entre Ga 2 O 3 e diferentes eletrodos Schottky (Ni 、 Cu 、 Au 、 Pt 、 TiN) [57,58,59], o mecanismo de transporte de elétrons da junção Schottky, os problemas de estados de interface, inomogeneidade de barreira e força de imagem existente no contato Schottky, e os métodos de como adquirir contato ôhmico perfeito na interface do cátodo [60, 61].
Com a clareza gradual das propriedades físicas e a melhoria cada vez maior dos processos de fabricação, o desempenho do dispositivo é aprimorado progressivamente. A seguir estão alguns trabalhos típicos no desenvolvimento de Ga 2 O 3 SBD.
Em 2013, K. Sasaki et al. em Tamura Corporation fabricado SBD com base em alta qualidade (010) β –Ga 2 O 3 substrato de cristal único cultivado pelo método da zona flutuante [62]. Eles investigaram o impacto das diferentes concentrações de dopagem no substrato sobre o desempenho do dispositivo e descobriram que a maior concentração de dopagem induziu menor resistência na resistência, mas menor tensão de ruptura reversa e maior corrente de fuga reversa. A Figura 5 mostra as características de degradação reversa dos dois SBDs fabricados com (010) β –Ga 2 O 3 substratos com diferentes concentrações de dopagem. A tensão de ruptura chega a 150 V. O fator de idealidade de ambos os dispositivos é próximo a 1. E a altura da barreira Schottky do Pt / β –Ga 2 O 3 interface foi estimada em 1,3-1,5 eV.
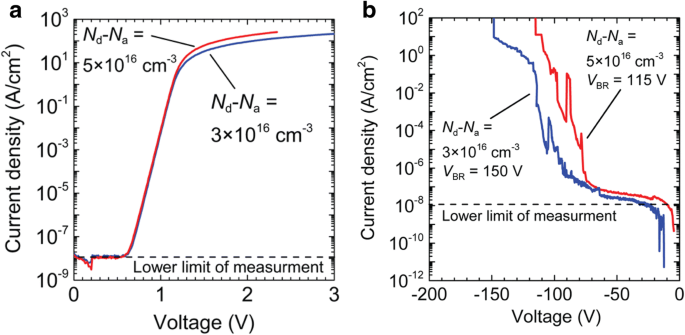
a , b Características elétricas de avanço e reverso do SBD com base em (010) β -Ga 2 O 3 substratos com diferentes concentrações de dopagem. O limite inferior da medição da densidade de corrente é 10 -8 A / cm 2 . Reproduzido da ref. [62]
Pesquisadores do Instituto de Microeletrônica da Academia Chinesa de Ciências (IMECAS) e da Universidade de Shandong colaboraram para investigar o SBD com base em β orientado para (100) –Ga 2 O 3 substrato a granel. Em 2017, eles relataram um Pt / β –Ga 2 O 3 SBD e suas características elétricas dependentes da temperatura. A análise de difração de raios-X (XRD) e microscopia eletrônica de transmissão de alta resolução (HRTEM) mostrou que o β –Ga 2 O 3 O cristal único crescido pela técnica de crescimento alimentado por filme definido por borda (EFG) apresentou boa orientação (100) e boa qualidade de cristal (Figs. 6a, b). Por meio de medições I – V e modelagem de emissão termiônica, o Pt / β fabricado –Ga 2 O 3 O dispositivo SBD exibiu bons desempenhos, incluindo taxa de retificação de 10 10 , fator de idealidade ( n ) de 1,1, altura da barreira Schottky ( Φ B ) de 1,39 eV, tensão de limiar ( V bi ) de 1,07 V, na resistência ( R em ) de 12,5 mΩ cm 2 , densidade de corrente direta a 2 V ( J @ 2V ) de 56 A / cm 2 , e concentração efetiva de doadores ( N d - N a ) de 2,3 × 10 14 cm −3 (Figs. 6c, d). Bom desempenho dependente da temperatura também foi encontrado no dispositivo (Figs. 6e, f). Com o aumento da temperatura, R em e J @ 2V ficou melhor, demonstrando que o dispositivo funcionava bem em altas temperaturas. Em seu trabalho seguinte, eles investigaram mais profundamente a dependência do fator de idealidade e da altura da barreira de Schottky com a temperatura e descobriram que este tipo de características de temperatura pode ser explicado pela distribuição gaussiana da falta de homogeneidade da altura da barreira [61]. Em 2018, eles otimizaram ainda mais os parâmetros de crescimento do cristal e melhoraram a concentração de dopagem de Sn ( N d - N a =2,3 × 10 14 cm −3 ) O novo Pt / β –Ga 2 O 3 O dispositivo SBD mostra desempenho significativamente melhorado, incluindo densidade de corrente direta ( J @ 2V =421 A / cm 2 ), Resistência do estado ON ( R em =2,9 mΩ cm 2 ), um curto tempo de recuperação reversa (20 ns) e uma tensão de ruptura reversa superior a 200 V [63]. Seu trabalho indica que EFG cresceu β –Ga 2 O 3 o cristal único é uma promessa para a aplicação de dispositivos de energia.

a Curva de difração de raios-X (XRD) de (100) β -Ga 2 O 3 substrato de cristal único, mostrando claramente os picos dos planos (400), (600) e (800). b Imagem de microscópio eletrônico de transmissão de alta resolução (HRTEM) transversal de Pt / β -Ga 2 O 3 Contato Schottky e micrografia de transformada rápida de Fourier (FFT) de β -Ga 2 O 3 cristal. c Curva J – V direta e reversa de um Pt / β -Ga 2 O 3 SBD e o esquema do SBD (detalhe). d Curva J – V direta em gráfico linear e semilogarítmico. e Curvas J – V dependentes da temperatura e o gráfico de Richardson (detalhe). f Dependência da resistência ON e densidade de corrente direta na temperatura. Reproduzido da ref. [60]
Q. Feng et al. da Xidian University estudaram os processos de preparação de deposição de laser pulsado (PLD) e as propriedades físicas básicas do dopado com Al β –Ga 2 O 3 filme [64,65,66]. Doping Al é capaz de ajustar o bandgap de β –Ga 2 O 3 incorporando diferentes razões de átomos de Al. Baseado neste tipo de filme dopado com Al, Ni / β - (AlGa) 2 O 3 O dispositivo SBD foi fabricado e caracterizado. A altura da barreira Schottky é de 1,33 eV. A atual relação liga-desliga e resistência liga chega a 10 11 e 2,1 mΩ cm 2 , respectivamente [65]. Eles também estudaram a influência da temperatura no fator de idealidade e na altura da barreira Schottky e também concluíram que essas características de dependência da temperatura de n e Φ B foram atribuídos à falta de homogeneidade da barreira de Schottky, assumindo a existência de uma distribuição gaussiana da altura da barreira [66].
Com o desenvolvimento da tecnologia de epitaxia de filme, a epitaxia de fase de vapor de haleto (HVPE) foi utilizada para cultivar Ga 2 O 3 filme. Devido às vantagens da velocidade rápida da epitaxia e da alta qualidade do filme, Ga cultivado em HVPE 2 O 3 é muito adequado para fabricar a camada de deriva do SBD de alta tensão. Em 2015, M. Higashiwaki et al. no Instituto Nacional de Tecnologia da Informação e Comunicação (NICT) cresceu 7 μm de espessura levemente dopado (~ 1 × 10 16 cm −3 ) camada epitaxial na camada altamente dopada ( N d - N a =2,5 × 10 18 cm −3 ) (001) β- Ga 2 O 3 substrato através do método HVPE e dispositivo SBD posteriormente fabricado. As características C – V e I – V do dispositivo em diferentes temperaturas foram investigadas. A tendência de mudança da altura da barreira Schottky, tensão de limiar, curvas C – V e I – V com a temperatura foi apontada. A Figura 7 mostra a estrutura do dispositivo e as curvas direta e reversa J – V – T [16]. Verificou-se que a 21–200 ° C, a altura da barreira manteve-se quase constante. A corrente direta e reversa concordou bem com o modelo de emissão termiônica (TE) e emissão de campo termiônico (TFE), respectivamente. Seus resultados demonstraram o potencial da aplicação do Ga 2 O 3 SBD em dispositivos de energia de última geração.
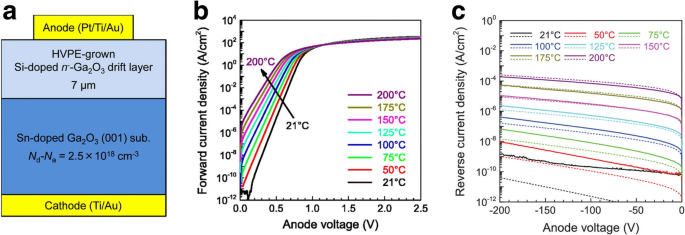
a Estrutura do dispositivo SBD com base no n - crescido em HVPE com 7 μm de espessura - Ga 2 O 3 camada de deriva homoepitaxial em n + - Ga 2 O 3 substrato de cristal único. b Características de avanço J – V do dispositivo medidas a 21–200 ° C. c J – V reverso a 21–200 ° C (linhas sólidas e pontilhadas representam os resultados experimentais e simulados, respectivamente). Reproduzido da ref. [16]
Em 2016, M. Oda et al. na FLOSFIA Inc. publicou um trabalho sobre α -Ga 2 O 3 SBD [18]. Por meio de uma técnica de deposição de vapor químico por névoa (CVD), ou seja, MIST EPITAXY®, eles cresceram pesadamente (3-4 μm de espessura) e levemente dopados com α -Ga 2 O 3 filmes em safira (Al 2 O 3 ) substratos. Depois de levantar o α -Ga 2 O 3 camadas dos substratos, cátodo e ânodo foram depositados na superfície inferior e superior do n - - Ga 2 O 3 / n + - Ga 2 O 3 camadas, respectivamente (Fig. 8). O dispositivo com um n - de 2580 nm de espessura - Ga 2 O 3 camada mostrou uma alta tensão de ruptura de 855 V e uma resistência de 0,4 mΩ cm 2 . Enquanto o dispositivo com um mais fino (430 nm) n - - Ga 2 O 3 SBDs de camada exibiram uma resistência muito baixa de 0,1 mΩ cm 2 e uma tensão de ruptura de 531 V. Em 2018, eles relataram ainda este tipo de dispositivo conduzido com um pacote TO220 [67]. A capacitância da junção de 130 pF foi obtida, então o dispositivo apresentou uma melhor característica de recuperação reversa em comparação com SiC SBD e Si SBD. Ao mesmo tempo, após a embalagem, o dispositivo exibiu uma resistência térmica de 13,9 ° C / W, comparável àquela do SiC SBD com a mesma embalagem (12,5 ° C / W), demonstrando que a adoção de camada de deriva fina pode efetivamente compensar o desvantagem da má condutividade térmica de Ga 2 O 3 material. Neste relatório, os autores também apontaram que α - (Rh, Ga) 2 O 3 pode atuar como uma camada de canal do tipo p eficaz de α -Ga 2 O 3 dispositivos.

Processos de fabricação do α -Ga 2 O 3 SBD proposto por FLOSFIA Inc. Reimpresso da ref. [18, 67]
Em 2017, K. Konishi et al. em NICT relatou um Pt / HVPE-n - - Ga 2 O 3 / (001) n + - Ga 2 O 3 Dispositivo SBD com uma tensão de ruptura de 1076 V e uma resistência ligada de 5,1 mΩ cm 2 (Fig. 9) [68]. Engenharia de placa de campo (FP), um tipo de tecnologia de terminação de borda, foi usada pela primeira vez no Ga 2 O 3 SBD. Adicionando um ânodo conectado SiO 2 FP, o campo elétrico máximo em toda a estrutura do dispositivo foi mantido abaixo do campo crítico, especialmente o campo elétrico ao redor do ânodo pode ser obviamente diminuído. Empregando este método, tanto a alta tensão de ruptura quanto a baixa resistência podem ser alcançadas. No mesmo ano, uma tensão de ruptura mais alta (1600 V) foi relatada por J. Yang, et al. da Universidade da Flórida em seu dispositivo SBD com um Ni / MOCVD-n - - Ga 2 O 3 / (- 201) n + - Ga 2 O 3 estrutura [69], mas a resistência ligada é muito grande (25 mΩ cm 2 ) Nenhuma terminação de borda foi usada. A investigação mostrou que o tamanho do eletrodo Schottky teve uma influência na tensão de ruptura e na resistência, porque um eletrodo maior teria mais defeitos e facilitaria a ruptura.
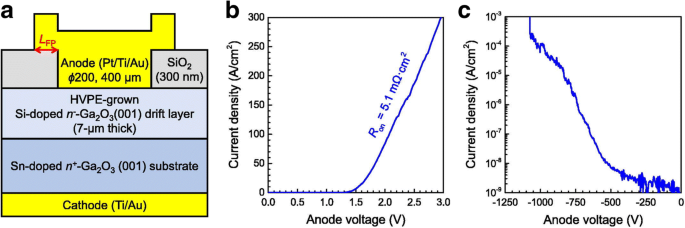
a Structure of the SBD with field plate. b , c Forward and reverse electrical characteristics (V br = 1076 V). Reprinted from ref. [68]
In 2017, K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 O 3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O 3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O 3 SBD exhibited superiority in switching loss.
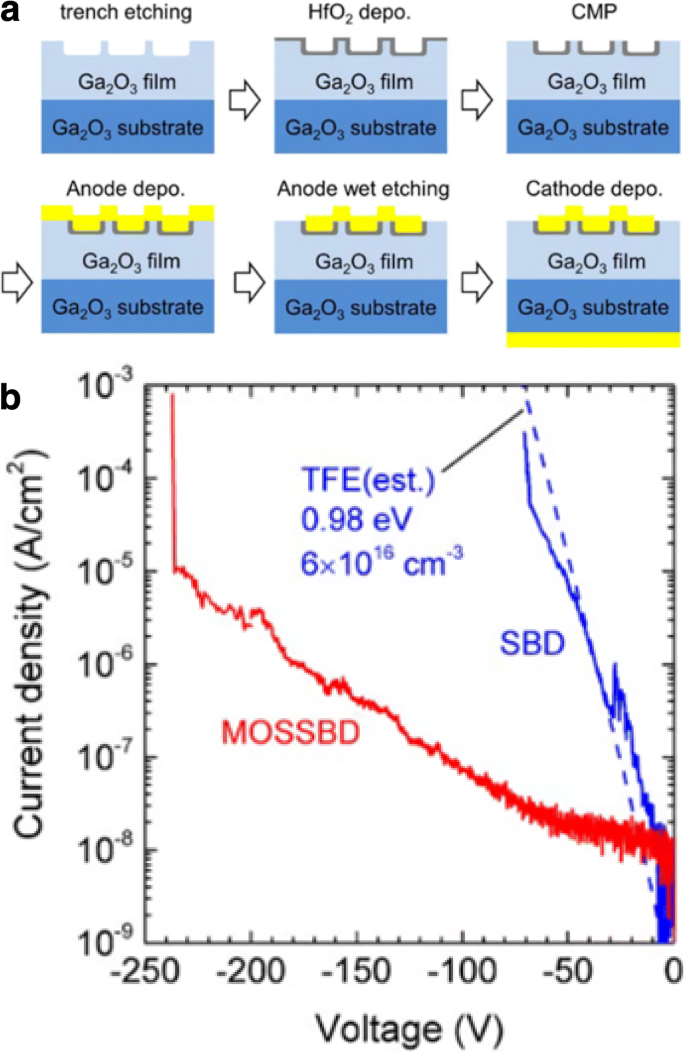
a Fabrication processes of the MOS-type Ga2 O 3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2 O 3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O 3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O 3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O 3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O 3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O 3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O 3 device before the successful preparation of p-type Ga2 O 3 .
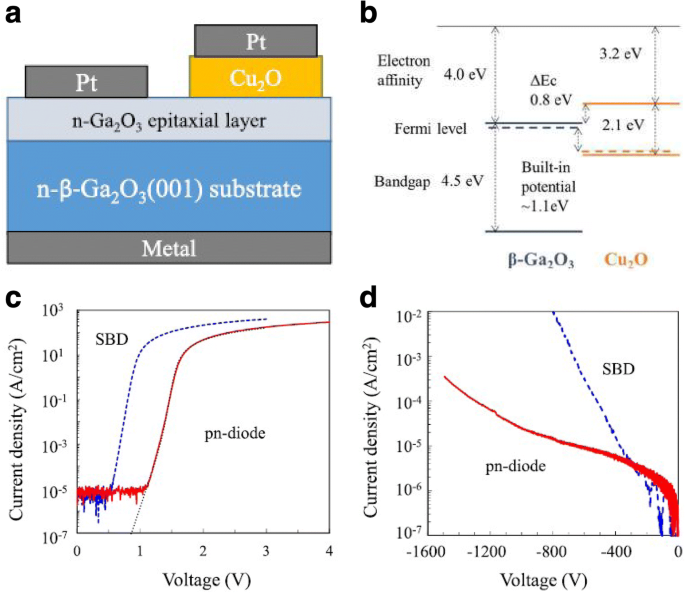
a Schematic of the cross-sectional Pt/Ga2 O 3 SBD and p-Cu2 O/n-Ga2 O 3 diode. b Band diagram of the p-Cu2 O/n-Ga2 O 3 interface. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O 3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O 3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O 3 SBD single device.

a Rectification circuit. b - e Rectifying effect of Pt/Ga2 O 3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O 3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Conclusões
Currently, Ga2 O 3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O 3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O 3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O 3 will better display its unique application value, which requires the joint efforts of the researchers.
Abreviações
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- CVD:
-
Deposição de vapor químico
- EFG:
-
Edge-defined film-fed growth
- FFT:
-
Fast Fourier transform
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
Metal-organic chemical vapor deposition
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
Pulsed laser deposition
- SBD:
-
Schottky barrier diode
- TE:
-
Thermionic emission
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
Difração de raios X
Nanomateriais
- Escolhendo os corantes solventes de melhor qualidade para uma aplicação perfeita
- 10 fatores para encontrar a opção perfeita para seu aplicativo
- Aproveitando o poder das cidades inteligentes para um futuro mais brilhante
- Em eletrônicos, a Índia pretende se tornar uma ‘Fábrica para o mundo’
- A busca por um gerador sobressalente:4 perguntas vitais
- As melhores opções de fabricação para gabinetes eletrônicos
- Uma rápida visão geral das perspectivas do mercado de guindastes para os próximos anos
- Escolhendo o gerador de energia certo para sua empresa
- O material de eletrodo certo para sua aplicação de soldagem por resistência
- Como escolher o filtro certo para seu aplicativo



