RRAM baseado em HfAlOx depositado em camada atômica com baixa tensão operacional para aplicativos de computação na memória
Resumo
Com a lei de Moore chegando ao seu limite físico, a arquitetura tradicional de von Neumann está enfrentando um desafio. Espera-se que a memória de acesso aleatório resistiva baseada em arquitetura de computação (RRAM) possa ser uma candidata potencial para superar o problema de gargalo de von Neumann dos computadores tradicionais [Backus, J, Pode a programação ser liberada do estilo de von Neumann ?, 1977]. Neste trabalho, RRAM baseado em HfAlOx compatível com a tecnologia CMOS foi fabricado por um processo de deposição de camada atômica (ALD). Metal Ag e TaN são selecionados como eletrodos superiores (TE). Experimentos mostram que o dispositivo Ag / HfAlOx / Pt demonstrou vantagens como dispositivo de computação de memória devido à baixa tensão de ajuste (0,33 ~ 0,6 V), o que significa baixo consumo de energia e boa uniformidade. Com base em uma estrutura Ag / HfAlOx / Pt, a lógica IMP foi implementada em alta velocidade aplicando um pulso de baixa voltagem de alta frequência de 100 ns (0,3 V e 0,6 V). Após duas etapas de implementação do IMP, o NAND também pode ser obtido.
Histórico
Para as fronteiras entre armazenamento e computação, os pesquisadores propuseram uma série de programas de pesquisa:memória de alta largura de banda, computação próxima à memória e redes de compressão neural. Esses métodos podem reduzir o tempo de acesso à memória, mas não resolvem esse problema fundamentalmente. Para resolver esse problema fundamentalmente, o conceito de computação in-memory ganhou atenção em todo o mundo. É importante notar que um dispositivo de memória de acesso aleatório resistivo (RRAM) atraiu a atenção generalizada como um candidato competitivo para o dispositivo de computação não-von Neumann devido à sua capacidade de computação in-memory [1,2,3,4,5, 6]. Dispositivos de computação in-memory atuam tanto como unidades de computação quanto de armazenamento no mesmo circuito [7]. Foi proposto pela primeira vez em 1971 por Chua [8]. Quase 40 anos depois, a operação lógica baseada em RRAM foi proposta pela primeira vez em 2010 [9]. Desde então, dispositivos de computação in-memory baseados em RRAM foram extensivamente estudados e muitos métodos de implementação foram propostos [10,11,12,13,14]. Mas, como um dispositivo de computação in-memory, o recurso mais importante é a estabilidade e o baixo consumo de energia. Ainda existem muitas questões nesta área que precisam ser exploradas. Nesta carta, dois tipos de dispositivos RRAM foram construídos e as propriedades elétricas foram testadas. No processo de implementação de operações lógicas, tensões de ajuste e reset estáveis e boa uniformidade entre os dispositivos são indicadores muito importantes.
Até agora, uma grande variedade de materiais mostraram comportamentos RRAM, mas poucos deles eram compatíveis com o processo CMOS. O filme binário de óxidos de alta k HfAlOx foi depositado usando deposição de camada atômica (ALD). ALD é bem adequado para deposição de filmes de óxido e sobre camadas para vários dispositivos e aplicações [15] porque é baseado na saturação da superfície e a dosagem precisa do precursor não é necessária. HfAlOx pode ser bem compatível com o processo CMOS tradicional e usado como a camada dielétrica do dispositivo de computação in-memory. Os dispositivos Ag / HfAlOx / Pt RRAM foram usados para implementar operações lógicas com estado. A lógica IMP foi considerada como uma das quatro operações lógicas fundamentais (OR, AND, NOT e IMP) por Whitehead e Russell em 1910 [16]. Além disso, a lógica NAND pode ser obtida por duas etapas da lógica IMP. A lógica NAND é conhecida como lógica universal, o que significa que qualquer lógica booleana pode ser construída por meio da lógica NAND. Este dispositivo de computação na memória compatível com CMOS, de alta velocidade e baixa tensão de operação mostra uma maneira eficaz de resolver as dificuldades da estrutura tradicional de von Neumann no futuro.
Métodos
Neste trabalho, os dispositivos Ag / HfAlOx / Pt e TaN / HfAlOx / Pt foram fabricados, respectivamente. O esquema é mostrado na Fig. 1a. Primeiro, um eletrodo de fundo de Pt com filme fino de 70 nm foi depositado por deposição física de vapor (PVD) no SiO 2 limpo Substrato / Si. Em seguida, um filme binário de alto k óxido HfAlOx com uma espessura de 16 nm foi depositado usando ALD derivado de tetraquisetilmetilamino háfnio (TEMAH), trimetil alumínio (TMA) e H 2 O precursores a 240 ° C. Finalmente, 50 nm Ag ou TaN filme eletrodo superior foi fabricado por fotolitografia e fabricado por PVD. Com polarização no eletrodo superior e aterramento no eletrodo inferior, as medições de corrente contínua dos dispositivos foram realizadas por um semicondutor Agilent B1500A em temperatura ambiente. Além disso, as medições lógicas foram realizadas usando um analisador de parâmetros de dispositivo semicondutor Agilent B1500A e duas unidades geradoras de pulso semicondutor (SPGU).

a O esquema dos dispositivos Ag / HfAlOx / Pt e TaN / HfAlOx / Pt. b Espectro XPS do HfAlO de 16 nm
Resultado e discussão
Memória e processador são separados em uma arquitetura de computador tradicional de von Neumann [17]. O tempo de transferência de dados armazenados na memória e calculados na unidade de computação limita muito o desempenho do computador. É possível quebrar a limitação operando os dados diretamente na memória. A pesquisa de computação in-memory tem o potencial de quebrar esse limite.
Para demonstrar as funções lógicas, RRAM foi preparado com Ag / HfAlOx / Pt e TaN / HfAlOx / Pt. O esquema é mostrado na Fig. 1a; dois dispositivos pequenos junto com um dispositivo grande formam uma unidade lógica IMP lógica RRAM mínima. Lógicas diferentes podem ser implementadas usando várias células IMP. Os filmes de HfAlOx de 16 nm cultivados por ALD foram caracterizados por espectroscopia de fotoemissão de raios-X (XPS). Como mostrado na Fig. 1b, os espectros XPS completos e Hf4f, Al2p, C1s e O1s são exibidos. A partir dos resultados do XPS, pode-se concluir que os filmes ALD HfAlO foram obtidos com sucesso. As Figuras 2a eb exibem o I - V características de comutação bipolar do Ag / HfAlOx / Pt e TaN / HfAlOx / Pt medidas por um analisador de parâmetros de dispositivo semicondutor Agilent B1500A. A tensão de varredura foi aplicada de - 1,5 a 1,5 V (para Ag) e - 3 a 3 V (para TaN) e uma tensão de leitura de 0,1 V à temperatura ambiente. A razão de resistência de ambas as estruturas Ag / HfAlOx / Pt e TaN / HfAlOx / Pt é mostrada na Fig. 3a e b. Um dispositivo com Ag como um eletrodo superior pode ter uma razão de resistência de 103 e TaN como o eletrodo superior pode chegar a 60. Ambos os eletrodos superiores de Ag e TaN exibem características de comutação bipolar superiores. A distribuição da tensão de operação set e reset é apresentada como histogramas nas Fig. 3c e d, respectivamente. Os dispositivos Ag / HfAlOx / Pt exibem tensão SET muito mais baixa. Os desempenhos das duas estruturas são comparados. A voltagem SET e RESET dos dispositivos Ag / HfAlOx / Pt foi de 0,33 a 0,62 V e de - 1,3 a - 1,5 V e os dispositivos TaN / HfAlOx / Pt foi de 0,8 a 1,8 V e de - 1,3 a - 2 V Após comparação, verificou-se que o dispositivo que utiliza Ag como eletrodo superior é mais adequado como dispositivo para implementação de lógica devido à melhor estabilidade e menor tensão de operação.
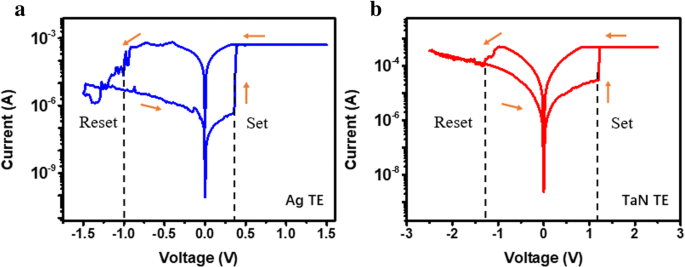
Características típicas de corrente-tensão de Ag / HfAlOx / Pt ( a ) e dispositivos TaN / HfAlOx / Pt ( b )

Características de resistência e distribuição definida / redefinida de Ag / HfAlOx / Pt ( a , c ) e dispositivo TaN / HfAlOx / Pt ( b , d ) menos de 100 ciclos de varredura DC consecutivos
Além disso, o mecanismo de comutação dos dois tipos de estrutura é mais exposto. O I – V as curvas são analisadas na Fig. 4a – d. As curvas são feitas em coordenadas logarítmicas para analisar o status atual no estado de baixa resistência (LRS) e estado de alta resistência (HRS), respectivamente. É mostrado na Fig. 4a eb o transporte de corrente de dispositivos Ag / HfAlOx / Pt exibem corrente ôhmica durante a varredura de tensão. Seja aplicando uma tensão direta ou aplicando uma tensão negativa para dispositivos TaN / HfAlOx / Pt mostrados na Fig. 4c e d, a corrente quase ôhmica (a inclinação é aproximadamente igual a 1) é apresentada no LRS, enquanto ôhmica, quase ôhmica, e a corrente limitada de carga espacial é apresentada em HRS no campo elétrico positivo.

A adaptação atual dos dispositivos Ag / HfAlOx / Pt sob a positivo e b campos elétricos negativos e o ajuste de corrente dos dispositivos TaN / HfAlOx / Pt sob c positivo e d campos elétricos negativos
A razão para esse fenômeno é que o mecanismo de mudança de resistência dos dispositivos TaN / HfAlOx / Pt é devido à geração de avalanching e recombinação do íon de oxigênio e da camada dielétrica de vacância de oxigênio. Em dispositivos Ag / HfAlOx / Pt, a formação e ruptura de filamentos condutores, graças às reações redox do Ag metálico, podem ser impulsionadas por um campo elétrico muito menor.
Neste experimento, o estado de baixa resistência (LRS) foi definido como lógico 1 e o estado de alta resistência (HRS) como lógico 0. O diagrama de teste da lógica IMP é mostrado na Fig. 5a. É implementado por dois dispositivos RRAM P e Q e um resistor de carga fixa. Os estados de P e Q são representados por p e q, respectivamente. O IMP é executado por dois pulsos de tensão simultâneos:Va e Vb (definimos Va> Vset> Vb e Va - Vb
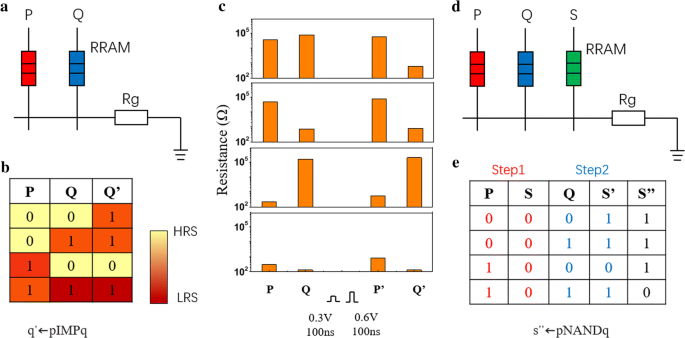
O diagrama de teste de IMP ( a ) e NAND ( d ) lógica. b A tabela verdade para a operação q ← pIMPq ( c ) eq ← pNANDq ( e ) O estado muda de P e Q com pulso ( c )
s ′ ← pIMPs (1).
s ′ ′ ← qIMPs ′ (2).
As tabelas verdade mostrando a equivalência da seqüência de operações para NAND são mostradas na Fig. 5e.
Conclusão
Em resumo, dois tipos de dispositivos (Ag / HfAlOx / Pt e TaN / HfAlOx / Pt) foram fabricados neste estudo. Ambos os dispositivos apresentam características de comutação superiores. O dispositivo Ag / HfAlOx / Pt demonstrou vantagens como um dispositivo de computação na memória, como compatibilidade CMOS, boa uniformidade, baixa tensão operacional e baixo consumo de energia. A lógica foi implementada por meio de dispositivos Ag / HfAlOx / Pt RRAM. A realização de dispositivos in-memory de computação de baixa tensão de operação fornece uma maneira eficaz de resolver as dificuldades da estrutura tradicional de von Neumann no futuro.
Abreviações
- ALD:
-
Deposição de camada atômica
- HRS:
-
Estado de alta resistência
- LRS:
-
Estado de baixa resistência
Nanomateriais
- Repensando a modernização de aplicativos para CIOs com o Google Cloud Platform
- Melhores práticas de segurança para Fog Computing
- ST:kit de avaliação de elemento seguro com software pronto para uso para aplicativos de TI e IoT
- Infineon:novo sensor de corrente para aplicações industriais cobre ± 25 A a ± 120 A faixa
- Renesas:RX72M MCUs com suporte EtherCAT para aplicações industriais
- American Control Electronics:drive DC de baixa tensão com opção de placa programável snap-on
- Administração de medicamentos baseados em células para solicitações de câncer
- Uma SRAM 4T integrada RRAM com carga de comutação resistiva autoinibida por processo lógico CMOS puro
- GE contribui para a necessidade de novas aplicações industriais com a linha Hornet
- Quais são as aplicações mais comuns para corrente CA?



