Investigando propriedades condutivas dependentes do tamanho em nanofios de Si individuais
Resumo
Matrizes ordenadas periodicamente de nanofios de Si alinhados verticalmente (Si NWs) são fabricados com sucesso por litografia de nanosfera combinada com corrosão química assistida por metal. Ajustando o tempo de corrosão, o diâmetro e o comprimento dos nanofios podem ser bem controlados. As propriedades condutoras de tais Si NWs e particularmente sua dependência de tamanho são investigadas por microscopia de força atômica condutiva (CAFM) em nanofios individuais. Os resultados indicam que a condutância de Si NWs é muito relevante para seu diâmetro e comprimento. Si NWs com diâmetros menores e comprimentos mais curtos exibem melhores propriedades condutoras. Juntamente com a caracterização da curva I – V, um possível mecanismo é suposto com o ponto de vista da altura da barreira Schottky dependente do tamanho, que é posteriormente verificado pelas medições de microscopia de força eletrostática (EFM). Este estudo também sugere que o CAFM pode atuar como um meio eficaz para explorar a dependência do tamanho (ou outros parâmetros) das propriedades condutoras nas nanoestruturas individuais, o que deve ser essencial para a otimização da fabricação e aplicações potenciais das nanoestruturas.
Introdução
Nanofios de silício (Si NWs) ganharam aplicações promissoras em campos eletrônicos, fotônicos, optoeletrônicos e muitos outros devido à sua alta razão de aspecto e propriedades elétricas, termoelétricas e fotoelétricas únicas, bem como a compatibilidade com a tecnologia de silício tradicional [1,2,3 , 4,5]. Nas últimas décadas, as pesquisas de Si NWs se concentraram principalmente nas melhorias de crescimento e medições de propriedades. Muitos métodos foram desenvolvidos para preparar Si NWs, incluindo métodos de baixo para cima, como método de vapor-líquido-sólido, deposição de vapor químico e epitaxia de feixe molecular [6,7,8,9,10] e abordagens de cima para baixo usando elétrons - litografia de feixe, corrosão iônica reativa ou corrosão química assistida por metal [11,12,13,14,15,16]. Entre esses métodos, a litografia de nanosfera (NSL) combinada com corrosão química assistida por metal (MACE) foi intensamente adotada para fabricar matrizes ordenadas de grande área de Si NWs verticalmente alinhados por sua simplicidade, baixo custo e versatilidade [15,16,17 , 18,19,20,21,22,23]. Os Si NWs alcançados pelo MACE costumam ter superfícies muito rugosas e até porosas [18,19,20,21], o que apenas os faz possuírem uma grande área superficial específica e excelentes propriedades, levando a grandes potenciais de aplicação em biossensores, dispositivos termoelétricos, lítio - baterias de íons, células solares, etc. [22,23,24]. Para realizar essas aplicações, é essencial obter um bom entendimento de suas propriedades elétricas. Hoje em dia, dois tipos de métodos têm sido frequentemente aplicados para investigar as propriedades elétricas dos nanofios. Um é realizado por métodos macroscópicos comuns, o que é relativamente fácil de fazer, mas só pode fornecer resultados médios em uma grande montagem de nanofios [24, 25]. O outro é realizado em nanofios individuais com dispositivos especiais de nanofio único fabricados [21, 26,27,28], o que poderia excluir a influência da inomogeneidade do tamanho, mas não é fácil de alcançar, especialmente ao medir a dependência de propriedade. Portanto, métodos mais convenientes para estudar as propriedades elétricas em NWs individuais sem nanofabricação complexa são fortemente necessários.
Nas últimas décadas, medições elétricas baseadas em microscopia de sonda de varredura (SPM) revelaram-se como técnicas poderosas para caracterizações elétricas em nanoescala [29, 30]. Dentre essas técnicas de SPM, a microscopia de força atômica condutiva (CAFM) tem sido aplicada com sucesso para estudar as propriedades condutoras em nanoestruturas individuais ou individuais [30,31,32]. As investigações do CAFM em uma variedade de nanofios, como ZnO, InAs, CdS, CdSe, GaAs, InAsSb e Si NWs, já foram relatadas [33,34,35,36,37,38]. Enquanto a maioria das pesquisas se concentra nas propriedades condutoras de nanofios com parâmetros fixos, algumas investigações foram realizadas para explorar a dependência de dopagem das propriedades condutoras [37,38,39]. As dependências de tamanho das propriedades condutoras dos nanofios foram muito menos investigadas ainda. Apenas alguns estudos foram relatados sobre as propriedades condutivas dependentes do diâmetro dos nanofios, mesmo não restritas ao CAFM, e uma parte considerável deles lidou com a dependência do diâmetro da resistividade dos nanofios [25, 40,41,42]. Por exemplo, algumas pesquisas em nanofios de GaN descobriram que a resistividade era alta em um diâmetro crítico (20 ~ 80 nm, dependendo dos métodos de fabricação) e manteve-se inalterada além dele [41, 43], enquanto outras pesquisas em nanofios de Si relataram que a resistividade do nanofio diminuiu com o aumento do diâmetro na faixa de dezenas a centenas de nanômetros [40, 44]. Para nanofios semicondutores com contatos de metal, a barreira de Schottky pode desempenhar um papel importante em suas propriedades condutoras. Portanto, exceto pela resistividade, a barreira de Schottky deve ser levada em consideração na presença de nanofios semicondutores. Vários trabalhos focaram na dependência do diâmetro da altura da barreira Schottky (SBH), mas os resultados não são consistentes. Por exemplo, Calahorra et al. calculou o SBH resolvendo a equação de Poisson em nanofios e encontrou uma tendência clara de aumento da altura da barreira com redução de tamanho [45]. Dependência semelhante de diâmetro foi experimentalmente relatada por Soudi et al. ao investigar a fotovoltagem de superfície dependente do diâmetro e a densidade do estado de superfície no dispositivo de nanofio único de ZnO. Eles descobriram que a altura da barreira superficial aumentou com a diminuição do diâmetro (20-60 nm), o que foi interpretado pela densidade do estado de superfície simulada usando a equação de Poisson [46]. Por outro lado, as medições de microscopia fotocorrente de varredura em transistores de efeito de campo de nanofio de Si por Yoon et al. revelou uma dependência contrária, ou seja, a altura da barreira diminuiu com a diminuição do diâmetro devido à contribuição dos estados de interface [47]. Outro trabalho experimental de Mao et al. em diodos Schottky com nanoneedle Pt / ZnO única também relataram que a altura da barreira diminuiu com a diminuição do diâmetro, o que foi explicado por um efeito de aquecimento joule e / ou falta de homogeneidade eletrônica da interface [48]. Portanto, até agora, a dependência do diâmetro das propriedades condutoras dos nanofios ainda não atingiu um consenso e está longe de ser totalmente compreendida. Especialmente, as propriedades condutivas dependentes do tamanho, bem como os estudos de SBH dependentes do tamanho, não foram relatados em Si NWs individuais fabricados pelo método MACE, que têm uma superfície bastante rugosa para aplicações promissoras.
Neste artigo, arranjos periódicos de Si NWs alinhados verticalmente com diferentes diâmetros e comprimentos são preparados pelo método de NSL combinado com MACE. Tanto o diâmetro quanto o comprimento dos SiNWs podem ser bem controlados ajustando o tempo de corrosão. As propriedades condutivas de Si NWs individuais dentro da matriz são investigadas pelo CAFM sem qualquer nanofabricação adicional, que pode estudar as propriedades condutivas dependentes do tamanho em Si NWs individuais de forma conveniente, simplesmente substituindo a amostra. Os resultados demonstram que a corrente medida em Si NWs individuais é fortemente dependente do diâmetro e comprimento dos NWs. Si NWs com diâmetros menores e comprimentos mais curtos exibem melhores propriedades condutoras. A partir do ajuste da curva I – V, podem ser obtidas alturas de barreira Schottky dependentes do tamanho, que atuam como um fator chave para determinar as propriedades condutivas dependentes do tamanho dos nanofios. Além disso, SBH dependente de tamanho semelhante foi obtido por medições de microscopia de força eletrostática (EFM). Portanto, nosso estudo não apenas revela as propriedades dependentes do tamanho dos Si NWs, mas também sugere que o CAFM pode atuar como um meio eficaz para explorar a dependência do tamanho (ou outros parâmetros) das propriedades condutoras em nanoestruturas individuais.
Materiais e métodos
Materiais
Os wafers de Si foram adquiridos da MTI (China). As suspensões (2,5% em peso em água) de esferas de poliestireno (PS, 490 nm de diâmetro) foram adquiridas na Duke Scientific (EUA). Acetona, metanol, ácido sulfúrico, peróxido de hidrogênio e ácido fluorídrico para a fabricação de Si NWs foram adquiridos na Sinopharm Chemical Reagent (China). Água desionizada (DI, 18,2 MΩ · cm) foi obtida a partir de um sistema de ultrafiltração (Milli-Q, Millipore, Marlborough, MA).
Fabricação de Si NWs
Matrizes de nanofios de silício ordenadas verticalmente são fabricadas por NSL combinadas com MACE, que foram descritas em detalhes em literaturas anteriores [49, 50]. O principal processo de fabricação está programado na Fig. 1a. Em primeiro lugar, uma monocamada de esferas de poliestireno (PS) com um diâmetro de 490 nm foi automontada na pastilha de Si quimicamente limpa (tipo n, 0,01 Ω cm) para formar uma monocamada hexagonal compactada. Posteriormente, a amostra coberta com PS foi gravada por corrosão iônica reativa (RIE, Tecnologia Trion) (50 W, 70 mTorr) com O 2 gás (20 sccm) para reduzir o diâmetro do PS, que atuou como camada de máscara nos procedimentos a seguir. Posteriormente, um filme de Au de 20 nm foi depositado por pulverização catódica sobre a amostra mascarada pela camada de PS atuou como um catalisador para o tratamento MACE seguinte. A amostra foi tratada por MACE em HF (40%) e H 2 O 2 (30%) solução mista (proporção de volume 4:1) à temperatura ambiente. No processo MACE, a superfície de Si coberta com Au foi efetivamente atacada, enquanto a coberta por PS (sem Au) foi protegida, resultando na formação de Si NWs. Finalmente, a camada de Au e as esferas de PS restantes foram removidas por imersão da amostra em KI / I 2 e soluções de tetra-hidrofurano, respectivamente. Com este método de fabricação, arranjos periódicos de grande área de arranjos de Si NW alinhados verticalmente podem ser obtidos.

a Ilustração esquemática dos procedimentos para fabricar uma matriz de nanofios de Si alinhada verticalmente. b Diagrama esquemático das configurações experimentais para medições CAFM e EFM em nanofios de Si individuais
Caracterização de Si NWs
A morfologia dos Si NWs fabricados foi verificada por microscopia eletrônica de varredura (SEM, SIGMA300), enquanto suas propriedades estruturais foram investigadas por espectroscopia Raman (sistema Jobin Yvon HR-Evolution 2) com um comprimento de onda de excitação de 532 nm e uma baixa potência de cerca de 1 mW .
As propriedades elétricas dos Si NWs foram investigadas pela CAFM e EFM com um equipamento SPM comercial (Multimode V, Bruker Nano Surfaces), conforme diagramado na Fig. 1b. Pontas revestidas com Cr / Pt (Multi75E-G, sensores de orçamento, raio de aproximadamente 25 nm) foram usadas para medições CAFM e EFM. No CAFM, a ponta condutiva foi varrida sobre a superfície da amostra em modo de contato com uma tensão de polarização DC aplicada ao substrato enquanto a ponta estava aterrada, e a corrente entre a ponta e a amostra foi medida. Como a oxidação anódica de superfície é séria sob os enviesamentos de amostra positivos, todas as imagens atuais foram medidas em enviesamentos de amostra negativos. Várias tensões negativas variando de - 0,5 a - 3,0 V foram testadas nos experimentos CAFM. Foi descoberto que, quando a tensão de polarização foi ajustada abaixo de -1,5 V, a corrente era muito pequena para ser detectada em amostras com baixa condutância. Enquanto a tensão de polarização foi definida como - 2,0 V ou maior, as medições foram instáveis, provavelmente devido ao dano da ponta e / ou amostra sob um grande campo eletrostático. Portanto, a tensão de polarização de -1,5 V foi escolhida para as medições da imagem atual. As medições de EFM foram realizadas em Si NWs no modo de duas passagens. Na primeira passagem, funcionou no modo de batida para obter a imagem da topografia, enquanto na segunda passagem a ponta foi elevada o suficiente para ignorar a força de Van der Waals. Na passagem elevada, uma tensão DC foi adicionada entre a amostra e a ponta aterrada, e o sinal de mudança de fase induzido pela força eletrostática foi detectado. Todos os experimentos foram operados em um fluxo N 2 ambiente para medições elétricas estáveis e as amostras foram pré-imersas na solução de HF (5%) por 30 s para reduzir efetivamente a influência da camada de óxido na caracterização condutiva. Como as medições foram realizadas imediatamente após a imersão em HF, a camada de oxigênio reformada deve ser fina o suficiente para ser penetrada pela ponta condutiva e seu efeito na condutância é mínimo.
Resultados e discussões
Fabricação de Si NWs
A fabricação de matrizes de nanofios ordenados de Si alinhadas verticalmente de grande área é ilustrada na Fig. 1a. Alterando o tempo RIE, o diâmetro das esferas PS pode ser reduzido aos valores desejados e, portanto, Si NWs com diâmetros controláveis podem ser alcançados. As imagens SEM de Si NWs obtidas após o ataque RIE de 90, 120 e 150 s são apresentadas na Fig. 2 a, be c, respectivamente. Pode-se observar que os Si NWs estão alinhados verticalmente em um arranjo hexagonal periódico em uma grande área. Esses Si NWs alinhados verticalmente têm o mesmo período de 490 nm e o mesmo comprimento de cerca de 350 nm (mesmo tempo MACE de 40 s). Os diâmetros dos Si NWs em (a), (b) e (c) estão em torno de 350, 260 e 190 nm, respectivamente. A dependência do diâmetro NWs no tempo de corrosão RIE é representada graficamente na Fig. 2d, mostrando uma boa correlação linear. Por outro lado, o comprimento dos nanofios pode ser ajustado variando o tempo de MACE em HF e H 2 O 2 solução mista. As imagens de SEM de seção transversal de Si NWs após 40, 60, 80 e 100 s MACE são mostradas na Fig. 2e. Pode-se ver que o comprimento dos NWs aumenta de 350 para 960 nm, aumentando o tempo MACE. Da mesma forma, o comprimento dos Si NWs exibe uma boa dependência linear no tempo MACE, como mostrado na Fig. 2f. Estes resultados indicam que Si NWs ordenados com diâmetros e comprimentos controláveis são fabricados com sucesso pelo método de NSL combinado com MACE.
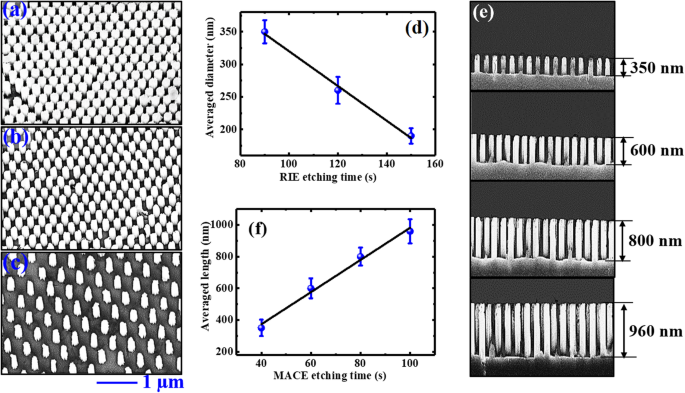
Imagens SEM de vista superior de Si NWs com o mesmo comprimento de 350 nm, mas diâmetros diferentes de a 350 nm; b 260 nm; e c 190 nm. A dependência do diâmetro NWs no tempo de corrosão RIE é traçada em d . e Imagens de SEM em corte transversal de Si NWs com o mesmo diâmetro de 260 nm, mas diferentes comprimentos de 350, 600, 800 e 960 nm. f Apresenta a dependência do comprimento NWs no tempo MACE
A partir das imagens de SEM, também pode ser descoberto que os Si NWs têm uma superfície muito áspera após o ataque químico, e sua superfície de parede lateral é especialmente áspera. Para verificar a microestrutura da camada superficial em função do diâmetro e do comprimento, os espectros Raman foram medidos em Si e Si NWs com diâmetros e comprimentos diferentes. Cada espectro foi normalizado usando a intensidade máxima de pico em 520 cm - 1 , e os resultados para diâmetros e comprimentos diferentes foram mostrados na Fig. 3 a e b, respectivamente. O espectro de silício em massa mostra um pico nítido localizado em ~ 520,1 cm - 1 . Tanto o desvio para o vermelho da posição do pico quanto o alargamento da largura do pico (denominado largura total na metade do máximo, FWHM) podem ser observados em Si NWs, conforme plotado na Fig. 3 c e d, correspondentemente. O redshift de pico e o alargamento são bastante pequenos para nanofios com comprimentos curtos de 350 e 600 nm e tornam-se relativamente óbvios à medida que o comprimento do nanofio aumenta para 800 nm e acima. Esse redshift e alargamento do pico Raman são algumas vezes atribuídos às mudanças no nível de dopante ou no conteúdo cristalino. De acordo com a literatura anterior [5, 51], para os Si NWs fabricados pelo mesmo método MACE, a concentração de dopagem poderia possuir o mesmo nível de dopagem do wafer inicial. Devido às limitações do equipamento, não foi possível confirmar este resultado. Por outro lado, embora esses Si NWs tenham uma superfície rugosa, literaturas anteriores descobriram que os Si NWs fabricados pelo método MACE podiam principalmente manter suas estruturas cristalinas para dopagem n e p e dopagem leve e pesada [5, 51 , 52]. Apenas uma fina camada amorfa foi observada na superfície da parede dos NWs. Resultados semelhantes foram obtidos em Si NWs com diâmetros e comprimentos diferentes por grupos diferentes. Como tal, pode-se presumir que os Si NWs fabricados pelo método MACE podem manter seu nível de dopante e conteúdo cristalino quase inalterado como sua contraparte em massa, exceto a camada superficial fina.

Espectros Raman típicos de nanofios de Si e Si em massa com a mesmo comprimento de 350 nm, mas diâmetros e b diferentes mesmo diâmetro de 190 nm, mas comprimentos diferentes. c e d representam o desvio para o vermelho da posição do pico e o alargamento FWHM em função do comprimento do nanofio
Portanto, a mudança de pico Raman e o alargamento são provavelmente induzidos pela superfície rugosa danificada dos nanofios [53]. Existem vários artigos relatando os resultados Raman de Si NWs fabricados pelo mesmo método MACE. Por exemplo, Feser et al. descobriram que o pico significativo se ampliando em 520 cm - 1 aumentou com o tempo MACE e atribuiu este alargamento de pico ao distúrbio do cristal (por exemplo, grupos de defeitos pontuais) induzido pelo processo de corrosão [23]. Lajvardi et al. descobriu que o desvio para o vermelho Raman aumentou com o tempo MACE, i. e. o pico de TO Raman estava localizado a 521,1 cm - 1 para Si em massa e deslocado para 518,7 cm - 1 para amostras gravadas de 80 min, respectivamente [54]. Eles afirmaram que a origem da mudança Raman pode ser devido à formação de nanocristais de Si na parede do nanofio. Lin et al. observou que o pico de TO Raman mudou de 520 para 516 cm - 1 quando o comprimento NWs aumenta de 0 (Si em massa) para 2,73 μm, enquanto a largura do pico foi ampliada de 3 para 9 cm - 1 com comprimento crescente de NWs de 0,19 para 2,73 μm [55]. Eles pensaram que o alargamento do pico Raman era dominado pela interação fônon-cepa e que o deslocamento do pico Raman provou ser proporcional à distorção da rede de superfície induzida pela deformação. Uma vez que a deformação induzida pela corrosão HF aumentou com o comprimento dos NWs (mais tempo de corrosão), tanto o redshift do pico Raman quanto o alargamento aumentaram com o aumento do comprimento dos NWs. Em nosso caso, a partir dos espectros Raman como mostrado na Fig. 3 a e b, podemos descobrir que o pico de TO Raman muda de 520 para 519,4 cm - 1 quando o comprimento NWs aumenta de 0 (Si em massa) para 960 nm, enquanto o FWHM é alargado de 4,41 para 4,47 cm - 1 conforme o comprimento de NWs aumenta de 350 para 960 nm. Preferimos que a mudança e o alargamento do pico Raman dependente do comprimento sejam originados da superfície danificada (deformação ou desordem). No entanto, devido à variação muito pequena tanto no redshift quanto no alargamento do pico para nanofios com diâmetros e comprimentos diferentes (<1,0 cm - 1 ), a mudança de tensão / distúrbio com o tamanho pode ser considerada mínima. Portanto, a deformação / desordem pode modificar a condutância dos NWs, mas sua influência na dependência do tamanho da condutância não será considerada nas próximas seções.
Medições de propriedade condutiva em Si único NWs
As propriedades condutoras de Si NWs são medidas pelo CAFM em NWs individuais com diâmetros e comprimentos diferentes. Imagens de topografia típicas dos Si NWs alinhados verticalmente com o mesmo comprimento de 350 nm, mas diâmetros diferentes de 350, 260 e 190 nm são mostrados na Fig. 4 a, b e c, respectivamente, enquanto suas imagens de corrente correspondentes obtidas na amostra bias de -1,5 V são apresentados em (d), (e) e (f). Deve-se notar que, como a ponta do AFM revestida com Cr / Pt é uma cunha com grande ângulo, os Si NWs apresentam um diâmetro maior do que os reais. Além disso, a corrente que sai dos nanofios não pode ser bem detectada, pois a ponta pode não ser capaz de entrar em contato com o substrato, então apenas as correntes medidas nos nanofios são levadas em consideração. Pelas imagens atuais, pode-se observar que a maioria das bordas dos nanofios de Si apresentam condutância um pouco melhor do que o centro. Isso pode ser resultado do contato lateral entre a ponta do AFM e o Si NW com uma área de contato maior. Além disso, devido à aspereza óbvia na superfície superior, algumas regiões na área central também podem mostrar grande corrente semelhante à borda, resultando em nenhuma distribuição de corrente em anel distinta. Por outro lado, a condutância de Si NWs está obviamente relacionada ao diâmetro dos nanofios. Pode-se ver que tanto a razão da área condutiva dos nanofios quanto os valores absolutos da corrente aumentam significativamente conforme o diâmetro diminui de 350 para 190 nm. Os resultados sugerem que os Si NWs com diâmetros menores são mais condutores do que aqueles com diâmetros maiores. Para obter a dependência do diâmetro de forma mais intuitiva, os perfis de corrente ao longo das linhas marcadas na Fig. 4 d a f são exibidos na Fig. 4g. Isso mostra claramente que os Si NWs com diâmetro de 190 nm são muito mais condutores do que aqueles com diâmetros de 260 nm e 350 nm. Essa dependência do diâmetro também pode ser obtida a partir dos histogramas estatísticos das distribuições de corrente em Si NWs com diâmetros diferentes, conforme mostrado no Arquivo adicional 1:Figura S1 (a), que exibe os deslocamentos da distribuição de corrente para valores elevados quando o diâmetro diminui. As correntes médias ( I av ) de Si NWs são calculados pela média da corrente de todos os nanofios nas imagens atuais, que é representada graficamente na Fig. 4h como uma função do diâmetro de NWs. A corrente média de Si NWs exibe um aumento dramático nove vezes quando o diâmetro dos NWs diminui de 350 para 190 nm. Dependência de corrente semelhante no diâmetro foi alcançada em nanofios de InAs simples, bem como em dispositivos de nanofio de Si único [35, 47].

As imagens de topografia de Si NWs com o mesmo comprimento de 350 nm, mas diâmetros diferentes de a 350 nm, b 260 nm, c 190 nm. Suas imagens de corrente correspondentes obtidas sob a polarização da amostra de - 1,5 V são fornecidas em d , e e f , respectivamente. Perfis atuais ao longo das linhas marcadas em d - f são plotados em g , e h apresenta a corrente média ( I av ) sobre os nanofios em função do diâmetro NWs. As linhas correspondentes são adicionadas nas imagens de topografia de a - c e as curvas do perfil em g são deslocados verticalmente para orientação
Imagens de correntes típicas de Si NWs com comprimentos diferentes e o mesmo diâmetro de 190 nm medidos na polarização da amostra de - 1,5 V são apresentadas na Fig. 5. As Figuras 5 a a d mostram as imagens atuais de Si NWs com comprimentos de 350, 600, 800 e 960 nm, respectivamente. Pode-se observar que nessas imagens atuais, as áreas condutoras diminuem obviamente com o aumento do comprimento, enquanto a diminuição da corrente absoluta não é tão óbvia, principalmente para os NWs com os comprimentos de 350 nm e 600 nm. Talvez devido à existência de rugosidade superficial irregular local, uma corrente ainda maior foi observada em alguns pontos na Fig. 5b. No entanto, a corrente média da Fig. 5b foi muito menor do que a da Fig.5a. Usando as mesmas análises acima, os perfis atuais ao longo das linhas marcadas são apresentados na Fig. 5e, e os histogramas estatísticos são mostrados no Arquivo adicional 1:Figura S1 (b). Ambos exibem claramente uma diminuição significativa da corrente com o aumento do comprimento dos NWs. As correntes médias dos nanofios em função dos comprimentos de NWs são representadas graficamente na Fig. 5f, e são da ordem de dezenas a centenas de pA, que é muito menor do que o mostrado na Fig. 5 a a e na ordem de nA . É porque os nanofios exibem uma corrente relativamente grande apenas em alguns pontos condutores quando a maioria das regiões não são condutivas. Da Fig. 5f, a corrente média exibe mais de três vezes menor quando o comprimento aumenta de 300 para 960 nm, indicando que a condutância dos nanofios diminui com o aumento do comprimento. A dependência da resistência do nanofio no comprimento foi investigada anteriormente por medições de resistência de quatro pontos em nanofios semicondutores, o que sugeriu que sob contato ôhmico a resistência do nanofio aumentou com seu comprimento linearmente com a inclinação de resistividade [56, 57]. Em nosso caso, do gráfico de I ~ 1 / L conforme dado no Arquivo adicional 1:Figura S2, a dependência é notavelmente não linear; portanto, a resistividade não poderia ser obtida corretamente a partir da inclinação da curva. É importante notar que nas medições CAFM, a resistência total medida inclui a resistência de contato entre as pontas revestidas com Cr / Pt e Si NW ( R tip / NW ), a resistência de Si NW ( R NW ) e a resistência das bolachas de Si ( R em massa ) Uma vez que a resistência medida pelo CAFM vem principalmente da área de superfície localizada abaixo da ponta e diminui rapidamente com o aumento da área ao longo do caminho atual, R em massa é muito menor em comparação com R NW e R tip / NW . Por outro lado, devido à área de contato metal-semicondutor muito pequena entre a ponta e o nanofio, a resistência de contato R tip / NW é muito maior do que a resistência do nanofio R NW . A não linearidade da dependência de corrente em 1 / L indica apenas a presença de grande resistência de contato. Portanto, nas medições realizadas pelo CAFM, a resistência de contato metal-semicondutor deve ser considerada enfaticamente, na qual a barreira de Schottky desempenha um papel importante.

As imagens atuais de Si NWs sob o viés de amostra de - 1,5 V com o mesmo diâmetro de 190 nm, mas diferentes comprimentos de a 350 nm, b 600 nm, c 800 nm e d 960 nm, respectivamente. Os perfis atuais ao longo das linhas marcadas em a - d são plotados em e , e f apresenta as correntes médias dos nanofios ( I av ) em função do comprimento de NWs. As curvas do perfil em e são deslocados verticalmente para orientação
Para verificar a inferência acima, curvas de corrente-tensão (I – V) foram registradas em Si NWs individuais para investigar a barreira Schottky no contato ponta de metal / nanofio de Si. Curvas I – V típicas em Si NWs com o mesmo comprimento de 350 nm, mas diâmetros diferentes são apresentadas na Fig. 6a e aquelas em Si NWs com o mesmo diâmetro de 190 nm, mas comprimentos diferentes são exibidos na Fig. 6b, respectivamente. Todas as curvas I – V exibem correntes maiores na região de tensão de amostra negativa, de acordo com as curvas I – V típicas com o contato Schottky entre a ponta de metal e o semicondutor tipo n. Como as curvas I – V exibem boas características de metal-semicondutor, isso indica que o efeito da camada de oxigênio na condutância não é sério e, portanto, assumido como mínimo na discussão a seguir. Enquanto isso, os resultados mostram que nanofios menores e mais curtos exibem maior condutância do que os maiores e mais longos, bem consistentes com os resultados obtidos a partir das imagens atuais. Para análises quantitativas, um modelo de emissão termiônica bem conhecido para um contato metal-semicondutor é adotado [58, 59]. Neste modelo, as características I – V de um contato Schottky com semicondutor tipo n na presença de resistência em série podem ser aproximadas como [59]:
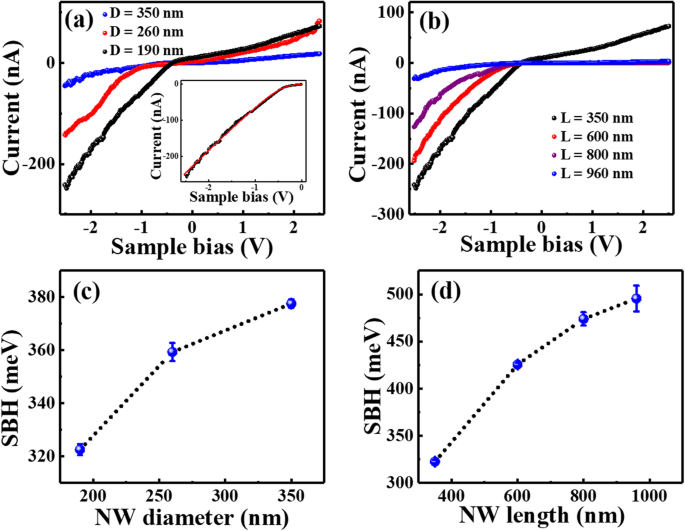
Curvas I-V típicas em Si NWs com o mesmo comprimento de 350 nm, mas diâmetros diferentes ( a ) e mesmo diâmetro de 190 nm, mas comprimentos diferentes ( b ) A inserção em a mostra um resultado de ajuste típico de Si NWs com o diâmetro de 190 nm e comprimento de 350 nm. c e d representam as alturas de barreira Schottky obtidas a partir dos resultados de ajuste em função do diâmetro e comprimento NWs, respectivamente
$$ I ={I} _S \ left [\ exp \ left (\ frac {q \ left (VI {R} _S \ right)} {\ mathrm {n} kT} \ right) -1 \ right], $ $ (1)
onde n é o fator ideal e R S é a resistência em série. eu S é a corrente de saturação, que pode ser expressa por:
$$ {I} _S =\ mathrm {AA} \ ast {T} ^ 2 \ exp \ left (- \ frac {\ varphi_B} {kT} \ right), $$ (2)
onde A é a área de contato, A * é a constante de Richardson e φ B é a altura da barreira Schottky (SBH) entre a ponta de metal e o nanofio de Si. Assim, SBH pode ser obtido com a fórmula:
$$ {\ varphi} _B =kT \ ln \ left (\ frac {\ mathrm {AA} \ ast {T} ^ 2} {I _ {\ mathrm {S}}} \ right), $$ (3)
As curvas I – V na Fig. 6 aeb podem ser bem ajustadas pela Eq. (1), e uma linha de ajuste típica na região dianteira é mostrada na inserção da Fig. 6a. Para obter os valores de SBH da corrente de saturação, a constante efetiva de Richardson A * é considerada aproximadamente igual à do silício bruto, ou seja, 112 A cm - 2 K - 2 para silício tipo n [59]. A área de contato é considerada 2 × 10 - 11 cm 2 tomando o raio da ponta revestida com Cr / Pt como 25 nm. Os valores de SBH são obtidos em cerca de 322, 359 e 377 meV para os Si NWs com o mesmo comprimento de 350 nm e diâmetros diferentes de 190, 260 e 350 nm, respectivamente. Para Si NWs com o mesmo diâmetro de 190 nm e diferentes comprimentos de 350, 600, 800 e 960 nm, os valores de SBH são 322, 425, 473 e 495 meV, correspondentemente. Para comparação, a curva I – V típica foi medida no mesmo tipo de wafer de Si, conforme mostrado no arquivo adicional 1:Figura S3 (a). Isso mostra claramente que a condutância do wafer de Si é muito menor do que os NWs produzidos. A corrente detectável só pode ser medida em altas tensões de polarização (- 4 ~ - 10 V). Após ajustar as curvas I – V com o modelo de emissão termiônica acima (Arquivo adicional 1:Figura S3 (b)), o valor de SBH de 0,60 eV foi obtido para Si em massa. Obviamente, todos os valores de SBH medidos para Si NWs com diâmetros e comprimentos diferentes são menores do que o Si em massa. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Mao et al. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
EFM Measurements on Single Si NWs
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)
onde C , V EFM e V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ amostra − φ dica )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)
onde Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
Da Eq. (5), it can be seen that the EFM phase shift should be equal to zero at V EFM = V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~ V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~ V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E F ) Como E n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). c e d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a e b are vertically shifted for guidance
Conclusion
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
Disponibilidade de dados e materiais
The datasets used for supporting the conclusion are included in the article and the supporting file.
Abreviações
- CAFM:
-
Microscopia de força atômica condutiva
- CPD:
-
Diferença de potencial de contato
- EFM:
-
Electrostatic force microscopy
- MACE:
-
Gravura química assistida por metal
- NSL:
-
Litografia de nanosfera
- PS:
-
Esferas de poliestireno
- RIE:
-
Gravura de íon reativo
- SBH:
-
Schottky barrier height
- SEM:
-
Microscopia eletrônica de varredura
- Si NWs:
-
Si nanowires
- SPM:
-
Scanning probe microscopy
Nanomateriais



