Nova tecnologia Samsung H-Cube 2.5D integra 6 HBMs para aplicativos HPC
A Samsung Electronics anunciou sua tecnologia de cubo de substrato híbrido (H-Cube), uma solução de empacotamento 2.5D especializada para semicondutores para HPC, IA, data center e produtos de rede que requerem alta performance e tecnologia de empacotamento de grande área.
Desenvolvido em conjunto pela Samsung Electro-Mechanics (SEMCO) e Amkor Technology, o H-Cube é adequado para semicondutores de alto desempenho que precisam integrar um grande número de matrizes de silício. A Samsung disse que expande e enriquece o ecossistema de fundição, fornecendo várias soluções de embalagem para enfrentar os desafios que seus clientes estão enfrentando.
“No ambiente de hoje, onde a integração do sistema é cada vez mais necessária e os suprimentos de substrato são limitados, a Samsung Foundry e a Amkor Technology co-desenvolveram com sucesso o H-Cube para superar esses desafios”, disse JinYoung Kim, vice-presidente sênior do centro global de P&D da Amkor Technology. “Este desenvolvimento reduz as barreiras de entrada no mercado de HPC / AI e demonstra colaboração e parceria bem-sucedidas entre a fundição e a empresa terceirizada de montagem e teste de semicondutores (OSAT).”
Estrutura e recursos do H-Cube
O pacote 2.5D permite que chips lógicos ou memória de alta largura de banda (HBM) sejam colocados em cima de um mediador de silício em um formato pequeno. A tecnologia H-Cube da Samsung apresenta um substrato híbrido combinado com um substrato de pitch fino que é capaz de conexão de bump fina e um substrato de interconexão de alta densidade (HDI), para implementar tamanhos grandes em embalagens 2,5D.
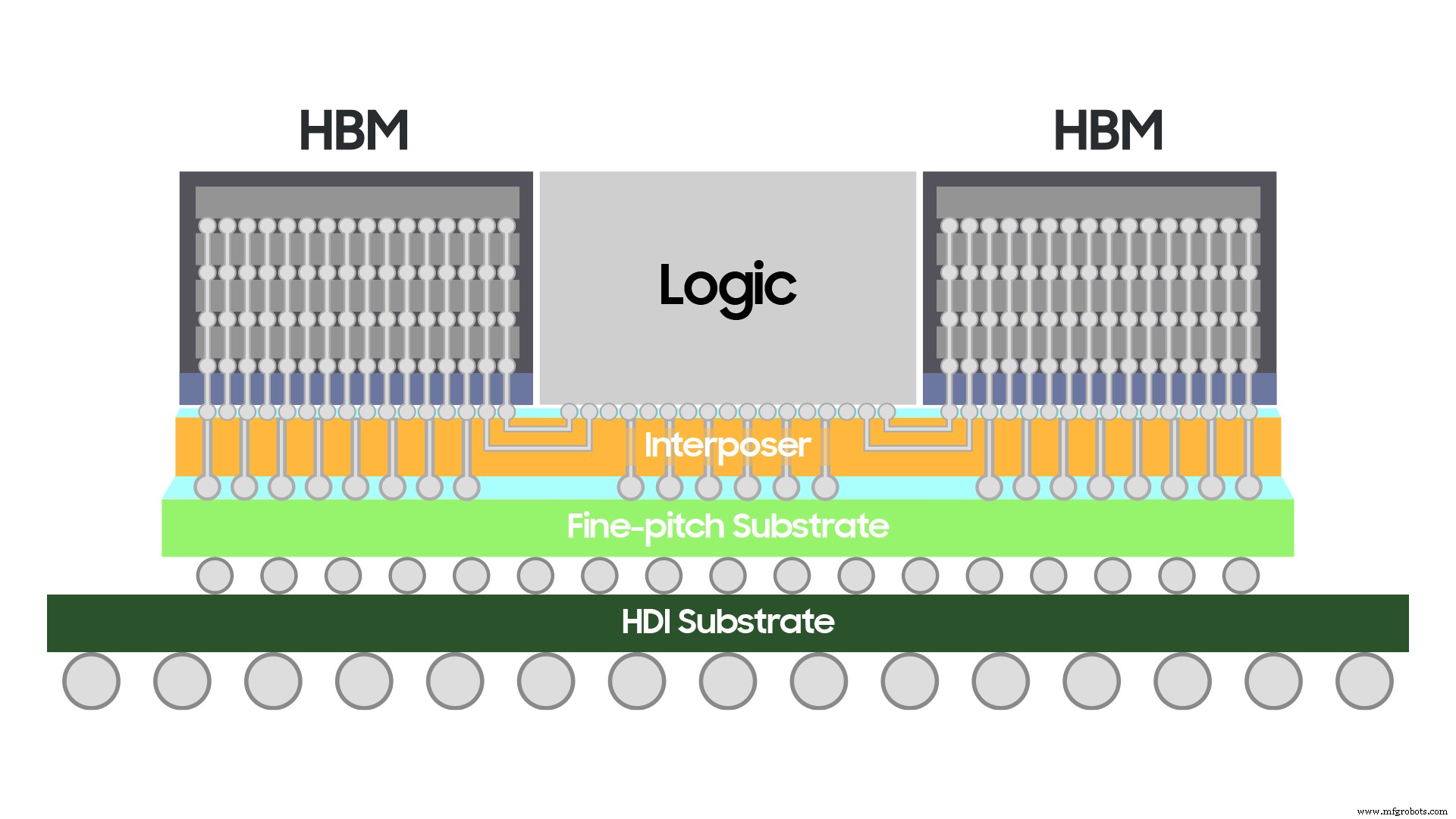
Com o recente aumento nas especificações exigidas nos segmentos de mercado de aplicativos de rede, HPC e IA, o empacotamento para grandes áreas está se tornando importante à medida que o número e o tamanho dos chips montados em um pacote aumenta ou a comunicação de alta largura de banda é necessária. Para fixação e conexão de matrizes de silício, incluindo o intermediário, substratos de passo fino são essenciais, mas os preços aumentam significativamente após um aumento no tamanho.
Ao integrar seis ou mais HBMs, a dificuldade na fabricação do substrato de grande área aumenta rapidamente, resultando em eficiência reduzida. A Samsung resolveu esse problema aplicando uma estrutura de substrato híbrido na qual substratos HDI fáceis de implementar em grandes áreas são sobrepostos sob um substrato de alta densidade de alta resolução.
Ao diminuir o passo da bola de solda - que conecta eletricamente o chip e o substrato - em 35% em comparação com o passo da bola convencional, o tamanho do substrato de passo fino pode ser minimizado, ao adicionar substrato HDI (módulo PCB) sob o pitch substrate para proteger a conectividade com a placa de sistema.
Além disso, para aumentar a confiabilidade da solução H-Cube, a Samsung aplicou sua tecnologia proprietária de análise de integridade de sinal / energia que pode fornecer energia de forma estável, minimizando a perda ou distorção de sinal ao empilhar vários chips lógicos e HBMs.
Integrado
- Uma nova era de ouro para a tecnologia industrial
- Considerando o que a nova tecnologia de impressão em metal significa para AM
- Opções de tecnologia para distanciamento social em aplicativos de varejo
- Infineon, Xilinx e Xylon se unem para novas soluções de microcontrolador em aplicativos de segurança crítica
- Infineon:novo sensor de corrente para aplicações industriais cobre ± 25 A a ± 120 A faixa
- MÓDULO DE DADOS:nova tecnologia de ligação para projetos de alto volume
- DUAGON-MEN-GROUP integra OEM Technology Solutions Austrália
- GE apresenta novo produto para aplicativos de controle e monitoramento
- SMI oferece a mais alta qualidade de tecnologia composta para aplicações militares
- BASF, Paxis Colaboram em Materiais para Nova Tecnologia de Impressão 3D



