Uma simulação teórica das respostas à radiação da superrede de Si, Ge e Si / Ge para irradiação de baixa energia
Resumo
Neste estudo, as respostas à radiação de baixa energia da superrede de Si, Ge e Si / Ge são investigadas por um método de dinâmica molecular ab initio e as origens de seus diferentes comportamentos de radiação são exploradas. Verificou-se que a resistência à radiação dos átomos de Ge que estão ao redor da interface da superrede de Si / Ge é comparável ao Ge em massa, enquanto os átomos de Si ao redor da interface são mais difíceis de serem deslocados do que o Si em massa, mostrando maior tolerância à radiação como em comparação com o Si em massa. Os mecanismos para geração de defeitos nas estruturas em massa e superrede mostram um caráter um pouco diferente, e os defeitos associados na superrede são mais complexos. Os cálculos de formação e migração de defeitos mostram que na estrutura da superrede, os defeitos pontuais são mais difíceis de formar e as vagas são menos móveis. A maior tolerância à radiação da superrede Si / Ge beneficiará suas aplicações como dispositivos eletrônicos e optoeletrônicos sob ambiente de radiação.
Histórico
Durante as últimas décadas, a superrede Si / Ge (SL) tem atraído muita atenção na pesquisa de semicondutores devido ao seu potencial de contribuição para o desenvolvimento de novos dispositivos eletrônicos e optoeletrônicos [1,2,3,4,5,6]. Por exemplo, o estudo da fotocondutividade de Si / Ge SL é de notável importância para fotodiodos como emissor e receptor para comunicação óptica rápida [5]. Em suas aplicações como o componente eletrônico espacial, o componente microeletrônico, a célula solar e a eletrônica baseada no espaço [1, 4, 6], as propriedades ópticas e eletrônicas do Si / Ge SL podem ser alteradas devido ao bombardeio de íons de energia do ambiente espacial, resultando na degradação do desempenho dos dispositivos eletrônicos. Portanto, é necessário investigar as respostas à radiação deste material semicondutor sob condições extremas de trabalho.
Recentemente, muitos pesquisadores estudaram os efeitos dos danos por radiação da superrede de Si / Ge [7,8,9,10,11,12,13,14,15,16]. Sobolev et al. investigaram as influências da irradiação de elétrons na fotoluminescência (PL) de Si / Ge SL contendo monocamada de Ge puro, e maior resistência à radiação da estrutura SL foi encontrada em comparação com silício bruto [12]. Fonseca et al. irradiou o Si / Ge SL com pontos quânticos Ge embutidos (QDs) empregando a irradiação de prótons de 2.0 MeV e encontrou uma extraordinária alta resistência à radiação da estrutura QD-in-SL [13]. Resultados semelhantes foram obtidos por Leitão et al., Que relataram que os poços quânticos Ge (QWs) depositados em uma estrutura de diodo contendo uma estrutura multicamadas de Si / Ge eram mais resistentes à irradiação de prótons em comparação com os QWs Ge simples [14]. Como materiais termelétricos promissores, as características termelétricas do sistema Si / Ge também podem ser afetadas sob o ambiente de radiação [11, 15]. Zheng et al. irradiou as múltiplas camadas periódicas de Si 1 - x Ge x / Si empregando íons de Si de 5 MeV, e eles descobriram que a figura de mérito termoelétrica aumenta com o aumento da fluência dos íons de Si [11]. Os defeitos e a desordem estrutural reduzem a condutividade térmica do plano cruzado ao absorver e dissipar o fônon ao longo da rede, e a densidade eletrônica de estados na minibanda da estrutura QD aumenta a condutividade elétrica e o coeficiente de Seebeck, que contribuem para o aumento da figura de mérito [11].
Teoricamente, Sayed e Windl investigaram os deslocamentos atômicos do Si em massa empregando o método clássico de dinâmica molecular (MD) [17, 18]. Eles descobriram que as energias de deslocamento de limiar (E d s) dependem da direção do knock-on e os estados danificados são principalmente defeitos do par de Frenkel (FP) [17, 18]. Caturla et al. estudaram os efeitos da massa e energia do íon no dano por radiação do Si em massa empregando o método MD [19]. Eles relataram que a produção de amorfização, bem como defeitos pontuais isolados e pequenos aglomerados, têm uma forte dependência da massa iônica e uma relação fraca com a energia iônica [19]. Holmström et al. calculou o E d s para germânio usando o método MD e descobriu que os defeitos estáveis são defeitos FP [20]. Shaw et al. aplicou um método ab initio para estudar os efeitos de defeitos de antimônio e germânio na estrutura eletrônica de heteroestruturas de Si / Ge e descobriu que esses defeitos interagem com as interfaces Si / Ge, resultando em ressonâncias localizadas relacionadas à interface e grandes perturbações locais no sistema eletrônico estrutura [21]. Apesar dessas investigações mencionadas, nenhuma simulação teórica do processo dinâmico de dano por radiação de Si / Ge SL foi relatada na literatura até o momento. Ainda falta uma compreensão em nível atômico da evolução microestrutural e do mecanismo subjacente para a geração de defeitos nas superredes semicondutoras.
O método de dinâmica molecular ab initio (AIMD) demonstrou ser uma ferramenta importante para lançar luz sobre os processos de dano por radiação e, de fato, foi bem-sucedido em simular os eventos de recuo de uma série de materiais semicondutores e cerâmicos [22,23,24, 25,26,27]. Em comparação com o método clássico de MD, os potenciais interatômicos são obtidos a partir de cálculos de estrutura eletrônica, em vez de ajuste empírico de resultados experimentais. Consequentemente, muitos parâmetros físicos como E d s podem ser determinados com precisão ab initio. Neste estudo, o método AIMD é empregado para comparar os comportamentos de resposta de Si, Ge e Si / Ge SL em massa sob irradiação de baixa energia. As energias de deslocamento de limiar foram determinadas e a distribuição de defeitos e o caminho para a geração de defeitos foram fornecidos. A possível origem para a discrepância na tolerância à radiação entre Si (Ge) e Si / Ge SL em massa também é explorada. Os resultados apresentados fornecem uma visão fundamental sobre o mecanismo microscópico de eventos de deslocamento em bulk Si, Ge e Si / Ge SL e avançam na compreensão das respostas à radiação desses materiais sob o ambiente de radiação.
Métodos
Os eventos de deslocamento de baixa energia de Si, Ge e Si / Ge SL em massa são simulados pelo código da Iniciativa Espanhola para Simulações Eletrônicas com Milhares de Átomos (SIESTA). Os pseudopotenciais Troullier-Matrins conservadores de normas [28] são empregados para determinar a interação entre íons e elétrons, e o potencial de correlação de troca é descrito pela aproximação de densidade local (LDA) na parametrização de Ceperly-Alder [29]. As funções de onda de valência são expandidas por um conjunto de base de orbitais atômicos localizados, e conjuntos de base única ζ mais orbital de polarização (SZP) são empregados, com uma amostragem de ponto K de 1 × 1 × 1 na zona de Brillouin e um corte fora da energia de 60 Ry. No presente estudo, um Si 2 / Ge 2 SL, que consiste em duas camadas de Si alternadas com duas camadas de Ge e no total 288 átomos, é considerado. A Figura 1 ilustra a configuração geométrica para Si e Si / Ge SL em massa. Um átomo específico é selecionado como o átomo primário de ativação (PKA) e recebe uma energia cinética para iniciar um evento de recuo. Se o PKA retornar à sua posição original no final do evento de deslocamento, a simulação é reiniciada com maior energia de recuo com um incremento de energia de 5 eV. Uma vez que o PKA é permanentemente deslocado de seu local de rede, execuções adicionais são pré-formadas para melhorar a precisão para 0,5 eV. Para cada tipo de átomo, quatro e cinco direções de incidência principais são levadas em consideração para Si (Ge) e Si / Ge SL em massa, respectivamente. As simulações são realizadas com um ensemble NVE e a duração máxima de cada corrida é de 1,2 ps para evitar a instabilidade do sistema.

Vista esquemática das estruturas geométricas de a bulk Si e b Superrede de Si / Ge. As esferas azuis e verdes representam os átomos de Si e Ge, respectivamente
Resultados e discussão
Os eventos de deslocamento em silício e germânio a granel
A constante de rede do Si em massa é determinada como 5,50 Å, o que concorda bem com o resultado teórico de 5,48 Å [30] e o resultado experimental de 5,43 Å [31]. Em comparação com o Si em massa, a constante de rede do Ge em massa é maior, ou seja, 5,71 Å, o que é consistente com o resultado calculado de 5,65 Å [30] e o valor experimental de 5,77 Å [31]. Nossas energias de deslocamento de limite calculadas para Si e Ge em massa estão resumidas na Tabela 1, junto com os defeitos associados após os eventos de deslocamento. As configurações para os estados finais de dano dos recuos de Si e Ge são plotadas nas Figs. 2 e 3, respectivamente.

a - d Visão esquemática de estruturas geométricas de danos Si após eventos de recuo. As esferas verde e vermelha representam a vacância e os defeitos intersticiais, respectivamente. V Si :vacância de silício; Si int :intersticial de silício

a - d Visão esquemática de estruturas geométricas de danos Ge após eventos de recuo. As esferas vermelha e azul representam a vacância e os defeitos intersticiais, respectivamente. V Ge :vacância de germânio; Ge int :intersticial de germânio
Para Si em massa, o E d os valores são ligeiramente menores do que os resultados experimentais de 21 eV para [001] [32], ~ 47,6 eV para [110] [33] e ~ 12,9 eV para [111] [34] direções, e tanto o experimento quanto os nossos cálculos revelar que os estados finais danificados são defeito do par de Frenkel (FP). Observa-se também que E d os valores do presente estudo são geralmente comparáveis aos resultados de DM relatados por Windl et al. [18], exceto o caso de [110], para o qual nosso valor calculado de 47 eV é muito maior do que o resultado MD de 24 eV. A simulação anterior do AIMD de interações íon-sólido em SiC revelou que o evento de deslocamento é na verdade um processo de transferência de carga e a transferência de carga de e para átomos em recuo pode alterar as barreiras de energia e a dinâmica para a formação de defeitos estáveis [35]. Os valores mais baixos de E d encontrados pelo AIMD em comparação com aqueles determinados pelo MD clássico pode ser devido ao fato de que a transferência de carga que ocorre durante os eventos de recuo é levada em consideração pelo método AIMD, enquanto na simulação MD clássica, a carga dos átomos é fixa. No estudo de Windl et al., A energia cinética é transferida para o PKA para gerar uma vacância de silício (V Si ) e um intersticial de silício (Si int ) defeitos [18]. Em contraste, em nosso estudo, os defeitos associados ao evento de deslocamento de Si [110] contêm dois V Si e dois Si int defeitos, resultando em maiores energias para a formação dos estados danificados. O E d os valores de Si [111] e Si \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) são muito próximos uns dos outros, ou seja, 9,5 e 10 eV, respectivamente. Em ambos os casos, os defeitos criados são V Si e Si int (ver Fig. 2c, d), enquanto os mecanismos de geração de defeitos apresentam caráter diferente. No caso de Si [111], o Si PKA se move ao longo da direção \ (\ left [11 \ overline {1} \ right] \) devido às interações repulsivas e colide com seu átomo de Si vizinho. O Si PKA então se espalha para ocupar um site intersticial (Si int ), e o Si substituído se move de volta para o local da rede de PKA. Os defeitos associados são um V Si e um Si int defeitos. Quanto a Si \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), o evento de deslocamento é relativamente mais simples, ou seja, o Si PKA se move 4,69 Å de seu local de rede para formar um Si int defeito. Nos casos de Si [001] e Si [110], o E d s são determinados como sendo 20 e 47 eV, respectivamente, indicando que os átomos de Si são mais difíceis de serem deslocados ao longo da direção [110]. Os estados finais de dano para Si [001] e Si [110] são um pouco diferentes. No caso de Si [001], o PKA recebe energia cinética e se move ao longo da direção [001] para colidir com seus átomos vizinhos. O átomo de Si substituído continua se movendo e ocupa um sítio intersticial, como mostrado na Fig. 2a. Quanto ao Si [110], o PKA se espalha na direção \ (\ left [11 \ overline {1} \ right] \) devido às interações repulsivas entre o PKA e seus átomos vizinhos e atinge um átomo de Si vizinho (Si1) . Então, o Si PKA rebate na direção [111] para substituir outro átomo de Si (Si2), e o átomo de Si2 ocupa um sítio intersticial no final. O átomo de Si1 recebe energia suficiente para se mover ao longo da direção [110] e substitui seu átomo de Si vizinho (Si3), que forma um defeito intersticial. No final, os defeitos associados são dois V Si e dois Si int defeitos, como mostrado na Fig. 2b.
Para Ge em massa, os valores de E d estão em boa concordância com o valor experimental de ~ 18 eV [36] e o valor teórico de 18,5 eV [20] para a direção [001]. Nota-se que o valor presente de 9,5 eV é comparável ao resultado de Holmström de 12,5 eV [20] para a direção [111], que são menores do que o valor experimental de ~ 15 eV [36]. Para Ge [111] e Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), o E determinado d os valores são tão pequenos quanto 9,5 eV, indicando que os átomos de Ge podem ser facilmente deslocados ao longo dessas duas direções. Em ambos os casos, os defeitos associados são vacância de germânio e intersticial de germânio (ver Fig. 3c, d). Para Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), o Ge PKA não segue um caminho reto, mas é fortemente desviado por um de seus vizinhos mais próximos para ocupar um site intersticial (Ge int ) Em contraste, no caso de Ge [111], o Ge PKA se move 4,92 Å ao longo da direção [111] para formar um defeito intersticial (Ge int ) Em comparação com o E d de Ge [001], o valor de Ge [110] é 10 eV maior, indicando que o átomo de Ge é mais difícil de ser deslocado ao longo da direção [110]. Embora os defeitos associados para Ge [001] e Ge [110] sejam semelhantes, os mecanismos para geração de defeitos são um pouco diferentes. O Ge PKA recebe energia cinética e se move ao longo da direção [001] para colidir com seus átomos vizinhos. O átomo de Ge substituído continua se movendo e ocupa um sítio intersticial, como mostrado na Fig. 3a. Quanto ao Ge [110], o recuo Ge colide com seu primeiro átomo Ge vizinho (Ge1) ao longo da direção [110] e rebate ao longo da direção [111], resultando na formação de Ge int . O átomo Ge1 deixa seu local de rede e substitui seu átomo Ge vizinho (Ge2). Posteriormente, o átomo Ge2 se move de volta para o local da rede de Ge1 e, eventualmente, apenas um V Ge e um Ge int defeitos são formados, como mostrado na Fig. 3b. Esses resultados sugerem que em Si e Ge em massa, o E d s são fortemente dependentes da direção cristalográfica, e os átomos são mais difíceis de serem deslocados ao longo da direção [110]. Os estados finais de dano de radiação em Si e Ge em massa são principalmente defeitos FP, isto é, vacância e defeitos intersticiais.
Os eventos de deslocamento na superrede de Si / Ge
Neste estudo, os eventos de deslocamento de Si 2 / Ge 2 SL, que contém duas camadas de Si alternadas com duas camadas de Ge (ver Fig. 1b), são consideradas. Os átomos de Si e Ge adjacentes à interface Si / Ge são selecionados como PKA. O E d s para recuos de Si e Ge e os defeitos associados estão listados na Tabela 2. As configurações de defeito para recuos de Si e Ge são ilustradas nas Figs. 4 e 5, respectivamente. É notado que no caso de Si [111], nenhum defeito é criado mesmo com energias de até 100 eV. Devido às restrições computacionais, não realizamos simulações adicionais de eventos de recuo em energias superiores a 100 eV, e o exato E d valor para Si [111] não é determinado.

a - d Visão esquemática de estruturas geométricas da superrede de Si / Ge de danos após eventos de recuo de Si. As esferas azuis e verdes representam os átomos de Si e Ge, respectivamente. V X : X vaga ( X =Si ou Ge); X int : X intersticial ( X =Si ou Ge); X Y : X ocupando o Y site de rede ( X e Y =Si ou Ge). As esferas roxa e vermelha representam a vacância e os defeitos intersticiais, respectivamente
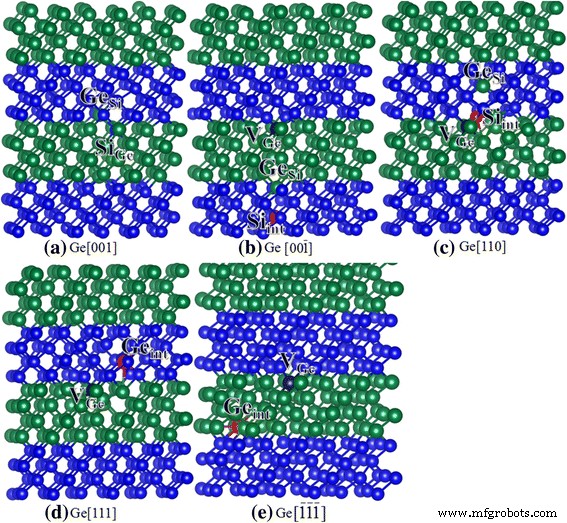
a - e Visão esquemática de estruturas geométricas da superrede de Si / Ge de danos após eventos de recuo de Ge. As esferas azuis e verdes representam os átomos de Si e Ge, respectivamente. V X : X vaga ( X =Si ou Ge); X int : X intersticial ( X =Si ou Ge); X Y : X ocupando o Y site de rede ( X e Y =Si ou Ge). As esferas roxa e vermelha representam a vacância e os defeitos intersticiais, respectivamente
Na estrutura Si / Ge SL, o Si PKA é facilmente deslocado ao longo da direção \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), conforme indicado pelo pequeno E d valor de 10 eV. O caminho para a geração de defeitos é muito simples, ou seja, o Si PKA se move 4,61 Å para longe de seu local de rede e forma um Si int defeito. Para Si [001] e Si \ (\ left [00 \ overline {1} \ right] \), o E d s são determinados como 46,5 e 42,5 eV, respectivamente, e os defeitos danificados são diferentes conforme o esperado. No caso de Si [001], o Si PKA se move ao longo da direção [001] para substituir seu átomo Ge vizinho (Si Ge ), e o átomo de Ge substituído colide com seu átomo de Si adjacente e ocupa seu sítio de rede, formando um Ge Si defeito anti-site. O átomo de Si substituído recebe energia suficiente e substitui outro átomo de Ge (Si Ge ), que finalmente ocupa um site intersticial. Eventualmente, os defeitos associados são um V Si , um Ge int e três defeitos anti-local. Quanto a Si \ (\ left [00 \ overline {1} \ right] \), dois átomos Ge vizinhos e um átomo Si vizinho também estão envolvidos no evento de deslocamento, e os estados danificados contêm duas vacâncias, dois intersticiais e dois defeitos anti-local, conforme mostrado na Fig. 4b. No caso de Si [110], o átomo de Si se move para atingir seu átomo de Si vizinho e se espalha na direção \ (\ left [11 \ overline {1} \ right] \). Então, o Si PKA substitui um átomo Ge vizinho, que ocupa um sítio intersticial no final. Após os eventos de deslocamento, os defeitos associados contêm um V Si , um Si Ge, e um Ge int defeitos. Em comparação com o Si em massa, os átomos de Si em Si / Ge SL são geralmente mais difíceis de serem deslocados, exceto no caso de [110] e os mecanismos de geração de defeitos são mais complexos, indicando que o Si em massa e Si / Ge SL mostram diferentes respostas de radiação à irradiação. Nossos resultados são consistentes com os experimentos realizados por Fonseca et al. e Leitão et al. [13, 14], que também descobriram que a resistência à radiação da estrutura SL foi aumentada em comparação com o silício em massa.
Para recuos Ge em Si / Ge SL, os átomos de Ge são facilmente deslocados ao longo das direções [111] e \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), que são semelhantes aos eventos de recuo Ge em Ge em massa. Embora os estados finais de dano de radiação para Ge [111] e Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) sejam muito semelhantes, ou seja, defeitos Ge FP, os mecanismos de geração de defeitos são diferentes. No caso de Ge [111], o Ge PKA se move 4,77 Å para longe de seu sítio de rede e forma um Ge int defeito. Para o Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), o átomo de Ge se move ao longo do \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) direção para substituir seu átomo Ge vizinho. O átomo de Ge colidido se move ao longo desta direção e ocupa um local intersticial no final. Observa-se que o E d valores de 16 eV para Ge [001] e 17,5 eV para Ge \ (\ left [00 \ overline {1} \ right] \) são comparáveis com o valor de 18 eV para Ge [001] em Ge em massa, enquanto o associado os defeitos mostram um caráter diferente. No caso de Ge [001], o Ge PKA recebe energia suficiente, mas se espalha ao longo da direção [111] para substituir seu átomo de Si vizinho, formando um Ge Si defeito anti-site. Então, o átomo de Si substituído ocupa o local da rede Ge PKA e forma um defeito anti-local (Si Ge ) No caso de Ge \ (\ left [00 \ overline {1} \ right] \), o Ge PKA se move 5,63 Å para substituir seu átomo de Si vizinho. O átomo de Si se move ao longo desta direção e forma um Si int defeito. Em comparação com o Ge [110] em Ge em massa, o E d para Ge [110] em Si / Ge SL é 8,5 eV menor, e os defeitos associados são mais complexos, conforme indicado por um V Ge , um Ge Si , e um Si int defeitos. Comparando os eventos de recuo de Ge em Ge e SL em massa, descobrimos que os átomos de Ge em Si / Ge SL são mais resistentes ao longo da direção [110]. Para outros eventos de deslocamento, o E d s são geralmente comparáveis aos dos estados em massa. No entanto, os estados finais de dano de radiação em Ge e Si / Ge SL em massa são diferentes, e alguns defeitos anti-local são criados na estrutura de SL de Si / Ge. Esses resultados sugerem que os recuos de Ge na estrutura Si / Ge SL apresentam diferentes respostas de radiação à irradiação. Comparando os recuos de Si e Ge na estrutura SL, descobrimos que os eventos de deslocamento dos átomos de Si são muito mais afetados do que Ge, ou seja, o E d s para átomos de Si na estrutura SL são geralmente aumentados, o que pode levar a uma maior resistência à radiação de Si / Ge SL. Sobolev et al. descobriram que as SLs de Si / Ge mostram uma dureza de radiação extraordinariamente alta em comparação com o Si em massa [12], o que é consistente com nossos resultados.
A barreira de migração e energia de formação de defeitos na superrede de Si, Ge e Si / Ge a granel
No Si e Ge em massa, os estados danificados são principalmente vacância e defeitos intersticiais. Quanto ao Si / Ge SL, os defeitos associados contêm defeitos de vacância, intersticiais e anti-local e os mecanismos de geração de defeitos são geralmente mais complexos. A discrepância na resistência à formação de defeitos entre os materiais do componente a granel e Si / Ge SL pode resultar em suas tolerâncias de radiação diferentes. Para investigar melhor a origem das diferentes respostas de radiação desses materiais semicondutores, calculamos as energias de formação de vacância, defeitos intersticiais e anti-local em estados volumosos e estruturas SL e a barreira de migração dos defeitos mais favoráveis empregando o método da teoria funcional da densidade. Os cálculos são baseados em uma supercélula consistindo de 64 átomos, com uma amostragem de 6 × 6 × 6 pontos k no espaço real e uma energia de corte de 500 eV.
As energias de formação de defeito em Si, Ge e Si / Ge SL em massa estão listadas na Tabela 3, juntamente com outros resultados calculados. No Si em massa, as energias de formação para V Si , Si int , e os defeitos de Si FP são calculados em 3,60, 3,77 e 4,62 eV, respectivamente, que estão em concordância razoável com outros cálculos [37,38,39,40]. Nossos resultados indicam que o V Si defeito é mais fácil de ser criado no Si em massa. Da mesma forma, o V Ge defeito em Ge em massa é energeticamente mais favorável do que Ge int e defeitos Ge FP, indicados pela menor energia de formação de defeito de 2,23 eV, que se compara bem com o valor teórico de 2,09 eV [39]. Quanto ao Si / Ge SL, a energia de formação de V Ge é determinado como 2,73 eV, que é menor do que as energias de formação de outros defeitos. O próximo defeito favorável é o V Si defeito, e a energia de formação é determinada como sendo 2,85 eV. Observa-se que o valor de 3,52 eV para Ge int é menor do que o valor de 3,77 eV para Si int defeito. Quanto ao defeito de FP, a energia de formação é obviamente maior, ou seja, 5,19 eV para Si FP e 5,01 eV para Ge FP, sugerindo que os defeitos de FP são difíceis de serem criados. Em comparação com os estados em massa, as energias de formação de defeito para a estrutura Si / Ge SL são geralmente maiores, exceto para os defeitos de V Si e Si int , indicando que na estrutura SL, os defeitos pontuais são geralmente mais difíceis de formar. Tal discrepância na resistência à formação de defeitos entre os estados de massa e a estrutura Si / Ge SL pode resultar em suas diferentes respostas à irradiação.
Com base nas estruturas otimizadas, os comportamentos de migração do V Ge e V Si defeitos que são os defeitos mais favoráveis em estruturas de massa e Si / Ge SL são investigados posteriormente. The V Ge e V Si defeitos que são adjacentes à interface Si / Ge são levados em consideração, e as barreiras de migração são resumidas na Tabela 4. Nota-se que as barreiras de migração ao longo das direções [100] e [110] para V Ge defeitos são menores do que aqueles para V Si defeitos e a barreira de energia para V Ge a migração ao longo da direção [111] é ligeiramente maior do que para V Si migração, que são consistentes com os resultados relatados por Cowern et al. [41].
As paisagens de energia da migração de defeitos ao longo das direções [100], [110] e [111] são plotadas na Fig. 6. Na Fig. 6a, as barreiras de migração do V Si defeito ao longo da direção [100] são determinados como sendo 4,32 e 3,92 eV em Si em massa e Si / Ge SL, respectivamente. Quanto à direção [110], a barreira de migração de 2,14 eV para V Si na estrutura Si / Ge SL está muito próximo do valor de 2,12 eV em Si em massa. Comparando a barreira de migração ao longo de cada direção, descobrimos que a direção [111] é a direção de migração mais favorável para vacâncias de Si e Ge, conforme indicado pelas barreiras de migração significativamente menores. Especialmente, o V Si os defeitos migram mais facilmente ao longo da direção [111] no bulk Si do que Si / Ge SL, uma vez que a barreira de energia de 0,11 eV no estado bulk é muito menor (ver Fig. 6e). Quanto ao V Ge defeitos, as barreiras de migração ao longo da direção [100] são calculadas em 3,67 eV em Ge bulk e 2,87 eV em Si / Ge SL. No caso da direção [110], as barreiras de energia são determinadas em 1,94 e 1,39 eV nas estruturas bulk e SL, respectivamente. Semelhante ao caso da migração de vacância de Si, o V Ge defeitos são mais fáceis de migrar ao longo da direção [111]. Além disso, a migração ocorre mais facilmente em Ge bulk do que Si / Ge SL, como mostrado na Fig. 6f. Nossos cálculos sugerem que as vacâncias de Si e Ge são mais móveis nos estados em massa do que na estrutura SL, o que pode resultar na formação de vazios e até mesmo no aumento do volume. Isso pode contribuir para diferentes respostas à irradiação para as estruturas em massa e SL.
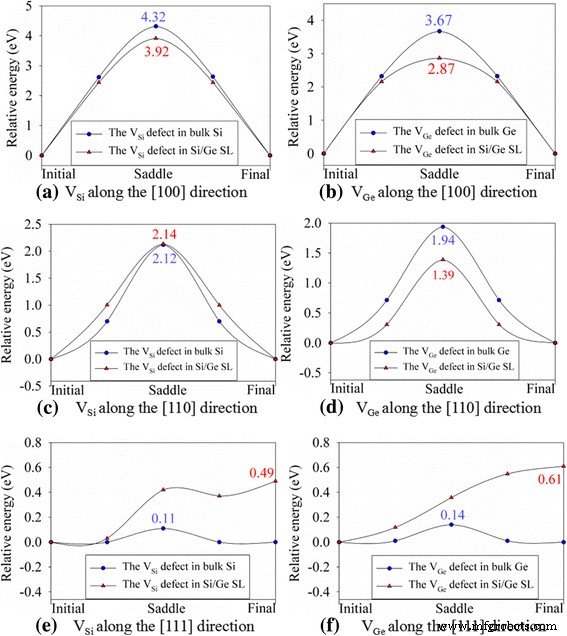
A barreira de migração da vacância de silício (V Si ) e vacância de germânio (V Ge ) defeitos obtidos por um método de banda elástica cutucada por cluster. a V Si ao longo da direção [100]; b V Ge ao longo da direção [100]; c V Si ao longo da direção [110]; d V Ge ao longo da direção [110]; e V Si ao longo da direção [111]; f V Ge ao longo da direção [111]
Conclusões
Em resumo, eventos de deslocamento de baixa energia na superrede bulk de Si, Ge e Si / Ge (SL) foram investigados por um método de dinâmica molecular ab initio. Em massa de Si e Ge, as energias de deslocamento de limiar são mostradas como dependentes da direção cristalográfica e os átomos são mais difíceis de serem deslocados ao longo da direção [110]. Os estados danificados nos estados em massa são principalmente vagas e defeitos intersticiais. Na estrutura Si / Ge SL, os átomos de Si são mais resistentes ao longo da direção [111], enquanto os átomos de Ge são mais difíceis de serem deslocados ao longo da direção [110]. Nossos cálculos mostram que as energias para os recuos Ge na estrutura SL são geralmente comparáveis àquelas no Ge em massa, enquanto as energias para os recuos de Si na estrutura SL são geralmente muito maiores do que aquelas no Si em massa, indicativo de resistência à radiação aumentada do Si / Ge SL. Cálculos de energia de formação de defeito mostram que os defeitos pontuais no Si / Ge SL geralmente têm energias de formação mais altas, indicando que na estrutura SL os defeitos pontuais são geralmente mais difíceis de formar. Também se descobriu que a direção [111] é o caminho de migração mais favorável para as vagas de Si e Ge, e ambas as vagas são mais móveis nos estados em massa do que na estrutura do SL. Nossos cálculos sugerem que o aumento da resistência à radiação do Si / Ge SL é benéfico para sua aplicação como dispositivos eletrônicos e optoeletrônicos sob condições extremas de trabalho, como radiação.
Abreviações
- AIMD:
-
Dinâmica molecular ab initio
- E d :
-
Limiar de energia de deslocamento
- FP:
-
Par Frenkel
- Ge:
-
Germânio
- Ge int :
-
Intersticial de germânio
- Ge Si :
-
Germânio ocupando o local da rede de silício
- LDA:
-
Aproximação de densidade local
- MD:
-
Dinâmica Molecular
- NVE:
-
Conjunto microcanônico
- PKA:
-
Átomo de conexão primária
- PL:
-
Fotoluminescência
- QD:
-
Ponto quântico
- QW:
-
Bem quântico
- Si:
-
Silício
- SIESTA:
-
Iniciativa espanhola para simulações eletrônicas com milhares de átomos
- Si Ge :
-
Silício ocupando o sítio de treliça de germânio
- Si int :
-
Intersticial de silício
- SL:
-
Superrede
- SZP:
-
Conjuntos de base única ζ mais orbital de polarização
- V Ge :
-
Vaga de germânio
- V Si :
-
Vaga de silício
Nanomateriais
- Avaliando a IoT e o impacto do 5G
- Revelando a estrutura atômica e eletrônica das nanofibras de carbono de copo empilhado
- Modelagem de Dinâmica Molecular e Simulação de Corte de Cério com Diamante
- Estudo de primeiros princípios sobre a estabilidade e imagem STM de Borophene
- Sondando as propriedades estruturais, eletrônicas e magnéticas dos aglomerados Ag n V (n =1–12)
- Efeito do recozimento em microestruturas e endurecimento de ligas de vanádio sequencialmente implantadas com hidrogênio e hélio
- Fabricação e caracterização de Nano-Clips de ZnO pelo processo mediado por poliol
- O mundo de simulação em rápida evolução
- A diferença entre motores CC e CA
- O poder da modelagem e simulação 3D estimula inovações nos processos de fabricação



