RTN e recozimento relacionados ao estresse e temperatura em ENCONTRAR Matriz RRAM
Resumo
Neste trabalho, é apresentada uma observação sobre o sinal de ruído telegráfico aleatório (RTN) na corrente de leitura de um dispositivo dielétrico FinFET RRAM (FIND RRAM). O sinal RTN de uma célula FIND RRAM muda após o dispositivo ser submetido ao estresse de ciclagem. Depois de passar por estresse de ciclagem, as células RRAM têm uma tendência mais forte de mostrar sinais de RTN mais frequentes e intensos. O aumento dos níveis de ruído em células FIND RRAM pode ser aliviado geralmente por recozimento de alta temperatura, e com este conceito, um esquema de recozimento no chip é proposto e demonstrado.
Introdução
O escalonamento contínuo da tecnologia CMOS melhorou drasticamente as características e o desempenho dos circuitos integrados na última década. No entanto, como o nó de tecnologia é reduzido abaixo de 20 nm, as variações devido a um único átomo / elétron nas características do dispositivo aumentam, por exemplo, flutuações dopantes aleatórias (RDF), trazendo assim questões fundamentais que não podem ser supervisionadas [1]. Por exemplo, quaisquer variações no número de portadores ou defeitos estruturais têm um impacto muito maior na saída e desempenho em um dispositivo dimensionado, e os efeitos do dimensionamento do dispositivo na variabilidade devido a RDF e rugosidade de borda de linha de porta (LER) também têm foi relatado [2,3,4]. O ruído telegráfico aleatório (RTN) é considerado outro grande desafio para dispositivos com área pequena, como NAND Flash e RRAMs [5,6,7,8,9,10,11]. Neste trabalho, investigamos o ruído RTN em uma célula FIND RRAM baseada em FinFET de canal n, que já foi implementada com sucesso no processo lógico padrão em matrizes de 1kbit [12]. Mudanças no RTN em resposta a tensões cíclicas e cozimento em alta temperatura são observadas. Neste trabalho, os efeitos do estresse e da temperatura no ruído RTN em células FIND RRAM são estudados, e um esquema de recozimento on-chip é proposto para aliviar o ruído de corrente de leitura variante do tempo após o ciclo.
Histórico e métodos
Um FIND RRAM consiste em dois transistores FinFET. Um atua como o transistor de seleção WL em série do nó RRAM. O dielétrico high-k gate entre o SiP e o SL do outro transistor serve como um nó de armazenamento, conforme mostrado na Fig. 1a. Os dispositivos FIND consistem no filme dielétrico de porta em FinFETs padrão, onde o eletrodo de porta é W para o eletrodo superior e TaN para o inferior. O óxido do gate stack consiste em HfO 2 / SiO 2 / Camadas de empilhamento TiN [12]. A condição de leitura de uma célula FIND RRAM é ilustrada na Fig. 1b, onde WL recebe 0,8 V para ligar o transistor selecionado, enquanto 0,8 V é adicionado ao SL a fim de conduzir uma corrente de leitura suficiente para os dados lidos. A comutação resistiva entre o estado de alta resistência (HRS) e os estados de baixa resistência (LRS) é obtida executando set / reset na célula FIND RRAM [13]. Um FIND RRAM mostra recursos de chaveamento resistivo razoavelmente estáveis em varreduras DC, veja a Fig. 2a, enquanto suas características de tempo para configurar e tempo para reconfigurar estão resumidas na Fig. 2b. As condições de operação listadas na Fig. 2a mostram que as operações de baixa tensão são possíveis. As células passam por vários ciclos de pulso para definir e redefinir a fim de atingir os níveis de corrente de leitura desejados. A largura de pulso aumentará se o dispositivo falhar em definir ou redefinir após vários pulsos serem aplicados, conforme ilustrado na Fig. 3a. O sinal RTN distinto pode ser encontrado nas células LRS e HRS FIND RRAM, como mostrado na Fig. 3b. Os sinais de RTN causados por captura e retirada de carga no caminho de condução da corrente podem levar a uma flutuação de corrente significativa [14,15,16,17].
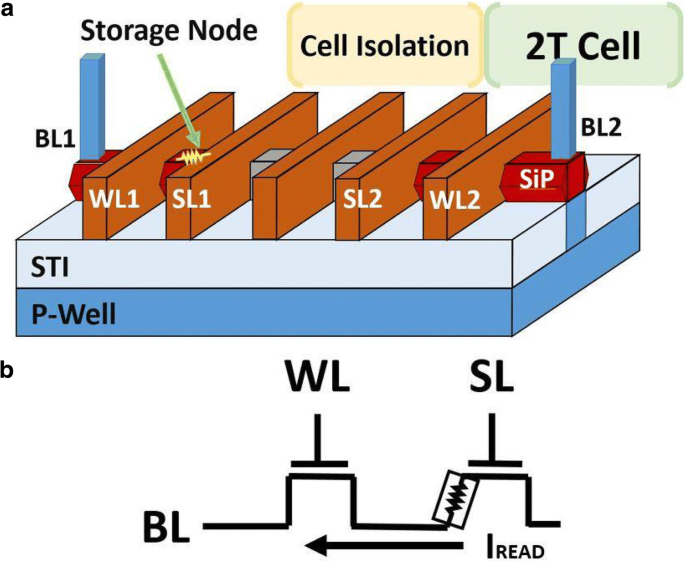
a Ilustração 3D das células 2 T FIND RRAM implementadas por tecnologias CMOS FinFET e b o esquema do circuito de uma célula unitária para FIND RRAM sob condição de leitura é mostrado, onde VSL =VWL =0,8 V e BL é polarizado em zero
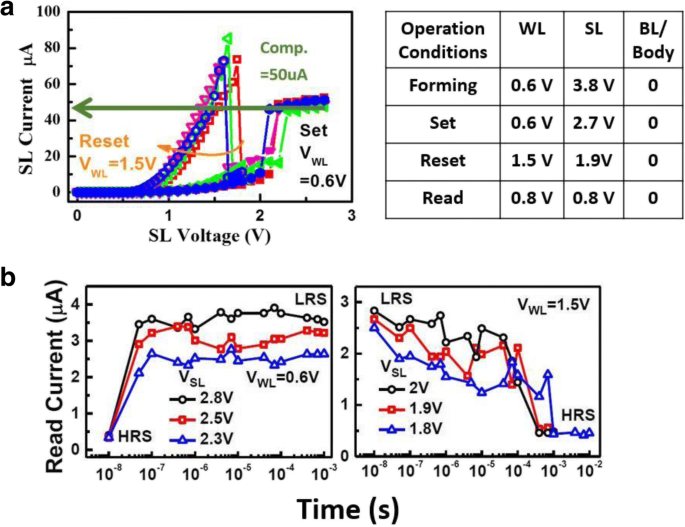
Os recursos de chaveamento resistivo DC do FIND RRAM e suas condições de operação são mostrados em ( a ) Suas características de tempo para definir e tempo para redefinir estão resumidas em ( b )

a Ilustração da largura de pulso crescente usada para realizar a operação de ajuste / reinicialização. Após o primeiro pulso de 1 μs, uma operação de leitura é realizada para avaliar se a corrente lida atinge os níveis alvo de 3 μA para LRS e menos de 1 μA para HRS. Se o estado requerido não for alcançado, o próximo pulso é dado. A largura do pulso é estendida em uma ordem a cada dez pulsos. b Comparação da corrente lida à temperatura ambiente amostrada em VSL =VWL =0,8 V e VBL =0, com taxa de amostragem de 500 Hz, antes e depois de ser ciclado 100 vezes
Está bem estabelecido que o ciclo repetido, ou seja, alternando entre os dois estados, pode induzir tensão na estratificação dielétrica da porta FinFET [18]. A camada de óxido de metal de transição (TMO) estressada nas células FIND RRAM tem uma tendência mais forte de mostrar ruídos RTN, levando a uma corrente de leitura variável no tempo que pode causar erros de leitura e desafios de estabilidade durante a leitura dos dados. Neste experimento, amostramos as correntes lidas da matriz no fresco, após 10 × ciclos e após 100 × ciclos, a fim de observar o efeito da tensão no RTN no FIND RRAM.
Para investigar o efeito da temperatura em células FIND RRAM estressadas, as amostras com sinais RTN distintos em LRS são primeiro resfriadas até 0 ° C e, em seguida, gradualmente aquecidas até 50 ° C. Durante esse processo, as correntes de leitura nessas temperaturas são amostradas continuamente por 20 s a uma taxa de 500 Hz. Isso nos dá algumas dicas de como o RTN se comporta sob mudanças de temperatura.
Resultados e discussão
Por meio de extensas medições, descobriu-se que o RTN é mais estável e facilmente observável em uma célula FIND RRAM em seu LRS. Portanto, no estudo do efeito de ciclagem e recozimento em RTN de células FIND RRAM, a seção a seguir se concentra na investigação de células em LRS. Conforme mostrado na Fig. 4a, os ruídos RTN levam a uma corrente de leitura variante no tempo que causa um erro de leitura. Este efeito pode ser observado na matriz de células de 1kbit. Em uma matriz que passou por 10 ciclos, flutuações de corrente de leitura significativas são encontradas ao amostrar a corrente de leitura durante um intervalo de 20 s. O mapa de corrente de bits normalizado em uma matriz é organizado na Fig. 4b, onde as flutuações de corrente no LRS podem ser tão altas quanto + 5%, que é comparável ao RTN observado na corrente de fuga da porta após o estresse [19]. Para investigar o efeito do estresse, rastreamos os níveis atuais de flutuação de 50 células antes e depois do estresse cíclico. Os dados na Fig. 5a revelam que mais de 90% das células exibem um aumento em ΔI / I após o ciclo. Nomeadamente, o ruído variante do tempo no FIND RRAM demonstrou piorar gradualmente à medida que as células experimentaram mais tensões de ciclo. À medida que comparamos a distribuição de corrente de leitura normalizada de células frescas e células cicladas, verifica-se que as células que passaram por mais ciclos exibem sinais RTN mais significativos e mostram duas ou mais distribuições de corrente de pico em estados específicos. Por outro lado, as células frescas têm uma distribuição de corrente de distribuição padrão, sugerindo que não há ruídos RTN envolvendo a flutuação, como demonstrado na Fig. 5b [20, 21]. Isso sugere que, uma vez que um FIND RRAM passa por um longo estresse de ciclo, sua corrente de célula de bits pode estar sujeita a uma flutuação mais drástica devido à adição de RTN.

a Uma corrente de leitura normalizada a 25 ° C amostrada a uma taxa de 500 Hz em uma célula RRAM que passou por 10 ciclos. Isso mostra que o RTN causa corrente de leitura variante do tempo. b Mostra o gráfico da corrente normalizada em matriz de 1kbit que passou por 10 ciclos, amostrados simultaneamente em t1 =3, t2 =7,5, t3 =14 e t4 =17,5 s, sequencialmente. Ao comparar o instantâneo em momentos diferentes, a leitura atual flutua nas mesmas condições de leitura

a Comparando a distribuição de | ΔI / I | de 50 amostras antes e depois do estresse. Pode-se ver que as células exibem ΔI / I geral maior após o estresse. Os valores percentuais do gráfico de caixa de baixo para cima representam os pontos percentuais 25, 50 e 75, respectivamente, enquanto os bigodes indicam os valores máximo e mínimo. b Um histograma de distribuição de corrente de leitura normalizada de uma célula medida a fresco e após 10 e 100 ciclos. Isso mostra que, uma vez que um FIND RRAM passa por um longo estresse de ciclo, sua corrente de célula de bits pode estar sujeita a uma flutuação mais drástica devido à adição de RTN
Os resultados normalizados da amostra de corrente lida em diferentes estágios de temperatura são comparados na Fig. 6. O tempo de captura e o tempo de emissão de traps RTN foram estudados e são conhecidos por mudar com a temperatura, sendo que ambos diminuem com o aumento da temperatura [22, 23 ] Como esperado, a frequência do ruído RTN aumenta à medida que a temperatura aumenta, nomeadamente que as flutuações da corrente lida a 0 ° C ocorrem com menos frequência do que a 25 ° C. No entanto, quando medido a 50 ° C, as flutuações de corrente entre dois estados tornam-se menos proeminentes. Isso pode ser revelado na Fig. 7a, que representa o histograma das correntes de leitura normalizadas medidas a 0 ° C, 50 ° C e à temperatura ambiente. As distribuições de corrente de 0 ° C e 25 ° C têm dois picos de distribuição, sugerindo estados de trapping único RTN dominando o caminho condutor [19], enquanto os estados discretos na corrente amostrada a 50 ° C tornam-se menos proeminentes. Isso sugere que em temperaturas mais altas, as armadilhas que causam o sinal RTN podem estar sujeitas a instabilidade como efeito de anelamento ou recombinação de defeitos, consequentemente afetando a probabilidade de aprisionamento de elétrons, facilitando assim o efeito RTN [27].

Uma comparação de correntes de leitura normalizadas de uma célula RRAM (no estado LRS) que passou por 100 ciclos com ruído RTN medido a 0, 25 e 50 ° C, a uma taxa de amostragem de 500 Hz

a Uma comparação de histogramas de distribuição de corrente de leitura normalizada de uma célula no estado LRS medido a 0, 25 e 50 ° C. b Uma comparação da probabilidade cumulativa de | ΔI / I | de 30 amostras antes do estresse, após o estresse e após recozido, respectivamente. Verificou-se que uma grande parte das células retorna ao seu ΔI / I original após o processo de recozimento
Em um estudo posterior, as amostras são aquecidas até 75 ° C. Essas células resfriam à temperatura ambiente após 30 min, então as amostras são coletadas. Trinta células são escolhidas e seus níveis de flutuação de corrente cumulativa em fresco, estressado e após recozido são comparados na Fig. 7b. Isso mostra que a maioria das células retorna ao seu ΔI / I original após o processo de recozimento. As correntes de leitura normalizadas de uma célula em seu estado fresco, estado estressado e depois de cozido são comparadas na Fig. 8. A corrente após o cozimento se assemelha àquela que é fresca, sugerindo que o cozimento em alta temperatura recoze as armadilhas que causam os sinais RTN. A Figura 9a é um gráfico organizado da corrente de leitura normalizada para uma matriz de 1kbit de células frescas, células ligeiramente estressadas, células altamente estressadas e depois do cozimento, respectivamente. A partir do gráfico, é demonstrado que as flutuações de corrente tornam-se mais intensas quando o RRAM está altamente estressado e é drasticamente reduzido após o cozimento em alta temperatura. Este efeito pode ser observado em toda a matriz, o que confirma que o cozimento em alta temperatura de fato fornece um efeito de recozimento para as armadilhas que induzem ruído RTN [24,25,26,27,28,29]. A Figura 9b compara ainda as distribuições ΔI / I em uma matriz de células obtida por dez amostragens diferentes sequencialmente. Verificou-se que a mesma matriz exibe diferentes distribuições ΔI / I em seus estados fresco, de tensão e após recozido. Os dados sugeriram que o recozimento ajuda a matriz de células a mostrar flutuações de corrente reduzidas, semelhante ao nível de uma matriz em seu estado fresco. Este resultado pode ser usado para corrigir e estender a vida útil das células FIND RRAM que exibiram sinais RTN após o estresse cíclico.

Leia as correntes de células frescas e estressadas amostradas a 25 ° C, 500 Hz em comparação com a da célula após assar em alta temperatura e resfriar em um período de 30 minutos até a temperatura ambiente. Isso mostra que após o cozimento, o estresse é aliviado e a célula se comporta de forma semelhante a uma nova

a Correntes de leitura normalizadas de uma matriz de 1kbit tomadas em um tempo específico plotadas em fresco, levemente estressado, altamente estressado e após recozido. Pode-se observar que o número de células com forte flutuação aumenta muito em toda a matriz conforme a matriz sofre mais estresse e morre após ser recozida. b Comparação das probabilidades cumulativas de | ΔI / I | distribuições de 50 amostras da mesma matriz em seus estados fresco, estressado e após recozido, em diferentes instâncias de tempo com um intervalo de 1 s. O ΔI / I geral nas amostras após o estresse é maior e retorna ao normal após o recozimento
É importante mencionar que algumas células presas em um estado intermediário durante o ciclo são revividas após o tratamento de alta temperatura. À medida que uma célula FinFET RRAM percorre LRS e HRS, o filamento condutor em algumas células pode formar um canal que não pode ser redefinido facilmente. O processo de cozimento fornece a essas células um caminho para redistribuir suas vacâncias de oxigênio, conseqüentemente permitindo um reset efetivo para HRS [30]. A Figura 10 mostra uma célula que não foi capaz de mudar para HRS sendo revivida após 125 ° C, 15 min de cozimento. Com isso em mente, um mecanismo de recozimento on-chip envolvendo o aquecimento local da célula FIND RRAM é proposto. Uma corrente constante de 1,5 mA com um período de 10 s é aplicada à célula por meio de polarização direta na junção de drenagem do FinFET selecionado, conforme ilustrado na Fig. 11a. Esta grande corrente aquece uma região confinada perto do RRAM TMO e fornece um efeito de recozimento semelhante. A corrente lida antes e depois do recozimento do dispositivo em teste (DUT) é medida e analisada na Fig. 11b. As distribuições cumulativas da corrente de leitura continuamente amostrada demonstram a remoção de RTN em uma célula após a etapa de recozimento no chip. Aqui, o recozimento no chip do FIND RRAM foi realizado em células individuais em etapas sequenciais para compreender a resposta nominal a uma célula RRAM típica após o estresse. Um novo procedimento de recozimento no chip precisa ser desenvolvido para um experimento em nível de array.

Ao aplicar o cozimento a 125 ° C às células que estão presas no estado intermediário e fornecer um processo de recozimento, convertemos essas células de volta ao estado funcional, prolongando assim a vida útil da célula

O esquema de recozimento no chip que propusemos envolve a aplicação de -1 V na polarização direta resultante de BL e uma corrente medida de 1,5 mA, que aquece e recoze a célula estressada. No gráfico, comparando a porcentagem cumulativa da corrente normalizada da célula antes e depois do processo, podemos ver que a flutuação da corrente causada pelo RTN é bastante reduzida
Conclusão
Neste artigo, o estresse e o efeito da temperatura no RTN no arranjo de células FIND RRAM são discutidos. Observa-se um aumento do RTN induzido pelo estresse do ciclismo. É observado o efeito do tratamento de alta temperatura na redução do RTN e no alívio do estresse para TMO em um FIND RRAM. Finalmente, um esquema de recozimento no chip é proposto e demonstrado.
Abreviações
- ENCONTRAR RRAM:
-
Memória de acesso aleatório resistiva dielétrica de transistor de efeito de campo Fin
- HRS:
-
Estado de alta resistência
- LER:
-
Rugosidade da borda da linha
- LRS:
-
Estado de baixa resistência
- RTN:
-
Ruído telegráfico aleatório
- TMO:
-
Óxido de metal de transição
Nanomateriais
- [Explicado] O que é rastreamento de ativos e perguntas relacionadas
- Controle de acesso com QR, RFID e verificação de temperatura
- Sensor de temperatura Python e Raspberry Pi
- Temperatura e umidade fáceis no Raspberry Pi
- DIY:Monitoramento e regulação de temperatura para HomeBrew
- Temperatura do Raspberry Pi e sensor de luz
- Materiais:Dicas de recozimento para polímeros amorfos, Parte 2
- Medindo a temperatura dentro de compósitos e linhas de adesão
- O que é recozimento? - Definição, processo e estágios
- Sensor de fluxo e temperatura Lab-On-Chip



