Estudo de EDX, HAADF e EELS de resolução atômica de ligas GaAs1-xBix
Resumo
A distribuição de átomos ligados em semicondutores freqüentemente desvia de uma distribuição aleatória que pode ter efeitos significativos nas propriedades dos materiais. Neste estudo, técnicas de microscopia eletrônica de transmissão de varredura são empregadas para analisar a distribuição de Bi em vários GaAs de crescimento distinto em MBE 1 − x Bi x ligas. Quantificação estatística de imagens HAADF de resolução atômica, bem como simulações numéricas, são empregadas para interpretar o contraste de colunas contendo Bi na interface GaAs-GaAsBi atomicamente abrupta (001) e o início da ordenação do tipo CuPt. Usando o mapeamento EELS monocromado, os desvios para o vermelho da energia do plasmon em massa são examinados em uma amostra exibindo domínios separados por fase. Isso sugere um método simples para investigar expansões de volume de célula unitária GaAsBi local e para complementar medições de deformação reticular baseadas em raios-X padrão. Além disso, uma amostra de GaAsBi ordenada por CuPt de variante única cultivada em um substrato de corte é caracterizada com mapeamentos EDX de composição em escala atômica e o parâmetro de ordem é estimado. Finalmente, uma liga GaAsBi com uma modulação de composição Bi vertical é sintetizada usando uma baixa taxa de rotação de substrato. Atomicamente, EDX resolvido e imagens HAADF mostram que a ordem usual do tipo CuPt é modulada adicionalmente ao longo do eixo de crescimento [001] com um período de três constantes de rede. Essas amostras distintas de GaAsBi exemplificam a variedade de distribuições de Bi que podem ser alcançadas nesta liga, lançando luz sobre os mecanismos de incorporação de átomos de Bi e maneiras de desenvolver semicondutores III-V contendo Bi.
Introdução
O bismídeo GaAs 1 − x Bi x A liga passou por uma extensa quantidade de pesquisas e representa a classe emergente de semicondutores do grupo III-V contendo bismuto [1]. O bismuto é o maior elemento estável e não tóxico, que após incorporação produz grande redução do gap de GaAs. A substituição de Bi na sub-rede do grupo V permite alcançar a curvatura do band gap de até 90 meV / Bi% em GaAsBi com uma deformação de rede moderada [1,2,3]. Uma grande divisão da banda spin-órbita é outro efeito notável da incorporação de Bi na rede. Isso pode permitir a supressão da absorção da banda de inter-valência e recombinação Auger-Meitner em GaAs 1 − x Bi x com concentrações x > 10% [4]. Combinado com a sensibilidade de banda gap reduzida, essas propriedades tornam o bismídeo um candidato atraente para aplicações em lasers infravermelhos de onda longa, fotodetectores e células solares multijuncionais, entre outros [1, 5,6,7].
A incorporação de Bi na matriz de GaAs requer condições não convencionais de crescimento, uma vez que os átomos de Bi tendem a se dessorver em temperaturas típicas de crescimento de GaAs [8,9,10]. As temperaturas do substrato abaixo de 400 ° C são normalmente necessárias, bem como as razões do grupo III / V quase estequiométricas. Deve-se ter cuidado para evitar a formação de gotas superficiais de Ga ou Bi, que podem ocorrer facilmente próximo a essas condições e estão associadas a não uniformidades da espessura da camada de crescimento e de sua composição [11,12,13,14]. Baixas temperaturas necessárias para incorporar maiores concentrações de Bi tornam a epitaxia de feixe molecular (MBE) o método preferido de síntese, embora tenha havido progresso com o uso de epitaxia de fase de vapor orgânico metálico [15,16,17]. As ligas de GaAsBi ainda mostram intensidade de fotoluminescência (PL) surpreendentemente alta para essas baixas temperaturas de crescimento, o que é atribuído ao efeito do surfactante Bi e densidade reduzida de defeitos pontuais relacionados ao As que normalmente se formam em GaAs de baixa temperatura [18, 19]. Na imagem do anti-cruzamento da banda de valência (VB), átomos Bi individuais incorporados produzem um estado ressonante abaixo do GaAs VB estendido, causando a redução do gap óptico [2, 20, 21]. Cálculos de primeiros princípios também demonstram que aglomerados compostos de átomos Bi que interagem nas proximidades podem produzir um estreitamento de lacuna de banda significativamente maior do que átomos Bi isolados [22]. Essas diferentes configurações Bi produzem fortes perturbações VB e podem introduzir estados de defeitos eletrônicos localizados. Estudos sugerem que a cepa de rede produzida por grandes átomos Bi fará com que os aglomerados se liguem a vacâncias V Ga e V As [23]. As condições de crescimento As-rich devem favorecer a formação de Bi Ga defeitos hetero-antisite que são previstos para causar armadilhas de orifícios profundos em GaAsBi [23, 24]. Efeitos pronunciados de localização de excitons são comumente observados em PL dependente da temperatura de ligas de GaAsBi e são atribuídos a tais aglomerados relacionados a Bi e complexos de defeitos [25, 26].
Como muitas outras ligas semicondutoras ternárias III-V, GaAsBi mostra a tendência de ordenação espontânea [27]. O chamado CuPt B A ordenação de tipo, em que a concentração de átomos Bi é modulada em cada segundo {111} plano do tipo B, foi observada usando microscopia eletrônica de transmissão de alta resolução (varredura) (STEM / TEM) [13, 17, 28]. É amplamente aceito que o CuPt B A modulação do tipo em ligas III-V é conduzida pela dinâmica de reconstrução de superfície e é acompanhada pela reconstrução (2 × 1) que consiste em linhas de dímero de superfície [27, 29,30,31,32,33]. Quando depositado em substratos planos (001) GaAs, a ordenação ocorre em dois dos quatro conjuntos distintos de {111} planos. Uma única subvariante de ordenação do tipo B pode ser posteriormente selecionada utilizando substratos vicinais. De fato, um trabalho recente mostrou que isso se aplica também ao GaAsBi, em que grande CuPt B Domínios -type foram alcançados em um único conjunto de {111} planos B usando wafers offcut de baixo ângulo [34]. A ordenação do tipo CuPt em GaInP 2 é provavelmente o mais estudado, uma vez que cristais de alta qualidade com parâmetros de ordem grandes podem ser obtidos nesta liga. A ordem de longo alcance muda a simetria do grupo de pontos de zinco-blenda do tetraédrico T d para trigonal C 3v [35, 36] . Os efeitos notáveis devido à redução da simetria incluem o estreitamento do gap, a polarização da fotoluminescência, birrefringência e deformação anisotrópica [37,38,39]. A magnitude desses efeitos depende do parâmetro de ordem de longo alcance, η , que mostra a extensão da distribuição elementar entre os planos de rede ordenados. Em um CuPt B -orded AB 1 − x C x liga (para x <=0,5), a rede alterna em AB rico em elementos B 1− ( x − η / 2) C x − η / 2 e AB rico em C 1- ( x + η / 2) C x + η / 2 monocamadas ao longo de uma direção <111> B. O parâmetro de pedido η =0 em uma liga aleatória enquanto em uma liga totalmente ordenada com concentração x é assim η =2 x .
Claramente, a distribuição de Bi dentro de tais ligas ordenadas difere de uma liga aleatória, e isso deve ser considerado ao deduzir as propriedades da liga [17, 40]. A compreensão dos efeitos do ordenamento do CuPt em ligas diluídas de GaAsBi ainda está nos estágios iniciais, exigindo estudos mais sistemáticos. Neste artigo, métodos avançados de STEM com correção de aberração são empregados para analisar os modos de distribuição de Bi em várias ligas de GaAsBi distintamente crescidas. A análise é realizada usando processamento estatístico de imagem de contraste STEM Z e simulações de imagem, bem como espectroscopia dispersiva de energia de raios X atomicamente resolvida (EDX). A espectroscopia de perda de energia de elétrons monocromada (EELS) é empregada para investigar as mudanças no volume da célula unitária local em GaAsBi usando mudanças de energia plasmônica em massa.
Resultados e discussão
O primeiro GaAs 1 − x Bi x a amostra apresentada aqui, S1, é um heterodíodo p-i-n com camadas de GaAs dopadas e bismeto intrínseco de 420 nm. A concentração de bismuto na amostra foi determinada como sendo 4,5% Bi usando difração de raios-X (não mostrado aqui) e PL à temperatura ambiente, indicando intervalo de banda de 1,10 eV (SI Fig. S1). As medições da borda da banda PL são traduzidas para Bi% usando as referências [1, 2, 4]. Uma imagem HAADF STEM de resolução atômica em corte transversal ao longo [110] do eixo da zona perto da interface GaAs-GaAsBi é mostrada na Fig. 1a. O eixo de crescimento [001] e outras direções cristalográficas relevantes estão marcados na Fig. 1b e também se aplica à Fig. 1a. Como os átomos Bi pesados espalham os elétrons da sonda em ângulos altos muito mais fortes do que os átomos Ga ou As, o detector HAADF com um grande ângulo de coleta interna (90 mrad aqui) destaca favoravelmente a distribuição Bi em amostras finas. O cristal visto ao longo de uma direção <110> aparece como uma coleção de “halteres” atômicos, que são orientados paralelamente ao eixo de crescimento [001]. Devido aos seus números atômicos semelhantes (Z), Ga (31) e As (33) não podem ser facilmente distinguidos pela mera inspeção das imagens HAADF. No entanto, as colunas do grupo V contendo Bi mostram um contraste visivelmente mais alto. Como pode ser visto na Fig. 1a e na região ampliada perto da interface, as colunas do grupo V são posicionadas na metade superior dos halteres acima das colunas de Ga. Isso é esperado ao obter imagens do GaAsBi ao longo do eixo da zona [110]. Observe que a polaridade dos halteres do grupo V / III é invertida quando a amostra é vista ao longo da direção ortogonal [\ (\ overline {1} \) 10]. Essas direções ortogonais no plano também podem ser distinguidas, uma vez que a ordenação do tipo CuPt ocorre em planos do tipo {111} B e, portanto, só podem ser vistos por imagem ao longo do eixo da zona [110]. A Figura 1b mostra uma imagem HAADF de ampliação inferior mais profunda no filme com CuPt B pronunciado -tipo ordenação. Os domínios ordenados alternam aleatoriamente entre os dois conjuntos de {111} planos B, ou seja, (\ (\ overline {1} \) 11) e (1 \ (\ overline {1} \) 1). Estes são denominados B + e B - subvariantes por convenção. A transformação de Fourier da imagem é mostrada na inserção superior esquerda. Os quatro pontos principais de Bragg são do tipo [111] *, enquanto os quatro pontos de superrede do tipo 1/2 [111] * indicam CuPt B ordenando com magnitude semelhante nos dois conjuntos de {111} planos B. Uma região GaAsBi separada por fase é visível na Fig. 1b como uma faixa mais escura na porção inferior da imagem. Este domínio parece mais escuro do que um bismídeo, uma vez que é semelhante ao GaAs Bi-deficiente. Devido à metaestabilidade das ligas GaAsBi, uma decomposição espinodal e separação de fases foram relatadas em muitos artigos [11,12,13,14, 41, 42]. Para uma descrição mais clara do B + e B - ordenação subvariante, Figs. 1c, d são apresentados formando imagens usando pares de reflexão de superrede 1/2 [111] *. Uma máscara é aplicada a cada par de superrede no espaço recíproco e Fourier inverso transformado de volta para o espaço real. Regiões mais brilhantes de (111) planos nessas imagens indicam que a ordem é mais pronunciada, ou em outras palavras, que o parâmetro de ordem está variando localmente. Existem também variações da espessura da superfície da amostra TEM devido à preparação da amostra por um feixe de íons focalizado. A preparação da amostra pode deixar camadas de superfície amorfas e aglomerados atômicos de Ga fundidos na superfície, o que pode causar modulações de intensidade de imagem fracas. No entanto, Ga se espalha de forma muito mais fraca para ângulos altos do que os átomos Bi e não deve influenciar significativamente a análise da distribuição de Bi. A seta na Fig. 1d mostra uma região com ordenação de limites antifásicos. Do outro lado dessa fronteira, o B + (B - ) o domínio muda sua fase trocando todos os planos Bi-ricos para planos As-ricos. A ordenação de limites antifásicos pode se formar por deslizamento de deslocamentos ou devido a uma alternância aleatória entre B + e B - domínios durante o crescimento [43]. O último parece ser o caso aqui.
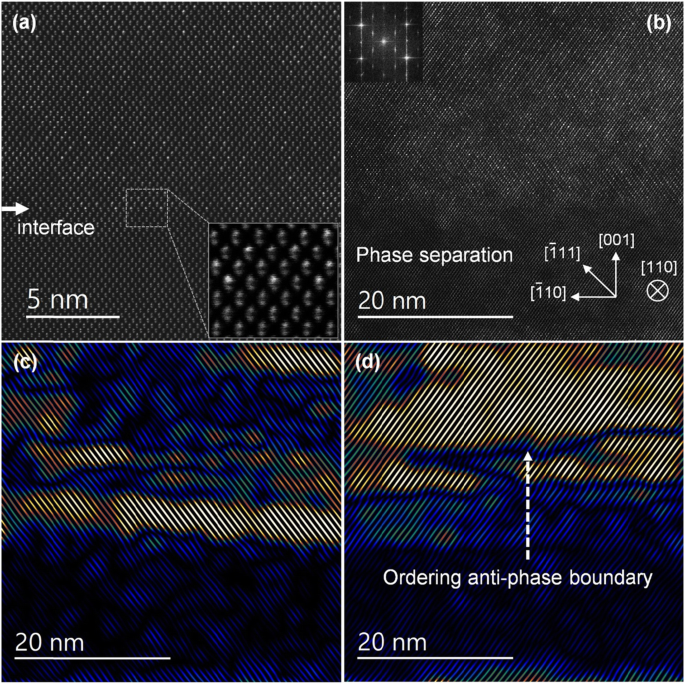
a Imagem HAADF transversal da área de interface de amostra S1 GaAs-GaAsBi. Uma inserção ampliada da interface é mostrada no canto inferior direito. As direções cristalográficas são as mesmas da Fig. 1b. b Imagem HAADF da amostra longe da interface. Um domínio semelhante a GaAs separado por fase espontaneamente alongado é visto no meio. A inserção mostra a transformação de Fourier da imagem. c Uma imagem formada a partir de ( b ) usando o 1/2 [\ (\ overline {1} \) 11] * par de reflexões de superrede. Cores mais brilhantes indicam uma ordem mais pronunciada. d Uma imagem formada a partir de ( b ) usando o par de ½ [1 \ (\ overline {1} \) 1] * reflexões
A quantificação da imagem HAADF mostrada na Fig. 1a é realizada a seguir, considerando as distribuições espaciais das seções transversais de espalhamento da coluna atômica (SCS) (ver Métodos). O algoritmo StatSTEM é usado para ajustar colunas com gaussianas bidimensionais, e o SCS de uma dada coluna é definido como volume sob essa gaussiana [44, 45]. Esta é uma quantificação baseada em modelo paramétrico, em oposição à integração direta de intensidades de coluna em uma imagem experimental. A abordagem do modelo paramétrico pode ser mais confiável se as intensidades da coluna tendem a se sobrepor, como em <110> GaAsBi. A distribuição de SCS na Figura 1a quantificada é plotada como um histograma na Figura 2b, que é provisoriamente ajustada com cinco gaussianas. As distribuições espaciais de SCS são então plotadas na Fig. 2a na estrutura do modelo composta de uma superposição de gaussianas usando os mesmos quadrados de esquema de cores colocados em cada coluna. As colunas SCS de Ga e As se sobrepõem fortemente e produzem o pico principal no histograma. Isso se deve aos números Z semelhantes desses átomos, bem como ao alargamento adicional introduzido experimentalmente (consulte Métodos). Ao representar graficamente o componente gaussiano inferior (cor azul escuro) ou o superior (azul mais claro) dentro deste pico principal mostra que ~ 60% de, por exemplo, as colunas As na camada tampão de GaAs são identificadas corretamente, como pode ser inspecionado a partir da polaridade do haltere . Para comparação, a quantificação SCS da camada tampão de GaAs inferior sozinha é apresentada na Fig. S2 suplementar. Isso sugere que mais de duas gaussianas são necessárias atualmente para distinguir melhor as colunas Ga e As no campo de visão e indica que seu SCS médio difere em até 10%. Essa diferença está de acordo com nossas simulações apresentadas a seguir e também com os resultados encontrados em Beyer et al. [17], onde as distribuições de intensidade da coluna integrada Ga e As em [010] GaAsBi foram resolvidas. A presença de átomos Bi fortemente dispersos estende o SCS a valores acima de ~ 5,5 × 10 5 e - Å 2 (ver SI Fig. S2), que dá origem ao ombro direito na Fig. 2b. É equipado com três gaussianas para distinguir provisoriamente as colunas com maior conteúdo de Bi. A interface GaAs-GaAsBi atomicamente abrupta pode ser vista na Fig. 2a. Uma inspeção mais detalhada mostra que a primeira camada de colunas do grupo V (001) contendo um número significativo de átomos Bi está disposta em cada segundo haltere ao longo da interface. Isso sugere o início da ordenação do tipo CuPt no início do crescimento epitaxial. Uma representação da configuração atômica da interface é mostrada na inserção da Fig. 2b. Ele recria o arranjo dos átomos ao longo da interface com os átomos Bi (laranja) em cada segunda coluna ao longo do primeiro plano do grupo V (001). Os primeiros ~ 4-5 (001) planos atômicos na Fig. 2a não mostram predisposição para CuPt B + ou B - subvariantes. A ordenação de variante única mais pronunciada emerge da ~ 6ª (001) camada atômica do grupo V e, em seguida, muda para a outra subvariante. Sem defeitos anti-local Bi Ga são indicados pela distribuição SCS na interface, que seriam visíveis como quadrados nas colunas do grupo III com cores associadas a Bi. Uma probabilidade de vários Bi Ga antisites, no entanto, é encontrado no canto superior direito da figura. Ambas as colunas do grupo III e do grupo V mostram SCS tipo Bi em halteres únicos naquela região, o que também pode indicar a presença de pares de defeitos Bi Ga -Bi As . Para ter uma ideia melhor do número de átomos Bi envolvidos na determinação do SCS, observe que em uma amostra nominal de 20-25 nm de espessura há 50-60 átomos em uma coluna <110>. Assim, 2–3 átomos Bi são mais prováveis de serem encontrados em uma coluna do grupo V para uma liga aleatória com atualmente 4,5% de Bi. Este número será maior em planos Bi-ricos ordenados, provavelmente alcançando até 6–7 em colunas com o maior SCS [40]. Para complementar a análise StatSTEM, a simulação de imagem HAADF multislice é apresentada a seguir em uma estrutura de supercélula modelo GaAsBi <110> (consulte Métodos para obter detalhes).

a Uma distribuição de SCS na Fig. 1a. Os quadrados coloridos em cada coluna atômica estão de acordo com o esquema de cores SCS da Fig. 2b. b Um histograma de SCS na Fig. 1a, equipado com 5 gaussianas. A inserção mostra uma representação da região da interface. As colunas atômicas Ga estão em azul escuro, As - em azul mais claro e as colunas que contêm Bi estão em laranja. c Imagem HAADF simulada da estrutura GaAsBi mostrada na Fig. 2d. O número de átomos Bi em uma coluna é mostrado entre parênteses em laranja à direita de cada coluna do grupo V. Os valores SCS ajustados são mostrados à esquerda de cada coluna e são normalizados para o maior valor SCS na supercélula. d A estrutura do modelo GaAsBi <110> girou lateralmente para destacar as posições Bi (laranja), átomos de azul claro-As e azul-escuro-Ga. A seta mostra a direção do feixe incidente
A contribuição para a intensidade da imagem HAADF de átomos Bi em diferentes profundidades de amostra pode ser não linear devido ao que é vagamente denominado como canalização [46,47,48,49]. A quantificação de dopantes na escala atômica, portanto, requer consideração ao distinguir a variação real na composição da variação nas configurações de dopante [50, 51]. Para ilustrar o comportamento de canalização, a variação média da intensidade da sonda com a profundidade da amostra quando posicionada sobre a coluna As em <110> GaAs é numericamente simulada e mostrada na Fig. S3 suplementar (consulte Métodos). O modelo GaAsBi estrutura 17 nm de espessura usado para simulações HAADF é mostrado na Fig. 2d girado lateralmente para destacar as posições dos átomos Bi (laranja) dentro de colunas As (As — azul claro, Ga — azul escuro). A seta marca a direção do feixe incidente. A imagem simulada mostrada na Fig. 2c é ajustada usando o algoritmo StatSTEM para comparação com o experimento. Os valores de SCS obtidos foram normalizados para o valor de SCS da coluna com o maior SCS (6 átomos Bi) e arredondados para dois dígitos significativos. Esses valores normalizados são mostrados à esquerda de cada coluna. O número de átomos Bi em cada coluna do grupo V é mostrado entre parênteses à direita da coluna. Em uma concordância razoável com as descobertas anteriores, a diferença entre os valores de As e Ga SCS é de aproximadamente 8%. A diferença no SCS entre a coluna As puro e as colunas As contendo um átomo Bi está em um intervalo de 2–4% para átomos Bi posicionados de forma diferente. Pode-se ver claramente que diferentes configurações de Bi podem ser mal interpretadas para diferentes composições, por exemplo, 4 e 5 átomos ou 5 e 6 átomos, que dão quase os mesmos valores de SCS. Os átomos bi em uma coluna em direção à superfície inferior contribuem cada vez menos para o SCS. Várias configurações com 2 átomos Bi, um após o outro, examinados aqui, parecem produzir grandes contribuições para os valores de SCS. Uma configuração de 2 átomos Bi ao longo de uma [110] coluna pode ser encontrada na prática se o CuPt B pedidos em ligas GaAsBi realmente produzem unidades estruturais com C 3v simetria de grupo de pontos, isto é, um átomo de Ga com os vizinhos mais próximos 1 átomos As e 3 Bi. Observe que as colunas Ga idênticas também mostram variação em seu SCS em até ~ 0,02. Isso sugere que seu ambiente imediato, por exemplo, nas proximidades de colunas fortemente dispersas, contribui com intensidade adicional devido ao espalhamento múltiplo ou por acoplamento a eles por meio de caudas de sonda estendidas [52]. Os melhores algoritmos de escalonamento introduzidos recentemente abrem a possibilidade de acelerar os cálculos multislice da mecânica quântica e, assim, de explorar os efeitos mencionados acima com mais detalhes [53, 54].
Para concluir a análise STEM da amostra S1, a espectroscopia de perda de energia de elétrons (EELS) é usada para mapear as energias do plasmon em massa. As mudanças de energia do plasmon estarão relacionadas às mudanças de volume da célula unitária e, portanto, à deformação da liga, como discutido a seguir. GaAs exibe um pico de plasmon principal em ~ 16 eV e, ao contrário, por exemplo, CdTe, ele não mostra recursos de interferência complexos de transições inter-bandas [55]. Como uma primeira aproximação para interpretar as mudanças medidas na energia do plasmon, empregamos o modelo de Drude-Lorenz para gás de elétron de elétron livre, onde elétrons livres são agora os elétrons de valência no semicondutor [56]. A energia plasmática em massa neste modelo é dada como \ ({E} _p =\ hslash {\ left (N {e} ^ 2 / Vm {\ epsilon} _0 \ right)} ^ {1/2} \), onde N é o número de elétrons de valência na célula unitária, e é a carga do elétron, V é o volume da célula unitária, m é a massa do elétron, e ε 0 é a permissividade do espaço livre. O modelo Drude-Lorenz simples geralmente prediz a energia do plasmon dentro de uma pequena porcentagem em semicondutores e precisa ser corrigido para efeitos de estrutura de banda se uma melhor correspondência for buscada [56]. Conforme mostrado em InGaAs e ligas semicondutoras de nitreto do grupo III, a mudança no volume da célula unitária é a quantidade principal que determina as mudanças de energia do plasmon [57, 58]. Da mesma forma, a substituição de átomos Bi isoeletrônicos na matriz de GaAs atua principalmente para expandir o volume da célula unitária, V e, assim, desviar para o vermelho a energia do plasmon. A seguir, empregamos as energias de pico medidas de GaAs e GaAsBi para inferir a mudança de estado de deformação local na camada de GaAsBi por meio de uma razão de seus volumes de células unitárias.
É selecionada uma região que contém domínios GaAsBi separados por fase mostrados na imagem HAADF Fig. 3. Os espectros de EELS foram coletados de cada pixel que acompanha a imagem HAADF adquirida simultaneamente (ver Métodos e SI Fig. S4 para espectro bruto). As linhas tracejadas na imagem HAADF indicam as interfaces entre o GaAsBi intrínseco e as camadas de GaAs tipo p (parte inferior) e tipo n (parte superior). As linhas de demarcação da interface foram determinadas a partir de imagens STEM de menor ampliação (não mostradas aqui). A camada protetora de Pt é visível como o material de maior contraste acima do n-GaAs superior. Camadas de GaAs e também domínios separados por fase dentro de GaAsBi aparecem mais escuros na imagem HAADF. O perfil da linha vertical na figura do EELS do lado direito foi adquirido categorizando todos os pontos de dados do EELS horizontalmente. Mostra a mudança relativa da energia de pico do plasmon em massa, E GaAsBi -E GaAs , conforme referido à energia de plasmon GaAs (medida como sendo 16,23 eV) dentro da camada tampão inferior de p-GaAs. O pico do plasmon muda em média 0,08 eV para reduzir as energias na camada de GaAsBi. As pequenas variações dentro de ~ 0,01 eV estão nos níveis de ruído de quantificação. Os domínios separados por fase próximos ao GaAs superior (camada fina) e inferior (dois domínios que se cruzam) retornam ao valor de energia do plasmon GaAs, sugerindo que eles contêm concentrações insignificantes de Bi. Concentrações de dopante nas camadas de GaAs (ordem 10 17 cm −3 ) são insignificantes em comparação com N / V e não deve afetar a energia do plasmon. Agora consideramos dois casos limites para o GaAs 1 − x Bi x volume de célula unitária V ; um onde a rede é totalmente relaxada e outro onde é totalmente tensionado para o substrato GaAs. No caso totalmente relaxado, a célula unitária é cúbica com constante de rede a ≈ 5,684 Å em x =4,5% Bi [1]. Usando a relação de raiz quadrada acima entre a energia do plasmon e V , a mudança de energia em relação a GaAs deve ser \ (\ Delta {E} _p ^ {GaAs Bi} =16,23 \ left ({\ left ({V} _ {GaAs} / {V} _ {GaAs Bi} \ right) } ^ {1/2} -1 \ right) =- 0,132 \ mathrm {eV} \), que é claramente maior do que o medido. Com base nas tendências de relaxação das ligas de GaAsBi, estimamos que ~ 30% da rede está relaxada neste filme de 420 nm de espessura, considerando que também experimentou um curto recozimento térmico ao crescer a camada superior de n-GaAs. Conseqüentemente, a célula unitária GaAsBi média será superestimada no cenário totalmente relaxado e explica o \ (\ Delta {E} _p ^ {GaAsBi} \) maior obtido acima. No outro limite, a rede bismida é considerada totalmente esticada com a constante de rede no plano igual à de GaAs ( a =5,653 Å). A constante de rede fora do plano necessária para recuperar a mudança de energia de - 0,080 eV é então encontrada a z =5,709 Å. Este é um sensato a z valor e pode ser comparado com as medições de XRD-RSM de GaAsBi comprimida para substrato de GaAs [1, 34, 59]. Devido ao relaxamento, espera-se que as constantes de rede reais estejam entre esses dois casos limites. Isso demonstra um método de caracterização promissor que pode fornecer informações sobre a cepa de rede complementar às técnicas baseadas em raios-X em ligas metaestáveis.

Imagem HAADF transversal (esquerda) da amostra p-i-n S1, com camadas marcadas de GaAs e GaAsBi. Regiões mais escuras dentro de GaAsBi são domínios separados por fase. O perfil da linha (à direita) mostra a mudança de energia de pico do plasmon em massa de EELS, E GaAsBi - E GaAs , em relação à camada de buffer GaAs. O perfil é alinhado de perto com a imagem HAADF adquirida simultaneamente à esquerda. Os pixels de dados do EELS são totalmente agrupados na direção horizontal e, portanto, indicam valores médios espaciais. A barra de escala é de 100 nm e também se aplica ao eixo vertical do perfil EELS
A segunda amostra de GaAsBi, S2, foi cultivada sobre uma camada de buffer de GaAs que foi depositada em um substrato Ge offcut (consulte Métodos). A heteroepitaxia Ge-GaAsBi foi analisada em nosso trabalho anterior, que também demonstrou CuPt B de uma única variante de domínio grande ordenação em GaAsBi [34]. Dados adicionais são apresentados neste trabalho e são usados para completar a discussão sobre o ordenamento atômico Bi. A concentração total de bismuto nesta amostra é ~ 5,8% conforme medido por PL (SI Fig. S1) [34]. O corte combinado com a camada tampão GaAs empregada nesta epitaxia ajuda a evitar a formação de domínios anti-fase em GaAsBi, que ainda são difíceis de eliminar quando crescem diretamente em Ge apolares [60,61,62]. A Figura 4a mostra a área da interface GaAs-GaAsBi com a camada GaAsBi visivelmente mais brilhante na imagem HAADF. Ao contrário do filme GaAsBi anterior depositado em um substrato GaAs plano, aqui, um único CuPt B A subvariante de ordenação é selecionada devido ao corte. Isso pode ser visto na imagem HAADF e sua transformação de Fourier inserida no canto superior direito mostrando um par de 1/2 [\ (\ overline {1} \) 11] * pontos de superrede. A Figura 4b foi formada pela aplicação de uma máscara ao par de reflexos da superrede, análoga à Fig. 1c, d. Mostra uma ordenação muito mais uniforme e de grande domínio no filme. Imagens EDX atomicamente resolvidas foram adquiridas desta amostra para estimar o parâmetro de ordem η com base na análise composicional. O mapeamento químico de EDX muitas vezes se destaca sobre a quantificação EELS de perda de núcleo alternativa, que tende a ter uma relação sinal-ruído pior ao quantificar bordas de ionização atrasadas e de alta energia [56, 63,64,65]. A direção da varredura STEM foi alterada para alinhar os planos ordenados (\ (\ overline {1} \) 11) horizontalmente. A Figura 4c-e mostra os mapas elementares de raios-X filtrados por Wiener. A ordem dos átomos Bi em cada segundo (\ (\ overline {1} \) 11) plano é clara e segue as posições atômicas. Para a quantificação composicional de EDX, dois conjuntos de dados com 512 × 512 pixels cada foram adquiridos de áreas diferentes da amostra usando condições experimentais idênticas. As sub-regiões foram alinhadas e os sinais brutos somados, resultando em um total de 10 quadros. Perfis de linha vertical de dados brutos somados horizontalmente de As-K e Bi-M são mostrados na Fig. 4f. Para quantificar a composição do bismuto nos planos Bi-ricos e Bi-deficientes (111), foi usada uma janela de integração de 3 Å de largura, centrada nos planos atômicos. Após a subtração do fundo e a média de todos os planos (111), isso mostra que as contagens de raios-X Bi são ~ 3 vezes maiores nos planos Bi-ricos. A concentração total de 5,8% Bi na amostra, conforme obtida por medições de PL e XRD-RSM, é então usada para dimensionar linearmente as contagens de raios-X Bi para a composição, o que mostra que Bi atinge até 9% nos planos Bi-ricos. O parâmetro do pedido pode, portanto, ser estimado (ver Introdução) como η =0,07. Observe que um bismídeo totalmente ordenado com esta concentração total de Bi teria o parâmetro de ordem η =0,116. Similarmente à análise HAADF, a quantificação de EDX de colunas individuais sofre de efeitos de canalização, uma vez que o potencial de ionização dos elétrons do núcleo é altamente localizado. Conforme mostrado por outros autores em Al x Ga 1-x Como liga, isso pode resultar em até ~ 5% do desvio padrão da contagem de raios-X devido a diferentes configurações de dopante [50]. Considerando o desvio, as contagens de raios-X ainda são encontradas em escala linear com uma série de dopantes em amostras não muito espessas. O erro de configuração no presente estudo é minimizado pela média efetiva de aproximadamente 11 colunas atômicas em cada plano (111), para um total de aproximadamente 130 colunas. Além disso, caudas de sonda de elétrons e espalhamento múltiplo podem produzir deslocamento de sinal em imagens EDX [52]. As simulações de imagem HAADF na seção anterior mostrando a variação dos valores de Ga SCS sugerem a magnitude esperada desses efeitos na quantificação de EDX. O ruído do tiro parece atualmente ser o principal fator de limitação da precisão devido às contagens de raios-X Bi inerentemente baixas em tais ligas diluídas.

a Imagem HAADF de GaAsBi amostra S2 perto da interface com a camada de buffer GaAs, crescida em offcut (001) Ge. A transformada de Fourier no canto superior direito mostra um par de picos indicando a ordem no único conjunto de (\ (\ overline {1} \) 11) planos. b Uma imagem formada por ( a ) usando o par de superrede 1/2 [\ (\ overline {1} \) 11] * manchas de Bragg. c - e Wiener filtrou imagens EDX da amostra GaAsBi, com emissões de raios-X Bi-M, As-K e Ga-K conforme indicado. Observe que nos dados EDX, as direções cristalográficas são giradas para alinhar os planos ordenados (\ (\ overline {1} \) 11) horizontalmente. f Perfil de contagens de raios-X vertical somados horizontalmente do sinal bruto As-K e Bi-M. Dois conjuntos de dados alinhados são combinados para obter o perfil
A amostra final de GaAsBi, S3, que desejamos explorar aqui foi sintetizada sob condições para criar as chamadas modulações de composição vertical (VCM) (ver Métodos) [66]. In contrast to samples S1 and S2, the VCM is achieved in S3 by utilizing a slower substrate rotation rate (RPM), which is coupled to intrinsically inhomogeneous elemental flux profiles reaching the substrate in a typical MBE chamber. The III/V elemental ratio within a sample region can be oscillated by controlling the RPM and the film growth rate to obtain the desired VCM period. A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens et al. [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

a HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. b A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. c Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
Conclusões
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB -type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordering. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
Métodos
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 cm −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 Torr. The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
Disponibilidade de dados e materiais
Os conjuntos de dados usados e / ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente, mediante solicitação razoável.
Abreviações
- BEP:
-
Beam equivalent pressure ratio
- EELS:
-
Electron energy-loss spectroscopy
- FFT:
-
Transformação rápida de Fourier
- HAADF:
-
Campo escuro anular de alto ângulo
- MBE:
-
Epitaxia de feixe molecular
- PL:
-
Fotoluminescência
- STEM:
-
Microscopia eletrônica de transmissão de varredura
- SCS:
-
Scattering cross-section
- VCM:
-
Vertical composition modulations
- EDX:
-
X-ray energy dispersive spectroscopy
Nanomateriais
- Aplicação do metal molibdênio e suas ligas
- 4 Usos de háfnio | As aplicações das ligas de háfnio
- Aplicações de molibdênio e ligas de molibdênio
- Propriedades e aplicações das ligas de cobre-níquel
- Um guia para cobre confiável e suas ligas
- Tipos e características:ligas de alumínio e bronze
- Compreendendo as ligas metálicas e a resistência ao escoamento
- 5 ligas metálicas industriais importantes e seus usos
- Tratamento térmico de alumínio e ligas de alumínio
- Tratamento térmico de cobre e ligas de cobre



