Transistores de efeito de campo ferroelétricos ZrO2 ativados pelos dipolos de vacância de oxigênio comutáveis
Resumo
Este artigo investiga os impactos do recozimento térmico pós-rápido (RTA) e a espessura do ZrO 2 na polarização P e características elétricas de TaN / ZrO 2 / Ge capacitores e FeFETs, respectivamente. Após o RTA variando de 350 a 500 ° C, TaN / ZrO 2 Capacitores / Ge com ZrO amorfo de 2,5 e 4 nm de espessura 2 filme exibir o estábulo P . Propõe-se que o comportamento ferroelétrico origina-se da migração dos dipolos voltados para a formação de vacâncias de oxigênio e cargas negativas. FeFETs com 2,5 nm, 4 nm e 9 nm ZrO 2 demonstrar a janela de memória decente (MW) com pulsos de programa / exclusão de 100 ns. Um ZrO 2 de 4 nm de espessura FeFET melhorou significativamente as características de fadiga e retenção em comparação com dispositivos com ZrO de 2,5 nm e 9 nm 2 . O desempenho de retenção do ZrO 2 O FeFET pode ser melhorado com o aumento da temperatura do RTA. Um MW de ~ 0,46 V é extrapolado para ser mantido ao longo de 10 anos para o dispositivo com ZrO de 4 nm 2 .
Histórico
Poli-HfO dopado 2 Os transistores de efeito de campo ferroelétrico (FeFETs) têm atraído considerável interesse nas aplicações de memória não volátil (NVM) devido à compatibilidade do processo CMOS [1]. Embora o desempenho elétrico decente tenha sido demonstrado em HfO dopado 2 à base de FeFETs [2], algumas limitações fundamentais ainda afetam suas aplicações práticas, incluindo o alto orçamento térmico de recozimento de 500 ° C necessário para formar fases de cristal ortorrômbico e a corrente de fuga indesejada ao longo dos limites de grão com a redução da espessura ferroelétrica. Ferroeletricidade foi amplamente observada em uma variedade de materiais diferentes, por exemplo, Sb 2 S 3 nanofios [3], GaFeO 3 filme [4], LaAlO 3 -SrTiO 3 filme [5] e amorfo Al 2 O 3 contendo nanocristais [6, 7]. Recentemente, relatamos os FeFETs com ZrO parcialmente cristalizado 2 isolador de porta funcionando como NVM e sinapse analógica [8]. Embora o ZrO 2 transistores exibiram desempenho elétrico decente com a espessura mais fina em comparação com o HfO dopado relatado 2 , o mecanismo subjacente para a ferroeletricidade em ZrO 2 filme permanece obscuro. É crítico e importante elucidar a origem da polarização comutável P para avaliar o limite de desempenho de ZrO 2 FeFETs.
Neste trabalho, TaN / ZrO 2 / Ge FeFETs com isoladores de 2,5 nm, 4 nm e 9 nm de espessura são fabricados. O comutável P em TaN / ZrO 2 / O capacitor Ge é proposto para originar a partir da migração de vacâncias de oxigênio acionadas por voltagem e cargas negativas. Os impactos do ZrO 2 espessura e o recozimento térmico pós-rápido (RTA) no P de TaN / ZrO 2 / Ge e a janela de memória (MW), resistência e características de retenção de FeFETs são investigadas.
Métodos
FeFETs com ZrO 2 isoladores de porta foram fabricados em 4 pol. substrato n-Ge (001) usando um processo semelhante em [8, 9]. Após a limpeza do pré-portão na solução diluída de HF (1:50), bolachas de Ge foram carregadas em uma câmara de deposição de camada atômica (ALD). ZrO 2 filmes com espessuras de 2,5 nm, 4 nm e 9 nm foram depositados a 250 ° C usando TDMAZr e H 2 O como precursores de Zr e O, respectivamente. Um eletrodo de porta TaN de 100 nm de espessura foi depositado por pulverização catódica reativa. Após a formação do eletrodo de porta, as regiões de fonte / dreno (S / D) foram implantadas por BF 2 + na dose de 1 × 10 15 cm −2 e uma energia de 20 keV. Um total de contatos S / D de níquel (Ni) de 15 nm foram formados por um processo de decolagem. Finalmente, o RTA a 350, 450 e 500 ° C por 30 s foi realizado.
A Figura 1a mostra o esquema do transistor fabricado. A Figura 1b-d mostra as imagens do microscópio eletrônico de transmissão (TEM) do TaN / ZrO 2 Amostras / Ge com ZrO de 2,5, 4 e 9 nm de espessura 2 , respectivamente. Todas as amostras foram submetidas a RTA a 500 ° C por 30 s. O ZrO de 2,5 nm 2 a amostra permanece uma película isolante após o recozimento. Para a amostra de 4 nm, embora alguns nanocristais sejam observados, ZrO 2 continua a ser uma camada amorfa. Enquanto a cristalização completa ocorre para o ZrO de 9 nm 2 filme. Notavelmente, uma camada interfacial (IL) de GeO x existe entre o ZrO 2 e região do canal Ge, embora seja muito fina para ser observada nas imagens TEM.
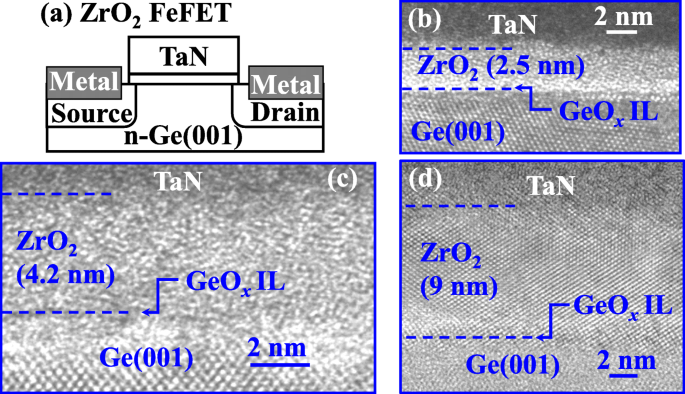
a Esquema do TaN / ZrO fabricado 2 / Ge FeFET. b , c , e d Imagens HRTEM do TaN / ZrO 2 / Ge stacks com diferentes ZrO 2 espessuras. As amostras foram submetidas a um RTA a 500 ° C por 30 s
Resultados e discussão
A Figura 2 mostra o P vs. tensão ( V ) curvas para o TaN / ZrO 2 / Ge capacitores com diferentes ZrO 2 espessuras e diferentes temperaturas de recozimento. As linhas sólidas com cores diferentes representam os loops menores com várias faixas de voltagem de varredura ( V intervalo ) A frequência de medição é 1 kHz. O ZrO de 2,5 nm e 4 nm 2 os dispositivos podem exibir ferroeletricidade estável após um RTA a 350 ° C. A Figura 3 representa o remanescente P ( P r ) em função da varredura V curvas de alcance para os capacitores recozidos em várias temperaturas.

Medido P vs. V características do TaN / ZrO 2 / Ge capacitores com diferentes ZrO 2 espessuras e várias temperaturas de recozimento
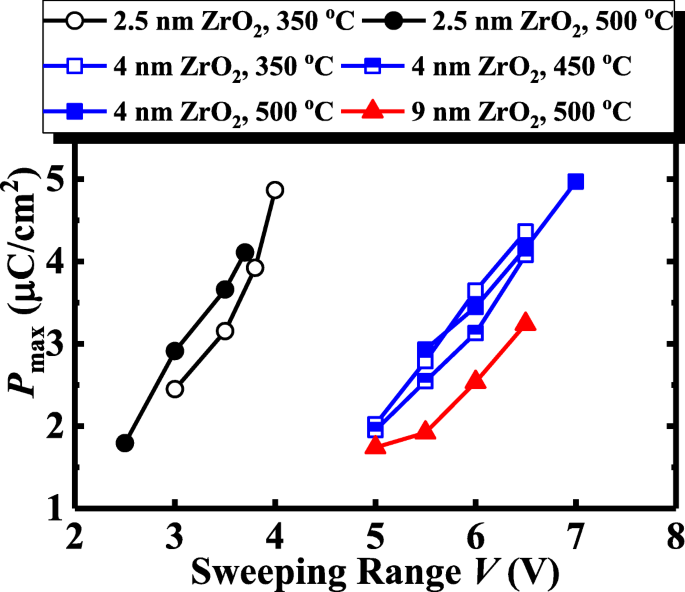
Comparação de P máximo em função de V intervalo para o TaN / ZrO 2 / Ge capacitores com diferentes ZrO 2 espessuras e várias temperaturas de recozimento
A Figura 3 mostra a comparação de P máximo em função de V intervalo para o TaN / ZrO 2 / Ge capacitores com os diferentes ZrO 2 espessuras e as várias temperaturas RTA. Para o ZrO de 4 nm 2 dispositivos, como a temperatura de recozimento aumenta de 350 para 450 ° C, um maior V intervalo é necessário para obter um P fixo máximo . Isso é atribuído ao fato de que a temperatura de recozimento mais alta produz as camadas interfaciais mais espessas (ILs) entre Ge / ZrO 2 e ZrO 2 / Interfaces TaN, levando a uma maior espessura equivalente de capacitância unificada (CET). Para o ZrO de 2,5 nm 2 capacitores, a amostra com recozimento de 500 ° C tem um V inferior intervalo do que a amostra de recozimento a 350 ° C com o mesmo P máximo . Embora os ILs fiquem mais espessos com o aumento da temperatura do RTA, alguns ZrO 2 foi consumido pela eliminação de oxigênio e interdifusão na interface. Para o ZrO muito fino 2 dispositivo, o último é dominante. Comparado com o ZrO de 2,5 nm 2 capacitor, um V muito maior intervalo é necessário para obter um P semelhante máximo . No entanto, o ZrO de 9 nm 2 capacitor não exibe o V mais alto intervalo em comparação com o dispositivo de 4 nm. Isso se deve ao cristal ZrO 2 que tem um κ muito maior valor do que o filme amorfo, o que reduz significativamente o CET do dispositivo de 9 nm.
A Figura 4a mostra a evolução extraída do positivo e negativo P r , denotado por \ ({P} _ {\ mathrm {r}} ^ {+} \) e \ ({P} _ {\ mathrm {r}} ^ {-} \), respectivamente, para os 4 nm- espessura ZrO 2 capacitores com RTA em diferentes temperaturas acima de 10 6 ciclos de varredura medidos a 1 kHz. Os dispositivos recozidos a 350 ° C e 450 ° C exibem o efeito de despertar óbvio. Nenhum despertar ou impressão é observado para o ZrO de 4 nm 2 o capacitor ferroelétrico foi submetido ao recozimento a 500 ° C. A Figura 4b compara o P r como uma função de ciclos de varredura para os dispositivos com os diferentes ZrO 2 espessuras. O ZrO de 4 nm 2 capacitor ferroelétrico atinge estabilidade melhorada de P r resistência comparada aos dispositivos de 2,5 nm e 9 nm durante o 10 6 Teste de resistência.

a P r vs. o número de ciclos de varredura de pulso ms para ZrO de 4 nm 2 capacitores com diferentes temperaturas RTA. b P r vs. número de ciclos de varredura de pulso ms para o ZrO 2 capacitores após recozimento a 500 ° C
A mudança P é observado em ZrO amorfo 2 capacitância, e infere-se que o mecanismo deve ser diferente daquele do poli-HfO dopado relatado 2 filmes ferroelétricos. Propomos que o mecanismo subjacente ao comportamento ferroelétrico está relacionado aos dipolos de vacância de oxigênio. É bem conhecido que, à medida que o metal TaN é depositado, as camadas sequestrantes de oxigênio Ta aumentam a concentração de vacância de oxigênio dentro do ZrO 2 [10]. Vagas de oxigênio também aparecem no ZrO 2 Interface / Ge. A Figura 5 mostra o esquema do comutável P em TaN / ZrO 2 / Ge originado da migração de vacâncias de oxigênio e cargas negativas para formar os dipolos positivos e negativos. Especula-se que as cargas negativas em ZrO 2 estão relacionados à vacância de Zr [11], que é semelhante àquelas em Al 2 O 3 filme [12]. A migração das vacâncias de oxigênio dirigidas por voltagem foi amplamente demonstrada em dispositivos resistivos de memória de acesso aleatório [13, 14]. Notavelmente, esta é a primeira demonstração de transistores não voláteis de três terminais dominados pelas vacâncias de oxigênio acionadas por voltagem.
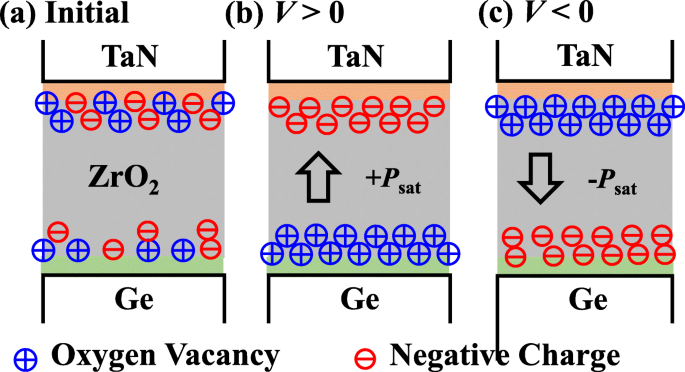
Esquema do mecanismo para P comutável em ZrO 2 capacitores, que é atribuído à migração de vacâncias de oxigênio acionadas por voltagem e cargas negativas para formar dipolos
O P-V histerese habilita o ZrO 2 FeFETs para obter um MW grande e estável para os aplicativos NVM incorporados (eNVM). A Figura 6 mostra o I medido DS - V GS curvas de 2,5, 4 e 9 nm ZrO 2 FeFETs para os dois estados de polarização com condições de programação / exclusão (P / E) de 1 μs. Os transistores foram recozidos a 500 ° C. A operação do programa (apagar) é alcançada pela aplicação de pulsos de tensão positivos (negativos) à porta do ZrO 2 FeFETs, para aumentar (diminuir) sua tensão limite ( V TH ) V TH é definido como V GS a 100 nA · W / L, e MW é definido como a mudança máxima em V TH . Todos os FeFETs com vários ZrO 2 espessuras têm MW acima de 1 V com pulsos de P / E de 1 μs. Para alcançar um MW semelhante, uma tensão de apagamento mais alta é necessária para o ZrO de 9 nm 2 FeFET em comparação com os outros dois transistores. É visto que uma magnitude maior apaga V GS é necessário para obter a mudança aproximadamente igual de I-V em relação à curva inicial em comparação com o programa V GS . Especula-se que as vagas de oxigênio contribuem para o P vêm principalmente da reação entre TaN e ZrO 2 , como o estado inicial do dispositivo na Fig. 5a. Como um V positivo GS (programa) é aplicado, as vacâncias de oxigênio se difundem e se acumulam na camada próxima ao ZrO 2 / Ge interface (Fig. 5b), onde a distribuição dos dipolos de vacância de oxigênio é bastante diferente do estado inicial. Portanto, é fácil mudar o I-V curva para um | V superior TH | com um V positivo GS . No entanto, como V negativo GS (apagar) é aplicado, a difusão posterior das vacâncias de oxigênio traz a pilha de portas de volta ao seu estado original (Fig. 5c). Portanto, a magnitude do negativo apaga V GS deve ser aumentado para atingir o deslocamento equivalente de I-V para o programa positivo V GS .
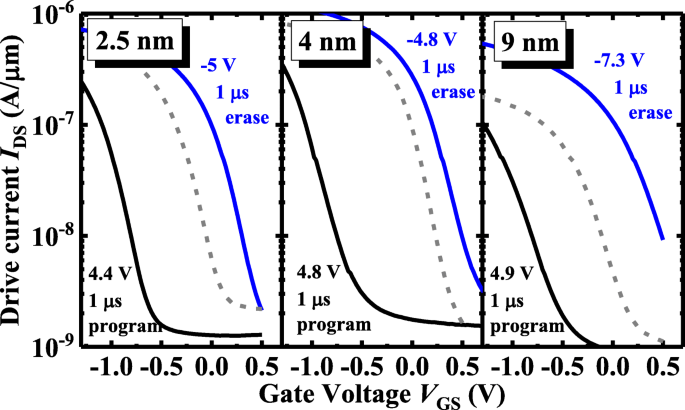
Medido I DS - V GS curvas do ZrO de 2,5, 4 e 9 nm de espessura 2 FeFETs para os estados de polarização inicial e dois com pulsos P / E de 1 μs
Como a largura do pulso P / E é reduzida para 100 ns, o ZrO 2 Os FeFETs ainda demonstram o MW decente, como mostrado na Fig. 7a. Especialmente, o transistor com 2,5 nm ZrO 2 recozido a 350 ° C atinge um MW de 0,28 V. A Figura 7b traça MW vs. número de ciclo para os FeFETs com vários ZrO 2 espessuras com condição de pulso P / E de 100 ns. O ZrO de 4 nm 2 dispositivo atinge um desempenho de resistência significativamente melhorado em comparação com 2,5 nm e 9 nm ZrO 2 FeFETs, que exibem o óbvio efeito de despertar e fadiga em até 10 3 ciclos.
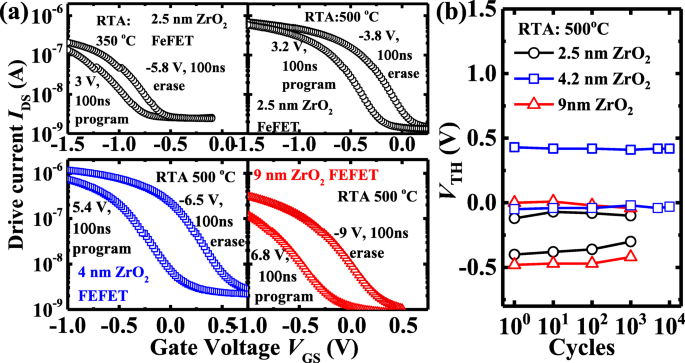
a eu DS - V GS curvas do ZrO de 2,5, 4 e 9 nm de espessura 2 FeFETs para os dois estados de polarização com pulsos P / E de 100 ns. Os dispositivos foram submetidos a um RTA a 500 ° C. b FeFET com 4 nm ZrO 2 tem uma resistência aprimorada em comparação com 2,5 e 9 nm ZrO 2 transistores
Finalmente, o teste de retenção do ZrO 2 FeFETs é caracterizado e mostrado nas Figs. 8 e 9. A Figura 8a mostra a evolução de I DS - V GS curvas para os dois estados de polarização do ZrO de 4 nm 2 FeFETs foram submetidos a RTA a 350, 450 e 500 ° C. O aprisionamento de carga leva à redução dos dispositivos com o tempo. Conforme mostrado na Fig. 8b, o desempenho de retenção dos dispositivos pode ser melhorado com o aumento da temperatura do RTA. Um MW de ~ 0,46 V é extrapolado para ser mantido ao longo de 10 anos. A Figura 9 compara as características de retenção dos FeFETs com diferentes ZrO 2 espessuras. O ZrO de 4 nm 2 dispositivo tem um desempenho de retenção aprimorado em comparação com os transistores com 2,5 e 9 nm de espessura ZrO 2 .
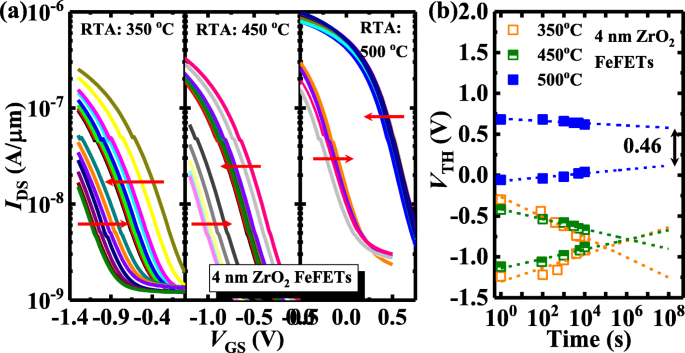
a A evolução do I DS - V GS curvas para os dois estados de polarização do ZrO de 4 nm 2 FeFETs com diferentes temperaturas RTA. b O ZrO de 4 nm 2 dispositivo recozido a 500 ° C tem um desempenho de retenção muito melhor em comparação com os transistores com RTA em temperaturas mais baixas
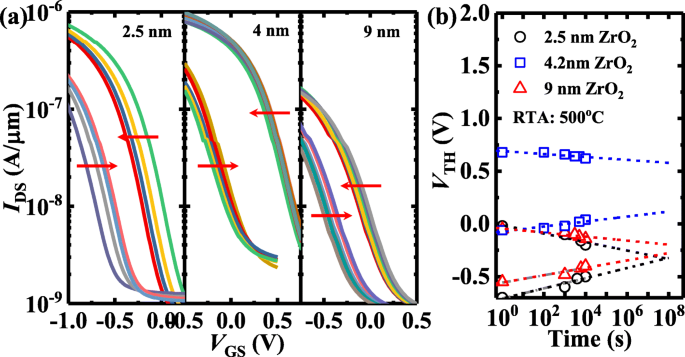
a A evolução do I DS - V GS curvas para os dois estados de polarização para o ZrO de 2,5, 4 e 9 nm de espessura 2 Os FeFETs foram submetidos a um RTA a 500 ° C. b O ZrO de 4 nm 2 dispositivo tem um desempenho de retenção aprimorado em comparação com os transistores com 2,5 e 9 nm de espessura ZrO 2
Conclusões
Em resumo, ZrO amorfo 2 capacitores ferroelétricos são demonstrados experimentalmente, e a ferroeletricidade é especulada como sendo devida à migração dos dipolos acionados por voltagem formados pelas vacâncias de oxigênio e cargas negativas. FeFETs com 2,5 nm, 4 nm e 9 nm ZrO 2 ter o MW acima de 1 V com pulsos P / E de 1 μs. As características aprimoradas de fadiga e retenção são obtidas no ZrO 2 de 4 nm de espessura FeFET em comparação com os dispositivos com 2,5 nm e 9 nm ZrO 2 . O teste de retenção indica que o ZrO de 4 nm 2 transistor mantém um MW extrapolado de 10 anos de ~ 0,46 V.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste artigo estão incluídos no artigo.
Abreviações
- RTA:
-
Recozimento térmico rápido
- IL:
-
Camada interfacial
- TaN:
-
Nitreto de tântalo
- FeFET:
-
Transistores de efeito de campo ferroelétricos
- TDMAZr:
-
Tetraquis (dimetilamido) zircônio
- Ge:
-
Germânio
- ZrO 2 :
-
Dióxido de zircônio
- ALD:
-
Deposição de camada atômica
- HF:
-
Acido hidrosulfurico
- BF 2 + :
-
Íon fluoreto de boro
- MW:
-
Janela de memória
- NVM:
-
Memória não volátil
- P r :
-
Polarização remanescente
- TEM:
-
Microscopia eletrônica de transmissão
- Ni:
-
Níquel
- P máximo :
-
Polarização máxima
- RTA:
-
Recuperação de recozimento térmico
- V intervalo :
-
Varredura de faixa de tensão
Nanomateriais
- DDS habilitado para web, The IoT e The Cloud
- Transistores, efeito de campo de junção (JFET)
- Transistores, efeito de campo de porta isolada (IGFET ou MOSFET)
- Transistores de efeito de campo de junção
- Transistores de efeito de campo de porta isolada (MOSFET)
- Introdução aos transistores de efeito de campo de junção (JFET)
- Introdução aos transistores de efeito de campo de porta isolada
- Ajustando a toxicidade de espécies reativas de oxigênio na terapia avançada de tumor
- Transistores de efeito de campo Nanoflake SnSe multicamadas com contatos óhmicos de baixa resistência
- Os benefícios da geração de oxigênio no local



