Variação na microestrutura e nas propriedades mecânicas de filmes de Ti-Al-N induzidas por fonte de íon RF-ICP com atmosfera reativa de plasma de nitrogênio aprimorada
Resumo
A aquisição das condições ótimas de crescimento dos filmes de Ti-Al-N, os efeitos da atmosfera gasosa, especialmente o plasma reativo nas microestruturas do material, e as propriedades mecânicas ainda são uma questão fundamental e importante. Neste estudo, os filmes de Ti-Al-N são reativamente depositados por um sistema de pulverização catódica aprimorado por fonte de íons de plasma indutivamente acoplado por rádio frequência (RF-ICPIS). Diferentes taxas de fluxo de gás nitrogênio na entrada da fonte de íons são adotadas para obter densidades de plasma de nitrogênio e alterar a atmosfera de deposição. Verificou-se que o conteúdo do elemento de nitrogênio nos filmes é bastante influenciado pela densidade do plasma de nitrogênio, e o valor máximo pode chegar a 67,8% em circunstâncias de alto fluxo de gás. Os espectros de XRD e as imagens FESEM indicam que a baixa densidade do plasma é benéfica para a cristalização do filme e a microestrutura densa. Além disso, as propriedades mecânicas como dureza e desempenho tribológico são mutuamente aprimoradas pelo ajuste da atmosfera de nitrogênio.
Introdução
Devido às propriedades mecânicas respeitáveis, como alta dureza, anticorrosão e resistência à oxidação superior, o Ti-Ai-N tem atraído muita atração no corte a seco e de alta velocidade como os filmes de proteção de superfície para máquinas-ferramenta [1,2,3]. Hoje em dia, variedades de técnicas têm sido desenvolvidas para a fabricação de filmes de Ti-Al-N, incluindo deposição química de vapor [4], evaporação por arco [5], revestimento iônico [6] e sputtering DC / RF reativo [7]. Durante o progresso da deposição do filme de Ti-Al-N, a atmosfera de gás é bastante importante e complexa [8,9,10,11,12]. Por exemplo, na deposição de pulverização catódica reativa, o plasma de nitrogênio em desequilíbrio não depende apenas da concentração de íons de nitrogênio ou argônio, mas também é afetado pela densidade de elétrons secundários ou pressão total de gás que agravam as dificuldades para entender a atmosfera de nitrogênio reativa induzida a variação nas propriedades do filme Ti-Al-N. Jeong et al. relataram a morfologia de crescimento de filmes de Ti-Al-N que foi influenciada pelas taxas de fluxo de nitrogênio [13]. Irudayaraj et al. descobriram que a taxa de deposição, o tamanho do grão e a razão de concentração de Ti para Al dos filmes de Ti-Al-N depositados diminuíram com o aumento de N 2 taxa de fluxo [14]. Devido à importância de adquirir conhecimentos valiosos para a seleção de condições ideais de crescimento, os efeitos da atmosfera de nitrogênio, especialmente a densidade do plasma reativo no conteúdo do elemento material e as microestruturas e propriedades mecânicas correspondentes do Ti-Al-N, ainda precisam ser explorados mais profundamente. .
Em nosso trabalho anterior, a fonte de íons de plasma indutivamente acoplada por radiofrequência (RF-ICPIS) foi verificada para aumentar a deposição de Ti-Al-N diminuindo a temperatura de ionização do gás argônio e aumentando as taxas de ionização [15]. Neste artigo, ionizamos diretamente o gás nitrogênio em uma cavidade RF-ICPIS descarregada, e um feixe de plasma denso de nitrogênio é introduzido diretamente na câmara reativa para participar da deposição reativa. Comparando com o tradicional sistema de pulverização catódica RF / DC, a densidade de plasma de nitrogênio fornecida pelo RF-ICPIS pode ser prontamente controlada alterando as potências de RF ou taxas de fluxo de gás. As influências da variação do plasma de nitrogênio no conteúdo do elemento, microestruturas, morfologias de superfície, bem como nas propriedades mecânicas dos filmes de Ti-Al-N, são estudadas e discutidas.
Método
Filme Deposição
Filmes de Ti-Al-N foram depositados em Si (100) e aço inoxidável polido em espelho por sistema de pulverização catódica de magnetron aprimorado por fonte de íons RF-ICP com temperatura de crescimento de 200 ° C. Os substratos foram colocados em um suporte de amostra rotativo (20 rpm) que era perpendicular a um Ti 0,5 Al 0,5 composto alvo com pureza de 99,9%. Após bombear a câmara de pulverização catódica para uma pressão de base inferior a 1,0 × 10 −4 Pa e limpeza da superfície alvo por íons de argônio, a camada tampão de Ti-Al foi então depositada nos substratos por pulverização catódica DC. Em seguida, o plasma de nitrogênio produzido a partir do RF-ICPIS foi introduzido próximo aos substratos para atender à deposição reativa do filme Ti-Al-N. A potência do RF-ICPIS foi controlada a 50 W, e as taxas de fluxo do gás nitrogênio na entrada da fonte de íons variaram de 5 a 25 sccm para alterar as densidades do plasma de nitrogênio e obter diferentes sputtering e atmosfera de deposição. Enquanto isso, a corrente de pulverização catódica DC foi fixada em 0,4 Å e a pressão total do gás da câmara de pulverização foi mantida em 0,5 Pa. Os parâmetros de crescimento detalhados estão listados na Tabela 1.
Caracterização
Os conteúdos dos elementos foram caracterizados por espectrômetro dispersivo de energia (EDS, Oxford X-Max 50), e as estruturas cristalinas dos filmes de Ti-Al-N foram reveladas por difração de raios-X (XRD, Bruker D8 Advance) com radiação Cu Kα ( λ =1,54056 Å). A morfologia da superfície e a microestrutura transversal dos filmes foram medidas por microscopia eletrônica de varredura por emissão de campo (FESEM, ZEISS Ultra 55). A microscopia de força atômica (AFM, Asylum Research) foi aplicada para medir o quadrado médio da raiz da superfície (RMS). A ponta de diamante piramidal foi adotada para o teste de nanoindentação, e a dureza foi medida pelo MTS Nano Indenter XP e calculada pelo método de indentação Oliver-Pharr. Cada amostra, dez medições de pontos separados, foram tomadas para obter um valor médio de dureza. Um aparelho de desgaste bola no disco convencional com uma velocidade de deslizamento de 0,2 m / s sob uma carga de 10 N foi usado para medir o coeficiente de atrito.
Resultados e discussão
A Figura 1 mostra os conteúdos dos elementos Ti, Al e N em filmes de Ti-Al-N depositados em diferentes taxas de fluxo de gás nitrogênio. Os teores de N em filmes de Ti-Al-N são monotonicamente melhorados com o aumento dos fluxos de gás nitrogênio admitidos na fonte de íons. Dentro da região de baixo fluxo de gás de nitrogênio (5–15 sccm), os conteúdos de N são mantidos em 45–50% e as relações (Ti + Al) / N são semelhantes à construção (Ti, Al) N. Quando melhoram ainda mais as taxas de fluxo de gás nitrogênio de 15 para 25 sccm, os conteúdos de N nos filmes de Ti-Al-N são aumentados rapidamente. O valor máximo de 67,8% é obtido em 25 sccm, que está além de 50% no comum (Ti, Al) N ou Ti x Al 1-x N microestrutura, que indica que as transições de fase ocorrem em S4 e S5. Teores de Ti e Al em filmes de Ti-Al-N exibem tendência oposta ao elemento N em função das taxas de fluxo de gás nitrogênio. Para todos os filmes, os conteúdos de Al são maiores do que os de Ti, o que é semelhante aos resultados dos filmes de Ti-Al-N depositados sob uma atmosfera de plasma aprimorada. A diferença de conteúdo entre os elementos de Al e Ti pode ser atribuída à diferença de rendimento de pulverização catódica entre o átomo de Al com qualidade de luz e o átomo de Ti. Além disso, os átomos de Al estão escapando facilmente para as regiões da superfície dos filmes, o que também pode fazer com que os teores de Al detectados sejam ligeiramente maiores do que os valores reais no interior dos filmes [16].

Conteúdo do elemento de filmes de Ti-Al-N fabricados em várias taxas de fluxo de gás nitrogênio
O XRD é realizado para as amostras depositadas em bolachas de Si (100). Conforme mostrado na Fig. 2, S1-S5 exibem a estrutura cúbica centrada na face tipo NaCl típica (fcc) com múltiplos planos de difração orientados em (111), (200), (220) e (311), exceto para (311) ) para amostras S4 e S5 depositadas em altas taxas de fluxo de gás [17]. Para a estrutura f.c.c Ti-Al-N, (111) é o plano densamente compactado com uma energia de superfície mais baixa, enquanto (200) e (220) seguiram. Em S1-S5, todos os Ti-Al-N depositados exibem a orientação preferencial (220) em vez de (111). Em nosso estudo anterior, descobrimos que as taxas de deposição de filme foram melhoradas no sistema de pulverização catódica aprimorado por RF-ICPIS. Isso leva à diminuição do tempo de migração de adátomos em substratos e favorece o crescimento de (220) planos de cristais com energia de superfície mais alta, às custas de outros por causa de sua densidade de borda mais alta e, em seguida, distância de difusão mais curta para os locais de energia mais baixa relativa [13 ] Além disso, a distorção de rede induzida por átomos de Al incorporando-se com uma alta concentração também contribui para o crescimento preferencial (220) ao invés de (111) [18]. As intensidades e FWHM de (220) picos também revelam a dependência da cristalização nas taxas de fluxo do gás nitrogênio. Na faixa de baixo fluxo de gás (5–15 sccm), a intensidade e FWHM são melhorados quando aumenta a taxa de fluxo de nitrogênio, o que indica os tamanhos de grãos cristalinos de Ti-Al-N em filmes que são diminuídos e qualidades de cristalização de filmes que são aprimoradas [ 19]. Para S4 e S5, as intensidades de pico reduzidas e FWHM ampliado que podem verificar altas taxas de fluxo de gás (20–25 sccm) são adversas às qualidades dos filmes de Ti-Al-N.
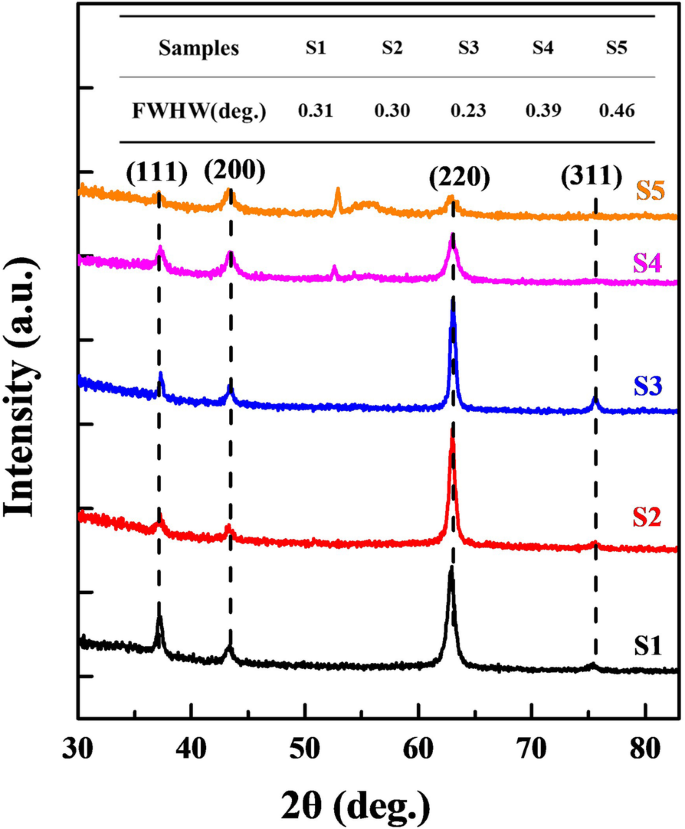
Espectros de XRD de amostras S1 – S5. A tabela de inserção é o valor FWHW de (220) para S1 – S5
A qualidade do cristal de Ti-Al-N degenerado em altas taxas de fluxo de gás de nitrogênio é o resultado da variação do plasma de nitrogênio originado do RF-ICPIS. Mais átomos de nitrogênio podem ser ionizados quando aumentam as taxas de fluxo de nitrogênio na fonte de íons, e as densidades de plasma correspondentes na câmara de pulverização também são aumentadas. As concentrações de elétrons perto dos substratos são medidas pela sonda Langmuir. Os resultados calculados mostram que as concentrações médias de elétrons variam de 1,5 × 10 16 para 2,7 × 10 16 cm −3 com as taxas de fluxo de gás nitrogênio aumentando de 5 para 25 sccm. As concentrações aprimoradas de elétrons indicam que as densidades do plasma são aprimoradas durante o progresso da deposição. Além disso, as tensões da fonte de pulverização catódica com uma corrente de pulverização catódica fixa de 0,4 A durante a deposição são 482, 461, 443, 408 e 376 V para 5, 10, 15, 20 e 25 sccm, respectivamente. A diminuição da impedância entre os substratos e o alvo também reflete a intensificação da atmosfera de plasma. A alta densidade do plasma melhora as colisões entre os átomos que levaram ao caminho livre médio dos átomos de metal pulverizados e as taxas de deposição do filme diminuem. Em seguida, os átomos adsorvidos nos substratos têm mais tempo para migrar e nuclear e contribuir para as cristalizações do filme. Quando as taxas de fluxo de nitrogênio excedem um certo limite, embora as densidades do plasma sejam melhoradas, mais átomos de nitrogênio não seriam totalmente ionizados sob uma fonte de íons fixa de energia de 50 W [20]. Em comparação com átomos de nitrogênio totalmente ionizados, esses átomos não totalmente ionizados estão mais próximos do substrato e participariam diretamente do crescimento da nucleação dos filmes. Como resultado, o conteúdo de nitrogênio nos filmes de Ti-Al-N está muito além da razão estequiométrica.
A Figura 3 mostra as micro-morfologias planas e em corte transversal de filmes de Ti-Al-N observados por FESEM. As morfologias da superfície Ti – Al – N são exibidas como os grãos de cone tripartidos típicos [21]. Comparando com a Fig. 3a, b, podemos encontrar que o filme depositado em densidade de plasma de nitrogênio (S3) tem tamanhos de grão menores e superfícies mais densas do que S5 depositado em densidade de plasma de alta, o que também está de acordo com os resultados de XRD. Em atmosfera de baixa densidade de plasma, átomos de nitrogênio totalmente ionizados e tempo de migração suficiente de adátomos promovem o crescimento e a cristalização de Ti-Al-N e contribuem para a superfície mais densa. As microestruturas da amostra comparativa CS3, que é depositada através do método tradicional de ionização do gás argônio e tem o mesmo parâmetro experimental do S3, também são estudadas (ver material complementar). Comparando com S3, CS3 mostra uma superfície plana mais solta e áspera, e muitos vazios aparecem entre os limites dos grãos. Enquanto isso, o CS3 tem a espessura de filme menor do que o S3. As razões são atribuídas principalmente às diferenças de atmosfera de deposição entre esses dois métodos de ionização de gás. Ao ionizar diretamente o gás nitrogênio no RF-ICPIS, a temperatura de ionização do gás pode ser reduzida de forma eficiente e o plasma de nitrogênio de alta densidade pode ser obtido. Consequentemente, os adátomos em substratos teriam alta energia de migração e seriam benéficos para o crescimento e cristalização de filmes de Ti-Al-N. Nas imagens transversais do FESEM, as estruturas colunares são claramente observadas para filmes de Ti-Al-N depositados a 15 e 25 sccm, e os filmes revelam a espessura de 1,002 e 1,561 μm, respectivamente. Em circunstâncias de alta densidade de plasma, a taxa de deposição do filme é aumentada em 50%. Os resultados são diferentes da taxa de deposição baixa induzida por espalhamento aprimorado de átomos e surgem principalmente do rápido crescimento de nitreto fracamente ligado associado a esses átomos de nitrogênio não totalmente ionizados. Enquanto isso, as estruturas colunares de S3 exibem nanoestruturas granuladas e mais densas, e a amostra S5 revela as estruturas colunares com vazios e limites em todo o filme. É ainda evidente que a alta densidade do plasma de nitrogênio é adversa às qualidades de cristalização dos filmes de Ti-Al-N.
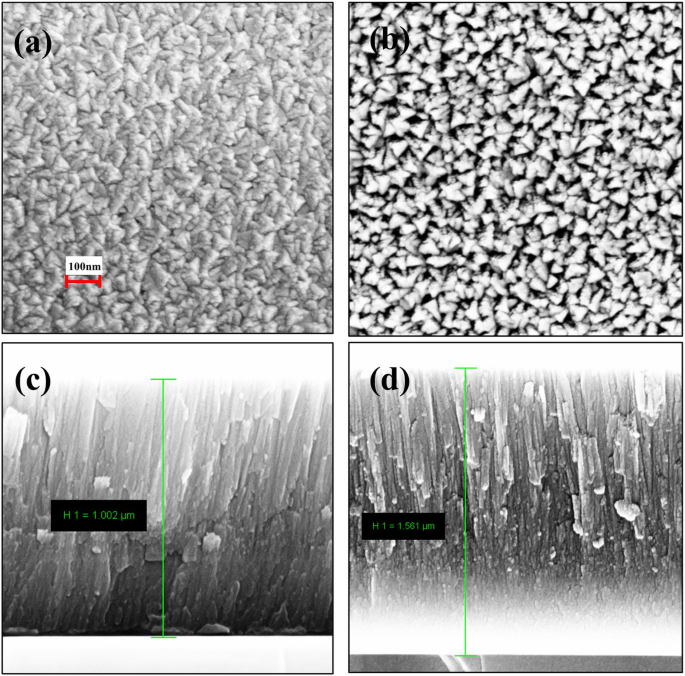
Imagens planas e transversais FESEM de S3 ( a , c ; 15 sccm) e S5 ( b , d ; 25 sccm)
Além disso, a rugosidade de filmes de Ti-Al-N depositados em várias taxas de fluxo de gás nitrogênio é estudada por AFM, e os valores de rugosidade quadrática média (RMS) são plotados na Fig. 4. A rugosidade é primeiramente reduzida e, em seguida, aumentada com o aumento das taxas de fluxo do gás nitrogênio, e o valor mínimo de 3,932 nm é obtido em 15 sccm. Enquanto isso, como mostrado na Fig. 4c, podemos encontrar a superfície do filme da amostra S5 que está preenchida com partículas inchadas e a ravina entre as partículas que são bastante profundas. As superfícies mais ásperas de S5 podem ser atribuídas às más qualidades do cristal e às superfícies esparsas. Na estrutura cristalina de Ti – Al – N, a razão Al / Ti também é um fator importante para que os átomos de Al ocupem sítios de rede de átomos de Ti e introduz defeitos de rede para influenciar a microestrutura e as propriedades mecânicas [18, 22]. As relações Al / Ti calculadas com base em testes de EDS são 1,66, 1,54, 1,43, 1,60 e 1,85 para S1 – S5, respectivamente. A excelente qualidade do cristal e a baixa razão Al / Ti contribuem para a superfície mais lisa da amostra de Ti-Al-N depositada a 1 sccm. Altas razões Al / Ti agravam os defeitos da estrutura de distorção da rede nos filmes S5 e exacerbam a rugosidade da superfície.

a Valores de rugosidade RMS de filmes de Ti – Al – N em função das taxas de fluxo de gás nitrogênio. A tabela de inserção é os valores das relações Al / Ti; b e c são as imagens AFM das amostras S3 e S5, respectivamente
A dureza dos filmes de Ti-Al-N depositados em substratos de aço inoxidável sob diferentes taxas de fluxo de gás nitrogênio são mostrados na Fig. 5. A dureza dos filmes de Ti-Al-N obtidos a 5, 10, 15, 20 e 25 sccm são 33,1, 33,3, 34,6, 29,1 e 26,4 GPa, respectivamente. Na faixa de baixo fluxo de nitrogênio, a dureza dos filmes de Ti-Al-N é bastante maior do que o material tradicional de Ti-N. A dureza aprimorada do Ti-Al-N é originada principalmente da evolução da microestrutura através da introdução de conteúdos de Al, que os átomos de Al ocupando sítios da rede parcial dos átomos de Ti causam a derrota da rede e aumentam o estresse interno dos filmes. Além disso, as razões Al / Ti das amostras S1-S5 são maiores do que os materiais Ti-Al-N fabricados no sistema de pulverização catódica convencional, uma vez que a técnica RF-ICPIS pode diminuir a temperatura de ionização do gás e aumentar a taxa de ionização durante a pulverização catódica de reação, também converter o rendimento de pulverização catódica de partículas de metal [23]. Altas razões Al / Ti que induzem a distorção da rede também causam a resistência ao movimento de deslocamento e o difícil movimento de deslizamento, o que pode contribuir conjuntamente para o excelente desempenho de dureza de filmes de Ti-Al-N depositados em baixas taxas de fluxo de nitrogênio. Enquanto isso, a cristalização otimizada e tamanhos de grão diminuídos promovem ainda mais a dureza para o máximo de 34,6 GPa a 15 sccm.

Dureza de filmes de Ti-Al-N depositados em diferentes taxas de fluxo de gás nitrogênio
As propriedades de atrito dos filmes de Ti-Al-N também são estudadas pelo aparelho de desgaste de bola no disco, e o coeficiente de atrito médio dos filmes de Ti-Al-N está representado na Fig. 6. A variação dos coeficientes de atrito dependendo do gás nitrogênio as taxas de fluxo são semelhantes com a rugosidade RMS. Obviamente, as superfícies lisas e as nanoestruturas de seção transversal densa de filmes de Ti-Al-N depositados em baixas taxas de fluxo de gás nitrogênio são benéficos para o desempenho tribológico da superfície. Enquanto isso, o S1 – S3 mostra menor coeficiente de atrito médio do que CS3 (consulte o material suplementar).

Coeficiente de atrito médio de filmes de Ti-Al-N depositados em diferentes taxas de fluxo de gás nitrogênio. As inserções são a curva do coeficiente de atrito de S3 e S5, respectivamente
Conclusão
Em resumo, a microestrutura e as propriedades mecânicas de filmes de Ti-Al-N depositados em diferentes atmosferas de plasma de nitrogênio são estudadas. Verificou-se que os conteúdos dos elementos nos filmes de Ti-Al-N são bastante influenciados pela densidade do plasma de nitrogênio. A baixa densidade de plasma é benéfica para as qualidades de cristalização do filme e microestrutura, que é suportada por espectros de XRD e FESEM. Além disso, a rugosidade da superfície e as propriedades mecânicas como dureza e coeficiente de atrito podem ser otimizadas ainda mais na faixa de densidade de plasma apropriada. Em alta densidade de plasma, o conteúdo excessivo de nitrogênio nos filmes pode induzir a fase de nitreto metaestável e ser responsável pela microestrutura solta e desempenho mecânico agravado. Nossos resultados seriam uma maneira eficiente de entender melhor o mecanismo de crescimento relacionado à atmosfera de deposição de filmes de Ti-Al-N.
Disponibilidade de dados e materiais
Todos os dados estão totalmente disponíveis sem restrição.
Abreviações
- RF-ICPIS:
-
Fonte de íons de plasma indutivamente acoplada por radiofrequência
- DC:
-
Corrente direta
- EDS:
-
Espectrômetro dispersivo de energia
- XRD:
-
Difração de raios X
- FESEM:
-
Microscopia eletrônica de varredura por emissão de campo
- AFM:
-
Força atômica microscópica
- FWHM:
-
Largura total pela metade no máximo
- RMS:
-
Raiz quadrada média
Nanomateriais
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- Influência da Água na Estrutura e Propriedades Dielétricas da Microcristalina e Nano-Celulose
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Efeito sinérgico do grafeno e MWCNTs na microestrutura e propriedades mecânicas de nanocompósitos Cu / Ti3SiC2 / C
- Síntese fácil de óxido de estanho mesoporoso semelhante a buraco de minhoca via auto-montagem induzida por evaporação e propriedades aprimoradas de detecção de gás
- Estudo da Força de Adesão e Transição de Vidro de Filmes de Poliestireno Fino por Microscopia de Força Atômica
- Preparação e propriedades ópticas de filmes GeBi usando o método de epitaxia de feixe molecular
- Sondando as propriedades estruturais, eletrônicas e magnéticas dos aglomerados Ag n V (n =1–12)
- Morfologia, estrutura e propriedades ópticas de filmes semicondutores com Nanislands GeSiSn e camadas deformadas



