Transistor de efeito de campo de capacitância negativa ZrOx com comportamento de oscilação de sublimiar Sub-60
Resumo
Aqui relatamos o ZrO x FETs de capacitância negativa (NC) com 45,06 mV / década de oscilação de sublimiar (SS) abaixo de ± 1 V V GS alcance, que pode alcançar novas oportunidades em futuras aplicações NCFET escalonáveis de voltagem. O comportamento semelhante ao ferroelétrico do Ge / ZrO x Propõe-se que os capacitores / TaN sejam originados dos dipolos de vacância de oxigênio. O efeito NC do HfO amorfo 2 e ZrO x dispositivos de filmes podem ser comprovados pela queda repentina de vazamento de porta, o fenômeno da resistência diferencial negativa (NDR), o aprimoramento de I DS e oscilação de sublimiar sub-60. 5 nm ZrO x NCFETs baseados em atingir uma histerese horária de 0,24 V, inferior a 60 mV / década SS e 12% I Melhoria do DS em comparação com o dispositivo de controle sem ZrO x . O efeito NC suprimido de Al 2 O 3 / HfO 2 NCFET comparado com ZrO x O NCFET está relacionado à troca parcial de dipolos de vacância de oxigênio na varredura para frente devido a dipolos interfaciais negativos no Al 2 O 3 / HfO 2 interface.
Histórico
À medida que os dispositivos semicondutores de óxido de metal complementar (CMOS) diminuem constantemente, a técnica do circuito integrado (IC) entrou na era de “mais do que a era de Moore”. A força motriz da indústria e da tecnologia de CI passa a ser a redução do consumo de energia, ao invés da miniaturização dos transistores [1, 2]. No entanto, a tirania Boltzmann dos MOSFETs, mais de 60 mV / década SS restringiu a energia / eficiência energética [3]. Nos últimos anos, muitos dispositivos novos propostos têm a capacidade de atingir oscilação de limiar inferior a 60 mV / década, incluindo MOSFETs de ionização de impacto, FETs de túnel e NCFETs [4,5,6,7]. Devido à estrutura simples, o SS íngreme e a corrente de transmissão melhorada, os NCFETs com um filme ferroelétrico (FE) têm sido considerados uma alternativa atraente entre esses dispositivos emergentes [8,9,10]. Os experimentos relatados em NCFETs incluem principalmente PbZrTiO 3 (PZT), P (VDF-TrFE) e HfZrO x (HZO) [11,12,13,14,15,16,17]. No entanto, a alta temperatura de processo e a indesejada corrente de fuga de porta ao longo dos limites de grão de materiais ferroelétricos policristalinos restringiram seu desenvolvimento para os nós de tecnologia de ponta [18,19,20,21,22,23,24,25 , 26]. Recentemente, ferroeletricidade no amorfo Al 2 O 3 e ZrO x filmes habilitados pelos dipolos de vacância de oxigênio modulados por voltagem foram investigados [27,28,29]. Comparado com a contraparte cristalina, os filmes amorfos semelhantes a ferroelétricos têm vantagens significativas na redução da temperatura do processo e da corrente de fuga. Assim, existem pesquisas em massa sobre FeFETs com isolador de porta amorfa para a memória não volátil e aplicações de sinapses analógicas [27, 30,31,32,33,34]. No entanto, a investigação sistemática em um transistor ZrO x NCFET baseado em não foi realizado.
Neste trabalho, Ge NCFETs com 5 nm ZrO x camada dielétrica ferroelétrica e 5 nm de Al 2 O 3 / HfO 2 camada dielétrica ferroelétrica foram propostas, respectivamente. Observamos experimentalmente declive acentuado de sub-60 mV / década em ZrO x (5 nm) NCFET, que pode ser atribuído ao efeito NC de ZrO x camada ferroelétrica. E analisamos a polarização P em função da tensão aplicada V para o Ge / ZrO x / Capacitores TaN. O comportamento semelhante ao ferroelétrico do Ge / ZrO x / Os capacitores TaN são induzidos pelos dipolos de vacância de oxigênio induzidos por voltagem. Além disso, atribuímos o I melhorado DS e a queda repentina de eu G no Al 2 O 3 / HfO 2 NCFETs e ZrO x NCFETs para o efeito NC. Também observamos o fenômeno NDR no Al 2 O 3 / HfO 2 NCFETs e ZrO x NCFETs. Além disso, analisamos ainda o mecanismo físico do efeito de NC diminuído induzido por dipolos interfaciais no Al 2 O 3 / HfO 2 NCFET. O ZrO x NCFETs com declive acentuado abaixo de 60 mV / década, tensão de drenagem aprimorada e baixa tensão de operação serão adequados para o projeto de NCFETs com baixo consumo de energia na “era mais que Moore”.
Métodos
Principais etapas do processo para NCFETs com ZrO x e Al 2 O 3 / HfO 2 fabricação são mostradas na Fig. 1a. Diferentes isoladores dielétricos de porta, incluindo Al 2 O 3 / HfO amorfo 2 (5 nm) filmes e ZrO amorfo x (4,2 nm) os filmes foram cultivados em substratos n-Ge (001) por deposição de camada atômica (ALD) a 300 ° C. TMA, TDMAHf, TDMAZr e H 2 O vapor de O foi usado como precursor de Al, Hf, Zr e O, respectivamente. O tempo de pulso e o tempo de purga dos precursores de Hf e Zr são 1,6 se 8 s, respectivamente. O tempo de pulso e o tempo de purga dos precursores do Al são 0,2 se 8 s, respectivamente. Um eletrodo de porta superior TaN foi então depositado em HfO 2 ou ZrO x superfícies por pulverização catódica reativa. As regiões de origem / drenagem (S / D) foram definidas por padrões de litografia e corrosão seca. Depois disso, boro (B + ) e níquel (Ni) foi depositado nas regiões de fonte / dreno (S / D). Finalmente, o recozimento térmico rápido (RTA) a 350 ° C por 30 s em um 10 8 O nitrogênio Pa ambiente foi realizado. A Figura 1b, d mostra o esquema do Al 2 fabricado O 3 / HfO 2 NCFETs e ZrO x NCFETs. Imagem de microscópio eletrônico de transmissão de alta resolução (HRTEM) na Fig. 1c mostra o HfO amorfo 2 (5 nm) filme em Ge (001) com Al 2 O 3 camada interfacial. A imagem HRTEM na Fig. 1e mostra o ZrO amorfo x (4,2 nm) filme em Ge (001). A curva C – V de ZrO x NCFETs e os espectros de fotoelétrons de raios-X (XPS) de TaN / ZrO x (4,2 nm) / capacitores Ge foram medidos no arquivo adicional 1:Fig. S1.
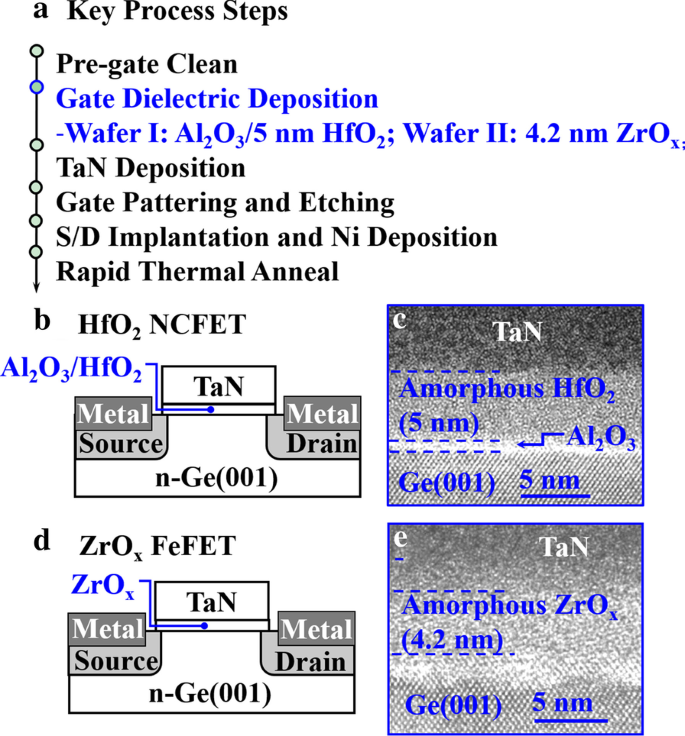
a Principais etapas do processo para a fabricação do Al 2 O 3 / 5 nm HfO 2 NCFETs e ZrO de 4,2 nm x NCFETs. b Esquemas e c Imagens HRTEM do ZrO fabricado x NCFETs. d Esquemas e e Imagens HRTEM do Al 2 fabricado O 3 / HfO 2 NCFETs
Resultados e discussão
A Figura 2a mostra as curvas medidas de polarização P v.s. tensão aplicada V características do Ge / ZrO x / Capacitores TaN a 3,3 kHz. O comprimento do portão ( L G ) dos capacitores são 8 μm. Observa-se que a polarização remanescente P r do Ge / ZrO x / Os capacitores TaN podem ser aprimorados com uma faixa de varredura maior de V . O comportamento semelhante ao ferroelétrico do ZrO amorfo x O filme da Fig. 2a é proposto como originado dos dipolos de vacância de oxigênio dirigidos por voltagem [35]. A Figura 2b mostra o P – V medido curvas para Ge / ZrO x / Capacitores TaN em diferentes frequências de 200 a 10 kHz. Podemos ver que o comportamento do tipo ferroelétrico do ZrO amorfo x o filme permanece estável para todas as frequências. No entanto, o P r do amorfo ZrO x o filme é reduzido com o aumento das frequências. Este fenômeno pode ser explicado pela troca de dipolos incompletos sob altas frequências de medição [36, 37]. Conforme as frequências de medição aumentam, o tempo para a mudança de direção do campo elétrico no ZrO amorfo x filme diminui. Assim, parte da troca de diploes de vacância de oxigênio está incompleta, proporcionando redução de P r .

Medido P versus V características do ZrO de 4,2 nm x capacitores com a diferentes alcances de varredura de V e b diferentes frequências de medição
A Figura 3a mostra o I medido DS - V GS curvas de um Al 2 ferroelétrico O 3 / HfO 2 NCFET na V DS de - 0,05 V e - 0,5 V. O L G dos dispositivos é de 3 μm. Os loops de histerese de 0,14 V ( V DS =- 0,05 V, I ds =1 nA / μm) e 0,08 V ( V DS =- 0,5 V, I ds =1 nA / μm) são demonstrados, respectivamente. Os loops de histerese no sentido horário são atribuídos à migração de vacâncias de oxigênio e cargas negativas acompanhadas. Os dipolos de vacância de oxigênio se acumulam (esgotam) no Ge / Al 2 O 3 interface sob positivo (negativo) V GS . Portanto, a tensão limite ( V TH ) aumenta (diminui) sob varredura direta (reversa) das tensões de porta. Conforme mostrado na Fig. 3b, as características de saída do Al 2 O 3 / HfO 2 O NCFET e o FET de controle são comparados. A corrente de saturação do Al 2 O 3 / HfO 2 NCFET excede 26 μA / μm, com um aumento de 23% em comparação com o FET de controle em | V GS - V TH | =| V DS | =0,8 V. O aumento de corrente é induzido pelo aumento da intensidade de carga de inversão ( Q inv ) no campo elétrico de polarização reversa e na amplificação do potencial de superfície [38, 39]. Além do aprimoramento atual, o NDR óbvio obtido prova o efeito NC do HfO amorfo 2 filme. O efeito NDR é causado pela comutação incompleta de dipolos de vacância de oxigênio devido ao acoplamento de dreno para canal como V DS aumenta [40, 41]. A Figura 3c compara o vazamento medido na porta I G - V GS curvas para 5 nm Al 2 O 3 / HfO 2 NCFET na V DS de - 0,05 V e - 0,5 V. As quedas repentinas de I G apenas durante a varredura reversa indica a voltagem diminuída no HfO amorfo 2 filme e a ampliação do potencial de superfície [42]. A ausência de efeito NC durante a varredura direta é causada pela troca de partículas de dipolos de vacância de oxigênio no HfO amorfo 2 filme [43]. A capacidade diferente de conter átomos de oxigênio entre Al 2 O 3 e HfO 2 camada leva à redistribuição de oxigênio e dipolos interfaciais negativos no Al 2 O 3 / HfO 2 interface [44, 45]. Devido à presença de dipolos interfaciais negativos, é difícil para o HfO amorfo 2 filme para realizar a comutação de polarização completa (efeito NC) na varredura para frente (arquivo adicional 1).
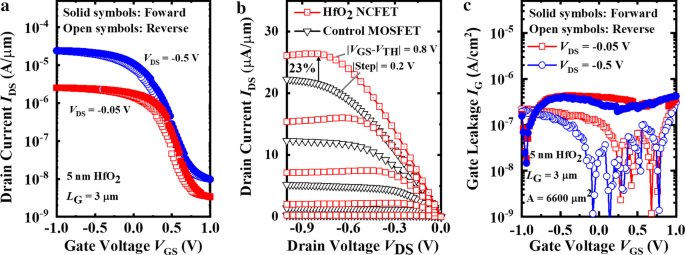
a Medido I DS - V GS curvas de 5 nm HfO 2 NCFET quando V DS =- 0,5 V e V DS =- 0,05 V. b Medido I DS - V DS curvas do HfO 2 NCFET e o MOSFET de controle. c Medido I G - V GS curvas de 5 nm HfO 2 NCFET quando V DS =- 0,5 V e V DS =- 0,05 V
A Figura 4a mostra as curvas de transferência medidas de um ZrO ferroelétrico x NCFET na V DS de - 0,05 V e - 0,5 V. O L G dos dois dispositivos são 4 μm. Os loops de histerese no sentido horário de 0,24 V ( V DS =- 0,05 V, I ds =1 nA / μm) e 0,14 V ( V DS =- 0,5 V, I DS =1 nA / μm) são demonstrados, respectivamente. Conforme mostrado na Fig. 4b, as características de saída do ZrO x O NCFET e o FET de controle são comparados. A corrente de saturação do ZrO x O NCFET excede 30 μA / μm, com um aumento de 12% em comparação com o FET de controle em | V GS - V TH | =| V DS | =1 V. O aprimoramento da corrente aprimorada e o NDR mais óbvio indicam o efeito NC aprimorado do ZrO amorfo x contraste do filme (5 nm) com o de 5 nm HfO 2 filme. A Figura 4c compara o vazamento de porta medido I G - V GS curvas para o ZrO de 5 nm x NCFET na V DS de - 0,05 V e - 0,5 V. Em comparação com o súbito I G gotas de Al 2 O 3 / HfO 2 NCFET apenas durante a varredura reversa na Fig. 3c, as quedas repentinas de I G tanto na varredura direta quanto na reversa na Fig. 4c também provam o efeito NC aprimorado no ZrO amorfo x filme.
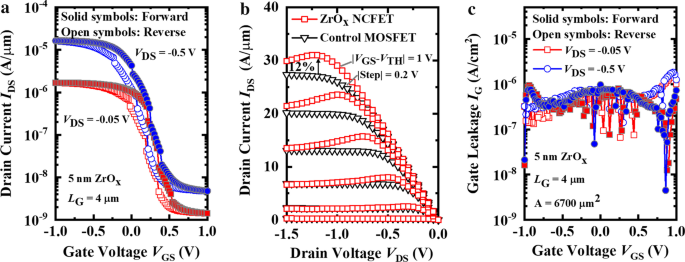
a Medido I DS - V GS curvas de 5 nm ZrO x NCFET quando V DS =- 0,5 V e V DS =- 0,05 V. b Medido I DS - V DS curvas do ZrO x NCFET e o MOSFET de controle demonstrando o fenômeno NDR óbvio. c Medido I G - V GS curvas de 5 nm ZrO x NCFET quando V DS =- 0,5 V e V DS =- 0,05 V
A Figura 5a, b mostra o ponto SS em função de I DS para o Al 2 O 3 / HfO 2 e ZrO x NCFET na V DS de - 0,05 V e - 0,5 V. Conforme mostrado na Fig. 5b, a oscilação do sublimiar (SS) abaixo de 60 mV / década pode ser alcançada durante a varredura para frente ou reversa de V GS no V DS de - 0,05 V e - 0,5 V. Quando V DS é - 0,05 V, um ponto à frente SS de 45,1 mV / dec e um ponto reverso SS de 55,2 mV / dec foram alcançados. Quando V DS é - 0,5 V, um ponto de SS à frente de 51,16 mV / dec e um ponto de SS reverso de 46,52 mV / dec foram alcançados. Devido à capacidade diferente de efeito de eliminação para o Al 2 O 3 / HfO 2 e ZrO x camada, a troca de dipolos particulados é causada no Al 2 O 3 / HfO 2 NCFET. Portanto, o efeito NC mais óbvio com SS sub-60 mV / década é alcançado em 5 nm ZrO x NCFET.
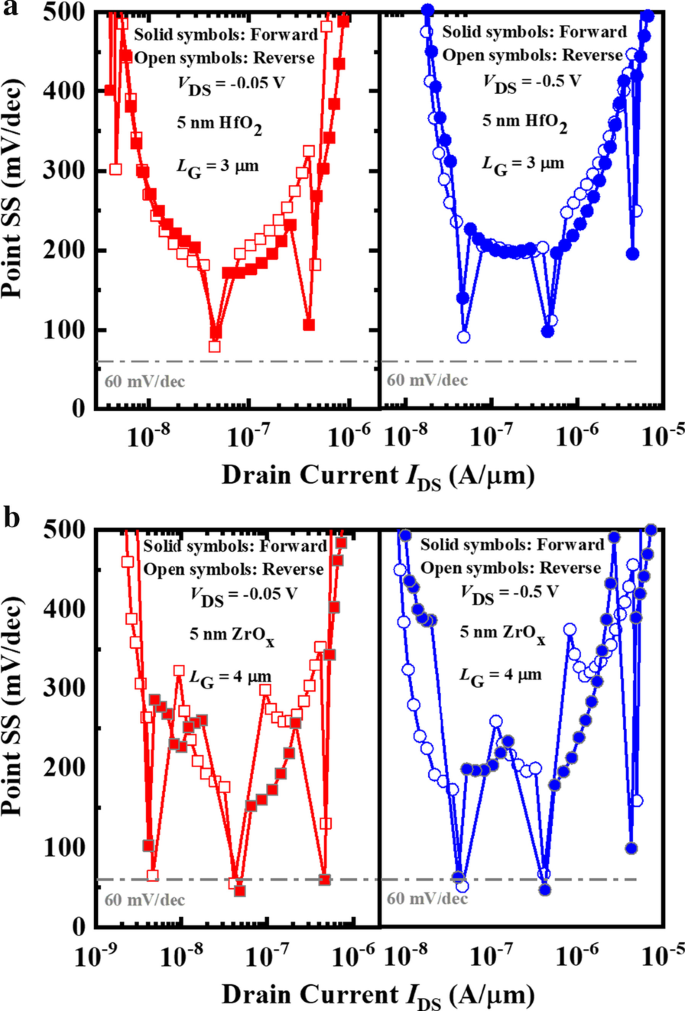
Ponto SS como uma função de I DS para o a Al 2 O 3 / 5 nm HfO 2 NCFETs e b 5 nm ZrO x NCFETs
Conclusões
Relatamos a demonstração do ferroelétrico NC ZrO x pFETs com SS sub-60 mV / década, baixa tensão operacional de 1 V e histerese de menos de 60 mV. O impacto do amorfo ZrO x filmes sobre o comportamento ferroelétrico é explicado pelos dipolos de vacância de oxigênio. O melhorado eu DS e o fenômeno NDR também são obtidos em Al 2 O 3 / HfO 2 NCFETs e ZrO x NCFETs em comparação com o dispositivo de controle. O efeito NC suprimido do Al 2 O 3 / HfO 2 NCFET pode ser atribuído à troca de dipolo partical devido a dipolos interficais no Al 2 O 3 / HfO 2 interface. O ZrO x NCFETs com declive acentuado de sub-60 mV / década, tensão de drenagem aprimorada e baixa tensão de operação abrem um novo caminho para o futuro design de NCFETs de baixo consumo de energia.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste artigo estão incluídos no artigo.
Abreviações
- TaN:
-
Nitreto de tântalo
- ZrO x :
-
Dióxido de zircônio
- TDMAZr:
-
Tetraquis (dimetilamido) zircônio
- P r :
-
Polarização remanescente
- E c :
-
Campo elétrico coercitivo
- MOSFETs:
-
Transistores de efeito de campo de metal-óxido-semicondutor
- Ge:
-
Germânio
- ALD:
-
Deposição de camada atômica
- B + :
-
Íon de boro
- Al 2 O 3 :
-
Óxido de aluminio
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- Ni:
-
Níquel
- RTA:
-
Recuperação de recozimento térmico
- I DS :
-
Corrente de drenagem
- V GS :
-
Tensão do portão
- V TH :
-
Tensão de limiar
- NCFET:
-
Transistor de efeito de campo de capacitância negativa
Nanomateriais
- O Transistor de efeito de campo de junção (JFET) como uma chave
- Materiais:Espuma EPP com propriedades de superfície aprimoradas e comportamento de enchimento otimizado
- Transistores de efeito de campo Nanoflake SnSe multicamadas com contatos óhmicos de baixa resistência
- Comportamento de sinterização de SiC sinterizado por plasma de faísca com nanopartículas compostas de Si-SiC preparadas por processo de plasma DC térmico
- Aerogel de Grafeno / Polianilina com Superelasticidade e Alta Capacitância como Eletrodo de Supercapacitor Altamente Tolerante à Compressão
- Transistores de efeito de campo ferroelétricos baseados em padrões de faixa de micron-largas dominadas por nanotubo de carbono de parede única com camada de controle de defeito de HfO2
- Desempenho analógico / RF do transistor de efeito de campo de túnel de fonte dupla com porta em forma de T
- Transistor de canal de vácuo em nanoescala à base de grafeno
- Transistor de semicondutor de óxido metálico difundido duplo e lateral de resistência ultrabaixa específica com porta dupla aprimorada e camada P-enterrada parcial
- Capacidade de torneamento de alto desempenho com pequena área ocupada



