Funções duplas do dispositivo V / SiOx / AlOy / p ++ Si como seletor e memória
Resumo
Esta letra apresenta funções duplas, incluindo seletor e comutação de memória em um V / SiO x / AlO y / p ++ Dispositivo de memória resistiva Si simplesmente controlando o limite de corrente de conformidade (CCL). A comutação de limite unidirecional é observada após uma formação positiva com baixo CCL de 1 μA. As mudanças para o lado do eletrodo V do oxigênio formam o VO x camada, onde a comutação de limiar pode ser explicada pelo fenômeno de transição metal-isolamento. Para maior CCL (30 μA) aplicado ao dispositivo, uma troca de memória bipolar é obtida, que é atribuída à formação e ruptura do filamento condutor em SiO y camada. AlO de 1,5 nm de espessura y camada com alta condutividade térmica desempenha um papel importante na redução da corrente de desligamento para memória e comutação de limite. Por meio da dependência da temperatura, é confirmada a barreira de alta energia (0,463 eV) no LRS, que pode causar não linearidade em um estado de baixa resistência. Quanto menor for o CCL, maior será a não linearidade, o que fornece um tamanho de array maior no array de ponto cruzado. A coexistência de memória e comutação de limite de acordo com o CCL fornece a flexibilidade para controlar o dispositivo para o uso pretendido.
Histórico
A memória de acesso aleatório resistiva (RRAM) é um dos candidatos promissores para a tecnologia de memória não volátil de próxima geração devido à sua velocidade de comutação rápida [1, 2], baixo consumo de energia [3,4,5,6,7 , 8], capacidade multinível [9,10,11,12,13,14,15], alta escalabilidade [16,17,18,19,20] e capacidade de empilhamento 3D [21,22,23,24,25 ] Essas propriedades são especialmente adequadas para memória de classe de armazenamento (SCM), que pode preencher a lacuna de desempenho entre a memória dinâmica de acesso aleatório (DRAM) como memória principal e unidade de estado sólido (SSD) como memória de armazenamento. Mesmo que o dispositivo RRAM tenha feito muito progresso nos últimos anos [1,2,3,4,5,6,7,8,9,10,11,12,13,14,15,16,17,18,19 , 20,21,22,23,24,25], permanece, no entanto, uma grande desvantagem:a corrente de fuga através das células vizinhas ocorre em uma matriz de pontos cruzados de alta densidade [26]. O dispositivo de memória com o componente seletor deve fornecer características não lineares de corrente – tensão (I – V) para superar esse problema [26,27,28,29,30,31,32,33,34,35]. Até agora, vários dispositivos com conceitos não lineares, como comutação resistiva complementar (CRS) [26], barreira de túnel [27,28,29,30,31,32,33], comutação de limiar baseada em Ag [34], tipo de diodo seletor [35, 36], comutação de limiar ovônico (OTS) [37, 38] e transição de isolador de metal (MIT) [39,40,41,42,43] foram relatados. VO x como um dos materiais MIT típicos pode ser amplamente utilizado em aplicações potenciais como componente de comutação óptico e elétrico [40,41,42]. SiO 2 é amplamente utilizado como camada de passivação na indústria de semicondutores. Além disso, SiO rico em Si x ( x <2) pode ser usado como uma camada de mudança de resistência em RRAM [44,45,46,47,48,49,49,50,51,52,53,54,55]. SiO x pode ser preferido em relação a muitos outros materiais em termos de compatibilidade com processos CMOS e baixo custo. SiO x Relata-se que dispositivos RRAM baseados em ação atuam como mediadores do papel das pontes condutoras simplesmente pelo uso de eletrodos como Cu e Ag com alta difusividade [44,45,46,47]. Em outro caso, a troca de memória é induzida pelo efeito de mudança de valência dentro do SiO x camada, o que pode ser explicado pela geração de vacâncias de oxigênio ou modelo de troca de prótons [48,49,50,51,52,53,54,55]. Na comutação unipolar em que uma operação definida precede um reset, ela é sensível à atmosfera ambiente. O desempenho de comutação no ar é significativamente degradado [48,49,50,51,52,53]. Por outro lado, a comutação filamentar sem efeitos de varredura para trás mostra a comutação unipolar e bipolar típica em vários SiO x dispositivos RRAM baseados em [52,53,54].
Aqui, apresentamos a coexistência de comutação de limiar e comutação de memória em V / SiO x / AlO y / p ++ Dispositivo de Si dependendo do limite de corrente de conformidade (CCL). O aparelho com eletrodo de fundo de silício (BE) apresenta diversas vantagens em relação ao eletrodo metálico convencional. O dispositivo RRAM com memória ou comutação de limite é conectado diretamente ao lado da fonte ou do dreno em um transistor, que é uma aplicação potencial para memória embutida e dispositivo de declive acentuado. A corrente de ultrapassagem pode ser reduzida devido à resistência em série do Si BE. Além disso, a nano-ponta de silício BE por meio de corrosão úmida e o ajuste da concentração de dopagem na superfície de silício podem melhorar o desempenho de comutação. O AlO y camada, que é uma grande lacuna de banda com uma propriedade isolada, ajuda a diminuir a corrente operacional durante o limite e a comutação de memória. O SiO x camada atua como camada de comutação de memória em um alto CCL, enquanto serve para fornecer oxigênio para V TE em baixo CCL, que fornece comutação de limiar.
Métodos
V / SiO x / AlO y / p ++ O dispositivo Si foi fabricado da seguinte forma:Primeiramente, BF 2 íons foram implantados com uma energia de aceleração de 40 keV e uma dose de 5 × 10 15 cm −2 em um substrato de Si para Si BE fortemente dopado. O dano da rede foi curado pelo processo de recozimento a 1050 ° C por 10 min. O Si BE fortemente dopado apresentou resistência de folha de 30,4 Ω / □. Em seguida, um AlO y de 1,5 nm de espessura camada foi depositada por um sistema de deposição de camada atômica (ALD) usando H 2 O e Al (CH 3 ) 3 e um SiO de 5,5 nm de espessura x camada sofreu deposição de vapor químico intensificada por plasma (PECVD) por reação de 5% SiH 4 / N 2 (160 sccm), N 2 O (1300 sccm) e N 2 (240 sccm) a 300 ° C. Posteriormente, um eletrodo superior (TE) de vanádio (V) de 50 nm de espessura com um diâmetro de 100 μm foi depositado por pulverização catódica DC um alvo V com gás Ar (30 sccm). Finalmente, um Al de 50 nm de espessura como uma camada protetora foi depositado por pulverização catódica DC para prevenir a oxidação adicional de V TE. Todas as propriedades elétricas foram caracterizadas por meio dos modos de varredura de tensão DC e pulso usando um analisador de parâmetros de semicondutor Keithley 4200-SCS (SPA) e um módulo de tensão de corrente ultrarrápido (I-V) 4225-PMU em temperatura ambiente, respectivamente. Para a operação do dispositivo, o TiN BE foi aterrado e a polarização de Ni TE foi controlada.
Resultados e discussão
A Figura 1a mostra a estrutura esquemática de V / SiO x / AlO y / p ++ Dispositivo de Si. Três V amorfos, SiO x , e AlO y camadas e camada de Si cristalino único são observadas por uma imagem transversal de microscopia eletrônica de transmissão (TEM), como mostrado na Fig. 1b. As espessuras do SiO x e AlO y as camadas são 5,5 e 1,5 nm, respectivamente. Para confirmar a proporção de composição de dois filmes dielétricos, a análise XPS foi conduzida (arquivo adicional 1). O x valor de SiO x e o y valor de AlO y são 0,88 e 1,33, respectivamente. Nosso SiO x filme usando PECVD em comparação com SiO 2 depositado usando oxidação seca é depositado em uma temperatura muito mais baixa e tem muito mais defeitos, tornando-os adequados para comutação resistiva em tensões relativamente mais baixas. A Figura 2a mostra a comutação de limiar típica de V / SiO x / AlO y / p ++ Dispositivo de Si. A comutação inicial com um processo de formação positiva requer tensão mais alta do que a comutação de limite subsequente, uma vez que as camadas dielétricas têm defeitos inicialmente menores. Um CCL de 1 μA é aplicado ao dispositivo para evitar a formação de filamentos condutores excessivos no SiO x camada. A corrente de fuga é muito baixa (100 pA a 1 V) em comparação com a comutação de limiar relatada anteriormente de VO x . Esta vantagem é atribuída ao Al 2 O 3 com maior permissividade e condutividade térmica em comparação com o SiO 2 . O estado desligado tem a propriedade de isolamento porque os filamentos se rompem facilmente e não há filamentos restantes. Um possível mecanismo de comutação de limiar é a oxidação do V TE do oxigênio fornecido pelo SiO x camada durante o processo de formação positiva como mostrado na Fig. 2b. A propriedade elétrica de VO x entre V TE e SiO x camada pode mudar do estado isolante para o estado metálico, causando uma mudança repentina na resistência. Um baixo CCL de 1 μA não é suficiente para causar filamentos condutores eficientes dentro do SiO x filme. Portanto, SiO x com propriedades isolantes pode ser outra causa para reduzir a corrente de saída. Para um processo de formação negativa de V / SiO x / AlO y / p ++ Dispositivo Si, uma comutação de limite não é observada (consulte o arquivo adicional 1). Quando a polarização negativa é aplicada ao V TE, o movimento do óxido se move em direção ao Si BE, de modo que o V TE não pode mais participar da mudança de limiar como VO x . O detalhe da Fig. 2a exibe a tensão limite (V th ) e reter a tensão (V manter ) durante os 100 ciclos. O V o onde a corrente aumenta acentuadamente com inclinação quase infinita está entre 1,08 e 1,82 V, e V mantenha nesse ponto, o retorno da corrente a um estado de alta resistência está entre 0,12 e 0,54 V. A Figura 2c mostra as características I – V na corrente ligada em diferentes temperaturas. A 25 ° C e 55 ° C, eles mostram comutação de limiar quase semelhante, mas a curva I – V em uma temperatura mais alta de 85 ° C perde a propriedade de comutação de limiar. É bem sabido que VO x perde seu MIT em altas temperaturas. Assim, este resultado é mais uma prova de que VO x é a principal causa da mudança de limite. A Figura 2d mostra as características transitórias para comutação de limite. O pulso com amplitude de 1 V monitorou a corrente lida antes e depois da escrita do pulso com largura de 1 μs. A alta corrente foi monitorada enquanto o pulso com alta amplitude é aplicado ao dispositivo, e então, o V / SiO x / AlO y / p ++ O dispositivo Si desligou a corrente imediatamente após o pulso de escrita ser removido. As propriedades do seletor analisadas acima podem ser usadas quando combinadas com a operação de elementos de memória abaixo de 1 μA [55, 56].
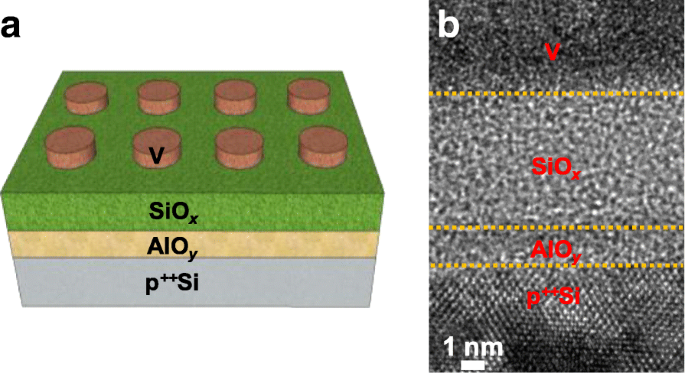
Configuração do dispositivo de V / SiO x / AlO y / p ++ Si. a Desenho esquemático e b Imagem TEM

Troca de limite unidirecional de V / SiO x / AlO y / p ++ Si quando uma formação positiva com CCL de 1 μA é aplicada. a Curvas I – V típicas. b Desenho esquemático do processo de conformação. c Características I – V por dependência da temperatura. d Características transitórias
A Figura 3a mostra a comutação resistiva bipolar de V / SiO x / AlO y / p ++ Dispositivo de Si após uma formação positiva com CCL de 100 μA. Em seguida, o processo de reinicialização com um rápido aumento na resistência é executado varrendo a tensão negativa e o dispositivo é colocado em um estado de alta resistência (HRS). O processo definido com uma diminuição rápida na resistência ocorre então em uma tensão de polarização positiva, fazendo com que o dispositivo volte a um estado de baixa resistência (LRS). Para entender as propriedades do filamento condutor, observamos a condutância normalizada e a dependência da temperatura. A condução no LRS é uma diretriz importante para informar indiretamente as propriedades do filamento condutor. A Figura 3b mostra a condutância normalizada (G N ) que é definida como a condutância dinâmica (G d ) dividir pela condutância estática (G 0 ) para curvas I – V de V / SiO x / AlO y / p ++ Dispositivo de Si no LRS com diferentes temperaturas. Independentemente da temperatura, o G N valor converge para 1 quando a tensão é zero. Isso nos permite descartar o mecanismo de condução bem conhecido, como a emissão de Schottky, o túnel de Fowler-Nordheim e a lei da criança (I ~ V 2 ) em corrente de carga limitada (SCLC). A condução ôhmica metálica também pode ser excluída considerando a dependência da temperatura, conforme mostrado na Fig. 3c. A diminuição da resistência com o aumento da temperatura sugere que o filamento condutor tem uma propriedade semicondutora. Assim, podemos excluir a penetração de V no SiO x camada para o filamento condutor principal de V / SiO x / AlO y / p ++ Dispositivo de Si em LRS. Portanto, a operação de memória bipolar do V / SiO x / AlO y / p ++ O dispositivo Si é dominado pela troca intrínseca de SiO x . Também é confirmado que as correntes positivas e negativas não são muito diferentes, sugerindo que ao invés de um tipo de interface como a emissão Schottky, ela é dominada pela condução em massa. Levando em consideração a condutância normalizada mencionada acima, existem dois mecanismos de condução dominante em massa possíveis. O primeiro é o salto de condução seguindo a fórmula:
$$ J ={qnav} _o {e} ^ {- q {\ o} _T / kT} {e} ^ {qaV / 2 dkT} $$
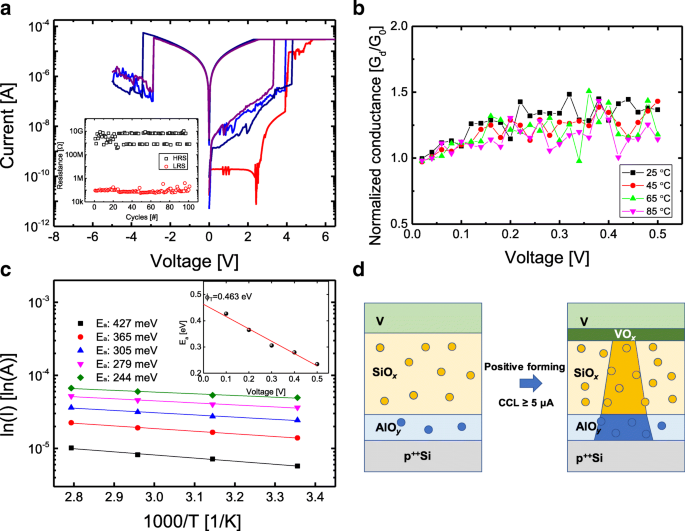
Troca de memória de V / SiO x / AlO y / p ++ Si quando uma formação positiva com CCL de 30 μA é aplicada. a Curvas I – V típicas. b Condutância normalizada. c Em (I) versus 1000 / T. d Desenho esquemático do processo de formação
onde q , n , a , ø T , v o e d são a carga elétrica, a concentração de carga espacial, a distância média de salto, a altura da barreira de elétrons para o salto, a frequência de vibração intrínseca e a espessura do filme dielétrico, respectivamente. O ø T calculado a partir da inclinação de um gráfico linear de ln (I) versus 1000 / T é 0,463 eV, conforme mostrado na Fig. 3c. Um valor calculado a partir da relação entre E a e V é 5,17 nm, indicando o filamento condutor formado no SiO x não é forte e está próximo do estado HRS. O outro mecanismo de condução, a emissão de Poole-Frenkel (P-F), foi abordada no arquivo adicional 1. Com base nos resultados acima, o modelo do filamento condutor na operação de memória de V / SiO x / AlO y / p ++ O dispositivo Si está representado na Fig. 3d. No processo de formação positiva, o processo de oxidação prosseguiu no lado V TE, mas devido ao alto CCL, um filamento condutor pode ser formado dentro do SiO x e AlO y devido ao movimento das vagas de oxigênio. Durante o processo de reset, o campo elétrico oposto à formação e conjunto induz oxigênio e recombinação com a vacância de oxigênio, resultando na ruptura do filamento condutor. Note-se que as operações do seletor e da memória são observadas na mesma célula. A operação de memória é possível após a operação de limite ter ocorrido e, em seguida, a chave for completamente desligada. No entanto, a direção reversa não é possível porque a comutação de reinicialização da operação de memória não está completamente desligada.
A Figura 4a mostra as curvas I – V normalizadas no LRS de V / SiO x / AlO y / p ++ Dispositivo de Si em regime de baixa tensão (0 ~ 1 V) para diferentes condições de CCL (5 μA, 30 μA e 1 mA). Aqui, a curva I – V normalizada é definida como a corrente em cada tensão dividida pela corrente em 1 V. Uma vez que os níveis da corrente LRS dependendo do CCL são variados, definimos o valor da corrente em 1 V para comparar facilmente o Não-linearidade. Pode-se observar que à medida que o CCL diminui, a corrente é suprimida em regime de tensão mais baixa. Para derivar uma relação mais quantitativa, a não linearidade é definida como a razão da corrente em V READ para aquele na metade de V READ . A Figura 4b mostra a corrente lida em 1 V e não linearidade como uma função de CCL para V / SiO x / AlO y / p ++ Dispositivo de Si. A diminuição na corrente de leitura devido à redução de CCL sugere que o filamento condutor está se tornando mais fino e, em seguida, a não linearidade aumenta. O filme de óxido de silício intrínseco exibe alta não linearidade, mesmo em uma única camada. A propriedade não linear intrínseca se deve à natureza volumosa do óxido de silício, e não à interface do silício. Quanto menor for o CCL, menor será a degradação gerada no SiO x , de modo que a redução do nível de energia da armadilha no LRS em comparação com aquele no HRS pode ser minimizada. Portanto, a barreira de energia mais alta pode maximizar a não linearidade no estado LRS quando o CCL mais baixo é aplicado ao dispositivo. Da mesma forma, a condução descrita pela emissão P-F no TaO x / TiO y pilha garante alta não linearidade [57]. Outra possibilidade é que, como a constante dielétrica do óxido é menor, mais passagens são feitas no filme de óxido devido à concentração do campo. Isso pode levar à redução do nível de energia da armadilha da camada de óxido, que pode servir como uma barreira de túnel para Al 2 O 3 . Para obter a margem de leitura (∆V) em n × n matriz de ponto cruzado, usamos o circuito equivalente simplificado, conforme mostrado na Fig. 4c. Considerando o pior caso, as células adjacentes são definidas para o LRS e a resistência de carga (R L ) à resistência LRS. O ∆V foi calculado a partir da diferença entre V OUT em LRS e V OUT no HRS. A Figura 4d mostra o ∆V em função do número de linhas de palavras ( n ) para V / SiO x / AlO y / p ++ Dispositivo de Si. Quanto menor for o CCL, maior será o ∆V porque a não linearidade aumenta. Quando a margem de leitura de 10% é assegurada, a matriz pode ser expandida para cerca de mais de 10 × 10 para CCL de 5 μA e 5 × 5 para CCL de 1 mA. O tamanho do array para suportar a corrente de fuga não é suficiente, mas ajudará a expandir o tamanho do array quando o dispositivo com função seletor estiver conectado em um V / SiO x / AlO y / p ++ Dispositivo de Si. Comparado com a leitura de 0,5 V em todos os CCLs, tem maior não linearidade com leitura em 1 V. Embora baixo V READ leva a baixa potência estática na operação de leitura, o valor da não linearidade torna-se menor, o que se deve ao fato do campo elétrico ser menor no SiO x / AlO y camada em V menor READ .

Características não lineares de V / SiO x / AlO y / p ++ Si para troca de memória. a Curvas I – V com diferentes CCLs. b Leia a corrente e a não linearidade como funções do CCL. c Circuitos equivalentes de matriz de ponto cruzado. d Margem de leitura como uma função do número da linha da palavra para diferentes CCLs e tensão de leitura
Conclusões
Neste trabalho, um V / SiO x / AlO y / p ++ O dispositivo Si tendo um seletor e uma função de memória simplesmente controlando CCL é investigado. Quando um CCL de 1 μA ou menos é aplicado, a comutação de limite unidirecional é observada para a aplicação do seletor. A formação positiva oxida o eletrodo V e o fenômeno MIT de VO x pode induzir a comutação de limite. O AlO y camada é capaz de atingir uma alta seletividade de 10 4 diminuindo a corrente de desligamento. Por outro lado, quando um CCL de 5 μA ou mais é aplicado, a troca de memória é observada conforme filamentos condutores efetivos são formados no SiO x camada. Quanto mais baixo for o CCL, maior será a não linearidade, o que ajuda a aumentar o tamanho da matriz de ponto cruzado.
Abreviações
- ALD:
-
Deposição de camada atômica
- BE:
-
Eletrodo inferior
- CCL:
-
Limite atual de conformidade
- CRS:
-
Comutação resistiva complementar
- DRAM:
-
Memória de acesso aleatório dinâmico
- HRS:
-
Estado de alta resistência
- I – V:
-
Corrente electrica
- LRS:
-
Estado de baixa resistência
- MIT:
-
Metal-isolador-transição
- OTS:
-
Troca de limiar ovônico
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- P-F:
-
Poole-Frenkel
- RRAM:
-
Memória de acesso aleatório resistiva
- SCLC:
-
Corrente limitada por carga espacial
- SCM:
-
Memória de classe de armazenamento
- SPA:
-
Analisador de parâmetro de semicondutor
- SSD:
-
Disco de Estado Sólido
- TE:
-
Eletrodo superior
- TEM:
-
Microscopia eletrônica de transmissão
- V:
-
Vanádio
Nanomateriais
- Termos e conceitos de memória digital
- O que é um sistema operacional e seus componentes
- Gerenciamento de memória C++:novo e excluir
- Memória da partição - introdução e serviços básicos
- Os processadores abordam a convergência de IoT e AI
- Controle de não linearidade dupla de propriedades de modo e dispersão em grafeno-dielétrico Plasmonic Waveguide
- Um estudo coletivo sobre modelagem e simulação de memória de acesso aleatório resistiva
- Fabricação de IoT:definição, funções e exemplos
- Partes da máquina caça-níqueis e suas funções
- Tipos de diferencial e suas funções



