Revisão do progresso recente em diodos PN baseados em GaN verticais
Resumo
Como um material semicondutor de largo bandgap representativo, nitreto de gálio (GaN) tem atraído atenção crescente por causa de suas propriedades de material superior (por exemplo, alta mobilidade de elétrons, alta velocidade de saturação de elétrons e campo elétrico crítico). Dispositivos GaN verticais foram investigados, são considerados um dos candidatos mais promissores para aplicação em eletrônica de potência e são caracterizados pela capacidade de alta tensão, alta corrente e alta tensão de ruptura. Entre esses dispositivos, o diodo de junção PN baseado em GaN vertical (PND) foi consideravelmente investigado e mostra um grande progresso de desempenho com base na alta qualidade de epitaxia e no design da estrutura do dispositivo. No entanto, a qualidade epitaxia do dispositivo requer melhorias adicionais. Em termos de desempenho elétrico do dispositivo, o efeito de aglomeração do campo elétrico na borda do dispositivo é uma questão urgente, o que resulta em colapso prematuro e limita a liberação de superioridades do material GaN, mas atualmente é aliviado pela terminação da borda. Esta revisão enfatiza os avanços no crescimento epitaxial de material e técnicas de terminal de borda, seguido pela exploração dos desenvolvimentos GaN atuais e vantagens potenciais sobre o carbono de silício (SiC) para materiais e dispositivos, as diferenças entre os diodos de barreira Schottky GaN (SBDs) e PNDs como diz respeito aos mecanismos e recursos, e às vantagens dos dispositivos verticais em relação às suas contrapartes laterais. Em seguida, a análise fornece uma perspectiva e revela a tendência do projeto do GaN PND vertical utilizado para um sistema de energia, incluindo um GaN PND vertical incipiente.
Introdução
O consumo global de energia está aumentando muito mais rapidamente do que nas últimas décadas, devido ao rápido crescimento da indústria e da economia. Portanto, tecnologias avançadas de economia de energia são necessárias para aliviar os problemas de aumento do consumo de energia.
Dispositivos baseados em silício são atualmente o tipo dominante entre dispositivos de energia [1]. Entre esses dispositivos de potência, as estruturas do transistor bipolar de porta isolada (IGBTs) desempenham um papel significativo e exibem uma tendência crescente para a substituição do transistor de junção bipolar de potência (BJT) e do transistor de efeito de campo semicondutor de óxido metálico (MOSFET) desde a invenção do IGBTs em 1982 [2]. Atualmente, os IGBTs são elementos essenciais dos campos eletrônicos de potência para conversão e transmissão [3]. No entanto, dispositivos de energia baseados em silício atingiram seus limites materiais fundamentais até o momento e são amplamente utilizados em aplicações de energia elétrica.
Dadas suas excelentes propriedades, GaN é um dos materiais semicondutores de largo bandgap (incluindo SiC, GaN, Ga 2 O 3 e diamante) capaz de fabricar dispositivos de energia com uma baixa capacitância e resistência para uma tensão de ruptura especificada em relação aos dispositivos baseados em Si. Assim, dispositivos baseados em GaN com baixo consumo de energia, altas densidades de potência e alta eficiência de conversão para sistemas eletrônicos de potência são esperados.
Conforme mostrado na Tabela 1, GaN tem uma figura de mérito de Baliga muito maior (BFOM) do que SiC (que foi comercializado), uma característica que é atribuída a sua maior velocidade de saturação de elétrons e maior campo elétrico crítico. No entanto, o SiC tem melhor condutividade térmica. Além disso, GaN possui uma maior mobilidade de portadores µ e uma condutividade térmica mais alta, e alcançou ambos p - e n -tipo dopagem em comparação com Ga 2 O 3 . Enquanto isso, para o semicondutor de gap largo definitivo, o diamante, um progresso considerável deve ser alcançado para atingir o estágio prático. Até o momento, dispositivos baseados em GaN, por exemplo, dispositivos de três terminais (transistores de efeito de campo Heterostructure (HFETs) e MOSFETs) e dispositivos de dois terminais (SBDs e PNDs) tornaram-se tópicos de pesquisa chave, e um grande progresso foi alcançado em seus aplicações em retificação e conversão de energia.
GaN versus SiC
De suas propriedades materiais inerentes, GaN tem vantagens ligeiramente superiores sobre SiC, incluindo um maior intervalo de energia, maior campo elétrico crítico, maior velocidade de saturação de elétrons e um BFOM 3-4 × melhor para dispositivos de energia [6]. Portanto, considerando seus excelentes recursos, os dispositivos baseados em GaN devem superar seus equivalentes baseados em SiC. Na aplicação prática, os dispositivos verticais baseados em GaN são essenciais para alta densidade de potência e alta frequência de operação (Fig. 1) por causa de suas excelentes propriedades do material.
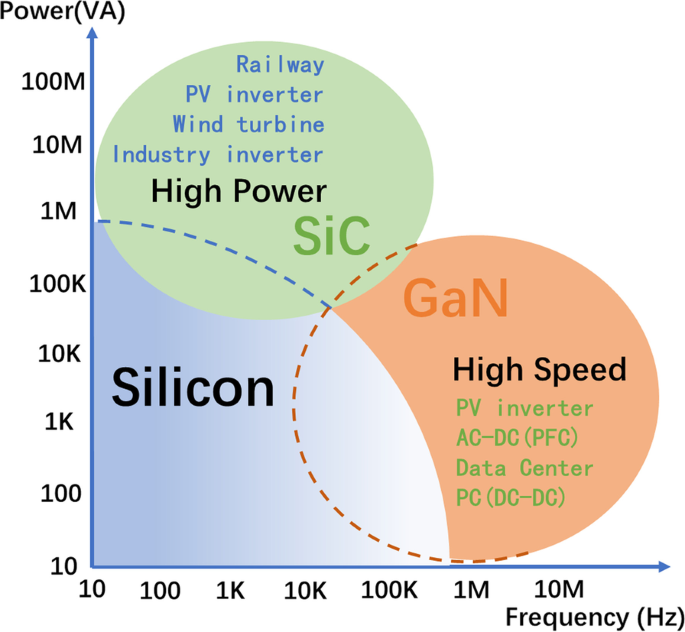
Aplicações potenciais de transistores de comutação de potência GaN e SiC [7]
Como os semicondutores de gap largo mais maduros, os dispositivos de SiC alcançaram avanços notáveis na última década e mostram um desempenho promissor em termos de alta tensão, baixa resistência específica e rápida velocidade de chaveamento [8]. Dada a profunda base de pesquisa desde 1980 e substrato de SiC maior disponível com baixo defeito (<10 4 cm −2 ), SBDs de SiC e transistores de efeito de campo de junção (JFETs) foram os primeiros dispositivos baseados em SiC comercializados desde 2001. Outros dispositivos de energia baseados em SiC, incluindo MOSFETs e BJTs, foram desenvolvidos com sucesso no campo de alta tensão e aplicação de energia e demonstraram ser impressionantes desempenho [9].
Em comparação com o SiC, os dispositivos GaN se desenvolveram muito lentamente. Sua qualidade insatisfatória de material impede a realização de algumas de suas propriedades teoricamente superiores. Dada a falta do substrato GaN, a maioria dos estudos sobre dispositivos GaN são baseados principalmente na estrutura lateral (por exemplo, heteroestrutura AlGaN / GaN) neste estágio. Com sua maior mobilidade de elétrons de 2.000 cm 2 / V s (gás de elétron bidimensional (2DEG) em AlGaN / GaN), 1000 cm 2 / V s (bulk GaN) e velocidade de saturação mais alta de 2,5 × 10 7 cm / s em relação às contrapartes de SiC, os dispositivos AlGaN / GaN são preferidos para aplicações de alta frequência e têm watts de baixa potência em relação aos dispositivos de SiC [10]. Em campos de alta frequência, os SBDs AlGaN / GaN alcançam excelentes desempenhos de transporte elétrico e são mais adequados para aplicações de microondas e ondas milimétricas no nível de watt [11, 12]. O AlGaN / GaN SBD é um dispositivo representativo para GaN SBDs. A alta mobilidade do 2DEG significa que os SBDs AlGaN / GaN demonstram enormes vantagens de desempenho em aplicações de alta frequência em relação aos SBDs verticais e também mantêm uma tensão de ativação baixa. Recentemente, os SBDs AlGaN / GaN foram a base para um circuito retificador de 5,8 GHz com uma potência de entrada de 6,4 W e uma tensão de ativação de 0,38 V com uma tensão de ruptura ( BV ) de 3000 V [13, 14]. A frequência máxima de corte é próxima a 1 THz a 0 V com uma distância anodo-catodo de 70 nm [15].
Para dispositivos de energia baseados em GaN, o substrato de GaN (bulk GaN) é ideal para o crescimento de epitaxia, que poderia utilizar a tecnologia homoepitaxia para eliminar a incompatibilidade. A baixa densidade de deslocamento do GaN bruto é essencial para o substrato epitaxial porque a alta densidade de deslocamento pode afetar as características de desempenho, como BV , corrente de fuga reversa, volume de produção e confiabilidade [16]. O desenvolvimento de dispositivos verticais baseados em GaN foram impulsionados pelo progresso do substrato de GaN nos últimos anos. No entanto, dada a tecnologia relativamente imatura para o triodo vertical, o diodo vertical GaN se tornou um tópico de pesquisa quente neste estágio inicial. Em comparação com os SBDs AlGaN / GaN, os SBDs GaN verticais têm vantagens semelhantes em campos de frequência, como alta velocidade de chaveamento com baixo tempo de recuperação reversa e baixa perda de condução; no entanto, o último tem grande densidade de corrente e menor caminho de fuga do que o primeiro [17, 18].
Alguns problemas surgiram para o substrato GaN. Em primeiro lugar, os substratos GaN estão atualmente disponíveis com densidades de deslocamento de 10 4 –10 6 cm −2 , mas essas densidades de deslocamento ainda são muito maiores do que aquelas de substratos de Si e SiC [19]. Em segundo lugar, com relação ao tamanho do wafer de 4–6 polegadas e custo razoável (10 euros / cm 2 ) de SiC, o tamanho de 2–3 polegadas e custo relativamente alto (100 euros / cm 2 ) do substrato GaN inibem a comercialização e a produtividade de GaN em grande escala [20]. Além de aumentar os fornecedores de fornecimento, a heteroepitaxia em substratos estranhos (Si, safira ou SiC) é uma maneira alternativa de reduzir o custo do substrato GaN, mas o desafio de incompatibilidade e defeitos relativamente altos deve ser abordado.
Além dos problemas mencionados acima em materiais a granel, o desafio para o diodo GaN é alcançar uma alta qualidade do p -tipo de material. Com relação às técnicas relativamente avançadas de formação de p -tipo SiC por implantação de íon Al, imaturo p - tecnologia de implantação de íon tipo e baixa ativação de aceitador para p -tipo GaN são obstáculos vitais, que limitam o desenvolvimento da estrutura e fabricação de dispositivos baseados em GaN. Assim, diferentes tipos de estruturas de terminação de aresta são propostas para melhorar o desempenho do diodo GaN e constituem uma parte importante desta revisão.
Dispositivos verticais baseados em GaN no substrato FS
Até 10 anos atrás, a maioria dos diodos de GaN, incluindo SBDs e PNDs, eram fabricados em substratos estranhos, formando estruturas de dispositivos laterais ou quase verticais devido à indisponibilidade de um substrato de GaN em massa. Diodos laterais ou quase verticais apresentam características elétricas excelentes, mas ainda sofrem de desvantagens inerentes à estrutura do dispositivo [21]. Primeiro, a incompatibilidade e os defeitos são inevitáveis. Então, para dispositivos GaN em substratos estranhos, um buffer é essencial entre a camada de deriva de GaN e o substrato estranho. Assim, o relaxamento da tensão da camada tampão causaria um arqueamento do wafer, o que diminuiria a espessura das camadas de epitaxia de GaN [22]. Além disso, a grande resistência térmica de contorno (GaN com substrato) tem uma séria influência no desempenho do dispositivo para os dispositivos GaN trabalhando em alta densidade de potência [23].
De acordo com o desenvolvimento de técnicas de epitaxia, o substrato autônomo de GaN (FS-GaN) com baixa densidade de deslocamento adotado para dispositivos de GaN verticais tem feito um grande progresso. A qualidade do material de GaN homoepitaxial no substrato FS-GaN tem uma melhoria óbvia e mostra o potencial para aplicações de energia. Dispositivos GaN verticais podem mitigar as desvantagens das contrapartes GaN laterais. Em primeiro lugar, camadas epitaxiais de GaN mais espessas podem ser cultivadas sem qualquer tampão e BV superior (que excedem os dispositivos GaN laterais) podem ser obtidos e determinados pela espessura da camada de deriva. Enquanto isso, um campo elétrico máximo está localizado na parte interna dos dispositivos e está longe da superfície do dispositivo (eliminando o efeito de aprisionamento de elétrons que geralmente ocorre em dispositivos laterais). Dada a alta qualidade do substrato FS-GaN, dispositivos GaN verticais têm sido estudados desde 2011 [24]. Desde então, PNDs de GaN verticais com alto BV e baixa resistência no estado foram fabricados e alcançam desempenho notável.
PND versus SBD
Para aplicações práticas, diodos são componentes essenciais para conversão e inversão de potência [25]. Com as propriedades distintas do material de GaN, diodos baseados em GaN (SBDs e PNDs) exibem desempenhos notáveis, que devem satisfazer os requisitos de aplicações de energia. Conforme mostrado na Fig. 2, os PNDs têm o maior escopo entre os dispositivos GaN com estruturas variadas e suportam tensões de 600 a 5000 V, um recurso que indica cenários de aplicação mais amplos.
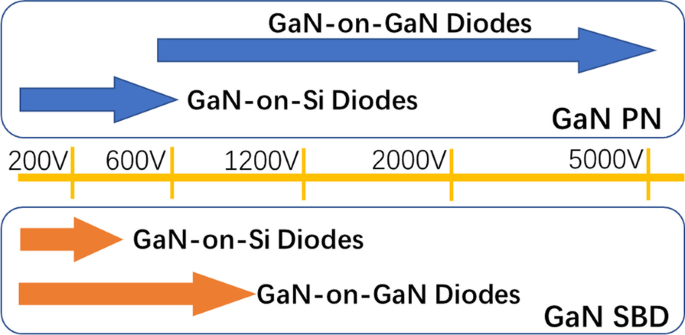
Visão geral dos tipos de dispositivos, relatórios e classes de tensão dos principais dispositivos de energia GaN verticais relatados nos últimos anos [26]
Comparado com PNDs, que não têm problemas de armazenamento de operadora minoritária e altura de barreira SBD mais baixa, os SBDs GaN apresentam uma baixa tensão de ativação direta ( V em ) e recuperação reversa rápida, e essas características indicam que os méritos do SBD são revelados em baixa condução / perda de comutação, operação de alta frequência, mas um BV inferior valor do que o do PND; além disso, observe que a alta tensão de ativação pode levar a uma alta perda de condução e degradar a eficiência dos circuitos e sistemas [27, 28].
Nos campos de alta potência, os SBDs quase verticais ou verticais têm excelentes vantagens sobre os SBDs AlGaN / GaN [29]. Além disso, uma baixa tensão de ativação (<0,5 V) é obtida ajustando a altura da barreira com um metal de baixa função de trabalho. No entanto, uma baixa altura de barreira pode facilmente levar à alta corrente de fuga reversa e diminuir o BV . Consequentemente, várias estruturas de terminação de borda são propostas para melhorar o desempenho. Com a ajuda de várias tecnologias de terminação de borda [27, 28, 30, 31], a alta densidade de corrente em KA / cm 2 nota com BV s acima de 1 kV é confirmado. Enquanto isso, SBDs verticais também exibem grande capacidade para alta frequência, como 177-183 GHz e uma frequência de corte máxima de 902 GHz a 0 V, um recurso que é esperado para fontes de energia em sistemas de comunicação terahertz-wireless [12, 32].
Com relação a n -tipo GaN, o p -tipo GaN crescido por deposição de vapor químico metalorgânico (MOCVD) e epitaxia de feixe molecular (MBE) foi introduzido usando Mg como aceptor [33]. Comparado com os SBDs de GaN, os PNDs de GaN têm muitas vantagens, como baixa resistência específica ( R em A ) e estabilidade adequada do dispositivo e capacidade de inibir correntes de surto. Apesar da alta tensão de ativação (> 3 V) e da velocidade de comutação relativamente baixa, uma corrente de fuga ultrabaixa devido à maior altura da barreira e alto BV é obtido. Observe que um alto BV de 0,6 a 5 kV é o desempenho mais notável para PNDs baseados em GaN. Assim, PNDs baseados em GaN têm grande potencial como importantes blocos de construção dos sistemas de energia de próxima geração para aplicações de alta potência, que requerem alta eficiência e baixa perda de energia [34]. Semelhante a GaN SBDs verticais, as terminações de borda para GaN PNDs também são fabricadas para aliviar o aglomerado de campos elétricos em torno do ânodo, um recurso que seria descrito em detalhes posteriormente neste artigo.
Em dispositivos de energia, a junção PN também pode ser tratada como uma nova estrutura de junção. Para utilizar um alto BV com baixa corrente de fuga reversa de PNDs, alto desempenho de comutação e baixa tensão de ativação de SBDs ao mesmo tempo, novas estruturas de dispositivos, incluindo a barreira de junção Schottky (JBS) e PN Schottky (MPS) fundidos, geram uma combinação de SBD e PND por a formação de p -tipo regiões de grade na região de contato Schottky. Dispositivos JBS ou MPS possuem as características de condução direta de SBDs e bloqueio reverso de PNDs e espera-se que tenham melhor desempenho de chaveamento e maior tensão reversa do que PNDs e SBDs convencionais, respectivamente [35].
Além de sua aplicação de alta potência, GaN PNDs também são adotados para dispositivos optoeletrônicos, como diodos emissores de luz (LEDs), fotodetectores e para detecção de chama por causa das baixas correntes escuras de alguns pA em fotodiodos de junção PN baseados em GaN [36 , 37].
Objetivo desta revisão
Com base nas propriedades superiores do material de GaN, os dispositivos baseados em GaN foram amplamente investigados e utilizados em aplicações de eletrônica de potência como um dos materiais semicondutores mais quentes. Entre os dispositivos baseados em GaN, o PND baseado em GaN vertical foi consideravelmente explorado e mostra excelente BFOM. As técnicas de terminal de borda também são essenciais para aliviar o aglomerado de campo elétrico em torno da almofada anódica.
Nesta revisão, os avanços no crescimento de epitaxia material e técnicas de terminal de borda como as principais ênfases são seguidos para ilustrar os desenvolvimentos GaN atuais, as diferenças entre SBDs e PNDs GaN em termos de mecanismos e recursos, e as vantagens dos dispositivos verticais sobre os laterais. . Esta análise fornece uma visão geral e revela a tendência do projeto de PNDs GaN verticais utilizados para um sistema de energia, incluindo PNDs GaN verticais incipientes. O desenvolvimento do crescimento epitaxial correspondente a uma camada diferente em PNDs GaN verticais é apresentado na Seção 2. As tecnologias de terminal de ponta são exploradas na Seção. 3. Na seção 4, os PNDs GaN verticais no substrato de Si são demonstrados como um método alternativo. Finalmente, a conclusão e as perspectivas do desenvolvimento futuro de PNDs GaN verticais são fornecidas.
Crescimento da epitaxia do material
Substrato GaN de PNDs verticais
Como um processo epitaxial principal, camadas epitaxiais de dispositivos verticais são atualmente cultivadas principalmente por MOCVD em substratos GaN condutores fabricados por epitaxi de fase de vapor de hidreto (HVPE). Nessa estrutura, a qualidade do substrato afeta diretamente a seguinte estrutura epitaxial. Muitos mecanismos de falha no dispositivo se originam da qualidade da epitaxia do substrato [38]. Um substrato de GaN condutor de alta qualidade deve ser obtido para melhorar ainda mais o I dianteiro e reverso - V desempenhos, especialmente a corrente de fuga reversa e BV capacidade.
O substrato cultivado por HVPE tem sido considerado o método mais conveniente para produção em massa devido ao seu custo e reprodutibilidade relativamente baixos. No entanto, no estágio inicial, a tecnologia de crescimento imaturo significava que o substrato GaN cultivado por HVPE tinha alta concentração de portadores de fundo (> 10 19 cm −3 ) e qualidade de cristal insatisfatória. Portanto, o HVPE não foi adotado para aumentar a estrutura do dispositivo [39]. Com o rápido desenvolvimento da tecnologia de crescimento de epitaxia, materiais de GaN a granel de alta qualidade por HVPE tornam-se gradualmente possíveis [40, 41]. Além do substrato, a camada parcialmente epitaxial no dispositivo pode agora ser cultivada por HVPE e pode resultar em maior uniformidade de corrente e a eliminação do macrostep na superfície de GaN combinando HVPE e o processo epitaxial MOCVD com tecnologia livre de carbono em comparação com dispositivos desenvolvidos apenas pelo MOCVD [42].
Atualmente, um substrato GaN comercial com densidade mínima de deslocamento inferior a 10 4 cm −2 está disponível. Os PNDs verticais de GaN em substrato de GaN de baixa densidade de defeito foram processados. No entanto, o arqueamento do wafer continua a ser um problema. Como uma solução promissora, o método ammonotérmico pode alcançar um substrato de GaN com melhor qualidade de epitaxi. Com as autoclaves de alta pressão e amônia supercrítica, o deslocamento da rosca pode ser reduzido significativamente para 10 4 –10 5 cm −2 [43]. Usando o método ammonotérmico, uma baixa resistência de 0,001 Ω cm 2 no substrato de GaN com n altamente dopado -tipo (1 × 10 19 –1 × 10 20 cm −3 ) foi relatado, bem como o BV de 3 kV [44]. No entanto, a desvantagem do método ammonotérmico é a baixa taxa de crescimento de aproximadamente 80–90 μm / dia, uma característica adversa para a produção prática. Melhorar a taxa de crescimento e manter a alta qualidade do material também são direções lucrativas para pesquisas subsequentes.
Além do substrato GaN comercial, alguns substratos também foram investigados por desempenhos distintos, incluindo o plano não-Ga ( c -plane) substratos. Geralmente, um Ga-polar (ou seja, c -plane) substrato é empregado para um dispositivo vertical de GaN. Então, as seguintes camadas epitaxiais mostram um efeito drástico de polarização. No entanto, na direção oposta das contrapartes Ga-polares, as camadas homoepitaxiais ao longo do N A direção polar demonstra propriedades únicas do dispositivo por causa da temperatura de decomposição mais alta e propriedade dependente da polaridade [45, 46]. Com o N substrato FS-GaN de cristal único polar, um campo elétrico de 2,2 MV / cm sem quaisquer terminações de borda foi alcançado, bem como um BV de 2,4 kV com N 2 O tratamento de plasma de superfície e placa de campo (FP) [46, 47]. Como outro substrato GaN especial, o m -plano também atrai grande atenção dada sua propriedade não polar para a qual o Ga:N foi 1:1 no m - plano em relação a apenas Ga no c -polar e apenas N no N -substratos polares. Com este substrato GaN apolar, as características dos PNDs foram relatadas com o campo elétrico crítico de 2,0 MV / cm e alta relação on / off sem FP ou terminação de borda [48].
Técnicas epitaxiais N-GaN
Antes da existência de substratos de GaN condutores de alta qualidade, os PNDs de GaN eram fabricados principalmente em substratos estranhos, incluindo Si, SiC e safira. Portanto, a estrutura dos dispositivos sempre se limitou aos laterais. Um método baseado na estrutura lateral foi proposto para melhorar a qualidade epitaxial. Dada a luxação de segmentação baixa (TD) na região da janela em dispositivos laterais, a camada epitaxial de GaN crescida lateralmente através da máscara pode atingir uma densidade TD muito mais baixa. Assim, o supercrescimento epitaxial lateral foi realizado para fazer crescer a camada epitaxial de GaN em um substrato de safira para DPNs laterais. A corrente de fuga reversa foi suprimida em três ordens de magnitude [49].
Com o desenvolvimento da tecnologia epitaxial, substratos de GaN de cristal único de alta qualidade com baixas densidades de deslocamento de 3 × 10 –6 cm −2 tornou-se disponível e os PNDs de GaN foram fabricados em substratos de GaN. Combinado com camadas epitaxiais superiores por MOCVD crescido, os dispositivos mostram uma corrente de fuga baixa e alta BV de 600 V a 4 kV correspondendo a espessura de deriva de 6 a 40 μm [16, 50]. Com relação ao dispositivo no substrato de safira, corrente de fuga reversa e BV melhorou significativamente [51].
Com o substrato GaN nativo, nenhuma camada de buffer especial geralmente ocorre na estrutura epitaxial PND como aquela em um substrato estranho. O efeito da camada tampão no PND no substrato GaN foi investigado como referência. A existência de uma camada tampão significa que a camada de deriva tem menor densidade de defeitos. Enquanto isso, um BV maior pode ser obtido com uma camada de deriva mais fina, mas com uma camada tampão mais espessa. A corrente de fuga reversa do dispositivo também foi melhorada. Esses parâmetros do dispositivo exibem uma forte relação com a espessura da camada tampão, que tem um leve efeito nas características dianteiras do dispositivo [52].
As camadas epitaxiais superiores são depositadas pelo MOCVD, epitaxia de fase de vapor orgânico metálico (MOVPE) e MBE, conforme discutido nesta parte. A estrutura epitaxial dos PNDs inclui um n altamente dopado + Camada -GaN e uma camada de deriva de n - -GaN entre o substrato e p -GaN (Fig. 3). O altamente dopado n + A camada -GaN atua como uma camada de transição no substrato GaN condutor em alguns relatórios.
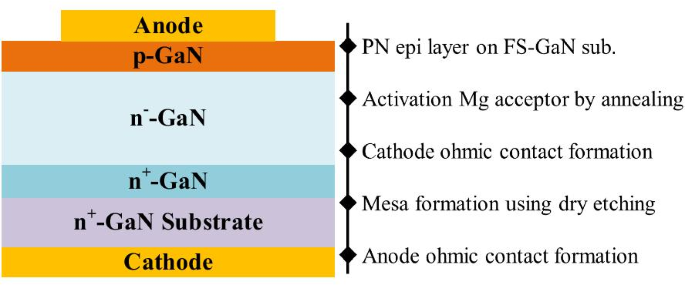
Estrutura esquemática e processo de fabricação de PND vertical de GaN
Em geral, o BV determina os cenários de aplicação dos dispositivos. Por exemplo, quanto maior o BV para um dispositivo SiC em relação àquele com GaN permite que o dispositivo SiC seja utilizado em aplicações de alta potência e alta tensão, como veículos elétricos e trens-bala (Fig. 1). Da mesma forma, os diodos PN são normalmente aplicados em tensões mais altas em relação ao diodo Schottky e HEMTs. Em PNDs, o BV é realizado principalmente pela camada de deriva (levemente dopada n - Camada -GaN) com o alargamento da região de depleção (conforme representado na Eq. 1 com tensão aplicada V para o qual V é positivo / negativo para polarização direta / reversa quando o dispositivo está sob polarização reversa. Além disso, o colapso ocorre com novo aumento no viés reverso.
$$ {W _ {\ text {D}}} =\ sqrt {\ frac {{2 {\ varepsilon _ {\ text {s}}} \ left ({{V _ {{\ text {bi}}}} - V } \ right)}} {q} \ frac {{{N _ {\ text {A}}} + {N _ {\ text {D}}}}} {{{N _ {\ text {A}}} {N_ {\ text {D}}}}}} $$ (1)
onde S , q , V bi , N D , e N A são a área da junção, carga eletrônica, potencial embutido, concentração do doador e concentração do aceitador, respectivamente [53].
De acordo com a largura de depleção, os dispositivos podem ser divididos em não perfurantes [ W D > W Dm ( W Dm :largura máxima da camada de depleção)] e punção ( W D < W Dm ) Dados os problemas de estrutura epitaxia e borda, a maioria dos dispositivos verticais de GaN se enquadram no tipo de punção, ou seja, suas regiões de depleção se expandem além de todo o n - Camada -GaN e alcance a n + Substrato -GaN antes da decomposição.
Além disso, conforme descrito na Eq. (2), o BV pode ser aprimorado aumentando a espessura e diminuindo o n -tipo concentração de dopagem da camada de deriva.
$$ {\ text {BV}} ={E _ {\ text {C}}} t - \ frac {{q {N _ {\ text {D}}} {t ^ 2}}} {{2 {\ varepsilon_0 } {\ varepsilon _ {\ text {r}}}}} $$ (2)
onde E C , q , t , N D e ε r são o campo elétrico crítico, carga de elétrons, n - - Espessura da camada de GaN, concentração líquida de portador do n - Camada -GaN e permissividade do semicondutor, respectivamente [54]. Felizmente, a experiência indica que uma camada de deriva com espessura mais espessa e menor dopagem contribui apenas para um ligeiro aumento da resistência no estado na condução direta.
Comparado com o aprimoramento do BV aumentando a espessura da camada de deriva, diminuindo o n -tipo concentração de doping no n - A camada -GaN é atualmente difícil, por causa das altas concentrações de fundo, incluindo aquelas de Si, O e assim por diante. Para maior diminuição da concentração de dopagem no n - Camada -GaN, a concentração de dopagem não intencional é investigada. Muitos grupos de pesquisa introduziram um i-GaN nominal aproximado de 10 15 –10 16 cm - 3 entrando em contato com p -GaN para formar o p - i - n estrutura para melhorar o BV dos diodos [55].
Certamente, a pré-condição dessas medidas é uma alta qualidade epitaxial da camada de deriva, porque os TDs podem aumentar o vazamento de estado desligado e degradar o BV propriedades [56].
Para melhorar ainda mais a qualidade epitaxial da camada de deriva em PNDs verticais de GaN, o crescimento por MBE foi investigado no substrato de GaN. Uma corrente de fuga de menos de 3 nA / cm 2 e campo elétrico de 3,1 MV / cm foram obtidos pela densidade de deslocamento muito baixa. Os desempenhos de decomposição quase ideais indicam que o MBE é um método eficaz para o crescimento de camadas epitaxiais em PNDs verticais de GaN [56]. No entanto, semelhante ao crescimento ammonotérmico, a taxa epitaxial é outra desvantagem.
P-GaN Epitaxy
P-GaN, um componente importante em PNDs verticais de GaN, foi relatado em 1989 desde o aparecimento de GaN por HVPE em 1969 [57, 58]. Foi utilizado pela primeira vez para obter LED azul. Então, o p -GaN foi gradualmente empregado no campo de dispositivos elétricos, como dispositivos normalmente desligados e PNDs. Em PNDs GaN verticais, o p -GaN constitui luz (cerca de 10 19 cm −3 ) e pesado (≥ 10 20 cm −3 ) concentração de dopagem, que corresponde à formação de uma camada de junção PN com a camada de deriva e facilitando os contatos ôhmicos como o eletrodo anódico.
Geralmente, o crescimento epitaxial de um p -GaN é fabricado por MOCVD a uma temperatura de cerca de 1000 ° C e adota o Mg 2+ como aceitador. Então, o p crescido A camada -GaN deve ser ativada em altas temperaturas de 700–800 ° C em N 2 ambiente ou 400 ° C em O 2 ambiente, facilitando assim uma concentração de furo relativamente alta [59,60,61]. No entanto, a alta energia de ionização de 150-200 meV da ligação Mg-H significa um p Taxa de ativação de -GaN de apenas 1–3%. Uma baixa taxa de ativação também está relacionada à temperatura. Os dopantes de Mg podem ser re-passivados em altas temperaturas de ≥ 600 ° C em NH 3 ou hidrogênio ambiente [62]. Para melhorar a concentração do orifício, apenas aumentar a concentração de dopagem não é viável porque uma concentração de dopagem mais alta no p -GaN pode levar a uma deterioração da qualidade cristalina da camada e reduzir a densidade do orifício por meio de um efeito de autocompensação [63]. No momento, um pico de densidade de orifício geralmente pode ser alcançado em uma concentração de aceitador de aproximadamente 3 × 10 19 cm −3 [64]. Embora sejam alguns problemas para p -GaN, relatórios de investigação relacionados não são muitos. Isso pode ser atribuído a duas razões. Uma são as limitações das propriedades intrínsecas do material e do equipamento epitaxial. Outra é que o presente p -GaN também pode obter desempenho comparativo do dispositivo.
No entanto, a otimização da condição de crescimento e o novo processo epitaxial ainda estão sendo investigados. Por exemplo, em 2017, o crescimento não ativado p -GaN por MBE foi proposto e tem uma vantagem sobre MOCVD. Com o ambiente de baixo crescimento de hidrogênio, um BV de 1,1 kV e fator de idealidade de 2,5 foram alcançados pelos PNDs GaN verticais fabricados [65]. Outro p interessante O método de fabricação -GaN é a implantação de íons Mg com um processo de recozimento de ultra-alta pressão (UHPA). Os resultados revelam que uma alta taxa de ativação de 70% e mobilidade do orifício de 24,1 cm 2 V −1 s −1 foram alcançados com um recozimento pós-implantação na temperatura de 1573–1753 K em N 2 pressão de 1 GPa. Este resultado é comparável ao do crescimento de epitaxia por MOCVD [66].
Em conclusão, para substrato, o substrato GaN comercial de baixo defeito está agora disponível. Enquanto isso, a tecnologia epitaxial ainda está em desenvolvimento, uma situação que afeta fortemente o desempenho do dispositivo. Em comparação com o MOCVD, o MBE pode alcançar excelente qualidade epitaxial, resultando em ótimo desempenho do dispositivo sem quaisquer terminações nas bordas. No entanto, sua taxa de crescimento lento e alto custo tornam o MBE impróprio para produtividade em grande escala. O crescimento de epitaxia por MOCVD ainda é o principal método produtivo na prática. Portanto, melhorar a qualidade das camadas epitaxiais cultivadas por MOCVD é uma questão urgente, que levaria um tempo considerável. Portanto, projetos ou medidas de estrutura de dispositivos avançados são propostos para um ótimo desempenho neste estágio.
Técnicas de terminação de borda
Para PNDs GaN verticais, BV é um parâmetro importante. Quase todas as investigações em PNDs GaN verticais são centradas em melhorar a tensão de suporte no reverso (ou seja, BV ) However, due to the electric field crowding at the edge of PN junction, the depletion layer edge, or the electrode edge, premature breakdown often occurs. Therefore, to reduce the electric field crowding of the device, advanced device structure designs (i.e., edge termination techniques) are developed. Varied edge termination techniques have now been adopted to relax the electric field crowding at the edge of GaN PNDs for a higher BV . These techniques include mainly the field plate (FP), ion implantation and plasma treatment, and mesa etching in varied angle or steps and guard rings (GRs) [49, 67,68,69]. These features are discussed in this section.
Metal Field Plates
The FP has been widely utilized in GaN-based devices for transferring the peak electric field far from the edge of the gate, anode, or junction. This method has an identical feature to relax the intensity of the electric field at the PN edge under reverse bias. Moreover, the low leakage current and high breakdown voltage under reverse voltage can be achieved by using FP termination, which has a relatively simple fabricating process as well.
The merits of the FP structure include a simple fabrication process and compatibility with the device process. Simultaneously, the dielectric layer of FP is also the passivation layer of the device. As the earliest and most widely used edge termination for vertical GaN PNDs, the non-extended FP termination was initially used, as shown in Fig. 4a. For fabricating the FP structure, mesa structures were processed by inductively coupled plasma (ICP) dry etching. Then, to suppress the parasitic leakage currents from plasma damage, a passivation dielectric film was deposited all over the anode electrode and the entire mesa structure [70].
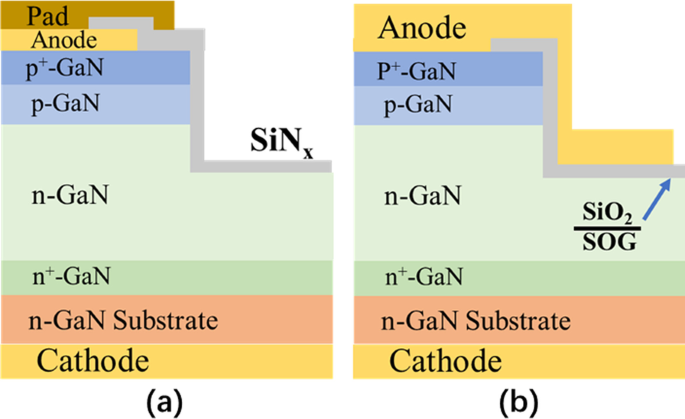
PNDs’ structures with a FP and extended passivation dielectric layer and b extended FP metal and passivation dielectric layer [70, 71]
To furtherly relax the electric field crowding at the periphery of the PN junction edge, the extended metal of the FP was utilized to cover the entire mesa to reduce the reverse leakage current and raise the BV [71]. This optimized FP structure is now widely employed in vertical GaN PNDs fabrications. As shown in Fig. 4b, the BV was raised over 3 kV with an extended FP structure. Meanwhile, the reverse leakage current was also suppressed to a quite low level at revere voltage of 3 kV.
As an essential component of the FP structure, the passivation layer has a considerable impact on the device characteristics. Thus, an appropriated passivation layer is essential. A passivation layer owned high-k permittivity is proposed by simulation, and uniform reverse current flow can be also obtained [50]. According to this theory, vertical GaN PNDs with FP termination using Ga2 O 3 (the dielectric permittivity of 10) as passivation film were reported. The BV had a large improvement from 200 to 550 V, thereby revealing that a high-k permittivity film such as Ga2 O 3 is promising as a passivation film of FP termination in vertical GaN PNDs for raising device characteristics [72]. However, some demerits arise for FP termination. The main issue is the defect during the dielectric layer deposition and interface between the dielectric and GaN, which result in carrier trapping. These would lead to the instability of device performance during long-term use. Therefore, the optimized deposition process of the dielectric layer must be investigated.
Mesa Termination
Mesa etching is an indispensable step to isolate adjacent devices in the fabrication of planar GaN-based devices. Given the simple process, this structure is popular for vertical GaN PND processes. Aside from a uniform electric field at the edge of PN junction, a high BV with nondestructive and avalanche characteristics can be achieved in PNDs. For instance, a simple but deep mesa structure can obtain great performance. As shown in Fig. 5a, with more than 10 µm depth of mesa structure in vertical PNDs, nondestructive BV and avalanche characteristics were confirmed [73].
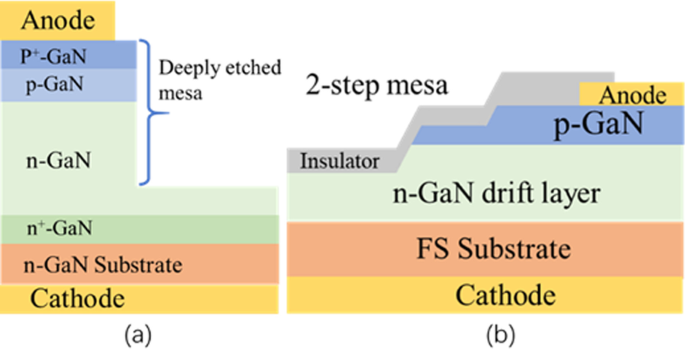
a PNDs with deeply etched mesa structure; b PNDs with two-step mesa [73, 74]
The novel mesa structures are investigated as shown in Fig. 5b. A multi-mesa (two-mesa) structure was adopted in vertical PNDs. With respect to the common single mesa structure, the two-mesa structure can shift the peak electric field from the edge of the PN junction to underneath the thinned p -GaN in the upper mesa because of the total depletion of holes in the thinned p -GaN layer. A high BV of 4.7–4.8 kV with nondestructive feature was successfully achieved by the two-mesa structure. Avalanche capability was obtained without lowering the forward I - V characteristics [74]. On the other hand, the two-mesa structure has the identical function for quasi-vertical PINDs [75]. The BV was enhanced from 665 to 835 V with the low leakage current simultaneously.
Besides the common perpendicular mesa structure, a mesa structure with negative bevel was recently proposed to mitigate the electric field crowding at edge of the PN junction. With the negative bevel mesa, the electric field at the edge has a decreasing trend when the bevel angle θ is lowered from 90˚. The peak electric field would be transferred into device inner. In [76], experimental investigation showed that beveled mesa structure (Fig. 6a) could induce a higher BV over 3 kV and a low leakage current with respect to BV of 3 kV in PNDs with steep mesa when using the same FP structure. Further investigation was performed by simulation using technology computer-aided design (TCAD). In vertical GaN PNDs with beveled mesa (Fig. 6b), the maximum electric field was determined by the acceptor concentration N A in p -GaN, donor concentration N D in n - -GaN drift layer, and θ of the beveled mesa. By theoretical analysis and simulation, the smaller θ could lead to higher E pp (parallel-plane breakdown field). At the same time, a lightly doped p -GaN is beneficial for achieving high BV for a fixed θ of the beveled mesa. Taking θ = 10° as an example, the experimental results support these findings. A parallel-plane breakdown field of 2.86 MV/cm was achieved, and this outcome is consistent with the simulation [77].
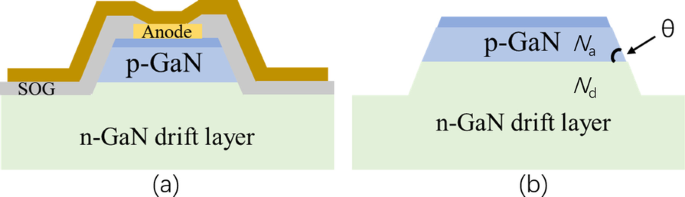
Schematic cross of PND structure with a bevel mesa and FP structure, b PND epitaxial structure is simulated by treating N A , N D e θ as variable [76, 77]
Similar with FP termination, the dry etching and/or insulator (or passivation film) is required in process of edge termination. Thus, the damage from dry etching must be considered and can cause a high reverse leakage current, even the premature breakdown. At the same time, it is a high demand to etched equipment for etched precision, and the etched depth is difficult to control. Meanwhile, the existence of damage generates a more complicated interface state between the insulator and the etched semiconductor, a situation that would affect device reliability. Consequently, reducing or alleviating damage is an inevitable issue. Now, some recipes (e.g., tetramethylammonium hydroxide (TMAH) and post-annealing that have the features of removing the damage by wet etching and repairing dry etching damage, respectively) have been adopted to treat etched surface to improve performance.
Ion Treatment
Ion implantation was employed to alleviate the electric field concentration near the edge. As a relatively simple termination structure, an implantation-based technique was investigated in GaN devices, which includes the compensating species (e.g., O, H, and Zn) or inert species (e.g., Ar, N, He, and Kr) to create deep-level traps in the termination regions [78,79,80,81,82]. Recently, for moderating the occurring of premature breakdown in vertical GaN PNDs, the ion implanted termination (e.g., N, F, Mg, and H) is also utilized. However, the mechanisms of these ion implanted terminations are different.
With respect to vertical GaN SBDs [83], N implantation in vertical GaN PNDs reveals a different mechanism, which entails creating the donor-like defects (N vacancy and N interstitial) to compensate for the p -type dopants. After processing by N implantation as shown in Fig. 7a and b, the conductivity of p -GaN can be reduced or eliminated (insulating) by N implantation [53]. To further improve the BV , a non-fully compensated layer was proposed, that is, a fully compensated layer coupled with a partially compensated counterpart in p -GaN. Thus, a higher BV was expected, and the mechanism was analyzed by simulation [84]. The experimental results show that N implantation with partially compensated p + -GaN could induce a BV of 1.68 kV without compromising the forward characteristics [85].
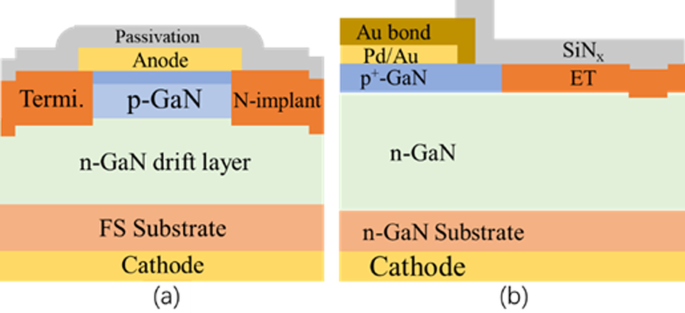
a Cross-sectional plot of the PNDs with N implantation termination, and b N implantation termination with fully and partially compensated [53, 84]
The hydrogen-plasma (H-plasma) edge termination can also reduce p -GaN conductivity, but with another mechanism. H-plasma treatment is an effective passivation method to transform the conductive p -GaN into a highly resistive one because of the strong bond of Mg-H in p -GaN. In contrast to N implantation, the H-plasma treatment is more appropriate for use in vertical GaN PNDs because of the low damage, low temperature, and simple operation involved. As shown in Fig. 8a, the PNDs exhibited an electric field of 3.0 MV/cm with just the H-plasma treatment. Simultaneously, the devices showed comparable forward I - V characteristics and a lower reverse leakage current [86].
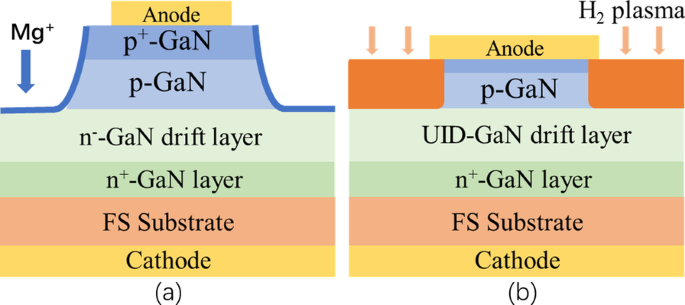
a Schematic view of PND structure by Mg ion treatment; b PNDs with H2 plasma treatment [86, 88]
At the same time, fluorine (F) ion also has the capability of modulating the peak electric field due to the negative fixed charges when the device is under a reverse bias. Nevertheless, if the F implanted edge termination is carried out in vertical GaN PINDs, strict design and structural optimization are needed [87].
In addition to the N, H, and F ion implantation as edge terminations, Mg ion implantation is also an alternative method to convert the surface/interface state, which originates from the damage of ICP dry etching. A novel Mg ion implantation coupled with moat mesa was recently adopted to compensate for the donor-like damage for GaN vertical PNDs (Fig. 8b). Then, a BV of 1.5 kV was achieved with a specific on-state R em of 0.7 mΩ cm 2 [88].
Ion implantation termination is an effective method for a high BV in vertical GaN PNDs. The ion implantation process is also relatively simple. However, crystal damage occurs during high-energy ion implantation. Moreover, post-annealing at high temperature is required in some of the ion implantation terminations for alleviating the crystal damage. The rectangle-shaped ion implantation profile is pursued, so the implantation depth must be controlled exactly. Finally, although the ion implantation process is simple, the equipment needed is costly due to usage of high energy ion.
Guard Rings
The use of floating guard rings (GR) as edge termination to improve BV is an effective method for vertical GaN PNDs, for which the reverse voltage has a voltage drop over the GR to relax the electric field crowding. At the same time, the GR fabrication process does not require a specialized step, which is synchronous with anode metal deposition. For a higher BV , a GR in the FP structure was fabricated in the PNDs (Fig. 9a), in which polyimide was set between the GR and anode portion as resistive device for a further voltage drop. Due to the resistance portion, an incremental 0.2–0.4 kV of BV to a maximum of 5.0 kV was obtained. Compared with normal PNDs without a GR structure, the device with a resistive GR exhibited a similar forward I - V characteristics with R em of 1.25 mΩ cm 2 , but a lower reverse leakage current with BFOM of 20 GW/cm 2 [69].
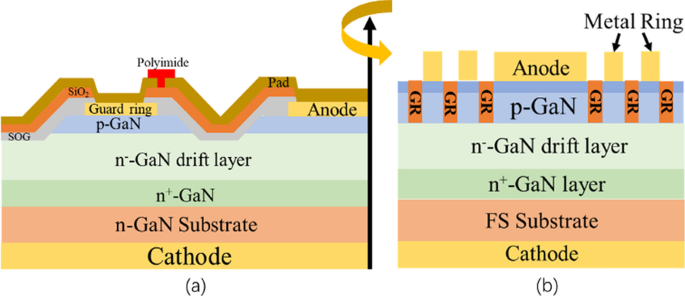
a Vertical GaN PNDs structure with floating GR termination; b PNDs structure with H-implanted GRs [69, 90]
Besides the floating GR, the H-plasma-based GR structure was also applied to form the edge termination. In addition to low damage, the low diffusivity of H-plasma could result in relatively ideal profile in GaN [89]. Owing to passivation effect of the H-plasma on p -GaN, the conductive p -GaN becomes highly resistive, and the GR structure was subsequently formed by the highly resistive p -GaN ring (Fig. 9b). The narrow GR width of 1–2 µm and decreasing spacing were used to improve the BV. GR structures with varied rings were measured. The PNDs with varied rings have similar forward characteristics with around 0.65 mΩ cm 2 and an ideality factor of 1.65 compared with those without GR. More GRs could further relax the electric field at the device edge. Thus, the devices exhibited a higher BV by increasing the number of rings after measurement. Consequently, the PNDs showed a BV of 1.7 kV with the highest electric field of 3.43 MV/cm 10 GRs [90].
The disadvantage of GR is its low area utilization rate, and the GR structure generally requires a large area, which is even bigger than anode. Then, the amount of GR raises the design difficulty such as the width and spacing of the GR. At present, two and more kinds of edge termination are adopted in single vertical GaN PNDs for a higher BV . These edge terminations typically include the FP, bevel mesa, and guard rings due to the relatively simple fabrications. On the other hand, these edge terminations are not meant to introduce the foreign element into the GaN crystal with respect to ion treatment, a feature that is beneficial for device performance. However, the quality of epitaxial layers still occupies a considerable proportion.
Vertical GaN PNDs on Si Substrate
To date, although vertical GaN-on-GaN devices exhibit excellent performance, the high cost and small diameter of GaN substrates still impede their large-scale market applications. Consider to the merit of a large scale and low cost of Si substrate, GaN-on-Si devices have attracted considerable many attentions at this stage.
For the quasi-vertical PND on Si substrate, high-quality buffer is essential. In [91], as shown in Fig. 10a, optimizing the AlN nucleation layer and the succeeding growth process, a GaN drift layer with a low threading dislocation density of 2.95 × 10 8 cm −2 and high electron mobility of 720 cm 2 /Vs was obtained. With the FP structure, the device has a BV of 820 V with R em of 0.33 mΩ cm 2 .
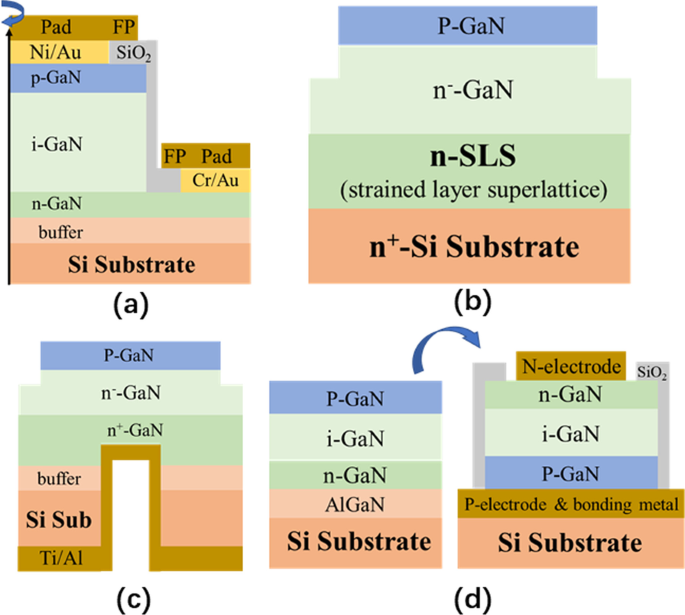
a Quasi-vertical PINDs with FP; b fully vertical PNDs by using the thin AlN and SLS superlattice structure on conductive Si substrate; c PNDs with trenched ohmic contact on back; d PNDs fabricated by layer transfer technology [91,92,93,94]
In addition to the challenge of materials mismatch, the conductive buffer layer and Si substrate are fundamental for fully vertical PNDs on Si substrate. In Fig. 10b, a n + -type Si substrate was first utilized as the cathode of vertical PNDs. Subsequently, the Si-doped thin AlN layer and GaN/AlN strained superlattice layer were employed to facilitate device performance [92]. Vertical PNDs on Si substrate are proposed with FP, and a BV of 288 V is confirmed with a drift layer of 1.5 µm. Moreover, a higher BV of 720 V in PNDs on Si with 5.7 µm drift layer is reported in Fig. 10c [93]. Unlike the conductive Si substrate method, the cathode ohmic on back approach was made by a trench, which reaches the n + -GaN layer through the selective removal of regular Si substrate and buffer layer.
Besides the conductive Si substrate and trenched ohmic contact on back, substrate removal technology is an alternative method to produce vertical GaN PNDs on Si substrates. In Fig. 10d, a layer transfer technology is used to process vertical PINDs on Si substrate. After Si substrate removal, transfer, n -electrode, and sidewall passivation, the devices exhibit a low R em of 3.3 mΩ cm 2 and BV of 350 V [94]. The high BFOM value of 37.0 MV/cm 2 in PINDs demonstrates that substrate removal technology is an effective way for GaN-based PIND fabrication on Si substrates. Relative to other technologies, however, the more complicated fabrication process and higher production cost are issues that must be addressed during the substrate removal part.
As an alternative technical route, PNDs on Si substrates are fabricated with quasi-vertical or vertical device structures. To mitigate the substantial material mismatch between the Si substrate and GaN epitaxial stacks, a more effective epitaxial technology must be investigated. For a higher BV , thicker drift layer is also essential for a higher BV . This fact presents another key issue to investigate because the drift layer thickness on Si substrate is approximately 5 µm.
Future Challenges and Conclusion
Vertical PNDs are essential to simultaneously obtain high current (> 100 A) with high voltages (> 600 V), which can meet the requirements of several applications including electric vehicles and recycled energy processing. Despite the great progress achieved, applications of vertical GaN PNDs remain several barriers such as cost and technical limitations.
For FS-GaN substrate, high epitaxial quality with low threading dislocation has been achieved by a common MOCVD. The small size and high cost of the FS-GaN substrate confine the applications of the vertical GaN PNDs within a narrow range, and the small size also raises the price of GaN. The commercial GaN substrate is only 2-inch and is much smaller than 4–6 inch SiC and 8–12 inch Si substrates. The primary challenge for vertical GaN PNDs is achieving high epitaxial quality, especially the high quality of the p -GaN layer with a high hole concentration. Recently, novel PNDs are proposed through replacing p -GaN with NiOx synthesized by thermal oxidation or sputtering; great performance is also demonstrated as replacement of p -GaN in vertical PND and guard ring in GaN SBD [95,96,97,98].
Vertical GaN PNDs, as one of the most promising power devices, are reviewed and summarized in this study. The recent progresses on vertical GaN PNDs, including comparison of different materials (SiC vs. GaN) and different device structures (SBD versus PND), material epitaxy growth and edge termination techniques (FP, MESA, ion implanted and GR edge terminations), are discussed. Os valores de R em versus BV by varied technologies are plotted in Fig. 11. Aside from the epitaxial technologies, edge termination technologies play a key role for vertical GaN PNDs to achieve high device performance at this stage. Despite its great progress in terms of device performance, the advantages of vertical GaN PNDs remain under-exploited. The characteristics of vertical GaN PNDs could be promoted by optimizing the device structure and epitaxial quality in succeeding studies. Then, commercialized vertical GaN PNDs will soon be available in the future with mature edge termination and epitaxial techniques.
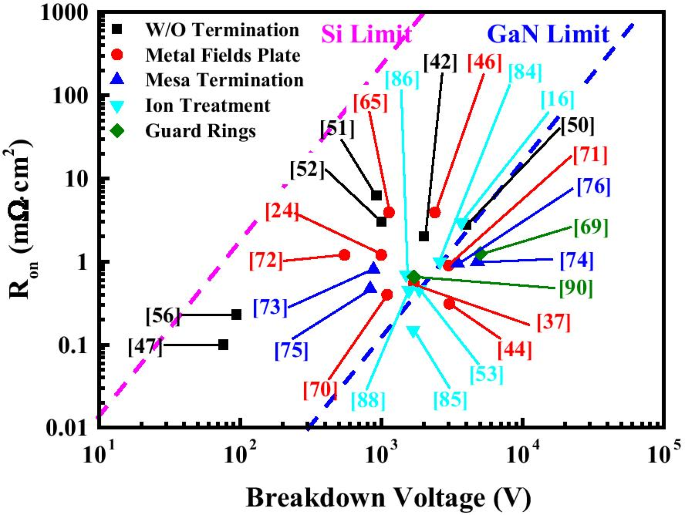
Benchmarking of the R em versus BV of quasi- or full-vertical GaN PNDs
Disponibilidade de dados e materiais
Os conjuntos de dados usados ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente, mediante solicitação razoável.
Abreviações
- GaN:
-
gallium nitride
- SiC:
-
silicon carbon
- PND:
-
PN junction diode
- PIND:
-
P-i-N junction diode
- SBD:
-
Schottky barrier diode
- IGBT:
-
insulated gate bipolar transistors
- BJT:
-
bipolar junction transistor
- MOSFET:
-
metal oxide semiconductor field effect transistor
- BFOM:
-
Baliga’s figure of merit
- HFET:
-
heterostructure field-effect transistor
- JFET:
-
junction field-effect transistor
- 2DEG:
-
two-dimensional electron gas
- BV:
-
breakdown voltage
- FS:
-
free-standing
- MOCVD:
-
metalorganic chemical vapor deposition
- MBE:
-
molecular beam epitaxy
- JBS:
-
junction barrier Schottky
- MPS:
-
merged PN Schottky
- LED:
-
light-emitting diode
- HVPE:
-
hydride vapor phase epitaxy
- FP:
-
field plate
- TD:
-
threading dislocation
- MOVPE:
-
metalorganic vapor phase epitaxy
- HEMT:
-
high electron mobility transistor
- UHPA:
-
ultra-high-pressure annealing
- GR:
-
guard ring
- ICP:
-
inductively coupled plasma
- TCAD:
-
technology computer-aided design
- TMAH:
-
tetramethylammonium hydroxide
Nanomateriais
- Fontes de energia
- Dispositivos de última geração trazem capacidade PoE aprimorada para dispositivos IoT
- Dispositivos aumentam a potência PoE sobre interruptores e cabos existentes
- Nanogerador
- Segurança da IoT:o que podemos aprender com as ameaças recentes
- Engenheiros desenvolvem rádios WiFi de potência ultrabaixa
- Como a energia sem fio está transformando a manufatura
- Alimente vários dispositivos vestíveis sem fio usando uma única fonte
- Uso de tecnologia solar para alimentar dispositivos inteligentes em ambientes internos
- Sistema coleta energia de ondas de rádio para alimentar dispositivos vestíveis



