Um Estudo sobre o Efeito dos Parâmetros Estruturais e Mecanismo Interno de um Transistor de Efeito de Campo S / D Controlado por Porta Bilateral S / D Simétrico e Intercambiável Bidirecional
Resumo
Um transistor de efeito de campo de túnel bidirecional simétrico e intercambiável S / D controlado por porta bilateral (B-TFET) é proposto neste artigo, que mostra a vantagem das características de chaveamento bidirecional e compatibilidade com circuitos integrados CMOS em comparação com o TFET assimétrico convencional. Os efeitos dos parâmetros estruturais, por exemplo, as concentrações de dopagem do N + região e P + região, comprimento do N + região e comprimento da região intrínseca, no desempenho do dispositivo, por exemplo, as características de transferência, I em - eu desligado proporção e oscilação subliminar, e o mecanismo interno são discutidos e explicados em detalhes.
Introdução
O consumo de energia é um dos principais problemas da indústria de circuitos integrados. Se um dispositivo funciona no estado ligado, sua corrente de condução deve atingir um determinado valor crítico; quando a corrente atinge um valor crítico, a tensão da porta correspondente é definida como a tensão limite. Quando o dispositivo está no estado desligado, a tensão da porta correspondente deve ser um valor diferente daquela no estado crítico ligado, que geralmente é chamada de tensão do estado desligado. O conceito de oscilação de sublimiar (SS) é aplicável ao dispositivo que opera entre o estado desligado e o estado crítico ligado, que é igual à mudança na tensão da porta quando a corrente aumenta em uma ordem de magnitude. Quando o dispositivo é bem projetado, o valor crítico da corrente no estado, a tensão limite e a tensão no estado desligado do dispositivo foram determinados; então, um SS menor corresponde a mudanças de corrente mais fortes na área de sublimiar, uma corrente estática menor do dispositivo no estado desligado e menor consumo de energia estática do dispositivo. O SS dos transistores de efeito de campo semicondutor de óxido metálico (MOSFETs), que são as células unitárias básicas amplamente utilizadas em circuitos integrados, é limitado pelo mecanismo físico da corrente gerada enquanto o dispositivo está funcionando e não pode ser inferior ao valor limite de 60 mV / dec. Para superar essa limitação, um transistor de efeito de campo de túnel (PIN ou NIP TFETs) baseado em tecnologia baseada em silício foi proposto nos últimos anos. Um TFET convencional é formado pela adição de uma camada de semicondutores intrínsecos de baixo dopagem entre p - e n -tipo de materiais semicondutores. Comparado com o MOSFET, o TFET tem as vantagens de alta sensibilidade e baixo consumo de energia estática [1]. O TFET é comutado modulando o tunelamento quântico através de uma barreira em vez de modular a emissão termiônica sobre uma barreira como no MOSFET tradicional. Assim, o TFET não é limitado pela cauda térmica de Maxwell-Boltzmann de portadores, que limita o SS do MOSFET a 60 mV / dec à temperatura ambiente [2] (exatamente 63 mV / dec a 300 K). O conceito foi proposto por Chang et al. enquanto trabalhava na IBM [3]. Pela primeira vez, Joerg Appenzeller e seus colegas da IBM demonstraram que o SS do TFET poderia ser inferior a 60 mV / dez. TFET pode ser usado como interruptores eletrônicos com eficiência energética [4], o que rompe o gargalo dos MOSFETs e reduz bastante o consumo de energia do IC. O processo de produção é compatível com MOSFETs. É provável que substitua o transistor MOSFET como a unidade básica dos circuitos integrados de próxima geração. Portanto, TFETs se tornaram um tema quente nos últimos anos [5, 6]. Para melhorar o desempenho dos TFETs em termos de SS, corrente de condução direta e fuga reversa, muitos estudos sobre o projeto de estrutura e otimização de dispositivos TFET foram realizados, os quais se concentram principalmente em melhorar a forma da estrutura do canal do dispositivo e eletrodo de porta [7 , 8,9,10,11,12] e os materiais dielétricos da porta com diferentes funções de trabalho. A análise característica e otimização da estrutura do material dielétrico da porta [13,14,15] e dielétricos da porta com diferentes constantes dielétricas foram realizadas [15,16,17,18,19,20]. Em física de dispositivo, a modelagem analítica de TFETs com a estrutura de porta dupla [21,22,23,24,25,26,27] e estrutura de porta envolvente [28,29,30,31,32,33] também tem foi extensivamente executado. Uma desvantagem dos TFETs baseados em silício em comparação com os MOSFETs é a corrente direta menor, e a magnitude da corrente direta é determinada pela eficiência da geração de corrente de tunelamento. A eficiência de geração de corrente de tunelamento pode ser aumentada reduzindo o gap entre a banda de valência e a banda de condução na região que é usada para gerar a corrente de tunelamento banda a banda ou reduzindo a espessura da região de tunelamento. Portanto, em engenharia de materiais, dispositivos TFET baseados em materiais semicondutores de gap de banda estreita e estruturas de tunelamento de heterojunção foram amplamente desenvolvidos [34,35,36,37,38]. Enquanto isso, a introdução de materiais bidimensionais em TFETs como camadas de tunelamento com espessura ultrafina foi amplamente estudada [39,40,41,42,43,44]. Além disso, alguns artigos relataram a confiabilidade dos TFETs, como o efeito do doping de origem na intercalação de gap de tunelamento [45], o efeito do tunelamento assistido por armadilha nas características subliminares dos TFETs [46] e o efeito de aleatório dopagem na perturbação de desempenho do dispositivo [47]. No entanto, os resultados da pesquisa atual visam principalmente as características básicas de trabalho e princípios de trabalho de TFETs individuais, e o propósito fundamental mais importante da pesquisa e desenvolvimento de TFETs é fornecer uma unidade estrutural básica com menor consumo de energia e substituir a estrutura MOSFET existente . Para atingir este objetivo fundamental, deve ser colocado em um circuito específico para verificar sua compatibilidade com a tecnologia MOSFET. Atualmente, pesquisas sobre a estratégia de projeto de circuitos com base em dispositivos TFET são gradualmente conduzidas, como o circuito de sinal analógico e misto [48,49,50], circuito lógico digital [50, 51], projeto de circuito de gerenciamento de energia [52]. Também existem estudos sobre o projeto de circuitos híbridos baseados em MOSFETs e TFETs [53]. No entanto, os tipos de dopagem da região de origem e região de drenagem são opostos entre si, o que cria uma assimetria de região de origem e região de drenagem. Esta estrutura assimétrica torna impossível substituir completamente o MOSFET com a simetria fonte / dreno.
Pegue o n -tipo TFET como exemplo. O lado com p -tipo de impureza é usado como a região de origem, enquanto o outro lado com n O tipo de impureza é usado como região de drenagem. Quando o dispositivo funciona, uma diferença de potencial positiva deve ser aplicada da região do dreno à região da fonte. Se o eletrodo de origem e o eletrodo de drenagem forem trocados, ou seja, o p -tipo de região de impureza é definido com um potencial mais alto em relação ao n -tipo região de impureza, então a junção PN formada pelo p -tipo região de impureza e n - A região de impureza do tipo estará sempre no estado de polarização positiva, o que causa a falha da função de controle do eletrodo da porta, o TFET estará quase sempre no estado ligado e não pode ser desligado. Em outras palavras, isso causa a falha da função do switch TFET. Em outras palavras, os módulos funcionais do circuito (como portas de transmissão), que devem usar as características de chaveamento bidirecional dos transistores para funcionar normalmente, são difíceis de realizar usando TFETs convencionais com uma estrutura assimétrica de fonte e dreno, a fim de resolver esses problemas , propusemos um dreno de fonte simétrico e TFET bidirecional intercambiável (B-TFET) [54], que mostra a vantagem das características de chaveamento bidirecional e compatibilidade com circuitos integrados CMOS em comparação com os TFETs assimétricos tradicionais. Neste artigo, propomos um B-TFET controlado por porta bilateral modificado com um canal planar. Os efeitos dos principais parâmetros estruturais, como as concentrações de dopagem do N + região e P + região, comprimento do N + região e comprimento da região intrínseca, no desempenho do dispositivo, por exemplo, as características de transferência, I em - eu desligado proporção e oscilação subliminar são explicados em detalhes com base na análise física. Depois disso, esses parâmetros estruturais principais são otimizados.
Métodos
A Figura 1a mostra uma vista superior esquemática do N-TFET Tipo B controlado por porta bilateral com um canal planar. A Figura 1b mostra uma visão cruzada do N-TFET Tipo B controlado por porta bilateral. Ao contrário do TFET convencional, o B-TFET proposto é completamente simétrico, a fonte / dreno intercambiável P + -regiões dopadas ficam em cada lado do corpo de silício, e o eletrodo de porta fica em ambos os lados do corpo de silício. Toda a estrutura do dispositivo é simétrica. O N + -região dopada está na parte central do corpo de silício. L e W são todo o comprimento e toda a largura do dispositivo proposto, respectivamente. L i é o comprimento da região intrínseca; L N + é o comprimento do N + região; L S / D e W S / D são o comprimento e a largura do P + regiões intercambiáveis de fonte / dreno, respectivamente; \ (T \) é a espessura do corpo de silício; \ (t _ {{{\ text {ox}}}} \) é a espessura do óxido de porta; \ (t_ {i} \) é a espessura da região intrínseca do túnel entre a região S / D e o óxido de porta.
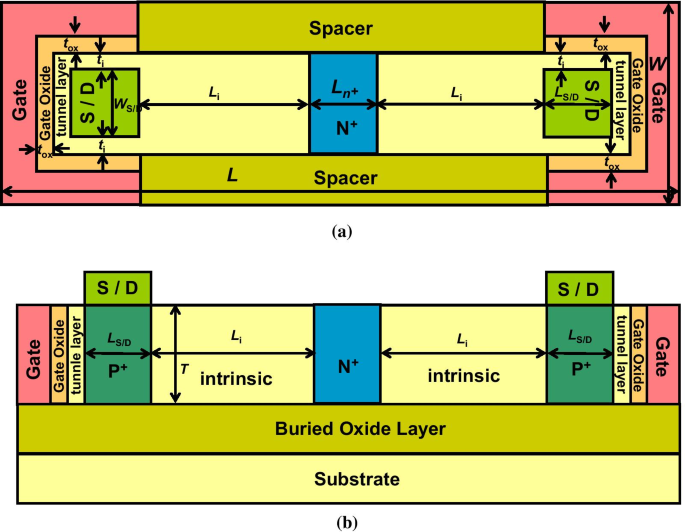
a Vista superior esquemática do N-TFET Tipo B controlado por porta bilateral com canal planar. b Visão cruzada do N-Tipo B-TFET controlado por porta bilateral
Neste artigo, todos os modelos físicos, como o modelo estatístico de Fermi, o modelo de mobilidade CVT, o modelo de recombinação Auger, o modelo de estreitamento de folga de banda e um modelo de tunelamento de banda a banda padrão são ativados. Todos os parâmetros do dispositivo neste documento estão listados na Tabela 1.
Resultados e discussão
A Figura 2a, b mostra a característica de transferência, \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) proporção e SS médio com diferentes \ (N_ { D} \) (\ (10 ^ {18} \) - \ (10 ^ {21} \, {\ text {cm}} ^ {- 3} \)). Na Fig. 2a, \ (N_ {D} \) afeta a intensidade da corrente de fuga dreno-para-fonte com polarização reversa. Com o aumento na concentração de dopagem, a corrente de fuga é significativamente suprimida e a corrente direta não muda significativamente. Na Fig. 2b, o SS e \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) também são afetados por \ (N_ {D} \ ) Com o aumento da concentração de dopagem, porque a corrente de fuga reversa é significativamente suprimida, a corrente no ponto de operação estático diminui, então o SS médio também diminui. Como a corrente direta é muito menos afetada do que o vazamento reverso, a razão \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) aumenta com o aumento na concentração de dopagem. A Figura 2c, d mostra as distribuições potenciais bidimensionais do B-TFET proposto com \ (N_ {D} \) igual a 10 19 cm −3 e 10 21 cm −3 , respectivamente. Quando o eletrodo de porta é polarizado reversamente, um forte campo elétrico será gerado entre o eletrodo de dreno polarizado para frente e o eletrodo de porta polarizado reversamente, o que resulta em um forte tunelamento banda-a-banda próximo à região de drenagem. Entre os pares elétron-buraco gerados resultantes, os elétrons podem fluir diretamente para fora do eletrodo de drenagem, enquanto os buracos da banda de valência devem fluir através do N + região, subsequentemente para a região intrínseca no lado da fonte e ser descarregada pelo eletrodo da fonte para formar a corrente de fuga contínua. Para minimizar a fuga de corrente, os orifícios produzidos pelo tunelamento banda a banda devem ser bloqueados de forma eficaz para que não fluam para fora da região N +. Comparada com a região N + com menor concentração, a região N + com maior concentração forma uma diferença de potencial maior entre a região P + e a região N +, ou seja, o valor potencial na fronteira entre a região intrínseca e a região N + aumentará com o aumento em \ (N_ {D} \) porque a região N + com maior concentração pode produzir uma maior diferença de concentração eletrônica entre a fonte e o dreno. Então, mais elétrons podem ser difundidos da região N + para as regiões intrínsecas em ambos os lados da região N +, o que aumenta a quantidade de carga positiva (composta principalmente de doador) na região N + após a ionização e, consequentemente, aumenta o potencial diferença entre a região P + e a região N +. Precisamente porque a região N + com maior concentração de dopagem tem um potencial mais alto do que os lados da fonte e do dreno após a ionização, os orifícios gerados pelo tunelamento banda a banda perto da região de drenagem podem ser bloqueados de forma mais eficaz, o que diminui mais efetivamente o corrente de fuga.
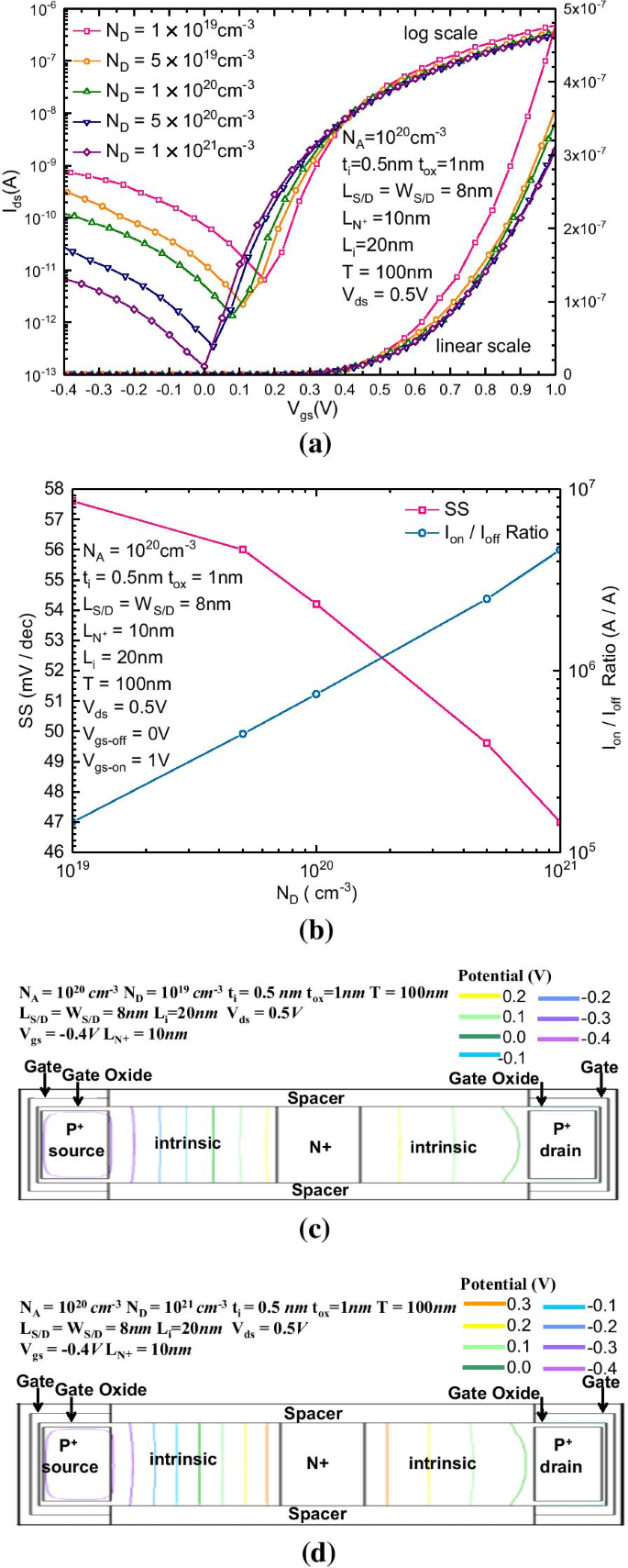
a \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) características de transferência e b variação em SS e a razão \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) do B-TFET proposto com diferentes \ (N_ {D } \); a distribuição de potencial bidimensional com polarização reversa com c N D =10 19 cm −3 e d N D =10 21 cm −3
Além da concentração de dopagem da região N +, outro parâmetro chave da região N +, que pode afetar significativamente a corrente de fuga com polarização reversa, é o comprimento da região N +. A Figura 3a, b mostra as características de transferência \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) do B-TFET proposto com diferentes L N + . A corrente de fuga com polarização reversa diminui amplamente com o aumento de L N + . Como mostra a Fig. 2b, a oscilação do sublimiar e \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) também são afetados por L N + . Com o aumento de L N + , porque a corrente de fuga reversa é significativamente suprimida, a corrente no ponto de operação estático e SS médio também são reduzidos. A corrente direta é muito menos afetada do que o vazamento reverso, e a razão \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) aumenta com o aumento em L N + . A Figura 3c, d mostra a distribuição de concentração de buraco bidimensional do B-TFET proposto com L N + igual a 2 nm e 80 nm, respectivamente. Quando L N + é igual a 2 nm, a concentração mínima do orifício na região N + é maior que 10 17 cm −3 , enquanto quando L N + é igual a 80 nm, a concentração mínima do orifício é inferior a 10 14 cm −3 . O aumento do comprimento da região N + aumenta sua capacidade de impedir que os orifícios passem pela região N +. Como um portador minoritário de não equilíbrio na região N +, quando a região N + é mais longa, mais buracos serão recombinados com elétrons antes de passarem pela região N +, então o aumento no comprimento da região N + também pode formar um corrente de fuga contínua com polarização reversa. O SS médio pode ser reduzido para 40,2 mV / dec, e a relação \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) pode exceder 10 10 .
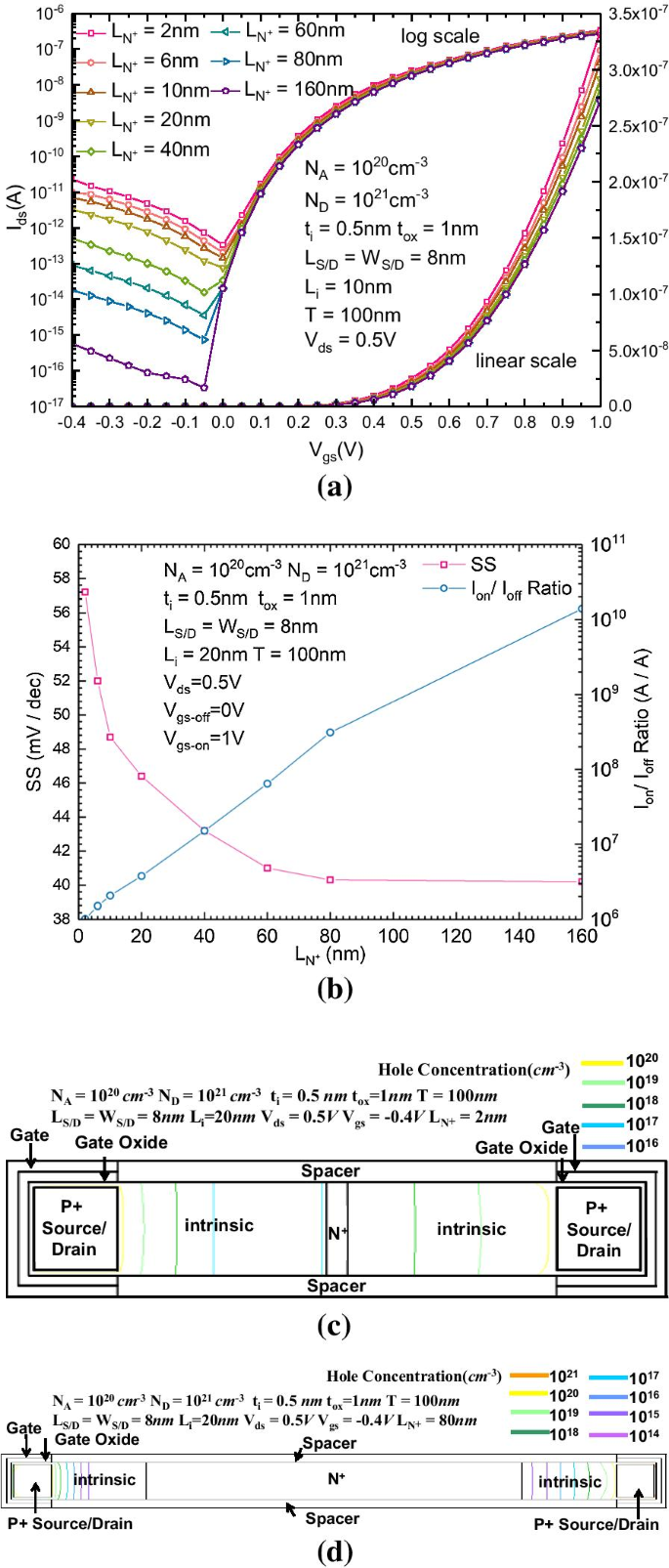
a \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) características; b variação no SS e a proporção \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) do B-TFET proposto com L N + ; Distribuição bidimensional da concentração do buraco do B-TFET proposto sob polarização reversa para L N + igual a (3) 2 nm e (4) 80 nm
A Figura 4a, b mostra as características de transferência \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) e mudanças em SS e \ (I _ {{{ \ text {on}}}} {-} I _ {{{\ text {off}}}} \) proporção do B-TFET proposto com L diferente i , respectivamente. A corrente direta diminui com o aumento de L i porque a resistência da região intrínseca é proporcional ao seu comprimento. Então, para maximizar a corrente direta, o comprimento da região intrínseca deve ser minimizado. No entanto, a diminuição do comprimento da região intrínseca aumenta o campo elétrico na região intrínseca entre a região P + da fonte e a região N +, de modo que a curvatura da banda próxima a esta região é maior do que a região intrínseca próxima ao eletrodo de dreno, o que induz corrente de fuga com polarização mais reversa. A Figura 4c, d mostra a distribuição de potencial com polarização reversa bidimensional do B-TFET proposto para L i igual a 4 nm e 100 nm, respectivamente. Para o mais curto L i (4 nm) caso, o campo elétrico na região intrínseca entre a região P + da fonte e a região N + perto do eletrodo da fonte é muito mais forte do que na região intrínseca entre a região P + do dreno e a região N + perto do eletrodo de drenagem. Então, a corrente de fuga quase permanece constante, o que é independente da mudança na tensão da porta. A Figura 4b mostra que a faixa de valor ideal de L i é aproximadamente 7–10 nm, onde o SS diminui para um valor de vale de 41 mV / dec e o \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}} } \) a proporção aumenta para um valor máximo de quase 10 8 .
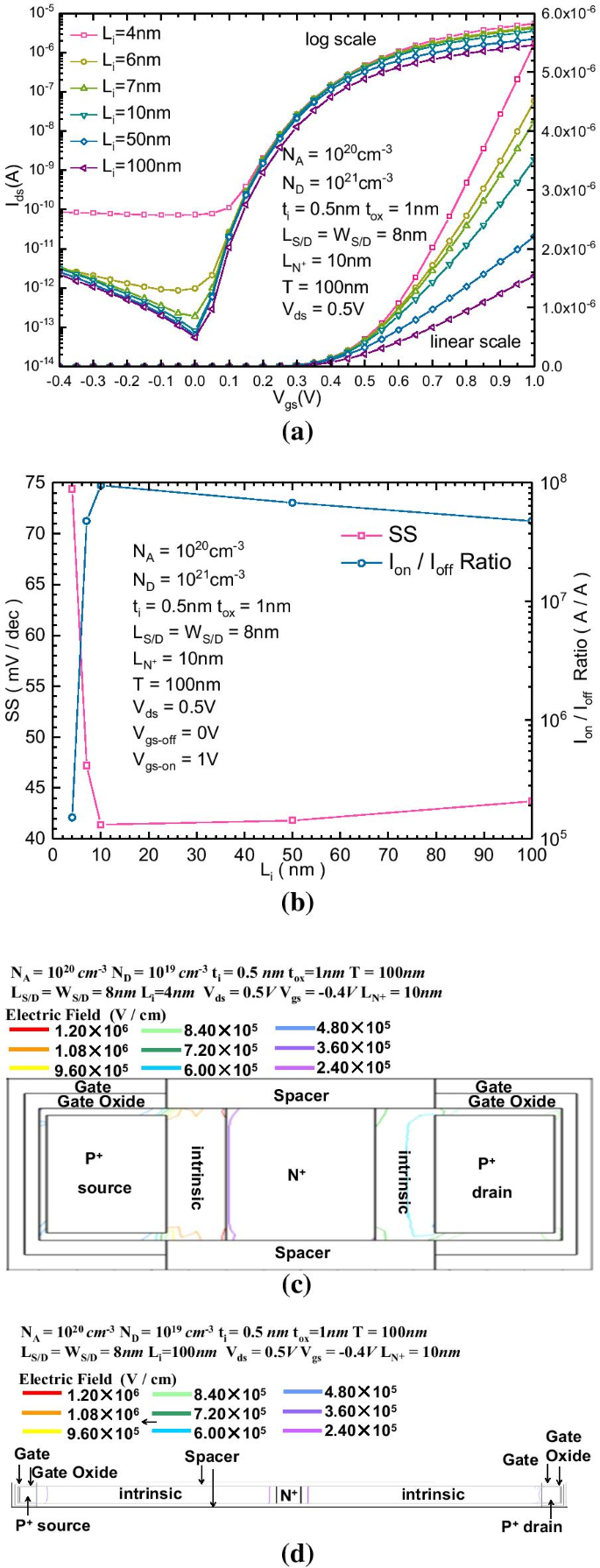
a \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) características de B-TFET e b variação em SS e a razão \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) com diferente \ (L_ {i} \); Distribuição de potencial com polarização reversa bidimensional do B-TFET proposto para L i igual a c 20 nm e d 100 nm
A Figura 5a, b mostra as características de transferência \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {ds}}}} \) e a mudança em SS e \ (I _ {{{ \ text {on}}}} {-} I _ {{{\ text {off}}}} \) proporção do B-TFET proposto com \ (N_ {A} \) diferente. A Figura 5a mostra que ao aumentar a concentração da região dopada com P +, podemos obter menos SS e uma corrente direta maior. A corrente de fuga com polarização reversa não é obviamente afetada pela mudança em \ (N_ {A} \), mas a corrente direta pode ser aumentada com o aumento em \ (N_ {A} \). Na Fig. 5b, a razão SS e \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) pode ser melhorada aumentando \ (N_ {A } \). A Figura 5c, d mostra a distribuição do campo elétrico bidimensional do B-TFET proposto com \ (N_ {A} \) igual a 10 19 cm −3 e 10 21 cm −3 , respectivamente. O aumento em \ (N_ {A} \) aumenta o campo elétrico na região intrínseca do túnel; então, mais pares elétron-buraco podem ser gerados através do tunelamento banda-a-banda, o que aumenta a corrente direta do B-TFET proposto.
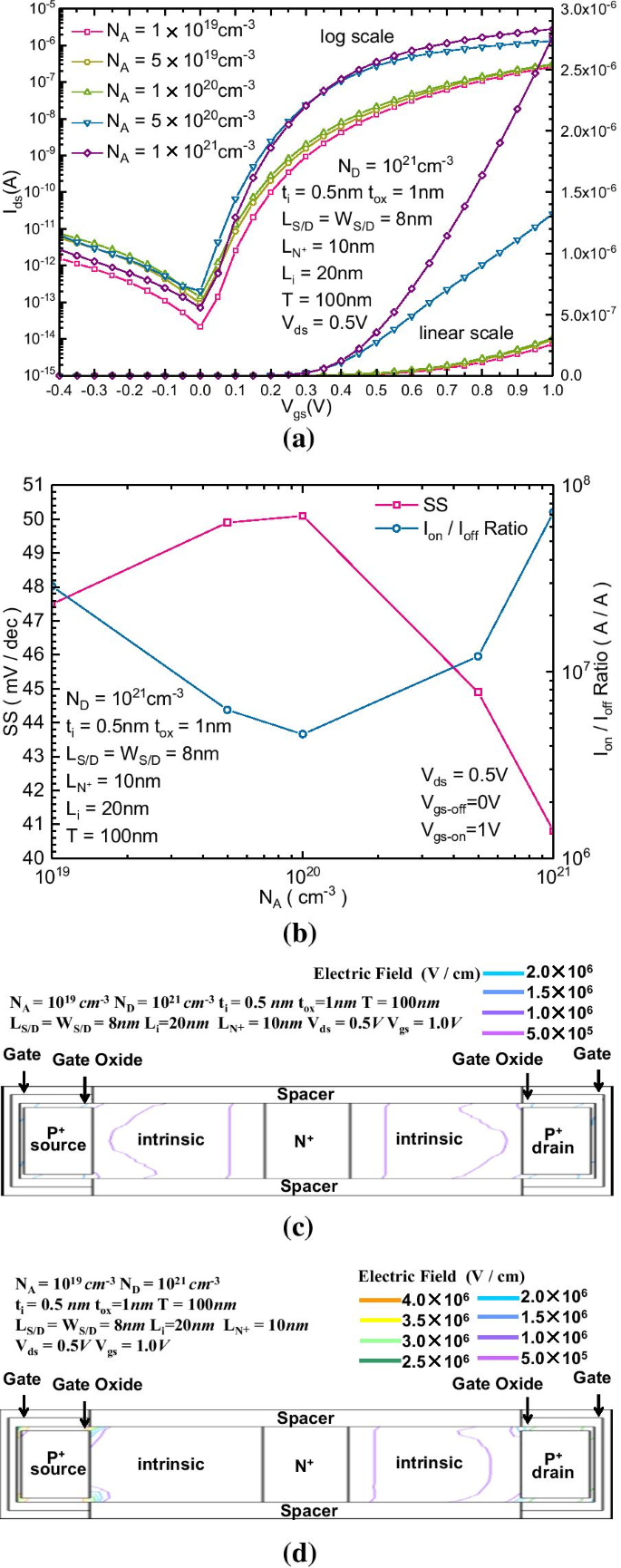
a \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {gs}}}} \) características de transferência, b variação em SS e proporção \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) do B-TFET proposto com diferentes \ (N_ {A} \). Distribuição bidimensional do campo elétrico com polarização reversa do B-TFET proposto para \ (N_ {A} \) igual a (3) 10 19 cm −3 e (4) 10 21 cm −3
De acordo com a discussão acima, ambos \ (N_ {D} \) e \ (N_ {A} \) devem ser ajustados para o valor máximo possível. O intervalo de valor ideal de L i é 7–10 nm. No entanto, há uma compensação entre o consumo de energia estática e L N + . A Figura 6 mostra as características de transferência \ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {ds}}}} \) do B-TFET otimizado com diferentes L N + . L N + pode ser selecionado de acordo com diferentes requisitos de projeto de consumo de energia estática. Como um meio-termo, para garantir que a proporção \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) esteja acima de 10 8 , L N + é recomendado estar acima de 20 nm. A corrente ligada é aumentada para aproximadamente 6 × 10 –6 A, e o SS é reduzido para 38 mV / dec.
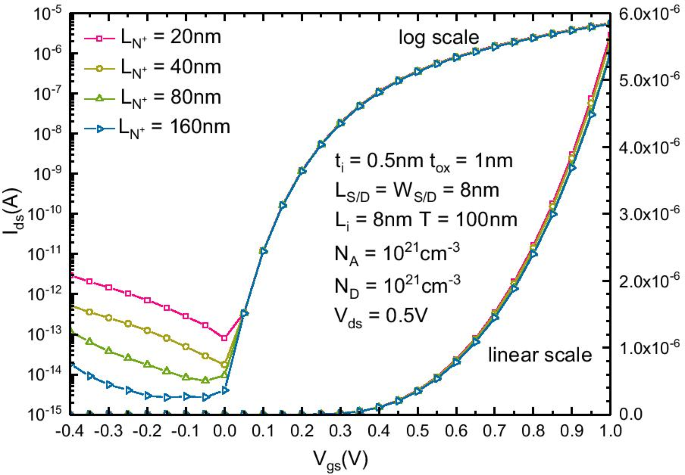
\ (I _ {{{\ text {ds}}}} {-} V _ {{{\ text {ds}}}} \) características de transferência do B-TFET otimizado com diferentes L N +
Conclusões
Neste artigo, são analisados os efeitos dos parâmetros estruturais e do mecanismo interno de um transistor de efeito de campo de tunelamento bidirecional S / D controlado por porta bilateral simétrico e intercambiável. Os efeitos dos parâmetros-chave, como a concentração e o comprimento da região N +, o comprimento da região intrínseca entre as regiões P + e N + e a concentração da região P + foram discutidos em detalhes. Comparado com o TFET convencional, o B-TFET tem a vantagem de uma forte resistência à corrente de fuga com polarização reversa. Posteriormente, pode-se obter um bom desempenho, como um SS médio inferior e uma relação \ (I _ {{{\ text {on}}}} {-} I _ {{{\ text {off}}}} \) superior. Além disso, devido à simetria estrutural e às características de chaveamento bidirecional e intercambiáveis fonte / dreno, é mais compatível com o circuito CMOS.
Disponibilidade de dados e materiais
Incluímos uma declaração de disponibilidade de dados e materiais para nós e em nome de nossos co-autores na seção “Interesses concorrentes”. Todos os dados e materiais disponíveis são trabalhos originais. Todos os dados foram fornecidos claramente no manuscrito, sem dados adicionais e materiais de apoio.
Abreviações
- L :
-
Comprimento total do dispositivo proposto
- W :
-
Toda a largura do dispositivo proposto
- L i :
-
Comprimento da região intrínseca
- L N + :
-
Comprimento do N + região
- L S / D :
-
Comprimento do P + regiões intercambiáveis de fonte / drenagem
- W S / D :
-
Largura do P + regiões intercambiáveis de fonte / drenagem
- \ (T \):
-
Espessura do corpo de silicone
- \ (t _ {{{\ text {ox}}}} \):
-
Espessura do óxido de porta
- \ (t_ {i} \):
-
Espessura da região intrínseca do túnel entre a região S / D e o óxido de porta
- MOSFET:
-
Transistor de efeito de campo semicondutor de óxido de metal
- TFET:
-
Transistor de efeito de campo de túnel
Nanomateriais
- O diodo Shockley
- Estudo de primeiros princípios sobre a estabilidade e imagem STM de Borophene
- Efeito da distribuição de nanopartículas de ouro em TiO2 nas características ópticas e elétricas de células solares sensibilizadas por corante
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- Efeito do tratamento de recozimento in situ na mobilidade e morfologia de transistores de efeito de campo orgânico baseados em TIPS-Pentaceno
- Estudo experimental sobre as características de fluxo e transferência de calor de nanofluidos de TiO2-água em um tubo espiralado
- Matrizes de nanotubos de TiO2:fabricadas por modelo Soft-Hard e a dependência do tamanho do grão do desempenho de emissão de campo
- Estudo sobre a memória de comutação de resistência multinível e fotovoltagem dependente do estado da memória em junções Pt / Nd:SrTiO3
- Projeto e ajuste da função de trabalho do grafeno via tamanho, modificação, defeitos e dopagem:um estudo da teoria do primeiro princípio
- Um estudo de nanofibras de carbono e carbono ativo como supercapacitor simétrico em eletrólito aquoso:um estudo comparativo



