Rompendo a largura do canal Multi-Mesa limitada de HEMTs normalmente fora de GaN por meio da modulação do comprimento do orifício
Resumo
Apresentamos novos transistores de alta mobilidade de elétrons (HEMTs) normalmente fora de GaN que superam as limitações típicas na largura do canal multi-mesa (MMC) por meio da modulação do comprimento do orifício via para regular o efeito da tela de neutralidade de carga. Preparamos HEMTs de GaN de modo de aprimoramento (modo E) com larguras de até 300 nm, com base em um efeito de fixação de superfície aprimorado. HEMTs de GaN de modo E com estruturas e larguras de MMC, bem como comprimentos de orifícios de 100 nm / 2 μm e 300 nm / 6 μm, respectivamente, exibiram tensões de limiar positivas ( V th ) de 0,79 e 0,46 V, respectivamente. As resistências ativas do MMC e das estruturas do comprimento do orifício via foram menores do que os HEMTs de GaN nanofibras de três portas típicas. Além disso, os dispositivos não apenas alcançaram o modo E, mas também melhoraram o desempenho de energia dos HEMTs de GaN e mitigaram efetivamente o efeito térmico do dispositivo. Controlamos o efeito de fixação da superfície da parede lateral do comprimento do orifício para obter os HEMTs de GaN do modo E. Nossas descobertas sugerem que o comprimento do orifício via normalmente fora de HEMTs de GaN tem grande potencial para uso em eletrônica de potência de próxima geração.
Histórico
Nitretos de banda larga III-V são materiais semicondutores promissores para operação em frequência e tensão por causa de suas excelentes propriedades de material, incluindo grandes lacunas de banda, campos elétricos de alta crítica, velocidades de elétrons de alta saturação e altas condutividades [1, 2]. Assim, eles são amplamente utilizados em várias aplicações, incluindo diodos emissores de luz (LED) e transistores [3]. Além disso, as heteroestruturas de nitreto de gálio / nitreto de gálio (AlGaN / GaN) formam gases de elétrons bidimensionais (2DEGs) adequados para o desenvolvimento de dispositivos de alto desempenho, aproveitando a polarização espontânea e piezoelétrica de compostos de nitreto III [4,5 , 6]. A quantidade de um 2DEG é influenciada pela proporção de dopagem induzida por polarização, que afeta diretamente as características do dispositivo [7,8,9]. Embora tenham muitas propriedades atraentes, os transistores de alta mobilidade de elétrons (HEMTs) AlGaN / GaN não encontraram utilidade universal porque suas características eletrônicas podem exigir configurações de circuito complexas para aplicações de circuito digital, de energia, RF e de micro-ondas. Consequentemente, a operação normalmente desligada seria essencial para quaisquer dispositivos semicondutores III-V futuros [10, 11]. Embora algumas técnicas de fabricação especiais tenham sido testadas (por exemplo, o uso de portas recuadas [12,13,14], inserção de camadas de cobertura do tipo p sob a porta [15, 16], estruturas de junção de túnel [17], implantação de íon fluoreto em a barreira sob a porta [18] e a inclusão de camadas de barreira finas de AlGaN com uma porta de metal especial e tratamento de recozimento térmico rápido (RTA) [19]), eles podem piorar o desempenho do dispositivo e causar problemas de estabilidade através de danos materiais induzidos por processamento e efeitos de campo elétrico e térmico aumentados.
Alternativamente, uma equipe da Universidade de Hokkaido descobriu que AlGaN / GaN HEMTs fabricados com nanocanais de fin exibiram uma mudança na tensão de limiar ( V th ) na direção positiva [20, 21]. Um grupo da Universidade Soochow relatou que o valor de V th sofreu uma mudança positiva sistemática quando a largura do nanocanal era inferior a 90 nm [22]. Pesquisadores da Universidade Nacional de Kyungpook consideraram o relaxamento da tensão parcial dos lados dos canais para explicar o comportamento [23]. Uma equipe do Massachusetts Institute of Technology simulou a tensão de limiar após a passivação de superfície de HEMTs baseados em GaN e determinou que os valores positivos ocorreram quando a largura do canal era inferior a 100 nm [24], o resultado de efeitos de parede lateral e aumento da tensão de tração que diminuiu a concentração de elétrons no canal. Estruturas em forma de aleta não apenas mudam a tensão de limiar, mas também melhoram a capacidade de controle da porta, devido à estrutura 3-D, que induz desempenho no estado ligado enquanto melhora as características do estado desligado. A corrente de drenagem máxima normalizada ( I D / mm) em um HEMT AlGaN / GaN tendo uma estrutura em forma de aleta é maior do que em uma estrutura plana correspondente [25]. Embora esses métodos tenham sido usados para fabricar HEMTs de modo E, continua sendo um grande desafio desenvolver transistores de potência de GaN de alto desempenho. Em primeiro lugar, a combinação de uma baixa resistência ( R em ) e uma baixa potência total do dispositivo deve ser alcançada quando a largura do canal é limitada a menos de 100 nm. Embora o valor de R em do canal pode ser diminuído encolhendo o comprimento do normalmente desligado, controlar a corrente de vazamento de drenagem de estado desligado representa outro desafio porque a largura da porta influencia a transcondutância e o vazamento de porta através do espalhamento de campo coulomb de polarização e caminhos de vazamento de porta [26, 27 ] Filmes depositados podem ser usados como dielétricos de porta para melhorar esses problemas [28].
Nesta carta, descrevemos um avanço na limitação de largura de canais de três portas e propomos um método para modular o comprimento do orifício de passagem dos canais. Nosso dispositivo atingiu o modo E com uma largura de estrutura MMC de 300 nm e um comprimento de orifício de passagem de 6 μm e exibiu uma tensão de limite de 0,46 V. Esta abordagem não apenas diminuiu a resistência do dispositivo ( R em ), mas também pode atenuar o efeito de aquecimento Joule. Combinando uma porta tripla 3-D com várias larguras de canal e comprimentos de orifício de passagem, alcançamos normalmente fora de GaN HEMTs com valores positivos de V th de 0,79 e 0,46 V quando a largura do canal / comprimento do orifício de passagem foi de 100 nm / 2 μm e 300 nm / 6 μm, respectivamente.
Métodos
O epi-wafer AlGaN / GaN foi cultivado em um substrato de safira (0001) usando um sistema de deposição de vapor químico orgânico metálico Nippon Sanso SR-2000 (MOCVD). O crescimento da estrutura epitaxial começou com uma camada de nucleação de GaN depositada a 600 ° C. Uma camada tampão de GaN dopada não intencionalmente com 2 μm de espessura, uma camada de barreira AlGaN dopada não intencionalmente com 21,8 nm de espessura com composição nominal de alumínio de 23% e uma camada de capa de GaN de 2 nm de espessura foram então depositadas a 1180 ° C. O processamento do dispositivo foi iniciado usando um sistema de corrosão iônica reativa (RIE) de plasma acoplado indutivamente (ICP) com um BCl 3 / Cl 2 mistura de gás para isolar uma mesa de 130 nm de profundidade e gravar uma estrutura de trincheira periódica. Posteriormente, dois processos foram aplicados para restaurar as facetas cristalinas da região do recesso e das paredes laterais da mesa e diminuir os níveis de defeitos de superfície e danos por bombardeio iônico. O primeiro envolveu o uso de KOH fundido para corrosão química úmida cristalográfica para remover danos de superfície induzidos por corrosão seca e simultaneamente produzir paredes laterais verticais lisas; o segundo envolveu a aplicação de solução de piranha (uma mistura de H 2 SO 4 e H 2 O 2 ) para limpeza de superfícies e remoção de resíduos orgânicos. A fotolitografia convencional com lâmpada de mercúrio foi aplicada para definir o dreno, a fonte, a porta e as almofadas de contato para as medições DC. Contatos ôhmicos para a heterojunção AlGaN / GaN, composta de titânio / alumínio / níquel / ouro (Ti / Al / Ni / Au, 30/120/20/80 nm), foram depositados nas regiões de dreno / fonte através da evaporação do feixe de elétrons e recozimento a 850 ° C por 30 s sob vácuo. Para completar o canal do transistor, um eletrodo de porta foi fabricado através da evaporação de feixe de elétrons de Ni / Au (20/80 nm). A Figura 1 fornece representações esquemáticas da seção transversal da estrutura HEMT, uma vista superior do dispositivo e um diagrama estrutural 3-D do dispositivo. O comprimento do portão ( L g ), Largura da estrutura MMC ( W MMC ), Estrutura MMC através do comprimento do orifício ( L MMC ), e altura da estrutura MMC ( H MMC ) foram 2 μm, 100–500 nm, 1–6 μm e 130 nm, respectivamente. Barbatanas foram conectadas em paralelo. Para aumentar o efeito de fixação da superfície, o GaN HEMT através da estrutura do comprimento do furo não foi submetido à passivação. A Figura 2a apresenta uma imagem de microscopia eletrônica de varredura (MEV) de vista superior da superfície metálica na região da fonte e do dreno. A imagem de microscopia óptica (OM) na Fig. 2b revela portas e canais completos; observar quantos canais existiam no dispositivo foi útil para calcular a corrente real. A superfície parecia rugosa na imagem porque, após o recozimento, os átomos migraram na rede cristalina e o número de deslocamentos diminuiu, diminuindo efetivamente a resistência. A imagem SEM na Fig. 2c confirmou as dimensões do canal.
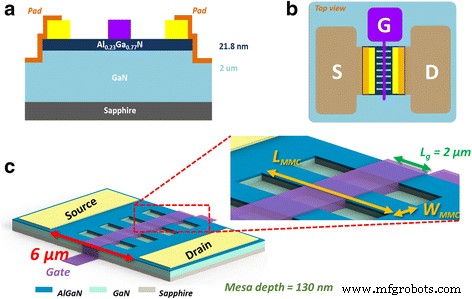
Representações esquemáticas de a a seção transversal da estrutura HEMT, vista de uma direção paralela ao canal do transistor; b a vista superior da estrutura HEMT; e c a estrutura 3-D do HEMT
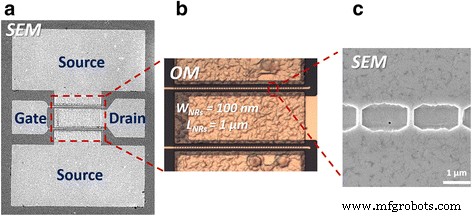
a Imagem SEM de vista superior do dispositivo; b imagem OM de vista superior do dispositivo, revelando uma largura e comprimento de canal de 100 nm e 1 μm, respectivamente; e c imagem SEM de vista superior do canal
Resultados e discussão
Até o momento, a maioria dos desenvolvimentos tecnológicos em transistores de alta tensão GaN foram baseados em AlGaN / GaN HEMTs, que são dispositivos de modo de esgotamento intrinsecamente (modo D) devido ao gás de elétron 2-D induzido por polarização na interface AlGaN-GaN [29]. No entanto, transistores normalmente desligados de GaN serão necessários se a indústria de eletrônica de potência adotar tecnologias GaN amplamente.
O número de ligações pendentes em uma superfície (Al) GaN é de aproximadamente 10 15 cm −2 ; essas ligações pendentes induzem a flexão da banda com superfície esgotada como resultado de um efeito de fixação na superfície. A Figura 3a exibe as áreas de depleção da superfície do canal lateral das portas das paredes laterais na estrutura de três portas. Pesquisadores da Kyungpook National University relataram um fenômeno semelhante [21]. A Figura 3b apresenta o I DS - V G características de transferência de dispositivos com um valor fixo de L MMC de 2 μm e valores de W MMC de 100, 300 e 500 nm. Quando a tensão dreno-fonte era de 8 V, os valores de V th desses dispositivos foram +0,79, −1,32 e −2,18 V, respectivamente. Assim, uma mudança positiva na tensão de limiar ocorreu à medida que os canais se tornaram mais estreitos. Este fenômeno pode ter sido devido ao esgotamento do canal lateral e fixação da superfície do comprimento do orifício de 2 μm da parede lateral no MMC através da estrutura do comprimento do orifício através dos efeitos do esgotamento do canal lateral e dobra da superfície do comprimento do orifício .

a Representação esquemática de AlGaN / GaN HEMTs com canais largos e estreitos. b eu DS - V G características de transferência medidas para um dispositivo com um valor de L MMC de 2 μm e vários valores de W MMC
A Figura 4 exibe o I DS –V G características de transferência de dispositivos com um valor fixo de W MMC de 300 nm e valores de L MMC de 1, 2 e 6 μm. Quando a tensão dreno-fonte era de 8 V, os valores de V th foram -2,12, -1,07 e +0,46 V, respectivamente. O dispositivo atingiu a operação normalmente desligada quando o comprimento e a largura do MMC foram de 6 μm e 300 nm, respectivamente. A modulação do comprimento do orifício de passagem e da largura do canal pode fornecer um dispositivo que exibe a operação normalmente desligada. A Tabela 1 lista as tensões de limite medidas para vários comprimentos de orifício via e larguras de canal multi-mesa. Quando a largura do canal foi fixada em 500 nm e o comprimento do orifício de passagem foi aumentado de 0,8 para 6 μm, o valor de V th aumentou de -2,62 para -1,62 V, a corrente de drenagem de saturação diminuiu de 747 para 98 mA / mm e a transcondutância diminuiu de 270 para 40 mS / mm. Quando a largura do canal foi fixada em 300 nm e o comprimento do orifício de passagem foi aumentado de 0,8 para 6 μm, o valor de V th aumentou de -2,15 para +0,46 V, a corrente de drenagem de saturação diminuiu de 685 para 6,8 mA / mm, e a transcondutância diminuiu de 290 para 7,4 mS / mm. Quando a largura do canal foi fixada em 100 nm e o comprimento do orifício de passagem foi aumentado de 0,8 para 2 μm, o valor de V th aumentou de -0,41 para +0,79 V, a corrente de drenagem de saturação diminuiu de 547 para 53 mA / mm, e a transcondutância diminuiu de 400 para 67 mS / mm. A capacidade de manuseio de corrente do HEMT é fortemente afetada pelas concentrações de portadores [20, 21]. Consequentemente, as correntes de drenagem de saturação e transcondutâncias dos dispositivos foram fortemente afetadas pelos estados de superfície total da parede lateral e o efeito de depleção da superfície do canal tri-gate ao variar as larguras e comprimentos de orifício de passagem dos HEMTs de GaN. Comparado com dispositivos relatados anteriormente [23], nosso dispositivo atingiu um novo marco para baixa resistência, normalmente fora de GaN HEMTs.

eu DS - V G características de transferência de dispositivos com um valor fixo de W MMC de 300 nm e vários valores de L MMC
Conclusões
Preparamos HEMTs de GaN de modo E com uma estrutura de canal multi-mesa (MMC); eles exibiram uma tensão de limiar positiva de 0,46 V quando a largura do canal e o comprimento do orifício de passagem foram 300 nm e 6 μm, respectivamente. Inferimos que os efeitos tanto da depleção do canal lateral quanto da flexão da superfície do comprimento do orifício. Ao conter um tri-gate com uma estrutura de comprimento de buraco de MMC, os novos HEMTs normalmente fora de GaN exibiram resistência muito baixa, mesmo ao aumentar a largura da estrutura de MMC para 300 nm (anteriormente limitado a menos de 100 nm). Além disso, a modulação da estrutura do MMC do comprimento do orifício via fornecido normalmente fora dos HEMTs de GaN, melhorando o desempenho de energia excelente, como resultado do aumento da largura do dispositivo da estrutura do MMC.
Nanomateriais
- Alças de soldagem vs através de pull:Qual é a diferença?
- Dividindo a anatomia de um parafuso
- Modulação por largura de pulso
- Código aberto e a IoT:inovação por meio da colaboração
- Construindo um caminho através do labirinto de segurança IoT
- Rompendo o ciclo da dívida tecnológica da cadeia de suprimentos
- Transformando o processo de aquisição por meio da robótica
- ProtoAbóboras Através dos Anos
- Secadores de ar refrigerados - detalhando o básico
- Detalhando os fundamentos da fabricação de dutos



