Investigação da Faixa de Energia nas Heterojunções de Bissulfeto de Molibdênio e ZrO2
Resumo
O alinhamento da banda de energia no MoS multicamadas 2 / ZrO 2 interface e os efeitos de CHF 3 o tratamento de plasma no deslocamento de banda foi explorado usando espectroscopia de fotoelétrons de raios-x. O deslocamento da banda de valência (VBO) e o deslocamento da banda de condução (CBO) para o MoS 2 / ZrO 2 a amostra é de cerca de 1,87 eV e 2,49 eV, respectivamente. Enquanto o VBO foi ampliado em cerca de 0,75 eV para a amostra com CHF 3 tratamento de plasma, que é atribuído à mudança para cima do nível do núcleo Zr 3d. Os resultados dos cálculos demonstraram que os átomos de F têm fortes interações com os átomos de Zr, e o deslocamento da energia da banda de valência para o orbital d dos átomos de Zr é de cerca de 0,76 eV, o que é consistente com o resultado experimental. Esta descoberta interessante incentiva a aplicação de ZrO 2 como materiais de portão no MoS 2 com base em dispositivos eletrônicos e fornece uma maneira promissora de ajustar o alinhamento da banda.
Introdução
Nas últimas décadas, SiO 2 Os materiais baseados em / Si desempenharam o papel dominante na fabricação de dispositivos eletrônicos, como circuitos lógicos integrados, memória não volátil e assim por diante. No entanto, como o tamanho dos dispositivos diminuiu incessantemente de micrômetros para abaixo de 10 nm, os semicondutores tradicionais têm sido difíceis de satisfazer a necessidade de capacitância específica aprimorada, corrente de fuga de porta baixa e alta mobilidade de portadora. Portanto, a exploração de novos semicondutores como os canais do dispositivo e os óxidos de alto κ como isoladores torna-se difícil. Desde a descoberta do grafeno, a fabricação bem-sucedida de materiais bidimensionais (2D), especialmente os semicondutores com gap adequado, tem fornecido uma maneira promissora de superar essa desvantagem.
Entre os materiais 2D, dissulfeto de molibdênio (MoS 2 ) com propriedades ajustáveis com base na contagem de camadas e na escolha de materiais de substrato tem chamado uma atenção cada vez maior devido não só à sua boa estabilidade química e flexibilidade mecânica, mas também excelentes propriedades ópticas e elétricas [1, 2]. O gap de energia da monocamada MoS 2 é cerca de 1,80 eV enquanto 1,20 eV para bulk. O desempenho promissor dos dispositivos eletrônicos e optoeletrônicos feitos de MoS 2 camadas, como transistores de efeito de campo [3,4,5], sensores [6] e fotodetectores [7], prova ser um potencial substituto de Si na eletrônica convencional e de semicondutores orgânicos em sistemas vestíveis e flexíveis [8, 9,10,11]. Embora MoS de camada única 2 Transistores de efeito de campo (FETs) baseados em campo exibiram excelentes desempenhos com uma alta relação liga / desliga de corrente de cerca de 10 8 e uma oscilação de sublimiar baixo ~ 77 mV / década [3], suas aplicações extensas foram prejudicadas pela síntese de MoS de camada única de alta qualidade de grande área 2 e a estabilidade dos dispositivos [12,13,14]. MoS de múltiplas camadas 2 poderia ser mais atraente devido à alta densidade de estados, que contribui para uma alta corrente de acionamento no limite balístico [15]. Além disso, a mobilidade da portadora de multicamadas MoS 2 pode ser melhorado significativamente por óxidos de alto κ devido aos efeitos de triagem dielétrica [16, 17]. Portanto, é essencial e importante investigar o MoS multicamadas 2 / heterojunções de óxidos de alta-k.
Em dispositivos eletrônicos de heterojunção, as propriedades de transporte de elétrons são precisamente controladas pelos perfis de banda de energia na interface entre o semicondutor e o óxido isolante em termos de deslocamento de banda de valência (VBO) e deslocamento de banda de condução (CBO). O VBO e o CBO devem ser o maior possível para operar como uma barreira a fim de reduzir a corrente de fuga formada pela injeção de buracos e elétrons, especialmente o CBO desempenha um papel fundamental na seleção de óxidos de alto k adequados para uma porta terminal e deve ser pelo menos maior que 1 eV para evitar vazamento de corrente [18,19,20]. Enquanto isso, as cargas de interface localizadas no semicondutor / óxidos impõem um efeito importante na engenharia de banda e precisam ser otimizadas por meio de tecnologia de passivação, como SiH 4 passivação e CHF 3 tratamento. Neste artigo, investigamos o alinhamento da banda de multicamadas MoS 2 / ZrO 2 sistemas, uma vez que a natureza da interface tem uma influência direta nas características dos dispositivos e no efeito de CHF 3 tratamento de plasma no deslocamento de banda no MoS 2 / ZrO 2 interface foi explorada.
Métodos e Experimentos
Nos experimentos, o MoS multicamadas 2 os filmes foram cultivados em SiO 2 / Si substratos por sistemas de deposição química de vapor (CVD) com MoO 3 e pó de enxofre como fontes de Mo e precursores de S, respectivamente. Durante o processo de crescimento, o gás Ar foi usado como gás de arraste e a temperatura de crescimento foi de 800 ° C por 5 min. Então o MoS 2 / ZrO 2 as amostras foram preparadas transferindo o MoS multicamadas de grande área 2 filme no ZrO 2 / Si substratos usando o método de polimetacrilato de metila (PMMA). O ZrO 2 óxido (15 nm) foi depositado em Si a 200 ° C usando o sistema de deposição de camada atômica (BENEQ TFS-200) com o precursor Tetrakis Dimetil Amido Zircônio (TDMAZr) como fonte de zircônio e água (H 2 O) como fonte de oxigênio. A fim de investigar os efeitos do CHF 3 tratamento no alinhamento da banda no MoS 2 / ZrO 2 interfaces, para uma amostra, o ZrO 2 Substrato / Si foi tratado por CHF 3 plasma com potência de RF de cerca de 20 W e taxa de fluxo de cerca de 26 sccm. Enquanto isso, o tempo de tratamento com plasma é de cerca de 60 s e a pressão foi mantida em 1 Pa durante o processo. Consequentemente, a dose de F resultante é de cerca de 2,0 × 10 14 átomos / cm 2 estimado por medições de espectrometria de massa de íons secundários (SIMS). Durante o processo de otimização do tempo de tratamento de plasma, o CHF 3 plasma deteriorou seriamente a qualidade do material ao introduzir flúor difundido em ZrO 2 principalmente quando o tempo foi fixado em 70 s. Enquanto quando o tempo de tratamento com plasma era de 50 s, menor que 60 s, os resultados do SIMS não demonstraram nenhum pico F óbvio na superfície do óxido. Para a outra amostra, sem CHF 3 tratamento com plasma foi implementado. As características Raman das amostras foram obtidas em sistema RENISHAW à temperatura ambiente. A espectroscopia de fotoelétrons de raios-X (XPS) foi medida usando um sistema VG ESCALAB 220i-XL. A energia do fóton da fonte monocromatizada de raios-x Al Kα é de cerca de 1486,6 eV. Durante as medições, a energia de passagem foi ajustada em 20 eV para a obtenção dos espectros de XPS. Além disso, o pico de C 1 s (284,8 eV) foi usado para corrigir a energia de ligação do nível do núcleo a fim de eliminar o efeito de carregamento diferencial da superfície da amostra.
Resultados e discussões
Os espectros Raman do MoS multicamadas conforme crescido e pós-transferido 2 foram caracterizados à temperatura ambiente, conforme mostrado na Fig. 1. Dois modos Raman proeminentes rotulados como A 1 g e \ ({\ mathrm {E}} _ {2g} ^ 1 \) foram observados no espectro. Especificamente, o modo \ ({E} _ {2g} ^ 1 \) é resultado do movimento oposto dos átomos S no plano em relação ao átomo central de Mo na região de frequência mais baixa, enquanto A 1 g é relativo às vibrações fora do plano dos átomos de S na região de alta frequência [21]. Foi observado que o \ ({\ mathrm {E}} _ {2g} ^ 1 \) e A 1 g modos de MoS 2 sofrem um deslocamento para o vermelho e um deslocamento para o azul, respectivamente, da monocamada para as amostras em massa, que é devido à força de restauração de Van der Waals entre camadas diferentes e à influência das mudanças estruturais induzidas pelo empilhamento [21]. Portanto, a diferença de frequência (Δk) entre o A 1 g e os modos \ ({\ mathrm {E}} _ {2g} ^ 1 \) são frequentemente usados para avaliar o número da camada ou espessura do MoS 2 filme. Aqui, Δk do MoS crescido 2 filme tem cerca de 25,32 cm −1 , indicando que o filme tem mais de seis camadas. Além disso, o resultado de microscopia eletrônica de transmissão em seção transversal (TEM) exibido na inserção da Fig. 1 demonstrou o número da camada do MoS cultivado 2 era cerca de 8 correspondendo à espessura de cerca de 4,5 nm. Além disso, a posição de pico Raman e largura total na metade do máximo (FWHM) de MoS 2 é quase o mesmo antes e depois da transferência, indicando que o processo de transferência exerce uma pequena influência na qualidade do material.
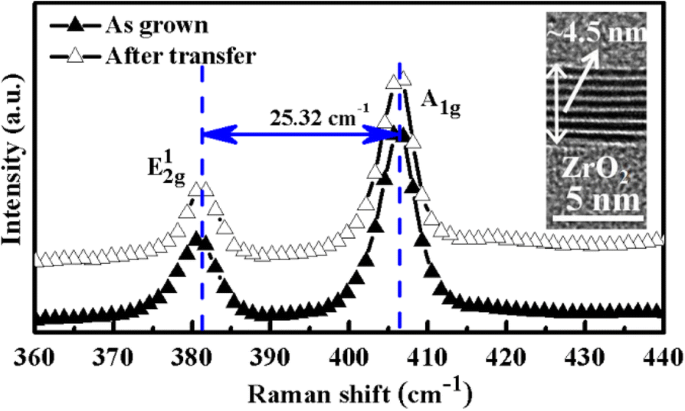
A espectroscopia Raman do MoS ultrafino 2 filme antes e depois da transferência. A inserção é a imagem de microscopia eletrônica de transmissão (TEM) transversal do MoS 2 no ZrO 2 Substrato / Si, que mostra as camadas de MoS 2
XPS foi profundamente provado ser uma maneira eficiente de determinar o deslocamento de banda na interface de heterojunção [22, 23]. No MoS 2 / ZrO 2 heterojunção, o valor VBO foi obtido a partir da mudança dos espectros da banda de valência do ZrO 2 entre aqueles do óxido puro e com MoS 2 material [24]. A Figura 2a, b mostrou o nível de núcleo e espectros de banda de valência de ZrO nu 2 e multilayer-MoS 2 / ZrO 2 , respectivamente. A interceptação entre a linha de base e a inclinação da borda de ataque dá o máximo da banda de valência (VBM) da amostra, onde o nível de Fermi é considerado o nível de referência. Os resultados demonstraram que o VBM de ZrO 2 e multilayer-MoS 2 / ZrO 2 os sistemas são cerca de 1,88 eV e 0,06 eV, respectivamente. Além disso, o espectro de nível de núcleo Zr 3d do ZrO 2 vazio exibe picos de dupleto bem separados referidos como Zr 3d 5/2 e 3d 3/2 com valores de energia de 182,05 eV e 184,45 eV, respectivamente, enquanto os valores correspondentes para o MoS 2 / ZrO 2 amostra são 182,10 eV e 184,50 eV, respectivamente. A mudança de nível central de Zr 3d 5/2 ou 3d 3/2 ~ 0,05 eV está na faixa de erro de medição e processamento de dados. Em comparação com ZrO vazio 2 amostra, multicamadas MoS 2 exerceu poucos efeitos no espectro Zr 3d, conforme mostrado na Fig. 2b. Então, a diferença de energia entre o Zr 3d 5/2 e VBM é 180,17 eV e 182,04 eV para o ZrO vazio 2 amostra e MoS 2 / ZrO 2 amostra, respectivamente. Consequentemente, o valor VBO para o multicamadas-MoS 2 / ZrO 2 interface é de cerca de 1,87 ± 0,05 eV, principalmente resultante da diferença VBM entre o ZrO vazio 2 e MoS 2 / ZrO 2 . Da mesma forma, para o MoS multicamadas 2 / ZrO 2 amostra com CHF 3 tratamento de plasma antes do MoS 2 transferência, o VBM é de cerca de 0,02 eV como mostrado na Fig. 2c, quase idêntico à amostra sem CHF 3 tratamento. No entanto, o espectro Zr 3d se move em direção a uma energia mais alta em cerca de 0,75 eV, Zr 3d 5/2 ~ 182,85 eV e 3d 3/2 ~ 185,25 eV, indicando que o valor VBO foi aumentado em cerca de 0,75 ± 0,04 eV após o condicionamento com plasma. Então, o valor CBO ∆E C pode ser obtido de acordo com a fórmula
$$ \ Delta {\ mathrm {E}} _ {\ mathrm {C}} ={E} _ {G, ZrO2} - {E} _ {G, MoS2} - \ Delta {E} _V. $$ (1)
onde E G , ZrO 2 e E G , MoS 2 são o gap de ZrO 2 e MoS 2 , respectivamente, e ∆E V corresponde ao valor VBO. Normalmente, a energia do band gap do isolador de óxido pode ser obtida a partir do espectro de energia de perda de O 1 s [25]. A Figura 3a mostra o espectro de energia de perda de O 1 s de ZrO 2 , e o E G , ZrO 2 é cerca de 5,56 eV calculado a partir da diferença de energia extrapolando a linha de base da borda linear (535,95 eV) ajustada ao nível de energia do núcleo das ligações Zr-O (530,39 eV). A lacuna de banda de MoS 2 neste trabalho é cerca de 1,2 eV. Portanto, o valor CBO para a amostra sem CHF 3 o tratamento é de cerca de 2,49 eV e 1,74 eV para a amostra com CHF 3 tratamento. Em seguida, as estruturas esquemáticas da engenharia de banda para as amostras sem e com CHF 3 tratamento com plasma são ilustrados na Fig. 3b. Obviamente, o multicamadas-MoS 2 / ZrO 2 sistema tem um alinhamento tipo I, o que facilita os elétrons e buracos confinados no MoS 2 . Enquanto isso, o grande ∆E C e ∆E V para MoS 2 / ZrO 2 interface implica que ZrO 2 poderia ser um bom dielétrico de porta para MoS multicamadas de canal n ou p 2 com base na aplicação de FETs em termos de supressão de corrente de fuga de porta. Além disso, a amostra com tratamento de plasma tem um maior VBO ∆E V (CBO inferior ∆E C ) em comparação com a amostra sem tratamento de plasma, que é melhor na aplicação de FETs de canal p.
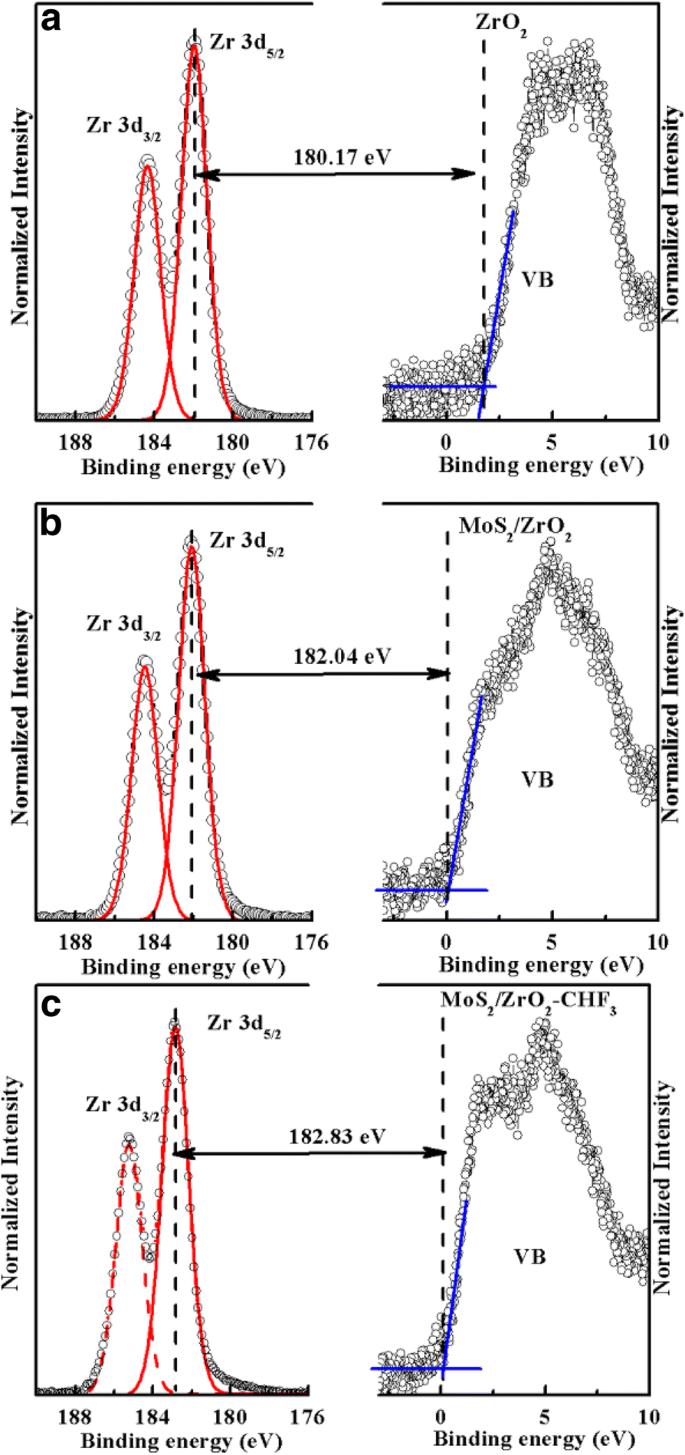
O nível de núcleo Zr 3d e os espectros da banda de valência para a ZrO nua 2 óxido, b multilayer-MoS 2 / ZrO 2 amostra e c CHF 3 MoS multicamadas tratado com plasma 2 / ZrO 2 amostra

a Espectros de perda de energia de fotoelétrons de O 1 s para o ZrO 2 óxido. b A estrutura esquemática do alinhamento da banda de energia no MoS 2 / ZrO 2 interface sem (parte superior) e com (parte inferior) CHF 3 tratamento com plasma. c Os perfis de profundidade SIMS (Si, Zr e F) para a amostra com CHF 3 tratamento de plasma
A mudança do alinhamento da banda no MoS multicamadas 2 / ZrO 2 interface acredita-se estar intimamente relacionada à camada interfacial rica em F induzida pelo CHF 3 tratamento com plasma. A Figura 3c exibiu o resultado SIMS da amostra tratada com plasma para os elementos Zr, F e Si, apresentando pico de íons F óbvio na interface. Enquanto isso, alguns íons F foram difundidos no ZrO 2 subjacente camada devido ao seu pequeno tamanho. No MoS 2 / ZrO 2 interface com CHF 3 No tratamento de plasma, o aumento do VBO (redução do CBO) é atribuído principalmente ao aumento dos níveis de Zr 3d core mostrado na Fig. 2c, indicando que os íons F têm uma forte interação com os átomos de Zr. Em seguida, os efeitos de CHF 3 tratamento nas propriedades eletrônicas do ZrO 2 óxidos foram investigados usando o Material Studio combinado com o Cambridge Sequential Total Energy Package (CASTEP) baseado na teoria do funcional da densidade (DFT) [26]. O gradiente generalizado de aproximação para o potencial de troca e correlação proposto por Perdew-Burk-Ernzerhof (PBE) [27] foi usado para tratar as interações íon-elétron junto com o potencial de onda aumentada do projetor (PAW) [28]. A energia de corte da onda plana é escolhida como sendo 750 eV, e uma malha k de Monkhorst-Pack de 1 × 1 × 1 é usada para amostrar a zona de Brillouin na otimização da estrutura e cálculo da energia total [29]. Todos os átomos foram relaxados em suas posições de equilíbrio até que as mudanças de energia total durante a otimização finalmente convergiram para menos de 10 −6 eV / átomo, a força e a tensão em cada átomo convergiram para 0,003 eV / nm e 0,05 GPa, respectivamente, e o deslocamento foi convergido para 1 × 10 −4 nm. A Figura 4a, b mostra a densidade total e parcial de estados (DOS) para ambos MoS 2 / ZrO 2 amostras, onde zero eV corresponde ao nível de Fermi. Obviamente, os íons F têm uma forte interação com os átomos de Zr, fazendo parte do orbital d dos átomos de Zr que é projetado para a banda de valência se mover para baixo cerca de 0,76 eV de - 0,06 a - 0,82 eV abaixo do nível de Fermi, o que é consistente com o alargamento do desfasamento da faixa de saia ∆E V ~ 0,75 eV. Os átomos F tendem a atrair elétrons devido à grande eletronegatividade (4.0) e tornam-se parcialmente carregados negativamente e, em seguida, formam dipolos com átomos de Zr, eventualmente contribuindo para a mudança do deslocamento de banda. Portanto, a banda muda no MoS 2 / ZrO 2 interface introduzida pelo CHF 3 o tratamento com plasma fornece uma maneira promissora de ajustar o alinhamento da banda nas heterojunções, o que facilita o projeto dos dispositivos relacionados.

A densidade total calculada de estados (TDOS) e densidade parcial de estados (PDOS) para as amostras sem CHF 3 tratamento ( a ) e com CHF 3 tratamento ( b )
Conclusões
Neste artigo, exploramos a engenharia de banda de energia no MoS multicamadas 2 / ZrO 2 interface e investigou os efeitos do CHF 3 tratamento usando espectroscopia de fotoelétrons de raios-x. Os resultados demonstraram que um alinhamento tipo I foi formado no MoS 2 / ZrO 2 interface de heterojunção com CBO e VBO cerca de 2,49 eV e 1,87 eV, respectivamente. Enquanto o CHF 3 o tratamento com plasma aumenta o VBO em cerca de 0,75 ± 0,04 eV principalmente devido ao aumento da energia do nível do núcleo Zr 3d, que é consistente com os resultados do cálculo. Este trabalho prova o grande potencial de aplicações de ZrO alto-κ 2 óxido em multicamadas MoS 2 com base em dispositivos e fornece uma maneira possível de modificar o alinhamento da banda de energia da interface.
Abreviações
- 2D:
-
Bidimensional
- CASTEP:
-
Pacote de energia total sequencial de Cambridge
- CBO:
-
Deslocamento da banda de condução
- CVD:
-
Deposição de vapor químico
- DFT:
-
Teoria da densidade funcional
- DOS:
-
Densidade de estados
- FETs:
-
Transistores de efeito de campo
- FWHM:
-
Largura total pela metade no máximo
- MoS 2 :
-
Dissulfeto de molibdênio
- PAW:
-
Onda aumentada do projetor
- PBE:
-
Perdew-Burk-Ernzerhof
- PMMA:
-
Polimetacrilato de metila
- SIMS:
-
Espectrometria de massa de íon secundário
- TDMAZr:
-
Tetrakis Dimetil Amido Zircônio
- TEM:
-
Microscopia eletrônica de transmissão
- TMDs:
-
Dichalcogenetos de metais de transição
- VBO:
-
Deslocamento da banda de valência
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- ZrO 2 :
-
Dióxido de zircônio
Nanomateriais
- Usos do molibdênio na indústria do aço
- Usos do molibdênio na indústria química
- Quais são os tipos e usos do bastão de molibdênio?
- Aplicações de molibdênio e ligas de molibdênio
- O impacto da condição na eficiência e confiabilidade do motor
- Usando ângulos para melhorar o futuro da eletrônica
- Absorvedor perfeito de banda ultra-estreita e sua aplicação como sensor plasmônico na região visível
- Mudando para verde:prós e contras da energia eólica
- Garantindo a OT no setor de energia e serviços públicos
- A história da serra de fita e suas ideias inovadoras



