HEMTs de canal duplo AlGaN de alto desempenho com densidade de corrente de drenagem aprimorada e alta tensão de ruptura
Resumo
Neste trabalho, a heteroestrutura de canal duplo AlGaN é proposta e desenvolvida por deposição de vapor químico orgânico de metal (MOCVD), e transistores de alta mobilidade de elétrons de canal duplo AlGaN de alto desempenho (HEMTs) são fabricados e investigados. A implementação do recurso de canal duplo melhora efetivamente as propriedades de transporte de heteroestruturas de canal AlGaN. Por um lado, a densidade de gás de elétron bidimensional total (2DEG) é promovida devido aos poços de potencial duplo ao longo da direção vertical e o confinamento de portador aprimorado. Por outro lado, a densidade 2DEG média em cada canal é reduzida, e a mobilidade é elevada devido à supressão do efeito de espalhamento portadora-portadora. Como resultado, a densidade máxima de corrente de drenagem ( I máximo ) de HEMTs de canal duplo AlGaN atinge 473 mA / mm com tensão de porta de 0 V. Além disso, o desempenho de ruptura superior dos HEMTs de canal duplo AlGaN também é demonstrado. Estes resultados não apenas mostram o grande potencial de aplicação de HEMTs de canal duplo AlGaN em eletrônica de potência de microondas, mas também desenvolvem uma nova forma de pensar para o estudo de dispositivos eletrônicos baseados em nitreto do grupo III.
Introdução
Os transistores de alta mobilidade de elétrons (HEMTs) baseados em nitreto do grupo III foram identificados como os candidatos mais promissores para a eletrônica de potência de micro-ondas de próxima geração devido à sua velocidade de comutação rápida e baixa perda de comutação [1,2,3,4,5] . Ultimamente, os HEMTs de nitreto mais avançados alcançaram a comercialização inicial de até 650 V. No entanto, com a maturidade da tecnologia de fabricação de dispositivos, tornou-se cada vez mais difícil aumentar ainda mais as tensões de ruptura ( V b ) e melhorando a confiabilidade do dispositivo em altas temperaturas. Portanto, em vista do maior bandgap e estabilidade térmica superior de AlGaN sobre GaN, os dispositivos de canal AlGaN foram propostos como candidatos promissores para melhorar ainda mais os limites de desempenho de HEMTs de nitreto em aplicações de alta tensão e alta temperatura [6,7,8 , 9,10,11,12,13,14,15].
Nanjo et al. demonstraram o notável aumento da tensão de ruptura de HEMTs de canal AlGaN, e as tensões de ruptura máximas obtidas foram 1650 V no Al 0,53 Ga 0,47 N / Al 0,38 Ga 0,62 N HEMTs com distâncias porta-dreno de 10 μm [6]. Posteriormente, Nanjo et al. promoveu ainda mais a tensão de ruptura do Al 0,40 Ga 0,60 N / Al 0,15 Ga 0,85 N HEMTs a 1700 V [8]. Zhang et al. fabricou os HEMTs do canal AlGaN com um novo contato de dreno ôhmico / Schottky-híbrido, e uma tensão de ruptura recorde de mais de 2200 V foi obtida para os HEMTs do canal AlGaN [11]. Xiao et al. propôs as heteroestruturas do canal AlGaN com alta mobilidade 2DEG de 807 cm 2 / V · s, e os registros da corrente máxima de drenagem e I em / I desligado proporção foi relatada para os HEMTs de canal AlGaN fabricados [14]. Posteriormente, Xiao et al. propôs os HEMTs normalmente desligados com camada de canal de superrede AlGaN pela primeira vez, e os dispositivos fabricados mostraram uma tensão de ruptura acima de 2.000 V, uma alta densidade de corrente de 768 mA / mm e uma tensão de limiar ( V T ) de 1,0 V [15]. Recentemente, Baca et al. avaliou o desempenho de radiofrequência (RF) de HEMTs de canal AlGaN com porta longa de 80 nm. O f T de 28,4 GHz e f MAX de 18,5 GHz foram determinados a partir de medições de parâmetros S de pequenos sinais [12]. Esses resultados ilustram a promessa dos HEMTs de canal AlGaN para aplicações de energia de RF.
No entanto, as limitações dos dispositivos de canal AlGaN relatados anteriormente são igualmente óbvias. Por um lado, devido ao efeito de espalhamento desordenado da liga ternária, a mobilidade bidimensional do gás de elétrons (2DEG) no canal AlGaN é muito menor do que no canal GaN. Como resultado, a capacidade de unidade atual dos dispositivos de canal AlGaN é muito menor do que os dispositivos de canal GaN tradicionais. Por outro lado, a fim de induzir a mesma quantidade de 2DEG no canal AlGaN, o componente AlN na camada de barreira AlGaN deve ser maior do que as heteroestruturas do canal GaN convencionais, o que aumentará as dificuldades no processo de crescimento do material. Essas contradições inibem seriamente a aplicação generalizada de dispositivos de canal AlGaN e as otimizações do layout de heteroestrutura são urgentemente necessárias.
A técnica de canal duplo é uma abordagem intrigante para promover a densidade de portadores de canal de heteroestruturas à base de nitreto sem qualquer impacto adverso na mobilidade do elétron, e a capacidade de condução de corrente dos dispositivos será melhorada [16,17,18]. No entanto, tem havido poucos relatórios sobre as heteroestruturas de canal duplo AlGaN ou dispositivos de elétrons até agora. Neste trabalho, pela primeira vez, a heteroestrutura de canal duplo AlGaN é proposta e desenvolvida para resolver as contradições entre a capacidade de acionamento de corrente e o desempenho de quebra do dispositivo eletrônico à base de nitreto. Além disso, HEMTs de canal duplo de AlGaN de alto desempenho com base na nova heteroestrutura são fabricados e investigados em detalhes.
Métodos
A seção transversal esquemática da heteroestrutura de canal duplo AlGaN é mostrada na Fig. 1a, e os processos de crescimento podem ser resumidos como segue. Em primeiro lugar, a camada tampão de 1600 nm GaN foi cultivada no substrato de safira. Em seguida, a camada tampão AlGaN graduada em 500 nm com composição de AlN aumentando de 0 a 10% foi cultivada, o que foi benéfico para suprimir a formação de canal parasitário. Posteriormente, canal AlGaN inferior de 100 nm, camada intermediária de AlN de 1 nm e barreira AlGaN inferior de 23 nm cresceram sucessivamente, e as composições de AlN nas camadas de canal e barreira são de 10% e 31%, respectivamente. Finalmente, o canal AlGaN superior de 30 nm, camada intermediária de AlN de 1 nm e camadas de barreira AlGaN superior de 23 nm foram cultivadas, para as quais as composições foram as mesmas com as camadas inferiores. O diagrama de banda de condução da heteroestrutura de canal duplo AlGaN pode ser calculado resolvendo de forma autoconsistente a equação unidimensional de Poisson-Schrödinger, que emprega o método das diferenças finitas com um tamanho de malha não uniforme [19]. O diagrama de banda de condução e a distribuição de densidade de elétrons extraída da heteroestrutura de canal duplo AlGaN são ilustrados na Fig. 2a, e os resultados da heteroestrutura de canal único AlGaN também são fornecidos na Fig. 2b para composição. Dois poços de potencial profundo são formados na interface das camadas intermediárias de AlN e Al 0.10 Ga 0,90 Camadas de canal N para a heteroestrutura de canal duplo AlGaN, correspondendo aos canais 2DEG duplos. Além disso, pode-se observar que a densidade 2DEG no canal superior é maior do que no canal inferior, o que pode ser explicado por dois aspectos. Por um lado, a barreira AlGaN inferior atua como barreira posterior do canal superior, o que é benéfico para promover o confinamento 2DEG do canal superior. Por outro lado, a principal fonte de suprimento do canal 2DEG em heteroestruturas de nitreto são os estados de superfície tipo doador [20], que estão mais próximos ao canal superior.
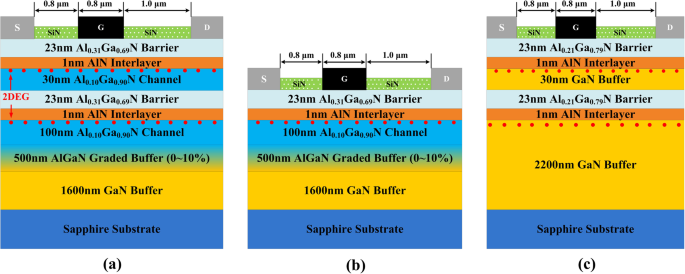
Vista em corte transversal (sem escala) de a Canal duplo AlGaN, b Canal único AlGaN e c Heteroestruturas de canal duplo GaN (HEMTs)
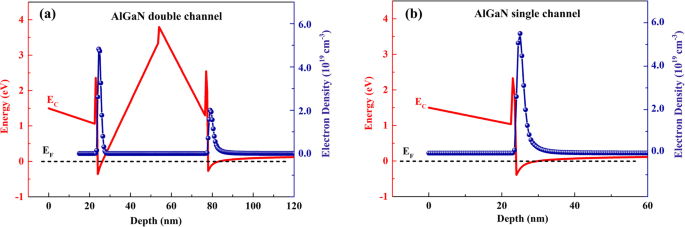
Diagramas de banda de condução e distribuições de densidade de elétrons de canal duplo AlGaN e heteroestruturas de canal único
Resultados e discussão
A Figura 3 exibe o resultado de difração de raios-x de alta resolução (HRXRD) ω-2θ da heteroestrutura de canal duplo AlGaN de reflexão simétrica (0004). A intensidade de difração da camada de nucleação AlN, tampão GaN, tampão graduado AlGaN, canal AlGaN e camadas de barreira AlGaN podem ser observadas. Além disso, a varredura do espectro de 71,0 a 73,2 ° é apresentada na Fig. 2b com uma ampliação para maior clareza, e a função de Lorentz é aplicada para ajustar os multipicos. Os picos de difração do tampão GaN, canal AlGaN e barreira AlGaN localizam-se a 71,6 °, 72,2 ° e 72,8 °, e o tampão graduado AlGaN resulta em uma plataforma entre os picos do tampão GaN e o canal AlGaN. Esses resultados indicam a estrutura multicamadas distinta e o controle sofisticado do processo de crescimento, e as composições de AlN de 10% e 31% no canal e barreira AlGaN podem ser extraídas.

HRXRD (0004) varredura do plano ω-2θ da heteroestrutura de canal duplo AlGaN
A medição de capacitância-tensão (C-V) com configuração de sonda de mercúrio foi realizada para investigar as características de canal duplo da heteroestrutura. Como mostrado na inserção da Fig. 4, duas etapas distintas de capacitância podem ser observadas em torno de - 2,5 V e - 10 V com a tensão aplicada varrida de 0 a - 15 V, correspondendo ao esgotamento de 2DEG em AlN / Al 0,10 Ga 0,90 interfaces. Além disso, as propriedades de distribuição de portadores podem ser extraídas da curva C-V e o resultado é ilustrado na Fig. 4. Dois picos de concentração de portadores localizam-se em 24 e 78 nm com os valores de 6,1 × 10 19 e 2,5 × 10 19 cm −3 , que está de acordo com o resultado calculado conforme mostrado na Fig. 2. Especialmente, nenhum canal de condução parasita pode ser observado até que a profundidade de teste alcance 1 μm, sugerindo a obtenção bem-sucedida de propriedades de canal duplo da heteroestrutura. Além disso, a densidade e a mobilidade da folha 2DEG foram determinadas como 1,3 × 10 13 cm −2 e 1130 cm 2 / V ∙ s pela medição do efeito Hall.
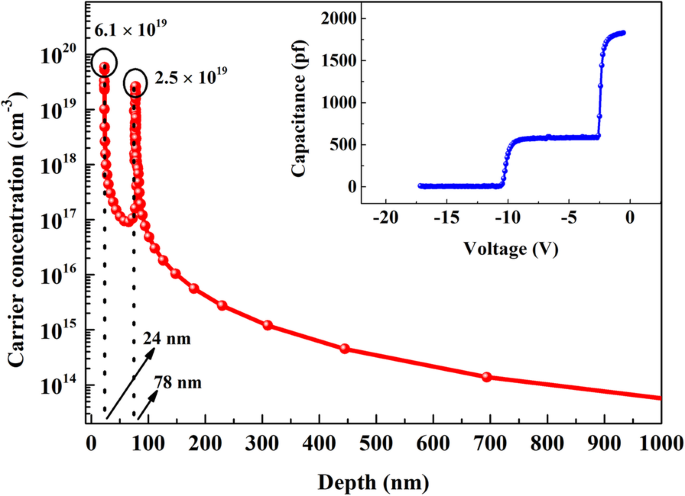
Características C-V e curva de distribuição de elétrons da heteroestrutura de canal duplo AlGaN
O processo de fabricação de HEMTs padrão foi realizado na heteroestrutura de canal duplo AlGaN. O processo de fabricação do dispositivo começou com o contato ôhmico formado com a pilha de metal multicamada Ti / Al / Ni / Au depositada por evaporação de feixe de elétrons, seguido por um recozimento térmico rápido a 850 ° C por 30 s em N 2 atmosfera. Em seguida, o isolamento da mesa foi realizado por Cl 2 / BCl 3 A corrosão por plasma indutivamente acoplada a uma profundidade de 200 nm e a camada de passivação de SiN de 100 nm de espessura foi formada por deposição de vapor químico intensificada por plasma. Depois, uma área de portão com um comprimento ( L G ) de 0,8 μm foi definido por fotolitografia após condicionamento do SiN superior com CF 4 plasma e, em seguida, um eletrodo de porta Schottky de Ni / Au foi depositado. O portal de origem ( L GS ) e dreno de portão ( L GD ) as distâncias são 0,8 e 1 μm, respectivamente. Para fins de comparação, duas amostras de HEMTs adicionais com base no canal único AlGaN convencional e heteroestruturas de canal duplo GaN também foram fabricadas, e os esquemas de seção transversal são mostrados na Fig. 1 b e c. O processo do dispositivo e os parâmetros característicos das amostras HEMTs adicionais são exatamente os mesmos com os HEMTs de canal duplo AlGaN. As propriedades de saída e transferência dos dispositivos foram realizadas com o analisador de parâmetros de semicondutores Keithley 4200 e as características de quebra foram realizadas com o sistema analisador de semicondutores de alta voltagem Agilent B1505A.
As características típicas de saída dos HEMTs são ilustradas na Fig. 5, para as quais o V GS e V DS foram varridos de 0 ~ - 10 V e 0 ~ 10 V. A densidade máxima de corrente de drenagem ( I máximo ) e diferencial na resistência ( R em ) da amostra de canal único AlGaN são 265,3 mA / mm e 27,1 Ω ∙ mm, respectivamente. Esses resultados estão de acordo com os relatórios anteriores, sugerindo a deficiência dos HEMTs do canal AlGaN na capacidade de acionamento atual. Para os HEMTs de canal duplo AlGaN, o I máximo aumenta dramaticamente para 473 mA / mm, que é 1,8 vezes maior do que HEMTs de canal único AlGaN. Atribuímos a melhoria em I máximo às propriedades de transporte superiores da heteroestrutura de canal duplo AlGaN. Por um lado, a estrutura de canal duplo possui dois poços de potencial ao longo da direção vertical, e a capacidade de armazenamento de portador do canal de condução AlGaN é promovida. Por outro lado, embora a densidade total da portadora do canal seja aumentada, a densidade média do elétron em cada canal é reduzida. Como resultado, o efeito de espalhamento portador-portador é suprimido e a mobilidade do elétron do canal é elevada. No entanto, pode-se observar que o R em de HEMTs de canal duplo AlGaN é 12,5 Ω ∙ mm, ainda maior do que o de HEMTs de canal duplo GaN. Este fenômeno está relacionado à grande altura da barreira de contato das camadas de barreira AlGaN, para as quais a composição de AlN é tão alta quanto 31%. Devido ao efeito de autoaquecimento resultante da dissipação de alta potência, o efeito de resistência diferencial negativo pode ser observado para os HEMTs de canal duplo de GaN quando V GS > - 4 V e V DS > 6 V. No entanto, para os HEMTs do canal AlGaN (canal único e canal duplo), esse efeito de resistência diferencial negativo é significativamente suprimido, manifestando o desempenho superior dos HEMTs do canal AlGaN em condições de temperatura elevada.

Características de saída de canal duplo AlGaN, canal único AlGaN e HEMTs de canal duplo GaN
A Figura 6 ilustra as propriedades de transferência típicas dos HEMTs com V DS de 10 V. Os HEMTs de canal único AlGaN exibem uma tensão limite ( V T ) de - 3,8 V, juntamente com uma transcondutância extrínseca de pico inferior ( G m, máx ) de 80,5 mS / mm na vizinhança de V GS =- 1,5 V. Para os HEMTs de canal duplo AlGaN e HEMTs de canal duplo GaN, o V T diminui notavelmente para - 9,2 e - 11,2 V, que é resultado da alta densidade da portadora do canal e da distância relativamente longa do eletrodo da porta ao canal 2DEG inferior. O alto V T pode resultar em alta perda de potência dos dispositivos no estado desligado, e este problema pode ser melhorado otimizando ainda mais os parâmetros de crescimento das estruturas de canal duplo, como a redução adequada da espessura da barreira e das camadas superiores do canal. Especialmente, características de corcunda dupla podem ser observadas nas curvas de transcondutância de HEMTs de canal duplo AlGaN e HEMTs de canal duplo GaN. Para os HEMTs de canal duplo AlGaN, dois valores de pico de 97,9 e 42,5 mS / mm podem ser extraídos em V G =- 1,0 e - 6,0 V. O valor de sub-pico atinge 43% do G m, máx , indicando a capacidade de controle de porta decente e linearidade dos HEMTs de canal duplo AlGaN. Além disso, com base em nossas realizações de pesquisa anteriores [21], os resultados podem ser melhorados modulando os parâmetros da estrutura, como a espessura e composição dos canais duplos de AlGaN, e o efeito de acoplamento entre os canais duplos e a linearidade do dispositivo pode ser melhorada.

Características de transferência de canal duplo AlGaN, canal único AlGaN e HEMTs de canal duplo GaN
As características de decomposição dos HEMTs com base em diferentes heteroestruturas são medidas e mostradas na Fig. 7. O V b é definido pelo critério de corrente de fuga atingindo 5 μA / mm. Pode-se observar que todas as três amostras apresentam características de ruptura rígidas, e o desempenho de ruptura dos HEMTs do canal AlGaN é obviamente melhor do que o dos HEMTs do canal GaN. O V b dos HEMTs de canal duplo AlGaN é 143,5 V, mais de duas vezes maior do que os HEMTs de canal duplo GaN. Pegando o L GD =1 μm em consideração, o V b, padrão (definido por V b / L GD ) é tão alto quanto 143,5 V / μm para os HEMTs de canal duplo AlGaN. O eu máximo e V b, padrão os resultados dos HEMTs de canal duplo AlGaN neste trabalho são comparados com os HEMTs do canal GaN e do canal AlGaN relatados por outros grupos na Fig. 8, e os resultados dos dispositivos de modo de depleção (DM) e modo de realce (EM) são distinguidos. Além disso, os índices centrais dos HEMTs do canal AlGaN (heteroestruturas) em relatórios anteriores e este trabalho estão resumidos na Tabela 1. Como mostrado na Fig. 8, é óbvio que o desempenho de ruptura dos HEMTs do canal AlGaN é geralmente melhor do que o de GaN canal HEMTs, acompanhando a deterioração em I máximo . Visivelmente, o eu máximo do canal duplo AlGaN neste trabalho é comparável à maioria dos resultados dos HEMTs do canal GaN. Além disso, é necessário observar que o eu máximo valor neste trabalho é obtido em V GS =0 V, que é conservador e pode ser melhorado pela aplicação de tensão de porta positiva. Portanto, esses resultados demonstram de forma convincente o enorme potencial dos HEMTs de canal duplo AlGaN em aplicações de dispositivos de energia de micro-ondas.

Características de decomposição do canal duplo AlGaN, canal único AlGaN e HEMTs de canal duplo GaN
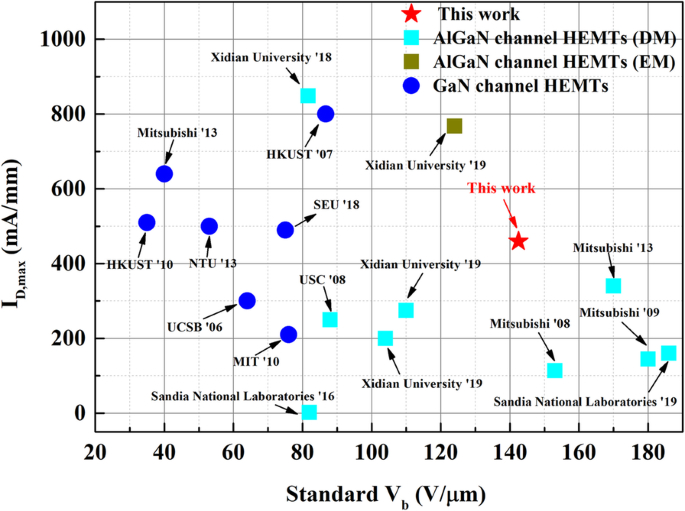
Referência de I máximo e V b, padrão para canal AlGaN e HEMTs de canal GaN
Conclusões
Em resumo, a heteroestrutura de canal duplo AlGaN é proposta para fabricar HEMTs de alto desempenho. As propriedades de transporte superiores da heteroestrutura de canal duplo AlGaN são reveladas, levando à capacidade de acionamento de corrente aprimorada dos HEMTs. Além disso, é demonstrado o excelente desempenho de decomposição dos HEMTs de canal duplo AlGaN. Os resultados neste trabalho mostram o grande potencial dos dispositivos de duplo canal AlGaN em aplicações de energia de micro-ondas no futuro.
Disponibilidade de dados e materiais
Todos os dados gerados ou analisados durante este estudo estão incluídos neste artigo publicado e seus arquivos de informações complementares.
Abreviações
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- HEMTs:
-
Transistores de alta mobilidade de elétrons
- 2DEG:
-
Gás de elétron bidimensional
- I máximo :
-
Densidade máxima de corrente de drenagem
- V b :
-
Queda de tensão
- V T :
-
Tensão de limiar
- RF:
-
Frequência de rádio
- HRXRD:
-
Difração de raios-x de alta resolução
- C-V:
-
Capacitância-tensão
- L G :
-
Comprimento do portão
- L GS :
-
Distância porta-fonte
- L GD :
-
Distância porta-dreno
- R em :
-
Na resistência
- G m :
-
Transcondutância
- DM:
-
Modo de esgotamento
- EM:
-
Modo de aprimoramento
Nanomateriais
- Tensão e corrente
- Tensão e corrente em um circuito prático
- Tensão de ruptura do isolador
- Capacitores e cálculo
- Cálculos de tensão e corrente
- Tensão complexa e cálculos de corrente
- Indutância mútua e operação básica
- O que é manutenção de avarias e como lidar com ela
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Materiais e design de PCB para alta tensão



