Um novo TFET de canal de SiGe sem dopagem e sem dopagem com desempenho aprimorado
Resumo
Neste trabalho, um canal TFET de SiGe em forma de barbatana sem dopagem (DF-TFET) é proposto e estudado. Para formar uma junção de tunelamento de linha sem dopagem de alta eficiência, um canal de SiGe em forma de aleta e uma sobreposição de porta / fonte são induzidas. Através desses métodos, o DF-TFET com alta corrente no estado, relação de comutação de 12 ordens de magnitude e nenhum efeito ambipolar óbvio pode ser obtido. Alto κ o dielétrico de porta de pilha de material é induzido para melhorar o vazamento de estado desligado, as características da interface e a confiabilidade do DF-TFET. Além disso, usando o canal sem dopagem e a estrutura de aleta, as dificuldades do processo de dopagem e a formação de sobreposição de porta assimétrica podem ser resolvidas. Como resultado, a estrutura do DF-TFET pode possuir boa aplicabilidade de fabricação e reduzir notavelmente o espaço ocupado. O mecanismo físico do dispositivo e o efeito dos parâmetros no desempenho são estudados neste trabalho. Finalmente, a corrente no estado ( I LIGADO ) de 58,8 μA / μm, oscilação mínima de subliminar de 2,8 mV / dec (SS min ), oscilação média de sublimiar (SS média ) de 18,2 mV / dec. Com características de capacitância aprimoradas, frequência de corte de 5,04 GHz e produto de ganho de largura de banda de 1,29 GHz podem ser obtidos. Com desempenho e robustez aprimorados, o DF-TFET pode ser um candidato muito atraente para aplicações de ultra-baixo consumo de energia.
Introdução
Com a redução dos MOSFETs, a velocidade de chaveamento, o desempenho de alta frequência, a densidade, o custo e a funcionalidade dos circuitos integrados (ICs) encontram uma grande melhoria [1]. Mas com o progresso contínuo da redução da tensão, o consumo de alta potência inaceitável se torna um problema sério para os ICs modernos [1, 2]. Beneficie-se do mecanismo de tunelamento banda a banda, túnel FET (TFET) com SS íngreme e baixo consumo de energia trazem uma nova solução para este problema e atraiu muita atenção [3,4,5,6,7,8,9 ] Mas as aplicações de TFETs convencionais à base de silício são limitadas pela corrente no estado consideravelmente baixa ( I LIGADO ), baixa taxa de comutação, efeito ambipolar severo e grande oscilação média de subliminar (SS) [1, 7]. Para melhorar o desempenho dos TFETs, aplicações de novas estruturas e novos materiais em TFETs foram propostas nos últimos anos. Por exemplo, TFETs com camada de tunelamento aprimorada são propostos nos últimos anos [5, 10, 11]. Com esta camada, o comprimento efetivo do caminho de tunelamento é reduzido e resulta em um aumento óbvio da taxa de tunelamento. Além disso, TFETs com estrutura de porta melhorada são estudados por muitos grupos de pesquisa [12,13,14,15,16,17,18,19,20]. O conceito de tunelamento de linha é introduzido no L-TFET [17,18,19]. Como resultado, SS avg de 42,8 mV / década e I LIGADO de 10 −6 A / μm pode ser alcançado por L-TFET. Para melhorar ainda mais o desempenho dos TFETs, um TG-TFET melhorado com sobreposição em forma de T e fonte dupla é relatado [20, 21]. Como resultado, o eu LIGADO de TG-TFET atinge 81 μA / μm. Para melhorar ainda mais o desempenho do dispositivo, é necessário um alto requisito no perfil de dopagem da junção de tunelamento. Os engenheiros de fundição precisam criar uma junção abrupta ultra-íngreme com apenas vários nanômetros de espessura, e isso é muito difícil de conseguir. A fim de evitar esta dificuldade, o TFET sem dopagem (DL-TFET) em filme semicondutor intrínseco fino usando o conceito de plasma de carga é relatado por grupos de pesquisa [22, 23]. No DL-TFET, a dificuldade de fabricação pode ser reduzida significativamente removendo a junção abrupta ultra-íngreme. A degradação do desempenho induzida por flutuações aleatórias de dopante pode ser evitada. Além disso, a fabricação do DL-TFET não exige altos orçamentos térmicos para a criação da fonte e drenagem, o que abre a possibilidade de realizar TFETs em outros substratos, como silício monocristalino sobre vidro. Como resultado, o SS do DL-TFET foi muito melhorado. No entanto, devido à baixa eficiência da junção de tunelamento de ponto, a corrente do DL-TFET não é alta o suficiente, o que é difícil de atender aos requisitos cada vez maiores das aplicações de circuitos modernos.
Neste artigo, um novo TFET de canal de SiGe em forma de barbatana sem dopagem (DF-TFET) é proposto e estudado. Para melhorar o desempenho e a robustez do dispositivo, junção de tunelamento de linha e material SiGe são aplicados ao DF-TFET. Enquanto isso, a função de trabalho do portão é otimizada para melhorar ainda mais a taxa de tunelamento. Além disso, o canal sem dopagem reduziu a dificuldade do processo de fabricação, enquanto a estrutura de aleta torna aplicável a fabricação de porta / porta traseira assimétrica. Como resultado, a corrente no estado ( I LIGADO ) de 58,8 μA / μm, corrente de fuga fora do estado ( I DESLIGADO ) perto de 10 −11 μA / μm, oscilação média de sublimiar (SS média ) de 18,2 mV / dec e oscilação mínima de subliminar (SS min ) de 2,8 mV / dec pode ser alcançado por DF-TFET. Com capacitância de porta relativamente pequena ( C gg ) e portão para drenar capacitância ( C gd ), um bom desempenho analógico / RF pode ser obtido. Finalmente, a frequência de corte ( f T ) atingiu 5,04 GHz e o produto de ganho de largura de banda (GBW) atingiu 1,29 GHz.
As estruturas deste artigo são as seguintes:A seção “Estrutura do Dispositivo e Método de Simulação” mostra os métodos de simulação TCAD deste trabalho. A estrutura e o parâmetro do DF-TFET são apresentados. As diferenças e vantagens do DF-TFET em comparação com DL-TFET e TG-TFET são ilustradas. O mecanismo, a característica e o desempenho analógico / RF do DF-TFET são discutidos na seção “Resultados e discussão”. Uma comparação de desempenho entre DF-TFET, DL-TFET e TG-TFET é realizada nesta seção. Além disso, a influência dos parâmetros do dispositivo no desempenho e nos parâmetros de RF típicos do DF-TFET é estudada nesta seção. A fim de compreender melhor o potencial dos DF-TFETs em aplicações de ultra-baixa potência, comparações das características elétricas entre diferentes TFETs e DF-TFETs sob polarização de baixa tensão foram realizadas.
Estrutura do dispositivo e método de simulação
A estrutura proposta do DF-TFET é ilustrada na Fig. 1a. Para melhorar o desempenho do dispositivo, a junção de tunelamento de linha é aplicada ao canal de SiGe em forma de barbatana sem dopagem pelo conceito de plasma de carga [24, 25]. Sabe-se que a espessura dielétrica da porta pode afetar significativamente a corrente de tunelamento. Isso porque no resultado da aproximação WKB [26], conforme mostrado na Eq. (1), a probabilidade de tunelamento depende do comprimento de triagem eficaz ( λ ), massa efetiva do portador ( m * ), gap de energia ( E g ) e janela de energia de triagem eficaz (Δ Φ )
$$ T _ {{{\ text {WKB}}}} \ approx \ exp \ left ({- \ frac {{4 \ lambda \ sqrt {2m ^ {*}} \ sqrt {E _ {{\ text {g} }} ^ {3}}}} {{3q \ hbar (E _ {{\ text {g}}} + \ Delta \ Phi)}}} \ right) $$ (1)
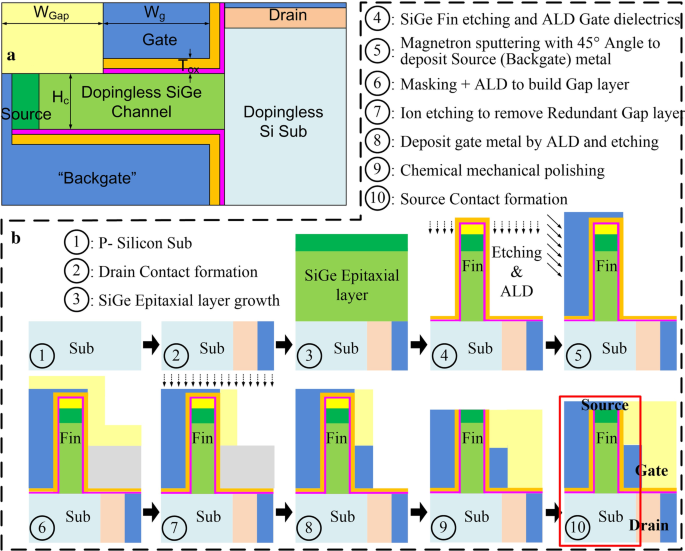
a Estrutura e b fluxo de fabricação de DF-TFET
Reduzindo a espessura do dielétrico da porta ou usando um alto κ dielétrico irá reduzir λ e aumentar Δ Φ , o que causará um aumento exponencial da probabilidade de tunelamento. Assim, usando alto κ dielétricos e redução da espessura dielétrica podem aumentar significativamente a corrente no estado de TFET. Mas a pequena espessura dielétrica e problemas de qualidade de interface de alta κ dielétricos causarão sérios problemas de confiabilidade. Assim, um dielétrico de porta de pilha de 0,5 nm de Al 2 O 3 e 2,0 nm de HfO 2 é definido para garantir uma boa qualidade de interface [27,28,29], o que pode reduzir significativamente a corrente de fuga e melhorar a confiabilidade do dielétrico da porta. O eletrodo fonte está localizado no topo da estrutura da aleta. Ao mesmo tempo, também fica próximo a um lado da nadadeira e funciona como uma “porta traseira” para aplicar um viés zero. Usando o eletrodo de porta e fonte com diferentes funções de trabalho em metal, uma junção de tunelamento de linha pode ser formada no canal de SiGe em forma de aleta sem dopagem pelo conceito de plasma de carga. A direção do tunelamento banda-a-banda (BTBT) é perpendicular à superfície do canal / porta. Isso pode ajudar a aumentar I LIGADO melhorando a área de junção de tunelamento eficaz.
Alta taxa de comutação ( I LIGADO / eu DESLIGADO ) pode ser obtido devido à grande corrente no estado ( I LIGADO ) e pequena corrente fora do estado ( I DESLIGADO ) fornecido pela junção de tunelamento de linha. Além disso, a aplicação de uma estrutura de aleta em DF-TFET pode reduzir notavelmente a pegada em comparação com o TFET de tunelamento de linha de plaina [30, 31]. A Figura 1b mostra um fluxo de fabricação disponível para formar a estrutura do DF-TFET. A Tabela 1 mostra os principais parâmetros de processo do DF-TFET. Finalmente, sem a dificuldade de fazer uma junção p – n abrupta e uniforme, bom desempenho e robustez do dispositivo podem ser alcançados.
Para melhor compreender as diferenças e vantagens do DF-TFET, DL-TFET e TG-TFET, a Fig. 2 mostra a estrutura destes três dispositivos. Com a junção de tunelamento de linha, espera-se que L-TFET e TG-TFET obtenham alta corrente no estado. Mas os resultados experimentais mostram que o desempenho real do L-TFET não é tão alto quanto o esperado [18, 19]. Uma das razões mais importantes é a dificuldade em formar uma junção p – n abrupta e uniforme com características de interface perfeitas. Com base na estrutura do L-TFET, o TG-TFET faz uma grande melhoria no I LIGADO . Mas o TG-TFET ainda enfrenta a dificuldade de formar uma junção p – n abrupta perfeita. Assim, para obter o bom desempenho desejável, uma junção p – n abrupta e uniforme e abrupta com apenas vários nanômetros de espessura deve ser obtida, mas é muito difícil de realizar no processo de fabricação. Ao usar um canal sem dopagem, o DL-TFET pode evitar esse problema e trazer uma melhor qualidade de interface perto da junção de tunelamento. No entanto, em comparação com TFETs de tunelamento de linha [16,17,18,19,20,21] com junções p-n abruptas, o resultado da simulação mostra que o I LIGADO de DL-TFET é relativamente baixo [22, 23]. Para melhoramento posterior, o DF-TFET é proposto e estudado neste trabalho.
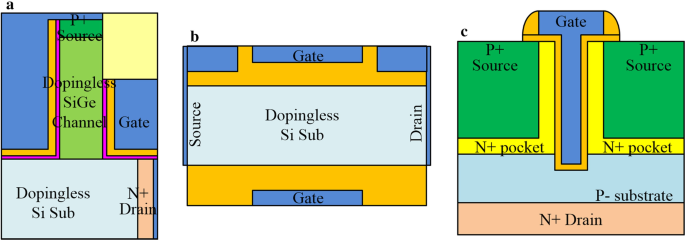
Estrutura de a DF-TFET, b DL-TFET, c TG-TFET
A simulação do DF-TFET é realizada nas ferramentas Silvaco Atlas TCAD. O modelo BTBT não local é apresentado nesta simulação para levar em consideração a variação espacial da banda de energia, o que pode ajudar a melhorar a precisão do processo de tunelamento BTBT. O modelo de mobilidade Lombardi é considerado para tornar a mobilidade do canal precisa. O modelo de estreitamento de gap é levado em consideração para ajustar as regiões de contato ôhmico dopado pesado, e o modelo de recombinação Shockley-Read-Hall também é levado em consideração neste artigo.
Resultados e discussão
Mecanismo e comparação de DF-TFET, DL-TFET e TG-TFET
A Figura 3a mostra a comparação das características de transferência de DF-TFET, DL-TFET e TG-TFET. Beneficie-se da junção de tunelamento de linha no canal SiGe em forma de aleta, DF-TFET atinge uma corrente no estado ( I LIGADO ) de 58,8 μA / μm e atinge uma grande taxa de comutação de mais de 12 ordens de magnitude onde nenhum efeito ambipolar óbvio ocorre. Além disso, oscilação mínima de sublimiar (SS min ) de 2,8 mV / dec e oscilação média de sublimiar (SS média ) de 18,2 mV / dec. Como resultado, DF-TFET tem melhorias óbvias em I LIGADO em comparação com DL-TFET e oscilação subliminar em comparação com TG-TFET. eu LIGADO de DF-TFET é mais de uma ordem de magnitude maior do que DL-TFET em V DS = V GS =1 V. A Figura 3b mostra a condição da banda de energia do DF-TFET e ilustra a formação da janela de tunelamento em canal em forma de barbatana. A linha pontilhada vermelha na inserção da Fig. 3b mostra a posição onde a curva da banda de energia é obtida.
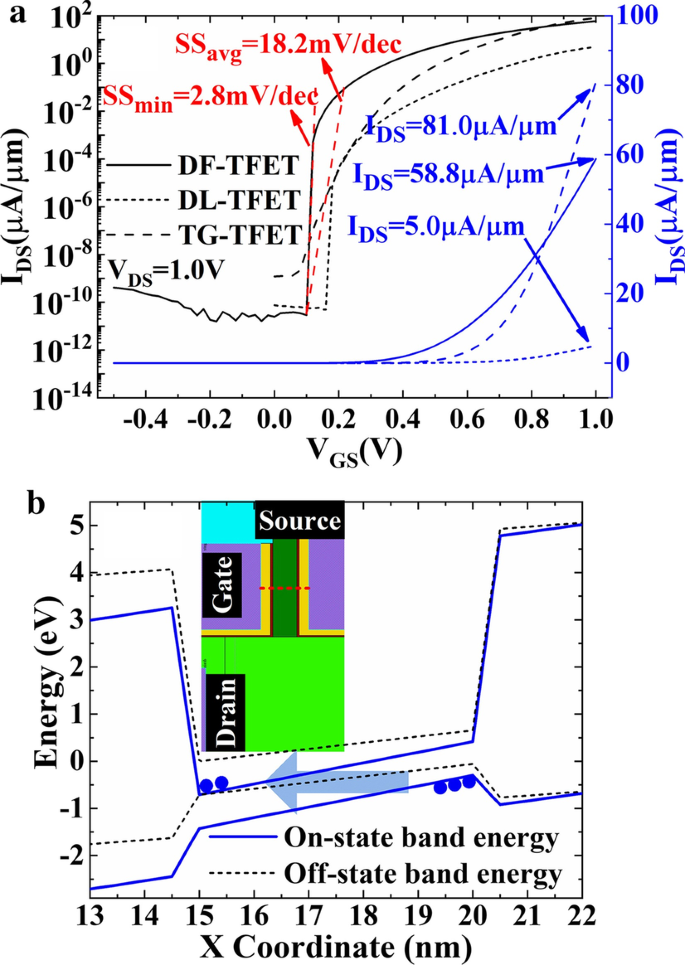
a Características de transferência de DF-TFET, DL-TFET e TG-TFET. b Condição da banda de energia do DF-TFET em diferentes condições de trabalho (a inserção mostra a posição da linha de corte)
A distribuição de quantidade física importante no processo de tunelamento do DF-TFET é mostrada na Fig. 4, que inclui a distribuição de (a) potencial, (b) e taxa de tunelamento, (c) densidade de corrente total e (d) taxa de recombinação em um condição de trabalho no estado. Na Fig. 4a, um claro gradiente de potencial perpendicular à interface porta / canal pode ser observado. Assim, uma enorme diferença de potencial é gerada no canal em forma de aleta e isso irá modular a concentração de elétrons e buracos em ambos os lados do canal de aleta. Ao mesmo tempo, uma curvatura íngreme da banda de energia pode ser formada no canal em forma de aleta. Como resultado, uma junção de tunelamento de linha paralela à interface porta / canal pode ser formada. A Figura 4b mostra a taxa de e-tunelamento no canal da estrutura da aleta. O valor de pico da taxa de e-tunelamento é uniformemente distribuído próximo à interface porta / canal e paralelo à superfície. Isso prova que a junção de tunelamento de linha é paralela à interface porta / canal. A Figura 4c mostra o caminho atual no DF-TFET. Os elétrons da banda de valência do lado do backgate / canal são tunelados para a banda de condução perto do lado do portão / canal. Sob a influência da tensão do gate e da tensão do dreno, os elétrons se movem ao longo do canal da aleta para o eletrodo do dreno. Desta forma, um caminho de corrente de tunelamento é formado no DF-TFET. A Figura 4d mostra a distribuição da taxa de recombinação em DF-TFET; isso pode ilustrar a localização da junção de tunelamento de forma mais óbvia. A faixa roxa no canal da aleta SiGe pode representar a localização da junção do túnel.
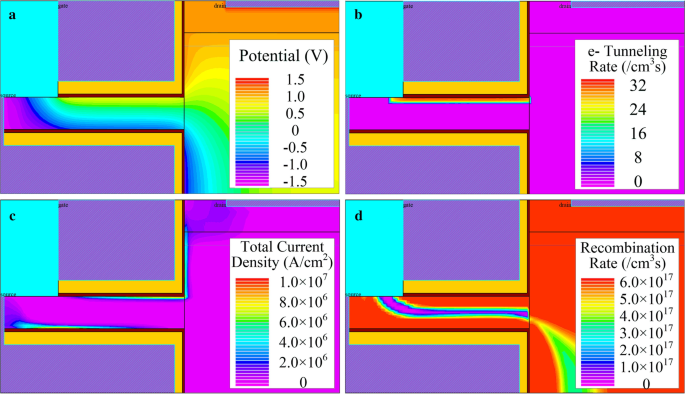
Distribuição de a potencial, b e taxa de tunelamento, c densidade de corrente e d taxa de recombinação de DF-TFET
Características DC com parâmetros diferentes e desempenho analógico / RF
A Figura 5a, b mostra as características de entrada e saída do DF-TFET sob diferentes vieses. O aumento de V DS tem pouco efeito nas características de oscilação do sublimiar, mas eu LIGADO terá um crescimento linear enquanto V DS aumenta de 0,2 para 1,2 V (em V GS =1,0 V). A Figura 5c mostra a frequência de corte ( f T ) e produto de ganho de largura de banda (GBW) calculado pelas Eqs. (2) e (3). O resultado mostra que uma frequência de corte de 5,04 GHz e um produto de ganho de largura de banda de 1,29 GHz podem ser obtidos.
$$ f _ {{\ text {T}}} =\ frac {{g _ {{\ text {m}}}}} {{2 \ pi C _ {{{\ text {gs}}}} \ sqrt {1 + 2C _ {{{\ text {gd}}}} / C _ {{{\ text {gs}}}}}}} \ approx \ frac {{g _ {{\ text {m}}}}} {{2 \ pi \ left ({C _ {{{\ text {gs}}}} + C _ {{{\ text {gd}}}}} \ right)}} =\ frac {{g _ {{\ text {m} }}}} {{2 \ pi C _ {{{\ text {gg}}}}}} $$ (2) $$ {\ text {GBW}} =g _ {{\ text {m}}} / 2 \ pi 10C _ {{{\ text {gd}}}} $$ (3)

a Entrada, b saída e c características de radiofrequência de DF-TFET
A Figura 6a mostra o efeito da função de trabalho do portão ( φ Portão ) e função de trabalho de drenagem ( φ Drenar ) nas características de transferência do DF-TFET. Com o aumento da função de trabalho, a curva característica de transferência muda para a direção positiva. Como a função de trabalho varia de 3,7 a 4,2 eV, o V th aumenta linearmente de 0 a 0,5 V enquanto o I LIGADO diminui linearmente de 93,4 para 18,6 μA / μm. Isso torna possível ajustar V th para se aplicar a diferentes requisitos de aplicação. A Figura 6b mostra o efeito da proporção de composição X de Si 1− X Ge X . O aumento na composição do germânio leva à diminuição do gap de energia e ao aumento da janela de tunelamento, como mostrado na inserção da Fig. 6b. Finalmente, resulta no I LIGADO A curva característica de aumento e transferência se traduz na direção negativa. No entanto, quando X > 0,7, tanto a curva característica de transferência quanto I LIGADO têm poucas mudanças com o aumento de X . Isso ocorre porque a estrutura da banda de energia do canal se torna insensível a X quando X > 0,7, conforme mostrado na inserção da Fig. 6b. A Figura 6c, d mostra o efeito do comprimento da porta ( W g ) e espessura do canal ( H c ) nas características de transferência. A inserção da Fig. 6c mostra as dimensões do canal do dispositivo sob diferentes W g . Não é difícil observar a partir da Fig. 6d que o DF-TFET irá sofrer I LIGADO diminuir quando H c torna-se muito pequeno e muito grande. Assim, um adequado H c irá beneficiar o desempenho do dispositivo.

Transferir características com diferentes a função de trabalho do portão ( φ Portão ) e função de trabalho de drenagem ( φ Drenar ), b Razão de composição de SiGe, c comprimento do portão ( W g ) e d espessura do canal ( H c )
Para entender o potencial do DF-TFET em aplicações de ultra-baixa energia, a Tabela 2 mostra uma comparação de desempenho de diferentes TFETs com DF-TFET. Comparado aos TFETs com uma junção de tunelamento p-n tradicional fortemente dopada [6, 20, 32,33,34,35], DF-TFET tem vantagens óbvias em SS e relação de comutação. Isso se deve às características do DF-TFET ao usar dopagem eletrostática. Comparado com outros TFETs sem dopagem [22, 23, 36, 37], DF-TFET tem vantagens óbvias em I ON . Isso ocorre por causa da taxa de tunelamento aprimorada usando junção de tunelamento de linha e material SiGe. Ao combinar as vantagens da junção de tunelamento p – n e junção de tunelamento sem dopagem, o DF-TFET pode fornecer alta corrente operacional e baixo consumo de energia estática em aplicações de ultra-baixo consumo de energia.
Conclusão
Neste trabalho, um novo DF-TFET é proposto e as características elétricas são analisadas pelo método de simulação. A característica da estrutura, mecanismo físico, desempenho com diferentes parâmetros e desempenho analógico / RF do DF-TFET são discutidos e estudados. Beneficie-se do canal de estrutura de aleta sem dopagem, dielétrico de porta de pilha, material de canal de SiGe e junção de tunelamento de linha de alta eficiência, bom desempenho nas características de comutação e características analógicas / RF podem ser obtidas. Além disso, evitando a formação da junção p – n abrupta no processo de manufatura, pode-se obter dopagem uniforme com alta consistência e alta robustez na flutuação do processo. O resultado da simulação mostra que, eu LIGADO de 58,8 μA / μm, razão de comutação de 12 ordens de magnitude, nenhum efeito ambipolar óbvio, SS min de 2,8 mV / dec e f T de 5,04 GHz pode ser alcançado por DF-TFET. Com grande corrente operacional, alta taxa de comutação, SS íngreme, boa confiabilidade, processo de fabricação estável e boa capacidade de fabricação, pode-se esperar que ele seja um dos candidatos promissores para as futuras aplicações de CI de baixa potência e sensores sensíveis.
Disponibilidade de dados e materiais
Não aplicável (Este manuscrito é um estudo puramente teórico sobre o desempenho analógico / RF do TFET. Os dados de simulação foram fornecidos neste manuscrito e não devem ser descritos aqui).
Abreviações
- DF-TFET:
-
TFET de canal de SiGe em forma de barbatana sem dopagem
- ICs:
-
Circuitos integrados
- TGTFET:
-
TFET de fonte dupla com porta em forma de T
- DL-TFET:
-
TFET sem doping
- I LIGADO :
-
Corrente no estado
- I DESLIGADO :
-
Corrente de estado desligado
- SS min :
-
Balanço mínimo do sublimiar
- SS média :
-
Balanço médio de sublimiar
- C gg :
-
Capacitância da porta
- C gd :
-
Porta para drenar capacitância
- f T :
-
Frequência de corte
- GBW:
-
Produto de ganho de largura de banda
- λ :
-
Comprimento efetivo da triagem
- m * :
-
Massa transportadora efetiva
- E g :
-
Lacuna de banda de energia
- Δ Φ :
-
Janela de energia de triagem eficaz
- W g :
-
Comprimento do portão
- W Lacuna :
-
Comprimento da lacuna
- T boi :
-
Espessura de óxido de porta de empilhamento
- H c :
-
Espessura do canal
- φ Portão / φ Drenar :
-
Função de trabalho de portão e drenagem
- V DS :
-
Drene para a tensão da fonte
- V GS :
-
Tensão da porta para a fonte
Nanomateriais
- Nova abordagem traz estabilidade aprimorada de PUF
- Melhore o desempenho com soldagem automatizada
- Blog:Vestíveis médicos com ótimo desempenho
- Um romance fotocatalisador de heterojunção Bi4Ti3O12 / Ag3PO4 com desempenho fotocatalítico aprimorado
- Desempenho aprimorado de um novo catalisador PdAu / VGCNF anódico para eletro-oxidação em uma célula de combustível de glicerol
- Mecanismo de condução e resistência aprimorada em RRAM baseado em HfO2 com tratamento de nitridação
- Fabricação de Hierárquicas ZnO @ NiO Core – Shell Heteroestruturas para melhorar o desempenho fotocatalítico
- Channel Plasmon Nanowire Lasers com cavidades em V-Groove
- Efeitos das variações de gravação na formação do canal Ge / Si e desempenho do dispositivo
- 6 maneiras de aprimorar o Protocase Designer com a versão 4.6



