Propriedades fotoeletrônicas do detector de arranjo nanowire InAsSb ligado por extremidade sob luz fraca
Resumo
Uma fabricação simples de detector de matriz de contatos ligados na extremidade InAsSb NW (nanofio) para luz fraca é demonstrada neste estudo. O detector é fabricado usando a matriz InAsSb NW desenvolvida por epitaxia de feixe molecular em substrato de GaAs. Os estados de gap induzidos por metal são induzidos pelo contato finalizado que suprime a corrente escura em várias temperaturas. A existência do dipolo de interface devido aos estados de lacuna interfacial aumenta a excitação da luz ao redor do campo local e, assim, aumenta a fotorresponsividade e fotodetetividade à luz fraca. A intensidade da luz da fonte de luz infravermelha neste relatório é 14 nW / cm 2 que é cerca de 3 a 4 ordens de magnitude menor do que a fonte do laser. A responsividade do detector atingiu 28,57 A / W em temperatura ambiente com a radiação de luz (945 nm), enquanto a detectividade é 4,81 × 10 11 cm · Hz 1/2 W −1 . O desempenho anômalo dependente da temperatura surge nos experimentos de temperatura variável, e discutimos o mecanismo detalhado por trás da relação não linear entre a fotorresposta do dispositivo e as temperaturas. Além disso, as características optoeletrônicas do detector esclareceram que o efeito de captura de luz e o efeito fotogante dos NWs podem aumentar a fotorresposta à luz fraca do ultravioleta ao infravermelho próximo. Esses resultados destacam a viabilidade do detector InAsSb NW array para a luz infravermelha fraca sem um sistema de resfriamento.
Introdução
Como um importante ramo dos semicondutores de banda estreita III-V, o InAsSb tem os benefícios herdados dos InAs, como pequena massa efetiva de elétrons e alta mobilidade de elétrons [1, 2]. Quando o elemento Sb é introduzido no InAs, a resposta do comprimento de onda de corte do InAsSb ternário poderia ser estendida para a faixa infravermelha de comprimento de onda longo devido ao efeito bandgap bowing [3]. Consequentemente, o InAsSb é considerado um candidato ideal na área de detecção de infravermelho [4,5,6]. No campo da optoeletrônica, as nanoestruturas unidimensionais (1D) [7] têm propriedades únicas tremendas, incluindo grande área de superfície com vários estados de armadilha, longo caminho para absorção de fótons e estrutura mecanicamente flexível devido às suas enormes proporções de aspecto [8]. Além disso, durante seu desenvolvimento, as nanoestruturas 1D podem facilmente liberar a incompatibilidade da rede para os substratos e, por sua vez, alcançar alta qualidade de cristal [9]. Aqui, as aplicações para optoeletrônica como fotodetectores [10], células solares [11] baseadas em nanoestruturas 1D estão atraindo enormes interesses de pesquisa. Dentre eles, as estruturas de dispositivos sob medida [12] foram trazidas para alcançar absorção de luz otimizada e coleta de luz de banda larga, tornando as nanoestruturas 1D adequadas para cenários de aplicação variados e alcançando os componentes compatíveis com circuitos integrados à base de silício. Recentemente, fotodetectores baseados em NWs de InAs individuais demonstraram seus potenciais na detecção de infravermelho [13]. Com a adição de Sb, InAsSb ternário pode ser acessível em uma faixa de amplo espectro para detecção de temperatura ambiente [14]. Com a passivação de Al 2 O 3 , os detectores baseados em InAsSb NWs alcançaram uma detecção não resfriada no espectro infravermelho de comprimento de onda médio [15]. No entanto, as fontes de luz convencionais amplamente aplicadas nesses estudos são lasers de alta intensidade e a maioria desses dispositivos não pode operar em temperatura ambiente [16]. Além disso, a estrutura do dispositivo convencional baseada em NWs não é amigável para a aplicação em massa em circuitos integrados compatíveis. Existem três tipos principais de detectores tradicionais baseados em InAsSb NWs, incluindo dispositivos NW individuais [17], poços quânticos embutidos em InAs NWs [3] e dispositivos NW individuais verticais [14]. Todos eles são necessários em processos de nanofabricação caros, como litografia por feixe de elétrons (EBL) e corrosão iônica reativa (RIE). Aqui, a inovação na estrutura do dispositivo é urgente para a aplicação de NWs.
A interface sempre desempenha um papel vital no desempenho ótico e elétrico do dispositivo, apesar do tamanho limitado, tornando a engenharia de contato em dispositivos baseados em NW outro fator essencial [18]. Por exemplo, células solares com excelentes propriedades de fotodetecção omnidirecional para luz fraca foram obtidas na estrutura híbrida utilizando a interface entre pontos quânticos de grafeno e sulfonato de poliestireno [19]. Neste estudo, modulamos o desempenho optoelétrico do dispositivo usando a estrutura de banda na interface entre o eletrodo e o semicondutor. A redistribuição de carga ocorre na interface metal-semicondutor, e a transferência de carga ocorre entre o metal e as caudas das funções de onda do metal para o semicondutor. A redistribuição é referida como MIGS, que poderia induzir estados de lacuna e dipolo de interface nos estados interfaciais [20]. No entanto, os resultados da simulação do modelo MIGS ainda apresentam desvios entre os experimentos, o que é considerado resultante de defeitos de interface, defeitos induzidos de fabricação e pinning em nível de Fermi [21]. Especialmente para InAsSb NWs com estados de superfície ricos, a fixação de nível de Fermi é inevitável, de modo que os estados de lacuna induzidos filtrariam a transferência de carga. Desta forma, a corrente escura do dispositivo pode ser suprimida em uma faixa aceitável. Além disso, o dipolo interfacial pode aumentar a excitação de luz no campo local, que é essencial para a detecção de luz fraca. Com base na discussão de Chu. et.al, as junções com ligações finais são mais propensas a atingir a sobreposição de estado entre o metal e o semicondutor do que as junções com ligações planas [18]. Ainda assim, o dispositivo final ligado via NW individual se depara com os obstáculos na fabricação. Aqui, encontramos uma solução usando matrizes NW para obter o contato final entre NWs e o metal. Em comparação com os fotodetectores convencionais, os dispositivos NW array estruturados em sanduíche têm as vantagens de fácil fabricação e alta adaptabilidade ambiental [22, 23]. O filler (AZ5214), que é spin-coating e cozido ao redor dos NWs durante o processo de fabricação, torna o dispositivo mais estável e antioxidante para o meio ambiente. Quando a luz é introduzida no arranjo NW, ela reflete e refrata em diferentes direções várias vezes, aumentando a absorção de luz em seu interior [24, 25]. O caminho de luz prolongado na matriz NW é referido como o efeito de captura de luz [26, 27], que é amplamente utilizado em dispositivos de matriz baseados em NW. Tanto a estrutura de banda quanto a estrutura do dispositivo fornecem ao dispositivo potencial para detecção de luz fraca em temperatura ambiente.
Neste estudo, fabricamos o dispositivo NW array baseado no InAsSb NWs cultivado por MBE (epitaxia de feixe molecular). Os estados de gap e dipolo de interface induzidos pelo contato metal-semicondutor poderiam suprimir a corrente escura e aumentar a detecção de luz separadamente [28]. O efeito de captura de luz da estrutura em sanduíche do arranjo NW contribui para a detecção de luz fraca [29]. A corrente escura suprimida em temperatura ambiente minimiza bastante o ruído de detecção e permite a detecção em temperatura ambiente [30]. A estrutura do dispositivo de cura torna o dispositivo capaz de trabalhar no ambiente ambiente. Além disso, a fotorresposta do dispositivo flutua com a temperatura porque os estados complicados da interface são antecipados. Com uma temperatura constante, o valor da fotocorrente aumenta linearmente com a intensidade da luz incidente, o que demonstrou potencial para o medidor de potência óptica.
Métodos / Experimental
InAsSb NWs foram cultivados em substratos GaAs {111} B usando o sistema MBE (Riber 32 R&D) com um sistema de evaporação de Au in situ. O substrato epi-ready foi pré-tratado para remover a contaminação. Em seguida, uma camada tampão de GaAs foi depositada a 540 ° C por 15 min e as nanopartículas de Au foram formadas por meio do processo de evaporação e recozimento. Os caules de InAs foram cultivados por 20 min com a temperatura mantida constantemente a 380 ° C e, em seguida, a fonte de Sb foi introduzida na câmara de crescimento por 60 min. Durante o crescimento NW, o In BEP (pressão equivalente do feixe) foi mantido como 2,7 × 10 –7 mbar, o As BEP era 2,2 × 10 –6 mbar, e o Sb BEP era 7 × 10 –7 mbar, levando a uma razão de fluxo V / III de ~ 11 e a razão Sb / As de ~ 0,3.
Para a fabricação do dispositivo, AZ5214 (fotorresiste) foi empregado como agente de sustentação para manter as orientações dos NWs. Em seguida, o array NW com o substrato foi revestido por rotação com AZ5214 a 3000 rpm por 30 se cozido por 2 min a 120 ° C. O gel AZ5214 é transparente o que minimiza a perda de luz durante a medição. Para expor as pontas dos NWs, a superfície da matriz foi polida por um medidor de cisalhamento de precisão (Logitech). As camadas InAsSb formadas na superfície do substrato durante o crescimento NW via mecanismo VS (vapor-sólido) podem atuar como o eletrodo de drenagem. De acordo com a medição Hall de epi-camadas InAsSb (mostrado no arquivo adicional 1:Figura S1), a concentração de transportador em temperatura ambiente é de cerca de 2 × 10 17 cm −3 , enquanto a mobilidade é de cerca de 1,6 × 10 4 cm 2 / (V · s) à temperatura ambiente. Em seguida, um filme de Au com espessura nominal de 8 nm foi depositado nas áreas selecionadas, uma delas no topo da matriz e a outra na epi-camada. A pequena espessura do Au depositado garante a fotopermeabilidade do eletrodo e a perda de luz aceitável durante as medições.
As características morfológicas, químicas e estruturais dos InAsSb NWs obtidos foram investigadas usando SEM (FE-SEM, JEOL 7800F) e TEM [TEM, Philips Tecnai F20, equipado com espectroscopia de dispersão de energia (EDS) para análise composicional]. Os NWs individuais para a análise de TEM foram preparados por ultra-sonicação das amostras de NW em etanol e dispersando-os nas grades de Cu suportadas por filmes de carbono.
As medidas de fotocondutividade foram feitas em um criostato de ciclo fechado de hélio equipado com LEDs como fontes de luz. A temperatura neste sistema pode ser modulada entre 2 K e a temperatura ambiente continuamente, enquanto a intensidade da luz dos LEDs pode ser ajustada facilmente pela corrente de entrada. LEDs com vários comprimentos de onda, incluindo 260 nm, 620 nm e 945 nm, foram empregados neste estudo. A intensidade da luz do LED está relacionada à temperatura e à corrente de entrada. A intensidade aumenta linearmente com a corrente e diminui com a temperatura. Os valores da intensidade da luz à temperatura ambiente nesta medição são 4000 nW / cm 2 para 260 nm, 558 nW / cm 2 para 620 nm e 14 nW / cm 2 para 945 nm. As informações relacionadas à intensidade da luz podem ser encontradas na Ref. [30]. Uma tensão constante V DS =100 mV foi aplicado entre a fonte e o dreno. A resposta da fotocondutividade pode ser obtida ajustando o ON / OFF dos LEDs.
Resultados e discussão
A Figura 1 mostra as investigações de microscopia eletrônica dos NWs do InAsSb. A Figura 1a é uma imagem SEM de vista inclinada, mostrando os diâmetros da faixa de NWs de 100 a 200 nm e a faixa de comprimento de 6 a 8 μm. A Figura 1b mostra uma imagem TEM de campo claro (BF) de um NW individual típico, indicando uma estrutura de afilamento clássica. Ao longo de sua direção axial, a composição do NW mostra uma mudança gradual moderada e a concentração média de Sb é elevada até 30% com base em nossa análise EDS quantitativa (detalhes disponíveis no arquivo adicional 1:Figura S2). A Figura 1c mostra a imagem HRTEM da parte central do NW, confirmando a existência dos planos gêmeos. O padrão de difração de elétrons de área selecionada (SAED) mostrado na Fig. 1d também verifica a estrutura de geminação, e dois conjuntos de difrações estruturadas com ZB (zinco blenda) podem ser distinguidos. O elemento Sb pode ser utilizado como surfactante e deprime a fase WZ (wurtzita) dos InAs NWs [31], favorecendo a mudança de fase da estrutura de WZ para ZB. Em nosso caso, a razão V / III é ~ 11, levando a um ambiente rico em V, o que favorece a nucleação da estrutura ZB [32], mas deixando alguns planos gêmeos. A investigação sobre a estrutura de gêmeos em InAsSb NWs alegou que o deslocamento na fronteira causaria uma distribuição local irregular de Sb [12], favorecendo o espalhamento de elétrons ou o aprisionamento de portadoras [33].
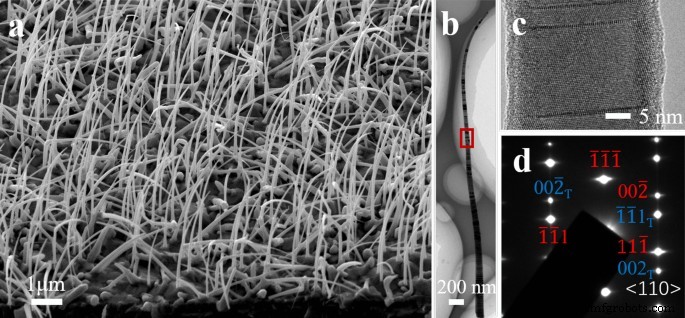
Investigações de microscopia eletrônica avançada em InAsSb NWs. a Uma imagem SEM de visão inclinada dos NWs. b Imagem TEM de campo claro (BF) de um NW individual. c Imagem TEM de alta resolução (HRTEM) tirada do meio do NW da região marcada em b . d Padrão SAED (difração de elétrons de área selecionada) correspondente tirado de c
A estrutura do dispositivo é ilustrada na Fig. 2a, na qual o filme de Au cobre as partes superior e inferior da matriz. A imagem SEM do dispositivo é mostrada no arquivo Adicional 1:Figura S3, onde o comprimento restante é de cerca de 3 µm e quase todos os NWs estão integrados. O fotorresiste é usado para manter os NWs orientacionais e integrá-los a um dispositivo de cura; desta forma, o dispositivo é mais antioxidante e adequado para a aplicação. A estrutura afilada é usada em dispositivos NWs de silício amorfo, demonstrando uma absorção de realce e é insensível ao ângulo de incidência [34]. A Figura 2b é um mapa de esboço da interface Au-InAsSb determinada pelo modelo MIGS. A Figura 2c, d confirma uma condutância quase constante independente da temperatura, e o valor da condutância é cerca de 1 × 10 –7 Ω −1 . As curvas I – V em 2 K e 300 K sem luz incidente são mostradas na Fig. 2d. O nanofio individual tem um valor muito maior da condutância mostrada no arquivo adicional 1:Figura S4. O dispositivo de arranjo é equivalente a um circuito paralelo unido por milhares de NWs individuais, de modo que a condutância teórica deveria ser um valor muito mais considerável. Além disso, temos dois conhecimentos básicos sobre as questões relacionadas à condutância:(1) a condutância do NW individual mostra uma forte dependência da temperatura; (2) os dispositivos de matriz feitos de InAs NWs em nosso estudo também têm condutância constante. Portanto, concluímos que o contato entre o metal e o semicondutor neste dispositivo tem uma resistência considerável dominando as características gerais de saída.

Estrutura e propriedades elétricas do dispositivo InAsSb NW array. a Mapa de esboço do dispositivo, com a imagem SEM mostrada na inserção. b O diagrama de energia dos estados da interface Au-InAsSb. c A condutância dependente da temperatura do dispositivo. d Curvas I – V a 2 K e 300 K sem luz, respectivamente
Quando Au é unido no InAsSb NWs por meio de um contato end-bonded, a transferência de carga ocorre na interface por meio das caudas das funções de onda de elétrons de metal, que é chamado de continuum de MIGS [18]. A redistribuição de carga na interface ocorreu uma vez que as formas de contato também causariam o desenvolvimento de dipolos de interface [35]. De acordo com o modelo MIGS, a altura da barreira da interface é determinada por \ ({\ Phi} _ {\ mathrm {Au}} \) (a função de trabalho do metal), \ ({\ Phi} _ {\ mathrm {NW }} \) (a afinidade eletrônica do InAsSb NW) e \ ({\ Delta} _ {i} \) (a queda de tensão devido a um dipolo de interface que ocorre na formação da interface). O \ ({\ delta} _ {i} \) é a distância dos estados de lacuna induzidos pelo metal. O estado eletrônico é exibido na Fig. 2b. O dipolo de interface poderia criar uma barreira extra para elétrons [36], mas o efeito é restrito em uma região do \ ({\ delta} _ {i} \). Acima de tudo, as propriedades intrínsecas do dispositivo são moduladas pela grande resistência de contato parasita [37]. Em nosso dispositivo, a grande resistência de contato diminui a corrente escura de forma eficaz, enquanto o valor é independente da temperatura. Desta forma, a concentração de transportador pode ser restringida em uma faixa favorável para detecção de luz. Ainda assim, o mecanismo de resistência de contato devido ao dipolo da interface se manter constante com a variedade de temperaturas continua sendo uma pesquisa mais detalhada.
Na Fig. 3a, mostramos as correntes do dispositivo de 2 a 120 K com e sem a iluminação, e o restante é mostrado no Arquivo Adicional 1:Figura S5. Os estados do LED são sintonizados com o tempo, nos quais os estados “ON” e “OFF” se manteriam por 60 s, respectivamente. Os valores de corrente específicos do LED mostrado nos estados “LIGADO” são 10, 20, 50, 100, 200, 500, 1000, 2000 e 3000 uA, respectivamente. A medição é feita em diferentes temperaturas de 2 a 300 K. A inserção na Fig. 3a mostra as condições com as três luzes mais fracas (cerca de 4–10 nW / cm 2 ) iluminação, indicando uma tendência semelhante à da Fig. 3a. No entanto, comportamentos óticos diferentes óbvios podem ser declarados com a luz mais fraca, especialmente para a velocidade de resposta mais lenta e uma fotocondutância ligeiramente persistente. A Figura 3b mostra o tempo de resposta do dispositivo a 20 K, enquanto a corrente do LED é de 2.000 μA. Vale a pena notar que, a Fig. 3c é obtida no ambiente ambiente à temperatura ambiente. Mais importante ainda, a fonte de luz que usamos aqui são todos os LEDs e os valores de intensidade da luz são 4000 nW / cm 2 (260 nm), 558 nW / cm 2 (620 nm) e 14 nW / cm 2 (945 nm), respectivamente. Além da fotorresponsividade, pelas velocidades de resposta com diferentes comprimentos de onda de luz, podemos concluir que os InAsSb NWs respondem melhor à luz infravermelha.
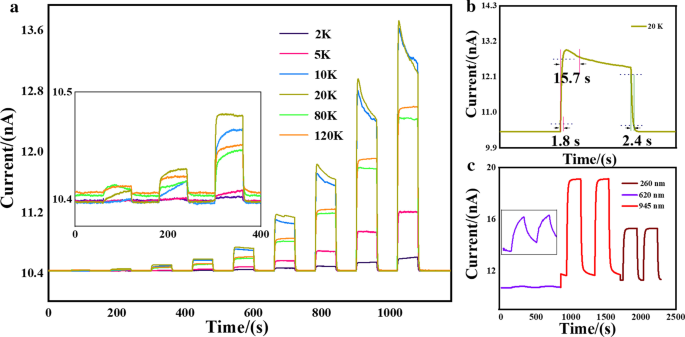
Dependência do tempo da condutância fonte-dreno sob diferentes temperaturas. a A fotorresposta do dispositivo em diferentes temperaturas para 620 nm LED com as diferentes correntes de entrada. b O tempo de resposta do dispositivo é de 20 K, enquanto a corrente de entrada do LED é de 2.000 μA. c O desempenho fotoelétrico da dependência do comprimento de onda do dispositivo à temperatura ambiente com a iluminação de 260 nm, 620 nm e 945 nm. A inserção mostra uma versão ampliada da fotorresposta para LED de 260 nm
A Figura 3a mostra que nosso dispositivo tem uma resposta positiva rápida e óbvia na mudança de estado do LED em diferentes temperaturas, e a fotocondutância aumenta com a corrente do LED. Sem iluminação, a condutância do dispositivo é de cerca de 1,04 × 10 –7 Ω −1 , que concorda com o teste de saída mostrado na Fig. 2c. Em uma temperatura fixa, o valor de Δ G (definida como a condutância menos a condutância escura) aumenta quase linearmente com a corrente do LED representando a intensidade da luz. Quando a fonte de luz foi bloqueada, a corrente do dispositivo recupera imediatamente para o estado de origem. O valor máximo de Δ G neste gráfico é 3,2 × 10 –8 Ω −1 a 10 K. Deve-se notar que dois tipos de fotorresposta podem ser distinguidos neste gráfico:
- 1.
para a maioria das temperaturas, as correntes aumentam rapidamente quando o LED é ligado, e as correntes permanecem estáveis enquanto o LED está ligado;
- 2.
a 10 K e 20 K, a corrente também aumenta rapidamente com a iluminação. Já a corrente tem uma ligeira diminuição com o LED aceso, deixando uma cauda no gráfico, que não é encontrada em outras temperaturas.
Para esclarecer o mecanismo intrínseco nos dois tipos diferentes de fotorresposta, a informação da velocidade de resposta a 20 K quando a corrente do LED é 2.000 μA é extraída como evidência e os valores específicos são mostrados na Fig. 3b. O tempo de resposta [38, 39] ( τ ris representando o intervalo de tempo do pico da corrente de 90% ao pico da corrente de 10%) é determinado como 1,8 s, enquanto o tempo de recuperação ( τ rec definido de forma oposta) é 2,4 s, que são quase uma constante em toda a faixa de temperatura. Para 10 K e 20 K, o tempo de atraso da estrutura “cauda” é de cerca de 15,7 s, o que é surpreendentemente ausente quando a iluminação da corrente do LED é menor que 500 μA. Combinado com a condição de luz fraca na inserção da Fig. 3a, três tipos de fotorresposta a 10 K e 20 K podem ser demonstrados. Com a luz mais fraca (10–50 μA), a corrente aumenta lentamente com o tempo. Quando a corrente do LED é aumentada para 100–500 μA, a resposta se torna rápida. Quando a corrente é superior a 1000 μA, a cauda se forma. Em outras palavras, apenas a intensidade de luz suficiente pode desencadear a estrutura de "cauda" transitória. Estruturas de "cauda" semelhantes foram amplamente relatadas em InAs NWs [40, 41]. As fontes de luz nesses relatórios são todos lasers com alta intensidade de luz, o que é consistente com nosso resultado de que a estrutura da “cauda” só aparece nas zonas de luz de alta intensidade. Eles alegaram que a “cauda” vem do efeito retardado que corresponde ao aprisionamento e retirada de portadores nos estados de superfície [42]. Para InAsSb NWs em nosso caso, os estados de superfície são mais inevitáveis devido ao efeito tensoativo severo incorporado com Sb [43]. Conseqüentemente, prevemos que a estrutura de “cauda” origina-se dos estados de defeito da estrutura de geminação apenas prendem elétrons em certas temperaturas com assistência de luz forte o suficiente.
Para um determinado fotodetector, a fotorresponsividade pode ser expressa por [44]
$$ \ mathrm {R} =\ frac {{I} _ {\ mathrm {p}}} {PA} $$ (1)
onde \ ({I} _ {\ mathrm {p}} \) é a fotocorrente do dispositivo, \ (P \) é a potência da luz no dispositivo e \ (A \) representa a área efetiva do dispositivo. Para o nosso dispositivo, a área efetiva do dispositivo é 1 mm 2 que é determinado pela máscara usada durante a evaporação dos eletrodos, e a área de recepção de luz do fotômetro é de 0,9 cm 2 . Sob esta circunstância, a fotorresponsividade do dispositivo pode ser determinada como sendo 4,25 mA / W (260 nm), 1,27 A / W (620 nm) e 28,57 A / W (945 nm), respectivamente, o que confirmou ainda mais o potencial de InAsSb Dispositivo NW com estrutura em sanduíche para detecção de infravermelho.
A fotodetetividade de um dispositivo pode ser apresentada como [14]
$$ {D} ^ {*} =R {A} ^ \ frac {1} {2} / {(2e {I} _ {\ mathrm {escuro}})} ^ \ frac {1} {2} $ $ (2)
onde R é a fotorresponsividade do dispositivo e e é a cobrança eletrônica. eu escuro representa a corrente escura do dispositivo e o valor é 10,8 nA. Com a corrente escura suprimida na estrutura de sanduíche InAsSb NW, os valores de \ ({D} ^ {*} \) do fotodetector alcançam 7,28 × 10 7 (260 nm), 2 × 10 10 (620 nm) e 4,81 × 10 11 cm · Hz 1/2 W −1 (945 nm), respectivamente. Notavelmente, a razão de trabalho de NWs nesta estrutura de matriz é menor que 50%, o que torna o R real e \ ({D} ^ {*} \) maior do que o resultado que calculamos. O alto R e \ ({D} ^ {*} \) não são apenas atribuídos ao efeito de captura de luz do dispositivo de matriz, mas também originados da estrutura da interface [2]. Em comparação com os fotodetectores baseados em nanofios resumidos na Ref. [45], a temperatura de operação de 300 K para nosso dispositivo tem potencial de aplicação superior em cenários do mundo real [6]. Além disso, na faixa de temperatura ambiente, a fotorresponsividade de nosso dispositivo de matriz InAsSb NW de fácil fabricação (28,57 A / W a 945 nm) pode exceder os dispositivos baseados em NW mais complicados (WSe 2 / Bi 2 Te 3 :20 A / W a 980 nm [46], PtSe 2 / perovskita:0,12 A / W a 800 nm [47]). Mesmo que o dipolo da interface seja experimentalmente inalcançável, as características de saída na Fig. 2 podem fornecer evidências sólidas de sua existência em nosso dispositivo. Como sugerido na discussão anterior, a camada interfacial do dispositivo poderia funcionar como a rede de dipolo óptico com a iluminação de luz, o que poderia contribuir para um fator de intensificação de campo maior. Este efeito é referido como efeito de intensificação de interface dipolo (IDEE) em estudos anteriores [48]. O IDEE funciona para uma faixa de comprimento de onda maior do que o efeito de aprimoramento do plasmon de superfície, que só existe dentro da faixa de comprimento de onda de ressonância. O efeito de aprimoramento em torno dos estados interfaciais e o efeito de captura de luz do dispositivo array trabalham juntos para a detecção de luz fraca em nosso dispositivo.
A Figura 4 mostra a relação entre a fotorresposta do dispositivo InAsSb NW em função das temperaturas (Fig. 4a) e a intensidade da luz (Fig. 4b). O valor de \ ({I} _ {p} \) é o valor extremo que a fotocorrente pode obter com a luz acesa. A fotorresposta é normalizada pela intensidade exata da luz para proteger sua influência sobre a tendência. A princípio, podemos concluir uma tendência semelhante com iluminação de diferentes intensidades de luz. Em todos os gráficos, a fotocondutância absoluta aumenta de 2 para 20 K e depois diminui até 80 K, deixando o primeiro pico em torno de 20 K e o segundo pico em torno de 100-120 K. A faixa de temperatura deste pico está de acordo com a temperatura específica faixa onde existe a “cauda” da fotocorrente transitória. O outro pico está em torno de 100-120 K, e sua localização específica muda para uma zona de temperatura mais alta com o aumento da intensidade da luz.
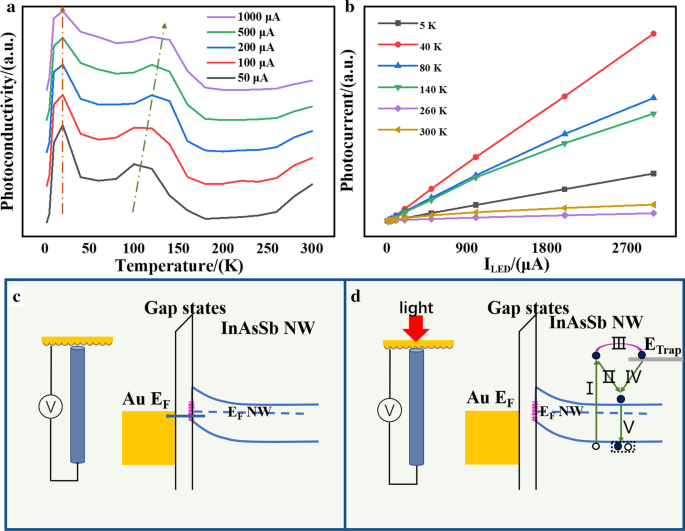
a A dependência da temperatura de Δ G medido com diferentes intensidades de luz. b A dependência de poder de Δ G medido em diferentes temperaturas. c A estrutura de banda do dispositivo com tensão de polarização. d A estrutura de banda do dispositivo com a iluminação de luz
A fotocorrente pode ser expressa por [28]
$$ {I} _ {p} =qg {V} _ {\ mathrm {NW}} [\ tau {\ mu} _ {d} / l] $$ (3)
onde \ (q \) é a carga elementar, \ (g \) é a taxa de geração do fototransportador, \ ({V} _ {\ mathrm {NW}} \) é o volume NW, \ (\ tau \) é o tempo de vida da portadora minoritária, e \ ({\ mu} _ {d} \) é a mobilidade de deriva e \ (l \) é o comprimento NW. Essa equação esclarece que a vida útil da portadora minoritária e a mobilidade de deriva são dois parâmetros-chave para a fotocorrente [43]. O processo optoelétrico do dispositivo de matriz InAsSb é mostrado na Fig. 4c, d. Antes da importação da luz, a transferência de elétrons entre Au e InAsSb NWs forma a corrente escura. Os estados de lacuna devido ao dipolo da interface são curtos o suficiente para a transferência da portadora com momento suficiente. Em nosso dispositivo, os estados de interface induzidos pela estrutura de geminação nativa e os defeitos induzidos por fabricação podem atuar como estados de captura. Com a luz acesa, os elétrons em excesso com energia e momento suficientes seriam aprisionados nos estados da interface, conforme mostrado nos processos I e III. A diminuição da concentração de elétrons aumenta a mobilidade no canal e prolonga a vida útil dos elétrons fotogerados. Por outro lado, os elétrons presos no estado de interface espalham os elétrons no canal e fazem a mobilidade diminuir. Os elétrons liberados voltariam para a banda de condutância através do processo IV e participariam da corrente. Os elétrons com energia mais baixa seriam motivados para a banda condutiva e participariam da corrente conforme mostrado no processo II. Depois de um tempo, os elétrons seriam recombinantes com os buracos deixados na banda de valência, como mostrado no processo V. Podemos concluir dois tipos de processos de espalhamento no dispositivo:os centros de espalhamento de elétrons de aprisionamento e espalhamento elétron-elétron no canal [49] . Mais elétrons de captura nos estados de interface diminuiriam a mobilidade da portadora e a concentração da portadora no canal. Posteriormente, o espalhamento elétron-elétron seria enfraquecido e atuaria no aumento da mobilidade por sua vez. Em conclusão, esses dois processos de espalhamento iriam cooperar na corrente e obter um extremo em torno de 10–20 K. A característica notável desse pico é a estrutura de “cauda”, o local do pico estável e a fotocondutância persistente com a iluminação de luz ultra fraca. Com a iluminação de luz ultrafraca, a quantidade induzida de fótons não é suficiente para atingir a fotocorrente saturada de uma vez. Portanto, o dispositivo mostra uma fotocorrente persistente até a saturação. Quando a intensidade da luz é aumentada, os portadores fotoexcitados aumentam a corrente e alcançam o valor extremo em um curto tempo de resposta. No entanto, é mais complicado com maior intensidade de luz. As portadoras em excesso nos estados saturados ficam presas nos estados da interface. Quando os elétrons presos são liberados para a banda de condutância, a concentração aumenta novamente. O aumento do espalhamento elétron-elétron diminui a corrente, o que é conhecido como efeito retardado, e cria a estrutura de “cauda”.
Para o segundo pico em torno de 100-120 K, uma mudança de pico semelhante foi relatada no Bi 2 Te 3 filme [50]. Nossa análise indica a existência de centros de recombinação nesta faixa de temperatura. O mecanismo intrínseco é semelhante ao Bi 2 Te 3 , ambos relacionados ao equilíbrio da fotocorrente (\ ({I} _ {\ mathrm {p}} \)) e da corrente escura (\ ({I} _ {\ mathrm {d}} \)). Em nosso caso, \ ({I} _ {\ mathrm {d}} \) é quase constante em toda a faixa de temperatura de medição. \ ({I} _ {\ mathrm {p}} \) é determinado pelo tempo de vida da portadora minoritária e mobilidade de deriva. Observou que esses dois parâmetros de InAsSb NWs têm relações de dependência oposta com a temperatura. Para o tempo de vida do portador minoritário, os portadores escuros excitados termicamente aumentam com a temperatura, bem como a taxa de recombinação dos portadores fotogerados [51]. Desse modo, a vida útil da portadora minoritária é inversamente proporcional à temperatura. A mobilidade da deriva é proporcional à temperatura, pois a alta temperatura surge o efeito da excitação térmica nos NWs. O pico surge quando \ ({I} _ {\ mathrm {p}} \) e \ ({I} _ {\ mathrm {d}} \) alcançam o equilíbrio em uma determinada temperatura, que é cerca de 100-120 K Com uma intensidade de luz mais alta, uma quantidade maior de portadores fotogerados precisaria de mais portadores termicamente excitados em uma temperatura mais alta para exigir o equilíbrio. Portanto, o segundo pico muda para uma temperatura mais alta quando a intensidade da luz aumenta. A Figura 4b mostra a fotocondutividade da dependência da intensidade da luz do dispositivo InAsSb NW, onde o Δ G os valores não são normalizados. Como pode ser visto, a intensidade da luz do LED aumenta estritamente linearmente com a corrente de entrada (consulte o arquivo adicional 1:Figura S6). Hence, this result represents the relationship between the photoresponse and the light intensity, demonstrating the potential of the InAsSb NW array device in optical power meter.
Conclusões
In summary, the sandwich-structured photodetector based on InAsSb NW array has achieved a splendid optical performance due to the MIGS induced by the end-bonded contact. Interface dipole and gap states suppress the dark current and enhance detection ability of the device. The native defects and the fabricated-induced defects in the device act as the interface states to modulate the optical properties. Even with the ultraweak light (4–20 nW/cm 2 ) illumination, the device shows obvious photoresponse at room temperature. The response to LEDs with different wavelengths indicated that the InAsSb NW array device has the strongest response to the infrared light (945 nm). The photoresponsivity and photodetectivity are 40 A/W and 7 × 10 11 cm Hz 1/2 W −1 , respectivamente. These results confirmed that the sandwich structure in this study favors the repeatability and reliability of the NW devices, which paves a way for the fabrication of NW-based devices. Most importantly, the device may work in an ambient environment at room temperature, which is a great breakthrough for infrared detection.
Disponibilidade de dados e materiais
Todos os dados estão totalmente disponíveis sem restrição. Os conjuntos de dados usados e / ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente, mediante solicitação razoável.
Abreviações
- MBE:
-
Epitaxia de feixe molecular
- 1D:
-
Unidimensional
- NW:
-
Nanowire
- BEP:
-
Pressão equivalente do feixe
- VS:
-
Vapor–solid
- VLS:
-
Vapor–liquid–solid
- EBL:
-
Litografia de feixe de elétrons
- RIE:
-
Reactive ion etching
- WZ:
-
Wurtzite
- ZB:
-
Zinc blende
- BFTEM:
-
Bright-field scanning electron microscope
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- SAED:
-
Difração de elétrons de área selecionada
- EDS:
-
Energy disperse spectroscopy
- MIGS:
-
Metal-induced gap state
- IDEE:
-
Interface dipole enhancement effect
- LED:
-
Light emitting diode
Nanomateriais
- Transporte quântico torna-se balístico
- Nanopartículas de semicondutor
- Nanocups podem dobrar luz
- Absorção de luz aprimorada por plasma em células solares nanowire de GaAs de junção (p-i-n):um estudo de método de simulação FDTD
- Desempenho fotovoltaico de uma célula solar nanofio / ponto quântico híbrido de nanoestrutura
- Dependências de temperatura e pressão das propriedades elásticas de cristais simples de tântalo sob carga de tração <100>:um estudo de dinâmica molecular
- Otimização de células solares GaAs Nanowire Pin Junction Array usando Heterojunções AlGaAs / GaAs
- Usando IA para controlar as propriedades da luz | Geração de supercontínuo
- C# - Propriedades
- Matriz Detector de Indutância Cinética de Microondas de Infravermelho Distante (FIR MKID)



