Resistência de contato reduzida entre metal e n-Ge por inserção de ZnO com tratamento de plasma de argônio
Resumo
Investigamos os contatos de metal-isolador-semicondutor em n-Ge utilizando uma camada interfacial de ZnO (IL) para superar o efeito de pinning de nível de Fermi (FLP) na interface metal / Ge e reduzir a altura da barreira para elétrons. Um pequeno deslocamento de banda de condução de 0,22 eV na interface entre ZnO e n-Ge é obtido, e o ZnO IL leva à redução significativa da resistência de contato ( R c ) em metal / ZnO / n-Ge em comparação com o dispositivo de controle sem ZnO, devido à eliminação de FLP. Observa-se que o tratamento com plasma de argônio (Ar) de ZnO pode melhorar ainda mais o R c características no dispositivo Al / ZnO / n-Ge, devido ao fato de que o tratamento com plasma Ar aumenta a concentração de vacância de oxigênio V o , agindo como dopantes do tipo n em ZnO. O contato ôhmico é demonstrado no Al / ZnO / n-Ge com uma concentração de dopante de 3 × 10 16 cm −3 em Ge. No n + fortemente dopado -Ge com um íon de fósforo (P + ) implantação, uma resistividade de contato específica de 2,86 × 10 - 5 Ω cm 2 é alcançado em Al / ZnO / n + -Ge com tratamento de plasma Ar.
Histórico
O germânio (Ge) tem atraído muita atenção para os transistores de efeito de campo semicondutores de óxido metálico avançado (MOSFETs) devido à sua maior mobilidade de portadores em comparação com o Si [1, 2]. Para os MOSFETs de canal p Ge, grande progresso foi feito no crescimento do canal Ge tenso [3,4,5], passivação de superfície [6,7,8,9] e contatos de fonte / dreno (S / D) [ 10], e os ultra-escalonados Ge pFinFETs [11] demonstraram o desempenho elétrico superior aos dispositivos de Si. Os transistores Ge n-channel, por outro lado, ainda enfrentam desafios, que produzem o obstáculo para a integração do Ge CMOS, incluindo a qualidade de interface ruim, resultando na baixa mobilidade de elétrons e a alta resistência S / D devido à ativação limitada taxa de dopantes tipo n em Ge [12] e a fixação de nível de Fermi (FLP) na interface metal / n-Ge [13]. FLP leva a uma barreira de altura Schottky de cerca de 0,5 eV para elétrons para a maioria dos metais em n-Ge, produzindo uma resistência de contato muito grande R c [13,14,15].
O depinning de nível de Fermi pode ser feito inserindo uma camada interfacial fina (IL), por exemplo, TiO 2 [16] e ZnO [17], entre os metais e n-Ge [18], devido a que o IL fino pode bloquear a função de onda do metal em Ge para reduzir os estados de gap induzidos por metal [19, 20]. ZnO tem deslocamento de banda de condução pequeno (CBO) em relação ao Ge, o que pode levar ao menor R c em metal / ZnO / n-Ge, em comparação com metal / TiO 2 / n-Ge com TiO 2 / Ge tendo o CBO positivo [16]. A constante dielétrica do ZnO é menor que a do TiO 2 , então ZnO IL pode obter uma região de depleção mais fina entre o metal e n-Ge em comparação com TiO 2 . Além disso, é fácil realizar a dopagem do tipo n em ZnO, introduzindo defeitos não estequiométricos, como lacunas de oxigênio V o [21, 22], o que dá origem a uma região de depleção de ZnO ainda menor entre o metal e o n-Ge. Até o momento, em contatos metal / ZnO / n-Ge, a dopagem de ZnO por V o foi realizada por recozimento em atmosfera de nitrogênio [16], o que, no entanto, pode resultar na interdifusão de ZnO e Ge durante o recozimento [23], e difusão de átomos dopantes em n-Ge durante o recozimento [24, 25], causando a degradação do desempenho atual do dispositivo. Desde então, um processo de baixa temperatura para deposição e dopagem de ZnO precisa ser desenvolvido.
Neste trabalho, investigamos o depinning em nível de Fermi na interface entre o metal e o n-Ge pela inserção de ZnO IL depositado por ALD. Os efeitos de melhoria do tratamento com plasma de argônio (Ar) da camada de ZnO nas características de resistência de contato do Al / ZnO / n-Ge são estudados.
Métodos
Contatos de metal foram formados em wafers n-Ge (001) levemente dopados e fortemente dopados. As amostras de Ge levemente dopadas têm uma concentração de dopagem de cerca de 3 × 10 16 cm −3 . Para alcançar o n-Ge fortemente dopado, um íon de fósforo (P + ) implante com uma dose de 1 × 10 15 cm −2 e uma energia de 30 keV foi realizada no n-Ge (001), que foi seguida por um recozimento térmico rápido a 600 ° C por 60 s. Após a limpeza do wafer usando vários ciclos de água desionizada e HCl diluído, os wafers de Ge foram imediatamente carregados na câmara ALD (Beneq TSF-200) para depositar ZnO e, em seguida, os contatos de alumínio (Al) foram depositados por pulverização catódica em Ge usando um processo de decolagem . Aqui, três espessuras de ZnO de 1, 2 e 3 nm foram utilizadas, as quais foram confirmadas por elipsometria espectroscópica (SE) (J. A. Woollam M2000). Durante a deposição de ZnO, dietil zinco (DEZn) e água desionizada (H 2 O) foram usados como precursores de Zn e O, respectivamente, e a temperatura do substrato foi mantida 150 ° C para eliminar a formação de GeO x . O detalhado processo de deposição de ZnO usando ALD foi relatado em nossos trabalhos anteriores na ref. [26, 27]. Para melhorar ainda mais a condutividade do filme de ZnO, algumas amostras de ZnO em Ge foram tratadas com plasma de argônio (Ar). A amostra de controle Al / n-Ge sem ZnO IL também foi fabricada. O R c de Al no ZnO / Ge foi extraído usando o método da linha de transmissão circular (CTLM), que foi formado por lift-off. O ZnO exposto foi totalmente decapado por ataque de plasma para garantir o isolamento completo entre dispositivos adjacentes [16].
Keithley 4200 SCS foi usado para medir as características elétricas dos contratos Al / ZnO / n-Ge e estruturas CTLM, microscópio eletrônico de transmissão de alta resolução (HRTEM) e espectroscopia de fotoelétrons de raios-X (XPS) foram usados para determinar a microestrutura e interface propriedades das amostras, e espectrofotômetro UV-VIS (LAMBDA 950, PerkinElmer) foi usado para determinar o gap E g de filme ZnO depositado.
Resultados e discussão
Caracterização do material de Al / ZnO / n-Ge
Os espectros da banda de valência XPS de Ge / ZnO e o espectro de transmitância de ZnO são apresentados nas Figs. 1 e 2, respectivamente, que foram utilizados para investigar o mecanismo do efeito de depinning do nível de Fermi na interface Al / ZnO / n-Ge. Conduzimos as medições XPS para a amostra de ZnO espessa, amostra de interface ZnO / n-Ge e amostra de Ge puro, para obter o deslocamento da banda de valência (VBO) de ZnO / Ge, como mostrado na Fig. 1. O Zn 2 p a posição do pico e o VBM para a amostra de ZnO espesso são 1021,9 eV e 2,59 eV, respectivamente. O Zn 2 p e Ge 3 d a posição de pico para a amostra de interface ZnO / Ge são 1021,7 eV e 29,1 eV, respectivamente. O Ge 3 d posição de pico e VBM para amostra de Ge puro são 29 eV e 0,06 eV, respectivamente. Isso indica que o VBO de ZnO / Ge é 2,33 eV [30].

Espectros XPS para bandas de valência de amostra ZnO / Ge. a Zn 2 p e b espectro de banda de valência para amostra de ZnO espesso c ZnO 2 p e d Ge 3 d espectros para amostra de interface ZnO / Ge e e Ge 3 d e f espectro de banda de valência para amostra Ge em massa
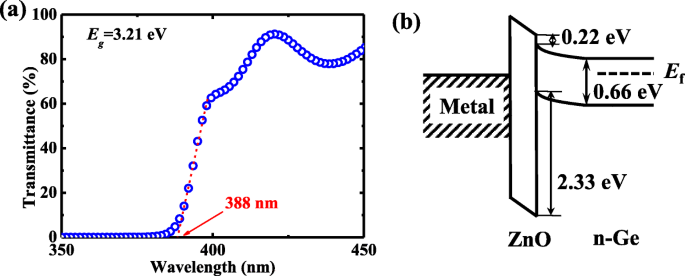
a Espectro de transmitância para o filme de ZnO depositado demonstrando o E g de 3,21 eV. b O alinhamento da banda para contato Al / ZnO / Ge
A Figura 2a mostra o gráfico de transmitância obtido a partir da espectroscopia UV-VIS para a amostra de ZnO espessa, e o E g de ZnO é determinado como sendo 3,21 eV, consistente com os valores relatados em [28, 29]. Usando o E obtido g de ZnO e VBO acima, um CBO de 0,22 eV entre ZnO e Ge é determinado, como mostrado na Fig. 2b. Isso indica que o depinning de nível de Fermi pode ser alcançado na interface Al / n-Ge usando a camada de inserção de ZnO, que pode produzir o baixo R c para contato Al / ZnO / n-Ge.
A Figura 3 mostra a imagem TEM da estrutura Al / ZnO / n-Ge com a espessura de ZnO de 3 nm. Uma camada de ZnO uniforme e conformada é observada entre Al e n-Ge. A inserção no canto superior direito ilustra a imagem HRTEM da visão ampliada da interface Al / ZnO / n-Ge. A espessura do filme de ZnO é medida em 3 nm, o que é consistente com o resultado obtido pela medição SE, e o filme de ZnO está na forma amorfa.
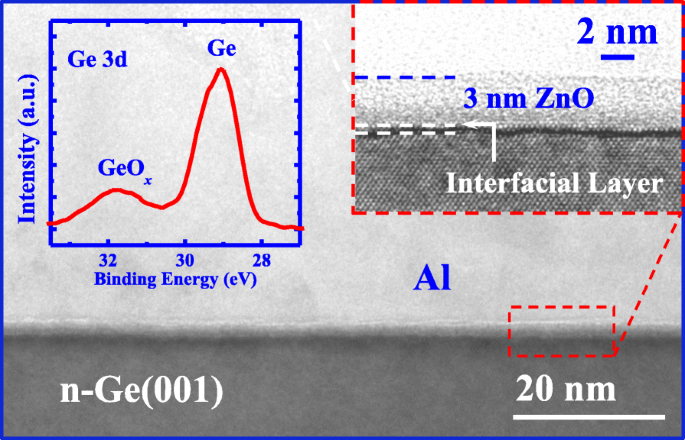
Imagem TEM para uma amostra Al / ZnO / n-Ge mostrando a camada uniforme de ZnO entre Al e Ge. A inserção superior direita mostra a imagem HRTEM da interface Al / ZnO / n-Ge, e a inserção superior esquerda mostra o XPS Ge 3 d resultado da amostra demonstrando a existência de GeO x camada interfacial
Um fino GeO x A camada interfacial é formada entre Ge e ZnO, que é muito menor em comparação com [31] devido à menor temperatura de deposição usada neste trabalho. Isso é atribuído ao fato de que, durante a deposição de ZnO, Ge reativo com o precursor O, levando à formação de GeO x IL. GeO x também é demonstrado pelo XPS Ge 3 d resultar na inserção no canto superior esquerdo.
A condutividade elétrica do filme de ZnO pode ser melhorada pelo tratamento com plasma Ar, que causa o aumento na concentração de vacâncias de oxigênio V o , atuando como os doadores em ZnO [32, 33]. A Figura 4 mostra os resultados de XPS de O 1 s para ZnO depositado e a amostra com tratamento de plasma Ar com uma potência de 50 W, um fluxo de gás Ar de 60 sccm e uma duração de 45 s. O 1 s o pico é deconvoluído em dois picos usando o ajuste de Gauss. O pico em ~ 530 eV corresponde ao oxigênio da rede em ZnO [34, 35]. Para a amostra conforme depositada, o pico em 531,7 eV corresponde a V o (~ 531,5 eV) e oxigênio adsorvido quimicamente na superfície de filmes finos de ZnO, como grupos carbonila e hidroxila [35, 37]. Para a amostra com tratamento de plasma Ar, o pico está em ~ 531,5 eV, que muda para menor energia de ligação e fica muito mais pronunciado em comparação com a amostra depositada, indicando que mais V o são gerados devido ao tratamento com plasma Ar, e o oxigênio adsorvido quimicamente é removido com eficácia. O aumento de dopantes tipo n em ZnO resulta na barreira de tunelamento mais fina e menor resistência em série na interface, sendo responsável pela redução em R c [36].

Resultados XPS de O 1 s e os resultados deconvoluídos para amostras de ZnO (3 nm) / n-Ge conforme depositadas (superior) e tratadas com plasma de Ar (inferior)
Fizemos as medições de XPS usando amostra de ZnO espessa e amostra de interface ZnO / Ge com e sem tratamento com plasma Ar, como mostrado na Fig. 5. Descobrimos que, após o tratamento com plasma Ar, houve um desvio de - 0,05 eV. Isso pode indicar que o ZnO / Ge VBO é cerca de 2,38 eV após o tratamento com plasma Ar e CBO de 0,17 eV.

VBM para amostra de interface ZnO / Ge com e sem tratamento de plasma de AR. a Zn 2 p e b espectro de banda de valência para amostra de ZnO espesso c ZnO 2 p espectros para amostra de interface ZnO / Ge. d Diagrama de alinhamento de banda para metal tratado com plasma Ar / ZnO / n-Ge
Desempenho elétrico de contatos Al / ZnO / n-Ge
A Figura 6a mostra a densidade de corrente medida J em função da tensão aplicada V características para contatos de Al em n-Ge levemente dopado. O Al / ZnO / n - -Os dispositivos GE têm diferentes espessuras de camada de ZnO. O esquema do dispositivo é mostrado na inserção da Fig. 6.
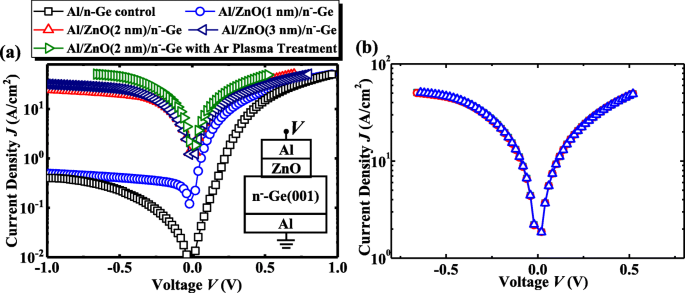
a J - V características para Al / n - -Ge controle, Al / ZnO / n - -Ge com espessuras de ZnO de 1 nm, 2 nm e 3 nm, e Al / 2 nm Ar tratado com plasma de ZnO / Ge, b J -V características para três dispositivos ZnO / Ge tratados com plasma Al / 2 nm Ar
Como previsto, o dispositivo de controle Al / n-Ge sem ZnO mostra as características de retificação com a alta altura de barreira para elétrons devido à fixação do nível de Fermi em Al / n - -Ge [38]. Em comparação com a amostra de controle Al / n-Ge sem ZnO, os dispositivos Al / ZnO / n-Ge exibem o reverso melhorado J , que é devido ao depinning do nível de Fermi induzido pela redução dos estados de gap induzidos por metal (MIGS) na interface metal / Ge [18, 19]. Essa melhora é mais intensificada com ZnO mais espesso, o que se deve ao fato de que mais MIGS são eliminados. Mas a densidade de corrente direta para um dispositivo inserido de ZnO de 3 nm é menor do que a de um de 2 nm. Isso pode ser explicado da seguinte maneira. A principal densidade de corrente para Al / ZnO / n-Ge é a corrente de tunelamento. Se o ZnO não for espesso o suficiente, o MIGS não será eliminado efetivamente e ainda apresenta características retificadoras. Mas se o ZnO for muito espesso, a resistência em série do ZnO dominará toda a resistência e a corrente ficará menor. Portanto, há um trade-off entre a eliminação do MIGS e o aumento da resistência em série do ZnO e, portanto, há uma espessura crítica para o IL [19]. Em conclusão, 2 nm é considerada a espessura ideal para o contato Al / ZnO / n-Ge.
Com o tratamento de plasma Ar, o desempenho de Al / ZnO / n - -Dispositivo Ge foi melhorado. Qualquer que seja a varredura reversa ou direta da tensão aplicada V , Al / 2 nm ZnO / n - -Dispositivo Ge com tratamento de plasma Ar atinge o J aprimorado em comparação com o dispositivo com ZnO de 2 nm ou ZnO de 3 nm, o que é devido a uma grande quantidade de V o são gerados no filme de ZnO durante o tratamento com plasma de AR. A maior concentração de dopagem em ZnO pode efetivamente reduzir a resistência em série do ZnO e reduzir a barreira de tunelamento para elétrons na interface entre ZnO e Al, melhorando a densidade de corrente de tunelamento.
A Figura 6b mostra J - V características para três Al / 2 nm ZnO / n - -Ge dispositivo com tratamento de plasma AR. É claro que o J para dispositivos diferentes é quase o mesmo, indicando que o processo ALD e o tratamento com plasma Ar têm efeito uniforme na melhoria da densidade de corrente.
Contatos ôhmicos são obtidos para Al / 2 nm ZnO / n - -Ge sem e com diferentes durações de tratamento com plasma Ar de 15 s, 30 s, 45 s e 60 s, respectivamente, que são mostrados na Fig. 7.

eu - V curvas em Al / 2 nm ZnO / n - -Faça com diferentes d a sem tratamento com plasma Ar e com duração do tratamento com plasma Ar de b 15 s, c 30 s, d 45 s e e anos 60
A resistência total bruta R tot entre dois contatos diminui com a diminuição de d , e o R final tot é modificado por um fator de correção C, que é calculado com a equação C =( L / d ) · Ln (1 + d / L ) [39], onde L =25 μm representa para o raio da almofada interna, conforme ilustrado na inserção na Fig. 8a. Traçando o R tot como uma função de d na Fig. 8a, a resistência da folha R sh do n - -Ge pode ser obtido a partir da inclinação da linha, e então ρ c é calculado a partir da interceptação da linha de ajuste linear com o eixo vertical. Para o ZnO / n Al / 2 nm - -Dispositivo Ge sem tratamento de plasma Ar, o ρ c é 6,87 × 10 −2 Ω cm 2 , mas após 45 s de tratamento com plasma Ar, há uma redução de 17,2 vezes em comparação com aquele sem tratamento com plasma Ar e tem a resistividade de contato ρ c de 3,66 × 10 −3 Ω cm 2 . Comparamos os valores de ρ c para Al / 2 nm ZnO / n - -Dispositivos Ge com diferentes durações de tratamento com plasma Ar na Fig. 8b. Observa-se que ρ c do dispositivo diminui com o tempo de tratamento até 30 s. No entanto, como o tempo de tratamento é superior a 30 s, ρ c quase permanece o mesmo. A redução em ρ c pode ser atribuída ao doping de ZnO, portanto, à redução da barreira de tunelamento e resistência em série, conforme já mencionado. Mas não há mudança observável na resistência da folha de n - -Ge, indicando que não há efeito na condutividade de n - -Ge com tratamento de plasma Ar.
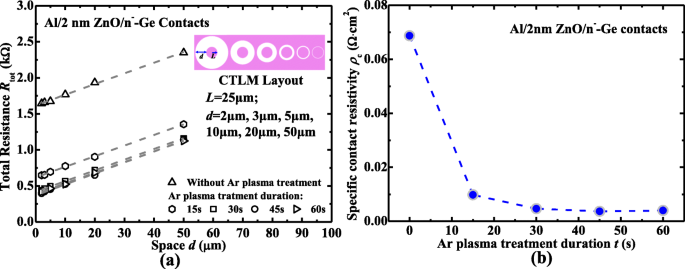
a R tot versus d curvas para o CTLM com Al / 2 nm ZnO / n - -Ge contatos com diferentes durações de tratamento com plasma Ar, a inserção na Fig. 5a é a informação da estrutura CTLM usada neste trabalho. b ρ c versus diferente duração do tratamento com plasma Ar
A estrutura CTLM com contatos de Al em Ge fortemente dopado é usada para investigar a característica de resistência de contato de Al / 2 nm ZnO / n + -Ge. A camada de ZnO foi submetida ao tratamento com plasma de Ar por 45 s. A Figura 9a mostra o I medido - V curvas entre os contatos Al com diferentes d , mostrando o excelente desempenho ôhmico. A Figura 9b representa o R tot como uma função de d para Al / 2 nm ZnO / n + -Ge CTLM e R sh e ρ c são extraídos para serem 64 Ω / □ e 2,86 × 10 −5 Ω cm 2 , respectivamente.
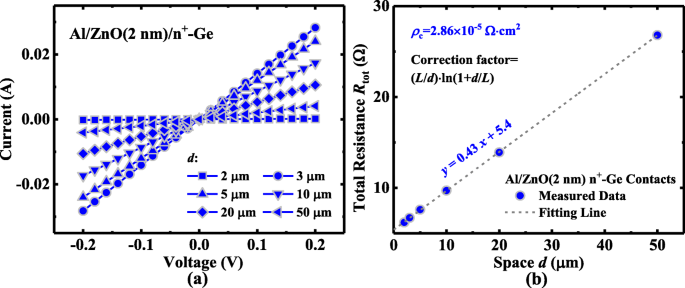
a eu - V curvas em Al / ZnO (2 nm) / n + -Faça com diferentes d com ZnO tratado com plasma de Ar. b R tot versus d curvas para o CTLM com Al / ZnO (2 nm) / n + -Ge contatos
Comparamos o ρ c de ZnO tratado por plasma de Ar Al / ZnO / n + -Ge dispositivos neste trabalho com aqueles relatados na literatura, como mostrado na Fig. 10. Para o n + fortemente dopado -Ge amostra de contato, Al / ZnO / n + -Ge contatos mostrados o menor ρ c em comparação com os de Ni / GeSn [40, 41], Ni / Ge [42], Ti / n + -Ge na ref. [31] e Ti / TiO 2 / GeO 2 / Ge [31], Ni / Ge com implantação de carbono [42] e Ti / n + -SiGe / n-Ge [43]. Contatos ôhmicos metálicos, como Ni / Ge, Ni / GeSn, Ti / Ge e Ni / Ge com implantação de carbono sofrem de forte fixação de nível de Fermi, resultando em grande ρ c . Para Ti / TiO 2 / GeO 2 / Ge contact, uma grande resistência de tunelamento foi introduzida pela bicamada de 1 nm TiO 2 /1,5 nm GeO 2 IL, degradando as características de resistividade do contato. Mas o ρ c neste trabalho é maior do que na ref. [44]. Presumimos que isso pode ser devido ao P + quatro vezes maior dose de implantação do que em nosso trabalho. Uma dose de implantação maior permitirá a dopagem de superfície mais pesada de n + -Ge, resultando em uma barreira Schottky mais fina e menor ρ c . Acreditamos que com doping mais pesado de n + -Ge em Al / ZnO / n + -Dispositivos Ge, menores ρ c vai resultar em.
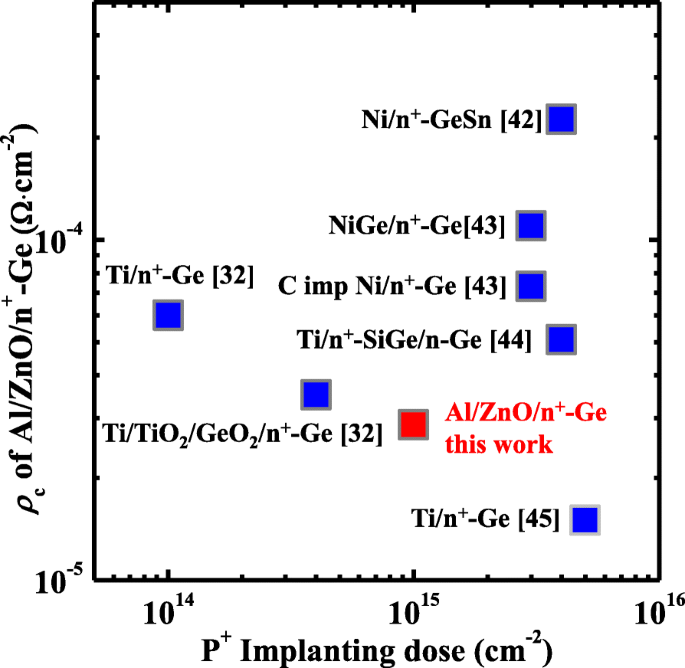
Comparação de ρ c de Al / ZnO / n + - Entre neste trabalho com os de outros contatos relatados, usando P + dose de implantação como x eixo
Conclusões
O efeito de depinning do nível de Fermi induzido por ZnO IL nas estruturas Al / ZnO / n-Ge é investigado. A medição XPS demonstrou um pequeno CBO de 0,22 eV em ZnO / n-Ge, ou seja, ocorre a eliminação de FLP, o que leva aos contatos ôhmicos de metal em n-Ge. É ainda relatado que o tratamento com plasma de Ar de ZnO leva ao aumento da concentração de V o , agindo como dopantes tipo n em ZnO, o que melhora o R c desempenho em dispositivos Al / ZnO / n-Ge. Contatos de metal ôhmico são obtidos em n - e n + -Ge com ZnO IL tratado com plasma Ar. Com base nas estruturas CTLM, valores de ρ c 3,66 × 10 −3 Ω cm 2 e 2,86 × 10 - 5 Ω cm 2 são alcançados em Al / 2 nm ZnO / n - -Ge e Al / 2 nm ZnO / n + -Ge, respectivamente, com o tratamento de plasma Ar de ZnO a uma potência de 50 W por 45 s.
Abreviações
- Al:
-
Alumínio
- ALD:
-
Deposição de camada atômica
- Ar:
-
Argônio
- CBO:
-
Deslocamento da banda de condução
- CTLM:
-
Método de linha de transmissão circular
- DEZn:
-
Dietil zinco
- E g :
-
Gap de banda
- FLP:
-
Fixação de nível de Fermi
- Ge:
-
Germânio
- GeO x :
-
Óxido de germânio
- GeSn:
-
Estanho de germânio
- HCl:
-
Ácido clorídrico
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- IL:
-
Camada interfacial
- MIGS:
-
Estados de lacuna induzidos por metal
- MOSFETs:
-
Transistores de efeito de campo semicondutores de óxido metálico
- Ni:
-
Níquel
- P + :
-
Íon fósforo
- R c :
-
Contato de resistência
- R tot :
-
Resistência total bruta
- SE:
-
Elipsometria espectroscópica
- Si:
-
Silício
- Ti:
-
Titânio
- TiO 2 :
-
Dióxido de titânio
- UV-VIS:
-
Ultravioleta-visível
- VBO:
-
Deslocamento da banda de valência
- V o :
-
Vaga de oxigênio
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- ZnO:
-
Óxido de zinco
- ρ c :
-
Resistividade de contato específica
Nanomateriais
- Qual é a diferença entre Inconel e Incoloy?
- Qual é a diferença entre chapa, chapa e folha de metal?
- Diferença entre estrutura e classe:explicada com exemplo de C++
- Diferença entre while e do-while:explicado com exemplos
- Ajuste da química da superfície de polieteretercetona por revestimento de ouro e tratamento com plasma
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- O que é tratamento térmico? - Processo e métodos
- Qual é a diferença entre fabricação de metal e soldagem de metal?
- Qual é a diferença entre fabricação de metal e soldagem?
- A diferença entre têmpera e recozimento



