Absorvente infravermelho próximo aprimorado:silício preto estruturado fabricado em duas etapas e sua aplicação no dispositivo
Resumo
O silício é amplamente utilizado na indústria de semicondutores, mas tem baixo desempenho em dispositivos fotoeletrônicos de infravermelho próximo por causa de sua alta refletância e limite de gap. Neste estudo, um processo de duas etapas, método de corrosão iônica reativa profunda (DRIE) combinado com implantação iônica de imersão em plasma (PIII), são usados para fabricar silício preto microestruturado na superfície de C-Si. Essas superfícies aprimoradas dopadas com elementos de enxofre realizam um gap mais estreito e um aumento da absorção de luz, especialmente na faixa do infravermelho próximo (800 a 2000 nm). Enquanto isso, a absorção de luz máxima aumenta significativamente até 83%. Um detector fotoeletrônico Si-PIN com silício preto microestruturado na superfície posterior exibe um desempenho notável do dispositivo, levando a uma responsividade de 0,53 A / W a 1060 nm. Este novo silício preto microestruturado, combinando a característica de gap estreito, pode ter uma aplicação potencial na detecção fotoeletrônica no infravermelho próximo.
Histórico
Até agora, muitos materiais de silício preto micro e nanoestruturados também podem ser fabricados usando tratamento DRIE e implantação de íons, com o objetivo de reduzir a refletância da luz e aumentar a absortância no infravermelho próximo [1,2,3,4,5]. O processo DRIE é geralmente realizado em um modo de etapas de passivação de corrosão cíclica com uma máscara fotorresistente que pode permitir a microfabricação de silício de estruturas de alta proporção de aspecto. Geralmente, esta abordagem utiliza plasmas baseados em F, como SF 6 para gravação isotrópica rápida e, em seguida, muda para um ciclo de passivação de parede lateral usando C 4 F 8 [6,7,8]. Durante o ciclo de ataque subsequente, o filme passivador é preferencialmente removido da parte inferior do sulco devido ao bombardeio de íons, evitando o ataque das paredes laterais [9]. Finalmente, a alternância dos ciclos de corrosão e passivação pode formar as geometrias específicas das estruturas de silício causadas pela corrosão, que dependem principalmente do tamanho da máscara, fluxo de gás, potência do eletrodo, tempo de processo, tempos de ciclo e assim por diante. A fim de aumentar a absorção de silício no comprimento de onda do infravermelho próximo, as estruturas de silício gravadas serão dopadas por implantação de íons após o processo DRIE. Sob certas condições, os arranjos de silício preto podem ser obtidos, e os dopantes de enxofre resultantes contidos na rede de silício acabarão por causar absorção significativa de radiação abaixo do intervalo de banda [10, 11].
Como um dos materiais mais importantes na indústria de semicondutores, o silício preto tem sido amplamente utilizado em detectores fotoeletrônicos sensíveis, células solares, sensores bioquímicos, dispositivos de exibição e objetos de comunicação óptica [12,13,14,15,16,17,18, 19,20]. Micro e nanoestruturas de silício preto têm sido o foco de intensas pesquisas nos últimos anos devido à sua ampla aplicação em dispositivos. Um detector fotoeletrônico Si-PIN com silício preto na superfície frontal foi investigado em nosso estudo inicial [21]. Esta estrutura do dispositivo tem uma ampla camada de depleção de modo que pode reduzir a influência do movimento de difusão do portador e atingir o objetivo de melhorar a sensibilidade do dispositivo e a velocidade de resposta. Também é notado que o uso de silício preto como superfície fotossensível é muito difícil para os portadores gerados serem coletados pela camada P para enviar fotocorrente através do eletrodo, resultando em uma resposta de luz visível relativamente baixa em comparação com um detector Si-PIN tradicional. Assim, parece que se um detector fotoeletrônico Si-PIN com silício preto na superfície posterior pudesse completar duas tarefas ao mesmo tempo, ou seja, aumentar a sensibilidade do dispositivo não apenas no infravermelho próximo, mas também no comprimento de onda visível?
Neste artigo, relatamos o aumento da absorção de luz e a característica de gap mais estreito do silício preto microestruturado fabricado por um processo de duas etapas:DRIE combinado com PIII. O efeito de diferentes processos de corrosão na absorção de luz na faixa de comprimento de onda de 400 a 2000 nm foram estudados, e o detector baseado neste silício preto microestruturado na superfície posterior também foi investigado com ênfase na responsividade do dispositivo no comprimento de onda de 400 ~ 1100 nm.
Métodos
Conforme mostrado na Fig. 1a, arranjos cilíndricos de distribuição uniforme e periódica foram escolhidos para pesquisar as propriedades ópticas do silício microestruturado pelo software de simulação FDTD. A Figura 1b representa a relação entre a absorbância e quatro diferentes tamanhos de modelo do silício microestruturado após simulação otimizada, em que quatro modelos têm o mesmo diâmetro de cilindro ( D =4 μm) mas distância central diferente ( T 1 =12 μm, T 2 =10 μm, T 3 =8 μm, T 4 =6 μm).
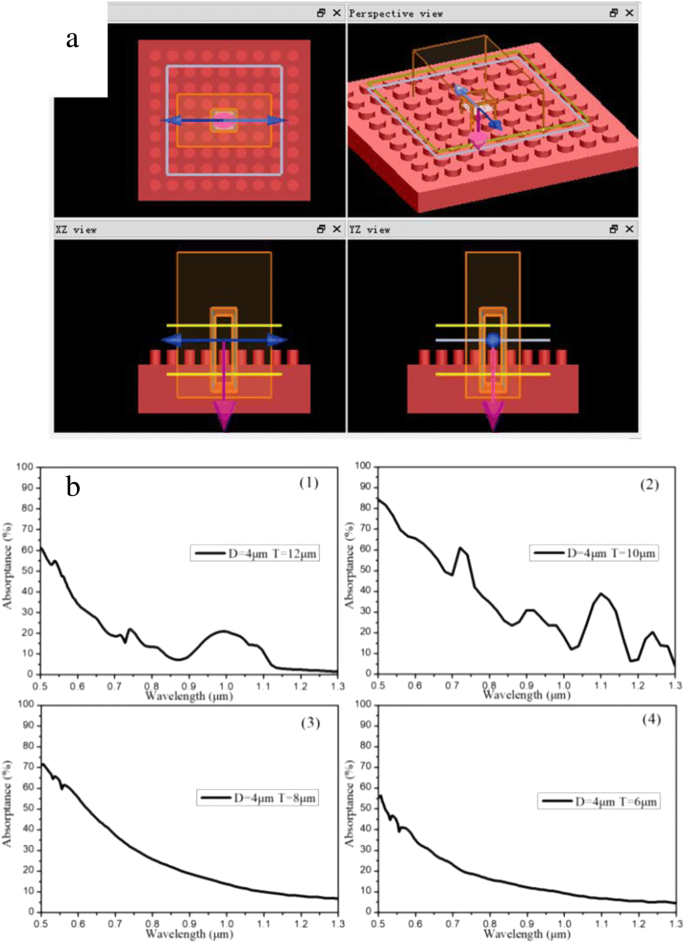
Modelo de simulação óptica ( a ) e resultados de simulação ( b ) de silício microestruturado
Conforme mostrado na Fig. 2, com base nos resultados de simulação otimizados acima, três diferentes máscaras de fotolitografia foram projetadas variando o tamanho da máscara denominada máscara I ( D =4 μm, T =6 μm), máscara II ( D =4 μm, T =8 μm) e máscara III ( D =4 μm, T =10 μm), respectivamente. Em seguida, fotoresiste NR9-1500PY foi aplicado para depositar máscara de matrizes circulares na superfície de polimento de peças de silicone (15 × 15 cm 2 ), que foram cortados de pastilhas de silício do tipo n com uma espessura de 500 μm e uma resistividade de 2500 a 3000 Ω · cm. A fim de investigar o efeito do processo de corrosão na absorção de luz do silício microestruturado, movemos as amostras de teste resultantes da máscara III para a cavidade do processo (DRIE, ICP-100D) e alteramos os tempos de ciclo, em que SF 6 foi usado como gás de corrosão e C 4 F 8 como gás passivador, 30 vezes, 70 vezes e 100 vezes, de maneira diferente. Após os processos de corrosão, as peças de silício foram removidas de qualquer fotorresiste residual sob a atmosfera de oxigênio para garantir que a superfície de silício estivesse limpa e lisa. A fim de aumentar a absortância do silício microestruturado, especialmente na faixa do infravermelho próximo, as amostras de teste resultantes da máscara III a seguir foram dopadas com elementos de enxofre através do processo PIII sob a condição de 1,0E + 15 cm - 2 dose de implantação e energia de implantação de 800 eV, respectivamente.

O diagrama esquemático do tamanho da máscara
As morfologias do silício preto foram caracterizadas por um microscópio eletrônico de varredura por emissão de campo (SEM, JSM-7500F). A absortância luminosa foi obtida em temperatura ambiente por meio de espectrômetro de fibra ótica (NIR2500) equipado com esfera integradora (Idea Optics, IS-20-5). A responsividade do detector foi medida usando um medidor de potência óptica (OPHIR, Vega), um chopper óptico (Scitec Instruments, Modelo-300CD) e um aparelho Keithley2636B em ambiente de sala escura. Para garantir a precisão da medição, realizamos a calibração antes do teste e cada uma dessas medições foi realizada em algumas amostras (geralmente 4 a 6).
Resultados e discussão
A Figura 3 dá as imagens típicas de SEM de matrizes de silício microestruturadas alinhadas que são perpendiculares à superfície do substrato para três tamanhos de máscara diferentes. É claramente mostrado que a vista superior do silício microestruturado não é realmente círculos padrão devido ao fato de que o processo DRIE depende principalmente do tamanho da máscara e da qualidade da técnica de fotolitografia. Então, a fim de investigar o efeito do processo de corrosão na absorção de luz do silício microestruturado, alteramos os tempos de ciclo como 30, 70 e 100 vezes nas amostras de teste da máscara III sob as condições de corrosão com SF 6 por 3 s, e passivando com C 4 F 8 por 2 s, a cada tempo de ciclo.
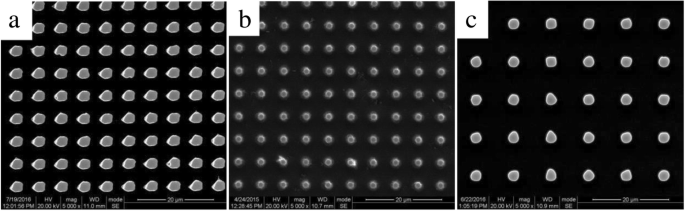
Matrizes de silício microestruturadas típicas feitas pela DRIE para diferentes tamanhos de máscara. a Máscara I. b Máscara II. c Máscara III
De acordo com a razão de diferentes taxas de corrosão entre fotorresiste e silício, a profundidade de corrosão pode ser controlada por parâmetros de processo, desde que o fotorresiste seja espesso o suficiente como uma máscara. Pode-se observar na Fig. 4 que a altura dos cilindros aumenta com o número de tempos de ciclo, em que a altura do topo ao substrato são cerca de 1,87 μm, 2,35 μm e 3,15 μm, respectivamente. É bem sabido que no processo DRIE, embora existam gases passivadores para proteger a parede lateral do alvo de ataque, ainda é mais ou menos acompanhado por ataque lateral. Esta é a razão pela qual as morfologias resultantes não são matrizes cilíndricas ideais. Obviamente, as morfologias dessas matrizes de silício microestruturadas podem ser bem controladas por processos de litografia variados e tempos de ciclo de corrosão.
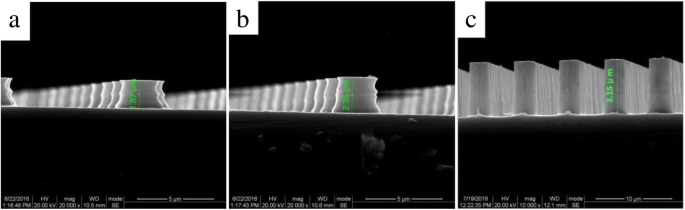
Vistas seccionais de amostras da máscara III fabricadas para diferentes tempos de ciclo. ( a ) 30, ( b ) 70, e ( c ) 100
A Figura 5a representa a absortância de luz de arranjos cilíndricos microestruturados em diferentes tempos de ciclo sem processo PIII. É mostrado que o C-Si com matrizes de silício gravadas, em comparação com o C-Si comum, pode aumentar a absorção de luz em toda a faixa de comprimento de onda de 400 a 2000 nm até certo ponto. A amostra condicionada por 100 tempos de ciclo apresenta a maior absortância, até 70% na faixa NIR (800 a 2000 nm), e a absortância média dessa amostra chega a 55% na faixa de comprimento de onda de 400 a 2000 nm. Isso se deve à reflexão e absorção múltiplas do silício microestruturado (como na Fig. 6). No curso da luz incidente sendo refletida continuamente na superfície lateral do cilindro, o comprimento do caminho de absorção da luz incidente aumenta, resultando no aumento da absorção. No entanto, a taxa de absorção ainda não é alta o suficiente quando o comprimento de onda é superior a 1000 nm. Portanto, a fim de melhorar ainda mais a absortância do silício microestruturado, especialmente na banda do infravermelho próximo, as mesmas amostras são dopadas com elementos de enxofre pelo processo PIII sob a condição de 1,0E + 15 cm - 2 dose de implantação e energia de implantação de 800 eV, respectivamente. Conforme mostrado na Fig. 5b, a absortância da luz é obviamente aumentada na faixa de comprimento de onda de 400 a 2000 nm após a implantação do íon. Aqui, a absorção de luz da amostra gravada por 100 tempos de ciclo é muito maior do que a do C-Si. A absorção de luz máxima e média aumentam significativamente até 83% e 62%, respectivamente. Além disso, pode-se observar facilmente (como na Fig. 5c) que a absortância de 100 amostras de ciclo tem uma mudança significativa no comprimento de onda de 800 a 2000 nm antes e depois da dopagem de elementos de enxofre, em que os valores máximos e médios aumentam em 13% e 7%, respectivamente.
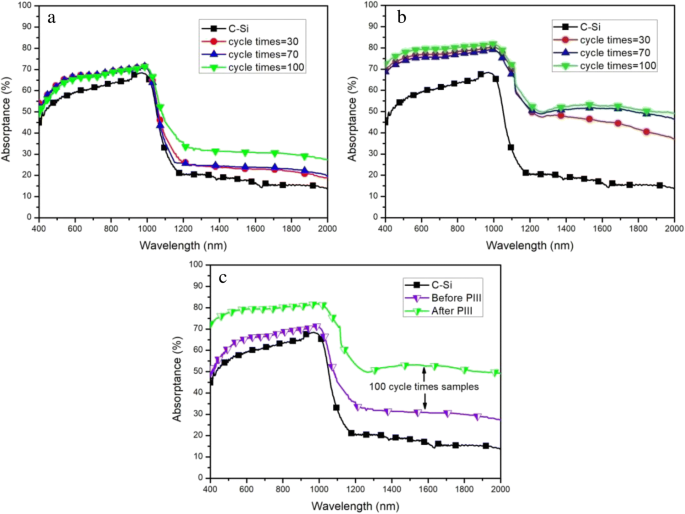
Absorção de C-Si e silício preto fabricado por diferentes tempos de ciclo antes ( a ) e após PIII ( b ) e comparação de 100 amostras de ciclo ( c )

O caminho de transmissão da luz incidente na superfície do silício microestruturado
Esta alta absortância vem principalmente da dopagem de enxofre entre arranjos cilíndricos microestruturados, formando vários níveis de impurezas na estrutura da banda de energia do C-Si. Como resultado, quando esses níveis de impureza múltiplos induzidos se sobrepõem, uma nova banda de impureza é formada após o alargamento, o que finalmente reduz o gap de C-Si. O gap pode ser obtido a partir do espectro de absortância da amostra por mapeamento Tauc. As etapas específicas adotadas são as seguintes:
(i) o espectro de refletância é convertido para a função K-M F ( R ∞ ) usando a teoria de Kubelka-Munk:
$$ F \ left (R \ infty \ right) \ approx \ frac {A ^ 2} {2R} $$ (1)
em que R e A são o espectro de refletância e o espectro de absortância da amostra, respectivamente.
(ii) A função K-M F ( R ∞ ) é substituído na fórmula Tauc da seguinte forma:
$$ {\ left (hv \ alpha \ right)} ^ {1 / n} =K \ left (hv- Ex. \ right) $$ (2) $$ hv =\ frac {1239,7} {\ lambda} $$ (3)
em que o valor do índice n está relacionado ao tipo de transição da amostra:transição direta, n =1/2; transição indireta, n =2. F ( R ∞ ) é proporcional ao coeficiente de absorção α, que pode ser substituído por F ( R ∞ ) e n =2 é substituído na fórmula (2) para obter:
$$ {\ left (hv F \ left (R \ infty \ right) \ right)} ^ {1/2} =K \ left (hv- Ex:\ right) $$ (4)
(iii) Os dados espectrais de refletância e absortância da amostra são substituídos na Eq. (1) e Eq. (1) é substituído na Eq. (4), com hv como a abscissa ( X eixo) e ( hvF (R ∞ )) 1/2 como a ordenada ( Y eixo).
(iv) O ponto de inflexão (o ponto máximo da primeira derivada) é obtido calculando a primeira derivada do hv - ( hvF (R ∞ )) 1/2 curva, e a tangente da curva é feita neste ponto. O valor de abscissa da interseção da tangente e do X eixo são o gap da amostra.
A Figura 7 mostra os intervalos de banda calculados finais de C-Si e silício preto com diferentes tempos de ciclo. Pode ser facilmente descoberto que três intervalos de banda inferiores de silício preto como 1,045 eV, 1,033 eV e 1,025 eV estão obviamente diminuídos, respectivamente, em comparação com o intervalo de banda de 1,12 eV de C-Si.
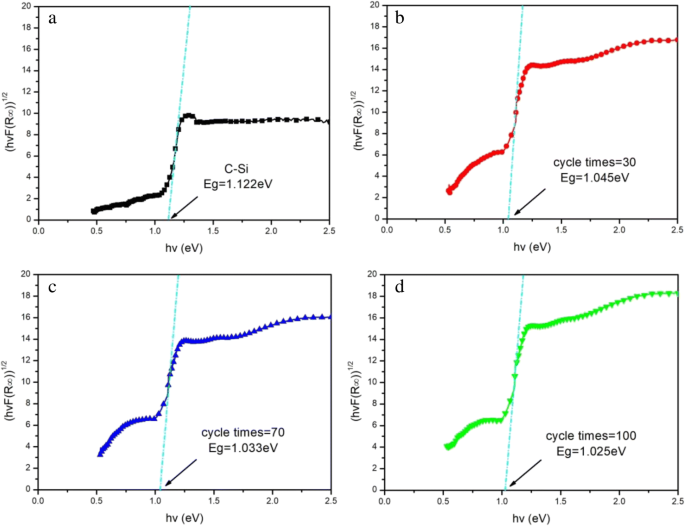
Lacunas de banda de C-Si ( a ) e silício preto feito por diferentes tempos de ciclo:( b ) 30, ( c ) 70, ( d ) 100
Com base no silício preto acima com propriedades ópticas aprimoradas, um detector de Si-PIN com silício preto formado na superfície posterior foi fabricado. Primeiro, um wafer de silício monocristalino intrínseco puro (tipo n) é oxidado em ambos os lados formando SiO 2 camadas. Em segundo lugar, a camada de P é fabricada por difusão de boro na região fotossensível que é formada precocemente gravando o SiO 2 camada na superfície frontal do wafer através do processo de fotolitografia. Terceiro, uma camada de Si 3 N 4 o filme de permeação é depositado na camada P e, em seguida, a superfície posterior do wafer é polida e triturada para cerca de 200 μm de espessura. Quarto, um N + dopado com P camada é depositada na superfície moída e, em seguida, o silício preto microestruturado é formado no topo de N + camada. Finalmente, as janelas do eletrodo são gravadas pelo processo de fotolitografia e eletrodos de metal são depositados em ambos os lados do wafer. A Figura 8 fornece uma imagem real do dispositivo (a), corrente escura (b), curva I – V sob iluminação de comprimento de onda de 1060 nm (c) e a comparação de responsividade de dois detectores diferentes (d). É declarado que a responsividade do dispositivo 1 (S1336-44BK, um detector comercial de Si-PIN) é re-plotada com base no site público da Hamamatsu Photonics Company [22], e a responsividade do dispositivo 2 é obtida em nosso novo detector fabricado de Si-PIN com silicone preto formado na superfície posterior, em que a superfície fotossensível era um círculo com diâmetro de 2 mm. Pode ser visto claramente que o dispositivo 2 realiza um aumento substancial na responsividade, particularmente em comprimentos de onda do infravermelho próximo, isto é, 0,53 A / W a 1060 nm e 0,31 A / W a 1100 nm, respectivamente.
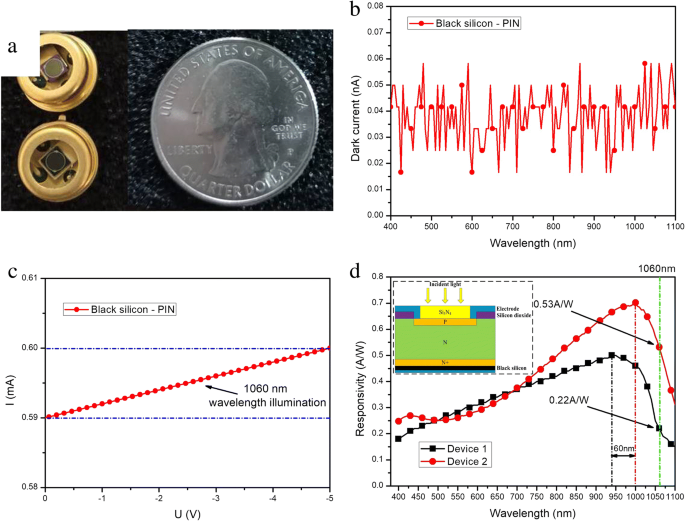
Imagem do detector ( a ), corrente escura ( b ), Curva I – V sob iluminação de comprimento de onda de 1060 nm ( c ), e responsividades de dois detectores diferentes ( d ):dispositivo 1 da ref. [22] e o dispositivo 2 com base nos resultados do presente artigo. A inserção de d mostra a estrutura do dispositivo
Pode ser visto na Fig. 8b que, embora o detector de Si-PIN com silício preto formado na superfície posterior (dispositivo 2) mostre uma capacidade de resposta de melhoria relativamente pequena no espectro visível, o espectro de resposta dele dá uma responsividade ainda maior no comprimento de onda variam de 680 a 1100 nm com cerca de 60 nm de desvio para o vermelho do pico de responsividade, em comparação com o detector comercial de Si-PIN (dispositivo 1). A principal razão para tal distinção é que a estrutura dos dispositivos desses dois detectores (dispositivos 1 e 2) é diferente. Quando a energia do fóton é maior do que o gap de C-Si, a luz incidente é absorvida principalmente pela camada P e, portanto, os portadores gerados têm energia suficiente para transitar pela camada N. A maioria das transportadoras geradas podem ser coletadas por N + camada para saída de fotocorrente através do eletrodo. Nesta condição, quer a superfície posterior do detector seja introduzida com ou sem silício preto, haverá uma influência limitada na resposta do dispositivo no comprimento de onda visível. Diferente do detector com silício preto na superfície frontal [21], o dispositivo 2 demonstra uma melhor resposta no comprimento de onda visível. É por isso que há uma melhoria relativamente pequena na resposta à luz visível de acordo com a curva de responsividade medida. Novamente no dispositivo 2, porque a camada de silício preta é definida na superfície posterior, mesmo se a energia do fóton for menor do que o gap de C-Si, a luz infravermelha próxima é capaz de penetrar na camada P e absorvida pela camada N, e então, um grande número de portadores gerados podem ser coletados pelo N + camada sob a ação do viés reverso. Como resultado, haverá uma saída de fotocorrente contável e o dispositivo representa um aumento substancial de responsividade no comprimento de onda do infravermelho próximo.
De acordo com os resultados acima, nosso presente estudo pode fornecer uma estratégia viável para o campo de detecção fotoeletrônica no infravermelho próximo, mas ainda existem muitos aspectos que devem ser considerados. Por exemplo, melhores processos de fabricação e tecnologias de implantação de íons de silício preto microestruturado, que poderiam controlar com precisão as morfologias e lacunas de banda do silício estruturado, devem ser explorados. Além disso, algumas outras novas estruturas de dispositivo de detector fotoeletrônico com base em silício preto devem ser projetadas a fim de realizar um melhor desempenho do dispositivo.
Conclusões
Em resumo, os materiais de silício preto microestruturados são fabricados por um processo de duas etapas:corrosão iônica reativa profunda combinada com implantação iônica por imersão em plasma. As matrizes cilíndricas microestruturadas na superfície das pastilhas de silício têm três tamanhos diferentes:máscara I ( D =4 μm, T =6 μm), máscara II ( D =4 μm, T =8 μm) e máscara III ( D =4 μm, T =10 μm), com a altura de 1,87 μm, 2,35 μm e 3,15 μm, respectivamente. Obviamente, a absorção de luz melhorada do silício preto foi obtida em uma ampla faixa de comprimento de onda de 400 a 2000 nm, e a absortância de luz máxima e média alcançou 83% e 62%, respectivamente. Esses aprimoramentos são discutidos extensivamente com base em reflexão múltipla, comprimento do caminho de absorção aumentado e gap estreito. Um novo detector fotoeletrônico Si-PIN com silício preto formado na superfície posterior foi fabricado e uma comparação da responsividade do dispositivo foi feita com um dispositivo comercial denominado S1336-44BK. Conclui-se que nosso detector fotoeletrônico Si-PIN com silício preto formado na superfície posterior tem um aumento substancial na responsividade, particularmente nos comprimentos de onda do infravermelho próximo, subindo para 0,53 A / W em 1060 nm e 0,31 A / W em 1100 nm , respectivamente.
Nanomateriais
- Aplicação do metal molibdênio e suas ligas
- Como obter uma integração suave e eficaz do dispositivo por meio de um aplicativo móvel
- Gerenciamento de dispositivos IoT e sua função em facilitar implantações IoT em escala
- Coin Paradox Spin-Orbit Interaction aumenta o efeito magneto-óptico e sua aplicação no isolador óptico integrado On-Chip
- Estados eletrônicos do nanocristal dopado com oxigênio e emissão visível em silício negro preparado por ns-Laser
- Absorvedor perfeito de banda ultra-estreita e sua aplicação como sensor plasmônico na região visível
- Uma Sonda Fluorescente Resumível BHN-Fe3O4 @ SiO2 Híbrida Nanoestrutura para Fe3 + e sua Aplicação em Bioimagem
- Revisão da aplicação de silício preto nanoestruturado
- Anticorpo monoclonal de heparanase marcado com nanopartículas de ouro magnético e sua aplicação subsequente para imagens de ressonância magnética de tumor
- Síntese fácil de nanofios de cobre ultralongos e finos e sua aplicação em eletrodos condutores transparentes flexíveis de alto desempenho



