Aprimoramento dielétrico de capacitores de Al2O3 / ZrO2 / Al2O3 MIM depositados na camada atômica por recozimento por micro-ondas
Resumo
Para capacitores de metal-isolador de metal (MIM) aplicados nos campos de RF, DRAM e circuitos integrados de sinal analógico / misto, uma alta densidade de capacitância é imprescindível com a redução do tamanho do recurso do dispositivo. Neste trabalho, a técnica de recozimento por microondas é investigada para melhorar as características dielétricas do Al 2 O 3 / ZrO 2 / Al 2 O 3 capacitores MIM baseados. Os resultados mostram que a permissividade de ZrO 2 é aumentado para 41,9 (~ 40% melhorado) com um recozimento por micro-ondas a 1400 W por 5 min. A temperatura do substrato é inferior a 400 ° C, o que é compatível com o processo de final de linha. As densidades de corrente de fuga são 1,23 × 10 −8 e 1,36 × 10 −8 A / cm 2 para amostra conforme depositada e amostra de 1400 W, respectivamente, indicando que a propriedade de vazamento não está deteriorada. O mecanismo de condução é confirmado como tunelamento assistido por campo.
Histórico
Capacitores de metal isolante (MIM) têm sido amplamente usados nas áreas de radiofrequência (RF), memória de acesso aleatório dinâmica (DRAM) e circuitos integrados de sinais mistos / analógicos. Com a redução do tamanho do recurso do dispositivo, é desejável obter uma densidade de capacitância cada vez maior. Por exemplo, a densidade da capacitância deve ser maior que 10 fF / μm 2 de acordo com o nó 2020 do International Technology Roadmap for Semiconductors (ITRS) [1]. Como consequência, um grande número de materiais high-κ foram investigados, como HfO 2 [2,3,4,5,6], ZrO 2 [7,8,9,10,11,12,13,14], Ta 2 O 5 [15,16,17,18] e TiO 2 [19,20,21,22,23,24]. Entre esses materiais de alto κ, ZrO 2 tem uma constante dielétrica (κ) de 16 ~ 25 (fase monoclínica) e um bandgap de 5,8 eV. No entanto, o valor κ de ZrO 2 pode ser aumentado para 36,8 e 46,6 quando é cristalizado em fase cúbica e tetragonal, respectivamente [25]. Portanto, a densidade da capacitância pode ser aumentada ainda mais. A técnica de recozimento por microondas (MWA) tem sido tremendamente explorada para a ativação de dopante em silício [26,27,28] e a formação de silicida [29, 30] devido à sua temperatura de processo mais baixa em comparação com as técnicas convencionais de processamento térmico. Além disso, Shih et al. [31] investigou o efeito do MWA nas características elétricas de TiN / Al / TiN / HfO 2 / Si capacitores MOS. Alguns parâmetros-chave, como espessura de óxido equivalente, densidade de estado de interface e densidade de corrente de fuga, foram todos aprimorados.
Neste trabalho, o efeito do MWA nas propriedades elétricas de TaN / Al 2 O 3 / ZrO 2 / Al 2 O 3 / TaN (TaN / A / Z / A / TaN) capacitores MIM são investigados. Com o uso de MWA, a permissividade de ZrO 2 é notavelmente aprimorado e a densidade da corrente de fuga é ligeiramente aumentada. Além disso, o mecanismo de condução subjacente também é estudado.
Métodos
Em primeiro lugar, um SiO 2 de 500 nm de espessura o filme foi cultivado em substrato de Si por PECVD, seguido pela deposição de filmes TaN (20 nm) / Ta (100 nm), e TaN foi crescido por pulverização catódica alvo Ta em N 2 / Ar plasma. Posteriormente, o wafer de Si revestido com os filmes TaN / Ta foi transferido para a câmara ALD, e o nano-stack de Al 2 O 3 (2 nm) / ZrO 2 (20 nm) / Al 2 O 3 (2 nm) foram depositados a 250 ° C. Al 2 O 3 e ZrO 2 os filmes foram cultivados a partir de Al (CH 3 ) 3 / H 2 O e [(CH 3 ) 2 N] 4 Zr / H 2 O, respectivamente. Vale a pena mencionar que um Al 2 ultrafino O 3 camada entre o eletrodo TaN inferior e o ZrO 2 camada foi inserida para conter a formação da camada interfacial durante ALD e recozimento pós-deposição. Posteriormente, as amostras foram submetidas ao recozimento por microondas. O MWA foi realizado em uma câmara octogonal DSGI a 5,8 GHz. Durante o recozimento, as amostras foram colocadas no meio da câmara, onde o campo eletromagnético é mais uniforme. A temperatura in situ das amostras foi monitorada por um pirômetro infravermelho da série Raytek XR voltado para a parte traseira das amostras. A potência foi variada de 700 W a 1400 W com um tempo de recozimento fixo de 5 min. Finalmente, um eletrodo de topo TaN de 100 nm de espessura foi formado por sua vez por pulverização catódica reativa, litografia e corrosão iônica reativa.
As espessuras do filme ALD foram medidas com elipsômetro (SOPRA GES 5E) e confirmadas por microscópio eletrônico de transmissão (TEM). Capacitância-tensão ( C-V ) foi medida por um analisador de impedância de precisão (Agilent 4294A) com uma amplitude de 50 mV AC. Tensão de corrente ( I-V ) as medições foram realizadas com um analisador de dispositivo semicondutor (Agilent B1500) em uma caixa escura. A polarização foi aplicada ao eletrodo superior.
Resultados e discussão
As estruturas esquemáticas do capacitor MIM baseado em A / Z / A e a câmara MWA são mostradas na Fig. 1a e b, respectivamente. A Figura 1c exibe a imagem TEM em seção transversal do capacitor MIM baseado em A / Z / A que está sujeito ao MWA a 1400 W por 5 min. Observa-se que o ZrO 2 a camada está totalmente cristalizada e as camadas empilhadas podem ser distinguidas claramente, consulte a inserção. A Figura 2a mostra o gráfico de probabilidade cumulativa da densidade da capacitância em diferentes potências de recozimento. Os resultados mostram que as densidades de capacitância dos capacitores MIM são 7,34, 8,87, 8,96 e 9,06 fF / μm 2 respectivamente para 0, 700, 1050 e 1400 W a uma probabilidade cumulativa de 50%. Portanto, a densidade da capacitância é aumentada sob o efeito das microondas. A distribuição muito estreita da densidade de capacitância para os capacitores MIM de pilha A / Z / A com MWA indica uniformidade de recozimento muito boa. A inserção na Fig. 2a exibe as curvas CV típicas de todas as amostras. Excluindo o efeito de Al 2 O 3 (κ ≈ 8), as constantes dielétricas do ZrO 2 os filmes são extraídos como 28,3, 40,1, 41 e 41,9 para 0, 700, 1050 e 1400 W, respectivamente, revelado pela Fig. 2b. Em relação à potência de microondas de 1400 W, a constante dielétrica do ZrO 2 o filme aumenta em 40% em comparação com a amostra conforme depositada. O aumento significativo da permissividade de ZrO 2 pode ser atribuída ao alto grau de cristalização durante o recozimento por micro-ondas, mostrado na Fig. 1c. Como mencionado acima, a constante dielétrica de ZrO 2 pode ser aumentado para 36,8 e 46,6 quando é cristalizado em fase cúbica e tetragonal, respectivamente [25]. Portanto, a medição de XRD foi realizada para investigar melhor o mecanismo de aumento da constante dielétrica. Como exibido na inserção da Fig. 2b, existia um pico em ~ 30. 7 ° após o processamento de MWA em 1400 W, indicando o aparecimento da fase tetragonal (111) em ZrO 2 [32, 33]. A presença desta fase tetragonal é responsável pelo aumento da constante dielétrica de 28,3 para mais de 40.

a A estrutura esquemática de Al 2 O 3 / ZrO 2 / Al 2 O 3 capacitor MIM baseado em b A estrutura esquemática da câmara MWA. c Foto TEM de Al 2 O 3 / ZrO 2 / Al 2 O 3 capacitor MIM baseado em MWA a 1400 W por 5 min

a O gráfico de probabilidade cumulativa da densidade de capacitância para diferentes amostras; a inserção exibe a densidade da capacitância contra a polarização. b O gráfico de probabilidade cumulativa da permissividade de ZrO 2 para amostras diferentes; a inserção exibe os padrões de XRD das amostras conforme depositadas e de 1400 W
Como os capacitores MIM são fabricados no back end of line (BEOL) de circuitos integrados, a temperatura do processo deve ser inferior a 400 ° C [34]. Conforme mostrado na Fig. 3, as curvas de temperatura de MWA indicam que as temperaturas mais altas do substrato são 260, 350 e 400 ° C para 700, 1050 e 1400 W, respectivamente. Portanto, o MWA é compatível com o processo CMOS do ponto de vista da temperatura do processo. Além disso, no trabalho anterior [13], Al 2 O 3 (2 nm) / ZrO 2 (20 nm) capacitores MIM foram submetidos a recozimento térmico rápido (RTA) a 420 ° C por 10 min em N 2 / H 2 ambiente e a constante dielétrica resultante de ZrO 2 foi avaliado como 40. Para RTA, o tempo de recozimento foi mantido constante a 420 ° C por 10 min, então o balanço térmico foi muito maior em comparação com o MWA. Para MWA [35, 36], a polarização dipolo é considerada o mecanismo mais importante para a transferência de energia a nível molecular. Quando os materiais em contato têm propriedades dielétricas diferentes, as microondas irão se acoplar seletivamente aos materiais de maior perda dielétrica. Em contraste, o RTA convencional transfere calor de forma mais eficiente para materiais com alta condutividade.
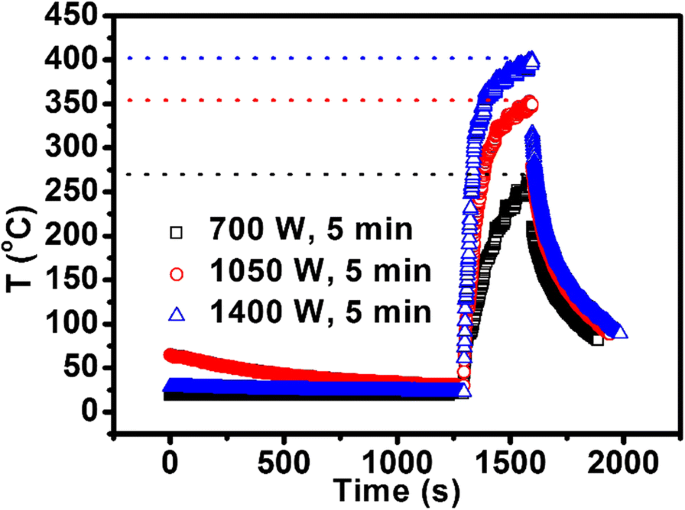
As curvas da temperatura do substrato para diferentes amostras durante o recozimento por microondas
A corrente de fuga é outro parâmetro importante para capacitores MIM. Conforme mostrado na Fig. 4a, a curva de corrente de fuga pode ser dividida em duas seções para todas as amostras, uma vez que há um ponto de viragem óbvio, indicando diferentes mecanismos de condução de elétrons. Já para as amostras com processamento MWA, a tensão correspondente ao ponto de inflexão é menor em comparação com a amostra como depositada. A Tabela 1 lista a densidade de corrente de fuga em ± 4 V para todas as amostras. Tome 4 V, por exemplo, a densidade da corrente de fuga é aumentada de 1,06 × 10 −7 a 1,92 × 10 −5 A / cm 2 , ou seja, duas ordens de amplitude aumentadas quando a potência de microondas é aumentada de 0 para 1400 W. Devido a uma alta cristalização do ZrO 2 filme, um grande número de limites de grão aparecerá e servirá como caminho de vazamento, aumentando assim a condução de elétrons sob um alto campo elétrico. No entanto, considerando uma tensão de trabalho de 2 V, as densidades de corrente de fuga são 1,23 × 10 −8 e 1,36 × 10 −8 A / cm 2 para amostra conforme depositada e amostra de 1400 W, respectivamente. Obviamente, o recozimento por micro-ondas tem pouco efeito no desempenho de vazamento em um campo elétrico baixo. Além disso, a tensão de ruptura foi extraída do I - V teste e plotados na Fig. 4b. Para a amostra conforme depositada, a tensão de ruptura é de cerca de 9,8 V a uma probabilidade cumulativa de 50%. Com a aplicação do MWA, a tensão de ruptura é reduzida para ~ 9 V. Esta redução da tensão de ruptura pode estar relacionada à mudança do ZrO 2 Microestrutura.
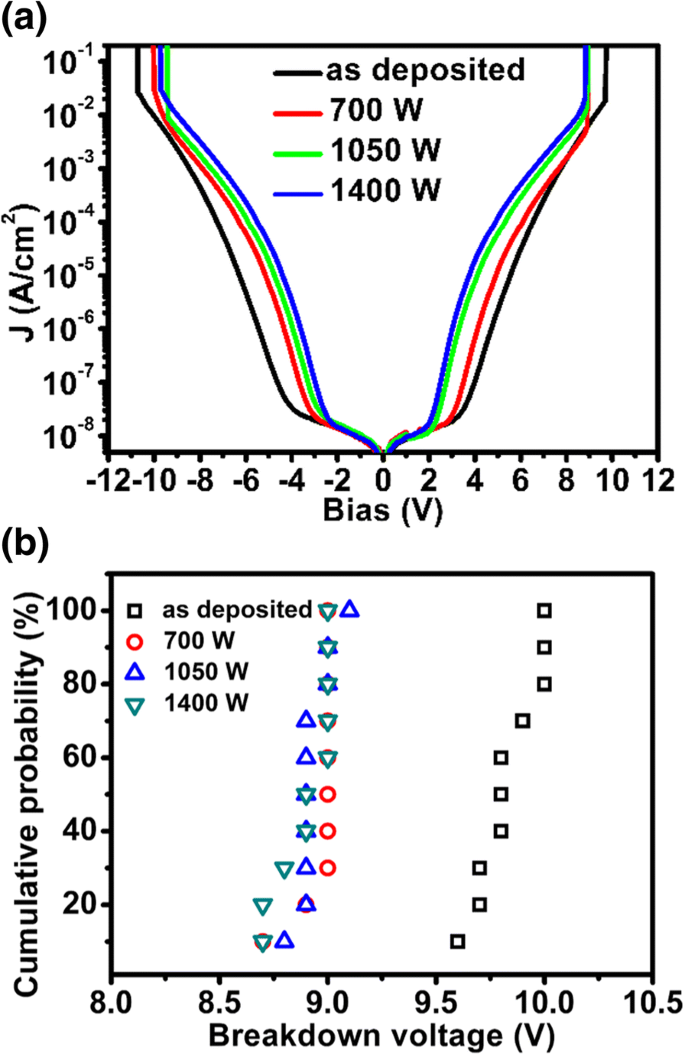
a O gráfico da densidade de corrente de fuga ( J ) vs enviesamento e b o gráfico de probabilidade cumulativa da tensão de ruptura para diferentes amostras
Para entender melhor o efeito do MWA na corrente de fuga, os mecanismos de condução dos capacitores MIM são investigados. Com base na pesquisa anterior sobre Al 2 O 3 (2 nm) / ZrO 2 (20 nm) baseado em capacitor MIM [13, 14], o mecanismo de condução dominante em um alto campo elétrico foi confirmado como tunelamento assistido por campo (FAT). Para FAT, que é o tunelamento relacionado à armadilha, os elétrons são capturados pelas armadilhas no isolador primeiro e, em seguida, tunelizam para a banda de condução do isolador diretamente [37]. No trabalho atual, o Al 2 O 3 e ZrO 2 os filmes nos capacitores MIM baseados em A / Z / A foram depositados nas mesmas condições, portanto, a corrente de fuga provavelmente também é predominante pelo FAT. O modelo FAT pode ser expresso pela Eq. (1) [37]
$$ J ={AE} ^ 2 \ exp \ left (- \ frac {8 \ pi \ sqrt {2 {m} ^ {\ ast} q {\ varphi} _t ^ 3}} {3 hE} \ right) $$ (1)
onde A é uma constante, E é o campo elétrico, q é a cobrança eletrônica, m * representa a massa efetiva do elétron (cerca de 0,25 m 0 , onde m 0 é a massa do elétron livre), k é a constante de Boltzmann, φ t é a barreira de energia que separa as armadilhas da banda de condução, e h é a constante de Planck.
Em termos de dielétricos empilhados, o campo elétrico aplicado a cada camada difere um do outro por causa de diferentes permissividade e espessura. Portanto, usar o campo elétrico médio em toda a pilha causará erros graves ao discutir o mecanismo de condução. Como consequência, o campo elétrico em todo o ZrO 2 camada deve ser extraída com precisão. Os campos elétricos em ZrO 2 são 3,125 × 10 7 × V pilha , 2,5 × 10 7 × V pilha , 2,47 × 10 7 × V pilha e 2,44 × 10 7 × V pilha respectivamente para como depositado, amostra de 700 W, 1050 W e 1400 W de acordo com a lei de Gauss e a lei de tensão de Kirchhoff [38, 39]:
$$ \ left \ {\ begin {array} {c} {k} _A {E} _A ={\ kappa} _Z {E} _Z \\ {} {d} _A {E} _A + {d} _Z {E } _Z ={V} _ {stack} \ end {array} \ right. $$ (2)
onde k A e κ Z representam as constantes dielétricas de Al 2 O 3 e ZrO 2 , respectivamente; E A e E Z denotam os campos elétricos em Al 2 O 3 e ZrO 2 , respectivamente; d A e d Z igual às espessuras de Al 2 O 3 e ZrO 2 , respectivamente; e V pilha é a voltagem aplicada à pilha. Assim, Ln ( J / E Z 2 ) versus 1 / E Z foi representado arbitrariamente na Fig. 5, onde um ajuste de linha reta foi alcançado na região de alto campo para cada amostra sob injeção de elétron no fundo (ver Fig. 5a) ou injeção de elétron no topo (ver Fig. 5b). Isso significa que o mecanismo FAT é dominado em campos elétricos elevados. O extraído φ t é 0,73, 0,51, 0,38 e 0,35 eV, respectivamente, para amostra conforme depositada, 700 W, 1050 W e 1400 W sob injeção de elétrons no fundo. Em termos de injeção no topo do elétron, o φ correspondente t é 0,82, 0,53, 0,47 e 0,43 eV, respectivamente. Portanto, algumas armadilhas rasas são induzidas por MWA. As armadilhas rasas são relatadas como surgindo de defeitos de contorno de grão que podem introduzir estados eletrônicos adicionais perto da banda de condução [40]. Além disso, o mecanismo de condução em campos baixos é mais provavelmente o tunelamento assistido por armadilha (TAT).
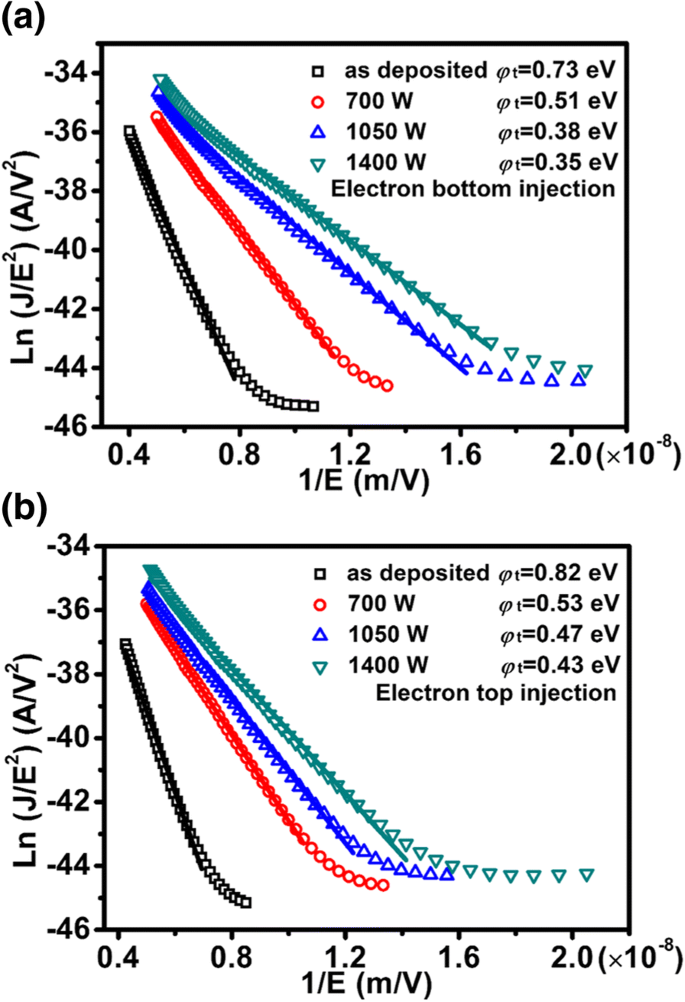
O enredo de Ln ( J / E 2 ) vs 1 / E para amostras diferentes. a Injeção de elétrons no fundo e b injeção de elétron no topo
Conclusões
Al 2 depositado em camada atômica O 3 / ZrO 2 / Al 2 O 3 nano-stack é usado como isolante dos capacitores MIM. Com o efeito do MWA em 1400 W por 5 min, a densidade da capacitância é aumentada para 9,06 fF / μm 2 , aproximadamente 23,4% da capacitância aumentada. Dissociando a influência de Al 2 O 3 , a constante dielétrica é deduzida como 41,9 para amostra de 1400 W (~ 40% da permissividade aumentada). Tal aumento da permissividade é originado de uma alta cristalização do ZrO 2 filme. Além disso, a temperatura do substrato é inferior a 400 ° C, o que permite MWA compatível com o processo BEOL. Esta menor temperatura do substrato pode ser atribuída ao aquecimento seletivo nos materiais de MWA. Em termos de tensão de trabalho de 2 V, as densidades de corrente de fuga são 1,23 × 10 −8 e 1,36 × 10 −8 A / cm 2 para amostra conforme depositada e amostra de 1400 W, respectivamente. O mecanismo de condução dominado nos campos elétricos elevados é confirmado como um processo FAT. A corrente de fuga nos campos elétricos baixos é provavelmente ditada pelo TAT. Com base nos fatos acima, o recozimento por micro-ondas é uma técnica promissora usada no processo CMOS para melhorar o desempenho dielétrico dos capacitores MIM.
Abreviações
- A / Z / A:
-
Al 2 O 3 / ZrO 2 / Al 2 O 3
- ALD:
-
Deposição de camada atômica
- BEOL:
-
Fim da linha
- C-V :
-
Capacitância-tensão
- DRAM:
-
Memória de acesso aleatório dinâmico
- FAT:
-
Tunelamento assistido em campo
- ITRS:
-
Roteiro de tecnologia internacional para semicondutores
- I-V :
-
Corrente electrica
- MIM:
-
Metal-isolante-metal
- MWA:
-
Recozimento por microondas
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- RF:
-
Frequência de rádio
- RTA:
-
Recozimento térmico rápido
- TAT:
-
Tunelamento assistido por armadilha
- TEM:
-
Microscopia eletrônica de transmissão
Nanomateriais
- AVX Lança Novos Capacitores de Linha de Transmissão de Filme Fino Ultra-Miniatura para Microondas de Alto Desempenho e Aplicações RF
- Imagens de átomos em cristais atômicos 2D em líquidos
- Carbono oceânico gerado na escala atômica
- Memória resistiva ZrO2 / ZrO2 - x / ZrO2 sem conformidade com comportamento de comutação multiestado interfacial controlável
- Propriedades de formação e luminescência de Al2O3:Nanocompósitos de SiOC na base de nanopartículas de alumina modificados por feniltrimetoxisilano
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Sensor plasmônico baseado em nanoprismas dielétricos
- Fotodetector controlado por comprimento de onda baseado em nanobelt de CdSSe único
- Efeito do recozimento pós-térmico nas propriedades ópticas de InP / ZnS Quantum Dot Films
- RRAM baseado em HfAlOx depositado em camada atômica com baixa tensão operacional para aplicativos de computação na memória



