Crescimento direto de nanofios de GaN cristalino único em sílica revestida com óxido de estanho de índio
Resumo
Neste trabalho, demonstramos o crescimento direto de nanofios de GaN em substrato de sílica fundida revestido com óxido de estanho e índio (ITO). Os nanofios foram cultivados sem catalisador usando epitaxia de feixe molecular assistido por plasma (PA-MBE). O efeito da condição de crescimento na morfologia e qualidade dos nanofios é investigado sistematicamente. A caracterização estrutural indica que os nanofios crescem na direção (0001) diretamente no topo da camada ITO perpendicular ao plano do substrato. A caracterização óptica dos nanofios mostra que a luminescência amarela está ausente da resposta de fotoluminescência do nanofio, atribuída ao baixo número de defeitos. A medição de microscopia de força atômica condutiva (C-AFM) em nanofios de GaN dopados com n mostra boa condutividade para nanofios individuais, o que confirma o potencial do uso desta plataforma para novas aplicações de dispositivos. Usando um processo de crescimento de temperatura relativamente baixa, fomos capazes de cultivar material de GaN de cristal único de alta qualidade sem a degradação da camada de ITO subjacente.
Introdução
Os dispositivos à base de nitreto III comercialmente disponíveis dependem principalmente da safira como substrato de crescimento, pois podem acomodar o crescimento de GaN com qualidade de material aceitável. No entanto, o desafio de produzir substrato de safira de grande diâmetro, mantendo uma qualidade de superfície aceitável do substrato, continua sendo um obstáculo para aumentar a produção [1, 2]. Uma alternativa viável à safira como substrato de crescimento de nitreto III seria o uso de substrato à base de sílica, visto que são economicamente mais baratos e amplamente utilizados na indústria e em aplicações de consumo. No entanto, como substratos à base de sílica são inerentemente não condutores, uma camada condutora não transparente deve ser usada para permitir a condutividade elétrica [3, 4]. Portanto, um método para fornecer condutividade e transparência simultâneas no topo do substrato de sílica torna-se muito importante. Anteriormente, empregamos uma camada intermediária de Ti fina como o local de nucleação do nanofio para fornecer transparência e condutividade simultâneas [5]. No entanto, como uma camada fina de Ti é necessária, a condutividade elétrica da amostra torna-se limitada.
Outro método possível para um substrato transparente e condutor é empregar óxido de índio e estanho (ITO) como local de nucleação de GaN, pois é transparente e eletricamente condutor e pode ser depositado sobre uma grande área de superfície. A tecnologia ITO já está madura e tem sido amplamente utilizada em várias indústrias de eletrodos transparentes. A técnica convencional atual usada para fabricar GaN, no entanto, não é compatível com ITO. A alta temperatura necessária para quebrar os precursores empregados no crescimento de deposição de vapor químico orgânico de metal (MOCVD) leva à degradação da camada de ITO. Assim, é necessário um método de crescimento de GaN em baixa temperatura capaz de produzir material de alta qualidade. Tentativas anteriores de cultivar GaN em ITO em baixa temperatura usando pulverização catódica e deposição química de vapor intensificada por plasma (PECVD) foram realizadas [6-12]. No entanto, os métodos de crescimento de baixa temperatura normalmente levam a material policristalino e grande número de defeitos.
Neste trabalho, tentamos contornar esse problema por meio do crescimento direto de nanofios de GaN cristalinos em sílica fundida revestida com ITO usando epitaxia de feixe molecular assistido por plasma (PA-MBE). No PA-MBE, as espécies de nitrogênio ativo são fornecidas ao sistema quebrando a ligação entre o N 2 puro gás usando potência de RF. Assim, a temperatura de crescimento pode ser significativamente menor em comparação com outros métodos de crescimento epitaxial de GaN, evitando a degradação da camada de ITO. Ao utilizar nanofios de GaN, é possível fazer crescer GaN de alta qualidade no topo da camada de ITO policristalina. Por causa do relaxamento de tensão e filtragem de deslocamento de threading atribuídos à alta razão entre a superfície e o volume dos nanofios [13, 14], os nanofios de GaN normalmente exibem cristalinidade única e nenhum deslocamento de threading, apesar da falta de correspondência de rede entre os nanofios e o nanofio subjacente camada de nucleação [15].
Nós investigamos a morfologia dos nanofios e sua relação com a camada de ITO subjacente, as características ópticas dos nanofios e a viabilidade do uso desta plataforma para aplicações em dispositivos. As caracterizações estruturais usando microscopia eletrônica revelam que os nanofios crescem diretamente na camada ITO perpendicular ao plano do substrato na direção do plano c (0001). A medição de fotoluminescência fornece um bom valor de eficiência quântica interna (IQE), enquanto a luminescência amarela associada ao defeito está ausente do espectro de emissão. Finalmente, a microscopia de força atômica condutiva (C-AFM) em nanofios GaN dopados com n confirma que os nanofios são condutores, destacando a possibilidade de fabricar novos dispositivos usando os nanofios GaN na plataforma ITO. Com nosso trabalho, abrimos o potencial de crescimento de nanofios de nitreto III em cima de ITO para aplicações de dispositivos onde a transparência e a condutividade do substrato são necessárias.
Métodos
ITO Thin Film Deposition
O filme fino ITO usado neste experimento foi depositado usando o método de pulverização catódica RF magnetron. A deposição foi feita à temperatura ambiente com plasma de argônio a 60 W de potência de RF, pressão de câmara de 2,5 mTorr e vazão de gás de 25 centímetros cúbicos padrão por minuto (sccm). Antes da deposição, as amostras são limpas com solvente padrão de limpeza usando acetona e álcool isopropílico. Uma película fina de ITO de aproximadamente 100 nm de espessura foi depositada diretamente na sílica nua.
III-Nitreto Nanowire Growth
As amostras de nanofios de GaN são cultivadas usando um reator de epitaxia de feixe molecular assistido por plasma Veeco Gen 930 (PA-MBE). Antes do crescimento de MBE, o substrato de sílica revestido com ITO foi recozido dentro de um forno de recozimento térmico rápido (RTA) a 650 ° C sob Ar ambiente por 5 min, a fim de melhorar a cristalinidade da camada de ITO. Antes de carregar na câmara, as amostras são limpas usando um método de limpeza com solvente padrão. As amostras passam por limpeza térmica subsequente a 200 ° C e 650 ° C dentro do bloqueio de carga MBE e da câmara de preparação, a fim de remover umidade e outros contaminantes, respectivamente.
Durante o crescimento do nanofio, usamos um valor de pressão equivalente do feixe de Ga (BEP) de 1 × 10 −7 Torr de acordo com a leitura do medidor de íons BFM. Todas as temperaturas do substrato são medidas usando o termopar. A fim de promover o crescimento do nanofio, uma camada de semeadura inicial foi depositada a 500 ° C. Após a deposição da camada de semeadura inicial, a temperatura do substrato foi elevada para 700 ° C para o crescimento do nanofio.
Caracterização estrutural, óptica e elétrica
A morfologia da superfície da camada ITO foi investigada usando o sistema Agilent 5500 SPM de microscopia de força atômica (AFM). A característica elétrica da amostra foi medida usando AFM condutivo (C-AFM) em modo de contato. Para melhorar o contato elétrico entre os nanofios e a ponta C-AFM, uma camada de Ni / Au com 5/5 nm de espessura foi depositada no topo dos nanofios usando evaporação de feixe de elétrons, seguido de recozimento térmico rápido a 600 ° C em ambiente atmosférico. A medição C-AFM foi feita usando uma ponta AFM revestida com Pt / Ir e aplicando polarização à camada ITO da amostra. Como em nossa configuração de polarização C-AFM é aplicada no substrato, o fluxo de corrente positiva indica a corrente fluindo da amostra para a ponta do AFM.
A qualidade estrutural dos nanofios de GaN crescidos em cima de ITO foi investigada usando a caracterização por microscopia eletrônica de transmissão (TEM). Uma amostra de seção transversal de TEM foi preparada usando um FEI Helios Nanolab 400s Dual Beam Focused Ion Beam (FIB) SEM. A imagem SEM foi feita usando o sistema SEM FEI Nova Nano e Zeiss Merlin. As caracterizações de microscopia eletrônica de transmissão de alta resolução (HRTEM) e STEM de campo escuro anular de alto ângulo de alta resolução (HAADF-STEM) foram realizadas usando um microscópio eletrônico de transmissão Titan 80-300 ST (FEI Company). O mapa de composição elementar foi obtido por espectroscopia de perda de energia de elétrons (EELS).
A fim de investigar a polaridade dos nanofios, utilizamos corrosão à base de KOH. Foi relatado que a corrosão química úmida usando KOH mostra a corrosão preferencial para GaN de face N. Portanto, a polaridade pode ser determinada comparando a morfologia dos nanofios antes e depois do ataque com KOH. Nós imergimos o nanofio de GaN em amostras de ITO em uma solução de KOH a 40% por 1 h em temperatura ambiente e comparamos a morfologia antes e depois da imersão química para determinar a polaridade de crescimento do nanofio.
Nós investigamos as propriedades ópticas dos nanofios de GaN cultivados diretamente no topo de ITO usando uma configuração de medição de fotoluminescência (PL) dependente da temperatura e dependente da potência. A amostra foi carregada em um criostato resfriado com hélio e excitada usando um laser de 266 nm (Teem photonics SNU-20F-10x). A temperatura variou de 10 a 290 K. Primeiramente estudamos a resposta de fotoluminescência dependente da potência, realizada a 10 K. A medição da transmitância foi realizada usando um espectrofotômetro UV-Vis-NIR (Shimadzu UV-3600).
A medição da difração de raios-X (XRD) foi realizada usando um sistema Bruker D2 Phaser em pó XRD.
Resultados e discussão
Como o crescimento de nanofios de GaN em alta temperatura pode resultar na degradação da camada ITO subjacente, primeiro investigamos o efeito do recozimento térmico no ITO nu depositado no topo do substrato de sílica. O experimento foi realizado dentro da câmara tampão do MBE, normalmente com 10 −8 Pressão Torr para simular a condição real de crescimento. Após o recozimento, a condutividade elétrica do ITO nu é medida usando uma medição de sonda de quatro pontos, e a rugosidade da superfície é investigada usando microscopia de força atômica (AFM). A partir do experimento de recozimento, mostrado na Fig. 1a, descobrimos que o valor da resistência da folha do filme fino ITO permanece abaixo de 10 \ (\ Omega / \ square \). No entanto, em uma temperatura de recozimento mais alta, o filme fino de ITO torna-se mais áspero com tamanho de grão maior, mostrado na Fig. 1b-d.

Efeito da temperatura de recozimento nas características elétricas e físicas do filme fino de ITO depositado. a Resistência da folha medida com uma sonda de quatro pontos após o recozimento em diferentes temperaturas. Topografia de superfície de AFM da película fina de ITO adquirida após o recozimento da amostra em b 500 ° C, c 600 ° C e d 700 ° C
O processo de crescimento do nanofio é ilustrado na Fig. 2
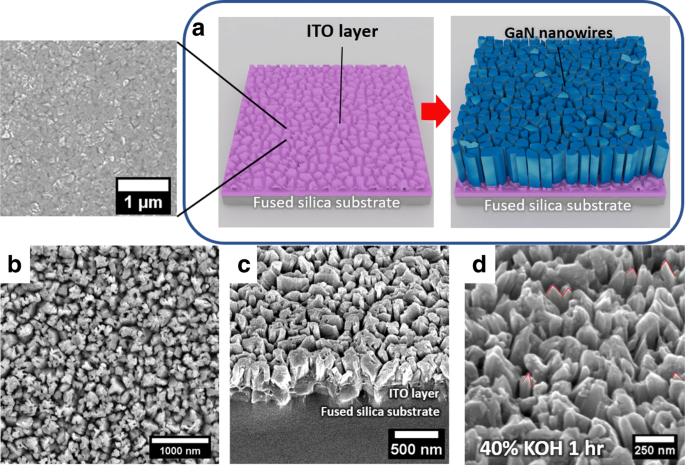
a Esquemático que ilustra o crescimento de nanofios de GaN em superfície áspera de ITO. A inserção mostra uma vista plana SEM da superfície áspera ITO após o recozimento térmico. b Vista plana de nanofios de GaN cultivados em ITO. c Vista de elevação de nanofios de GaN crescidos em ITO. d Vista de elevação de nanofios de GaN após 1 h de corrosão KOH, expondo a ponta do nanofio GaN gravada
uma. Conforme mostrado no resultado do AFM, o recozimento da camada de ITO em temperatura elevada resultará em uma superfície de ITO áspera com grande tamanho de grão. Durante o crescimento do MBE, os nanofios GaN vizinhos que crescem na superfície de um único grão tendem a se aglutinar e formar um nanofio maior composto de um cluster de nanofios. Portanto, a morfologia do ITO subjacente afetará diretamente a morfologia dos nanofios crescidos em cima dele. A vista plana da micrografia de microscópio eletrônico de varredura (SEM) é mostrada na Fig. 2b. Do ponto de vista do plano, a densidade do nanofio é estatisticamente estimada em 9,3 × 10 9 cm −2 com um fator de preenchimento de 73%. A vista em corte transversal da amostra é mostrada na Fig. 2c. Os nanofios crescem perpendicularmente ao plano do substrato com algum grau de inclinação diretamente no topo da camada ITO.
A imagem SEM da amostra de nanofio após 1 h de imersão em solução de KOH a 40% é mostrada na Fig. 2d. Percebe-se que, após o tratamento químico, as pontas dos nanofios são parcialmente decapadas, o que indica a polaridade N. Esta descoberta está de acordo com os resultados relatados anteriormente, onde nanofios de nitreto III crescidos espontaneamente são tipicamente N-polares [16-19].
A Figura 3a mostra a microscopia eletrônica de transmissão de varredura de campo escuro anular de alto ângulo (HAADF-STEM) dos nanofios. Os nanofios crescem diretamente no topo da camada ITO. Para estudar a composição elementar da interface entre os nanofios e a camada ITO, realizamos uma varredura de linha de mapeamento elementar para Ga, In, N e O utilizando EELS na área delimitada por uma caixa vermelha. O perfil de varredura de linha é mostrado na Fig. 3b. O perfil da linha indica um limite claro entre os nanofios de GaN e ITO. Uma imagem TEM de alta resolução de um único nanofio na Fig. 3c mostra o arranjo de rede do nanofio, confirmando a cristalinidade única do material. TEM de alta resolução na interface entre os nanofios GaN e a camada ITO na Fig. 3d mostra o que parece ser uma camada intermediária (IL) composta de uma mistura entre a camada policristalina e amorfa com cerca de 4 nm de espessura entre a base do nanofio e o ITO . Esta camada fina é sugerida como uma camada de transição de GaN, formada entre a camada de ITO policristalina e a camada de GaN cristalino. Uma camada semelhante foi relatada antes, onde nanofios de GaN são cultivados diretamente no topo de uma camada de sílica fundida amorfa [15].

TEM e mapeamento elementar de nanofios de GaN crescidos na camada ITO. a Imagem HAADF de nanofios de GaN crescidos diretamente no topo da camada ITO. A caixa vermelha indica onde a varredura da linha EELS foi realizada. b Perfil de varredura da linha EELS da interface entre a base do nanofio de GaN e a camada ITO. O mapeamento elementar para Ga, In, N e O é mostrado no gráfico. c TEM de alta resolução do nanofio de GaN, mostrando cristalinidade única. A seta vermelha indica a direção do crescimento. O espaçamento entre planos corresponde ao GaN c-plano. d Imagem TEM de alta resolução da interface entre o nanofio de GaN e a camada ITO. Uma camada intermediária parcialmente amorfa (IL) pode ser vista entre os nanofios GaN e a camada ITO, limitada pelas linhas vermelhas tracejadas
O resultado da fotoluminescência dependente da temperatura é mostrado na Fig. 4a. A partir da medição, é mostrado que a luminescência amarela comumente associada a defeitos em materiais de GaN é cerca de três magnitudes menores do que a emissão de borda de banda de GaN, destacando o crescimento de material de GaN de alta qualidade. A fotoluminescência dependente da temperatura é mostrada na Fig. 4b. O resultado mostra o desvio para o vermelho com o aumento da temperatura comumente associado ao encolhimento do intervalo de banda Varshni. A intensidade do pico de emissão é reduzida com o aumento da temperatura devido à ativação dos centros de recombinação não radiativos. O ajuste de Arrhenius é feito na mudança na intensidade integrada PL ao longo da temperatura, mostrado na Fig. 4c. O encaixe fornece uma energia de ativação de 195 meV. Usando a razão de intensidade integrada em 290 K e 10 K, estimamos a eficiência quântica interna dos nanofios em cerca de 67%.

a Medição dependente de energia de nanofios de GaN cultivados em Óxido de Índio e Estanho realizada a 10 K. b PL de nanofios de GaN crescidos na camada de ITO depende da temperatura. c Energia de ativação calculada com base na medição PL dependente da temperatura. d Transparência do substrato de sílica fundida, camada de ITO recozida em sílica fundida e nanofios de GaN crescidos na camada de ITO; e Os perfis de XRD para sílica fundida nua, filme fino de ITO como depositado, filme fino de ITO recozido e nanofios de GaN crescidos em ITO
A Figura 4d mostra a mudança na transmitância para o ITO recozido, sílica fundida e nanofio de GaN em ITO / sílica. A transmitância da amostra é reduzida após o crescimento do nanofio de GaN. Como os nanofios de GaN não são absorventes na faixa de comprimento de onda visível, a transmitância reduzida pode ser atribuída ao espalhamento de luz causado pelos próprios nanofios.
A Figura 4e mostra os resultados de XRD do substrato de sílica nua, substrato de sílica com ITO como depositado, ITO / sílica recozida por RTP e nanofios de GaN crescidos em ITO / sílica. Nenhum pico de XRD pode ser observado na camada ITO conforme depositada, indicando uma camada quase amorfa. Após o recozimento RTP, picos de ITO (211), ITO (222), ITO (400), ITO (440) e ITO (622) podem ser observados, indicando que o recozimento melhora a cristalinidade da camada de ITO, o que está de acordo com relatórios anteriores [20]. Os picos mais dominantes são o pico de ITO (222) e o pico de ITO (400). O pico medido de GaN (0002) no 2 θ scan indica que este plano é paralelo aos planos ITO, o que mostra que os nanofios de GaN crescem na camada ITO policristalina.
Para testar se os nanofios GaN na plataforma ITO seriam viáveis para a aplicação do dispositivo, desenvolvemos nanofios GaN com nanofios GaN dopados com silício como dopante e medimos a característica I-V de nanofios individuais usando C-AFM. Por meio desse método, foram obtidos os dados estatísticos I-V da amostra. A medição resultante é mostrada na Fig. 5.

a Mapeamento C-AFM da topologia dos nanofios. b Corrente de ponta correspondente, com polarização de -8 V aplicada à amostra. c Curva I-V de um único nanofio com polarização de voltagem de amostra de -10 V a 10 V, mostrando características I-V diferentes entre a varredura inicial e a segunda. d Distribuição da curva I-V de uma série de nanofios, após a varredura inicial do punch-through
O mapeamento atual na Fig. 5b mostra que os nanofios na Fig. 5a são inicialmente não condutores, com apenas vários pontos mostrando o fluxo de corrente. Para investigar melhor por que os nanofios não são condutores, realizamos uma caracterização I-V em nanofios individuais. A faixa de varredura de voltagem da amostra é de - 10 a 10 V, com a corrente de ponta resultante variando de - 10 a 10 nA, que é limitada pela especificação do sistema AFM. O resultado é mostrado na Fig. 5c. Para a primeira varredura, descobrimos que os nanofios exibem uma voltagem de ativação muito alta, indicando um comportamento de contato Schottky entre o n-GaN e a camada ITO. No entanto, após repetir a medição, descobrimos que a tensão de ativação da curva I-V foi significativamente reduzida, atribuída ao abaixamento da altura da barreira Schottky. Observamos essa tendência de voltagem de ativação reduzida após a varredura de voltagem punch-through inicial em vários nanofios na área de varredura AFM mostrada na Fig. 5d, confirmando que isso se aplica a todos os nanofios cultivados em ITO. O mecanismo exato de redução da tensão de ativação ainda requer uma investigação mais aprofundada. Relatórios anteriores mostraram que a aplicação de uma alta tensão ao material pode ter induzido caminhos de transporte de corrente por meio de colapso elétrico [21, 22], ou modificar a estrutura do nanofio de GaN em si [23], levando a uma melhoria na tensão de ativação.
Conclusões
Em conclusão, realizamos o crescimento de nanofios de GaN sobre um filme fino de ITO depositado em um substrato de sílica fundida. A caracterização física usando microscopia eletrônica mostra que os nanofios crescem perpendicularmente ao plano do substrato, mantendo a alta qualidade do cristal. Uma forte emissão de borda de banda de GaN foi detectada através da caracterização de fotoluminescência, enquanto a luminescência amarela comumente associada a defeitos está ausente. Os nanofios têm uma polaridade N preferencial, indicada pela gravação preferencial do plano do cristal em uma solução de KOH. As medições de C-AFM em nanofios dopados com n mostram boa condutividade, destacando a possibilidade da plataforma para aplicação do dispositivo.
Abreviações
- AFM:
-
Força atômica microscópica
- BEP:
-
Pressão equivalente do feixe
- C-AFM:
-
Microscopia de força atômica condutiva
- EELS:
-
Espectroscopia de perda de energia de elétrons
- FIB:
-
Feixe de íons focado
- IQE:
-
Eficiência quântica interna
- HAADF:
-
Campo escuro anular de alto ângulo
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- ITO:
-
Óxido de índio estanho
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- PA-MBE:
-
Epitaxia de feixe molecular assistida por plasma
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- PL:
-
Fotoluminescência
- RF:
-
Frequência de rádio
- RTA:
-
Recozimento térmico rápido
- sccm:
-
Centímetro cúbico padrão por minuto
- SEM:
-
Microscopia eletrônica de varredura
- STEM:
-
Microscopia eletrônica de transmissão de varredura
- TEM:
-
Microscopia eletrônica de transmissão
- XRD:
-
Difração de raios X
Nanomateriais
- Cientistas de materiais ensinam nanofios a 'dançar'
- Detectando o magnetismo do núcleo de um átomo único
- Nanocristais de estanho para bateria futura
- Sobre nanopartículas semicondutoras
- Crescimento autocatalisado de nanofios de GaSb verticais em hastes de InAs por deposição de vapor químico orgânico-metálico
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Em direção a cadeias de átomo único com telúrio esfoliado
- Crescimento direto de estruturas ZnO semelhantes a penas por uma técnica de solução fácil para aplicação de detecção de foto
- Controlando o crescimento de seleneto de índio de alta uniformidade (In2Se3) Nanofios por meio do processo de recozimento térmico rápido em baixa temperatura
- Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LED…



