Desempenho de Recuperação de Diodos de Barreira Ge-Dopados Vertical GaN Schottky
Resumo
Diodos de barreira Schottky vertical GaN (SBDs) foram fabricados em substratos GaN autônomos dopados com Ge. A qualidade do cristal dos SBDs foi caracterizada por medição de luminescência catódica, e a densidade de deslocamento foi determinada como sendo ~ 1,3 × 10 6 cm - 2 . Com as medições de desempenho elétrico realizadas, os SBDs mostram uma baixa tensão de ativação V em (0,70 ~ 0,78 V) e alta corrente I em / eu desligado proporção (9,9 × 10 7 ~ 1,3 × 10 10 ) As características de recuperação reversa foram investigadas. O tempo de recuperação reversa foi obtido em 15,8, 16,2, 18,1, 21,22 e 24,5 ns para os SBDs de 100, 200, 300, 400 e 500 μm de diâmetro, respectivamente. Enquanto isso, o tempo de recuperação reversa e a carga de recuperação reversa mostram uma correlação positiva significativa com a área do eletrodo.
Introdução
Recentemente, um semicondutor de gap largo - como GaN - com as vantagens inerentes, atraiu muita atenção de pesquisa para os dispositivos eletrônicos de próxima geração, particularmente no campo de alta frequência, alta potência e alto desempenho [1,2,3 , 4,5,6]. Enquanto isso, graças aos desenvolvimentos de epitaxia de fase de vapor de hidreto (HVPE), baixa densidade de deslocamento (≤ 10 6 cm - 2 ) Substratos GaN estão agora disponíveis comercialmente [7,8,9,10]. Em comparação com os dispositivos laterais, os dispositivos do tipo vertical fabricados com esses substratos são considerados uma estrutura mais avançada que é propícia para alcançar uma corrente maior, menos caminho de fuga e melhor confiabilidade para o sistema [11, 12]. Entre eles, o diodo de barreira Schottky (SBD) baseado em GaN é um componente vital nos dispositivos de comutação. Diferente de um diodo bipolar, o SBD com sua natureza unipolar reduz enormemente o efeito de armazenamento de portadora minoritária e, correspondentemente, oferece uma alta velocidade de comutação com baixa perda de recuperação reversa. No entanto, poucos grupos realizaram um estudo sistemático das características de recuperação reversa para SBDs GaN verticais [13,14,15,16,17], dos quais os estudos se concentraram mais na comparação do tempo de chaveamento em dispositivos de diferentes estruturas. Assim, ainda existe a necessidade urgente de uma investigação aprofundada sobre o mecanismo de desempenho de recuperação para os SBDs de GaN, especialmente para os verticais.
Enquanto isso, uma vez que a técnica de contato ôhmico tem sido continuamente explorada para melhorar o desempenho do dispositivo em muitos artigos publicados [18], o GaN tipo n fortemente dopado é um elo chave para a fabricação de dispositivos de nitreto. Ultimamente, Ge é proposto como uma alternativa ao dopante Si em GaN, porque ambos compartilham uma característica semelhante de impureza de nível raso (a energia de ativação é relatada como sendo 20 e 17 meV para Ge e Si, respectivamente) e a distorção de rede causada por átomos de Ge substituindo em sítios de Ga seriam menores devido a seus raios iônicos mais próximos [19, 20]. Acredita-se que o doping Ge forme uma superfície mais lisa com menos defeitos [21, 22]. Além disso, com a menor distorção da rede e estresse do filme, esse doping também mostra uma promessa em dispositivos eletrônicos de alta temperatura que colocam mais ênfase na estabilidade térmica. Embora o Ge-dopado GaN tenha sido estudado teoricamente, é essencial investigar o impacto real no dispositivo em questão. Neste artigo, os novos GaN SBDs verticais fabricados em substrato de GaN dopado com Ge-dopado (FS) são propostos. Os SBDs GaN verticais exibem uma qualidade de cristal superior e propriedade eletrônica. Enquanto isso, o desempenho de recuperação de SBDs verticais é sistematicamente investigado. O tempo de recuperação reversa e a carga de recuperação reversa finalmente mostram uma correlação positiva significativa com a área do eletrodo.
Métodos e Experimentos
O esquema das estruturas do dispositivo para os SBDs fabricados é exibido na Fig. 1a, que consiste principalmente em um FS n + de 390 μm Substrato -GaN e um 9-μm n - Camada de deriva -GaN. Neste trabalho, a camada de substrato GaN orientada (0001) com uma concentração de Ge de 1 × 10 18 cm - 3 e uma densidade de deslocamento de 1 × 10 6 cm - 2 foi cultivado por HVPE. E a camada epitaxial não dopada neste substrato foi cultivada por deposição de vapor químico metalorgânico, com uma taxa de crescimento de ~ 2 μm / h. Para a fabricação de SBD, contatos ôhmicos Ti / Al / Ni / Au foram formados na superfície posterior do substrato de GaN. Eletrodos Ni / Au Schottky foram formados na superfície frontal da camada epitaxial com cinco diâmetros diferentes (100, 200, 300, 400 e 500 μm), conforme mostrado na Fig. 1b. Mais informações sobre o processo de fabricação podem ser encontradas em nosso relatório anterior [23, 24].
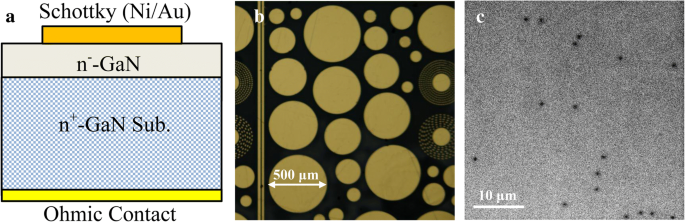
a Seção transversal esquemática do SBD vertical fabricado. b Imagem de microscopia óptica dos diferentes eletrodos. c Imagem CL pancromática da camada epitaxial
As imagens de catodoluminescência (CL) foram obtidas usando um microscópio eletrônico de varredura (MEV) Quanta 400 FEG com uma tensão de aceleração de 10 kV para estudar a distribuição espacial da densidade de deslocamento para a camada epitaxial. Capacitância-tensão ( C-V ) e corrente-tensão ( I-V ) as medições foram realizadas usando um analisador de parâmetros semicondutores Keithley 4200 para avaliar as propriedades eletrônicas dos SBDs. E as medições dependentes da temperatura foram realizadas na faixa de 300 a 500 K com uma configuração experimental personalizada.
Resultados e discussão
O resultado CL da camada epitaxial é apresentado na Fig. 1c. Como acredita-se que o deslocamento seja um centro de recombinação não radiativo, ele aparece na imagem CL na forma de uma mancha escura. Uma vez que nenhuma diferença de distribuição espacial perceptível é observada, o valor médio da densidade de deslocamento foi calculado em ~ 1,3 × 10 6 cm - 2 , com as medições CL realizadas em várias regiões diferentes. Este resultado indica que uma camada epitaxial de alta qualidade foi obtida para SBDs verticais.
Como os SBDs verticais foram caracterizados em um modo paralelo, o C-V e G-V curvas foram obtidas com frequência de 1 MHz. Os resultados dos SBDs são mostrados nas Fig. 2a eb, respectivamente, onde ( 1 / C 2 ) versus tensão aplicada V é plotado na inserção. Aqui, concentração de portador N d poderia ser avaliada com a expressão:\ ({N} _d =\ frac {-2} {A ^ 2 q \ varejpsilon \ left [d \ left (1 / {C} ^ 2 \ right) / dV \ right]} \), onde A é a área dos eletrodos Schottky, q é a carga do elétron (1,602 × 10 - 19 C), e ε é a constante dielétrica de GaN (8.854 × 10 - 11 F / m). Portanto, o N d da camada epitaxial foi determinada como sendo ~ 6,2 × 10 15 cm - 3 . E o ângulo de fase θ também pode ser calculado pela seguinte equação:\ (\ theta ={\ tan} ^ {- 1} \ left (\ frac {2 \ pi fC} {G} \ right) \), onde f é a frequência aplicada, C é a capacitância, e G é a condutância medida (vazamento de porta). Como os resultados para diâmetros diferentes são semelhantes, o ângulo calculado θ versus tensão aplicada V dos SBDs de 300 μm de diâmetro é mostrado na inserção da Fig. 2b como um exemplo. Observe que o θ está muito próximo de 90 °, isso confirma que uma excelente porta de Schottky com um baixo caminho de vazamento foi alcançada neste estudo. O J-V as características também são apresentadas na Fig. 2c. É visto claramente que o eu em / eu desligado as proporções são 3,8 × 10 9 , 5,9 × 10 8 , 1,3 × 10 10 , 6,5 × 10 8 e 9,9 × 10 7 para os SBDs de 100, 200, 300, 400 e 500 μm de diâmetro, respectivamente, dos quais o I em e eu desligado são definidos como a corrente na tensão da porta de 1,6 e -2 V, respectivamente. Após o ajuste linear, a tensão de ativação V em de SBDs verticais é determinado como sendo 0,70, 0,76, 0,72, 0,70 e 0,78 V, respectivamente, com os diâmetros do eletrodo aumentando de 100 para 500 μm. Esses resultados indicam que uma boa propriedade eletrônica foi obtida para os SBDs verticais.
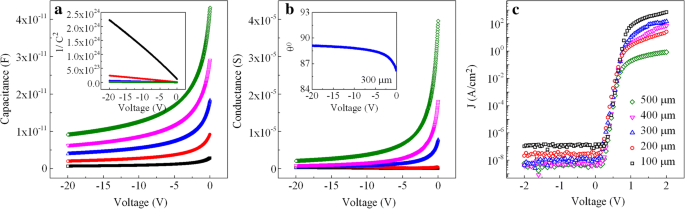
a Temperatura ambiente C-V curva de SBDs verticais para cada eletrodo diferente a uma frequência de 1 MHz. A inserção é um enredo de ( 1 / C 2 ) versus tensão V . b G-V curva de SBDs verticais para cada eletrodo diferente. A inserção é um gráfico do ângulo de fase θ versus tensão V para SBDs de 300 μm de diâmetro. c J-V curva de SBDs verticais para cada eletrodo diferente
Um circuito de teste típico foi usado para medir as características de recuperação reversa dos SBDs verticais, conforme mostrado na Fig. 3a. Os sinais de tensão de onda quadrada periódica (de + 20 a - 20 V) foram aplicados sequencialmente a um dispositivo em teste (DUT), onde um indutor parasita armazenaria a energia magnética e afetaria a corrente. Quando o sinal de tensão muda, uma corrente de oscilação pode ocorrer durante o período. Uma ponta de prova de corrente de alta velocidade com um osciloscópio Tektronix MDO 4104-3 foi disposta para detectar a variação de corrente transiente nos SBDs verticais. Como a forma de onda esquemática da corrente de recuperação reversa é mostrada na Fig. 3b, neste estudo, t a é definido como o tempo de armazenamento enquanto t b é definido como o tempo de atraso da corrente reversa. E o tempo de recuperação reverso T rr é definido como o tempo em que a corrente reversa recupera para 10% da corrente de recuperação reversa máxima I RM , que é a soma de t a e t b . E a cobrança de recuperação reversa Q rr é obtido integrando a corrente reversa até T rr que corresponde à carga acumulada em um diodo.

a O circuito de teste usado para medir as características de recuperação reversa de SBDs verticais. b Forma de onda esquemática das características de recuperação reversa de SBDs verticais
A Figura 4 mostra a curva de recuperação reversa de SBDs verticais para cada diâmetro do eletrodo quando a tensão aplicada mudou de + 20 para - 20 V. Aqui, para os SBDs de 100, 200, 300, 400 e 500 μm de diâmetro , o T rr os valores obtidos foram 15,8, 16,2, 18,1, 21,22 e 24,5 ns, enquanto o Q rr os valores foram integrados em 0,0127, 0,0536, 0,150, 0,280 e 0,405 nC, respectivamente. Todos esses dispositivos verticais exibiram um tempo de comutação rápido (menos de 25 ns). Uma considerável baixa corrente reversa também é observada nos resultados, o que pode ser devido à menor quantidade de carga armazenada nos SBDs [13]. Enquanto isso, também é visto claramente que o valor de T rr e Q rr ambos aumentam junto com o aumento dos diâmetros dos eletrodos, e o menor mostra o T mais rápido rr de 15,8 ns.
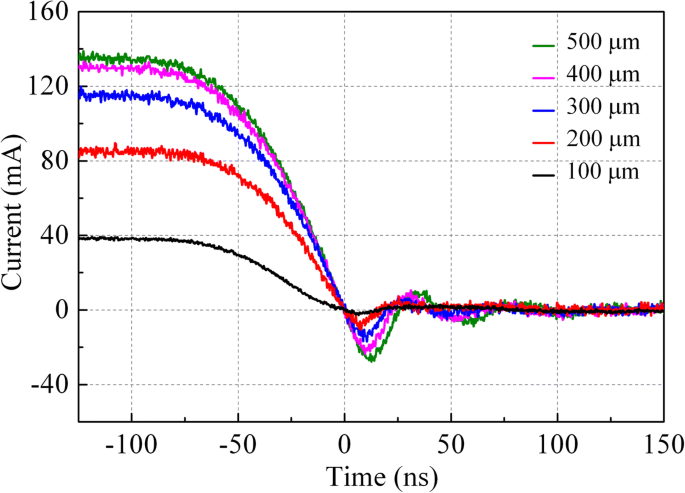
Corrente de recuperação reversa de SBDs verticais para cada eletrodo diferente
Para investigar melhor o mecanismo subjacente a essas mudanças, os SBDs verticais também foram medidos quando a tensão mudou de + 10 para - 10 V. Como o tempo de recuperação reverso T rr versus o diâmetro do diodo d é plotado na Fig. 5, o valor de T rr para cada diodo não foi alterado de forma perceptível. A cobrança de recuperação reversa Q rr versus o d é exibido na Fig. 6 simultaneamente, onde os dados de duas curvas apontam para a mesma tendência. Enquanto isso, é notável que o Q rr de ambos os testes mostram uma correlação positiva significativa com o d 2 , ou seja, a área do eletrodo.
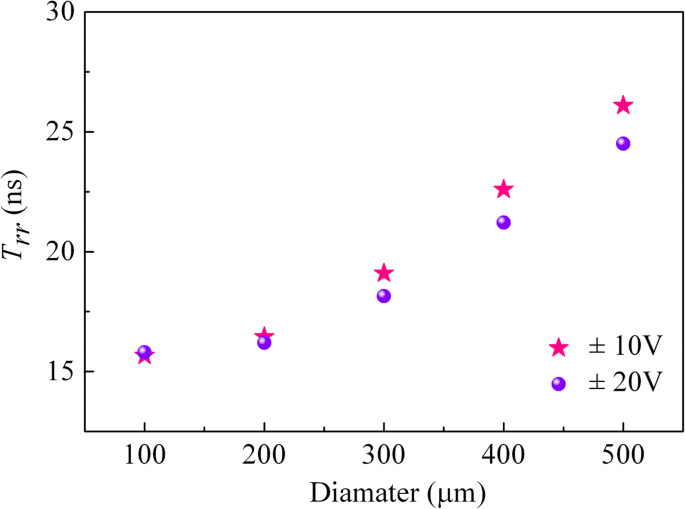
Tempo de recuperação reversa T rr versus diâmetro do eletrodo d
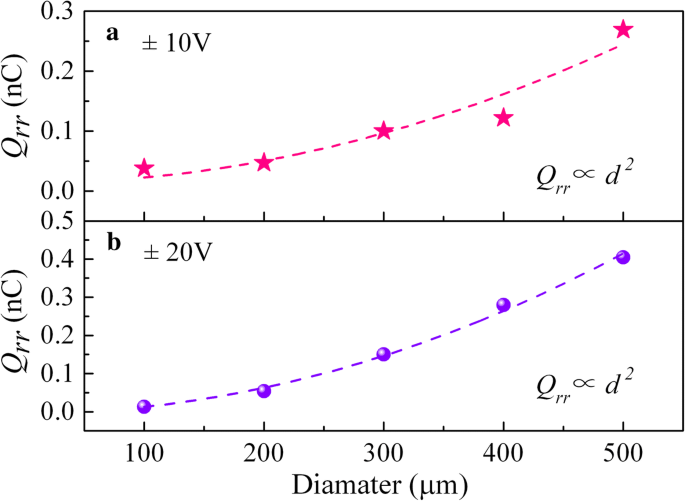
Carga de recuperação reversa Q rr versus diâmetro do eletrodo d
Na verdade, é relatado que o efeito de recuperação reversa deve ser principalmente da indutância parasitária e interceptação de interface de SBDs [25, 26]. Considerando que a contribuição da indutância parasitária é caracterizada na forma de corrente de oscilação que não é obviamente observada nessas curvas de recuperação reversa, portanto, a mudança do tempo de recuperação reversa e da carga de recuperação reversa deveriam ter resultado das armadilhas [27, 28]. Uma vez que a concentração de armadilhas é uniforme em SBDs verticais, o Q rr dependeria da área de contato do dispositivo e finalmente aumentaria com a área do eletrodo, conforme mostrado na Fig. 6. Assim, as armadilhas atuam como um limitador de campo elétrico na interface. Durante o t a período, o atraso foi fortemente influenciado pelo trapping de portadora na junção Schottky, enquanto no t b período, a velocidade de recuperação reversa também é diminuída pelo tempo para varrer a carga armazenada para fora da junção. Esses resultados são consistentes com nosso relatório anterior [29], que sugeriu o RC a constante de tempo aumenta com o aumento do diâmetro do dispositivo e mostra uma boa dependência com o tempo de recuperação reversa. E uma melhoria adicional das características de recuperação reversa pode ser esperada de um eletrodo menor ou uma camada de deriva mais fina nesses dispositivos.
Além disso, o desempenho de recuperação de SBDs verticais é ainda investigado em uma temperatura mais alta. A Figura 7 mostra a corrente de recuperação reversa para SBDs GaN de 500 μm de diâmetro que foram medidos a 300, 400 e 500 K, respectivamente. Nem o tempo de recuperação reversa nem a carga de recuperação reversa são observados alterados com o aumento da temperatura. Esses resultados são consistentes com a análise acima, pois a concentração da armadilha não é muito sensível à temperatura. Por outro lado, é relatado que o tempo de recuperação reversa de SBDs à base de Si aumentaria em 191% conforme a temperatura sobe de 300 para 425 K [17]. Aqui, com uma vida útil curta da portadora e um intervalo de banda mais amplo, os SBDs de GaN são mostrados para fornecer melhorias substanciais na capacidade de manuseio de corrente, recuperação reversa e perda de energia. Como a estabilidade térmica dos SBDs baseados em GaN é superior à dos tradicionais semicondutores de bandgap estreito [30], pode-se concluir que o GaN também é um material adequado para dispositivos de chaveamento aplicados a um ambiente de alta temperatura.
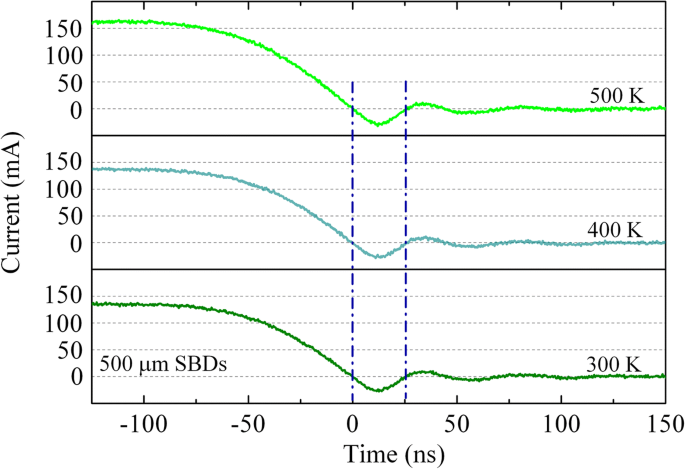
Características de recuperação reversa para SBDs de 500 μm de diâmetro medidos em 300, 400 e 500 K, respectivamente
Conclusões
Em resumo, nós fabricamos SBDs GaN verticais em substratos FS GaN dopados com Ge crescidos por HVPE. Com a caracterização do material e as medições de corrente-tensão realizadas, isso indica que uma excelente qualidade de cristal e propriedade eletrônica foi obtida para os SBDs verticais. As características de recuperação reversa foram sistematicamente investigadas. O tempo de recuperação reversa foi obtido em 15,8, 16,2, 18,1, 21,22 e 24,5 ns para os diodos de 100, 200, 300, 400 e 500 μm de diâmetro, respectivamente. Enquanto isso, o tempo de recuperação reversa e a carga de recuperação reversa mostram uma correlação positiva significativa com a área do eletrodo. Nossos resultados podem servir como uma referência para melhorar ainda mais o desempenho de recuperação de SBDs baseados em GaN.
Abreviações
- CL:
-
Catodoluminescência
- C-V :
-
Capacitância-tensão
- DUT:
-
Dispositivo em teste
- FS:
-
Autônomo
- GaN:
-
Nitreto de gálio
- HVPE:
-
Epitaxia de fase de vapor de hidreto
- I-V :
-
Corrente electrica
- SBDs:
-
Diodos de barreira Schottky
- SEM:
-
Microscópio eletrônico de varredura
Nanomateriais
- Diodos
- Dispositivos Quantum
- Diodos para fins especiais
- Navistar:Desempenho para serviços pesados
- Tecnologia HDPE de alta barreira de umidade para embalagens flexíveis multicamadas
- Efeito da irradiação ultravioleta nas características dos diodos 4H-SiC PiN
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Células endoteliais de segmentação com nanopartículas de GaN / Fe multifuncionais
- Desempenho fotocatalítico acionado por luz visível de nanocompósitos N-dopados com ZnO / g-C3N4
- 3 maneiras de melhorar o desempenho de sua bomba vertical



