Efeito da irradiação ultravioleta nas características dos diodos 4H-SiC PiN
Resumo
Neste artigo, o efeito da irradiação ultravioleta (UV) nas características estáticas do 4H-SiC PiN de alta tensão é investigado. Nenhuma mudança significativa é observada na característica de forward on state dos diodos 4H-SiC PiN antes e depois da irradiação de luz ultravioleta. No entanto, verifica-se que a tensão de bloqueio aumenta significativamente com a irradiação UV, que é resultado da extensão da largura da região de depleção com a coleta de cargas positivas sob o aumento da densidade de carga negativa superficial. A espectroscopia transiente de nível profundo revela que os defeitos de nível profundo induzidos pela irradiação UV desempenham um papel dominante sobre as cargas negativas aprisionadas e, portanto, leva ao aumento da tensão de bloqueio dos diodos 4H-SiC PiN.
Introdução
Espera-se que o carboneto de silício (SiC) seja um material candidato promissor para a próxima geração de dispositivos eletrônicos de alta potência e alta temperatura, devido ao seu largo bandgap, alta intensidade de campo elétrico crítico, alta velocidade de saturação de elétrons e condutividade térmica superior [1 , 2,3,4]. Os dispositivos de SiC estão sendo desenvolvidos para substituir muitos dos dispositivos atualmente usados em silício, especialmente nos requisitos que precisam operar em altas tensões e níveis de corrente, e em temperaturas acima de 200 ° C. Em comparação com os dispositivos unipolares, os dispositivos bipolares de SiC estão atraindo interesses consideráveis devido às aplicações de ultra-alta tensão devido ao efeito da modulação da condutividade nos últimos anos. Como um dispositivo bipolar típico, o diodo 4H-SiC PiN de alta tensão foi demonstrado, que é uma escolha potencial para aplicações de retificador de alta tensão, incluindo rede inteligente avançada, armazenamento de energia e energia pulsada [5,6,7,8]. No processo de fabricação de dispositivos de energia de SiC, vários processos de plasma, como corrosão a seco e deposição por pulverização catódica, são amplamente utilizados. Vários trabalhos têm sido relatados sobre danos induzidos por processo em dispositivos de SiC para causar degradação elétrica [9, 10]. Além disso, estudos anteriores revelam que a irradiação UV reduz significativamente o desempenho dos transistores de efeito de campo semicondutores de óxido metálico de SiC (MOSFETs) por bombardeio de íons de alta energia e fotoemissão de plasma [11, 12]. Recentemente, é relatado que a irradiação de laser UV pulsado em 4H ‑ SiC semicondutor de óxido metálico (MOS) pode induzir a armadilha de óxido da interface próxima e causar desvio de desempenho do dispositivo e degradação da confiabilidade [13]. No entanto, até onde sabemos, a irradiação UV em dispositivos SiC PiN não foi investigada até o momento e é necessário entender os efeitos nas características dos dispositivos SiC PiN.
Neste estudo, investigamos o efeito da irradiação UV em diodos 4H-SiC PiN nas características de bloqueio direto e reverso usando irradiação UV de comprimento de onda de 184,9 nm. A influência da acumulação de carga superficial na tensão de ruptura dos diodos SiC PiN é apresentada usando simulação de Technology Computer-Aided Design (TCAD). SiO 2 / As densidades do estado de SiC antes e depois da irradiação foram caracterizadas por sistema de espectroscopia transiente de nível profundo (DLTS) em SiC MOS. DLTS é amplamente utilizado para estudar a distribuição de densidade de estados de interface (Dit) e defeitos profundos em capacitores MOS [14, 15].
Métodos
A estrutura esquemática do diodo 4H-SiC PiN relatada neste artigo é mostrada na Fig. 1. A camada tampão de 2 μm de espessura dopada para 1 × 10 18 cm −3 e camada de deriva n de 60 μm de espessura com uma concentração de dopagem de 2 × 10 14 cm −3 cresceram continuamente em substratos 4H-SiC (0001) tipo n fortemente dopados a 4 ° fora do eixo. Então, a camada superior era p + ânodo com 2 μm de espessura e uma concentração de dopagem de 2 × 10 19 cm −3 . Após o crescimento epitaxial, uma estrutura de mesa de isolamento circular com 2,5 μm de altura e 300 μm de diâmetro foi padronizada usando plasma acoplado indutivamente reagindo através da camada de ânodo p + na camada de deriva n. Os gases de corrosão e o material da máscara foram SF 6 / O 2 e depositados por deposição de vapor químico intensificada por plasma, respectivamente. Seguindo o isolamento da mesa, um duplo implante de Al de 1 × 10 17 cm −3 A extensão de terminação de junção baseada (JTE) foi formada para aliviar o aglomerado de campos elétricos próximo à borda da mesa. Os implantes foram ativados por recozimento em Ar a 1650 ° C por 30 min. Um sacrificial SiO 2 A camada foi cultivada a 1100 ° C durante 1 h e mergulhada com HF para fornecer uma superfície nova para a oxidação térmica. Em seguida, oxidação térmica em O 2 seco ambiente foi realizado a 1100 ° C por 3 h com SiO 2 camadas de espessura de cerca de 40 nm, seguido por recozimento em Ar ambiente a 1100 ° C por 1 h. Os materiais de contato foram Ni / Ti / Al para o ânodo e Ni para o cátodo. Esses metais foram recozidos a 800 ° C e 1000 ° C por 2 min para obter contato ôhmico de alta qualidade, respectivamente. As resistências de contato específicas caracterizadas pelo método do comprimento de transferência linear foram 1 × 10 −5 Ω cm 2 e 3,75 × 10 −5 Ω cm 2 para contato ôhmico do tipo Ni n e Ni / Ti / Al p, respectivamente. A camada de metal com Al espesso foi depositada no ânodo e cátodo. A camada de dióxido de silício e uma camada espessa de poliimida foram padronizadas na frente para evitar faíscas na superfície durante as medições de alta tensão. Além disso, os capacitores SiC-MOS foram fabricados em um tipo n de alta qualidade (7 × 10 15 cm −3 ) camada de epitaxi em um substrato 4H-SiC fortemente dopado. O óxido térmico de 40 nm foi cultivado com base no processo padrão de SiC PiN. O eletrodo de porta e o contato ôhmico posterior foram formados com Al e Ni, respectivamente.

Seção transversal esquemática de diodos 4H-SiC PiN
Diodos 4H-SiC PiN e capacitores SiC-MOS foram irradiados por luz ultravioleta usando lâmpada de mercúrio com comprimento de onda de 184,9 nm no ar por 72 h sem estresse de polarização. As características elétricas do 4H-SiC PiN antes e depois da irradiação UV foram avaliadas pela sonda Wentworth e pelo sistema de caracterização de semicondutores Agilent B1505A. Os estados de interface dos capacitores SiC-MOS e cargas fixas foram caracterizados por um sistema DLTS PhysTech Fourier Transform. A polarização reversa aplicada V R e a tensão de pulso de enchimento V P foram 15 V e 2 V, respectivamente. O período de amostragem t w do pulso de polarização de V R para V P foi de 1,5 s.
Resultados e discussão
O efeito da irradiação UV nas características estáticas de SiC PiN é mostrado nas Figs. 2 e 3 onde as características medidas antes e depois da irradiação são comparadas para o dispositivo 1 (D1) e o dispositivo 2 (D2). O diâmetro dos diodos circulares SiC PiN é de 3,5 mm e a área ativa é de cerca de 10 mm 2 . A queda de tensão direta para SiC PiN é de cerca de 3,95 V na densidade de corrente de 100 A / cm 2 para ambos os dispositivos antes da irradiação UV. Observa-se claramente na Fig. 2 que não há mudanças significativas na característica forward on state para dois dispositivos, passando de 3,95 para 4,0 V após a irradiação UV. As tensões de bloqueio alcançadas do dispositivo 1 e do dispositivo 2 fabricados em uma camada de epilação n-drift de 60 μm de espessura são 7 kV e 7,2 kV na corrente de fuga de menos de 1μA, respectivamente. Deve-se notar que a eficiência de bloqueio dos diodos PiN é de cerca de 70% do valor teórico de 9,7 kV para camada de deriva de 60 μm de espessura, em que a imprecisão da ativação de impurezas provavelmente leva ao desvio da janela ideal de implante JTE. Após a irradiação UV, a tensão de bloqueio do dispositivo 1 mostra um aumento notável de 7 para 9,2 kV com melhoria de 2,2 kV, aproximando-se do valor do plano paralelo ideal. Correspondentemente, uma melhoria de 1,7 kV é alcançada para o dispositivo 2 após a irradiação UV.

Avançar na característica de estado do diodo 4H-SiC PiN antes e depois da irradiação UV
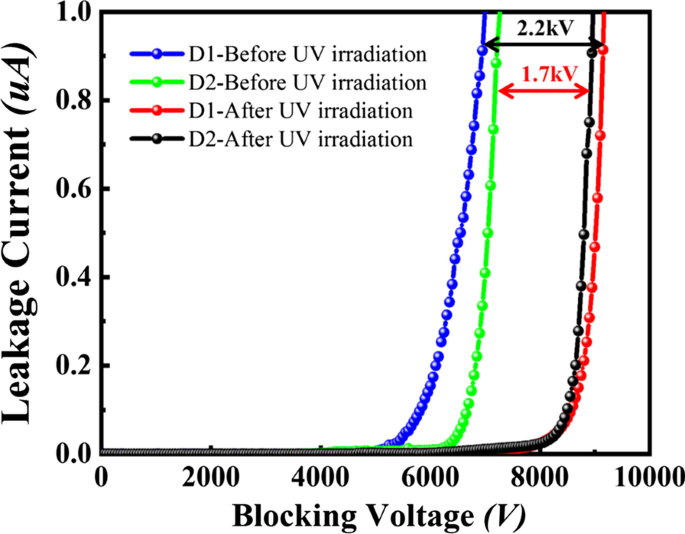
Característica reversa do diodo 4H-SiC PiN antes e depois da irradiação UV
É bem conhecido que as armadilhas de superfície têm um efeito significativo na distribuição do campo elétrico na região terminal e, então, afetam as características de bloqueio reverso no dispositivo de energia SiC. Ikeguchi et al. indicaram que a iluminação UV de alta energia com energia de fóton ≥ 5 eV pode transformar as ligações duplas C – C tensas pré-existentes em armadilhas eletrônicas ativas e, portanto, leva à produção de defeitos de interface carregados negativamente observados por V

Tensão de ruptura simulada versus concentração de implante JTE para carga negativa de superfície, incluindo sem carga, 1 × 10 11 cm −2 , 5 × 10 11 cm −2 , 1 × 10 12 cm −2 , 5 × 10 12 cm −2 e 1 × 10 13 cm −2 respectivamente
A Figura 5 compara a influência do acúmulo de carga superficial negativa no perfil do campo elétrico na característica de bloqueio. A distribuição do campo elétrico com a evolução da região de depleção nos diodos 4H-SiC PiN é mostrada na Fig. 5a. Quando a carga negativa aumenta para 5 × 10 12 cm −2 no SiO 2 / SiC (região da estrutura JTE) da interface SiC PiN, a carga positiva da camada de deriva N é coletada para a superfície da interface, levando à extensão significativa da região de depleção [16]. A Fig. 5b mostra a linha de corte do campo elétrico abaixo da junção da região JTE / n-drift com a densidade de carga negativa da superfície de 1 × 10 11 e 5 × 10 12 cm −2 . No caso de carga superficial baixa de 1 × 10 11 cm −2 , forte aglomeração de campo elétrico aparece na região de terminação de borda com um valor máximo de 2,5 MV / cm e a tensão de ruptura é de cerca de 8 kV. Conforme a densidade de cargas aumenta para 5 × 10 12 cm −2 , o campo elétrico de pico cai para 2,2 MV / cm e a aglomeração do campo elétrico na região de terminação da borda é suprimida em comparação. Enquanto isso, a distribuição do campo elétrico é mais uniforme e a tensão de ruptura aumenta evidentemente. Portanto, a carga negativa de superfície pode causar a extensão do esgotamento e aliviar o congestionamento do campo elétrico, resultando na melhoria da tensão de ruptura.

Distribuições de campo elétrico simulado de SiC PiN com densidade de carga negativa de superfície de 1 × 10 11 cm −2 e 5 × 10 12 cm −2 : a distribuição do campo elétrico com a evolução da região de esgotamento b linha de corte do campo elétrico abaixo da junção da região JTE / n-drift. A concentração do implante é usada 6 × 10 16 cm −3
Para validar ainda mais os mecanismos físicos de geração dos defeitos eletrônicos induzidos pela irradiação, uma melhor caracterização elétrica do SiO 2 A interface / SiC é necessária para investigar mais detalhes. Os espectros DLTS para capacitores 4H-SiC SiC-MOS foram caracterizados em depleção de 15 a 2 V antes e depois da irradiação UV, como mostrado na Fig. 6. A partir dos espectros DLTS, dois picos foram observados nos capacitores 4H-SiC MOS antes e após irradiação UV, localizando-se a 210 K e 490 K, respectivamente. Os picos DLTS negativos indicam que os níveis P1 e P2 são armadilhas de elétrons. O nível amplo e significativo de P2 mostra um aumento significativo da amplitude do pico, o que significa que a concentração da armadilha de elétrons é aumentada pela irradiação UV. Além disso, verifica-se que o sinal DLTS aumenta proporcionalmente ao tempo de preenchimento, exibindo uma cinética de preenchimento de armadilha característica de defeitos estendidos, como defeitos de interface ao invés de defeitos pontuais. A inserção mostra as distribuições de densidade de estado de interface versus energia de ativação E T . A densidade do estado da interface é calculada por \ (D _ {{{\ text {it}}}} =\ varepsilon _ {{{\ text {sic}}}} C _ {{{\ text {ACC}}}} AN _ {{ \ text {D}}} \ Delta C / \ left [{C_ {R} ^ {3} kT} \ right] \) [17]. Pode-se observar na figura que o defeito da interface dá origem a uma banda de energia no bandgap de E C - 0,65 eV para E C - 1,25 eV e sua densidade aumentou significativamente de 2 × 10 12 cm −2 eV −1 para 6 × 10 12 cm −2 eV −1 após a irradiação UV. Combinando medições de capacitância transitória, microscopia eletrônica de transmissão de alta resolução e cálculos de teoria funcional de densidade, Dong et al. sugeriram que os defeitos dessa interface se originaram de carbono intersticial dividido em excesso carregado negativamente na interface [18]. O pico P1 em 210 k corresponde a uma armadilha de elétrons em E C - 0,41 eV. Sua concentração não exibe nenhuma mudança essencial após a irradiação UV, e provisoriamente atribuída a armadilha P1 para apontar defeitos na camada de epilação de SiC. No entanto, sua configuração atômica ainda não está clara e precisa ser esclarecida em investigações futuras.
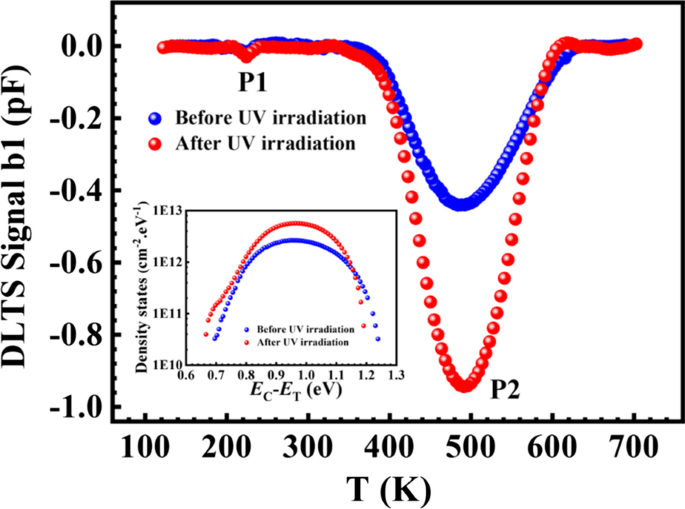
Espectros DLTS para diodos 4H-SiC PiN antes e depois da irradiação UV. A inserção mostra o D distribuições para diodos 4H-SiC PiN antes e depois da irradiação UV
Conclusões
A influência da irradiação UV nas características elétricas dos diodos 4H-SiC PiN foi investigada. A partir dos resultados de experimentos elétricos, uma mudança insignificante da corrente direta é observada após a irradiação UV. No entanto, a irradiação UV parece um aumento notável da tensão de bloqueio. Verifica-se que a irradiação UV gera defeitos de nível profundo na interface dos diodos PiN, resultando em aumento dos níveis de aceitador profundo no bandgap. Esses defeitos de nível profundo servem como o centro de captura de elétrons e levam ao aumento significativo da carga negativa em SiO 2 Interface / SiC. As cargas positivas da camada de sujeira N são coletadas para a superfície da interface e ainda promovem a extensão da região de depleção com distribuição mais uniforme do campo elétrico, o que ocasiona o aumento da tensão de bloqueio.
Disponibilidade de dados e materiais
Todos os dados estão disponíveis sem restrições.
Nanomateriais
- Diodos
- Diodos para fins especiais
- Rolling Pin
- Pino de boliche
- Características da fibra de vidro
- Efeito da distribuição de nanopartículas de ouro em TiO2 nas características ópticas e elétricas de células solares sensibilizadas por corante
- Efeito do polietileno glicol no fotocátodo de NiO
- Efeito do recozimento em microestruturas e endurecimento de ligas de vanádio sequencialmente implantadas com hidrogênio e hélio
- Efeito do revestimento de nanocamada de tungstênio no eletrodo de Si na bateria de íon de lítio
- Diodos emissores de luz ultravioleta baseados em AlGaN quase isentos de eficiência com uma camada de bloqueio de elétrons tipo p de superrede especificamente projetada para alta eficiência de dopag…



