Um CRD de bloqueio reverso de AlGaN / GaN de alta precisão (RB-CRD) com cátodo de trincheira híbrido
Resumo
Um diodo regulador de corrente de bloqueio reverso lateral AlGaN / GaN (RB-CRD) com ânodo Schottky de trincheira e cátodo de trincheira híbrido foi proposto e experimentalmente demonstrado em substrato de silício. O diodo de barreira Schottky (SBD) integrado no ânodo exibe uma tensão de ativação de 0,7 V e uma tensão de ruptura reversa de 260 V. O cátodo de trincheira híbrido atua como um CRD, que está em conexão em série com o ânodo SBD. Uma tensão de joelho de 1,3 V e uma tensão de operação direta além de 200 V podem ser alcançadas para o RB-CRD. O RB-CRD é capaz de produzir uma excelente corrente constante em uma ampla faixa de temperatura de 25 a 300 ° C. Além disso, a corrente de regulação direta exibe pequenos coeficientes de temperatura negativos menores que - 0,152% / o C.
Histórico
Os semicondutores de largura de banda larga têm atraído uma atenção considerável para a próxima geração de dispositivos de alta potência, alta frequência e alta temperatura. GaN é um dos mais promissores semicondutores de bandgap largo devido às suas propriedades superiores, como grande bandgap, alta mobilidade de elétrons e alto campo elétrico crítico [1,2,3,4,5]. Além disso, devido à combinação de polarização espontânea e polarização piezoelétrica, um gás de elétron bidimensional de alta densidade (2DEG) pode ser obtido na heterointerface AlGaN / GaN. Essas excelentes propriedades permitem que os dispositivos de energia baseados em AlGaN / GaN operem com uma baixa resistência enquanto mantêm uma alta tensão de ruptura. A plataforma de silício GaN-on (GaN-on-Si) [6,7,8] tem sido considerada a tecnologia mais promissora para dispositivos de energia de alto desempenho e baixo custo, devido à disponibilidade de pastilhas de silício de grande diâmetro e compatibilidade com o processo de fabricação de CMOS amadurecido existente. Até o momento, uma variedade de dispositivos de energia [9,10,11,12,13,14,15,16] foram demonstrados em AlGaN / GaN-on-Si e alguns deles estão disponíveis comercialmente. Ao mesmo tempo, o desenvolvimento do dispositivo AlGaN / GaN com novas funcionalidades pode expandir o potencial de aplicação do AlGaN / GaN-on-Si, o que é benéfico para impulsionar a comercialização extensiva da tecnologia AlGaN / GaN.
Conforme apresentado na Fig. 1a, neste trabalho, um novo tipo de dispositivo denominado como diodo regulador de corrente de bloqueio reverso (RB-CRD) foi experimentalmente demonstrado em AlGaN / GaN-on-Si. O RB-CRD apresenta um ânodo de trincheira Schottky e um cátodo de trincheira híbrido. Um diodo de barreira Schottky de trincheira (SBD) é formado no ânodo, enquanto um CRD é obtido no cátodo de trincheira híbrido. O RB-CRD pode ser considerado um SBD em conexão em série com um CRD. Uma aplicação típica do RB-CRD é o carregamento da bateria, conforme mostrado na Fig. 1b. No circuito de carregamento de bateria mencionado anteriormente, o CRD atua como uma fonte de corrente constante, que produz uma corrente constante para carregar a bateria [17,18,19], independentemente da flutuação de tensão direta entre a entrada e a bateria. Se a tensão de entrada cair abaixo da tensão da bateria, o SBD de polarização reversa no circuito impedirá que a bateria descarregue.
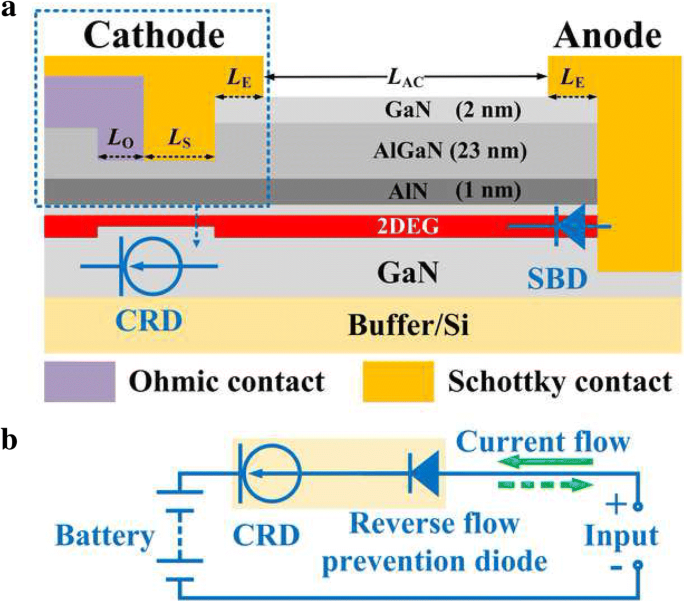
a Seção transversal esquemática do RB-CRD. b Diagrama do circuito de carregamento da bateria usando o RB-CRD
Métodos
A heteroestrutura epitaxial AlGaN / GaN usada para fabricar os RB-CRDs foi cultivada em 6-in (111) substrato de silício por deposição de metal orgânico químico em vapor (MOCVD). As camadas epitaxiais consistem em capa de GaN de 2 nm, barreira AlGaN de 23 nm, intercamada de AlN de 1 nm, canal de GaN de 300 nm e tampão de 3,5 μm. A densidade e mobilidade medidas do efeito Hall do 2DEG foram 9,5 × 10 12 cm −2 e 1500 cm 2 / V · s, respectivamente. O processo de fabricação do dispositivo é mostrado na Fig. 2. Primeiro, uma vala rasa (ver Fig. 3) foi gravada no cátodo do RB-CRD por um Cl 2 de baixa potência / BCl 3 técnica de corrosão com plasma indutivamente acoplado (ICP). Uma taxa de corrosão de 7 nm / min foi observada usando a receita de corrosão desenvolvida com uma potência de RF de 20 W, uma potência de ICP de 60 W, um Cl 2 fluxo de 5 sccm e um BCl 3 fluxo de 10 sccm. Em seguida, o isolamento da mesa com uma profundidade de 300 nm foi formado usando a mesma técnica de ataque ICP para desconectar os dispositivos. A vala anódica foi realizada por este processo simultaneamente. Depois disso, as pilhas de metal Ti / Al / Ni / Au (20/150/55/60 nm nm) foram depositadas pela evaporação do feixe de elétrons, seguido pelo recozimento térmico rápido a 880 ° C por 35 s em N 2 ambiente. A resistência ôhmica de contato de 1,1 Ω mm e a resistência da folha de 400 Ω / quadrado foram extraídas pelo método da linha de transmissão. Por fim, o processo de fabricação do dispositivo acabou com a deposição da pilha de metal Schottky Ni / Au (50/300 nm). A distância entre o ânodo e o cátodo ( L AC ) é 4 μm. Os comprimentos do contato ôhmico ( L O ) e o contato Schottky ( L S ) na vala catódica são 0,5 μm e 1 μm, respectivamente. A saliência estendida ( L E ) do contato Schottky é 0,5 μm.
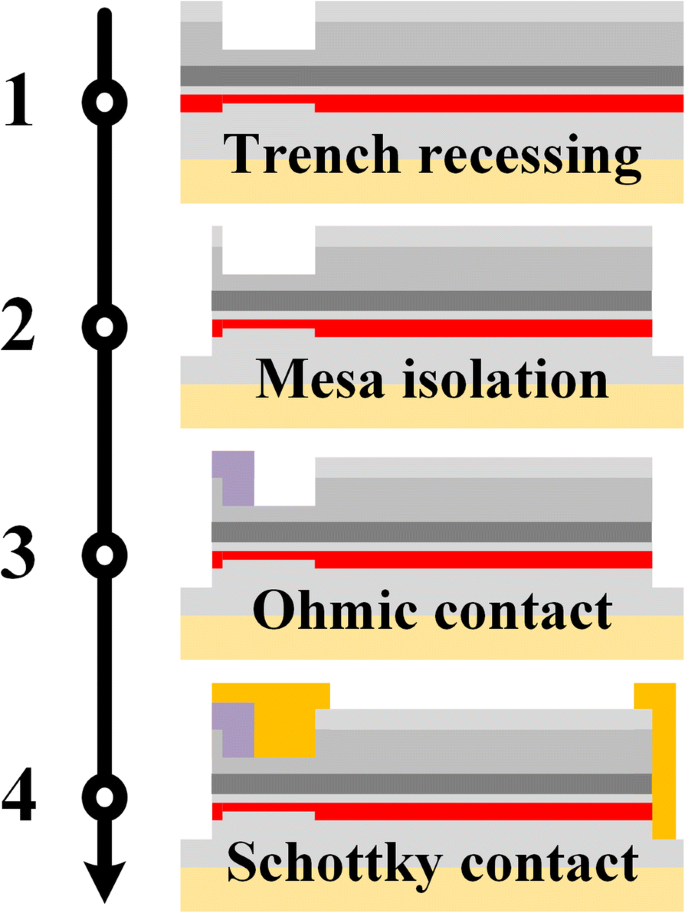
Fluxo do processo de fabricação do RB-CRD
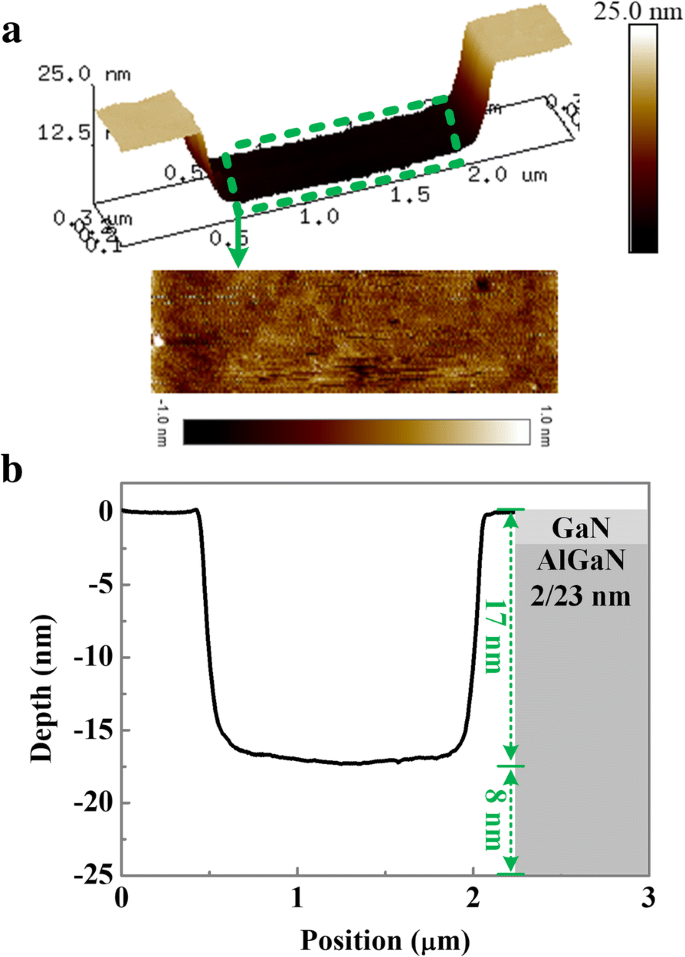
a Imagens AFM da trincheira catódica. b Perfil de altura retirado da vala catódica
Resultados e discussão
A Figura 3a mostra a imagem do microscópio de força atômica 3D (AFM) da trincheira catódica fabricada. A rugosidade da superfície do fundo da vala catódica é de 0,3 nm. Essa pequena rugosidade de superfície é benéfica para o seguinte contato metal-semicondutor. Como mostrado na Fig. 3b, com um recesso da vala catódica de 17 nm, a camada de barreira AlGaN de 8 nm permanece na região da vala catódica. Essa camada de barreira AlGaN restante permite que o canal 2DEG na região de trincheira catódica esteja sempre existindo em polarização zero.
A Figura 4 ilustra o mecanismo de operação do RB-CRD. Quando uma polarização zero é aplicada ao ânodo ( V AC =0 V) (ver Fig. 4a), o RB-CRD é análogo a um HEMT no modo de depleção do dreno Schottky com os eletrodos porta-fonte conectados. Quando uma polarização negativa é aplicada ao ânodo ( V AC <0 V) (ver Fig. 4b), os elétrons se acumularão na região da vala catódica, enquanto o canal 2DEG será esgotado na região anódica devido à junção Schottky polarizada reversa. Não há corrente desejada seguindo entre o ânodo e o cátodo, e o RB-CRD atua como um SBD com polarização reversa. Conforme mostrado na Fig. 4c, quando uma polarização positiva está além da tensão de ativação ( V T , a 1 mA / mm) do ânodo SBD é aplicado ao ânodo ( V AC > V T ), os elétrons fluirão entre o contato ôhmico no cátodo e o contato Schottky no ânodo. Enquanto isso, a junção Schottky no cátodo é polarizada reversa e o canal 2DEG sob o contato Schottky será gradualmente esgotado com o aumento da polarização direta. Portanto, a corrente de saída aumentará inicialmente com a tensão do ânodo aplicada e, em seguida, atingirá gradualmente a saturação. Nesse caso, uma corrente de saída estável pode ser obtida.
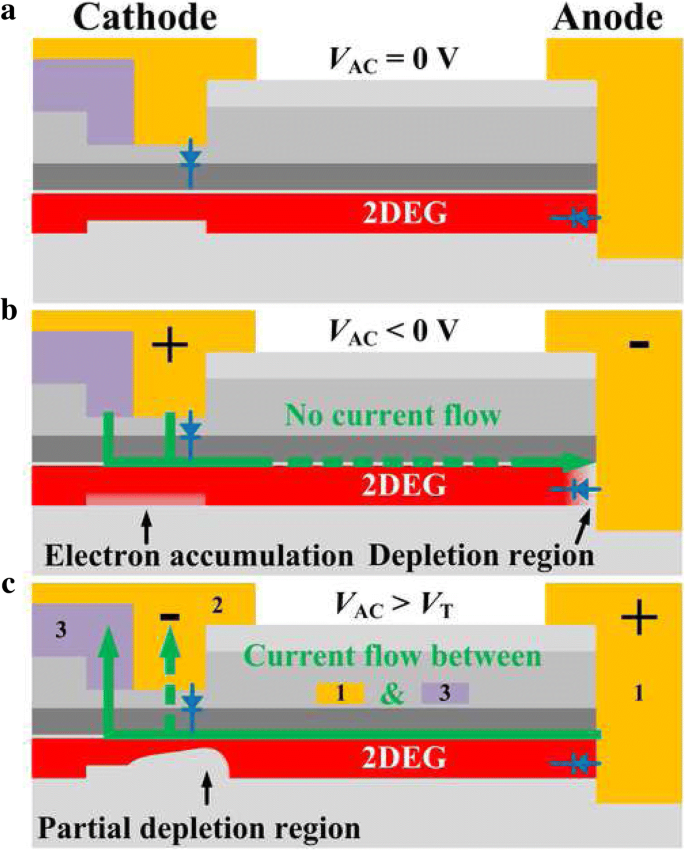
Mecanismo de operação esquemática do RB-CRD sob a polarização zero, b polarização reversa e c condições de polarização direta
O avanço dependente da temperatura I-V as características do RB-CRD no wafer são mostradas na Fig. 5. Conforme mostrado na Fig. 5a, para o RB-CRD, uma tensão de joelho ( V K , a 80% da corrente de regulação constante) de 1,3 V é obtido, o que é maior do que nossos CRDs relatados anteriormente (por exemplo, valor típico 0,6 V) [20, 21]. Isso se deve à queda de tensão adicional (por exemplo, valor típico 0,7 V) no ânodo SBD do RB-CRD. Com o aumento da temperatura de 25 para 300 ° C (ver Fig. 5a), uma mudança negativa no V T é observado, o que pode ser explicado pelo modelo de emissão termiônica (ou seja, menos energia é necessária para que os elétrons superem a barreira de Schottky em temperaturas mais altas). O RB-CRD é capaz de produzir uma corrente de regulação constante de até 200 V (ver Fig. 5b), que é maior do que a tensão máxima de operação relatada dos CRDs comerciais baseados em Si [22,23,24]. A 25 ° C, a relação da corrente reguladora ( I 200 V / eu 25 V ) do RB-CRD proposto é 0,998, indicando que a corrente de saída é bastante estável. Graças à capacidade de operação intrínseca de alta temperatura da plataforma AlGaN / GaN, o RB-CRD exibe degradação insignificante na estabilidade do I A até 200 V em temperaturas de até 300 ° C. Enquanto isso, com a temperatura aumentando de 25 para 300 ° C, a frente I A reduz de 31,1 para 23,1 mA / mm devido à diminuição da mobilidade do elétron em temperaturas elevadas, como mostrado na Fig. 5b. Os coeficientes de temperatura ( α ) da corrente de regulação em diferentes faixas de temperatura pode ser calculada pela seguinte fórmula
$$ \ alpha =\ frac {I_1- {I} _0} {I_0 \ left ({T} _1- {T} _0 \ right)} \ times 100 \% $$
onde eu 0 é a corrente de saída na temperatura T 0 e eu 1 é a corrente de saída na temperatura T 1 . Um pequeno coeficiente de temperatura menor que - 0,152% / o C é observado, indicando que o RB-CRD fabricado apresenta excelente estabilidade térmica.

Polarização direta dependente da temperatura I - V características do RB-CRD. Faixas de tensão do ânodo: a 0–2 V, b 0–200 V
Conforme mostrado na inserção da Fig. 6, a tensão de ruptura reversa do RB-CRD é 260 V a 25 ° C. O campo elétrico crítico médio correspondente é calculado em 0,65 MV / cm. O reverso dependente da temperatura I-V as características do RB-CRD são mostradas na Fig. 6. O aumento da temperatura ambiente de 25 para 300 ° C dá origem a um aumento da corrente de fuga em duas ordens de magnitude.

Polarização reversa dependente da temperatura I - V características do RB-CRD
Conclusões
Em conclusão, um novo AlGaN / GaN-on-Si RB-CRD apresentando ânodo Schottky de trincheira e cátodo de trincheira híbrido foi demonstrado com sucesso pela primeira vez. O RB-CRD fabricado exibe um V K de 1,3 V, uma tensão de operação direta acima de 200 V e uma tensão de ruptura reversa de 260 V. Uma excelente precisão, bem como um pequeno coeficiente de temperatura negativo inferior a - 0,152% / o C foram obtidos para o RB-CRD. O RB-CRD multifuncional com alta precisão é de grande potencial para ser incorporado em sistemas eletrônicos de potência GaN emergentes.
Abreviações
- 2DEG:
-
Gás de elétron bidimensional
- AFM:
-
Microscópio de força atômica
- ICP:
-
Plasma indutivamente acoplado
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- RB-CRD:
-
Diodo regulador de corrente de bloqueio reverso
- SBD:
-
Diodo barreira Schottky
Nanomateriais
- Criação de Blockchain Híbrido / Aplicativos em Nuvem com Ethereum e Google
- Aprimoramento da fabricação de aditivos com engenharia reversa
- Infineon:IGBT de condução reversa com recursos de proteção
- Arrays Python:Criar, Reverter, Pop com Exemplos de Array Python
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Emissão multicolor da estrutura ultravioleta de nanopiramida quasicristal fotônica baseada em GaN com InxGa1 semipolar − xN / GaN vários poços quânticos
- As propriedades elétricas de compostos híbridos baseados em nanotubos de carbono multifoliados com nanoplacas de grafite
- Síntese e propriedades eletroquímicas de materiais catódicos de LiNi0,5Mn1,5O4 com dopagem composta Cr3 + e F− para baterias de íon-lítio
- PEDOT Altamente Condutivo:Camada de Transporte de Furo Transparente PSS com Tratamento Solvente para Células Solares Híbridas Orgânicas / Silicone de Alto Desempenho
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo



