Investigações sobre as propriedades ópticas de poços quânticos múltiplos de InGaN / GaN com espessura variável da camada de cobertura de GaN
Resumo
Três amostras InGaN / GaN MQWs com diferentes espessuras de camada cap GaN foram cultivadas por deposição de vapor químico metalorgânico (MOCVD) para investigar as propriedades ópticas. Descobrimos que uma camada de cobertura mais espessa é mais eficaz na prevenção da evaporação da composição In na camada de poço quântico InGaN. Além disso, o efeito Stark confinado por quantum (QCSE) é aprimorado com o aumento da espessura da camada de cobertura de GaN. Além disso, em comparação com os resultados da medição de eletroluminescência, nos concentramos na diferença de estados de localização e defeitos em três amostras induzidas por várias espessuras de capa para explicar as anomalias nas medições de fotoluminescência à temperatura ambiente. Descobrimos que a camada de capa de GaN muito fina exacerba a falta de homogeneidade dos estados de localização na camada de InGaN QW, e a camada de capa de GaN muito espessa irá gerar mais defeitos na camada de capa de GaN.
Introdução
A estrutura de poços quânticos múltiplos (MQWs) InGaN / GaN é amplamente utilizada em diodos emissores de luz visível (LEDs) e diodos laser (LDs) como uma região ativa, e tem obtido grande sucesso [1,2,3,4]. Melhorar a qualidade dos MQWs InGaN / GaN é tecnologicamente importante para a realização de LEDs e LDs baseados em GaN de alto desempenho. Em pesquisas anteriores, foi descoberto que as barreiras quânticas (QBs) crescidas em alta temperatura GaN (HT-GaN) são benéficas para melhorar a qualidade do cristal e a intensidade luminosa de poços quânticos InGaN / GaN [5, 6]. Devido à fraca força de ligação In-N, a temperatura de crescimento da camada de poços quânticos (QWs) de InGaN é geralmente menor do que os QBs de GaN para obter alto teor de In. Isso pode fazer com que os átomos de índio evaporem de InGaN QW durante o crescimento de GaN QB em temperaturas mais altas. Foi comprovado que a inserção de uma camada de capa de GaN crescida em baixa temperatura (capa LT-GaN) entre InGaN QW e GaN QB reduz efetivamente a dessorção de In composição, o que pode melhorar a uniformidade da espessura da camada de InGaN QW e a distribuição da composição de In [7,8,9]. No entanto, quando a temperatura de crescimento da camada cap de GaN diminui, a capacidade de migração dos adátomos torna-se mais fraca, resultando na deterioração dos materiais de GaN. Além disso, é relatado que o número de defeitos aumenta com o aumento da espessura da camada cap de GaN crescida em baixa temperatura, o que não é a favor de melhorar a uniformidade da distribuição dos átomos de índio e a intensidade luminosa dos poços quânticos InGaN [10]. Muitos relatórios anteriores não se concentraram no efeito dos estados de localização nas propriedades de luminescência na região ativa com várias espessuras de capa de GaN. Neste trabalho, usamos difração de raios-X (XRD), eletroluminescência (EL) e fotoluminescência (PL) para relatar a influência da espessura da camada cap de GaN crescida em baixa temperatura sobre a estrutura e as propriedades de luminescência do InGaN / GaN MQWs, e descreve em detalhes o papel dos estados de localização nas características de luminescência por experimentos de PL dependentes da temperatura.
Métodos
Três amostras InGaN / GaN MQWs foram cultivadas no substrato de safira plano c por deposição de vapor químico metalorgânico (MOCVD). Todas as amostras contêm as mesmas estruturas, consistindo em uma camada tampão GaN não dopada (1,2 μm), uma camada n-GaN dopada com Si (1 μm), uma região ativa MQW InGaN / GaN de dois períodos e um p-GaN dopado com Mg camada (40 nm). No processo de crescimento da região ativa de InGaN / GaN, as condições de crescimento de InGaN QWs eram idênticas entre si; uma fina camada de cobertura de LT-GaN foi cultivada na mesma temperatura que InGaN QW (710 ° C) para evitar a evaporação do índio, e o tempo de crescimento da camada de cobertura de LT-GaN foi de 150 s, 300 s e 500 s para a amostra A, B e C, respectivamente; e então a temperatura de crescimento de GaN QB foi elevada até 810 ° C para melhorar a qualidade do material de GaN QB, e o tempo de crescimento de HT-GaN QB foi idêntico para essas amostras. A difração de raios X (XRD) foi usada para determinar os parâmetros estruturais dessas três amostras. Eletroluminescência (EL) e fotoluminescência à temperatura ambiente (PL) foram realizadas para caracterizar as propriedades ópticas das regiões ativas.
Os espectros EL foram medidos usando o espectrômetro de alta resolução Ocean Optics HR2000 em corrente contínua (DC), onde a potência de saída é detectada usando um fotodiodo Si, e a energia de pico espectral EL e FWHM são detectados por um monocromador e um tubo fotomultiplicador. Para medição de PL, um λ =Laser He-Cd de onda contínua de 325 nm foi usado como fonte de excitação, com uma potência óptica incidente de 3 mW e um tamanho de ponto de 0,5 mm 2 . Medições de PL dependentes da temperatura de 30 K a 300 K foram registradas para analisar o efeito dos estados de localização nas características de luminescência usando um laser semicondutor de GaN de 405 nm com potência de emissão de 5 mW como fonte de excitação. A amostra foi resfriada por hélio líquido de fluxo livre e um refrigerador de ciclo fechado da CTI Cryogenics foi usado para as medições dependentes da temperatura
Resultados e discussões
A Figura 1a mostra os padrões de difração do plano (0002) obtidos pela varredura ω-2θ para essas amostras. Os picos de satélite dessas amostras podem ser vistos claramente, indicando que a estrutura periódica fina e a interface precisa existem nesses MQWs. Usamos o SmartLab Studio II e o programa Global Fit (oferecendo um método de ajuste de base de têmpera paralela avançado para analisar os dados gerados pelo difratômetro SmartLab) para obter a composição média e a espessura QB e QW, conforme mostrado na Tabela 1. Pode ser claramente visto que a composição In no QW aumenta com o aumento da espessura da camada de cobertura de LT-GaN, indicando que uma camada de cobertura mais espessa é mais eficaz na prevenção da evaporação da composição de In. A Figura 1b mostra o mapeamento recíproco do espaço (RSM) da amostra C. O pico principal de GaN e os picos de satélite estão em uma linha, sugere que as camadas QW com o maior conteúdo de In em todas as amostras estão completamente sob tensão. Portanto, a influência do campo piezoelétrico nas propriedades luminosas deve ser levada em consideração.
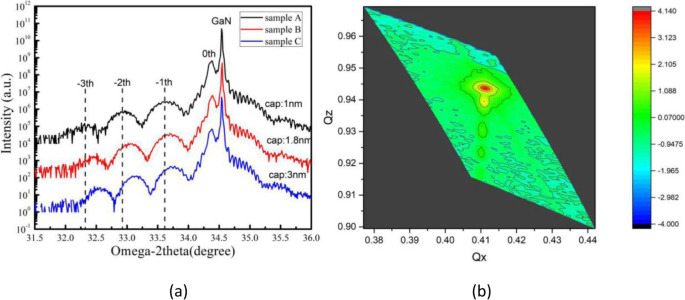
a Curvas de varredura XRD ω-2θ no plano de GaN (0002) para as amostras A, B e C. b Mapeamento do espaço recíproco da amostra C
A Figura 2 mostra os espectros de EL das amostras A, B e C sob corrente de 5 mA. O comprimento de onda de pico é de 453,6 nm, 456,3 nm e 466,7 nm para as amostras A, B e C, respectivamente. A partir dos resultados das medições de XRD, conforme a espessura da camada de cobertura LT-GaN aumenta, o aumento da composição In em QWs induzirá o desvio para o vermelho da energia de pico de EL. Também encontramos a diminuição da intensidade de EL com o aumento da espessura da camada de cobertura de LT-GaN. Sabe-se que uma camada de barreira de GaN mais espessa (a espessura total da camada de cobertura LT-GaN e HT-GaN QB) aumenta a distância dos orifícios de p-GaN para a região ativa, resultando em uma redução na eficiência de injeção do orifício, o que leva a uma diminuição na intensidade de EL [11, 12]. Além disso, o aumento da composição de In aumentará o campo piezoelétrico na camada InGaN QW, de modo que a inclinação da banda de energia é agravada, resultando em um desvio para o vermelho da emissão de pico e uma redução da eficiência luminosa, que é conhecido como Stark confinado por quantum efeito (QCSE) [13,14,15]. Para verificar a influência de QCSE em EL, energia de pico e FWHM de mudança de EL com injeção diferente são mostrados na Fig. 3. À medida que a corrente de injeção aumenta, o deslocamento de azul de energia de pico de emissão pode ser atribuído ao efeito de preenchimento de banda e QCSE compensado pelo efeito de blindagem de elétrons [16,17,18]. Uma vez que a amostra C com a maior composição de In tem o poço de potencial mais profundo e o campo piezoelétrico mais forte, o efeito de preenchimento de banda e o efeito de triagem de carga são os mais significativos, então a quantidade de desvio de azul de energia de pico EL é o maior para a amostra C (166 meV ) O efeito de preenchimento de banda e efeito de seleção de carga na amostra A é o mais fraco, de modo que o encolhimento do intervalo de banda devido ao efeito térmico é gradualmente dominante sob alta corrente de injeção (50 mA), resultando em um desvio para o vermelho da energia de pico. Para a amostra A, o FWHM aumenta com o aumento da corrente de injeção como mostrado na Fig. 3b, indicando que o alargamento do espectro EL induzido pelo efeito de preenchimento de banda é sempre dominante. Foi relatado que a triagem de carga do campo elétrico polarizado no InGaN QWs causará o estreitamento da largura de banda espectral de EL com o aumento da corrente de injeção [19]. Portanto, para as amostras B e C, o efeito de preenchimento de banda é significativo em correntes de injeção mais baixas e o espectro EL é ampliado. À medida que a corrente de injeção aumenta ainda mais, a triagem de portadores do processo de campo elétrico polarizado assume gradualmente, de modo que o FWHM diminui. Além disso, também descobrimos que a corrente correspondente ao ponto de viragem de FWHM de subir para cair para as amostras B e C é de cerca de 10 mA e 20 mA, respectivamente, o que também implica que o campo piezoelétrico na amostra C é o mais forte.
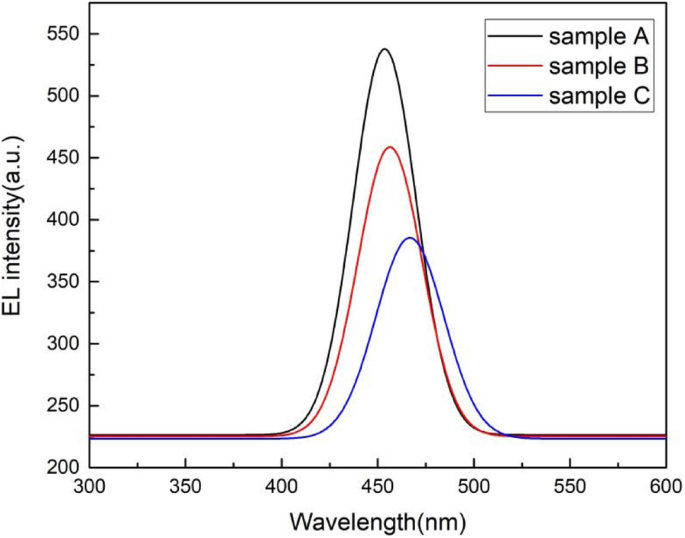
Espectros EL das amostras A, B e C sob corrente de 5 mA
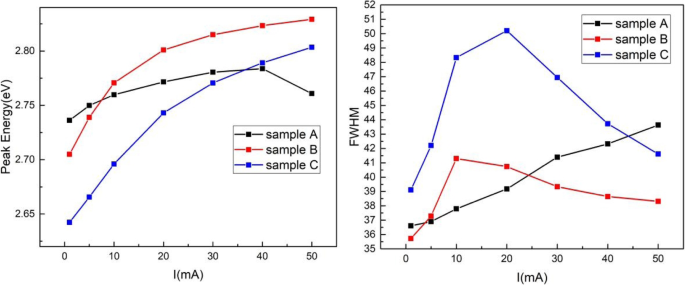
( a ) Energia de pico EL e ( b ) EL largura total na metade do máximo (FWHM) em função da corrente de injeção para as amostras A, B e C
A Figura 4a mostra os espectros de PL à temperatura ambiente para as amostras A, B e C a 5 mW de potência de excitação do laser semicondutor GaN 405 nm. O comprimento de onda de pico é 473,1 nm, 472,9 nm e 478,2 nm para as amostras A, B e C, respectivamente. Uma vez que a intensidade PL das amostras B e C na Fig. 4a são relativamente fracas, também utilizamos o laser He-Cd de 325 nm como uma fonte de excitação para executar o experimento de fotoluminescência. Os resultados experimentais de PL nas Fig. 4a eb são consistentes entre si, o que elimina a incerteza dos resultados experimentais obtidos na Fig. 4a. Em comparação com os resultados da medição EL da Fig. 2, encontramos algumas anomalias na Fig. 4a:(1) A amostra A contém menos composição do que a amostra B, mas o comprimento de onda de pico da amostra A é ligeiramente mais longo do que a amostra B; (2) a intensidade PL da amostra B e C é semelhante entre si, e a intensidade luminosa da amostra A é muito maior do que a amostra B e C. Para descobrir as razões relevantes para explicar essas anomalias, PL dependente da temperatura (TDPL ) foi realizado para três amostras, e a energia de pico de PL em função da temperatura é mostrada na Fig. 5. Para a amostra B, a energia de pico de emissão diminui monotonicamente com o aumento da temperatura. De um modo geral, o aumento da redução da lacuna de banda induzida pela temperatura resultará em um desvio para o vermelho da energia de emissão. No entanto, há uma mudança notável para o azul na amostra A quando a temperatura aumenta de 70 K para 190 K. A redistribuição térmica de excitons localizados foi introduzida para explicar a mudança anormal do azul de emissão em TDPL:com o aumento da temperatura, excitons localizados foram termicamente ativados e transferir termicamente de potenciais mínimos de estados de localização para um estado de maior energia [5, 20, 21]. Para a amostra C, a energia de pico de PL é quase inalterada na faixa de 50 K a 175 K, indicando que o efeito de encolhimento da lacuna de banda e o efeito de localização de excitons compensam um ao outro.
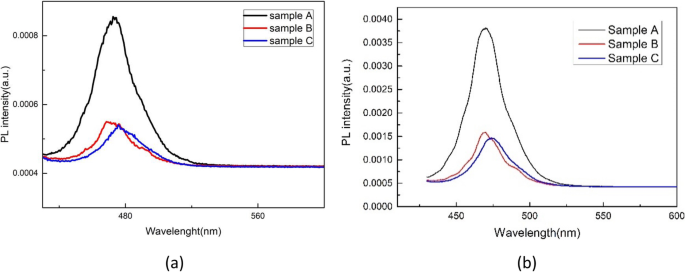
Espectros PL de temperatura ambiente para as amostras A, B e C usando um laser semicondutor GaN 405 nm ( a ) e laser He-Cd de 325 nm ( b ) O comprimento de onda de pico é 473,1 nm, 472,9 nm e 478,2 nm obtido de ( a ) e 470,5 nm, 470,1 nm e 475,2 nm obtidos de ( b ) para as amostras A, B e C, respectivamente
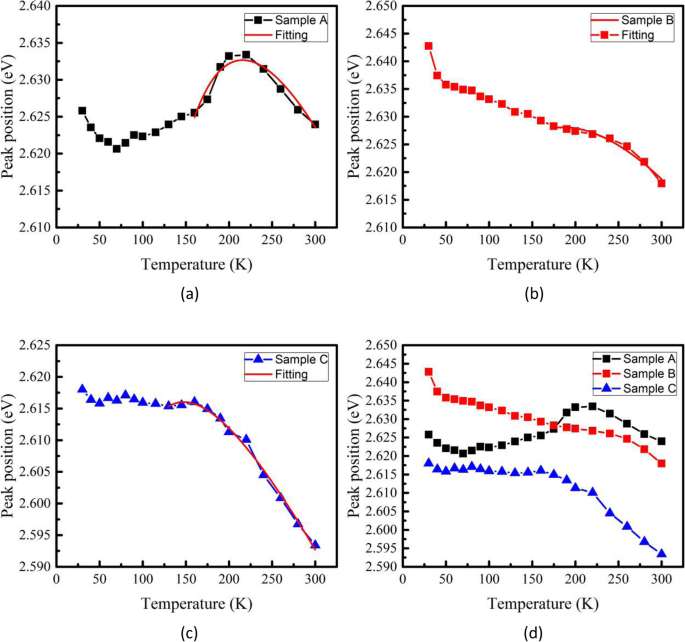
As linhas vermelhas em ( a ), ( b ), e ( c ) são curvas de ajuste com base na Eq. (1) e o parâmetro de ajuste σ é 36,96 meV, 18,89 meV e 23,77 meV para as amostras A, B e C, respectivamente. ( d ) Mostra os dados experimentais da energia de pico PL em função da temperatura
Considerando o efeito de localização de exciton, o modelo de cauda de banda pode ser revisado para a seguinte expressão para descrever a energia de pico de emissão dependente da temperatura [22, 23]:
$$ {E} _0 (T) ={E} _0 (0) \ hbox {-} \ frac {\ alpha {T} ^ 2} {T + \ beta} \ hbox {-} \ frac {\ sigma ^ 2 } {{\ mathrm {k}} _ BT} $$ (1)
onde E 0 (0) é o gap em T =0, α e β são os parâmetros de Varshini, k B é a constante de Boltzmann. O terceiro termo σ é o desvio padrão da distribuição localizada e descreve o grau de efeito de localização, ou seja, um valor maior de σ significa uma maior falta de homogeneidade dos estados de localização. A flutuação da composição de In em InGaN pode ser a principal razão para a formação de cauda de banda. Os estados nas caudas de banda são formados na energia potencial local mínima, semelhante aos pontos quânticos. A recombinação de pares de elétron-buraco nestes pontos quânticos autoformados pode ser considerada como recombinação de exciton localizada [24, 25]. O modelo não é aplicável a baixas temperaturas devido à forte degenerescência e possível desvio do quase equilíbrio [20]. O parâmetro de ajuste σ é 36,96 meV, 18,89 meV e 23,77 meV para as amostras A, B e C, respectivamente, o que implica que os estados de localização da amostra A com a camada de cobertura mais fina são os mais heterogêneos. Em geral, os estados de localização originam-se de aglomerados ricos em In com diferentes tamanhos e a flutuação da espessura QW em ligas InGaN. Portanto, acreditamos razoavelmente que uma camada de cobertura mais fina de LT-GaN não pode prevenir eficazmente a evaporação do índio ao aumentar a temperatura para uma camada de GaN QB crescida. O processo de evaporação aleatória da composição do índio resulta na flutuação do conteúdo de In e da espessura de InGaN QW. Para a amostra B, a camada de cobertura de GaN de espessura de 1,8 nm é espessa o suficiente para proteger In da dessorção para formar uma camada de InGaN QW mais uniforme. Estados de localização não homogêneos geralmente retêm um estado potencial mais profundo e resultam em um desvio para o vermelho da energia de pico de emissão. É por isso que o pico de comprimento de onda da amostra A é maior do que a amostra B observada na Fig. 4. Além disso, um aumento da composição In na camada QW InGaN também promoverá a formação de clusters In de tamanho grande, o que explica por que o efeito de localização de exciton na amostra C com o maior teor de índio é ligeiramente mais forte do que a amostra B.
A Figura 6 mostra a intensidade PL integrada em função da temperatura para a amostra A e C, que pode ser bem ajustada pela seguinte expressão [5, 26]:
$$ I (T) =\ frac {1} {1 + {\ sum} _ {\ mathrm {i}} {C} _i \ exp \ left (- \ frac {E_i} {k_BT} \ right)} $ $ (2)
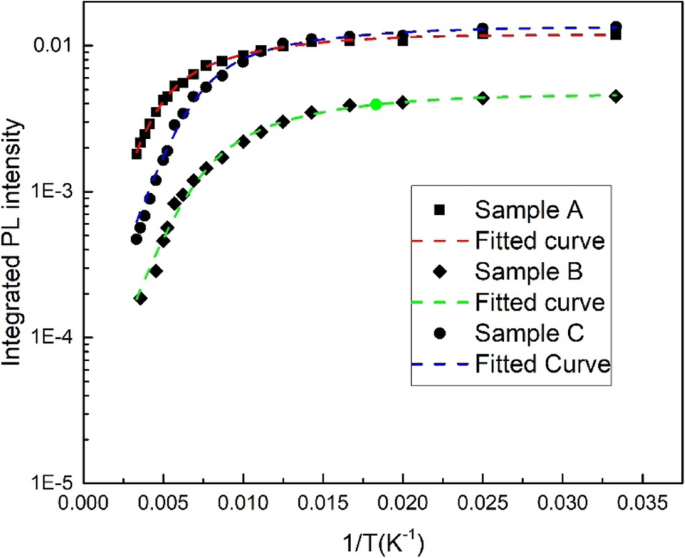
Intensidade PL integrada em função da temperatura reversa para as amostras A, B e C
onde C i é uma constante que corresponde à densidade dos centros de recombinação não radiativa, e E i representa a energia de ativação de centros de recombinação não radiativos. O parâmetro de ajuste C i e E i foram mostrados na Tabela 2. É perceptível que a tensão do fotomultiplicador no espectrômetro de grade para a amostra B foi definida mais baixa do que as amostras A e C durante as medições de PL dependentes da temperatura; portanto, a intensidade PL integrada da amostra B é a mais baixa, mas não afeta os resultados de ajuste.
C 2 para as amostras B e C são maiores do que a amostra A, indicando que mais defeitos são formados em uma camada de cobertura LT-GaN mais espessa. Observou-se que os defeitos na camada de cobertura de LT aumentam com o aumento da espessura da camada de cobertura de LT [6, 10]. A influência de defeitos na camada de cobertura LT-GaN próxima ao poço quântico na intensidade de PL é significativa, pois as funções de onda de elétron e buraco penetram nas barreiras. A energia ativa de 79,67 meV ( E a2 para a amostra A) está relacionada com a emissão de orifícios de QWs seguidos de aprisionamento por defeitos de barreira e recombinação não radiativa, que consistem nos relatórios de Olaizola [6]. Também comparamos as imagens micro-PL das amostras A, B e C, conforme mostrado na Fig. 7. Os pontos escuros nas imagens micro-PL podem ser atribuídos à recombinação não radiativa na região ativa InGaN / GaN. Em comparação com a amostra A, mais manchas escuras de tamanho grande podem ser obviamente observadas nas amostras B e C, indicando que existem mais defeitos em uma camada de cobertura mais espessa de LT-GaN. Em geral, o recozimento térmico é implementado após a camada de cobertura LT para reduzir o aglomerado de índio na camada InGaN e melhorar a qualidade do cristal. Se a camada de cobertura for muito espessa, o efeito do recozimento térmico será enfraquecido e a formação de mais precipitados de índio metálico impedirá os adátomos da difusão da camada de cobertura de GaN e introduzirá mais defeitos na camada de cobertura de LT. O aparecimento de mais defeitos e QCSE mais forte em MQWs InGaN / GaN com uma camada de cobertura LT-GaN mais espessa é desvantajoso para melhorar a intensidade de luminescência, então por que a intensidade PL de C é comparável a B? Na verdade, os estados de localização também desempenham um papel importante na melhoria da eficiência luminosa. Os portadores podem ser capturados em estados localizados e recombinar radiativamente. Quanto mais forte o efeito localizado dos excitons, mais portadores não serão capturados nos defeitos, o que parece explicar que a intensidade PL das amostras B e C é semelhante entre si, e a intensidade luminosa da amostra A é muito maior do que as amostras B e C.
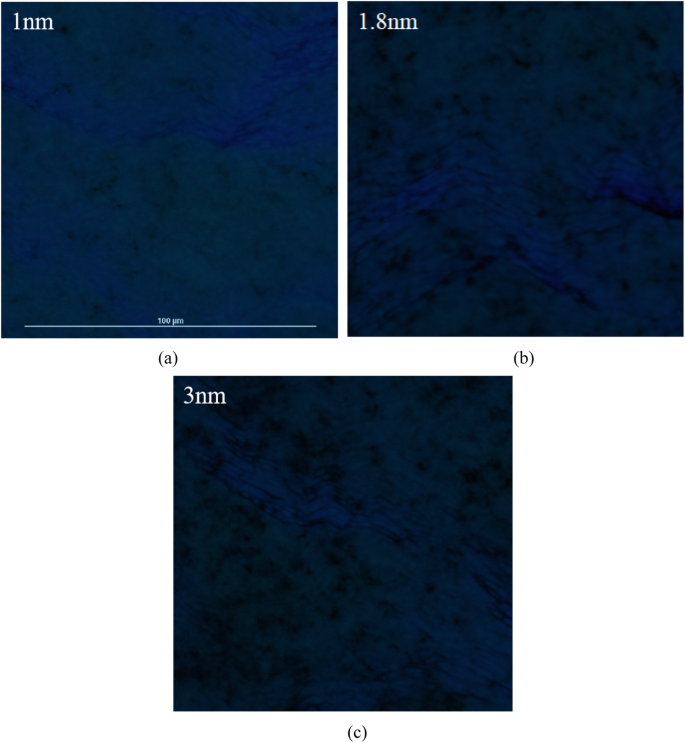
Imagens Micro-PL das amostras A, B e C com várias espessuras de camada de cobertura LT-GaN ( a ) 1 nm, ( b ) 1,8 nm, e ( c ) 3,0 nm
Conclusões
Em resumo, a influência da espessura da camada de cobertura de GaN nas características ópticas foi investigada. Os resultados obtidos a partir de medições de XRD mostram que uma camada de cobertura mais espessa é mais eficaz para proteger a composição da dessorção. QCSE é aprimorado e a eficiência de injeção de orifícios é reduzida com o aumento da espessura da camada de cobertura de GaN. Os vários graus de efeito de localização de exciton induzido por diferentes espessuras da camada cap de GaN explicam as anomalias do pico de comprimento de onda PL e intensidade para três amostras. A camada de cobertura LT muito fina exacerba a falta de homogeneidade dos estados de localização na camada QW InGaN, e a camada de cobertura LT muito espessa irá gerar mais defeitos na camada de cobertura de GaN. Portanto, otimizar a espessura da camada de cobertura de LT-GaN é uma questão chave para promover a uniformidade e a intensidade de emissão da camada ativa de InGaN.
Disponibilidade de dados e materiais
Os conjuntos de dados usados e / ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente, mediante solicitação razoável.
Abreviações
- MOCVD:
-
Deposição de vapor químico metalorgânico
- QCSE:
-
Efeito Stark confinado quântico
- MQWs:
-
Múltiplos poços quânticos
- QB:
-
Barreira quântica
- LEDs:
-
Diodos emissores de luz
- LDs:
-
Diodos laser
- HT:
-
Temperatura alta
- LT:
-
Temperatura baixa
- EL:
-
Eletroluminescência
- TDPL:
-
Fotoluminescência dependente da temperatura
- XRD:
-
Difração de raios X
- FWHM:
-
Largura total pela metade no máximo
Nanomateriais
- O rearranjo atômico de poços quânticos múltiplos baseados em GaN em gás misto H2 / NH3 para melhorar propriedades estruturais e ópticas
- Emissão multicolor da estrutura ultravioleta de nanopiramida quasicristal fotônica baseada em GaN com InxGa1 semipolar − xN / GaN vários poços quânticos
- As propriedades elétricas de compostos híbridos baseados em nanotubos de carbono multifoliados com nanoplacas de grafite
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- Efeitos da Espessura de Bicamada nas Propriedades Morfológicas, Óticas e Elétricas de Nanolaminados de Al2O3 / ZnO
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LED…
- Uma investigação em uma célula solar de silício cristalino com camada de silício preta na parte traseira
- Morfologia, estrutura e propriedades ópticas de filmes semicondutores com Nanislands GeSiSn e camadas deformadas
- Propriedades ópticas de filmes ZnO com dopagem Al-Dopada na região infravermelha e suas aplicações de absorção



