Ge pMOSFETs com passivação GeOx formada por ozônio e pós-oxidação de plasma
Resumo
Um estudo comparativo sobre o desempenho elétrico de Ge pMOSFETs com um GeO x camada de passivação formada pela pós-oxidação do ozônio (OPO) e pós-oxidação do plasma (PPO). PPO e OPO foram realizados em um Al 2 O 3 / n-Ge (001) substrato seguido por um HfO de 5 nm 2 portão dielétrico in situ depositado em uma câmara ALD. A qualidade da camada de interface dielétrica / Ge foi caracterizada por espectroscopia de fotoelétrons de raios-X e microscopia eletrônica de transmissão. O tratamento PPO leva a uma tensão de limiar positiva ( V TH ) turno e um I inferior LIGADO / eu DESLIGADO proporção, implicando em uma qualidade de interface ruim. Ge pMOSFETs com OPO exibem um maior I LIGADO / eu DESLIGADO razão (até quatro ordens de magnitude), oscilação de sublimiar aprimorada e características de mobilidade da portadora aprimoradas em comparação com dispositivos PPO. Um Al 2 mais espesso O 3 camada de bloco no processo OPO leva a uma maior mobilidade nos transistores Ge. Ao comparar dois métodos de oxidação diferentes, os resultados mostram que o OPO é uma forma eficaz de aumentar a qualidade da camada de interface, o que está contribuindo para a melhoria da mobilidade efetiva de pMOSFETs Ge.
Histórico
Com os dispositivos semicondutores de óxido metálico complementar (CMOS) convencionais se aproximando de seu limite físico, o aprimoramento do desempenho é difícil de realizar para dispositivos semicondutores de alta velocidade com silício (Si) como material do canal. Substituir o substrato ou material do canal por outro material com alta mobilidade é uma opção imperativa. O germânio (Ge) tem sido considerado um material de canal alternativo promissor devido à maior mobilidade de portadores do que a do Si. O MOSFET geralmente precisa de uma interface de óxido / semicondutor de alta qualidade para alcançar alta mobilidade efetiva. No entanto, por uma longa história, Ge MOSFETs sofreram com a alta densidade de estado da interface ( D it ) causado pela fraca estabilidade térmica do GeO 2 e títulos pendentes [1]. Assim, muitas pesquisas foram realizadas sobre a passivação da interface Ge.
Diversas abordagens para alcançar uma camada de interface Ge / dielétrica de alta qualidade foram relatadas, como a passivação de Si depositando uniformemente várias monocamadas de Si no substrato de Ge antes da epitaxia dielétrica ou autopassivação pela formação de GeO 2 propositalmente [2, 3]. Para formar um GeO 2 de alta qualidade camada, existem muitos processos de oxidação para reduzir D it e melhorar a estabilidade térmica incluindo oxidação de alta pressão [4], oxidação de ozônio [5], H 2 Plasma O [6] e plasma de ressonância cíclotron de elétrons (ECR) pós-oxidação [7].
Nos últimos anos, muitos trabalhos foram relatados que Ge MOSFET de alto desempenho pode ser realizado por pós-oxidação através de Al 2 O 3 Interface / Ge. Em 2014, um inversor Ge CMOS foi realizado em um substrato Ge-on-insulator (GeOI) com GeO x crescido por recozimento térmico rápido em ambiente de oxigênio puro após 1 nm de Al 2 O 3 foi depositado em Ge [8]. Na ref. [7], Ge pMOSFETs e nMOSFETs com GeO x passivação foram fabricados com pós-oxidação de plasma de oxigênio e dependência da temperatura de GeO x espessura e desempenho elétrico também foram discutidos. A oxidação térmica do Ge pelo ozônio pode ser realizada a uma temperatura mais baixa, pois o ozônio é mais reativo que o oxigênio [5]. O impacto da temperatura no GeO x espessura aumentada pelo ozônio na superfície Ge foi demonstrada. Ge pMOSFETs com GeO x a passivação fabricada pela pós-oxidação do ozônio também foi relatada [9].
Neste trabalho, Ge pMOSFETs com GeO x a passivação é fabricada usando pós-oxidação de ozônio (OPO) e pós-oxidação de plasma de oxigênio (PPO) do Al 2 O 3 Interface / n-Ge. É realizado um estudo comparativo do desempenho elétrico de Ge pMOSFETs com OPO e PPO. Todos os processos, exceto a passivação, são precisamente controlados para serem iguais. A pós-oxidação foi realizada após o Al 2 O 3 deposição de camada de bloco que é diferente de [9] em que a pós-oxidação foi após HfO 2 deposição. O mecanismo de degeneração da mobilidade de Coulomb e a dispersão de rugosidade é investigada. O impacto da espessura do Al 2 O 3 camada de bloco no desempenho do dispositivo também é discutida. No geral, demonstramos que OPO é uma técnica de passivação promissora para a futura fabricação de Ge MOSFET.
Métodos
Os Ge pMOSFETs foram fabricados em 4 pol. wafers n-Ge (001) com uma resistividade de 0,14–0,183 Ω cm. Três processos de passivação diferentes foram realizados, e as etapas principais do processo são mostradas na Fig. 1a. As bolachas foram limpas por HF diluído (1:50) e água desionizada por vários ciclos para remover o óxido nativo e, em seguida, transferidas para uma câmara PEALD de deposição de camada atômica aprimorada por plasma (Picosun R200 Advanced) imediatamente. Em seguida, um fino Al 2 O 3 filme (~ 1 nm) foi depositado a 300 ° C com trimetilalumínio (TMA) e água desionizada (H 2 O) como os precursores de Al e O, respectivamente. Porque o Al 2 O 3 / GeO 2 camada é muito fina para ter uma proporção precisa de átomos de oxigênio, marcamos essas duas camadas como AlO x / GeO x . A PPO foi realizada com a fonte de plasma remota Litmas por 60 s. Um gerador de ozônio (IN USA AC series geradores de ozônio) com o fluxo de oxigênio de entrada de 750 sccm foi usado para o tratamento OPO em 50% O 3 / O 2 ambiente. Sem quebrar o vácuo, 60 ciclos HfO 2 foi então depositado no topo de AlO x / GeO x após tratamento com PPO ou OPO a 300 ° C usando tetraquis dimetilamino-háfnio (TDMAHf) e H 2 O como os precursores de Hf e O, respectivamente. Um TaN de 100 nm foi então depositado por pulverização catódica reativa como porta de metal. Após a padronização e gravação do portão, BF auto-alinhado 2+ implantação em regiões de fonte / dreno (S / D) com uma energia de 20 keV e uma dose de 1 × 10 15 cm - 2 foi realizado. Um metal Ni S / D de 20 nm foi depositado e padronizado por um processo de decolagem. Finalmente, o recozimento térmico rápido a 450 ° C por 30 s para ativação de dopante e contato ôhmico S / D foi seguido. As imagens esquemáticas e microscópicas dos pMOSFETs Ge fabricados são mostradas na Fig. 1b e c, respectivamente.
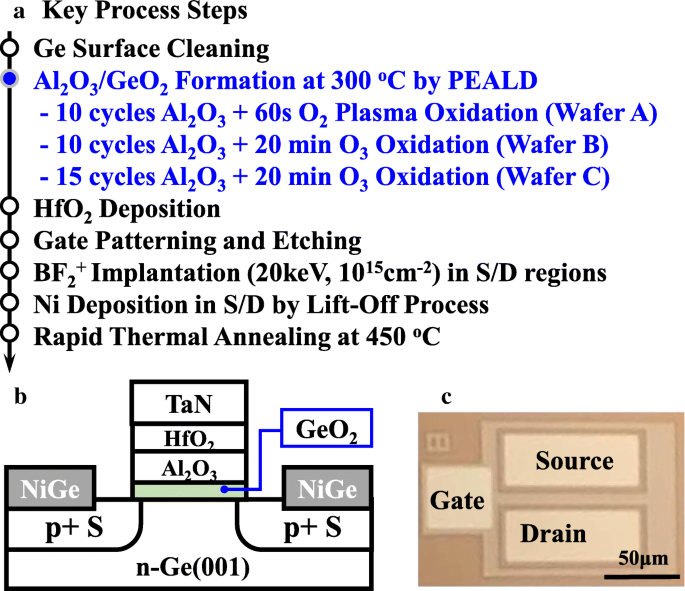
a Fluxo de processo chave para a fabricação de Ge pMOSFETs com GeO 2 passivação de superfície com três métodos diferentes de passivação. b Esquemático e c imagens de microscópio do transistor fabricado Ge
A seção transversal de TaN / HfO 2 / AlO x / GeO x A pilha de portas / Ge foi representada usando um microscópio eletrônico de transmissão (TEM) para comparar o impacto do plasma de oxigênio ou ozônio no GeO x formação. As Figuras 2a eb mostram as imagens TEM em corte transversal de TaN / HfO 2 / AlO x / GeO x / Ge gate stack com PPO e OPO, respectivamente. A espessura do HfO amorfo 2 camada em ambos os dispositivos é de 6 nm. Wafer A com tratamento PPO 60s tem um AlO distinto x / GeO x camada entre o HfO 2 e substratos Ge. Este AlO x / GeO x camada no wafer B formada por 20 min OPO tem uma margem desordenada. A espessura do GeO x camada está de acordo com os dados em [10].
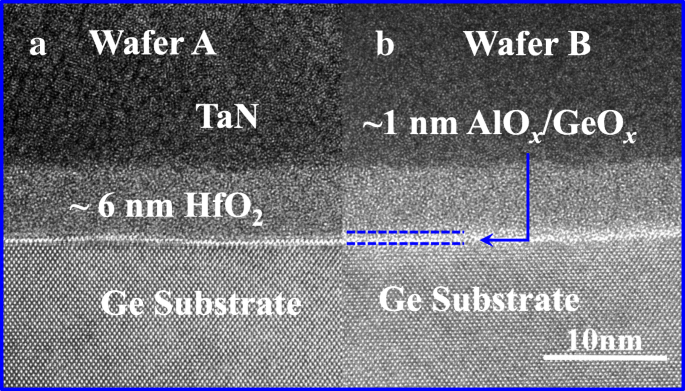
Imagens TEM em corte transversal da pilha de portas high-k / metal com um AlO x / GeO x camada interfacial (IL) fabricada por a OPO e b PPO em um canal n-Ge (001)
Resultados e discussão
As características de saída e transferência, juntamente com a tensão de capacitância (CV) porta-a-fonte de alta frequência, foram medidas por Keithley 4200-SCS. A Figura 3 mostra a comparação da característica de transferência e saída de Ge pMOSFETs com três diferentes condições de formação do AlO x / GeO x camada de passivação. Todos os dispositivos em vários wafers têm um comprimento de porta ( L G ) de 3 μm. Dispositivos no wafer A apresentam uma maior corrente de drenagem saturada ( I DS ) em comparação com as outras duas bolachas. Mas os wafers B e C com OPO mostram uma corrente de estado OFF muito mais baixa ( I DESLIGADO ) em comparação com o wafer A com PPO. Também é visto que os wafers B e C com OPO funcionaram no modo de realce e o wafer A funcionou no modo de depleção. Infere-se que, após o tratamento com PPO, a superfície n-Ge ainda permanece do tipo p devido ao alto D it valor que foi discutido em [11]. Wafer C com Al 2 mais espesso O 3 camada de bloco mostra um V positivo TH deslocamento em comparação com o wafer B e um D superior it do que a bolacha B. Observa-se a partir das características de saída mostradas na Fig. 3b que, sob uma tensão de porta baixa ( V GS ), o wafer A tem um I inferior DS sobre as bolachas B e C devido à oscilação menos acentuada do sublimiar (SS). Quando o V GS aumenta, eu DS do wafer A está ficando mais alto em comparação com os outros dois dispositivos. Portanto, a partir da Fig. 3 e das imagens TEM na Fig. 2, a difusão do AlO x / GeO x camada pode suprimir o I DESLIGADO , resultando assim em uma melhora dos efeitos de passivação.
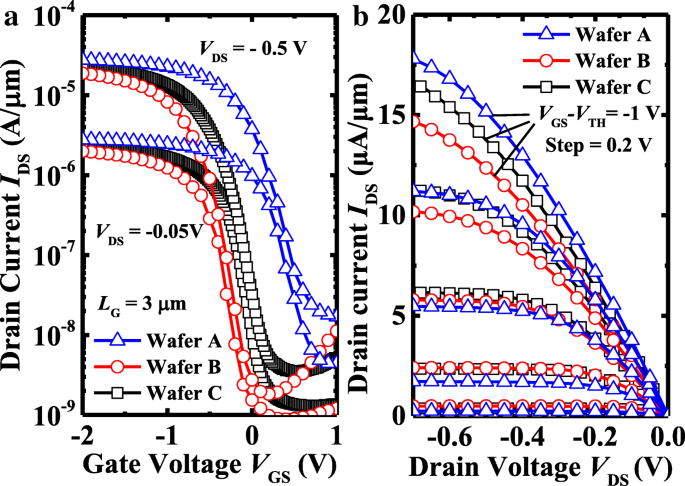
a eu DS –V GS e b eu DS –V DS características de Ge pMOSFETs com Al 2 O 3 / GeO 2 camada de passivação fabricada por PPO (wafer A) e OPO (wafers B e C)
A Figura 4 resume os resultados estatísticos do I LIGADO / eu DESLIGADO proporção e oscilação subliminar dos dispositivos em diferentes wafers. Ge pMOSFETs com OPO exibem um maior I LIGADO / eu DESLIGADO razão (~ 4 ordens de magnitude) e SS notavelmente melhorado em comparação com o dispositivo PPO, indicando uma qualidade superior da interface dielétrica / canal. Quando comparado com o wafer B, o wafer C exibe uma corrente mais alta no estado ON ( I LIGADO ), mas um I inferior LIGADO / eu DESLIGADO Razão.
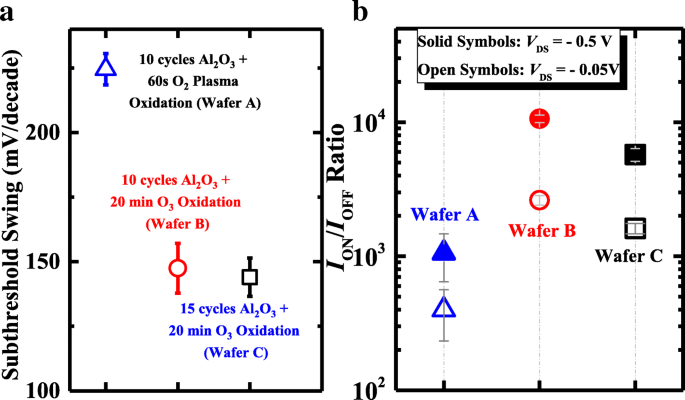
Gráficos estatísticos de a SS e b eu LIGADO / I DESLIGADO razão para Ge pMOSFETs com diferentes condições de passivação
Para representar ainda mais a qualidade da camada interfacial de diferentes métodos de pós-oxidação, bolachas A, B e C (amostras simuladas sem HfO 2 e metais Gate) foram testados por espectroscopia de fotoelétrons de raios-X (XPS). A medição de XPS foi realizada em três amostras simuladas pós-oxidação após tratamento com PPO ou OPO sem HfO 2 deposição e pulverização catódica TaN. A estequiometria de GeO x em Al 2 O 3 As amostras / GeO / Ge foram investigadas com uma fonte de raios-X monocromática suave Al Kα (1486,6 eV). Ge 3 d picos e análises de diferenciação de pico são mostrados na Fig. 5. O Ge 3 d 5/2 pico das três amostras é unificado em 29,7 eV, e as mudanças químicas de Ge 3 d 3/2 , Ge 1+ , Ge 2+ , Ge 3+ e Ge 4+ para Ge 3 d 5/2 são definidos como 0,6, 0,8, 1,8, 2,75 e 3,4 eV, respectivamente [12]. Na Fig. 5b, o wafer A mostra que após um PPO de 60s, a valência Ge principal em GeO x são Ge 1+ e Ge 3+ . Uma distribuição de estado de valância Ge semelhante é observada no wafer C, e um Ge 3+ componente é ligeiramente aumentado. Na Fig. 5b, o wafer B mostra que um dispositivo OPO com mais fino (10 ciclos) Al 2 O 3 irá oxidar ainda mais Ge 1+ em Ge 2+ , Ge 3+ e Ge 4+ , enquanto Ge 1+ é significativamente reduzido.
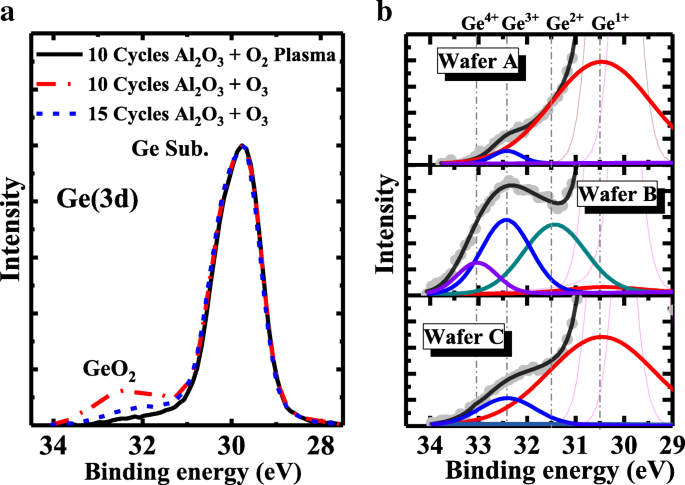
a Ge 3 d Espectros XPS de Al 2 O 3 / GeO x / Ge formado por diferentes condições. b Ajustes de pico do Ge 3 d Espectros XPS do GeO 2 camada para as três amostras
As características de CV de porta para fonte são mostradas na Fig. 6. A partir da curva de CV de 1 MHz, o D it próximo ao midgap é estimado por Terman's método [13], e um valor de espessura de óxido equivalente (EOT) também é avaliado como listado na Tabela 1. OPO de vinte minutos (bolachas B e C) resulta em uma maior EOT em comparação com PPO (bolacha A). O wafer C exibe um EOT maior do que o wafer B, devido ao Al mais espesso 2 O 3 como uma camada de bloqueio. Foi relatado que a espessura do GeO x em uma superfície Ge nua em O 3 o ambiente atinge a saturação em poucos minutos e a espessura da saturação é dominada pela temperatura ao invés do tempo de oxidação [10]. Portanto, neste artigo, a espessura do GeO x por ozônio a pós-oxidação é saturada após alguns minutos e o tempo de oxidação à esquerda é apenas para recozimento.
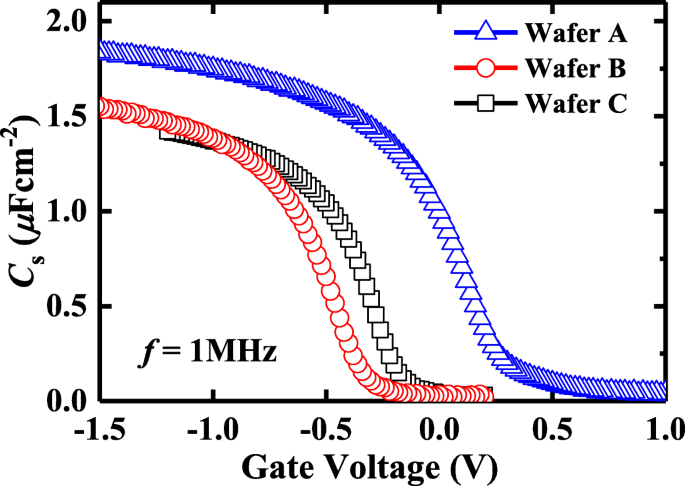
Capacitância porta-fonte versus V GS características de Ge pMOSFETs passivados por PPO (wafers A) e OPO (wafers B e C)
A Figura 7 resume a resistência total ( R T ) versus L G de cada dispositivo neste trabalho. Aqui, R T é definido como V DS / eu DS em V DS =0,05 V e V GS - V TH =1 V. A resistência da série fonte / dreno (S / D) ( R SD ) e resistência do canal ( R CH ) pode ser extraído da interceptação e inclinação do ajuste linear de R T - L G linhas como mostrado na Fig. 7. O R extraído SD e R CH os resultados estão resumidos na Tabela 1. A Figura 7 mostra que os Ge pMOSFETs com PPO exibem um menor R SD e R CH o que é consistente com os resultados de capacitância mostrados na Fig. 6.
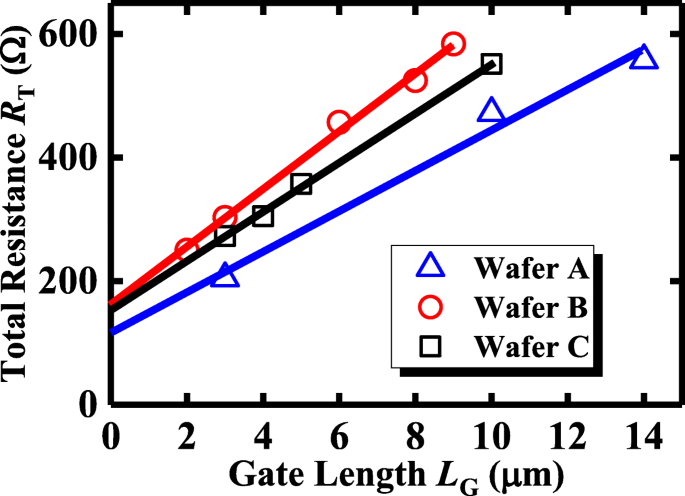
Resistência total ( R T ) versus comprimento do portão ( L G ) de Ge pMOSFETs
Mobilidade efetiva do orifício μ eff foi extraído com base em uma abordagem baseada em inclinação de resistência total. Na Fig. 8, comparamos o μ eff de nossos pMOSFETs Ge com tratamento PPO e OPO com os de outros pMOSFETs Ge relatados [9, 14]. Q inv é a densidade de carga de inversão no canal do dispositivo. Ge pMOSFETs com OPO exibem um pico mais alto μ eff em comparação com os dispositivos com PPO. Wafer C com Al 2 mais espesso O 3 camada de bloco tem uma maior mobilidade de orifício de pico de 283 cm 2 / V s em comparação com wafer B com o mais fino Al 2 O 3 . Wafer A com PPO exibe um buraco de alto campo inferior μ eff com os dispositivos com OPO, o que é atribuído ao menor espalhamento de rugosidade. Mas, em campo baixo, os transistores no wafer A com PPO alcançam um μ inferior eff do que os dispositivos OPO devido ao maior espalhamento coulomb [15]. Apenas alguns trabalhos sobre Ge pMOSFETs fabricados por passivação de ozônio foram relatados. Aqui, uma comparação do desempenho do dispositivo-chave entre nossos dispositivos e os pMOSFETs Ge relatados tratados com OPO [9, 14] são realizados, e os resultados são mostrados na Tabela 2. Conclui-se que o wafer C neste trabalho atinge o alto -field μ eff aprimoramento e superior I LIGADO / eu DESLIGADO em comparação com o dispositivo relatado tratado com OPO. Além disso, em um Q inv de 5 × 10 12 cm - 2 , o wafer C demonstra um 2,37 × maior μ eff em comparação com a mobilidade universal Si. O eu LIGADO da bolacha C é ligeiramente menor do que na Ref. [9] que se deve ao maior EOT.
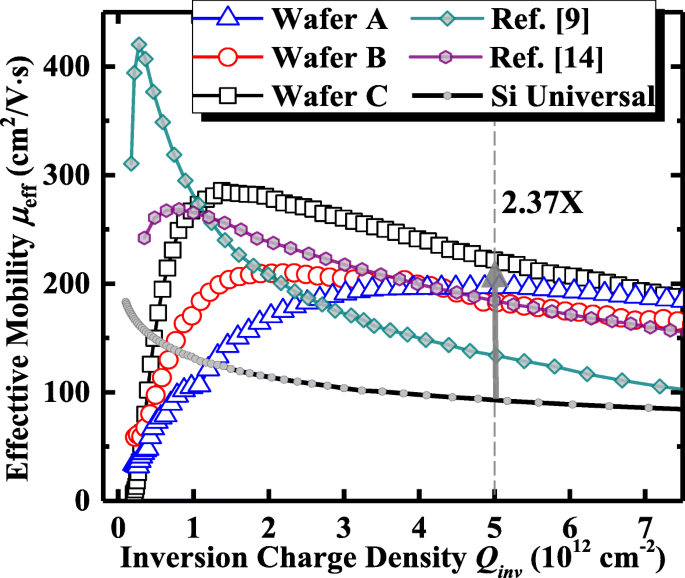
μ eff versus Q inv de Ge pMOSFETs com diferentes condições de passivação. Transistores Ge com 15 ciclos Al 2 O 3 + 20 min O 3 oxidação (wafer C) exibe um pico μ eff de 283 cm 2 / Vs. O impacto da resistência S / D em μ eff a extração foi removida pelo método de extração de mobilidade de canal eficaz baseado em declive de resistência total [16]
Conclusões
Ge pMOSFETs são realizados com GeO x passivação, que é formada por tratamento OPO ou PPO de Al 2 O 3 / n-Ge em PEALD. Os dispositivos OPO exibem as melhores características de transferência e saída, quanto maior I LIGADO / eu DESLIGADO proporção, a oscilação de sublimiar melhorada e o pico mais alto μ eff em comparação com os dispositivos PPO. Para o processo ODO de 15 ciclos, um Al 2 mais espesso O 3 camada leva a um valor EOT mais alto e um μ melhorado eff em dispositivos em comparação com a caixa de 10 ciclos. Todos os resultados neste trabalho indicam que o OPO é uma forma de passivação eficaz para alcançar uma interface Ge / dielétrica de alta qualidade e, portanto, pode ser uma técnica de passivação candidata promissora para a fabricação de Ge MOSFET no futuro.
Abreviações
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposição de camada atômica
- BF 2 + :
-
Íon fluoreto de boro
- EOT:
-
Espessura de óxido equivalente
- Ge:
-
Germânio
- GeO x :
-
Óxido de germânio
- HF:
-
Acido hidrosulfurico
- HfO 2 :
-
Dióxido de háfnio
- TEM:
-
Microscopia eletrônica de transmissão
- MOSFETs:
-
Transistores de efeito de campo semicondutores de óxido metálico
- OPO:
-
Ozônio pós-oxidação
- PPO:
-
Pós-oxidação do plasma
- Q inv :
-
Densidade de carga de inversão
- SS:
-
Balanço de sublimiar
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- μ eff :
-
Mobilidade efetiva do buraco
Nanomateriais
- Construindo robôs com Raspberry Pi e Python
- Liderando com Persistência e Perseverança
- Sensor Portenta e Termopar (com MAX6675)
- Classe e objeto C++ com exemplo
- Nanomaterial inteligente e nanocompósito com atividades agroquímicas avançadas
- Ajuste da química da superfície de polieteretercetona por revestimento de ouro e tratamento com plasma
- Resistência de contato reduzida entre metal e n-Ge por inserção de ZnO com tratamento de plasma de argônio
- Ge pMOSFETs de alta mobilidade com passivação de Si amorfo:impacto da orientação da superfície
- O que é o corte a plasma e como funciona o corte a plasma?
- Node-RED e introdução ao Docker



