Transistores de efeito de campo de capacitância negativa de germânio:Impactos da composição de Zr em Hf1 − xZrxO2
Resumo
Transistores de efeito de campo de capacitância negativa de germânio (Ge) (NCFETs) com várias composições de Zr em Hf 1− x Zr x O 2 ( x =0,33, 0,48 e 0,67) são fabricados e caracterizados. Para cada composição de Zr, o NCFET exibe a queda repentina em alguns pontos de oscilação subliminar (SS), que é induzida pelo efeito NC. Conduza a corrente I DS aumenta com o aumento da temperatura de recozimento, que deve ser devido à redução da resistência da fonte / dreno e à melhora da mobilidade do portador. Os pontos SS íngremes são repetíveis e estáveis por meio de múltiplas medições de varredura DC, provando que são induzidos pelo efeito NC. Os valores da tensão da porta V GS correspondentes a SS íngremes são consistentes e no sentido horário I DS - V GS são mantidos por meio de múltiplas varreduras DC. Na temperatura de recozimento fixa, dispositivo NC com Hf 0,52 Zr 0,48 O 2 atinge o I superior DS mas histerese maior em comparação com as outras composições. NCFET com Hf 0,67 Zr 0,33 O 2 pode obter o excelente desempenho com curvas livres de histerese e alto I DS .
Histórico
O transistor de efeito de campo de capacitância negativa ferroelétrica (NCFET) com um filme ferroelétrico inserido na pilha de portas é um candidato promissor para as aplicações de dissipação de baixa potência devido à sua capacidade de superar a limitação fundamental em oscilação de sublimiar (SS) para o metal convencional. transistor de efeito de campo semicondutor de óxido (MOSFET) [1]. Os fenômenos de capacitância negativa (NC) em NCFETs foram extensivamente estudados em materiais de diferentes canais, incluindo silício (Si) [2, 3], germânio (Ge) [4], germânio-estanho (GeSn) [5], III-V [6] e materiais 2D [7]. Além disso, as características NC foram demonstradas em NCFETs com vários ferroelétricos, como BiFeO 3 [8], PbZrTiO 3 (PZT) [9], PVDF [10] e Hf 1− x Zr x O 2 [11]. Comparado a outros ferroelétricos, Hf 1− x Zr x O 2 tem a vantagem de ser compatível com a integração CMOS. Estudos experimentais têm mostrado que o desempenho elétrico de NCFETs pode ser otimizado variando a espessura e área de Hf 1− x Zr x O 2 , que afeta o casamento entre a capacitância MOS ( C MOS ) e capacitância ferroelétrica ( C FE ) [12, 13]. Espera-se que a composição Zr em Hf 1− x Zr x O 2 também tem um grande impacto no desempenho de NCFETs, porque determina as propriedades ferroelétricas de Hf 1− x Zr x O 2 . No entanto, ainda falta um estudo detalhado sobre os impactos da composição do Zr nas características elétricas dos NCFETs.
Neste artigo, estudamos de forma abrangente as influências da temperatura de recozimento e da composição de Zr no desempenho do Ge NCFET.
Métodos
Principais etapas do processo para a fabricação de NCFETs de canal Ge p com as diferentes composições de Zr em Hf 1− x Zr x O 2 são mostrados na Fig. 1 (a). Após a limpeza pré-impregnada, substratos de n-Ge (001) foram carregados na câmara de deposição de camada de átomo (ALD). Um fino Al 2 O 3 (25 ciclos) filme foi depositado, o que foi seguido pelo O 3 passivação. Então, o Hf 1- x Zr x O 2 filmes (x =0,33, 0,48 e 0,67) foram depositados na mesma câmara ALD usando [(CH 3 ) 2 N] 4 Hf (TDMAHf), [(CH 3 ) 2 N] 4 Zr (TDMAZr) e H 2 O como os precursores Hf, Zr e O, respectivamente. Depois disso, a porta de metal TaN foi depositada usando a pulverização catódica reativa. Após a padronização e gravação do portão, íons de boro (B + ) foram implantados em regiões de fonte / dreno (S / D) a uma energia de 20 keV e uma dose de 1 × 10 15 cm −2 . Metais S / D não autoalinhados foram formados pelo processo de decolagem. Finalmente, o recozimento térmico rápido (RTA) foi realizado em várias temperaturas para ativação de dopante, metalização S / D e cristalização de Hf 1− x Zr x O 2 filme. Ge controle pMOSFETs com o Al 2 O 3 / HfO 2 pilha também foi fabricada.

( a ) Principais etapas do processo para a fabricação de Ge NCFETs com as diferentes composições de Zr em Hf 1 −x Zr x O 2 ferroelétricos. ( b ) Esquemático do transistor NC fabricado. ( c ) Imagem TEM da pilha de portas do dispositivo NC ilustrando o H de 7 nm 0,52 Zr 0,48 O 2 camada e 2 nm Al 2 O 3 camada
A Figura 1 (b) mostra o esquema do NCFET fabricado. A imagem do microscópio eletrônico de transmissão de alta resolução (HRTEM) na Fig. 1 (c) mostra a pilha de portas no canal Ge do dispositivo com Hf 0,52 Zr 0,48 O 2 ferroelétrico. As espessuras de Al 2 O 3 e Hf 0,52 Zr 0,48 O 2 as camadas são 2 nm e 7 nm, respectivamente.
Para confirmar as estequiometrias de Hf 1− x Zr x O 2 , foi realizada a medição de espectroscopia de fotoelétrons de raios-X (XPS). As Figuras 2 (a) e (b) mostram o Hf 4f e Zr 3d espectros de nível de núcleo de fotoelétrons, respectivamente, para o Hf 0,67 Zr 0,33 O 2 , Hf 0,52 Zr 0,48 O 2 e Hf 0,33 Zr 0,67 O 2 filmes. As composições do material foram calculadas com base na razão da área dos picos e os fatores de sensibilidade correspondentes. Os dois picos de Zr 3d 5/2 e Zr 3d 3/2 tem uma divisão spin-orbital de 2,4 eV, que é composta por Refs. [14, 15]. Com o incremento da composição de Zr em Hf 1− x Zr x O 2 , Zr 3d e Hf 4f os picos mudam para a direção de menor energia.

( a ) Hf 4f e ( b ) Zr 3d espectros de nível de núcleo para o Hf 1− x Zr x O 2 amostras com as diferentes composições de Zr
As propriedades ferroelétricas do Hf 1− x Zr x O 2 filmes ( x =0,33, 0,48 e 0,66) foram caracterizados pela polarização P vs. tensão da unidade V medição de loops de histerese. P - V loops foram gravados nos dispositivos pristine. A Figura 3 mostra as curvas de P vs. V para TaN / Hf 1− x Zr x O 2 (10 nm) / amostras TaN em uma série de tensões de acionamento. Com o aumento da temperatura pós-recozimento de 500 para 550 ° C, o P - V curvas do Hf 1− x Zr x O 2 tendem a ficar saturados em um estado de sub-loop. À medida que a composição de Zr aumenta, a polarização remanescente do filme é obviamente melhorada e o afinamento do ciclo de histerese em polarização zero é observado, o que pode ser fenomenologicamente melhor descrito como características semelhantes a antiferroelétricas sobrepostas [16, 17].
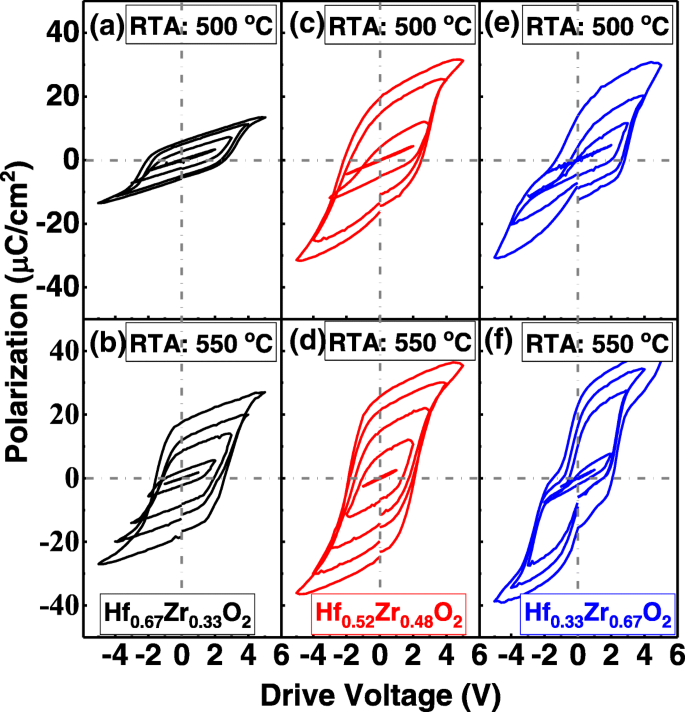
Curvas medidas P-V do Hf 1-x Filmes de ZrxO2 com diferentes composições de Zr recozidos em 500 e 550 o C. ( a ) e ( b ) são os Hf 0,67 Zr 0,33 O 2 filme recozido em 500 e 550 o C, respectivamente. ( c ) e ( d ) são os Hf 0,52 Zr 0,48 O 2 filme recozido em 500 e 550 o C, respectivamente. ( e ) e ( f ) são os Hf 0,33 Zr 0,67 O 2 filme recozido em 500 e 550 o C, respectivamente. Com o pós recozimento, a temperatura aumenta de 500 para 550 o C, as curvas P-V do Hf 1-x Zr x O 2 tendem a ficar saturados em um estado de sub-loop. Uma evolução do comportamento ferroelétrico para um comportamento antiferroelétrico é observada com o aumento da composição de Zr.
Resultados e discussão
A Figura 4 (a) mostra as características de transferência medidas de Ge NCFETs com Hf 0,52 Zr 0,48 O 2 ferroelétricos com diferentes temperaturas de recozimento e dispositivo de controle com Al 2 O 3 / HfO 2 empilhar dielétrico. O dispositivo de controle foi recozido a 500 ° C. Todos os dispositivos têm um comprimento de portão L G de 2 μm. A varredura para a frente e para trás são indicadas pelos símbolos aberto e sólido, respectivamente. Os NCFETs têm uma corrente de acionamento muito mais alta em comparação com o dispositivo de controle. É visto que, com a temperatura de recozimento aumentando de 450 para 550 ° C, a tensão limite V TH dos dispositivos NC mudam para o V positivo GS direção. Os NCFETs apresentam uma pequena histerese, que se torna desprezível com o aumento da temperatura do RTA. O efeito de trapping também leva à histerese, mas isso produz o I no sentido anti-horário DS - V GS loop, oposto aos resultados induzidos por chaveamento ferroelétrico [18]. Ponto SS vs. I DS curvas na Fig. 4 (b) mostram que o transistor NC exibe a queda repentina em alguns pontos de SS, correspondendo à mudança abrupta de I DS induzido pelo efeito NC [19]. Observa-se que os NCFETs alcançam as características de SS melhoradas em relação ao dispositivo de controle. Descobrimos que os pontos de queda repentina dos dispositivos são consistentes nas diferentes temperaturas de recozimento. O medido eu DS - V DS curvas dos NCFETs com Hf 0,52 Zr 0,48 O 2 recozidos ferroelétricos em diferentes temperaturas são mostrados na Fig. 4 (c). eu DS - V DS curvas do transistor NC mostram o fenômeno NDR óbvio, que é uma característica típica dos transistores NC [20,21,22,23]. A Figura 4 (d) são os gráficos do I DS dos Ge NCFETs com o Hf 0,52 Zr 0,48 O 2 camada ferroelétrica recozida a 450, 500 e 550 ° C, respectivamente, a V DS =- 0,05 V e - 0,5 V, e | V GS - V TH | =1,0 V. Aqui, o V TH é definido como o V GS em eu DS de 10 −7 A / μm. eu DS aumenta com o aumento da temperatura do RTA, que é devido à redução da resistência da fonte / dreno e melhora da mobilidade do portador na temperatura de recozimento mais alta.
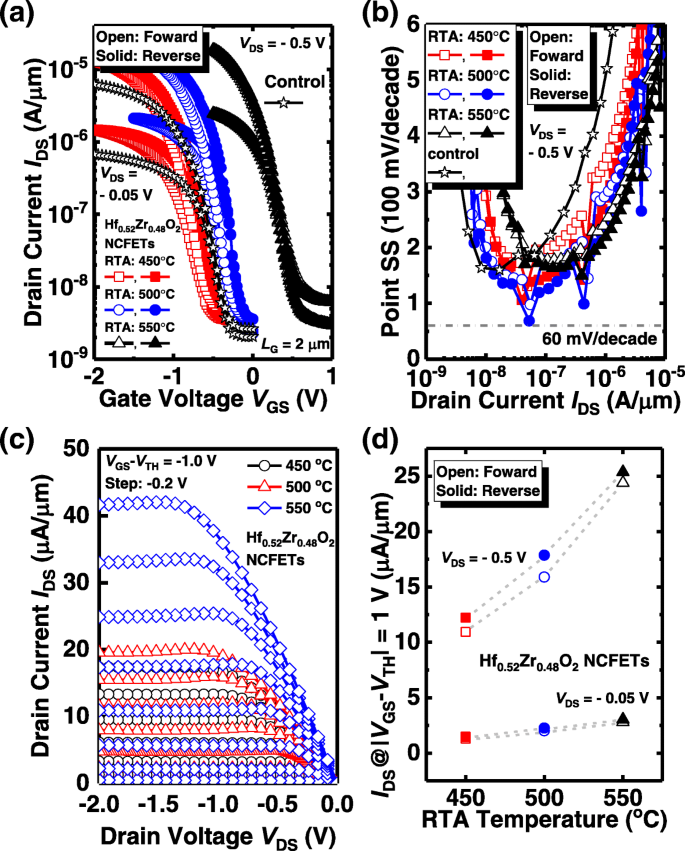
( a ) Medido I DS - V GS curvas para NCFETs com Hf 0,52 Zr 0,48 O 2 dispositivo ferroelétrico e de controle. ( b ) Ponto SS vs. I DS curvas mostrando que os NCFETs têm SS mais íngreme em comparação com o MOSFET de controle. ( c ) Eu DS - V DS curvas para os NCFETs demonstrando os fenômenos NDR típicos. ( d ) Comparação do I DS para os NCFETs recozidos em várias temperaturas em uma ultrapassagem de porta de 1 V
Além do Hf 0,52 Zr 0,48 O 2 transistor ferroelétrico, também investigamos as características elétricas dos transistores Ge NC com o Hf 0,33 Zr 0,67 O 2 ferroelétrico. A Figura 5 (a) apresenta o I DS - V GS características dos dispositivos com Hf 0,33 Zr 0,67 O 2 com as diferentes temperaturas de recozimento em V DS =- 0,05 V e - 0,5 V. Comparado com o Hf 0,52 Zr 0,48 O 2 Transistores NC, histerese ainda menor é obtida. Semelhante ao Hf 0,52 Zr 0,48 O 2 Transistores NC, conforme a temperatura de recozimento aumenta de 450 para 550 ° C, V TH do aumento do dispositivo de - 0,63 V para 0,51 V na varredura para frente em V DS =- 0,05 V. Ponto SS em função de I DS características para o Hf 0,33 Zr 0,67 O 2 NCFETs ferroelétricos são representados na Fig. 5 (b). Além disso, dispositivos com temperatura de recozimento de 450 ° C e 500 ° C obtêm a queda repentina mais óbvia em SS em comparação com o transistor recozido de 550 ° C. Os pontos de queda repentinos em diferentes temperaturas de recozimento ocorrem na mesma tensão de porta. A Figura 5 (c) exibe para frente e para trás I DS do Hf 0,33 Zr 0,67 O 2 NCFETs em V DS =- 0,05 V e - 0,5 V, e | V GS - V TH | =1,0 V. Seja para a varredura para frente ou para trás, o I DS aumenta com a temperatura de recozimento, que é consistente com a característica do Hf 0,52 Zr 0,48 O 2 dispositivo.
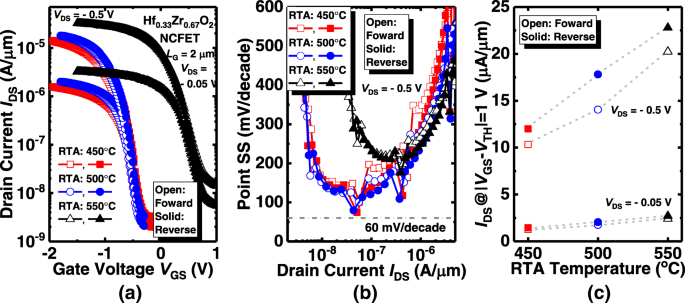
( a ) Características de transferência medidas do Hf 0,33 Zr 0,67 O 2 NC Ge pFETs recozidos de 450 a 550 ° C. ( b ) Ponto SS em função de I DS para o Hf 0,33 Zr 0,67 O 2 dispositivos. ( c ) Eu DS para os transistores NC ferroelétricos com diferentes temperaturas de recozimento em uma ultrapassagem de porta de 1 V
Também investigamos o desempenho elétrico do Ge NCFET com a menor composição de Zr. As características de transferência do Hf 0,67 Zr 0,33 O 2 NCFETs recozidos em diferentes temperaturas de recozimento são apresentados na Fig. 6 (a). Nenhum fenômeno de histerese é observado. Comparado com Hf 0,33 Zr 0,67 O 2 e Hf 0,52 Zr 0,48 O 2 dispositivos, o V TH o deslocamento induzido pela variação da temperatura de recozimento é menos pronunciado em Hf 0,67 Zr 0,33 O 2 NCFETs. Ponto SS vs. I DS curvas na Fig. 6 (b) mostram que o Hf 0,67 Zr 0,33 O 2 Transistor NC exibe queda repentina em alguns pontos do transistor SS de NC em V DS =- 0,05 V. A Figura 6 (c) apresenta o I DS de Hf 0,67 Zr 0,33 O 2 Ge NCFETs recozidos a 450 ° C, 500 ° C e 550 ° C, a V DS =- 0,05 V e - 0,5 V, e | V GS - V TH | =1,0 V. Da mesma forma, eu DS aumenta à medida que a temperatura do RTA aumenta.
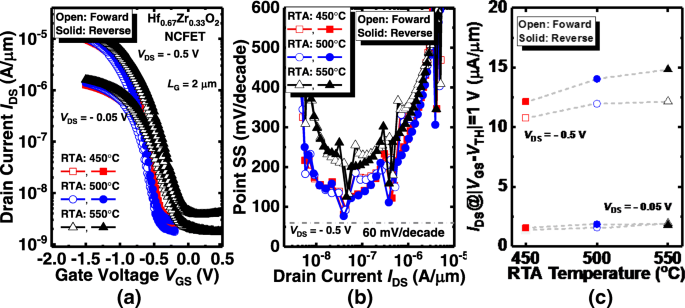
( a ) Medido I DS - V GS do Hf 0,67 Zr 0,33 O 2 NC Ge pFETs recozidos a 450 ° C, 500 ° C e 550 ° C. ( b ) Ponto SS vs. I DS características dos dispositivos. ( c ) Eu DS para os transistores NC ferroelétricos com diferentes temperaturas de recozimento em uma ultrapassagem de porta de 1 V
A estabilidade do efeito NC induzido pela camada ferroelétrica do Hf 0,52 Zr 0,48 O 2 O NCFET foi verificado por múltiplas medições de varredura DC. O medido eu DS - V GS curvas ao longo de 100 ciclos de varredura DC são mostradas na Fig. 7 (a). Pode-se ver que os valores de V GS correspondentes a SS íngremes são consistentes. Além disso, o sentido horário I-V os loops são mantidos por meio de múltiplas varreduras DC. Os pontos SS íngremes são repetíveis e estáveis por meio de múltiplas varreduras DC, o que prova ainda que eles são induzidos pelo efeito NC. A Figura 7 (b) apresenta o melhor ponto SS e a corrente de comando ao longo do número de ciclos de varredura. A Figura 7 (c) mostra as características de histerese em função do número de ciclos de varredura CC. Estável I-V janela de histerese de ~ 82 mV são vistas.
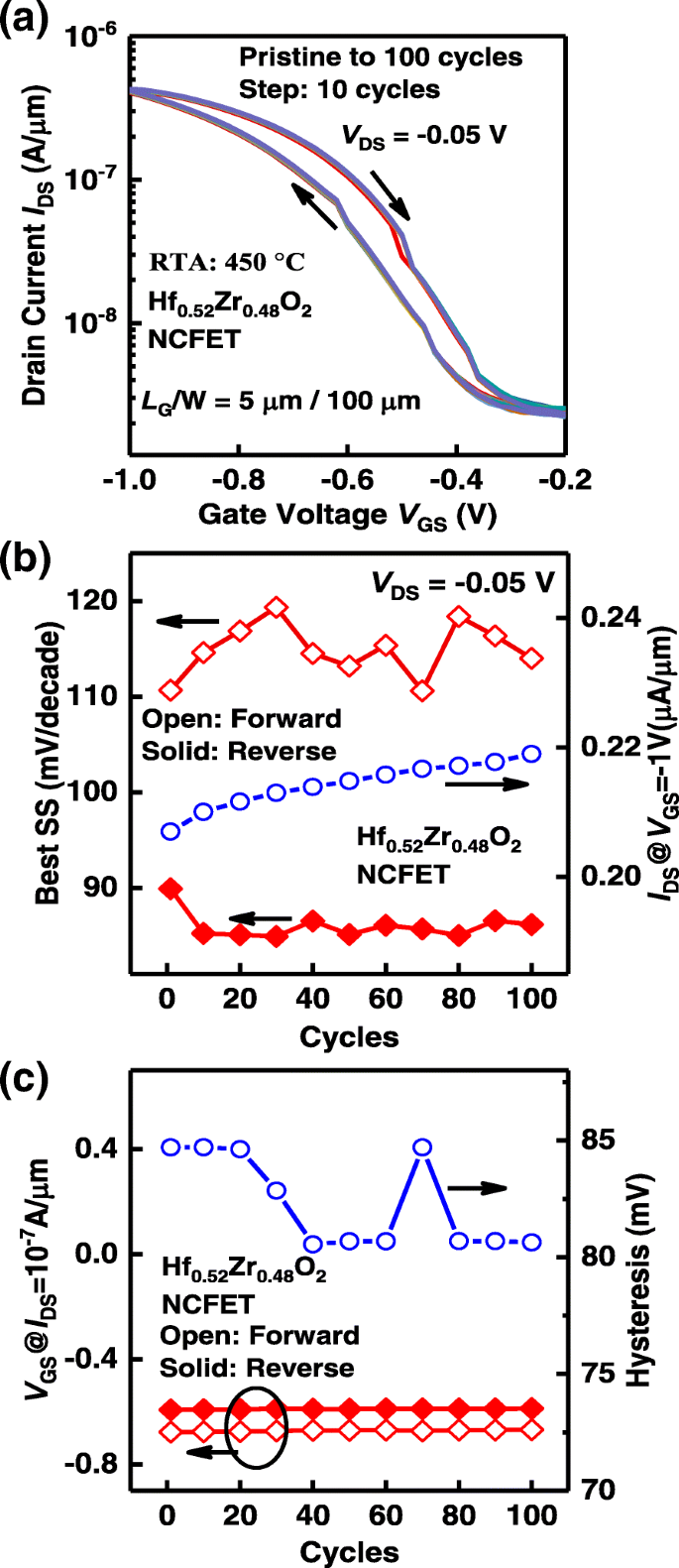
( a ) Medido I DS - V GS curvas de um Hf 0,52 Zr 0,48 O 2 NC Ge pFET em 100 ciclos de varredura DC. ( b ) Melhor ponto SS e I DS vs. número do ciclo. ( c ) Características de histerese em função do número de ciclos de varredura DC
Resumimos a histerese e as características de corrente do drive de Ge NCFETs com diferentes composições de Zr em Hf 1− x Zr x O 2 na Fig. 8. Conforme mostrado na Fig. 8 (a), os valores de histerese são 70, 148 e 106 mV para dispositivos com x =0,33, 0,48 e 0,67, respectivamente, em um V DS de - 0,5 V. Conforme a composição aumenta de 0,33 para 0,48, a histerese do dispositivo NC aumenta significativamente. Com o aumento adicional da composição de Zr, a histerese diminui rapidamente. O eu DS de NCFETs recozidos a 450 ° C é representado graficamente na Fig. 8 (b), em V DS =- 0 . 5 V e V GS - V TH =- 1 . 0 V. Aberto e sólido representam a varredura para frente e para trás, respectivamente. O dispositivo NC com Hf 0,52 Zr 0,48 O 2 atinge o mais alto I DS , mas sua histerese é séria. NCFET com Hf 0,67 Zr 0,33 O 2 pode obter excelente desempenho com curvas livres de histerese e alto I DS . À medida que a composição de Zr aumenta, a capacitância ferroelétrica C fe (=0,3849 * P r / ( E c * t fe ) [24]) aumenta com o aumento de P r e, entretanto, a capacitância MOS ( C MOS ) também aumenta devido à crescente permissividade do filme HZO. O eu DS e a histerese é determinada por | C fe | e C MOS do transistor. Com a composição de Zr aumentando de 0,33 para 0,48, o aumento de | C fe | é especulado para ser mais lento do que o C MOS , levando ao alargamento da histerese. No entanto, o maior C MOS produz um I superior DS . Com o aumento da composição de Zr, o aumento de | C fe | é mais rápido que C MOS , que pode fornecer | C fe | ≥ C MOS , reduzindo a histerese de NCFET.
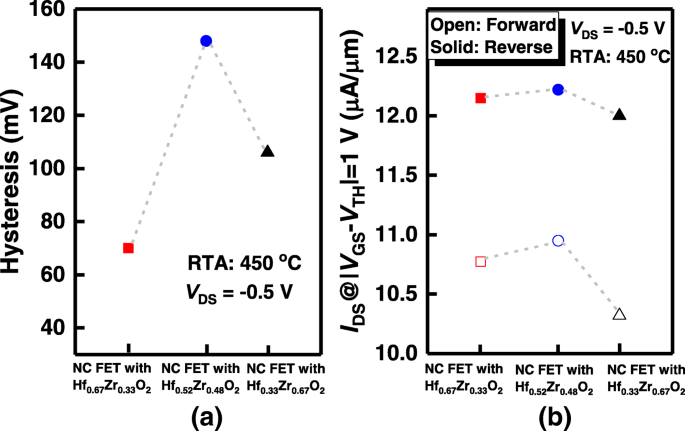
Gráficos estatísticos de ( a ) histerese e ( b ) Eu DS de Ge NCFET com Hf 1− x Zr x O 2 ( x =0,33, 0,48 e 0,67)
Conclusões
Os impactos da temperatura de recozimento e da composição de Zr em Hf 1 −x Zr x O 2 sobre o desempenho elétrico do Ge NCFETs são estudados experimentalmente. As estequiometrias e propriedades ferroelétricas de Hf 1− x Zr x O 2 foram confirmados por XPS e P-V medições, respectivamente. NCFETs demonstram o ponto íngreme SS e melhorou I DS em comparação com o dispositivo de controle, devido ao efeito NC. O V TH e eu DS do Hf 1 −x Zr x O 2 Os NCFET são muito afetados pela temperatura de recozimento. Múltiplas medições de varredura DC mostram que a estabilidade do efeito NC induzido pela camada ferroelétrica é alcançada no NCFET. Hf 0,67 Zr 0,33 O 2 O NCFET pode atingir mais facilmente as características livres de histerese do que os dispositivos com maior composição de Zr.
Abreviações
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposição de camada atômica
- BF 2 + :
-
Íon fluoreto de boro
- DC:
-
Corrente direta
- Ge:
-
Germânio
- GeO x :
-
Óxido de germânio
- HF:
-
Acido hidrosulfurico
- HfO 2 :
-
Dióxido de háfnio
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- MOSFETs:
-
Transistores de efeito de campo semicondutores de óxido metálico
- NC:
-
Capacitância negativa
- Ni:
-
Níquel
- SS:
-
Balanço de sublimiar
- TaN:
-
Nitreto de tântalo
- TDMAHf:
-
Tetraquis (dimetilamido) háfnio
- TDMAZr:
-
Tetraquis (dimetilamido) zircônio
Nanomateriais
- Campos elétricos e capacitância
- Fatores que afetam a capacitância
- Dispositivos de efeito Hall digital (ON / OFF):interruptores e travas
- Detecção de posição de efeito Hall:Linearidade e inclinação de resposta para configurações deslizantes
- Espaçadores de ar para chips de 10 nm
- Um salto nanométrico para trilhões de transistores
- Efeito da irradiação ultravioleta nas características dos diodos 4H-SiC PiN
- Efeito do tratamento de recozimento in situ na mobilidade e morfologia de transistores de efeito de campo orgânico baseados em TIPS-Pentaceno
- Efeito do polietileno glicol no fotocátodo de NiO
- Investigação teórica de nanofios de germânio deformados biaxialmente por tração



