Alta tensão de ruptura e baixa resistência dinâmica ON AlGaN / GaN HEMT com implantação de íons de flúor na camada de passivação SiNx
Resumo
Neste estudo, propusemos e demonstramos experimentalmente uma alta tensão de ruptura (BV) e baixa resistência dinâmica ON ( R ON, D ) Transistor de alta mobilidade de elétrons AlGaN / GaN (HEMT) implantando íons de flúor no SiN x espesso camada de passivação entre os eletrodos de porta e dreno. Em vez da implantação de íons de flúor na fina camada de barreira AlGaN, a posição de pico e as distribuições de vacância estão longe do canal de gás de elétron bidimensional (2DEG) no caso de implantação de íons de flúor na camada de passivação espessa, que efetivamente suprime o degradação da característica estática e dinâmica pulsada da corrente (DC). Os íons de flúor na camada de passivação também estendem a região de depleção e aumentam a força do campo elétrico médio (campo E) entre a porta e o dreno, levando a um aumento do BV. O BV do HEMT proposto aumenta para 803 V de 680 V do HEMT AlGaN / GaN convencional (Conv. HEMT) com os mesmos parâmetros dimensionais. O R medido ON, D do HEMT proposto é apenas aumentado em 23% em uma polarização quiescente de alto dreno de 100 V, enquanto o R ON, D do HEMT com implantação de íon flúor na fina camada de barreira AlGaN é aumentada em 98%.
Histórico
Nas últimas décadas, novos materiais semicondutores, como GaN, óxidos de metal e materiais 2D, têm sido amplamente estudados para aumentar ainda mais a conversão de energia e a eficiência de armazenamento, devido às suas propriedades superiores de material e dispositivo [1,2,3,4, 5,6,7,8]. Entre eles, os transistores de alta mobilidade de elétrons (HEMTs) baseados em GaN AlGaN / GaN são bons candidatos para aplicações de alta potência, alta frequência e baixa perda devido ao alto campo de ruptura crítica e alta mobilidade de elétrons [9,10,11,12,13 , 14]. A tensão de ruptura (BV) é um dos alvos mais importantes do projeto, e os valores relatados ainda estão muito abaixo do limite teórico [15, 16]. Portanto, é de grande importância melhorar ainda mais a VB, especialmente não ao custo de aumentar o tamanho do dispositivo. Várias técnicas de terminação foram propostas para melhorar o BV, como placa de campo [17,18,19], implantação de íons de flúor [20,21,22] e terminação de gate-edge recesso [23, 24]. Os íons de flúor implantados na fina camada de barreira AlGaN (FBL) [22] têm um processo de fabricação simples sem induzir uma capacitância parasita adicional; no entanto, a posição do pico do perfil de flúor e as distribuições de vacância estão perto do canal de gás de elétron bidimensional (2DEG), o que inevitavelmente causaria degradação de característica estática e dinâmica significativa.
Neste trabalho, uma alta tensão de ruptura e baixa resistência dinâmica ON ( R ON, D ) AlGaN / GaN HEMT com implantação de íon flúor no SiN x camada de passivação (FPL HEMT) é investigada experimentalmente. Ao contrário do caso da implantação do íon flúor na fina camada de barreira AlGaN, a implantação do íon flúor na camada de passivação espessa poderia manter a posição de pico das distribuições de flúor e vacância longe do canal 2DEG, suprimindo assim efetivamente a degradação das características estáticas e dinâmicas . Os íons de flúor na camada de passivação como uma técnica de terminação também são usados para otimizar a distribuição do campo elétrico de superfície (campo E), alcançando assim um BV aprimorado. Em conclusão, o FPL HEMT demonstra excelentes características estáticas e características dinâmicas.
Métodos de fabricação
A Figura 1 é o esquema tridimensional de FPL HEMT, FBL HEMT e Conv. HEMT, respectivamente. Todos os dispositivos apresentam um comprimento de portão L G de 2,5 μm, uma distância porta-fonte L GS de 1,5 μm, e uma distância porta-dreno L GD de 10 μm. A heteroestrutura epitaxial AlGaN / GaN usada para fabricar o FPL HEMT foi cultivada em 6 pol (111) substrato de silício por deposição de metal orgânico químico em vapor (MOCVD). As camadas epitaxiais consistem em um cap GaN de 2 nm, Al 23 nm 0,25 Ga 0,75 Barreira N, camada intermediária de AlN de 1 nm, canal de GaN de 150 nm e tampão de GaN de 3,5 μm. A densidade e mobilidade medidas do efeito Hall do 2DEG foram 9,5 × 10 12 cm −2 e 1500 cm 2 / V s, respectivamente. O FPL HEMT proposto começou com isolamento de mesa que foi implementado por um Cl 2 de alta potência / BCl 3 corrosão por plasma indutivamente acoplado (ICP). Em seguida, uma deposição de vapor químico de baixa pressão de 40 nm de espessura (LPCVD) SiN x camada foi depositada a 780 ° C / 300 mTorr com um NH 3 fluxo de 280 sccm e um SiH 2 Cl 2 fluxo de 70 sccm, produzindo uma taxa de deposição de 3,7 nm / min. O índice de refração é medido por elipsômetro como 1,978, e a razão N / Si de SiN x é 1,31 [25]. A cristalinidade de LPCVD SiN x é amorfo, o que é confirmado por microscopia eletrônica de transmissão de alta resolução (HR-TEM) (veja a inserção da Fig. 1a). Depois de abrir a fonte e as janelas de contato de drenagem por SF 6 gravação a seco de plasma, o contato ôhmico Ti / Al / Ni / Au (20/150/45/55 nm) foi depositado e recozido a 890 ° C por 30 s em N 2 ambiente. A resistência de contato de 1 Ω mm e a resistência da folha de 400 Ω / quadrado foram extraídas pelo método da linha de transmissão linear. Em seguida, o eletrodo de portão metálico é formado por deposição de Ni / Au (50 nm / 150 nm) e processo de decolagem. Em seguida, a janela de implantação do íon flúor (Comprimento da janela =3 μm) é formada pelo fotorresiste AZ5214, e os íons flúor foram implantados pelo implantador de íons SEN NV-GSD-HE a uma energia de 10 keV a uma dose de 1 × 10 12 cm −2 . Finalmente, as amostras foram recozidas a 400 ° C por 15 min em N 2 ambiente para completar o fluxo de fabricação do transistor [26].
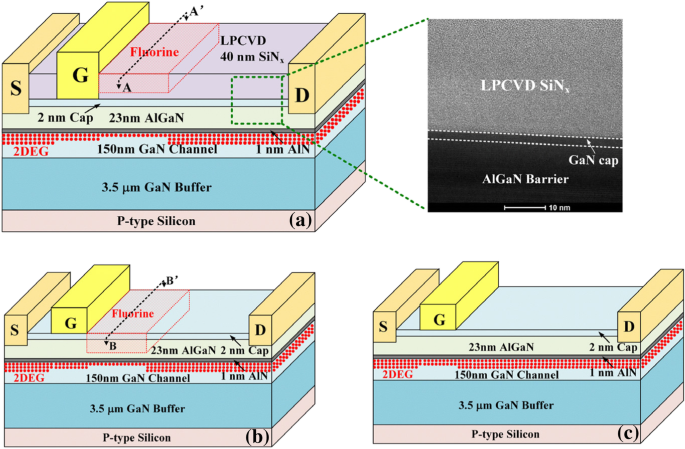
Esquema tridimensional de a FPL HEMT (inserção:micrografia HR-TEM de LPCVD SiN x ), b FBL HEMT e c Conv. HEMT
Resultados e discussão
A Figura 2 mostra o perfil medido de espectroscopia de massa de íons secundários (SIMS) de concentração de íons de flúor e concentração de vacância simulada por TRIM ao longo das linhas de corte:(a) A-A ′ de FPL HEMT e (b) B-B ′ de FBL HEMT, respectivamente. Com a mesma energia e dose de implantação do íon flúor, a posição de pico medida da superfície e a concentração máxima do perfil de flúor é quase a mesma para as duas estruturas. No caso da implantação do íon flúor na fina camada de barreira AlGaN, as vacâncias induzidas pelo flúor se estendem para a região do canal 2DEG. A distribuição da concentração de vacância é descontínua em cada interface porque a energia de ligação de cada material é diferente [27]. No entanto, no caso da implantação do íon flúor no SiN espesso x camada de passivação, a distribuição de vacância está localizada dentro do SiN x camada de passivação e longe do canal 2DEG. As vacâncias induzidas pela implantação de íons capturariam o canal 2DEG, e 2DEG poderia ser facilmente capturado se a distribuição de vacâncias estiver próxima ao 2DEG [28]. Em conclusão, a implantação de íons de flúor no SiN x espesso A camada de passivação pode reduzir significativamente a influência da implantação de íons no canal 2DEG e suprimir a degradação de característica estática e dinâmica de forma eficaz.

Perfil SIMS medido de concentração de íons de flúor e concentração de vacância simulada por TRIM ao longo das linhas de corte. a A-A ′. b B-B ′
A Figura 3 ilumina o I-V medido características de transferência e características de saída de corrente contínua (DC). Em comparação com o Conv. HEMT, tanto o FPL HEMT quanto o FBL HEMT mostram uma diminuição em I DS e um aumento na resistência estática ON ( R LIGADO ), porque os íons de flúor causam a depleção assistida do 2DEG na região de deriva e, assim, diminuem a densidade do 2DEG [29]. Além disso, a implantação de íons também diminui a mobilidade 2DEG. As mobilidades 2DEG medidas do efeito Hall dos HEMTs FPL e FBL são de 228 cm 2 / V se 203 cm 2 / V s após implantação de íons, respectivamente. Devido à mesma dose de íons de flúor, as características de saída e R LIGADO de FPL HEMT e FBL HEMT são quase os mesmos em uma baixa tensão de drenagem (por exemplo, V DS <3 V). No entanto, quando V DS > 3 V, o colapso da corrente de drenagem de saturação ocorre no FBL HEMT, porque o perfil de vacância do flúor se estende até a região do canal 2DEG, e o 2DEG poderia ser facilmente preso por essas vacâncias de nível profundo induzidas pelo flúor quando a tensão de drenagem é maior do que crítica tensão de drenagem (por exemplo, V DS > 3 V) [30], diminuindo assim a corrente de dreno. A distribuição de vacância de FPL HEMT está longe do canal 2DEG, suprimindo assim o colapso da corrente de drenagem de saturação efetivamente.

Medido a I-V características de transferência e b Características de saída DC para três HEMTs
A Figura 4 mostra o I-V medido características e distribuições de campo E de superfície simulada no estado de bloqueio. Os BVs do FPL / FBL / Conv. HEMTs são 803/746/680 V, respectivamente. O BV é definido como a tensão da fonte de drenagem na corrente de drenagem ( I DS ) de 1 μA / mm com V GS =- 4 V. Os íons de flúor entre a porta e o dreno como técnica de terminação reduzem o pico do campo E na borda da porta e causam um novo pico de campo E no final da região de implantação do íon e, portanto, FPL HEMT e FBL O HEMT alcança uma distribuição de campo E de superfície mais uniforme e maior BV do que o Conv. HEMT. Comparado com FPL HEMT, FBL HEMT tem um efeito de modulação de campo elétrico aprimorado, porque o perfil de íon de flúor está próximo ao canal 2DEG. No entanto, para o FBL HEMT, a implantação de íons inevitavelmente induziria danos adicionais na barreira AlGaN [31, 32], levando a um caminho de corrente de fuga de porta contínua de camada porta-barreira-2DEG ; portanto, o BV do FBL HMET é ligeiramente menor do que o do FPL HEMT.

a Medido fora do estado I-V características com uma tensão de porta de − 4 V, mantendo o substrato flutuado. b Distribuições de campo-E de superfície simulada em V DS =150 V
Pulsado eu DS - V DS medições [33] sob comutação lenta foram realizadas para caracterizar o comportamento da resistência dinâmica ON ( R ON, D ) dos HEMTs AlGaN / GaN fabricados. A Figura 5a é o esquema que descreve a aplicação de tensão de estresse durante o I pulsado DS - V DS Medidas. Em pulsado I-V medições, os eletrodos de porta e dreno dos HEMTs de GaN foram submetidos a pulsos de tensão curtos antes de cada I-V medição para garantir que os dispositivos estavam no estado desligado. A largura do pulso é de 3 ms e o período é de 5 ms. A Figura 5 b – d mostra a comparação das características de saída pulsada dos dispositivos em ( V GS0 , V DS0 ) de (0 V, 0 V) e (0 V, 100 V). Pode ser visto que há uma ligeira degradação (12,3%) da resistência dinâmica ON para o Conv. HEMT, devido à ausência do processo de implantação do íon flúor. Em comparação com FBL HEMT, FPL HEMT tem uma baixa degradação da resistência dinâmica ON. Devido à camada de passivação, a distribuição de vacância está longe do canal 2DEG e está localizada dentro da camada de passivação, o que suprime o aprisionamento de carga no FPL HEMT. A Figura 6 resume os valores de razão de R ON, D / R LIGADO para os três HEMTs sob ( V GS0 , V DS0 ) de (0 V, 0 V) e (0 V, 100 V) em uma etapa de 20 V. Para o FBL HEMT, o R medido ON, D já aumentou em 98% do estático em ( V GS0 , V DS0 ) de (0 V, 0 V) e (0 V, 100 V), enquanto o R ON, D do FPL HEMT é aumentado em apenas 23% em um viés quiescente de drenagem alta de 100 V.
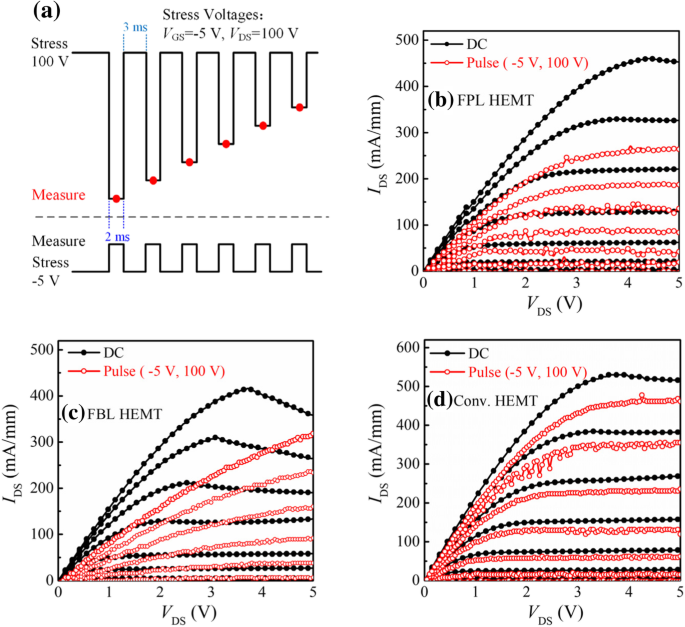
a Esquema que descreve a aplicação de tensão de estresse durante a pulsação I DS - V DS Medidas. Pulsado eu DS - V DS características dos HEMTs AlGaN / GaN fabricados com b FPL HEMT, c FBL HEMT e d Conv. HEMT ( V GS =- 4 ~ 0 V; etapa:0,5 V)
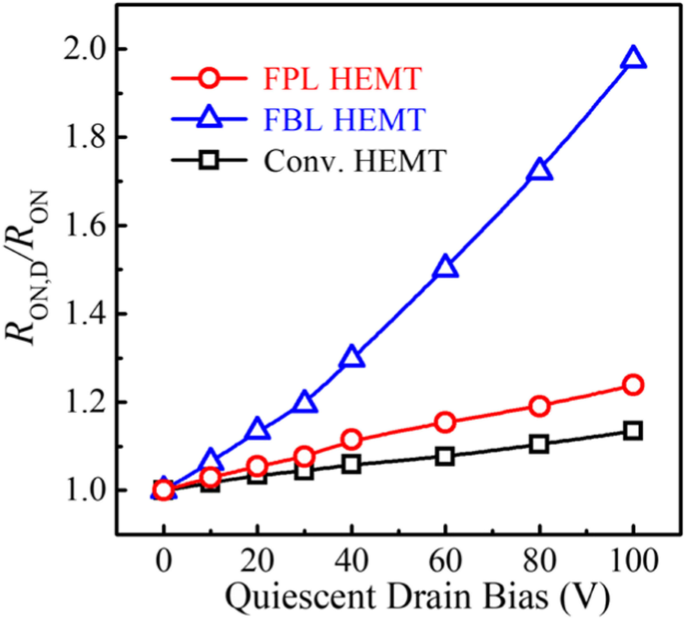
Proporção de R ON, D / R LIGADO para os HEMTs fabricados em diferentes pontos de polarização de drenagem quiescente. A largura e o período do pulso são de 3 ms e 5 ms, respectivamente
Conclusões
Em conclusão, propusemos um novo AlGaN / GaN HEMT com uma alta tensão de ruptura e baixa resistência dinâmica ON. Possui implantação de íon flúor no SiN x espesso camada de passivação. A implantação de íons de flúor na camada de passivação pode suprimir efetivamente a degradação das características elétricas. A resistência dinâmica ON é apenas 1,23 vezes maior que a resistência estática ON após o estado desligado V DS tensão de 100 V, enquanto é 1,98 vezes para o FBL HEMT. Além disso, os íons de flúor na camada de passivação também modulam a distribuição do campo E e espalham a região de depleção; assim, o BV do HEMT proposto aumenta para 803 V de 680 V do HEMT AlGaN / GaN convencional.
Disponibilidade de dados e materiais
Todos os dados gerados ou analisados durante este estudo estão incluídos neste artigo publicado.
Abreviações
- 2DEG:
-
Gás de elétron bidimensional
- HEMT:
-
Transistor de alta mobilidade de elétrons
- ICP:
-
Plasma indutivamente acoplado
- LPCVD:
-
Deposição de vapor químico de baixa pressão
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- SIMS:
-
Espectroscopia de massa de íon secundário
- TEM:
-
Microscopia eletrônica de transmissão
Nanomateriais
- O que é manutenção de avarias e como lidar com ela
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- RGO e redes de grafeno tridimensionais TIMs co-modificados com alto desempenho
- Aerogel de Grafeno / Polianilina com Superelasticidade e Alta Capacitância como Eletrodo de Supercapacitor Altamente Tolerante à Compressão
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN
- RRAM baseado em HfAlOx depositado em camada atômica com baixa tensão operacional para aplicativos de computação na memória
- Transistor de semicondutor de óxido metálico difundido duplo e lateral de resistência ultrabaixa específica com porta dupla aprimorada e camada P-enterrada parcial
- Uma referência de voltagem sem resistor de baixa potência em nanoescala com alto PSRR
- Materiais e design de PCB para alta tensão



