Impactos do Cu-doping no desempenho de dispositivos RRAM baseados em La
Resumo
Neste artigo, os efeitos da camada de inserção de Cu e do recozimento térmico rápido nos comportamentos de chaveamento resistivo de dispositivos de memória de acesso de chaveamento resistivo baseados em La (RRAM) foram investigados. Comparado com a amostra de controle não dopada (Cu / LaAlO 3 / Pt), os dispositivos embutidos em Cu mostram maior rendimento do dispositivo e redefinem a tensão de parada, o que indica que a confiabilidade do RRAM baseado em La foi efetivamente melhorada. No entanto, o Cu / LaAlO não recozido 3 :O dispositivo RRAM Cu / Pt ainda sofre de dispersão séria de parâmetros. Foi provado que o dispositivo RRAM com camada de inserção de Cu e tratamento de recozimento exibe as melhores características de chaveamento resistivo, como baixa tensão de formação, alta relação liga / desliga e uniformidade elétrica fina. Essas melhorias podem ser atribuídas à difusão de átomos de Cu e à formação de nanocristais de Cu (Cu-NCs) após o processo de recozimento, uma vez que os átomos de Cu difundidos e os Cu-NCs podem aumentar o campo elétrico local e enfraquecer a aleatoriedade da formação / ruptura de filamentos condutores.
Introdução
A memória de acesso aleatório resistiva (RRAM) é considerada como uma direção de desenvolvimento para os dispositivos de memória não volátil de próxima geração, que tem chamado muita atenção devido à sua estrutura simples, baixo consumo de energia, alta escalabilidade, velocidade de operação rápida e multi-valor capacidade de armazenamento [1]. RRAM é frequentemente fabricado em uma estrutura de sanduíche metal-isolador-metal (M-I-M), e a camada dielétrica intermediária tem uma influência significativa em seu desempenho de chaveamento resistivo (RS). Assim, uma grande variedade de materiais, incluindo muitos comumente usados com alta constante dielétrica (alta- k ) materiais (como HfO 2 [2], Al 2 O 3 [3], e ZrO 2 [4]), foram investigados extensivamente para aplicações RRAM. Entre todos os materiais de óxido, o óxido à base de lantânio é um dos mais promissores de alta k materiais dielétricos, que tem despertado grandes interesses de pesquisa devido ao seu alto- k valor, grande intervalo de banda e estabilidade térmica fina [5]. Recentemente, boas características de comutação de resistência, como baixa tensão de operação, janela de alta resistência, longo tempo de retenção, longa duração de ciclo e boa consistência, foram encontradas em RRAMs baseados em La, indicando a aplicação potencial de alta- k materiais em RRAMs [6, 7].
Além disso, devido às vantagens de excelente uniformidade, controle preciso de espessura e compatibilidade com o processo CMOS, a tecnologia de deposição de camada atômica (ALD) tem sido um dos métodos de crescimento mais comumente usados para produzir filmes dielétricos baseados em La [8]. Infelizmente, altas tensões de formação indesejáveis são sempre necessárias em dispositivos RRAM depositados em ALD por causa dos filmes dielétricos de boa qualidade, que podem levar a uma alta taxa de falha, baixa relação liga / desliga, baixa resistência e ampla dispersão dos dispositivos [9] . A fim de obter dispositivos RRAM com melhor desempenho de RS, materiais / engenharia de estrutura do dispositivo, incluindo implantação de íons [10], difusão de dopante [11] ou inserção de nanocristais (NCs) [12], precisam ser adotados no LA preparado por ALD RRAMs baseados em
Em relatórios recentes, diferentes tecnologias de dopagem para melhorar os comportamentos de RS do tradicional alto- k materiais (HfO 2 [13], ZrO 2 [14], etc.) foram amplamente estudados. No entanto, os comportamentos de RS aprimorados por NC de dispositivos RRAM baseados em La não foram relatados até agora. Assim, um LaAlO incorporado em Cu 3 dispositivo com a estrutura de Cu / LaAlO 3 / Cu / LaAlO 3 / Pt é fabricado para o aplicativo de memória, e a atenção foi focada nos impactos do doping com Cu no desempenho e no mecanismo de comutação de dispositivos RRAM baseados em La.
Métodos
O diagrama esquemático do dispositivo fabricado com a estrutura de Cu / LaAlO 3 / Cu / LaAlO 3 / Pt é mostrado na Fig. 1. O processo de fabricação do dispositivo RRAM baseado em La é o seguinte:Um metal de bicamada, Pt 100 nm / Ti 10 nm, foi primeiro depositado em um dispositivo de 2 pol. SiO 2 / Wafer de Si como o eletrodo inferior (BE) por evaporação do feixe de elétrons. Posteriormente, a temperatura do reator Picosun R-150 ALD foi definida como 300 ° C, e ~ 10 nm LaAlO 3 (Relação La / Al como 3:1) filme fino foi depositado no Pt / Ti / SiO 2 Substratos / Si, usando La ( i- PrCp) 3 como o precursor La, Al (CH 3 ) 3 como precursor Al e O 3 como o oxidante. Em seguida, a camada de Cu ~ 2 nm foi cultivada no LaAlO 3 a uma taxa de 0,1 Å / s usando um evaporador de feixe de elétrons (EBE). Novamente, ~ 10 nm LaAlO 3 (Razão La / Al de 3:1) o filme fino foi depositado por ALD a 300 ° C. Após o LaAlO 3 / Cu / LaAlO 3 camada de comutação foi preparada usando o processo ALD-EBE-ALD, o processo de recozimento térmico rápido (RTA) foi realizado em um N 2 ambiente a 600 ° C por 30 s. O eletrodo superior (TE) de 10 nm Au / 150 nm Cu foi depositado no LaAlO 3 dielétrico por evaporação de feixe de elétrons após litografia, e seguido por descolamento para fabricar dispositivos que têm tamanhos de 50 × 50 μm 2 para 250 × 250 μm 2 . A fim de compreender melhor os impactos da dopagem com Cu no desempenho de dispositivos RRAM baseados em La, duas amostras de controle, S1:Au / Cu / LaAlO 3 / Pt (não recozido) e S2:Au / Cu / LaAlO 3 :Cu / Pt (não recozido), foram configurados. E a amostra com Au / Cu / LaAlO 3 :A estrutura Cu-NC / Pt foi designada como S3.
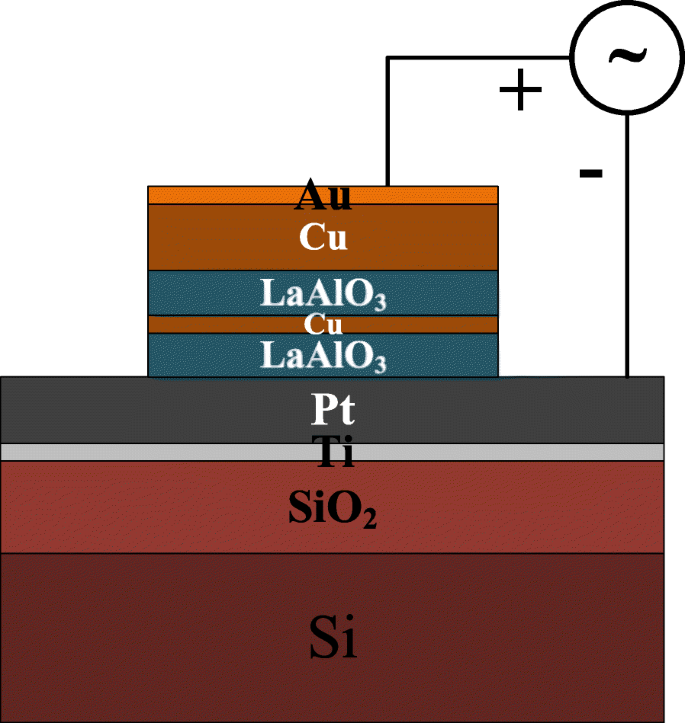
Diagrama esquemático de LaAlO incorporado em Cu 3 dispositivo com a estrutura de Cu / LaAlO 3 / Cu / LaAlO 3 / Pt
A espectroscopia de fotoelétrons de raios-X (XPS) foi usada para analisar a distribuição dos átomos de Cu dopados e a microscopia eletrônica de transmissão transversal (TEM) foi usada para observar a microestrutura dos dispositivos RRAM fabricados. As propriedades RS foram medidas em diferentes modos usando um analisador de parâmetro de semicondutor Agilent B1500A. Uma conformidade de corrente de 1 mA foi imposta para proteger as unidades do dispositivo fabricadas de danos de altas correntes durante os processos de conformação e configuração.
Resultados e discussão
A Figura 2 mostra a análise de profundidade de espectroscopia de fotoelétrons de raios-X (XPS) de espectros de Cu 2p no LaAlO dopado com Cu 3 filme (parâmetros de corrosão:2 KVM Ar ion, taxa de corrosão de ~ 1 Å / s). Como pode ser visto na Fig. 2, o pico de Cu 2p dificilmente pode ser encontrado na amostra não recozida (S2) após o ataque por 30 s ou 60 s, enquanto após o ataque por 90 s, um pico notável de Cu 2p aparece, indicando que o Cu os átomos concentram-se principalmente na camada embutida em Cu. Diferentemente, os átomos de Cu são observados em todo o LaAlO 3 filme após tratamento de recozimento, isto é, após ataque por 30 s, 60 s e 90 s, picos de Cu 2p óbvios podem ser observados em S3. Os resultados de XPS confirmam que o recozimento de alta temperatura levará à redistribuição dos átomos de Cu dopados, o que pode ajudar a melhorar as características elétricas de RRAMs baseados em La.
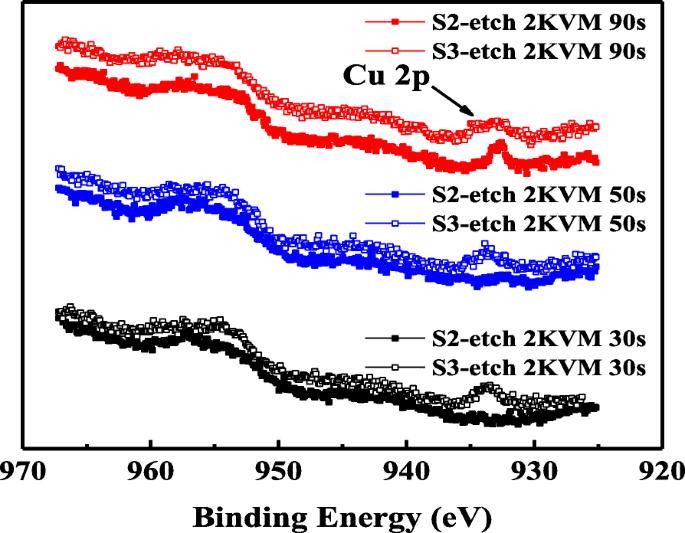
Resultados de XPS dos espectros de Cu 2p para S2 e S3 após corrosão do íon Ar por 30 s, 60 s e 90 s
A Figura 3 mostra a imagem típica do microscópio eletrônico de transmissão transversal (TEM) dos dois LaAlO embutidos em Cu 3 RRAMs (ou seja, S2 e S3). Como mostrado na Fig. 3a, a estrutura laminada do Cu / LaAlO não recozido 3 / Cu / LaAlO 3 / Pt dispositivo pode ser reconhecido claramente na imagem TEM de S2. É importante notar que após a deposição do LaAlO superior 3 a 300 ° C do processo ALD, a nanocamada de Cu ~ 2 nm embutida foi ligeiramente afetada pela difusão térmica. Portanto, a partir da imagem de alta resolução da Fig. 3b, as nanopartículas de Cu irregulares e separadas com o tamanho de 2 ~ 6 nm embutidas em LaAlO 3 camada pode ser claramente observada. O tratamento de recozimento adicional após o processo ALD aumentaria ainda mais a difusão térmica dos átomos de Cu, tornando difícil distinguir a existência de nanocamada de Cu como mostrado na Fig. 3c. Com a ajuda de uma imagem TEM de alta resolução, conforme mostrado na Fig. 3d, uma espessura aproximada de LaAlO 3 de 25 nm camada embutida com vários Cu-NCs esféricos e separados pode ser observada, indicando que parte da nanocamada de Cu já se difundiu no LaAlO 3 dielétrico com alguns Cu-NCs de tamanho menor sendo deixados para trás após o tratamento de recozimento de 600 ° C.
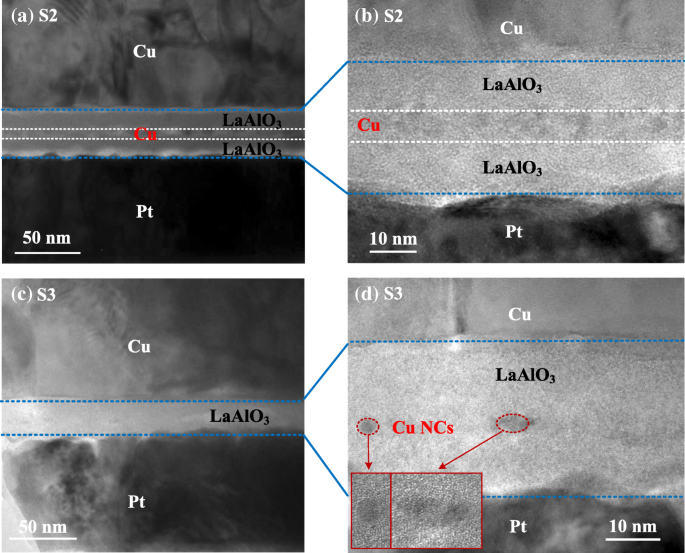
Imagens TEM dos dispositivos RRAM embutidos em Cu. a Uma imagem TEM em seção transversal típica de S2. b Uma imagem HRTEM de S2. c Uma imagem TEM em corte transversal de S3. d Uma imagem HRTEM de S3
O processo de formação elétrica das amostras S1, S2 e S3 são mostrados na Fig. 4. Como pode ser visto na Fig. 4, uma alta tensão de cerca de 12 V é necessária no processo de formação de S1, e uma tensão de formação muito mais baixa (~ 7 V) é necessário em S2 e S3, mostrando que a tensão de formação dos dispositivos baseados em La pode ser efetivamente reduzida pela inserção de uma nanocamada de Cu no filme dielétrico. Além disso, em comparação com o valor de resistência inicial de S1 (2,51 × 10 12 Ω, lido a 1 V), a resistência de S2 é muito mais baixa (2,65 × 10 6 Ω, ler a 1 V), e este valor aumenta após o processo de recozimento (S3, 2,83 × 10 12 Ω, leia a 1 V). As variações acima da tensão de formação e da resistência inicial podem ser atribuídas às mudanças nas propriedades dielétricas de LaAlO 3 filmes por meio de materiais / engenharia de estrutura de dispositivos. Devido à excelente qualidade dos filmes dielétricos à base de La preparados pelo método ALD, uma intensidade de campo elétrico extremamente alta é necessária para quebrar o isolador (isto é, S1). Depois que a nanocamada de Cu foi inserida no filme dielétrico, a camada de comutação de alta qualidade desenvolvida com ALD será afetada por esta nanocamada de metal, o que tornaria o dielétrico mais fácil de quebrar e, por fim, leva a uma tensão de formação muito mais baixa em S2. Além disso, a barreira de energia da formação de vacância de oxigênio poderia ser efetivamente diminuída e defeitos mais metaestáveis seriam trazidos para o filme dielétrico por causa das diferenças estruturais entre Cu e LaAlO 3 materiais (correspondência de rede, correspondência de expansão térmica, etc.) [15]. Consequentemente, um número maior de defeitos (armadilhas de carga, íons metálicos, vacâncias de oxigênio, etc.) seria introduzido no LaAlO 3 camada de chaveamento resistivo, levando à redução da resistência inicial de S2 [16]. No entanto, esse grande número de defeitos nos filmes finos dielétricos de S2 poderia ser efetivamente reduzido (ou eliminado) por tratamento de recozimento adicional, levando a uma alta resistência inicial de S3 [17]. Além disso, o tratamento de recozimento adicional trouxe alguns Cu-NCs e átomos de Cu difundidos para o LaAlO 3 filmes dielétricos, que aumentariam ainda mais o campo elétrico local e resultariam em uma baixa tensão de formação de S3 [18].
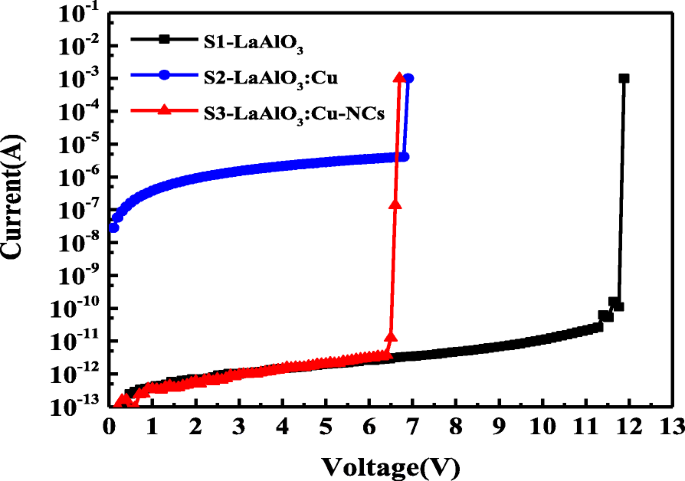
Processo de formação dos três tipos de RRAM baseados em La
Tensão-corrente bipolar típica ( I - V ) curvas de ~ 100 ciclos de varredura de corrente contínua (DC) para os três tipos de dispositivos RRAM baseados em La (tamanho de área de 50 μm × 50 μm) são obtidas na Fig. 5a-c. A tensão de teste (0 a - 1,5 V e - 1,5 a 0 V para o processo de reset; 0 a 5 V e 5 a 0 V para o processo definido) é polarizada no TE (Cu) enquanto o BE (Pt) está aterrado . Embora três dispositivos RRAM baseados em La exibam 100 ciclos consecutivos de comportamento RS bipolar repetível, existem algumas grandes diferenças entre eles. Em primeiro lugar, em comparação com S2 e S3, a amostra não dopada S1 é mais fácil de ser danificada durante as operações cíclicas de ajuste e reinicialização com a voltagem de parada de reinicialização ( V parar ) de - 1,5 V (como mostrado na inserção da Fig. 5a), o que indica que o V máximo parar de S1 é menor do que aqueles de S2 e S3. Considerando isso, um V relativamente baixo parar de -1,4 V é usado no caso da amostra S1. Outra diferença é que o eu - V curvas de S1 e S2 mostram flutuações anormais (ascensão e queda) durante o processo de conjunto, que é bastante diferente do suave I - V curvas de S3. Este fenômeno está intimamente relacionado ao remanescente de alguns filamentos condutores (CFs) no LaAlO não dopado (ou dopado, mas não recozido) 3 filmes dielétricos após o processo de reinicialização. Além disso, em comparação com S1 e S2, S3 tem I - V curvas mostrando mais consistência e menor distribuição de tensões de ajuste / redefinição, o que implica que a estabilidade dos dispositivos RRAM pode ser efetivamente melhorada por tratamento de dopagem e recozimento. As Figuras 5d – f são os testes de resistência (~ 100 ciclos, lidos em - 0,1 V) de S1 – S3 extraído à esquerda da Fig. 5a – c. A razão de resistência máxima de Cu / LaAlO 3 / Pt RRAM dispositivos, ou seja, o estado de alta resistência máxima (HRS) para o estado de baixa resistência mínima (LRS) pode ser tão alto quanto 6 ordens de magnitude. No entanto, a ampla flutuação aleatória em HRS de S1 e S2 traz uma janela liga / desliga de nível muito baixo (~ 10). Ao contrário de S1 e S2, a janela liga / desliga de S3 é cerca de 100 vezes maior do que aquela de S1 e S2, indicando que a característica de consistência de dispositivos RRAM baseados em La dopado com Cu é efetivamente melhorada após o recozimento. O tratamento de recozimento em S3 não só faz com que os átomos de Cu se difundam em torno de todo o LaAlO 3 filme, mas também forma Cu-NCs no dielétrico. Assim, o campo elétrico local foi aprimorado; a aleatoriedade da formação / ruptura de FC foi controlada e a distribuição de HRS (LRS) foi melhorada [19]. Os resultados acima sugerem que a ideia de incorporar uma nanocamada de Cu na RRAM à base de La requer um certo grau de tratamento térmico para obter um melhor desempenho do dispositivo.

a - c Bipolar típico I - V curvas e d - f o teste de resistência de S1, S2 e S3
A Figura 6a mostra a probabilidade cumulativa das resistências HRS e LRS (lidas em -0,1 V), e a Fig. 6b registra a probabilidade cumulativa das tensões de ajuste e reinicialização. Na Fig. 6a, os valores médios ( μ ) de LRS e HRS em S1, S2 e S3 são obtidos como sendo 50,7 Ω e 1,59 MΩ, 100,6 Ω e 1,51 MΩ e 80,6 Ω e 1,95 MΩ, respectivamente. No entanto, o coeficiente de variação ( σ / μ ) de LRS e HRS variam muito quando comparados com os valores médios mais ou menos semelhantes em S1, S2 e S3. Entre eles, S3 tem o valor mínimo σ / μ (LRS - 0,74, HRS - 1,02), seguido por S2 (LRS - 1,33, HRS - 1,23), e o σ / μ de S1 é o pior (LRS - 1,22, HRS - 3,00). Conforme mostrado na Fig. 6b, os valores médios das tensões de reset / set são cerca de - 0,79 V / 2,36 V, - 0,83 V / 2,49 V e - 1,25 V / 2,59 V para as amostras S1, S2 e S3, respectivamente. O desvio padrão ( σ ) das tensões de reset / set, que são usadas para avaliar a dispersão dos parâmetros, são encontradas como 0,20 / 0,82 (S1), 0,23 / 1,16 (S2) e 0,13 / 0,45 (S3), respectivamente. Pode-se descobrir que grandes variações de HRS, LRS, V conjunto e V redefinir em S1 e S2 são melhorados após o recozimento. Comparado com S1 e S2, o dopado e recozido (S3) apresenta melhor uniformidade, indicando que S3 possui a melhor estabilidade de operação entre os três. Como mencionado acima, é provável que um grande número de defeitos seja introduzido no S2, o que causará problemas com a confiabilidade e estabilidade dos dispositivos. Para S3, esses grandes números de defeitos são eliminados pelo processo térmico, e a aleatoriedade de formação / ruptura dos CFs é reduzida devido à existência de Cu-NCs. Assim, uniformidade fina com pequenas variações nas tensões de chaveamento e valores de resistência são obtidos em S3.
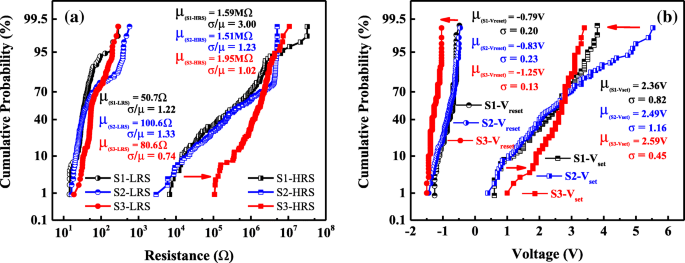
Probabilidade cumulativa de a HRS e LRS (leitura em - 0,1 V) e b definir e redefinir tensões
As características de retenção dos três tipos de dispositivos RRAM baseados em La sob tensão de leitura de - 0,1 V à temperatura ambiente são ilustradas na Fig. 7. Durante o teste de retenção, o Cu / LaAlO 3 :Dispositivos Cu-NC / Pt apresentam desempenho de retenção estável por mais de 10 4 s à temperatura ambiente com um R quase constante HRS / R LRS razão de até três ordens de magnitude, conforme as características não voláteis dos RRAMs baseados em La. DC SET / RESET O rendimento bipolar de 10 ciclos é medido para avaliar a capacidade de comutação de S1, S2 e S3. Conforme mostrado na Fig. 8, S3 tem o melhor rendimento, seguido por S2, e S1 é o pior. Este resultado mostra que uma camada de Cu incorporada é útil para aumentar o rendimento de RRAMs baseados em La, e o rendimento dos dispositivos pode ser melhorado por tratamento térmico adicional. Além disso, pode ser verificado na Fig. 8 que os rendimentos dos dispositivos aumentam com a diminuição da área do dispositivo. Este fenômeno indica que o mecanismo de chaveamento resistivo de Cu / LaAlO 3 Os dispositivos RRAM / Pt podem estar intimamente relacionados ao efeito do calor Joule, ou seja, o calor Joule participa da formação / ruptura dos filamentos condutores e parece ser mais proeminente em dispositivos de menor porte.
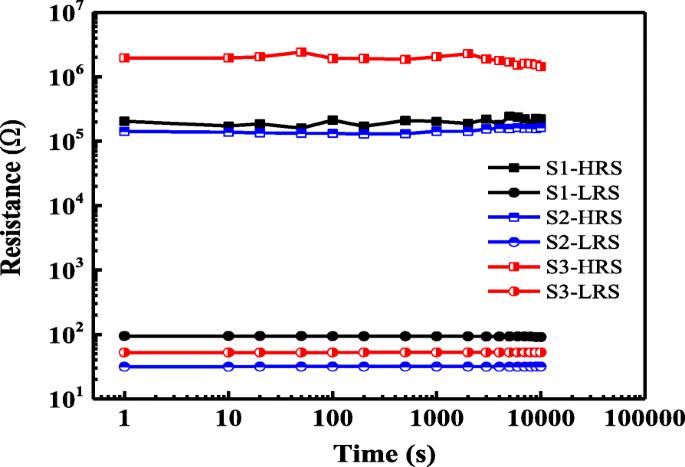
Comportamentos de retenção de dispositivos RRAM baseados em La à temperatura ambiente
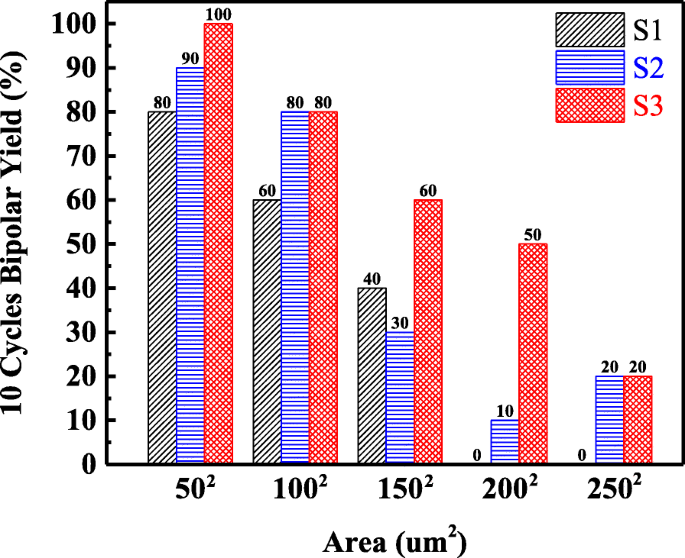
DC SET / RESET rendimento bipolar de 10 ciclos de dispositivos RRAM baseados em La
A fim de obter mais informações sobre os RRAMs baseados em La tratados com Cu-NC, uma análise mais aprofundada foi focada no mecanismo de troca de resistência de S3. Conforme mostrado na Fig. 9a, as tensões de configuração e redefinição em diferentes direções são aplicadas no I - V medição de S3. Os resultados do teste mostram que S3 tem comportamentos de comutação resistivos unipolares e bipolares, indicando que os RRAMs baseados em La tratados com Cu-NC são apolares. Os pesquisadores acreditam que os comportamentos de comutação resistiva não polar (unipolar) estão intimamente relacionados à formação / ruptura assistida por calor de Joule de CFs [7]. No processo de reinicialização do RRAM baseado em La, um fenômeno de overshoot de alta corrente é observado e, em seguida, o efeito de aquecimento Joule é induzido, levando à fusão, sinterização ou oxidação térmica dos CFs. A Figura 9b mostra a plotagem logarítmica dupla de I - V curvas e ajustes lineares de S3, e a inserção mostra o ln ( I / V ) - V 1/2 curva do processo definido. Obviamente, o eu - V A relação em LRS exibe um comportamento de condução ôhmica com uma inclinação de cerca de 1, implicando na existência de CFs no dielétrico após o processo de ajuste. No entanto, o mecanismo de condução do HRS é um pouco complicado, e o I - V as curvas no HRS podem ser divididas em três linhas retas com três inclinações diferentes. Na região de baixa tensão (<0,8 V, linha laranja), a inclinação da linha de ajuste é de cerca de 1,33, que está próxima ao mecanismo de transporte ôhmico. Com o aumento da tensão (~ 0,8 a ~ 2 V, linha verde), a inclinação da linha de ajuste aumenta para 1,93 ( I ~ V 1,93 ), que está em conformidade com a lei da quadratura de Child ( I ~ V 2 ) Na terceira região (> 2 V, linha roxa), a inclinação da linha de ajuste continuará a aumentar (por exemplo, 2,86 neste caso), e a corrente aumentará acentuadamente quando V conjunto é atingido. O modo de condução do HRS, que é composto pela região de transporte ôhmico e região da lei de Child, está em bom acordo com o mecanismo clássico de corrente limitada de carga espacial (SCLC) [20, 21]. O aparecimento do mecanismo de condução do SCLC indica a formação e ruptura do caminho de condução local [22], que é considerado o principal mecanismo RS do Cu / LaAlO 3 :Dispositivos Cu-NC / Pt. Além disso, a condução HRS também se ajusta bem ao mecanismo de condução de Poole-Frenkel (a inserção). O efeito Poole-Frenkel é causado principalmente pelos portadores excitados do campo elétrico saltando através dos estados presos [23], o que sugere que ainda há um grande número de defeitos no LaAlO 3 filmes mesmo após o tratamento de recozimento.
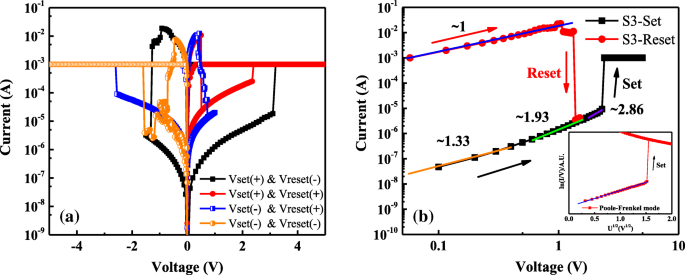
a eu - V medição de S3 em diferentes direções de tensão. b Plotagem logarítmica dupla de I - V curvas e ajustes lineares de S3, e a inserção mostra o ln ( I / V ) - V 1/2 plotagem do processo definido
A dependência de S3 na área do eletrodo (Fig. 10a) e na temperatura (Fig. 10b) foi estudada para entender melhor o mecanismo de RS. Pode ser visto na Fig. 10a que a resistência LRS é independente da área do eletrodo, enquanto a resistência HRS (e resistência inicial) diminui com o aumento da área do dispositivo, o que indica que o mecanismo RS de S3 se origina da formação e ruptura de CFs. Na Fig. 10b, as resistências HRS diminuem com o aumento da temperatura, mostrando que o estado OFF de S3 pode estar associado a um comportamento semicondutor. Em contraste, as resistências LRS aumentam com o aumento da temperatura, indicando uma característica metálica no estado ON [24]. De acordo com a literatura, a relação entre a resistência do metal e a temperatura é geralmente estudada pela equação de R ( T ) = R 0 [1 + α ( T - T 0 )] [25]. E o ajuste linear azul na Fig. 10b determina o coeficiente de temperatura ( α ) como 1,03 × 10 −3 K −1 . Este valor é ligeiramente menor do que os valores relatados dos nanofios de Cu em outras literaturas (2,5 × 10 −3 K −1 [26], 2,39 × 10 −3 K −1 [27]). Devido ao fato de que um grande número de defeitos foram introduzidos no LaAlO dopado com Cu-NC 3 filmes, um menor α valor de Cu CFs é obtido neste artigo.
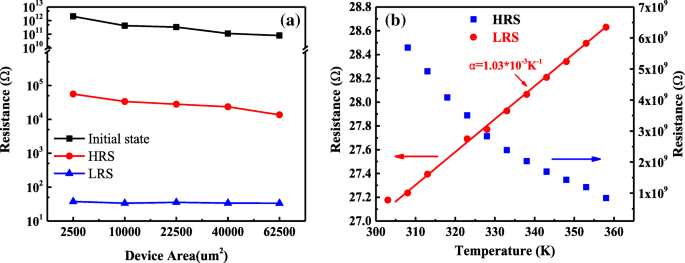
a Dependência da área do eletrodo do HRS e LRS. b Dependência da temperatura do HRS e LRS
Portanto, uma explicação razoável foi proposta para o efeito RS de Cu / LaAlO 3 :Dispositivos Cu-NC / Pt em nosso caso. É muito provável que a formação e a ruptura dos Cu CFs sejam mediadas pela metalização eletroquímica (ECM) e pelo efeito do calor Joule. A Figura 11 mostra diagramas esquemáticos para o mecanismo RS de dispositivos Cu / LaAlO3:Cu-NC / Pt em (a) estado inicial; (b), (c) Processo de configuração; (d) estado LIGADO; e (e) Processo de reinicialização. Quando uma tensão positiva é aplicada a TE (Cu), uma reação de oxidação, que é descrita como Cu → Cu 2+ + 2e - , ocorre no material eletroquimicamente ativo (Fig. 11b). Sob a ação do campo elétrico, o celular Cu 2+ cátions migram para BE (Pt) por meio de LaAlO 3 filme e uma reação de redução de Cu 2+ + 2e - → Cu ocorre no cátodo (Fig. 11c). É importante notar que existem alguns Cu-NCs e átomos de Cu difundidos nos dielétricos baseados em La de S3, que são as vias naturais para a formação de Cu CFs. Assim, os átomos de cobre continuamente precipitados tenderão a crescer ao longo dessas vias naturais e, eventualmente, alcançar o TE para formar um canal condutor (Fig. 11d). Quando a polaridade da voltagem aplicada é invertida, o processo de dissolução, que está intimamente relacionado ao efeito eletroquímico e ao efeito de calor Joule, ocorre em algum lugar ao longo do filamento, resultando em uma fratura quase completa dos CFs e o dispositivo no estado DESLIGADO (Fig. 11e )
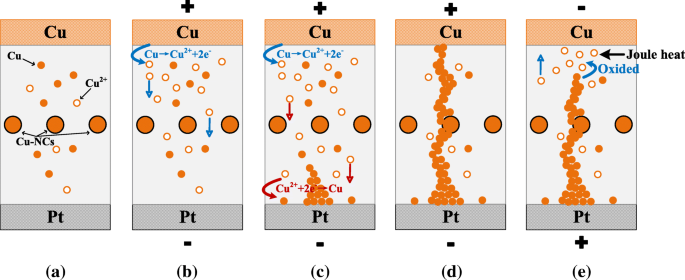
Diagramas esquemáticos para o mecanismo RS de dispositivos Cu / LaAlO3:Cu-NC / Pt em a Estado inicial; b , c definir processo; d Estado ON; e e processo de reinicialização
Conclusão
Em resumo, um método dopado com metal é introduzido para melhorar o desempenho de dispositivos RRAM baseados em La. Melhorias óbvias das características de chaveamento resistivo, incluindo menor tensão de formação, maior relação liga / desliga, melhor uniformidade elétrica e rendimento superior do dispositivo, são corroboradas pelo I - V resultados de medição da amostra dopada com Cu e recozida. Os resultados das análises de XPS e TEM confirmaram que as melhorias no desempenho de troca podem ser atribuídas à difusão de átomos de Cu e à formação de nanocristais de Cu (Cu-NCs) após o processo de recozimento. Outros estudos revelam que o mecanismo de comutação resistivo de Cu \ LaAlO 3 :Dispositivos Cu-NC \ Pt podem ser atribuídos à formação e ruptura de filamentos condutores de Cu, o que está intimamente relacionado ao mecanismo SCLC e ao efeito de aquecimento Joule. Este estudo demonstra um método viável para controlar os comportamentos de chaveamento resistivo dos RRAMs incorporando nanocristais de Cu, e mais trabalhos precisam ser feitos para a compreensão do mecanismo físico e das leis inerentes aos RRAMs baseados em La.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste manuscrito estão incluídos no manuscrito.
Abreviações
- ALD:
-
deposição da camada atômica; RRAM
memória de acesso aleatório resistiva; NCs
nanocristais; M-I-M
metal-isolante-metal; RS
comutação resistiva; Alto- k
alta constante dielétrica; RS
comutação resistiva; SER
eletrodo inferior; RTA
recozimento térmico rápido; TE
eletrodo superior; XPS
Espectroscopia de fotoelétrons de raios-X; DC
corrente direta; CFs
filamentos condutores; HRS
estado de alta resistência; LRS
estado de baixa resistência; SCLC
carga espacial corrente limitada
Nanomateriais
- 5 impactos que a IoT terá na fabricação
- Os dispositivos SAW ultrapequenos de Murata atendem às necessidades de 5G
- A crescente ameaça da IoT habilitada para Wi-Fi
- Conectando a IoT - A oportunidade de banda estreita
- A função da IoT na saúde durante a Covid-19
- Descobrindo o ponto cego da IoT em um mundo pós-pandêmico
- Como o End-Effector Robótico Certo Impacta o Desempenho Robótico
- Os desafios de testar dispositivos IOT de software
- O desempenho eficaz da moldagem por injeção rápida
- Kaizen, o gerenciamento de desempenho operacional?



