Comportamento semelhante ao ferroelétrico originado de dipolos de vacância de oxigênio em filme amorfo para memória não volátil
Resumo
Dispositivos ferroelétricos tradicionais sofrem com a falta de escalabilidade. HfO dopado 2 o filme fino é promissor para resolver o problema de incrustação, mas desafiado pela alta corrente de fuga e pela preocupação com a uniformidade da natureza policristalina. O comportamento do tipo ferroelétrico estável é demonstrado pela primeira vez em um Al amorfo de 3,6 nm de espessura 2 O 3 filme. O amorfo Al 2 O 3 os dispositivos são altamente escaláveis, o que permite transistor de efeito de campo não volátil multiportas (NVFET) com passo de aleta em escala nanométrica. Ele também possui as vantagens de baixa temperatura de processo, alta frequência (~ GHz), ampla janela de memória e longa durabilidade, sugerindo grande potencial em sistemas VLSI. A polarização comutável ( P ) induzida pelos dipolos de vacância de oxigênio modulados por voltagem.
Histórico
A memória ferroelétrica de acesso aleatório (FeRAM) com base em ferroelétricos de perovskita convencionais (por exemplo, PZT) tem sido uma das memórias não voláteis comerciais (NVMs) [1], embora não possa ser escalonada e não compatível com CMOS. Ferroeletricidade foi amplamente observada em uma variedade de materiais diferentes, como paredes aórticas porcinas [2], Sb 2 S 3 nanofios [3], GaFeO 3 filme [4], poli-HfO dopado 2 filmes [5], filmes de hidroxiapatita nanocristalina [6] e LaAlO 3 -SrTiO 3 filme [7]. Entre esses materiais, HfO dopado 2 os filmes atraíram interesses especiais para a aplicação NVM devido à compatibilidade do processo CMOS. Mas a estrutura policristalina é inevitável para gerar ferroeletricidade em HfO dopado 2 , que trouxe obstáculos para a aplicação do dispositivo serem superados como segue:1) é incompatível com o processamento gate-last no que diz respeito ao orçamento térmico de 500 ° C necessário para formar as fases do cristal ortorrômbico [8]; 2) o consumo de energia é induzido pela corrente de fuga indesejada ao longo dos limites do grão, que aumenta exponencialmente junto com a redução da espessura ferroelétrica. Recentemente, um estudo teórico propôs que a ferroeletricidade adicional em poli-HfO espesso 2 (> 5 nm) pode vir de correlações de longo alcance na montagem de dipolos elétricos criados por vacâncias de oxigênio [9]. Observou-se que o mecanismo de captura / retirada de carga de defeito produziu um comportamento semelhante ao ferroelétrico em um Al amorfo de 5 nm de espessura 2 O 3 para uma memória multi-estado, que, no entanto, sofre de uma frequência de captura / retirada de captura muito baixa (por exemplo, ~ 500 Hz) [10].
Neste trabalho, comportamento semelhante a ferroelétrico estável é demonstrado em um Al amorfo de 3,6 nm de espessura 2 O 3 filme, onde a polarização comutável ( P ) é proposto para ser induzido pelos dipolos de vacância de oxigênio modulados por voltagem. O amorfo Al 2 O 3 o filme possui as vantagens de baixa temperatura de processo e frequência operacional de até ~ GHz, o que permite transistor de efeito de campo não volátil multiportas (NVFET) com passo de aleta em escala nanométrica. Al 2 O 3 Memória NVFET com um programa / apagar (P / E) voltagens de largura de pulso de 100 ns e mais de 10 6 A resistência dos ciclos P / E é demonstrada. Os efeitos dos eletrodos e da espessura do filme no P em Al 2 O 3 capacitores também são investigados. Os dispositivos amorfos não voláteis mostram um futuro promissor nas memórias VLSI.
Métodos
Amorfo Al 2 O 3 os filmes foram cultivados em substratos de Si (001), Ge (001) e TaN / Si por deposição de camada atômica (ALD). TMA e H 2 O vapor de O foi usado como precursor de Al e O, respectivamente. Durante a deposição, a temperatura do substrato foi mantida a 300 ° C. Diferentes eletrodos de metal superior, incluindo TaN / Ti, TaN e W, foram depositados em Al 2 O 3 superfícies por pulverização catódica reativa. Capacitores com eletrodos diferentes foram fabricados por litografia padronizada e corrosão seca. Recozimento térmico rápido (RTA) a 350 ° C por 30 s foi realizado. NVFETs com TaN / Al 2 O 3 empilhamento de porta foram fabricados em Ge (001). Após a formação do portão, as regiões de origem / drenagem (S / D) foram implantadas por BF 2 + com uma dose de 1 × 10 15 cm -2 e uma energia de 20 keV, e eletrodos de metal S / D de níquel de 20 nm de espessura foram então formados pelo processo de decolagem. As Figuras 1a eb mostram os esquemas do Al 2 fabricado O 3 capacitor e o NVFET do canal p. Existe uma camada interfacial (IL) entre o eletrodo e o Al 2 O 3 filme. A Figura 1c e d mostram as imagens do microscópio eletrônico de transmissão de alta resolução (HRTEM) do TaN / Al 2 O 3 / Ge stacks com diferentes Al amorfo 2 O 3 espessuras ( t AlO ) após um RTA a 350 ° C.
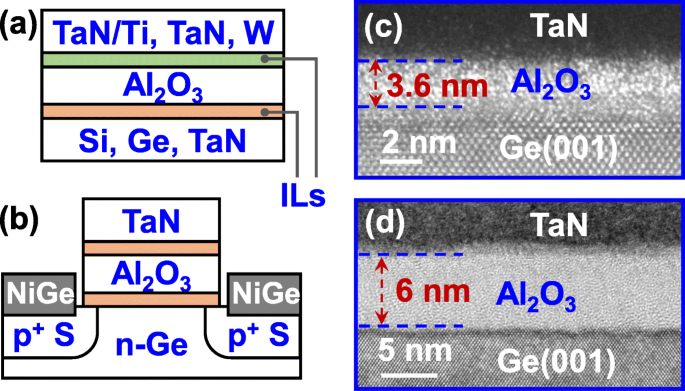
Esquemas do fabricado a Al 2 O 3 capacitores com vários eletrodos e b Al 2 O 3 NVFET. c e d Imagens HRTEM do TaN / Al fabricado 2 O 3 / Ge stacks com diferentes t AlO , mostrando o amorfo Al 2 O 3 filmes após um RTA a 350 ° C
Resultados e discussão
A Figura 2 mostra o P medido vs . tensão V características para o Al amorfo 2 O 3 capacitores com diferentes t AlO e vários eletrodos superior e inferior. A frequência de medição é 1 kHz. Conforme mostrado na Fig. 2a-c, com 3,6 nm fixos de t AlO , TaN / Al 2 O 3 O capacitor / Ge atinge uma saturação mais alta P ( P sat ) em comparação com os dispositivos com eletrodos superiores de TaN / Ti e W. O comportamento do tipo ferroelétrico é fortemente correlacionado com interfaces, e é proposto que a formação de TaAlO x IL entre TaN e Al 2 O 3 produz mais vagas de oxigênio, contribuindo para uma troca mais forte P , em comparação com o TiAlO x e WAlO x ILs. P-V curvas na Fig. 2d indicam que TaN / Al 2 O 3 / O capacitor TaN tem um P muito maior sat em comparação com TaN / Al 2 O 3 / Ge, que é atribuído ao fato de que TaAlO dual x ILs fornecem maior concentração de vacância de oxigênio. Enquanto P sat é significativamente menor do que com o eletrodo inferior de Si (Fig. 2e), em comparação com o eletrodo Ge. Este resultado indica que Al 2 O 3 A qualidade da interface / Si é melhor, ou seja, menos vagas de oxigênio, em comparação com a do dispositivo com base no substrato Ge. A Figura 2f mostra o P-V curvas de um TaN / Al 2 O 3 (6 nm) / capacitor Ge, exibindo um maior V c e um quase idêntico P sat em comparação com o do dispositivo com 3,6 nm de Al 2 O 3 filme na Fig. 2b. Observa-se que o motivo do não divulgado P - V loops é porque realmente existe um vazamento. Foi relatado que o grande deslocamento em um campo elétrico de zero sempre ocorria com um campo grande e sempre desaparecia gradualmente com o alcance de varredura menor de V [11, 12].
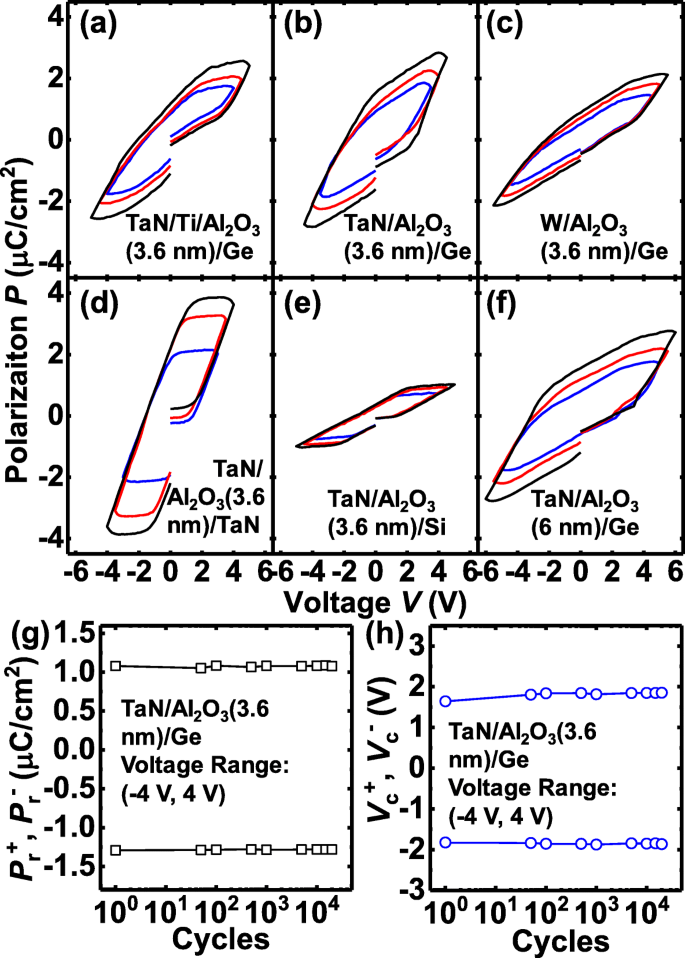
Medido P vs. V características do Al 2 O 3 capacitores com eletrodos diferentes. a , b , e c mostrando o P - V curvas de TaN / Ti / Al 2 O 3 / Ge, TaN / Al 2 O 3 / Ge e W / Al 2 O 3 / Ge, respectivamente, com um t de 3,6 nm AlO . d e e mostrando que o P sat é aprimorado (reduzido) usando TaN (Si) como o eletrodo inferior em vez de Ge. f TaN / Al 2 O 3 (6 nm) / capacitor Ge tem um V maior c e um semelhante P sat em comparação com o dispositivo de 3,6 nm de espessura em b . g e h Medições de resistência mostrando nenhuma degradação de P r e V c observado após 10 4 ciclos de varredura para um TaN / Al 2 O 3 (3,6 nm) / capacitor Ge
As Figuras 2g eh mostram a evolução extraída do remanescente positivo e negativo P ( P r ) e coercitivo V ( V c ) valores, respectivamente, acima de 10 4 ciclos de varredura para um TaN / Al 2 O 3 / Capacitor Ge. Nenhum efeito de despertar, impressão ou fadiga é observado. V c do dispositivo é ~ 1,8 V, indicando que o E no Al 2 O 3 o filme é de 4 ~ 6 MV / cm e nas ILs pode ultrapassar 8 MV / cm, o que é alto o suficiente para conduzir as vacâncias de oxigênio [13, 14]. P sat dos dispositivos varia de 1 a 5 μC / cm 2 , correspondendo a uma concentração de vacância de oxigênio razoável no intervalo 3 ~ 15 × 10 12 cm -2 presumindo que eles tenham o comando de mais dois.
O mecanismo subjacente para o comportamento semelhante ao ferroelétrico associado a vacâncias de oxigênio em Al 2 O 3 dispositivos são discutidos. A migração das vacâncias de oxigênio dirigidas por voltagem foi amplamente demonstrada em dispositivos resistivos de memória de acesso aleatório [15, 16]. A Figura 3 mostra o esquema do comutável P em TaN / Al 2 O 3 / Ge, que se origina da segregação de vacâncias de oxigênio moduladas por voltagem e cargas negativas para formar os dipolos elétricos. É razoável inferir que as vagas de oxigênio móvel surgem principalmente da formação de TaAlO x IL e estão localizados na vizinhança da interface superior no estado inicial (Fig. 3a). As Figuras 3b ec indicam como o positivo e o negativo P são formados, respectivamente, com a modulação da vacância de oxigênio e dipolos de carga negativa sob a tensão aplicada. Espectro de fotoelétrons de raios-X (XPS) de Al 2 O 3 / Ge e (Ti, TaN e W) / Al 2 O 3 / Ge amostras são medidas e mostradas na Fig. 4). Para todo o metal / Al 2 O 3 / Ge amostras, há um óxido de metal IL formado entre metal e Al 2 O 3 , que se propõe ser o reservatório de íons de oxigênio e vazios, o que é consistente com a Ref. [17].
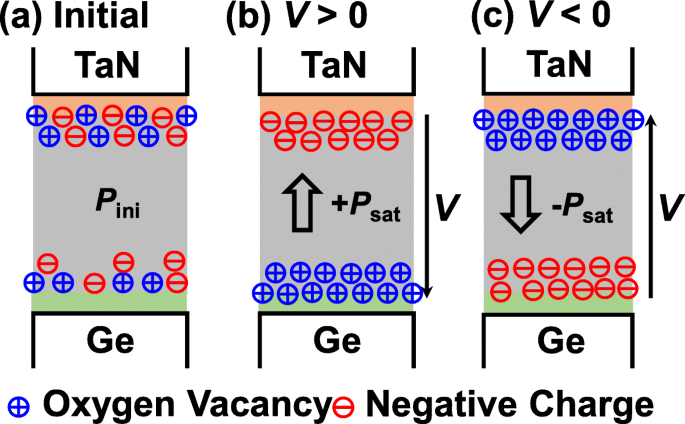
Esquemas do mecanismo de comportamento do tipo ferroelétrico em Al 2 O 3 capacitores. Comutável P é devido à migração de vacâncias de oxigênio e cargas negativas para formar dipolos

Espectros XPS de nível central de a Al 2 O 3 / Ge, b TaN / Al 2 O 3 / Ge, c Ti / Al 2 O 3 / Ge e d W / Al 2 O 3 / Ge samples
Para caracterizar o desempenho elétrico de Al 2 O 3 NVFET como NVM, a operação do programa (apagar) é alcançada pela aplicação de pulsos de tensão positivos (negativos) à porta, para aumentar (diminuir) sua tensão limite ( V TH ) A Figura 5a mostra como as características de transferência da região linear do Al 2 O 3 Mudança de NVFET em relação ao I inicial DS - V GS curva medida com tensões de programa (apagar) de ± 4 V com largura de pulso de 100 ns. Aqui, V TH é definido como um V GS em 100 nA⋅W / L, e MW é definido como a mudança máxima em V TH . O Al 2 O 3 NVFET obtém MW de 0,44 V, embora Al amorfo 2 O 3 o filme tem P menor r do que o HfO dopado relatado 2 filmes [5, 8]. Observa-se que a alta frequência de operação de até 10 MHz de Al 2 O 3 Memória NVFET, o que é indicativo de que P comutável em Al 2 O 3 origina-se da migração de vacância de oxigênio acionada por voltagem para formar dipolos, não de defeitos de captura / retirada de carga. Programa alternado e pulsos de apagamento foram aplicados ao Al 2 O 3 dispositivos para estudar mais a resistência do dispositivo. A Figura 5b mostra os gráficos de V TH vs . Número do ciclo P / E, sugerindo que um MW estável pode ser mantido sem uma degradação significativa ao longo de 10 6 Ciclos de P / E para um Al 2 de 3,6 nm de espessura O 3 NVFET.
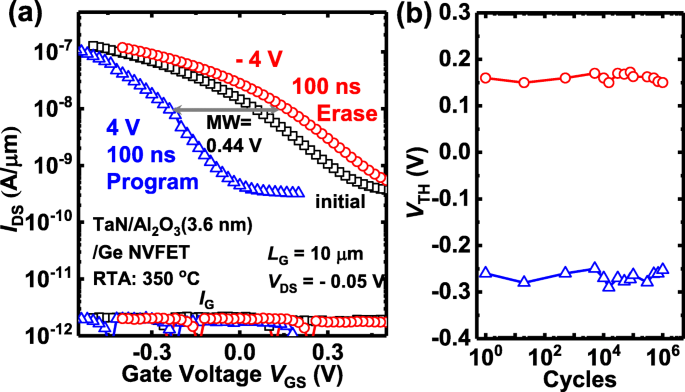
a Medido I DS - V GS curvas de um Al 2 de 3,6 nm de espessura O 3 NVFET para os estados inicial e dois de polarização. Um MW de 0,44 V é obtido. b A medição de resistência demonstra que nenhuma degradação de MW é observada após 10 6 Ciclos P / E
Notavelmente, o comportamento semelhante ao ferroelétrico observado no Al amorfo 2 O 3 os dispositivos podem ser estendidos aos óxidos amorfos universais, por exemplo, óxido de háfnio (HfO 2 ) e óxido de zircônio (ZrO 2 )
Conclusões
Comportamento semelhante a ferroelétrico estável é percebido pela primeira vez em capacitores com um fino Al amorfo 2 O 3 isolador. Comutável P em Al amorfo 2 O 3 capacitores é demonstrado por P-V loops e teste NVFET. O comportamento do tipo ferroelétrico é proposto como originado das vacâncias de oxigênio da interface e dipolos de íons. O Al 2 de 3,6 nm de espessura O 3 NVFET atinge MW de 0,44 V e mais de 10 6 resistência do ciclo abaixo de ± 4 V na condição P / E de 100 ns. Ao todo, este trabalho abriu um novo mundo para dispositivos ferroelétricos de óxido amorfo, que são promissores para NVFETs multiportas (em forma de aleta, nanofio ou nanofolha) com passo de aleta potencialmente nanoescala em sistemas VLSI.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste artigo estão incluídos no artigo.
Abreviações
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposição de camada atômica
- BF 2 + :
-
Íon fluoreto de boro
- E c :
-
Campo elétrico coercitivo
- Ge:
-
Germânio
- GeO x :
-
Óxido de germânio
- HRTEM:
-
Microscópio eletrônico de transmissão de alta resolução
- I DS :
-
Corrente de drenagem
- MOSFETs:
-
Transistores de efeito de campo semicondutores de óxido metálico
- MW:
-
Janela de memória
- Ni:
-
Níquel
- NVFET:
-
Transistor de efeito de campo não volátil
- P r :
-
Polarização remanescente
- P sat :
-
Polarização de saturação
- RTA:
-
Recuperação de recozimento térmico
- TaAlO x :
-
Óxido de alumínio tântalo
- t AlO :
-
Espessura de óxido de alumínio
- TaN:
-
Nitreto de tântalo
- V GS :
-
Tensão do portão
- V TH :
-
Tensão de limiar
- XPS:
-
Espectro de fotoelétrons de raios-x
Nanomateriais
- Uma memória mais inteligente para dispositivos IoT
- Família de memória não volátil aumenta a densidade
- Testador de velocidade do obturador para câmeras de filme
- Filme antifog para PC para visores, lentes e óculos
- Dieletroforese de aquecimento aprimorado para filme nanotubo de carbono de parede única alinhado de densidade ultra-alta
- Nanofios de silício amorfo cultivados em filme de óxido de silício por recozimento
- Microesferas de carbono magnético como um adsorvente reutilizável para remoção de sulfonamida da água
- Filme à base de epóxi Solvay para pré-impregnados
- Filme Sensor para Aeroespacial
- Novo método cria memória de computador com óxido de titânio



