Modelo de retenção de TaO / HfO x e TaO / AlO x RRAM com características de chave auto-retificadora
Resumo
Um modelo de comportamento de retenção para auto-retificação TaO / HfO x - e TaO / AlO x é proposta a memória resistiva de acesso aleatório (RRAM). RRAM do tipo trapping pode ter um estado de alta resistência (HRS) e um estado de baixa resistência (LRS); a degradação em um LRS é geralmente mais severa do que em um HRS, porque o LRS durante o processo SET é limitado pela camada do resistor interno. No entanto, se TaO / AlO x os elementos são empilhados em camadas, a retenção LRS pode ser melhorada. O tempo de retenção LRS estimado pelo método de extrapolação é de mais de 5 anos à temperatura ambiente. TaO / HfO x - e TaO / AlO x As estruturas RRAM com base têm a mesma camada de cobertura de TaO, e os níveis de energia de ativação de ambos os tipos de estruturas são 0,38 eV. Além disso, o AlO adicional x camada de comutação de um TaO / AlO x estrutura cria uma barreira de difusão de O mais alta que pode aumentar substancialmente a retenção, e o TaO / AlO x a estrutura também mostra um LRS bastante estável sob condições tendenciosas.
Histórico
Como a tecnologia flash NAND está enfrentando um limite de escala, os designs de memória de acesso aleatório resistiva vertical (VRRAM) com poucas pilhas de filme, alto rendimento de fabricação e nenhum problema de acoplamento cruzado são candidatos promissores para aplicativos de memória de alta densidade [1,2,3 ] A arquitetura 1TnR com estrutura vertical tridimensional (3D) ajuda a perceber o custo de bits ultrabaixo para matrizes densas altamente compactas [4,5,6]. Vários pesquisadores propuseram operar o RRAM em baixos níveis de corrente, alterando o mecanismo de comutação de resistência de um modelo filamentar para um modelo de caminho de condução do tipo defeitos, modulação por vacância ou tipo de interface [7,8,9]. No entanto, as questões centrais para as falhas de retenção e a migração de vagas de oxigênio ainda não foram resolvidas [3, 10]. Em alguns estudos de retenção do tipo filamentar, muitos modelos diferentes foram propostos para explicar as perdas de retenção [11,12,13]. A mudança do mecanismo de chaveamento também indica uma direção diferente que pode melhorar a retenção [11]. Nossos estudos anteriores mostraram que TaO / HfO x os dispositivos podem mostrar valores de não linearidade favoráveis de aproximadamente 40, valores de resistência que excedem 1000 ciclos e retenção de dados de 85 ° C [6, 7]. No entanto, obter retenção estável em níveis de corrente operacional tão baixos ainda é um desafio. Nesta carta, um modelo de retenção é proposto para perceber a perda de retenção em dois dispositivos diferentes do tipo trapping de defeito com o método de Arrhenius. A energia de ativação extraída não explica de forma convincente a melhoria da retenção pelo AlO x camada. Mesmo que o original fosse ambíguo, a interpretação mais provável é que a ligação densa facilita a retenção.
Métodos
Na fabricação de TaO / HfO x e TaO / AlO x dispositivos para o presente estudo, o eletrodo inferior (BE) é composto de metal TiN depositado por deposição física de vapor (PVD) em 8 pol. substratos de óxido térmico / Si. Cada BE foi padronizado e gravado com litografia convencional e processo de condicionamento. Após cada TiN BE ter sido atacado com gás à base de cloro, o fotorresiste restante (PR) e os resíduos de corrosão foram removidos usando um sistema de plasma remoto que aplicou O 2 e H 2 O a 180 ° C. Durante o processo de remoção do PR, uma fina camada de oxidação de TiON foi formada na superfície de cada TiN BE. Então, camadas de comutação resistiva de HfO x e AlO x foram preparados através da deposição da camada atômica (ALD) com HfCl 4 -H 2 O e TMA-H 2 O precursores, respectivamente. Os dois elementos resistivos HfO x e AlO x foram depositados a 300 e 250 ° C. No topo das camadas de comutação resistivas, a camada TaO foi então depositada por PVD através da oxidação de plasma de baixa temperatura (LTPO) [14]. Esta fabricação deposita metal Ta a uma taxa ultrabaixa (0,2 Å / s). A oxidação plasmática estável foi realizada com uma mistura de Ar e O 2 gases. Esta camada TaO serviu como uma resistência interna de auto-conformidade, que era relativamente furada em comparação com os filmes de chaveamento resistivo anteriores [7]. O eletrodo superior também era PVD-TiN. As vistas de seção transversal e informações de espessura do TaO / HfO x e TaO / AlO x dispositivos de memória são ilustrados na Fig. 1a, b, respectivamente. A espessura do filme de TaO / HfO x foi verificado por microscopia eletrônica de transmissão (não mostrado). Após as células terem sido padronizadas, o óxido de baixa temperatura foi depositado para passivação a 250 ° C. Finalmente, um processo back-end convencional foi aplicado para finalizar a fabricação das estruturas de contato e de metal.

Gráficos esquemáticos de células com informações de espessura para a TaO / HfO x dispositivos e b TaO / AlO x dispositivos. Ambos os gráficos descrevem dispositivos para os quais PVD depositou as camadas TaO com processos LTPO, e as camadas interfaciais de TiON inferiores foram formadas por oxidação de plasma durante a remoção de fotoresiste
Resultados e discussão
As medidas elétricas foram realizadas com um analisador de parâmetros semicondutores HP4156C. Definir e redefinir a densidade de corrente ( J ) versus tensão ( J - V ) curvas de TaO / HfO x e TaO / AlO x dispositivos são mostrados na Fig. 2a, b, respectivamente. Ambos os estados de resistência iniciais ( R inicial ) do TaO / HfO x e TaO / AlO x dispositivos eram HRS. Os dispositivos de memória virgem foram programados para LRS com tendência positiva e foram retrocedidos. Em seguida, cada célula foi trocada de LRS para HRS por voltagem negativa aplicada. Ambos J – V os gráficos contêm três tamanhos de células, a saber, 0,1, 0,56 e 25 μm 2 . No J – V plotagens, todas as curvas de dispositivos com áreas diferentes se assemelham, o que indica TaO / HfO x e TaO / AlO x os dispositivos tinham (i) a mesma densidade de corrente no estado inicial, (ii) tensões de ajuste e reset semelhantes e (iii) a mesma densidade de corrente em LRS e HRS. Além disso, a propriedade de densidade de corrente constante é claramente ilustrada pela resistência versus área ( R - A ) plotagens na Fig. 2c, d. A forte dependência de área em ambos R inicial e o LRS pode ser observado pelo controle da densidade de corrente. Independentemente da escala da área da célula e da corrente de conformidade, a mesma relação de resistência liga / desliga é mantida em ambos os dispositivos. Esta característica da chave de densidade de corrente constante implica que as células de memória são uniformemente programadas ou apagadas pelo campo elétrico. Esses dispositivos são considerados como tendo propriedades de chaveamento do tipo trapping, que estão fortemente relacionadas à modulação de vagas [8]. No caso de RRAM do tipo trapping, nenhum salto acentuado de corrente foi observado durante o processo de ajuste, mas saltos acentuados de corrente foram comumente observados para RRAM do tipo filamentar. Na presente pesquisa, diferentes tensões de chaveamento foram observadas para as diferentes camadas de chaveamento com HfO x ou AlO x . A faixa de tensão definida de um TaO / AlO x dispositivo é de 4 a 4,5 V, que é maior do que TaO / HfO x dispositivo (3 a 4 V). A faixa de voltagem de redefinição de um TaO / AlO x dispositivo é −1,5 a −2,5 V, que é maior do que o de um TaO / HfO x dispositivo (−0,5 a −1,5 V). Um AlO x sistema consome mais energia para completar os interruptores definir e redefinir do que um HfO x sistema consome. Durante a configuração de switches, as camadas de comutação HfO x e AlO x alcançar interrupções suaves em tensões de aproximadamente 3 e 3,5 V, respectivamente. Em ambos os tipos de dispositivos, antes que os filamentos se formem na camada de comutação, a corrente é limitada pela resistência interna da camada TaO. Durante o processo de auto-conformidade do RRAM do tipo trapping, vacâncias excessivas de oxigênio são geradas dentro da camada de comutação [7]. Essas vacâncias de oxigênio são recombinados durante o processo de redefinição de polarização negativa. Ao contrário do RRAM do tipo filamentar, o HRS é sempre menor do que o estado de resistência inicial (IRS) após uma operação de reset [15,16,17]. Para resumir, a captura de defeitos é um processo que modula as vacâncias por meio da recombinação de íons de oxigênio-vacância para controlar a variação da resistência na camada de comutação. Comparado com um HfO x camada de comutação, a detecção de defeitos causa maior tensão e potência no AlO x camada durante a configuração e a reinicialização de um switch.
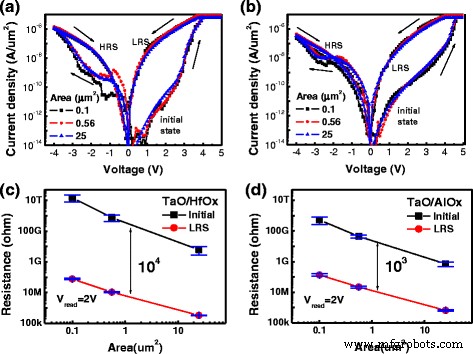
Densidade de corrente com gráfico de voltagem de a TaO / HfO x dispositivos com diferentes tamanhos de células. b TaO / AlO x dispositivos com diferentes tamanhos de células. A resistência versus o gráfico da área de c a TaO / HfO x dispositivo e d a TaO / AlO x dispositivo. Ambos os gráficos contêm o IRS e o LRS com tensão de leitura =2 V. Cada ponto de dados fornece a média de 10 dispositivos e o desvio padrão correspondente
Depois que o comportamento de comutação foi investigado, os comportamentos de retenção HRS e LRS das unidades de memória do tipo trapping foram investigados. Os gráficos de variação da resistência em função do tempo a 85 ° C e 1 V para o TaO / HfO x e TaO / AlO x dispositivos são mostrados na Fig. 3a, b. Em ambos os gráficos, a variação LRS é mais pronunciada do que a variação HRS. A estabilidade da resistência de TaO / AlO x é maior do que TaO / HfO x . As figuras ilustram que os HRSs tenderam a derivar em direção aos IRSs para ambos os tipos de dispositivos; os IRSs são marcados por linhas tracejadas na Fig. 3a, b. A tendência de resistência voltando ao estado virgem do dispositivo é ilustrada na Fig. 3c para TaO / AlO x e na Fig. 3d para TaO / HfO x . Para realizar isso, ambos os tipos de dispositivos foram inicialmente programados para LRS em temperatura ambiente, conforme mostrado no I – V varreduras (linha preta). Então, o TaO / AlO x e TaO / HfO x os dispositivos foram cozidos em fornos a 150 ° C por 48 he a 120 ° C por 120 h, respectivamente. Para ambos os casos, o I – V a varredura depois de cozida foi semelhante à varredura inicial. Por meio desse procedimento, os LRSs dos dispositivos do tipo trapping retornaram aos estados originais após algum tempo em um ambiente de alta temperatura. Ao contrário dos dispositivos do tipo filamento, que apresentam movimento notável de átomos de oxigênio, os dispositivos do tipo aprisionamento têm pares de íons de oxigênio e espaços vazios separados por distâncias curtas. A tendência da resistência derivar ao estado inicial está relacionada à sua cristalinidade original, que é controlada principalmente pela temperatura de processo de ALD. Como resultado, os LRSs em ambos os tipos de dispositivos podem ser redefinidos para HRSs (ou IRSs) por polarização negativa ou energia térmica. Esta propriedade é diferente com RRAM filamentar.
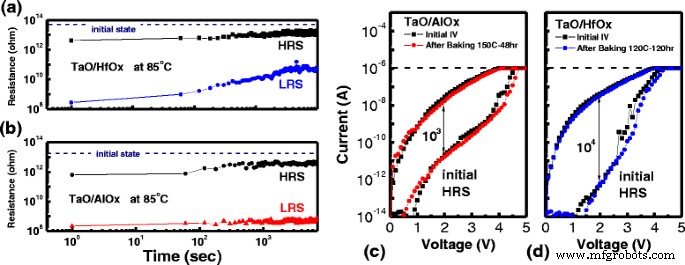
Gráficos de variação de resistência em função do tempo para a TaO / HfO x e b TaO / AlO x dispositivos. Ambos os gráficos contêm variação de HRS e LRS na tensão de leitura =1 V em 85 ° C. Depois do eu - V varreduras de cada dispositivo virgem foram definidas, o dispositivo foi cozido e, em seguida, programado para LRS novamente: c TaO / AlO x (150 ° C durante 48 h); d TaO / HfO x (120 ° C por 120 h)
No teste de retenção padrão para memória não volátil, a retenção de dados é testada tanto em temperatura ambiente quanto em alta temperatura; os dispositivos devem ser capazes de reter dados em temperatura ambiente e em alta temperatura para serem úteis em aplicações reais. Energia de ativação ( E a ) a extração pelo método de Arrhenius no gráfico de retenção é um método comum para avaliar a retenção de dados [18, 19]. Como pode ser visto na Fig. 3a, a variação LRS é mais pronunciada do que a variação HRS. Portanto, a razão de resistência ( R proporção ) de LRS versus tempo de cozimento em temperaturas variando de 30 a 150 ° C. Um exemplo de extração de tempo de retenção de um TaO / AlO x dispositivo é mostrado na Fig. 4a. A taxa de degradação da resistência pode ser calculada pela inclinação do ajuste linear no log ( R proporção ) -log (tempo) escala. Considerando a relação de resistência máxima liga / desliga de aproximadamente 10 3 para um TaO / AlO x dispositivo, como mostrado na Fig. 3c, um tempo de retenção com 10 3 vezes a variação LRS pode ser calculada. A retenção de dados LRS estimada em temperaturas de medição variando de 30 a 150 ° C é mostrada na Fig. 4b. Cada ponto de dados representa informações de mais de 18 dispositivos para ambos os tipos de dispositivos. Em um TaO / AlO x dispositivo, a retenção de dados chega a 10 6 s a 150 ° C e 2 × 10 8 s (aproximadamente 5 anos) à temperatura ambiente; esses tempos são quase 10 1,5 vezes mais do que aqueles de TaO / HfO x dispositivo. O ponto mais interessante é que TaO / HfO x e TaO / AlO x dispositivos mostram o mesmo E a =0,38 eV, calculado a partir do declive extraído. O mesmo E a implica que ambos os tipos de dispositivos passam por reações químicas semelhantes no processo de degradação do LRS. Este E a está envolvido em todos os processos cinéticos termicamente ativados, incluindo a liberação de íons de oxigênio perto de interfaces TaO e os processos de difusão de oxigênio em AlO x e HfO x camadas. No entanto, os coeficientes de autodifusão de oxigênio de HfO x e AlO x as camadas são diferentes em altas temperaturas (> 1000 ° C); medidas exatas podem ser encontradas na literatura [20, 21]. O coeficiente de difusão de oxigênio em baixa temperatura (<200 ° C) também depende da espessura do HfO x dielétricos [22]. Se os processos de difusão na troca de camadas dominam a reação química, então o E a os valores devem ser diferentes devido aos diferentes coeficientes de difusão em HfO x e AlO x camadas. Ambos os tipos de dispositivos neste trabalho exibiram o mesmo E a =0,38 eV; isso estava relacionado ao fato de que ambos os tipos de dispositivos tinham a mesma camada de cobertura de TaO no topo das camadas de comutação. A degradação do LRS é um processo de recombinação de vacâncias e íons, o que significa que a camada de TaO controla essa reação química e a maioria das vacâncias estão aglomeradas perto da interface entre o TaO e a camada de comutação. Essas vagas preferem ficar na interface TaO / camada de comutação; esse fenômeno poderia ser apoiado pelo ponto de vista da estabilidade termodinâmica, conforme relatado por Zhong et al. [23]. Em sua simulação de TiN / Ta / HfO x / TiN stacks, os íons de oxigênio preferiram permanecer no Ta / HfO x interface porque existia uma diferença de baixa energia entre Ta e HfO x [23]. Em sua simulação, como nos experimentos atuais, a camada resistiva TaO capturou a maioria dos íons de oxigênio e dominou este processo de recombinação de vacância. A degradação de LRS é esquematizada na Fig. 4c. Os íons de oxigênio retornam ao estado de equilíbrio térmico anterior durante o processo de cozimento, o que resulta em perda de retenção. As diferenças podem ser notadas entre o Ta / HfO x dispositivo como proposto por Zhong et al. e o TaO / HfO x dispositivo neste estudo, mas em ambos os estudos, a camada de TaO foi formada por vários ciclos de deposição de Ta de metal e processos LTPO [14]. Por causa do processo LTPO, o TaO / HfO rico em metal x interface pode ser considerada como um reservatório de íons de oxigênio. Durante o processo de recombinação de íons de oxigênio e vacâncias, a densidade de empacotamento de átomos desempenha um papel essencial. As propriedades de retenção LRS superiores obtidas no AlO x camada de comutação pode ser explicada pela alta densidade atômica do AlO x camada. É bem conhecido que o comprimento da ligação do Al – O é menor do que o do Hf – O [24, 25]. O vínculo curto no AlO x reduz a mobilidade dos íons de oxigênio devido à alta interação coulomb, que resulta em uma alta barreira de difusão por vacância de oxigênio. Esta barreira faz com que o tempo de retenção seja maior em um TaO / AlO x dispositivo do que em um TaO / HfO x 1.
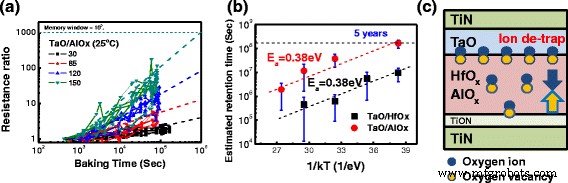
a Taxa de variação da resistência em relação ao tempo de cozimento para diferentes temperaturas em TaO / AlO x dispositivos. A resistência inicial média foi de 179 MOhm com uma tensão de leitura de 2 V, e a taxa de degradação da resistência LRS foi calculada pelo método de ajuste linear em log ( R proporção ) –Log (T) escala. b Tempo de retenção estimado (1000 ×) versus gráfico de 1 / kT. Cada ponto contém dados de 18 dispositivos tomados em uma tensão de leitura de 2 V. As energias de ativação extraídas foram de 0,38 eV em ambos TaO / AlO x e TaO / HfO x dispositivos. c Diagrama esquemático de retenção de diferentes barreiras de difusão de oxigênio em HfO x ou AlO x com uma camada de cobertura TaO
Além disso, o modelo de perda de retenção de um dispositivo do tipo filamentar é diferente daquele de um dispositivo do tipo trap de defeito. O comportamento de retenção para RRAM do tipo filamentar está relacionado à ruptura do filamento, e a direção de difusão da vacância é lateral [11, 19, 24]. No RRAM de captura de defeitos, a direção de difusão do defeito é longitudinal, que é paralela ao campo elétrico externo. Portanto, o comportamento de retenção pode ser afetado pela direção e magnitude da polarização. A Figura 5a, b mostra a retenção on-bias por meio da razão de resistência para os dois dispositivos. A relação de resistência é definida como a resistência do dispositivo de estresse à resistência do LRS. Um viés positivo pode ajudar a manter o LRS, mas um viés negativo acelera o processo de degradação. Essas propriedades on-bias podem ser explicadas pela interação entre o campo localizado de pares de íons de oxigênio e vacâncias e o campo elétrico externo. Se a direção do campo externo for a mesma que a direção definida (positiva), ele estende o tempo de retenção; se o campo externo estiver na direção de reset (negativo), causa degradação. Em um campo elétrico baixo com ± 100 mV, a degradação de polarização é a mesma que a degradação de polarização em ambos os tipos de dispositivos. Esta polarização de ± 100 mV pode ser coberta pelos deslocamentos de banda de TiON-HfO x , TiON-AlO x e junções TiN-TaO. A TaO / AlO x dispositivo sob uma polarização positiva alta de 500 mV não mostra degradação óbvia.
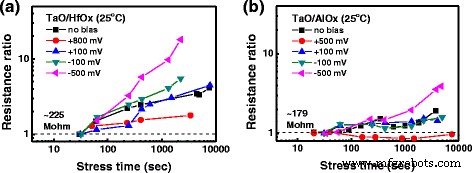
Razão de resistência sob polarização versus tempo de estresse para a TaO / HfO x e b TaO / AlO x dispositivos em temperatura ambiente
Conclusões
Em resumo, comparamos dois tipos de dispositivos RRAM auto-retificados por meio de suas características de switch e analisamos seus comportamentos de retenção. O TaO / AlO x dispositivo mostrou uma tensão de comutação mais alta e uma estabilidade térmica LRS mais robusta do que o TaO / HfO x dispositivo fez. O benefício da retenção robusta do AlO x camada de comutação é devido à alta barreira de difusão de oxigênio, em vez de energia de ativação. A energia de ativação da perda de retenção está relacionada ao processo de remoção de íons na camada resistiva TaO. A alta densidade atômica de AlO x o filme pode melhorar a retenção de LRS. Um modelo esquemático de perda de retenção foi proposto e os resultados de retenção on-bias apoiaram este modelo. Este modelo pode ser benéfico para o desenvolvimento de dispositivos RRAM de baixa corrente, retenção longa e autorretificação para futuras aplicações de memória de alta densidade.
Nanomateriais
- Características e aplicações do titânio
- Circuito com interruptor
- Liderando com Persistência e Perseverança
- switch…case em C (Instrução Switch em C) com exemplos
- Nanomaterial inteligente e nanocompósito com atividades agroquímicas avançadas
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- Síntese fácil de compósito CuSCN colorido e condutor revestido com nanopartículas de CuS
- Biocompatibilidade aprimorada em TaO anódico x arranjos de nanotubos



