Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
Resumo
SiO formado in situ 2 foi introduzido no HfO 2 dielétricos de porta em substrato de Ge como camada intermediária por deposição de camada atômica aprimorada por plasma (PEALD). As características interfaciais, elétricas e de alinhamento de banda do HfO 2 / SiO 2 stacks dielétricos high-k gate em Ge foram bem investigados. Foi demonstrado que a camada intermediária de Si-O-Ge é formada na superfície Ge durante o PEALD SiO in situ 2 processo de deposição. Este interlayer mostra uma estabilidade térmica fantástica durante o recozimento, sem a formação óbvia de silicatos de Hf. Além disso, ele também pode suprimir o GeO 2 degradação. As medições elétricas mostram que a espessura equivalente de capacitância de 1,53 nm e uma densidade de corrente de fuga de 2,1 × 10 −3 A / cm 2 na polarização da porta de V fb + 1 V foi obtido para a amostra recozida. Os deslocamentos da banda de condução (valência) no HfO 2 / SiO 2 A interface / Ge com e sem PDA são 2,24 (2,69) e 2,48 (2,45) eV, respectivamente. Estes resultados indicam que in situ PEALD SiO 2 pode ser uma camada de controle interfacial promissora para a realização de dispositivos de transistores baseados em Ge de alta qualidade. Além disso, pode ser demonstrado que PEALD é uma tecnologia muito mais poderosa para deposição de camada de controle interfacial ultrafina do que MOCVD.
Histórico
Com a redução contínua de transistores de efeito de campo semicondutores de óxido metálico (MOSFETs), o MOSFET baseado em Si está se aproximando de sua limitação física e técnica. Materiais de canais alternativos, como germânio (Ge) [1, 2] e materiais III-V [3–5], recentemente atraíram um grande interesse para aplicações de dispositivos lógicos de alto desempenho. Entre eles, Ge tem o potencial de substituir o silício como o material do canal no MOSFET por causa de sua mobilidade intrínseca de portador de buraco mais alta [6]. No entanto, a deposição direta de dielétricos de porta de alta k em substratos Ge muitas vezes causa alta densidade de interceptação de interface (D it ) e a formação indesejada de camada interfacial entre Ge e camadas dielétricas de alto k [7]. Portanto, para obter MOSFETs baseados em Ge de alta velocidade e baixo consumo de energia, é muito importante obter um k de alta qualidade Interface / Ge. Felizmente, muitos métodos foram relatados para melhorar a qualidade da interface high-k / Ge [8], como a introdução de SiO 2 [9], Si [10], GeO 2 [11], Al 2 O 3 [12, 13], GeO x N y [14, 15], e óxidos de terras raras [16, 17] como a camada de controle interfacial entre o substrato Ge e alto- k dielétricos de porta. Em particular, o GeO 2 A estrutura / Ge tem propriedades de interface superiores, uma densidade de estado de interface extremamente baixa (D it ) de menos de 1 × 10 11 cm −2 eV −1 pode ser alcançado [18]. No entanto, GeO 2 decompõe-se acima de 425 ° C e é solúvel em água. Como resultado, um D it inaceitável é sempre revelado para o capacitor Ge-MOS (MOSCAP) [6]. Felizmente, Kita et al. relatou que capping layer em GeO 2 pode suprimir o GeO 2 degradação; no entanto, a seleção do material para a camada de cobertura deve ser muito importante [19-21]. Por exemplo, Si ou Y 2 O 3 funciona com mais eficiência do que HfO 2 para retardar a dessorção de Ge-O. Estes resultados indicam a importância de materiais high-k ou seleção de camada de controle interfacial para inibir o GeO 2 degradação. Nakashima et al. relatou que um SiO 2 muito fino / GeO 2 bicamada por deposição física de vapor (PVD) é uma camada intercalar promissora para passivação de Ge, um D it de 4 × 10 11 cm -2 eV −1 foi alcançado próximo ao midgap [22, 23]. Li et al. introduziu o SiO 2 camada intermediária em Ge por deposição de vapor químico orgânico de metal (MOCVD) e SiO 2 a camada intermediária pode suprimir a difusão de Ge durante o HfO 2 crescimento e subsequente processo de recozimento pós-deposição [9]. Portanto, SiO 2 deve ser uma camada de controle interfacial maravilhosa para o substrato Ge. No entanto, em comparação com PVD e MOCVD, PEALD pode fornecer uma camada de passivação muito mais uniforme, especialmente para espessura ultrafina. Conseqüentemente, SiO formado por PEALD 2 pode ser uma camada de controle interfacial promissora para alcançar dispositivos de transistor baseados em Ge de alto desempenho.
Aqui, apresentamos o SiO formado por PEALD in situ 2 em HfO 2 / Ge stacks como camada interfacial. As características interfaciais, elétricas e de alinhamento de banda de ALD HfO 2 filmes em substratos Ge do tipo n foram investigados cuidadosamente. O SiO 2 foi primeiro depositado nos substratos Ge como camada de controle interfacial por PEALD. Então, HfO 2 O dielétrico de porta foi depositado in situ pelo modo ALD térmico. Recozimento pós-deposição (PDA) a 500 ° C por 60 s em N 2 foi realizado para o HfO 2 / SiO 2 pilhas dielétricas de porta high-k em Ge. As análises de espectroscopia de fotoelétrons de raios-X revelam que a camada intermediária de Si-O-Ge e o GeO 2 camada é formada na superfície Ge durante PEALD SiO 2 deposição. Esta camada intermediária de Si-O-Ge não só mostra uma fantástica estabilidade térmica, mas também pode suprimir a decomposição térmica do GeO 2 . Portanto, boas propriedades elétricas foram alcançadas para o HfO 2 / Si-O-Ge / GeO 2 / Pilhas Ge. Comparado com MOCVD SiO 2 intercalar, in situ PEALD SiO 2 exibe propriedades elétricas muito melhoradas. Portanto, PEALD é uma tecnologia muito mais poderosa do que MOCVD na área de fabricação de MOSFETs, especialmente para deposição de camada de controle interfacial ultrafino.
Métodos
Ge dopado com Sb tipo N (100) com uma resistividade de 0,2–0,3 Ω ∙ cm foram usados como substratos. Os substratos foram primeiramente limpos por sonicação em acetona, etanol, isopropanol e água deionizada por 5 min, respectivamente. Em seguida, uma solução diluída de HBr (H 2 O / HBr =3:1) foi usado para gravar os óxidos nativos da superfície durante 5 min. Após a limpeza química úmida, os substratos foram enxaguados com água desionizada e secos em N 2 puro . Posteriormente, os substratos foram imediatamente transferidos para o PEALD (Picosun SUNALE TM R-200) câmara. Antes da alta- k HfO 2 deposição de filmes, 10 ciclos SiO 2 o filme foi depositado a 250 ° C por PEALD como intercamada, onde um ciclo consistia em 1 s de injeção de fonte de Si, 10 s N 2 purga, injeção de oxidante de 13,5 s e 4 s N 2 purgando. Tris- (dimetilamino) -silano (TDMAS) e O 2 plasma foram usados como precursor de Si e oxidante para SiO 2 deposição, respectivamente. O TDMAS foi mantido à temperatura ambiente. Pure O 2 gás (99,999%) foi usado como O 2 fonte de plasma. A potência do plasma e O 2 a taxa de fluxo de gás foi de 2500 W e 160 sccm, respectivamente. A taxa de crescimento de PEALD SiO 2 foi determinado ser ~ 0,7 Å / ciclo por elipsometria de espectroscopia ex situ. Então, HfO 2 de ~ 4 nm de espessura o filme foi depositado in situ a 250 ° C por 40 ciclos por ALD térmico, onde um ciclo consistia em dosagem de fonte de 0,1 s Hf, 4 s N 2 purga, 0,1 s H 2 O dosagem, e 4 s N 2 purgando. Tetraquis- (etilmetilamino) -háfnio (TEMAH) e H 2 O foram usados como precursor de Hf e oxidante para HfO 2 deposição, respectivamente. TEMAH foi evaporado a 150 ° C e H 2 O foi mantido à temperatura ambiente. Pure N 2 (99,999%) foi usado como gás de arraste e gás de purga. PDA foi executado em N 2 ambiente a 500 ° C por 60 s sob pressão atmosférica usando recozimento térmico rápido.
As estruturas interfaciais e ligações químicas dos filmes foram investigadas por espectroscopia de fotoelétrons de raios-X ex situ (XPS, Thermo Fisher K-Alpha) com fonte de raios-X padrão Al Kα (1486,7 eV). Os espectros de XPS foram coletados em um ângulo de decolagem de 90 °. A escala de energia de ligação foi calibrada usando o Ge 3d 5/2 pico em 29,4 eV. Além disso, os espectros XPS foram ajustados com funções Gaussian-Lorentzian (G-L) após a subtração de fundo do tipo inteligente. Eletrodos de topo de Pt de área 1,55 × 10 −4 cm 2 foram depositados na superfície do HfO 2 filmes usando uma máscara de sombra pelo método de pulverização catódica para medições elétricas. As características de capacitância-tensão (C-V) e densidade de corrente de fuga (J-V) foram medidas por um sistema analisador de semicondutor Keithley 4200 com uma plataforma de sonda (Cascade summit 12000B-M).
Resultados e discussão
Para o PEALD SiO fino 2 (~ 0,7 nm) em Ge, Si 2p exibe um pico em 102,4 eV correspondente à ligação Si-O (Fig. 1a), que é menor do que a energia de ligação do SiO ideal 2 [24]. Ambos subóxido de silício (SiO x ) deposição e formação de Si-O-Ge na superfície de Ge durante o processo PEALD pode fazer com que o deslocamento de Si 2p diminua a energia. Portanto, o espectro de Si 2p de PEALD espesso (~ 7 nm) em Ge também foi realizado. Pode ser descoberto que ele exibe um pico principal em 103,6 eV correspondendo ao SiO ideal 2 ligação, como mostrado na Fig. 1b. Então, o óxido de silício depositado por PEALD aqui é SiO ideal 2 . No entanto, além do pico forte de Si-O-Si, há um pico fraco localizado em ~ 102,4 eV, que deve corresponder à ligação Si-O-Ge na superfície Ge. Portanto, pode-se concluir que Si-O-Ge é formado na superfície Ge no PEALD SiO inicial 2 crescimento. Após in situ 4 nm HfO 2 deposição, a intensidade do pico de Si 2p diminui sem mudança química óbvia (102,3 eV), como mostrado na Fig. 1a. Além disso, o Si 2 p pico também não exibe nenhum deslocamento químico evidente (102,2 eV) após o PDA de 500 ° C em N 2 , sugerindo a boa estabilidade térmica do HfO 2 / SiO 2 interface durante HfO 2 deposição e processo de PDA. No espectro Hf 4f de HfO conforme depositado 2 / SiO 2 pilhas de porta (Fig. 1c), o dupleto em 16,5 e 18,2 eV pode ser atribuído a Hf 4f 7/2 e Hf 4f 5/2 picos de HfO 2 com a energia de divisão da órbita do spin de 1,7 eV, consistente com o valor da literatura de HfO 2 [25]. Após 500 ° C PDA, o espectro Hf 4f não mostra nenhuma mudança óbvia com apenas 0,1 eV mudança para energia mais alta. Isso implica que não há silicatos de Hf evidentes formados durante o processo de PDA. Na Fig. 1d, o espectro Ge 3d da amostra conforme depositada exibe os picos do dupleto em 29,4 e 30,0 eV, que podem ser atribuídos aos picos Ge 3d5 / 2 e Ge 3d3 / 2 do substrato Ge com a energia de divisão da órbita de spin de 0,6 eV. Exceto o sinal do substrato Ge, há um grande pico em 32,7 eV para a ligação Ge-O. O pico Ge-O deve ser resultado da formação de Ge-O-Si e GeO 2 . O GeO 2 camada foi formada pela oxidação de plasma de oxigênio de superfície durante PEALD SiO 2 processo de deposição. Portanto, a verdadeira estrutura fabricada aqui é HfO 2 / Si-O-Ge / GeO 2 / Pilhas Ge. Além disso, o espectro Ge 3d não mostra nenhuma mudança evidente após o tratamento de PDA a 500 ° C, indicando a estabilidade térmica do HfO 2 / Si-O-Ge / GeO 2 / Ge stacks sem GeO 2 degradação. Foi relatado por Kita et al. que algumas camadas de cobertura em GeO 2 poderia suprimir o GeO 2 decomposição, como Si ou La 2 O 3 [19]. Portanto, o PEALD induziu a camada intermediária de Si-O-Ge aqui também pode suprimir o GeO 2 decomposição. Com base na análise XPS acima, pode-se concluir que uma camada intermediária de Si-O-Ge ultrafina é formada na superfície de Ge. Além disso, este interlayer exibe uma estabilidade térmica fantástica sem a formação de Hf-silicatos, ele também pode inibir o GeO 2 degradação.
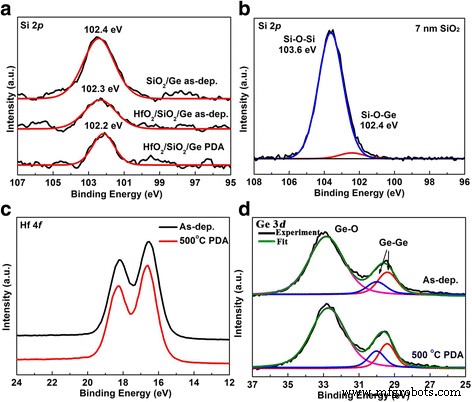
Espectros XPS de SiO 2 / Ge e HfO 2 / SiO 2 / Estruturas Ge. a Espectros Si 2p de SiO 2 , HfO como depositado e recozido 2 / SiO 2 em Ge. b Espectro de Si 2p de SiO espesso 2 (7 nm) em Ge. c, d Espectros Hf 4f e Ge 3d de HfO conforme depositado e recozido 2 / SiO 2 / Estruturas ge
A Figura 2a representa as curvas C-V de alta frequência (1 MHz) de HfO 2 / SiO 2 gate stacks em Ge antes e depois de PDA. Pode ser encontrado que a tensão de banda plana ( V fb ) valores de HfO 2 / SiO 2 / Ge antes e depois de PDA são 0,42 e 0,27 V, respectivamente. O ideal calculado V fb o valor é 0,55 V. O ligeiramente negativo V fb deslocamento indica cargas fixas positivas, que podem ser induzidas pelas lacunas de oxigênio nos dielétricos [26, 27]. Durante o processo de recozimento de atmosfera inerte, mais vacâncias de oxigênio podem ser induzidas, resultando em um V ligeiramente negativo fb mudança. Foi demonstrado em muitas literaturas relatadas que o GeO 2 degradação durante o recozimento causará o V positivo fb mudança. Acredita-se que o processo de dessorção do Ge-O gere cargas negativas adicionais [28, 29]. Portanto, também pode ser concluído que GeO 2 a decomposição é suprimida pela camada intermediária Ge-O-Si de V fb mudança. A capacitância de acumulação evidentemente aumenta do original 1,92 para 2,25 μF / cm 2 após PDA. Os valores de espessura equivalente de capacitância (CET) dos capacitores MOS podem ser calculados a partir das capacitâncias de acumulação das curvas C-V usando ε 0 ε r A / C acc [30]. Portanto, um CET menor de 1,53 nm é obtido após PDA em comparação com a amostra como depositada de 1,80 nm. Isso pode ser atribuído ao fato de que uma camada high-k mais densa e mais fina pode ser adquirida após o processo de PDA. A Figura 2b mostra as características da corrente de fuga de HfO 2 / SiO 2 filmes sobre Ge antes e depois do PDA. Na tensão de polarização de V fb + 1 V, a densidade de corrente de fuga é 2,1 × 10 −3 A / cm 2 e 2,2 × 10 −4 A / cm 2 para a amostra antes e depois do PDA, respectivamente. O aumento da densidade de corrente de fuga após o PDA também pode ser atribuído à diminuição da espessura dos dielétricos da porta.
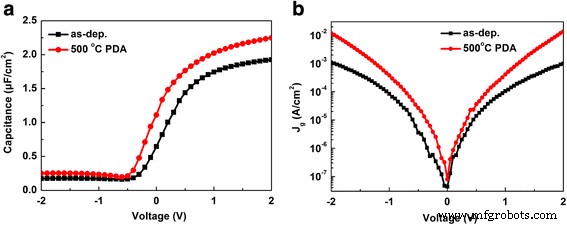
Características elétricas do HfO 2 / SiO 2 gate stacks em substratos Ge antes e depois de 500 ° C PDA. a Curvas C-V de alta frequência (1 M Hz). b Curvas J-V
Para examinar a qualidade da interface do HfO 2 / SiO 2 / Ge quantitativamente, a densidade do estado da interface ( D it ) foi determinada pelo método da condutância [31]. A Figura 3 mostra a distribuição de D it abaixo de E c no gap extraído pelo método de condutância à temperatura ambiente para Pt / HfO 2 / SiO 2 / Ge antes e depois de 500 ° C PDA. O D it pode ser calculado aproximadamente a partir de D it =2,5 × ( G p / w ) max / A q, onde ( G p / w ) max é o valor de pico das características de condutância-tensão, f (= w / 2π) é a frequência, A é a área do eletrodo, e q é a carga elemental. Portanto, D it valores de Pt / HfO 2 / SiO 2 / Estruturas Ge sem e com PDA são determinadas como 4,05 × 10 12 eV −1 cm -2 e 5,37 × 10 12 eV −1 cm −2 em E-E v =0,38 eV, respectivamente. O inferior D it valores de 2,03 × 10 12 cm −2 eV −1 e 2,67 × 10 12 cm −2 eV -1 perto da parte inferior da banda de condução são observados para as amostras sem e com PDA, respectivamente.
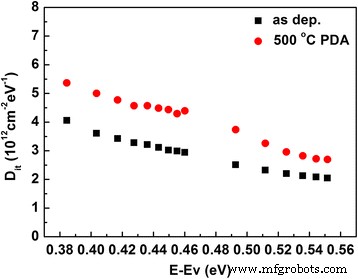
Distribuição de D it abaixo de E c no gap de banda à temperatura ambiente para Pt / HfO 2 / SiO 2 / Ge antes e depois de 500 ° C PDA
A Figura 4 ilustra a densidade de corrente de fuga ( J g ) -CET relacionamento do capacitor MOS baseado em Ge com a camada de controle interfacial diferente [32, 33]. Comparado ao Ge passivado por S sem intercamada relatado por nosso trabalho anterior [34], o HfO 2 / SiO 2 / Ge neste trabalho exibe propriedades muito melhoradas com CET menor (1,53 vs 2,18 nm), densidade de corrente de fuga (2,1 × 10 −3 vs 3,1 A / cm 2 ) e D it (4,37 × 10 12 vs 8,61 × 10 12 eV −1 cm −2 ) Isso implica que SiO 2 formado por PEALD in situ é uma camada de passivação maravilhosa para Ge. Além disso, em comparação com o SiO formado ex situ 2 interlayer por MOCVD [9], a amostra com SiO formado por PEALD in situ 2 a camada intermediária neste trabalho mostra melhor desempenho elétrico com CET menor (1,53 vs 1,75 nm) e densidade de corrente de fuga (2,1 vs 3,9 mA / cm 2 ) Pode ser atribuído ao fato de que SiO 2 depositados por PEALD são mais uniformes do que MOCVD, especialmente para espessura ultrafina.
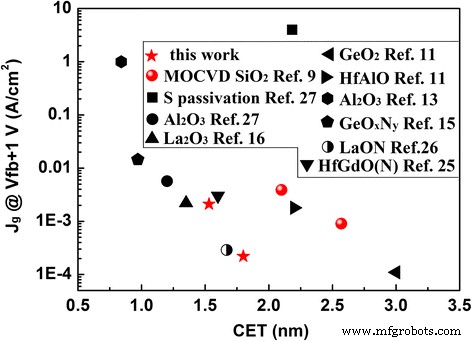
Relação de densidade de corrente de fuga (Jg) -CET para capacitores MOS baseados em Ge com camada de controle interfacial diferente
O alinhamento da banda em HfO 2 / SiO 2 A interface / Ge também foi determinada medindo o deslocamento da banda de valência ∆E v (VBO) usando XPS. Os valores de VBO podem ser obtidos partindo do pressuposto de que a diferença de energia entre o nível do núcleo e a borda da banda de valência (VB) do substrato permanece constante com / sem a deposição de filmes dielétricos [35]. Aqui, o substrato Ge foi escolhido como referência para determinar o VBO entre a pilha de dielétricos de porta e o substrato Ge. A Figura 5a apresenta os espectros VB do substrato Ge limpo, HfO conforme depositado e recozido 2 / SiO 2 / Pilhas Ge determinadas pelo método de extrapolação linear, respectivamente. A borda VB do substrato Ge limpo foi determinada como 0,10 eV. E, as bordas VB de HfO como depositado e recozido 2 / SiO 2 as amostras são 2,55 e 2,79 eV, respectivamente. Pode-se notar que há uma pequena cauda nos espectros VB para HfO 2 / SiO 2 / Ge stacks, que corresponde ao sinal do substrato Ge [36]. A borda dianteira desta cauda fraca é medida como 0,10 eV e igual à borda VB do substrato Ge. Portanto, os VBOs na interface do HfO 2 / SiO 2 / Ge com e sem PDA são estimados em 2,69 e 2,45 eV, respectivamente. O deslocamento da banda de condução ∆ E c (CBO) pode ser obtido subtraindo o VBO e o bandgap do substrato do bandgap de HfO 2 :
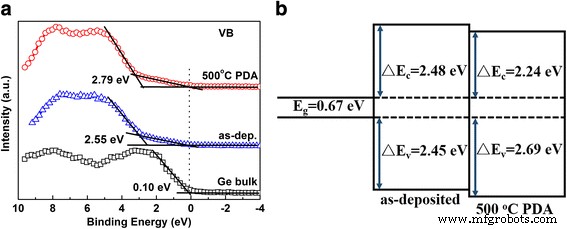
Alinhamento de bandas de HfO conforme depositado e recozido 2 / SiO 2 filme sobre Ge. a Espectros de banda de valência do substrato Ge, HfO conforme depositado e recozido 2 / SiO 2 filmes. b Esquema do alinhamento da banda de HfO conforme depositado e recozido 2 / SiO 2 filme em ge
onde E g (HfO 2 ) e E g (Ge) são o bandgap de HfO 2 e Ge, respectivamente. Os bandgaps de Ge e HfO 2 são 0,67 e 5,6 eV, respectivamente. Portanto, os valores CBO na interface de HfO 2 / SiO 2 / Ge com e sem PDA são estimados em 2,24 e 2,48 eV, respectivamente. Os valores CBO são consistentes com os dados relatados anteriormente de 1,8–2,6 eV [37]. A Figura 5b ilustra o alinhamento da banda correspondente de HfO conforme depositado e recozido 2 / SiO 2 / Estruturas Ge. Evidentemente, o HfO 2 / SiO 2 As pilhas dielétricas de porta high-k em Ge exibem grandes valores de VBO e CBO com alturas de barreira enormes para inibir a corrente de fuga.
Conclusões
Em resumo, SiO 2 interlayer foi introduzido em HfO 2 gate dielectrics em substratos n-Ge com sucesso por in situ PEALD. Investigamos a interface, as propriedades elétricas e o alinhamento da banda de HfO 2 / SiO 2 / Ge MOS. Foi demonstrado que a camada intermediária Ge-O-Si e GeO 2 camada é formada na superfície Ge durante o SiO in situ 2 deposição. Este interlayer Ge-O-Si mostra uma estabilidade térmica fantástica durante o PDA sem a formação de silicatos de Hf. Além disso, a camada intermediária Ge-O-Si também pode inibir o GeO 2 degradação durante o processo de recozimento. O HfO 2 / SiO 2 A amostra / Ge após PDA exibe um valor CET de 1,53 nm com baixa densidade de corrente de fuga de 2,1 × 10 −3 A / cm 2 em V fb + 1 V. Os valores VBO no HfO 2 / SiO 2 / Ge com e sem PDA são determinados como 2,69 e 2,45 eV, e os valores CBO como 2,24 e 2,48 eV, respectivamente. Comparado com o SiO formado ex situ 2 intercamada por MOCVD, a amostra com SiO formado por PEALD in situ 2 interlayer neste trabalho mostra desempenho elétrico melhorado, atribuído ao fato de que SiO 2 depositados por PEALD são mais uniformes do que MOCVD. Portanto, PEALD é uma tecnologia muito mais poderosa para deposição de camada de controle interfacial ultrafina do que MOCVD.
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Modelo de retenção de TaO / HfO x e TaO / AlO x RRAM com características de chave auto-retificadora
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características ópticas e elétricas de nanofios de silício preparados por corrosão eletrolítica
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Propriedades elétricas de materiais compostos com alinhamento assistido por campo elétrico de cargas de nanocarbono
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Dependência da espessura nas propriedades interfaciais e elétricas na camada atômica AlN depositado no plano c GaN



