Memória resistiva ZrO2 / ZrO2 - x / ZrO2 sem conformidade com comportamento de comutação multiestado interfacial controlável
Resumo
Uma transformação controlável do modo de comutação interfacial para filamentar é apresentada em um ZrO 2 / ZrO 2 - x / ZrO 2 memória resistiva de três camadas. Os dois modos de comutação são investigados com possíveis mecanismos de comutação e transformação propostos. Modulação da resistividade do ZrO 2 - x A camada é proposta para ser responsável pela comutação no modo de comutação interfacial através da injeção / retração de íons de oxigênio. A comutação é livre de conformidade devido ao resistor em série intrínseco pelos filamentos formados no ZrO 2 camadas. Ajustando o RESET voltagens, memória multiestado estável e controlável podem ser alcançadas, o que aponta claramente para a capacidade de desenvolver a memória multiestado de próxima geração de alto desempenho.
Histórico
O desenvolvimento de memórias não voláteis mais densas, rápidas e com menor consumo de energia é de grande importância para as inovações na tecnologia da informação moderna [1, 2]. Embora muitos concorrentes tenham surgido para ser a próxima geração de dispositivos de memória, a memória de acesso aleatório resistivo (RRAM) baseada em óxidos de metal é um dos candidatos mais promissores por suas vantagens de alta velocidade, alta escalabilidade, baixo consumo de energia e boa compatibilidade com o Processo CMOS [3]. Embora o mecanismo de chaveamento detalhado da memória resistiva permaneça incerto, é amplamente aceito que a migração de vacâncias de oxigênio sob um campo elétrico aplicado desempenha um papel fundamental no comportamento de chaveamento [4]. Dependendo do mecanismo de comutação, a comutação resistiva pode ser classificada em modos filamentares e interfaciais (homogêneos). O modo filamentar é obtido pela formação e ruptura do (s) filamento (s) vazio (s) de oxigênio entre dois eletrodos. Por outro lado, a mudança de resistência no modo interfacial é controlada pela distribuição de vacâncias de oxigênio ao longo de uma interface. A corrente está localizada no (s) filamento (s) condutor (es) no modo filamentar, enquanto é distribuída homogeneamente pela área do dispositivo no modo interfacial [5, 6]. O modo de chaveamento resistivo caracterizado em um dispositivo de memória é fortemente dependente de sua estrutura. Em geral, a exibição do modo interfacial no sistema à base de óxido metálico depende da existência de um perfil de gradiente de oxigênio ao longo do eixo vertical [7, 8]. Recentemente, a coexistência de ambos os modos em um sistema de material também foi relatada [9,10,11]. Modulando os parâmetros de medição, a transformação entre esses dois modos também pode ser alcançada [12]. No entanto, a mudança no modo interfacial é geralmente atribuída à mudança da altura da barreira Schottky induzida pelos processos de acumulação e depleção de portadores através de estados defeituosos na interface eletrodo / camada de função [7, 9,10,11,12,13, 14,15,16,17,18] em vez do efeito da migração de vacâncias de oxigênio nas interfaces óxido / óxido.
Nos últimos anos, um grande progresso foi feito para aumentar a densidade de armazenamento de RRAM. Além dos esforços para reduzir as dimensões físicas da célula de memória, utilizar os estados de resistência intermediária (IRS) entre o estado de alta resistência (HRS) e o estado de baixa resistência (LRS) para realizar o armazenamento multiestado dentro de uma célula de memória tornou-se uma solução alternativa popular [19, 20]. Este comportamento de armazenamento multiestado é importante para armazenamento de alta densidade e dispositivos sinápticos eletrônicos baseados em óxido [21,22,23]. O armazenamento multiestado no modo de comutação filamentar é realizado controlando a largura e / ou número de filamentos condutores com diferentes RESET tensões ou SET conformidades atuais. Uma variedade de óxidos de metal, incluindo TiO x , ZnO, SiO x e HfO 2 , demonstraram comportamento multiestado em dispositivos RRAM [24,25,26,27]. O armazenamento multiestado em modo de comutação interfacial também foi relatado, onde o ajuste das larguras das regiões defeituosas de oxigênio foi proposto como sendo o responsável por este comportamento [12, 28]. No entanto, ambos os modos de comutação requerem conformidade atual no SET processo para proteger o dispositivo de quebra e, no caso de comutação filamentar, para atingir múltiplos estados de resistência mais baixos. Esses requisitos podem levar à complexidade no projeto do circuito RRAM. Memória resistiva livre de conformidade com comportamento de comutação multiestado controlável pode, portanto, ser vantajosa, pois minimiza o excesso de corrente durante a comutação e tem o potencial de reduzir significativamente o custo de fabricação [29, 30].
Recentemente, o uso de ZrO 2 como a camada de comutação ativa tem atraído atenção por causa de sua alta estabilidade termodinâmica, composição simples e compatibilidade de processo semicondutor [31,32,33]. Além disso, inserir uma camada alienígena dentro do ZrO 2 filme para produzir uma heteroestrutura de óxido provou ser um método eficaz para melhorar as características de comutação em ZrO 2 dispositivos baseados em [34, 35]. Neste trabalho, demonstramos um ZrO 2 / ZrO 2 - x / ZrO 2 com base na memória resistiva em que um ZrO não estequiométrico 2 - x camada é formada dentro do ZrO 2 camada inserindo uma camada Zr. Ambos os modos interfacial e filamentar são observados, e uma transformação controlável de interfacial para filamentar pode ser realizada. As características de comutação e o desempenho para ambos os modos são investigados. Enquanto a interface óxido / eletrodo tem um efeito sobre os comportamentos de comutação no modo filamentar, a comutação no modo interfacial depende fortemente das interfaces óxido / óxido nas estruturas de três camadas. Mais importante ainda, a comutação resistiva sob o modo interfacial goza de uma propriedade livre de conformidade integrada, bem como comportamento de armazenamento multiestado sob diferentes RESET tensões.
Métodos
ZrO 2 filmes finos foram preparados por pulverização catódica assistida por plasma de média frequência (Leybold Optics HELIOS Pro XL) em temperatura ambiente. Nesse processo, o substrato girava a uma velocidade de 180 rpm para garantir uma deposição uniforme. Durante cada rotação, uma fina camada de Zr foi primeiramente depositada a partir de alvos de metal Zr (99,99% de pureza) usando uma potência de 2.000 W em uma atmosfera de Ar. Este filme fino foi transformado em uma camada de óxido passando o substrato por baixo do O 2 plasma da fonte de RF. O 2 a taxa de fluxo pode ser ajustada para produzir ZrO x filmes com diferentes composições. As propriedades composicionais dos filmes depositados foram investigadas usando raios-X de dispersão de energia (EDX), onde um microscópio Zeiss EVO LS 25 equipado com um detector de raios-X Oxford INCA X-act foi usado. Filmes com uma grande espessura de 1 μm foram depositados diretamente em wafers de Si para minimizar a influência do substrato. Os padrões de difração de raios-X (XRD) foram coletados na incidência de pastagem ( θ =1 °) usando um difratômetro Rigaku Smartlab com um Cu – K de 9 kW α fonte. Os dados de espectroscopia de fotoelétrons de raios-X (XPS) foram obtidos usando um ThermoScientific Theta Probe System com Al – K α radiação (energia do fóton =1486,6 eV). O perfil de profundidade XPS foi realizado usando um canhão de íons de Ar a uma tensão de feixe de 3 kV em uma área raster de 2 × 2 mm. Espécimes de microscopia eletrônica de transmissão (TEM) foram preparados usando polimento mecânico convencional seguido de moagem iônica para transparência eletrônica usando Ar + a 6 keV. Uma etapa final de moagem de baixa energia foi realizada a 500 eV. A fim de minimizar os danos à superfície, a estrutura e morfologia das amostras foram analisadas usando um JEOL 2100 TEM equipado com LaB 6 e JEOL ARM200F TEM / varredura TEM (STEM) com uma pistola Schottky, ambos operando a 200 kV. A medição de STEM de campo escuro anular (ADF) foi realizada no ARM200F, com sonda e corretores CEOS de aberração de imagem. As imagens ADF-STEM foram obtidas usando um detector de campo anular JEOL com uma corrente de sonda de aproximadamente 23 pA, um semi-ângulo de convergência de ∼25 mrad e um ângulo interno de 45–50 mrad. Um Oxford Instruments X-Max N O detector de desvio de silício sem janela 100TLE (SSD) foi usado para realizar a análise STEM-EDX.
O comportamento de comutação resistiva do ZrO de três camadas 2 / ZrO 2 - x / ZrO 2 o filme foi investigado como memória. Um filme de TiN de 200 nm de espessura foi pulverizado reativamente (alvo de Ti em um N 2 atmosfera) para o SiO 2 camada para formar o eletrodo inferior. Isso foi seguido por pulverização catódica reativa de um segundo SiO 2 camada (alvo Si em um O 2 atmosfera). Esta camada de SiO 2 foi padronizado para formar áreas ativas do dispositivo por fotolitografia e corrosão iônica reativa. Posteriormente, ZrO 2 / ZrO 2 - x / ZrO 2 (20 nm / 5 nm / 20 nm) camadas triplas foram depositadas para formar a camada de comutação. A estrutura de três camadas foi obtida interrompendo o plasma de oxigênio durante o ZrO 2 crescimento. ZrO 2 camada é alcançada sob um O 2 taxa de fluxo de 20 sccm enquanto o ZrO 2 - x camada é obtida desligando o O 2 fluxo por 20 s. Um ZrO idêntico 2 / ZrO 2 - x / ZrO 2 tripla camada também foi depositada em substrato de Si para caracterização de XRD e XPS. Finalmente, uma camada de TiN de 200 nm foi pulverizada e padronizada na camada tripla para formar o eletrodo superior. Todas as medições elétricas foram realizadas com um sistema de caracterização de semicondutor Keithley 4200. Durante as medições, a polarização da tensão de programação foi aplicada ao eletrodo superior, mantendo o eletrodo inferior aterrado. Os contatos sonda / ponto para os eletrodos superior e inferior dos dispositivos foram realizados por meio de um par de agulhas de sonda Wentworth, utilizando uma sonda semiautomática AVT 702 dos laboratórios Wentworth. As medições de varredura de tensão DC foram conduzidas a uma taxa constante de 0,5 V / s.
Resultados e discussão
As propriedades da estrutura de três camadas foram investigadas inicialmente por XRD. A Figura 1 representa o padrão de XRD das camadas triplas conforme depositadas (vermelho), que apresenta dois picos posicionados a 28,2 ° e 29,8 °. Esses dois picos podem ser atribuídos ao pico −111 do ZrO monoclínico 2 fase e o pico 101 do ZrO tetragonal 2 fase, respectivamente, indicando a existência de duas fases. Caracterizações de EDX e XRD realizadas em um único ZrO x camadas com composições diferentes (mostrado no arquivo adicional 1:Figura S1 e S2) revelam que o ZrO estequiométrico 2 exibe a fase monoclínica (azul) enquanto a fase tetragonal (verde) foi detectada a partir do ZrO deficiente em oxigênio 2 - x camada. Não foram observados picos de XRD de Zr metálico (rosa) no padrão de XRD de três camadas. Isso sugere a coexistência de ambos ZrO estequiométrico 2 e ZrO deficiente em oxigênio 2 - x camada na estrutura de três camadas e a camada embutida de Zr foi oxidada.
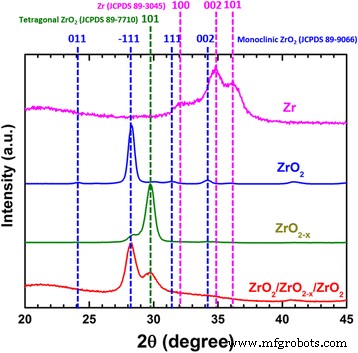
Padrões de XRD do ZrO conforme depositado 2 / ZrO 2 - x / ZrO 2 estrutura de três camadas ( vermelho ), ZrO deficiente em oxigênio 2- x camada ( verde ), estequiométrico ZrO 2 camada ( azul ) e camada de Zr metálico puro ( rosa )
A Figura 2a, b apresenta os resultados de XPS dos perfis de pico de Zr 3d e O 1s ao longo de um tempo de corrosão de 800 s. Dois picos posicionados em ca. 182,3 e 184,5 eV podem ser atribuídos ao Zr totalmente oxidado 4+ estado [36, 37], que domina os espectros Zr até um tempo de corrosão de ca. 300 s. Uma clara intensidade aprimorada de dois picos posicionados em ca. 178,3 e 180,5 eV podem ser subsequentemente observados entre o tempo de corrosão de 300 a 400 s; isso também é acompanhado pela redução de O 2− intensidade de pico em ca. 530,0 eV. Foi sugerido que esses dois picos de Zr 3d estão associados ao Zr metálico ou não oxidado 0 estado [36]. Isso indica o ZrO deficiente em oxigênio 2 - x camada encontra-se no meio desta estrutura de três camadas. Após 400 s de tempo de gravação, o Zr 4+ os picos retomam seu domínio e a intensidade do O 2− pico está de volta ao normal. A concentração atômica ao longo do perfil de profundidade na Fig. 2c confirma ainda a oxidação da camada de Zr embutida em ZrO não estequiométrico 2 - x . Também vale a pena mencionar que gradientes de composição entre ZrO 2 e ZrO 2 - x interfaces também foram observadas, o que é sugerido para facilitar a formação de comportamento de comutação interfacial [8]. Considerando os resultados de XRD e XPS, é razoável acreditar que a fase monoclínica detectada no XRD é originada dos dois ZrO estequiométricos 2 camadas. O ZrO deficiente em oxigênio imprensado 2 - x camada, por outro lado, contribui para a fase tetragonal, embora alguns traços de regiões amorfas não possam ser excluídos.
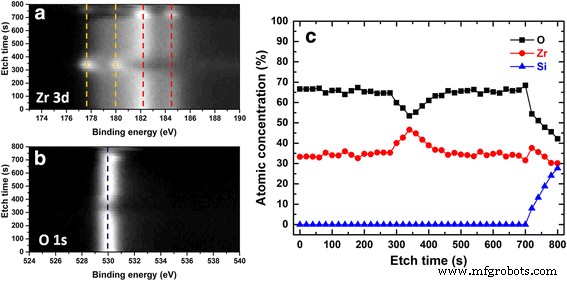
Espectros XPS de a Zr 3d e b O 1s para o ZrO 2 / ZrO 2 - x / ZrO 2 estrutura de três camadas ao longo de um tempo de corrosão de 700 s. c Perfil de profundidade XPS do ZrO 2 / ZrO 2 - x / ZrO 2 estrutura de três camadas
A medição TEM confirma ainda a estrutura de três camadas com o ZrO deficiente em oxigênio 2 - x camada claramente observada como mostrado na Fig. 3a. Além disso, outra camada interfacial entre o ZrO 2 camada e eletrodo TiN inferior também são visíveis. O perfil EDX correspondente é demonstrado na Fig. 3b em que a interdifusão de átomos de Ti, O, N e Zr são evidentes nos primeiros 10 nm. Além disso, a razão O:Zr muito maior (quadrado aberto) nos primeiros 5 nm confirma a existência de um TiO x N y camada interfacial entre o ZrO 2 e o eletrodo inferior TiN. Na verdade, como ZrO 2 é pulverizado imediatamente após TiN, o O 2 o plasma reagirá com a superfície TiN para formar um TiO x N y camada quando o ZrO 2 camada ainda é muito fina. Formação semelhante de TiO interfacial x N y camada também foi relatada [38, 39].
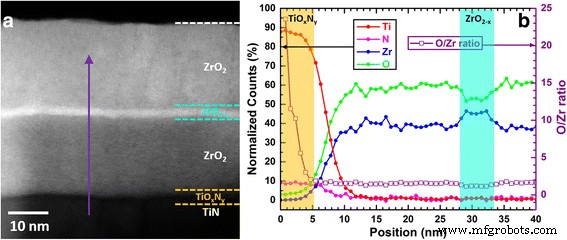
a Imagem ADF-STEM da seção transversal da amostra e b Perfis de linha elementar STEM-EDX do TiN / ZrO 2 / ZrO 2 - x / ZrO 2 estrutura
Com base nos resultados da caracterização, o esquema do ZrO 2 / ZrO 2 - x / ZrO 2 a memória de três camadas é representada na Fig. 4a. O dispositivo original é medido para estar no estado de alta resistência, conforme mostrado na Fig. 4b. Uma grande tensão de formação negativa ( I CC =1 mA) é necessário para induzir a quebra do dielétrico suave e iniciar a comutação. Muito incomum, isso está associado a um processo de formação de duas etapas, o que sugere a formação consecutiva de dois filamentos nos dois ZrO 2 camadas e o dispositivo é SET em um estado de baixa resistência. Uma tensão positiva foi então aplicada a RESET o dispositivo no HRS conforme demonstrado na Fig. 4c. Visivelmente, este RESET O processo é caracterizado por uma diminuição gradual e contínua na corrente, uma característica típica para a comutação resistiva interfacial. O SET O processo aplicando uma polarização de tensão negativa também mostra comportamento semelhante, sugerindo que a comutação resistiva interfacial é o modo de comutação dominante. O comportamento de comutação interfacial é ainda provado pela dependência da área da corrente em ambos HRS e LRS (mostrado na Fig. 4d). Ambas as correntes aumentam conforme o tamanho do eletrodo aumenta, indicando que a condução da corrente não é filamentar. O aumento da corrente, embora não seja totalmente proporcional à área. Isso pode ser explicado pela modulação menos eficaz da resistividade em tamanhos de células maiores durante a comutação interfacial devido à maior quantidade de contornos de grão e corrente de fuga [12]. Comportamento semelhante também foi relatado em outros dispositivos de chaveamento resistivo interfacial de bicamada [8, 12]. O SET processo demonstra um comportamento de auto-conformidade. Isso é benéfico para a aplicação em memória resistiva, pois minimiza o overshoot de corrente durante a comutação e tem o potencial de reduzir significativamente o custo de fabricação [29, 30].
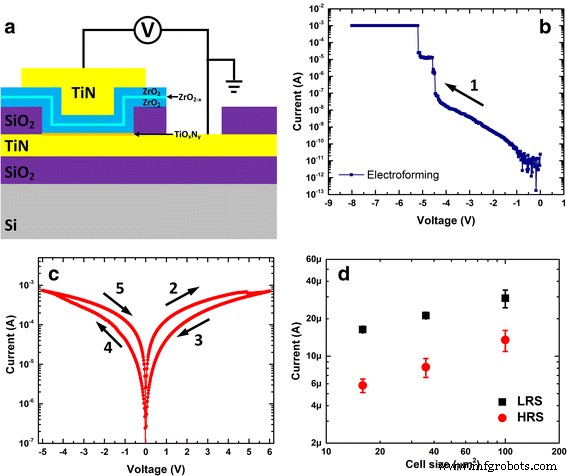
a Esquema da tri-camada TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / Memória TiN. b I – V características do processo de eletroformação para o TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / Dispositivo TiN. c I – V características da comutação interfacial após a formação. d Atual como a função do tamanho do dispositivo para ambos HRS / LRS no modo de comutação interfacial
A transformação do modo de comutação interfacial para o modo de comutação filamentar pode ser desencadeada por uma segunda etapa de formação, conforme demonstrado na Fig. 5a. Uma polarização mais negativa foi aplicada no dispositivo em HRS com uma conformidade de corrente de 20 mA. Isso leva a um aumento abrupto da corrente em ca. −8 V, e o dispositivo subsequentemente permanece em um estado de resistência muito mais baixo. Após o RESET processo com uma polarização positiva, o modo de comutação do dispositivo foi completamente transformado em filamentar, caracterizado pelo acentuado SET (controle atual) e RESET transições. A Figura 5b mostra a distribuição de probabilidade cumulativa dos LRSs e HRSs de ambos os modos de comutação interfacial e filamentar em que diferenças distintas podem ser observadas entre esses dois conjuntos de estados de resistência, indicando que o dispositivo foi comutado em modos diferentes. Para lançar luz sobre o mecanismo de condução de ambos os modos de comutação, o logarítmico I – V gráficos de curvas e ajustes lineares do SET processos são apresentados. O I – V curva em HRS no modo interfacial segue um comportamento ôhmico em baixa tensão com a adição de um termo quadrático em alta tensão, ou seja, I ∝ aV + bV 2 , que é a característica típica do modelo de corrente limitada de carga espacial (SCLC) como mostrado na Fig. 5c [40,41,42]. Observações semelhantes deste mecanismo SCLC também foram relatadas em outros dispositivos de memória resistiva interfacial [8, 12]. Por outro lado, o logarítmico I – V curvas do SET processo de comutação filamentar após a transformação é mostrado na Fig. 5d. A curva sugere que a corrente é governada pelo modelo SCLC com traps [40,41,42]. Embora um modelo de condução semelhante seja utilizado para explicar a comutação interfacial e filamentar, os dois modos ainda demonstram características distintas, particularmente em um estado de baixa resistência. A condução atual para LRS no modo filamentar consiste em duas regiões:a região ôhmica ( I ∝ V ) e a região de direito da criança ( I ∝ V 2 ), enquanto o último não foi observado na condução LRS de comutação interfacial. Isso indica que a comutação filamentar é mediada por um processo de trapping / destrapping de portadora [43]. Especulamos que uma quantidade substancial de armadilhas são geradas nos caminhos condutores durante o segundo processo de formação, levando ao termo quadrático de corrente em LRS do modo filamentar.

a eu - V características do processo de transformação ( laranja ) da comutação interfacial ( vermelho ) para a comutação filamentar ( azul ) b Gráfico de probabilidade cumulativa de HRS e LRS para ambos interfaciais ( V REINICIAR =6 V) e modos de comutação filamentares. O SET processo I – V curvas do c interfacial e d modos de comutação filamentar em gráfico logarítmico duplo
ZrO de camada única 2 memória com uma espessura de filme de 40 nm também foi fabricada para comparação com o esquema mostrado na Fig. 6a. O processo de eletroformação ( I CC =1 mA) do TiN / ZrO 2 O dispositivo / TiN apresenta uma única etapa com tensão muito mais alta (Fig. 6b). O comportamento de comutação bipolar foi subsequentemente observado (Fig. 6c), que é semelhante ao modo filamentar no dispositivo de três camadas. No entanto, o modo de comutação interfacial não foi observado neste dispositivo de camada única. A Figura 6d mostra o logarítmico I – V curvas do SET processos para dispositivos de camada única que demonstram bons acordos com o modelo SCLC com armadilhas. Isso também apóia a conclusão de que o ZrO imprensado 2 - x camada é crucial para a comutação interfacial que ocorre tanto no ZrO 2 - x camada ou próximo ao ZrO 2 - x / ZrO 2 interface.
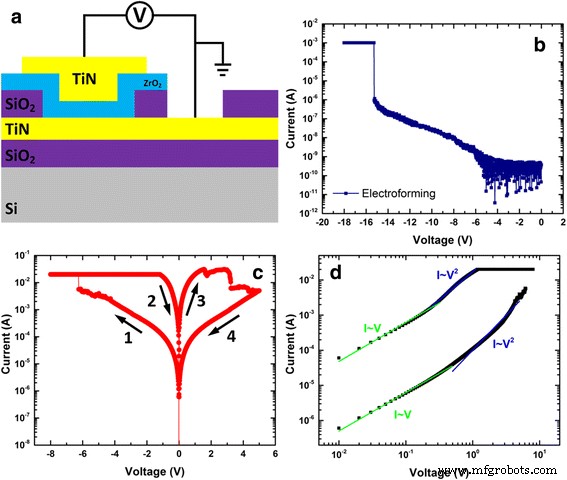
a Esquema da camada única TiN / ZrO 2 / Dispositivo TiN. b I – V características do processo de eletroformação para o TiN / ZrO 2 / Dispositivo TiN. c I – V características do TiN / ZrO 2 / TiN dispositivo após a formação. d I – V curvas do SET processo em gráfico logarítmico duplo com ajuste linear
Com base nos resultados da caracterização, um mecanismo detalhado de ambos os modos de comutação e a transformação são propostos como mostrado na Fig. 7. Ao aplicar uma tensão de formação negativa, os íons de oxigênio são empurrados para baixo em direção ao eletrodo inferior, enquanto os vazios de oxigênio migram para o topo eletrodo e formar um filamento condutor. O TiO interfacial x N y camada desempenha um papel crucial no comportamento bipolar, pois serve como um reservatório de oxigênio [38, 44]. Dois filamentos fracos são gerados consecutivamente no ZrO inferior e superior 2 camadas, caracterizadas pelo processo de formação de duas etapas (Fig. 7b, c). Embora alguns íons de oxigênio possam ter sido injetados no ZrO do meio 2 - x camada, o nível de vacâncias de oxigênio ainda é alto o suficiente para manter a camada em um estado de baixa resistência. Portanto, o dispositivo foi comutado para o LRS (Fig. 7c). Quando uma polarização positiva é aplicada, os íons de oxigênio são atraídos do TiO x N y camada para o ZrO 2 - x camada, resultando na formação de uma camada rica em oxigênio. Esta modulação estequiométrica do ZrO 2 - x camada muda a memória para HRS (Fig. 7d). Outro viés negativo é necessário para SET o dispositivo em LRS empurrando os íons de oxigênio da camada do meio de volta para o TiO x N y reservatório (Fig. 7e). A propriedade livre de conformidade do dispositivo pode derivar da baixa condutividade dos dois filamentos, que efetivamente servem como resistores em série intrínsecos. A transformação ocorre quando uma polarização significativamente grande é aplicada, o que induz a formação de um filamento muito mais forte e condutor através de toda a estrutura de três camadas (Fig. 7f). A resistência do dispositivo não depende mais do ZrO 2 - x camada, e o modo de comutação é transformado de interfacial para filamentar. O dispositivo pode então ser LIGADO e DESLIGADO usando polarização positiva e negativa, respectivamente (Fig. 7g, h).
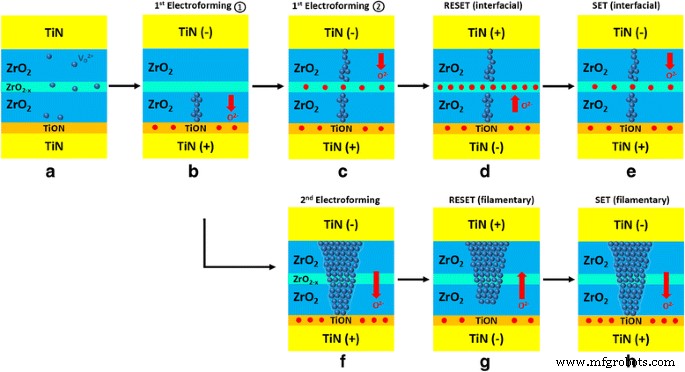
Esquemas do mecanismo de comutação no TiN / ZrO de três camadas 2 / ZrO 2 - x / ZrO 2 Dispositivo / TiN para o modo de comutação interfacial ( a - e ) A transformação do modo interfacial para o modo filamentar ( f ) e o modo filamentar ( g , h )
O modo de comutação interfacial neste trabalho oferece o potencial para armazenamento multiestado. Como a resistência do dispositivo no modo interfacial é mediada pelo nível de íons de oxigênio no ZrO 2 - x camada, multiplica os estados de resistência podem ser alcançados controlando a quantidade de íons de oxigênio na camada do meio usando diferentes RESET tensões. A Figura 8a mostra o I – V características do dispositivo com RESET tensões de 5,0, 5,5 e 6,0 V com um SET constante tensão de −5 V. Vale ressaltar que, como a migração de vacâncias de oxigênio é impulsionada pelo campo elétrico, esses parâmetros são escalonáveis com a espessura da camada. Com uma camada funcional espessa de cerca de 50 nm, este trabalho apresentado ainda tem um bom potencial para diminuir a escala e reduzir significativamente tanto o SET e REINICIAR tensões. A Figura 8b exibe as características de ciclo desta operação de memória multiestado, onde a propriedade de comutação resistiva reversível e reproduzível é demonstrada para ca. 100 ciclos, indicando um comportamento de resistência promissor deste dispositivo.
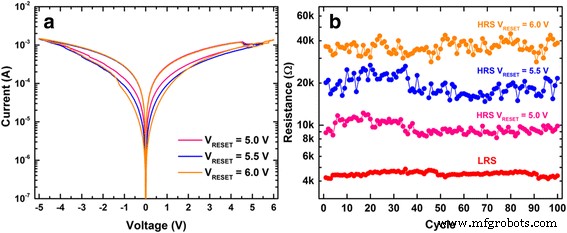
a I – V características da comutação interfacial para TiN / ZrO de três camadas 2 / ZrO 2 - x / ZrO 2 Dispositivo / TiN com RESET variável tensões. b Teste de resistência de 100 ciclos para a comutação interfacial com diferentes RESET tensões
Conclusões
Uma transformação controlável do modo interfacial para o modo interfacial do modo filamentar foi observada em um ZrO 2 / ZrO 2 - x / ZrO 2 memória de três camadas. O possível mecanismo de comutação e transformação é proposto. O ZrO incorporado 2 - x camada é considerada uma camada crucial para o modo de comutação interfacial. Este modo exibe um comportamento livre de conformidade, possivelmente devido ao resistor em série intrínseco pelos dois filamentos finos formados no ZrO 2 camadas. Ao controlar o RESET tensões, resistências multiestado em HRS podem ser alcançadas. Esse comportamento de armazenamento multiestado aponta claramente para a capacidade de desenvolver a memória de alto desempenho multiestado de próxima geração.
Abreviações
- ADF-STEM:
-
Microscopia eletrônica de transmissão de varredura de campo escuro anular
- EDX:
-
Espectroscopia de raios-X de dispersão de energia
- HRS:
-
Estado de alta resistência
- IRS:
-
Estado de resistência intermediária
- LRS:
-
Estado de baixa resistência
- RRAM:
-
Memória de acesso aleatório resistiva
- SCLC:
-
Corrente limitada de carga espacial
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- XRD:
-
Difração de raios X
Nanomateriais
- Uma SRAM 4T integrada RRAM com carga de comutação resistiva autoinibida por processo lógico CMOS puro
- Um estudo coletivo sobre modelagem e simulação de memória de acesso aleatório resistiva
- Conversor de polarização com birrefringência controlável baseado em metassuperfície híbrida totalmente dielétrica-grafeno
- Efeito de campo ferroelétrico Efeito de comutação assimétrica resistiva induzida em BaTiO3 / Nb:SrTiO3 Heterojunções epitaxiais
- Um estudo da variabilidade na memória de acesso aleatório resistiva de contato por modelo de vacância estocástica
- Fabricação de padrões de comutação ótica com microfibras estruturais coloridas
- Funções duplas do dispositivo V / SiOx / AlOy / p ++ Si como seletor e memória
- Investigação da Faixa de Energia nas Heterojunções de Bissulfeto de Molibdênio e ZrO2
- Aprimoramento dielétrico de capacitores de Al2O3 / ZrO2 / Al2O3 MIM depositados na camada atômica por recozimento por micro-ondas
- Ge pMOSFETs de alta mobilidade com dielétrico ZrO2:Impactos do pós-recozimento



