Avanços recentes nos contatos β-Ga2O3 – Metal
Resumo
Óxido de beta-gálio de banda ultralarga (β-Ga 2 O 3 ) tem atraído atenção considerável como um material semicondutor promissor para a eletrônica de potência de próxima geração. Possui excelentes propriedades de material, como um largo bandgap de 4,6-4,9 eV, um campo elétrico de alta degradação de 8 MV / cm e a excepcional figura de mérito de Baliga (BFOM), juntamente com estabilidade química e térmica superior. Essas características sugerem seu grande potencial para futuras aplicações em dispositivos optoeletrônicos e de energia. No entanto, a questão crítica dos contatos entre o metal e Ga 2 O 3 limita o desempenho de β-Ga 2 O 3 dispositivos. Neste trabalho, revisamos os avanços nos contatos de β-Ga 2 O 3 MOSFETs. Para melhorar as propriedades de contato, quatro abordagens principais são resumidas e analisadas em detalhes, incluindo pré-tratamento, pós-tratamento, eletrodo de metal multicamada e introdução de uma camada intermediária. Em comparação, os dois últimos métodos estão sendo estudados de forma intensiva e mais favorável do que o pré-tratamento que inevitavelmente geraria danos incontroláveis. Finalmente, são apresentadas as conclusões e as perspectivas futuras para melhorar os contatos ôhmicos.
Introdução
Recentemente, óxido de gálio (Ga 2 O 3 ) foi considerado um candidato promissor para a preparação de dispositivos de alta potência e alta eficiência em virtude de suas excelentes propriedades de material [1,2,3]. Ga 2 O 3 tem cinco polimorfos diferentes, designados como α-Ga 2 O 3 , β-Ga 2 O 3 , γ-Ga 2 O 3 , δ-Ga 2 O 3 , e ε-Ga 2 O 3 , entre os quais β-Ga 2 O 3 é o mais termodinamicamente estável e tem sido amplamente estudado [4]. Com bandgap ultra-largo de 4,6-4,9 eV [5,6,7], o campo elétrico de quebra teórica ( E br ) de 8 MV / cm para β-Ga 2 O 3 é cerca de três vezes maior do que o de SiC ou GaN [8,9,10], o que permite β-Ga 2 O 3 com base em dispositivos para lidar com tensões de comutação gigantescas. A adequação dos semicondutores para aplicações de dispositivos de potência é geralmente avaliada pela figura de mérito de Baliga (BFOM) [11]. O BFOM de β-Ga 2 O 3 é quase o triplo do SiC e GaN, reduzindo significativamente a perda de condução [3, 12,13,14]. Além disso, a velocidade do elétron de saturação é teoricamente estimada em cerca de 2 × 10 7 cm / s, tornando-o atraente para operações de alta frequência [15,16,17,18,19,20]. Outro interesse distinto de β-Ga 2 O 3 entre os semicondutores de largura de banda larga é que cristais únicos de alta qualidade podem ser sintetizados de maneira econômica usando técnicas de crescimento por fusão [21,22,23,24]. Além disso, de alta qualidade tipo n β-Ga 2 O 3 filmes epitaxiais podem ser realizados por dopagem precisa com Sn, Si, Ge e Mg, e a densidade de elétrons obtida varia de 10 16 a 10 19 cm −3 [25,26,27,28]. Por causa das vantagens acima mencionadas sobre outros semicondutores de gap largo, β-Ga 2 O 3 mostra suas capacidades de ser um material promissor para eletrônica de potência, bem como para ambientes extremos (alta temperatura, alta tensão e alta radiação) [29,30,31].
Muitos promissores β-Ga 2 O 3 dispositivos foram relatados, incluindo diodos de barreira Schottky [32], MOSFETs [1,2,3] e vários tipos de fotodetectores cegos ao sol [33, 34]. Entre esses dispositivos, os MOSFETs são a configuração mais prevalente para operação de radiofrequência e alta potência [35], dando plena execução ao seu E alto br e BFOM. No entanto, um dos desafios para β-Ga 2 O 3 aplicação em dispositivos MOSFET é a dificuldade em formar contatos ôhmicos em comparação com semicondutores de bandgap estreito [36]. Normalmente, um excelente contato ôhmico entre o semicondutor e o eletrodo de metal é essencial para dispositivos semicondutores de alto desempenho [37, 38]. Contatos de baixa resistência podem reduzir a queda de tensão no contato e, consequentemente, aumentar a tensão no canal, garantindo a densidade de corrente projetada e altas velocidades de chaveamento. Além disso, os contatos de baixa resistência contribuem para a redução da geração de calor que pode agravar o efeito de autoaquecimento.
Consequentemente, a fabricação de contatos ôhmicos de alta qualidade é um pré-requisito para a obtenção de dispositivos de alto desempenho. Nesta revisão, começamos com os conceitos fundamentais de contatos de metal / semicondutor. Na seção “Abordagens para contatos ôhmicos”, um resumo dos avanços significativos recentes nos contatos ôhmicos para β-Ga 2 O 3 é apresentado, e abordagens para contatos ôhmicos são discutidas e analisadas. Finalmente, algumas perspectivas são fornecidas para melhorar os contatos ôhmicos para β-Ga 2 O 3 no futuro.
Física Básica de Contatos Ómicos
Um contato ôhmico é uma junção de metal / semicondutor na qual não há barreira na interface impedindo o transporte de portadoras, conforme ilustrado na Fig. 1a. Pelo contrário, uma barreira de energia existente na interface inibirá o transporte de portadores entre o metal e o semicondutor, como é evidente na Fig. 1b. Notavelmente, os contatos formados entre semicondutores de largo bandgap e metais são sempre Schottky. Assim, a resistência de contato normalmente depende da altura da barreira de Schottky de metal / semicondutor (SBH) Φ B . Para um semicondutor do tipo n, ele obedece à equação:
$$ {q \ Phi} _B ={q \ Phi} _m - {\ chi} _s $$ (1)
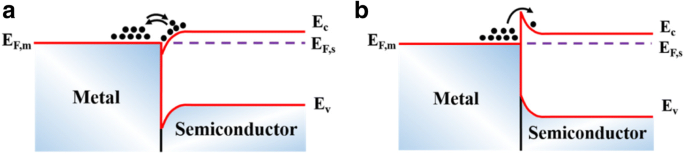
Ilustrações esquemáticas de a Contatos ómicos e b Contatos Schottky. E C , E V , E F , m , e E F , s são os níveis de energia da borda da banda de condução, borda da banda de valência, energia Fermi do metal e do semicondutor, respectivamente
onde Φ m é a função de trabalho do metal e χ s é a afinidade eletrônica do semicondutor.
Conforme descrito na Eq. (1), é importante reduzir o SBH para formar o contato ôhmico. Além disso, alto dopagem em semicondutores pode facilitar a formação de contatos ôhmicos, por exemplo, para semicondutores fortemente dopados (N D > ~ 10 18 cm −3 ), a barreira se tornará estreita o suficiente e permitirá que os elétrons diretamente para um túnel através da interface devido à curvatura significativa da banda de condução [39], como mostrado na Fig. 2. No entanto, os níveis de dopagem que podem ser alcançados em β- Ga 2 O 3 geralmente estão abaixo do que pode ser obtido em Si, como é o caso de outros semicondutores largos. Fora isso, os estados de superfície também desempenham um papel importante na formação de contatos ôhmicos que são frequentemente definidos como regiões de recombinação de alta taxa. Esses níveis de defeito de bandgap médio induzidos pelos estados de superfície são capazes de ajudar no transporte dos portadores. Isso implica que um bom contato ôhmico pode ser formado pela introdução de estados de superfície apropriados nos semicondutores [40,41,42,43].
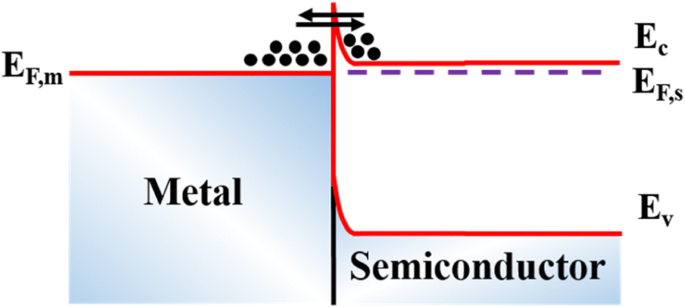
O diagrama de banda de energia na interface metal / semicondutor com semicondutores altamente dopados
Uma quantificação elétrica das características do contato é necessária para avaliar a qualidade dos contatos. Atualmente, a resistividade de contato específica ρ C é um dos parâmetros comumente usados para acessar o desempenho de contatos ôhmicos, normalmente expresso em Ω ∙ cm 2 [44]. A resistividade de contato específica é uma quantidade muito útil que é independente da geometria do contato e se refere apenas à interface metal / semicondutor. Até agora, o menor ρ C de 4,6 × 10 −6 Ω ∙ cm 2 foi relatado para contatos Ti / Au para β-Ga 2 O 3 [45]. Wong et al. também obteve um baixo ρ C de 7,5 × 10 −6 Ω ∙ cm 2 com contatos Ti / Au [46]. Até agora, muitos esforços têm sido dedicados para obter o contato com baixo ρ C , e os valores típicos para resistividades de contato específicas espalhadas por um intervalo de 10 −5 –10 −6 Ω ∙ cm 2 para bons contatos ôhmicos [36].
Abordagens para contatos ôhmicos
Até o momento, as investigações sobre as propriedades intrínsecas de β-Ga 2 O 3 principalmente foram realizados em sua estrutura MOSFET, em que dois tipos de método de síntese de canal são geralmente adotados. Um é o floco esfoliado micromecanicamente (nanomembrana); o outro é o epitaxial β-Ga 2 O 3 filme em seu substrato nativo, conforme resumido na Tabela 1.
Normalmente, esfoliado β-Ga 2 O 3 flocos podem ser transferidos para qualquer substrato de forma conveniente e econômica. Verificou-se que as propriedades do material de β-Ga 2 O 3 flocos não degeneram durante a esfoliação, como evidenciado por espectroscopia Raman e microscopia de força atômica [19], o que significa que o desempenho dos MOSFETs baseados nos flocos esfoliados é comparável àquele baseado nas camadas epitaxiais. Devido a essas vantagens, este método é recomendado para estudar as características elétricas que consistem na densidade de defeitos interfaciais, tensão de ruptura, espalhamento de fônon óptico de superfície [47,48,49] e propriedade térmica, ou seja, efeito de autoaquecimento [50, 51].
Conforme resumido na Tabela 1, os métodos empregados para melhorar os contatos ôhmicos podem ser geralmente categorizados em três tipos:(1) pré-tratamento, (2) pós-tratamento e (3) eletrodo de metal multicamada. Além disso, a introdução de uma camada intermediária também pode obter contatos ôhmicos superiores, o que não é mostrado na Tabela 1.
Pré-tratamento
O pré-tratamento é realizado antes da deposição do metal, incluindo implantação de íons, bombardeio de plasma e corrosão de íons reativos (RIE). Higashiwaki et al. demonstraram que os contatos formados pelo uso da pilha Ti / Au com o processo de pré-tratamento RIE apresentaram comportamento quase ôhmico, enquanto a amostra sem o tratamento RIE apresentou comportamento Schottky, conforme ilustrado na Fig. 3 [1]. A diferença significativa pode ser atribuída à difusão dos átomos de oxigênio livres gerados através do bombardeio contínuo quebrando as ligações Ga – O expostas, deixando muitos vazios de oxigênio que atuam como doadores em β-Ga 2 O 3 . Por outro lado, o tratamento RIE contínuo também geraria estados de superfície consideráveis que desempenham um papel importante durante a formação do contato [41]. A Figura 4 mostra as características de saída DC associadas a partir das quais a corrente quase linear em baixa tensão de dreno pode ser observada. Em seu trabalho posterior, como demonstrado na Fig. 5, as características de saída exibiram boa relação de linearidade entre a corrente e a tensão de dreno em que a implantação de íons de Si e RIE foram aplicados a β-Ga 2 O 3 juntos e uma resistividade de contato específica extremamente baixa de 8,1 × 10 −6 Ω ∙ cm 2 foi alcançado [12]. Obviamente, o comportamento ôhmico obtido por RIE e Si + a implantação em conjunto superaria o desempenho do RIE apenas uma vez que os átomos de Si são conhecidos por serem doadores superficiais com pequenas energias de ativação em β-Ga 2 O 3 [34]. Além disso, Zhou et al. relatou o β-Ga 2 de alto desempenho O 3 transistores de efeito de campo com bombardeio de plasma Ar antes da deposição de metal de contato [52]. Ao contrário, a amostra sem bombardeio de Ar exibiu contato de Schottky. A diferença pode ser atribuída à geração de vacâncias de oxigênio e estados de superfície durante o processo de bombardeio de plasma Ar, o mesmo que o tratamento RIE.
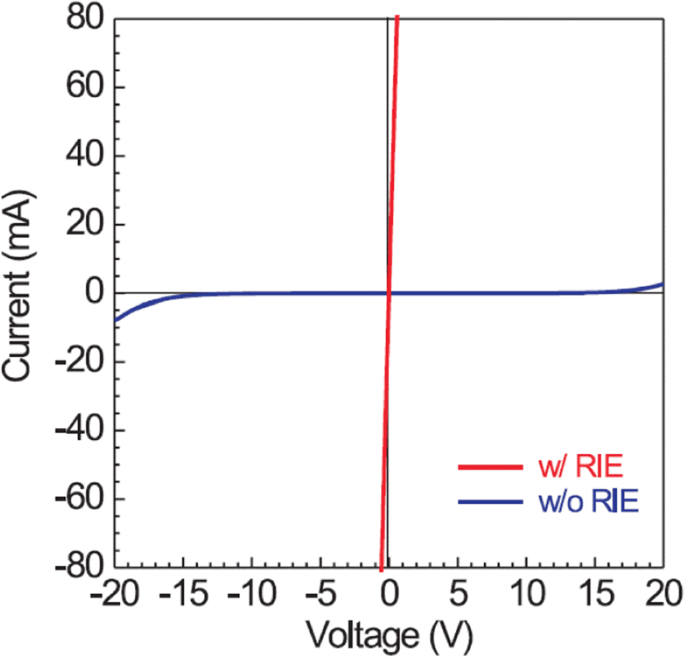
(Cor online) Curvas I – V medidas entre dois contatos (Ti / Au conforme depositado) fabricados com e sem tratamento RIE em n-Ga 2 O 3 substratos. Reproduzido da Ref. [1]
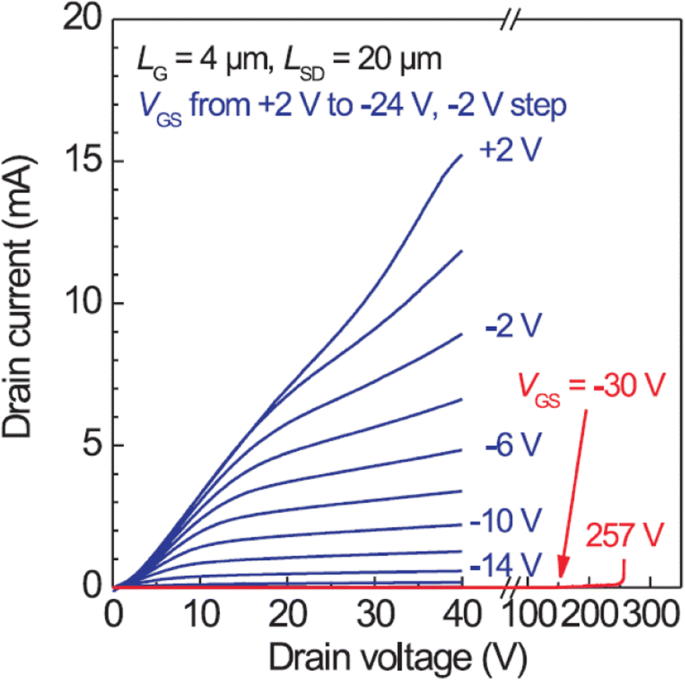
(Cor online) Características de saída DC de Ga 2 O 3 transistores de efeito de campo de metal / semicondutor. Reproduzido da Ref. [1]
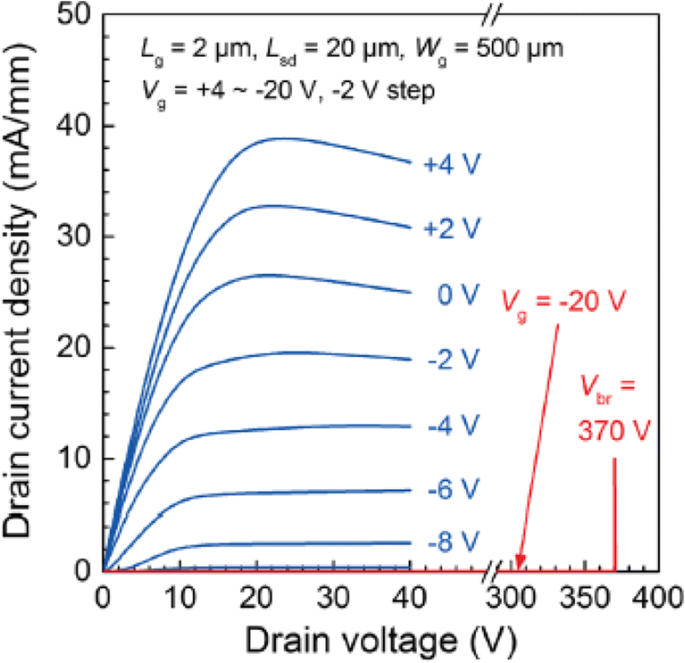
Curvas DC I – V de Ga 2 O 3 MOSFET ( L g =2 μm) medido em RT. Reproduzido da Ref. [12]
Embora as técnicas acima mencionadas possam melhorar o desempenho dos contatos ôhmicos, tais tecnologias não são praticamente aplicáveis porque o dano induzido é geralmente a última coisa que os engenheiros de processo desejam em dispositivos semicondutores e, além disso, os contatos ôhmicos induzidos por dano nem sempre são reproduzíveis.
Por esta razão, além das técnicas tradicionais mencionadas usadas frequentemente para formar contatos ôhmicos de baixa resistência, uma técnica relativamente nova - dopagem spin-on-glass (SOG) - foi recentemente adotada [53], e uma resistividade de contato específica de 2,1 ± 1,4 × 10 −5 Ω ∙ cm 2 foi alcançado, o que verificou a eficácia da técnica de dopagem SOG. A Figura 6 mostra as características de saída de β-Ga dopado com SOG 2 O 3 MOSFETs que exibiram excelente comportamento linear em baixa tensão de dreno. Comparado com a implantação de íons, o doping SOG reduz a difusão de espécies induzida por danos e diminui os custos ao abandonar o caro implantador de íons. Semelhante às implantações de íons, o princípio básico por trás dessa tecnologia é dopar a região S / D com doadores superficiais. Obviamente, o contato ôhmico superior pode ser alcançado com β-Ga intencionalmente dopado 2 O 3 . Por exemplo, o altamente dopado β-Ga 2 O 3 foi usado para fabricar β-Ga 2 O 3 transistores de efeito de campo com correntes de drenagem superiores a 1,5 A / mm [50]. O recorde de alta corrente de drenagem é devido ao forte doping em β-Ga 2 O 3 o que causa uma camada de depleção muito fina e os elétrons podem criar um túnel facilmente através dessa barreira, levando a um comportamento de contato ôhmico. Curiosamente, a orientação do β-Ga 2 O 3 superfície também pode exercer uma influência no comportamento de contato. Baik et al. relataram que os mesmos eletrodos em β-Ga 2 O 3 mostraram propriedades de contato diferentes, nas quais a amostra em (\ (\ overline {2} \) 01) substrato se comportou como contatos ôhmicos, enquanto a amostra de controle em (010) exibiu comportamento Schottky. Isso pode ser atribuído a diferentes razões Ga / O e densidade de ligações pendentes em orientações específicas [54].
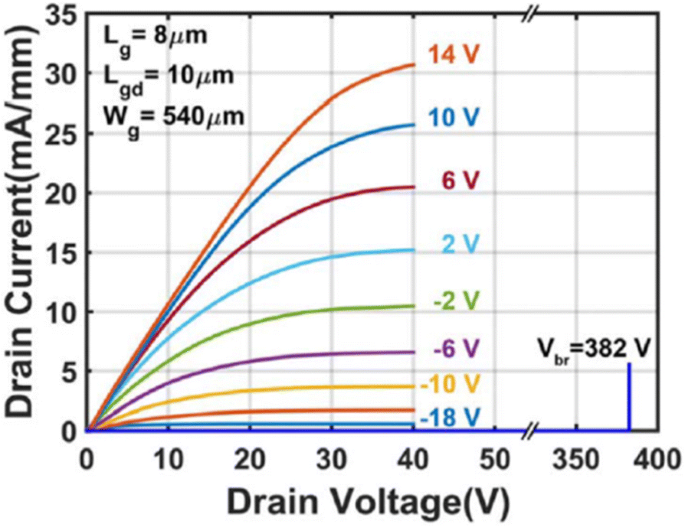
Características de saída do MOSFET dopado com SOG S / D com L g =8 μm, espaçamento da porta de drenagem L gd =10 μm. Reproduzido da Ref. [53]
Pós-tratamento
O pós-tratamento é realizado após a deposição do metal, principalmente referente ao processo de recozimento. O recozimento desempenha um papel na redução do dano induzido por tecnologias de processo anteriores, como implantação de íons e bombardeio de plasma. Além disso, contribui para a formação de uma camada intermediária que pode reduzir a descontinuidade da banda de condução entre o metal e β-Ga 2 O 3 . Notavelmente, os parâmetros incluindo temperatura, atmosfera e tempo de recozimento exercem uma influência importante no desempenho dos dispositivos. O experimento no recozimento no ar e N 2 foi implementado para comparar o efeito da atmosfera de recozimento em β-Ga 2 O 3 com base em contatos ôhmicos [55]. Como pode ser visto na Fig. 7, o desempenho do recozimento em N 2 superou o do ar, o que poderia ser atribuído ao fato de que a pressão parcial de oxigênio no ar suprimiu a formação de vacâncias de oxigênio. No entanto, a dependência das características de contato na temperatura, atmosfera e tempo de recozimento nas características de contato não é clara; portanto, é ainda necessário otimizar os parâmetros do processo de recozimento.
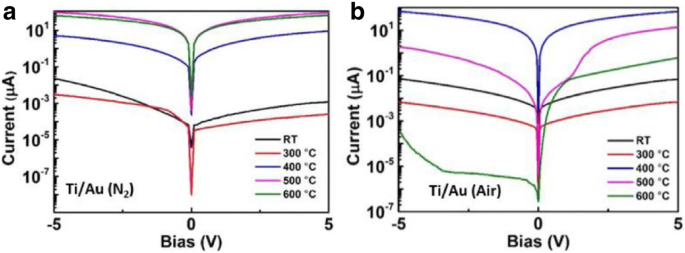
Propriedades elétricas de β-Ga 2 O 3 flocos com atmosfera de recozimento térmico e temperatura de recozimento diferentes. Contatos Ti / Au em a N 2 e b ar. Reproduzido da Ref. [55]
Eletrodo de metal multicamada
Outra abordagem para formar contatos ôhmicos é reduzir o SBH na interface metal / semicondutor. O SBH é igual à diferença entre a função de trabalho do metal e a afinidade eletrônica do semicondutor. Com base neste reconhecimento, pode-se esperar que metais com baixa função de trabalho formem contatos ôhmicos em β-Ga 2 O 3 . No entanto, foi comprovado que a função trabalho não é o fator dominante na formação do contato ôhmico [56].
Nove metais depositados em β-Ga 2 O 3 foram selecionados com base nas propriedades como função de trabalho, temperatura de fusão e estabilidade do óxido [57]. A função de trabalho do metal do Ti e a afinidade eletrônica de β-Ga dopado não intencionalmente 2 O 3 são conhecidos por serem 4,33 eV e 4,00 ± 0,05 eV, respectivamente [19, 58, 59], então uma barreira de 0,22 eV deve existir na interface que leva ao contato Schottky. No entanto, descobriu-se que os contatos de Ti com uma camada de cobertura de Au eram ôhmicos com a resistência mais baixa entre nove metais após o recozimento. Nesse ínterim, Bae et al. explorou a dependência das propriedades de contato no Ti / Au e Ni / Au para dispositivos baseados no β-Ga esfoliado 2 O 3 flocos [55]. Foi observado que o desempenho dos MOSFETs com eletrodos de metal Ti / Au superou aqueles com eletrodos de metal Ni / Au sob a mesma condição de recozimento. No início, considerou-se que as funções de trabalho de Ni e Ti são 5,01 eV e 4,33 eV, respectivamente, então Ti pode formar um contato ôhmico mais facilmente do que Ni; no entanto, estudos através da espectroscopia dispersiva de energia (EDS) demonstraram que a porcentagem atômica de oxigênio no β-Ga 2 O 3 região diminuiu enquanto a porcentagem atômica de oxigênio no Ti perto da interface aumentou após o recozimento, como ilustrado na Fig. 8 [55]. Este fenômeno é atribuído à difusão externa de átomos de oxigênio de β-Ga 2 O 3 em metal Ti, levando à formação de lacunas de oxigênio atuando como doadores. Além disso, durante o processo de recozimento, a difusão acelerada de átomos de oxigênio em β-Ga 2 O 3 poderia reagir com Ti e formar Ti 2 O 3 que é útil para formar contatos ôhmicos devido à sua baixa função de trabalho (3,6–3,9 eV). Portanto, a reação interfacial entre metais e β-Ga 2 O 3 é um fator importante na formação de contatos ôhmicos na interface metal / semicondutor.
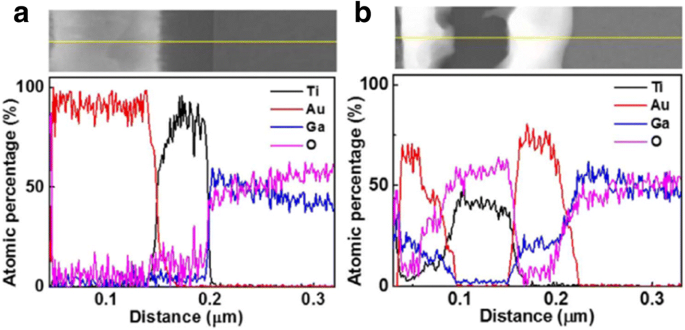
Perfis de porcentagem atômica por EDS de metalização e β-Ga 2 O 3 a pré- e b pós-recozimento a uma temperatura de 500 ° C. Reproduzido da Ref. [55]
Além disso, descobriu-se que a maioria dos eletrodos de metal Ti / Au usados para formar contatos ôhmicos foram recozidos a 450 ° C [45, 53] ou 470 ° C [12, 46, 57, 60] por processo térmico rápido. Um comportamento de degradação semelhante das características de contato foi observado quando o recozimento foi realizado acima de 500 ° C na Ref. [55, 56], conforme ilustrado nas Figs. 7 e 9, respectivamente. Yao et al. especularam que uma camada de óxido isolante foi formada possivelmente em temperatura elevada de recozimento, resultando nos contatos deteriorados. No entanto, Bae et al. observaram que a superfície do metal depositado era muito mais áspera após 700 ° C recozimento devido à mistura de metais e à difusão de átomos de gálio e oxigênio em eletrodos de metal, que foi apontado como a razão para o comportamento de degradação. Obviamente, os mecanismos de degradação dos contatos Ti / Au para β-Ga 2 O 3 após o recozimento de alta temperatura ainda estão em debate.
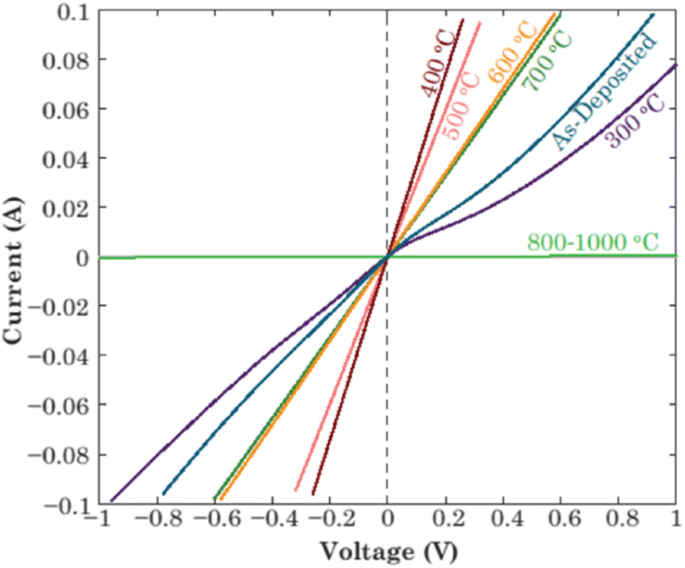
Gráficos I – V para contatos Ti / Au em dopado com Sn (\ (\ overline {2} \) 01) Ga 2 O 3 wafer em função da temperatura de recozimento em Ar (tempo de recozimento 1 min). Reproduzido da Ref. [56]
β-Ga 2 O 3 Dispositivos baseados em Ti / Au não podem atender a demanda para trabalho sob alta temperatura. Portanto, para evitar a degradação das características de contato em temperatura elevada de recozimento, pilhas de metal mais complexas devem ser adotadas. De longe, Ti / Al / Au [50, 52], Ti / Au / Ni [61, 62] e pilhas de metal Ti / Al / Ni / Au [13, 21, 63, 64] têm sido empregados para formar eletricidade contatos em β-Ga 2 O 3 . Mas uma comparação abrangente das características de contato entre essas pilhas de metal ainda é insuficiente.
Mohammad [65] e Greco et al. [36] discutiram o papel de cada camada de metal nas pilhas de metal complexas, fornecendo algumas orientações para melhorar os contatos ôhmicos. O esquema das pilhas de metal é mostrado na Fig. 10. Observe que esta abordagem está sendo desenvolvida atualmente para dispositivos de energia baseados em GaN [66,67,68,69].
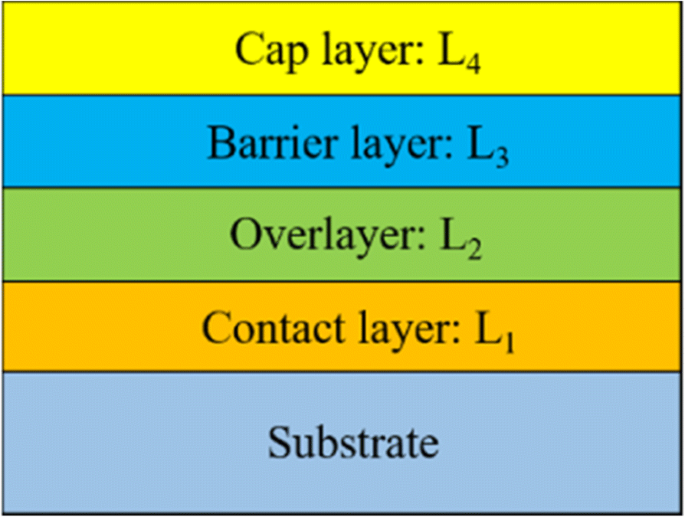
O esquema de pilhas de metal para a obtenção de contatos ôhmicos para semicondutores de largo bandgap
A primeira camada de metal no substrato, conhecida como camada de contato, deve ter uma função de trabalho baixa e boa adesão ao substrato. Além disso, também pode bloquear a difusão de metais da camada superior com grandes funções de trabalho para o substrato. Atualmente, Ti é o principal metal como camada de contato para β-Ga 2 O 3 devido a sua baixa função (4,33 eV) e boa adesão ao substrato. Além disso, a formação de Ti 2 O 3 e Ti 3 O 5 com funções de trabalho menores que o Ti na interface é favorecido na formação de contatos ôhmicos, uma vez que os óxidos reduzem a SBH e deixam vagas de oxigênio atuando como doadoras. No entanto, outros metais com funções de baixo trabalho, incluindo Ta (3,1 eV) e Hf (3,9 eV), ainda não foram explorados. A segunda camada com baixa função de trabalho deve ser capaz de formar compostos intermetálicos com a camada de contato para evitar sua difusão na interface. Atualmente, Al é usado como camada de cobertura, uma vez que pode atender a esses requisitos. A terceira camada de metal (camada de barreira) serve ao propósito de limitar a difusão interna da camada metálica superior e a difusão externa das camadas metálicas inferiores [70, 71]. Ni é a camada de barreira mais comumente usada para β-Ga 2 O 3 . Existem outros bons candidatos, como Mo, Nb e Ir com pontos de fusão elevados para substituir o Ni, os quais devem ter menor reatividade e solubilidade para Au do que Ni [72,73,74,75]. A quarta camada de cobertura atua como uma camada protetora para prevenir ou minimizar a oxidação dos metais subjacentes. Na prática, Au é comumente empregado para servir a esse propósito.
Apresentando um intercalar
Existem basicamente dois métodos de introdução de uma camada intermediária no metal / β-Ga 2 O 3 interface. Um é formar uma camada semicondutora intermediária (ISL) com baixa função de trabalho por recozimento, por exemplo, Ti 2 O 3 . A outra é inserir o ISL depositado entre o metal e β-Ga 2 O 3 , que tem sido intensamente estudado [76,77,78]. Comparado com o primeiro método, o último é mais favorável para formar contatos ôhmicos devido à alta concentração de portadores de ISL. Os bandgaps dos ISLs variam de 3,5 a 4,0 eV [79,80,81], como AZO (~ 3,2 eV) [82], In 2 O 3 (~ 2,9 eV) [83, 84] e IGZO (~ 3,5 eV) [85]. Normalmente, os SBHs de vários metais depositados em β-Ga 2 O 3 estão na faixa de 0,95-1,47 eV [86, 87], como mostrado na Fig. 11a. No entanto, a incorporação de um ISL fino reduz o SBH, facilitando o transporte de elétrons do metal para a banda de condução de β-Ga 2 O 3 , conforme ilustrado na Fig. 11b. Além disso, a alta densidade de elétrons no ISL pode reduzir ainda mais a resistência de contato.
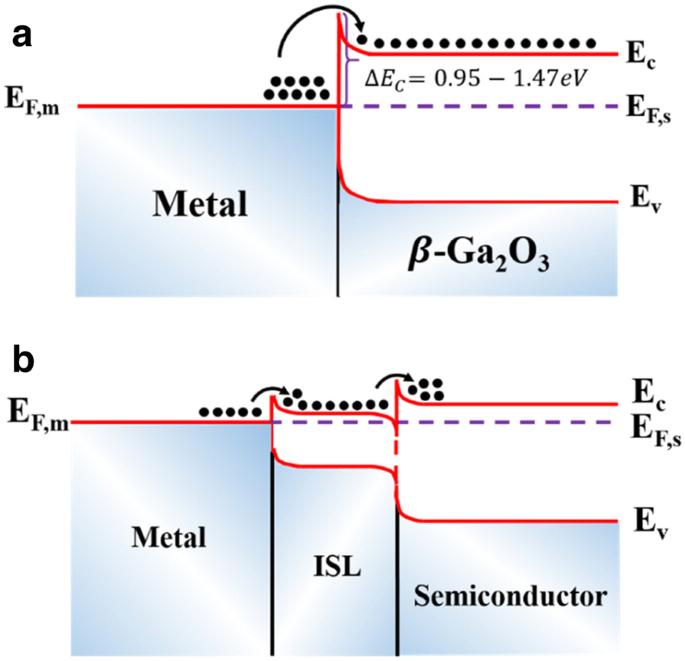
O esquema de deslocamentos de banda para a metal / β-Ga 2 O 3 e b metal / ISL / β-Ga 2 O 3 . ∆E c é igual à diferença de energia entre a energia Fermi dos metais e a banda de condução dos semicondutores
Ultimamente, AZO / Ti / Au foi usado como eletrodos no Si + -implantado β-Ga 2 O 3 , e a resistividade de contato específica obtida foi 2,82 × 10 −5 Ω ∙ cm 2 após o recozimento [76]. Oshima et al. alcançou contatos óhmicos de platina / índio-estanho (Pt / ITO) para β-Ga 2 O 3 com uma ampla faixa de janela de temperatura de processo [77]. A grande janela de processo de 900–1150 ° C permite a realização de operação em alta temperatura. E eletrodos ITO / Ti / Au para β-Ga 2 O 3 também foram demonstrados por Carey et al. [78] em que a amostra mostrou comportamento ôhmico com ρ C de 6,3 × 10 - 5 Ω ∙ cm 2 após o recozimento. Sem o ITO, o mesmo recozimento não forneceu características lineares de corrente-tensão. Esses resultados verificam a eficácia da adição de ISL para a obtenção de contatos ôhmicos.
Notavelmente, uma bolha na superfície dos contatos ITO / Ti / Au foi observada enquanto nenhum borbulhamento na única camada de ITO sem camada de metal acima [78]. Foi considerado o resultado da difusão de átomos de oxigênio na camada de ITO para as camadas superiores de metal. Portanto, é necessário escolher metal apropriado ou pilhas de metal como camadas de cobertura em ITO para prevenir a degradação da morfologia da superfície.
Conclusões
Neste trabalho, resumimos o progresso significativo em P&D de β-Ga 2 O 3 MOSFETs. No entanto, os contatos em β-Ga 2 O 3 são um dos principais problemas que limitam sua aplicação potencial como dispositivos de alta frequência e alta tensão no futuro. Embora esta revisão forneça uma visão geral dos métodos de última geração para formar contatos ôhmicos, ainda há muito espaço a ser explorado e um conjunto de perspectivas concisas pode ser digerido da seguinte forma:(i) A dependência da temperatura e o mecanismo de degradação das características de contato precisa de mais investigações para um claro esclarecimento; (ii) Metais com baixa função de trabalho como Ta e Hf e metais com alto ponto de fusão como Mo, Nb e Ir são dignos de serem peneirados para servir como camada de contato e camada de barreira, respectivamente; (iii) As pilhas de metal ideais em β-Ga 2 O 3 não foram totalmente realizados ainda, e um estudo abrangente e sistemático de pilhas de metal para β-Ga 2 O 3 é imperativo para alcançar contatos ôhmicos de baixa resistência e termicamente estáveis; e (iv) Outros ISLs potenciais consistindo de ZnO, IZO, IGZO, etc. permanecem inexplorados, bem como a influência da espessura variável e proporção de ingredientes de ISLs no desempenho dos contatos. Em resumo, os estudos sobre contatos ôhmicos para β-Ga 2 O 3 ainda são bastante superficiais; acreditamos que este tópico continuará a ser uma das questões em foco no futuro. Esperançosamente, as abordagens para formar contatos ôhmicos apresentadas nesta revisão seriam fundamentais para alcançar β-Ga 2 de alto desempenho O 3 dispositivos.
Nanomateriais
- Contatos de tungstênio para aparelhos elétricos
- Mudar design de contato
- Funções de lógica digital
- Os fabricantes impulsionam mais avanços no flash 3D NAND
- Monitorando os avanços do dispositivo médico
- Artigos recentes detalham a escalabilidade do nanotubo de carbono, avanços de integração
- Os 10 principais avanços na tecnologia de fabricação de compósitos
- Avanços e desafios dos nanomateriais fluorescentes para aplicações biomédicas e de síntese
- 5 Grandes Leituras Recentes na Convergência de TI/OT
- 5 Grandes Leituras Recentes em IIoT



