Recombinação controlada por tensão em poços quânticos múltiplos de InGaN / GaN em substratos de silício
Resumo
Este artigo relata as propriedades de fotoluminescência (PL) de diodos emissores de luz de poço quântico múltiplo InGaN / GaN (MQW) crescidos em substratos de silício que foram projetados com diferentes arquiteturas de controle de tensão de tração, como Si δ-dopagem periódica para a camada de GaN tipo n ou inserir a camada InGaN / AlGaN para investigar o mecanismo de recombinação controlada por cepa no sistema. Os resultados de PL revelaram que as amostras liberadas por tensão de tração tiveram melhores desempenhos de PL, pois suas eficiências quânticas externas aumentaram para 17%, 7 vezes maior do que a da amostra regular. A análise detalhada confirmou que eles tinham taxas de recombinação não radiativa menores ((2,5 ~ 2,8) × 10 −2 s −1 em comparação com (3,6 ~ 4,7) × 10 −2 s −1 ), que foi associada à melhor qualidade cristalina e ausência de luxações ou fissuras. Além disso, suas taxas de recombinação radiativa foram consideradas mais estáveis e foram muito maiores ((5,7 ~ 5,8) × 10 −3 s −1 em comparação com [9 ~ 7] × 10 −4 s −1 ) à temperatura ambiente. Isso foi atribuído à supressão de estados localizados rasos em interfaces MQW, deixando os centros de localização radiativa profundos dentro das camadas InGaN dominando a recombinação radiativa.
Histórico
Estruturas de poço quântico múltiplo InGaN / GaN (MQW) crescidas em substratos de silício em vez de safira convencional têm atraído atenções crescentes para suas aplicações potenciais em iluminação de estado sólido de baixo custo, exibição de painel e fotônica de silício [1,2,3,4, 5]. O obstáculo crítico na fabricação de filme de GaN de alta qualidade sobre Si é a incompatibilidade de expansão térmica (56%) entre GaN e Si, que introduziu grande tensão de tração e rachaduras nos filmes de GaN crescidos [6,7,8,9]. Além disso, uma camada de GaN tipo n dopada com Si abaixo das camadas MQW é necessária para diodos emissores de luz (LEDs) ou diodos laser (LDs). Nestes casos, a tensão de tração adicional de dopagem de Si será trazida. Nos últimos anos, esforços têm sido feitos para superar essas dificuldades por meio do uso de camadas intermediárias com tensão de compressão adequada para contrabalançar a tensão de tração [10,11,12,13,14, 15,16], dopagem delta para relaxamento de deformação [17, 18], ou a deposição de camada tampão combinada de rede [19, 20]. De acordo com trabalhos anteriores [17], a arquitetura periódica de dopagem com Si δ da camada de GaN do tipo n poderia atingir uma camada de GaN mais lisa com maior qualidade cristalina e menor densidade de trinca do que em GaN uniformemente dopado com Si. Isso foi atribuído à redução da tensão de tração. Vários trabalhos foram feitos para examinar a morfologia da superfície, densidade de deslocamento e propriedades elétricas de GaN / Si cristalino δ-doping GaN camadas em safira [21, 22] ou substratos de silício [23]. Infelizmente, poucos deles investigaram diretamente as propriedades de luminescência de estruturas MQW InGaN / GaN no topo de uma camada de GaN de dopagem com Si δ e esclareceram a relação entre o aumento da eficiência da luminescência e a liberação de tensão causada pelas melhorias na estrutura do filme, que são críticas para o dispositivo fabricação. Também vale a pena mencionar que, medir diretamente a deformação ou observar as distorções da rede sem quebrar as amostras de LED é difícil. Métodos indiretos são sempre aplicados para avaliar a deformação interna. Por exemplo, pressão mecânica foi aplicada para modular a deformação interna, o que levou às mudanças do campo piezoelétrico dentro de MQWs, bem como ao desempenho optoeletrônico de dispositivos LED [24,25,26,27]. Em qualquer um desses casos, as medições dos espectros de luminescência foram consideradas indispensáveis para avaliar o desempenho do dispositivo relacionado à deformação.
Portanto, neste trabalho, estruturas de LED MQW InGaN / GaN foram depositadas em substratos de silício cristalino. Tanto GaN uniformemente dopado com Si quanto GaN dopado com Si δ periódico trabalhando como camada de GaN tipo n foi cultivado para comparação. Além disso, mais duas amostras de controle baseadas em camadas de GaN tipo n dopadas uniformemente com Si, inseridas por uma camada fina de AlGaN ou InGaN respectivamente, também foram preparadas para apoiar a análise da influência da tensão de compressão ou tensão no desempenho do dispositivo, como AlGaN tem constante de rede menor do que GaN, o que irá liberar parcialmente a tensão de tração na superfície, assim como a camada inserida de InGaN agravará a tensão de tração ao contrário. Eficiências de fotoluminescência relativa (PL) e tempos de vida de recombinação (taxas) para cada amostra foram extraídas de espectros de PL em estado estacionário com variação de temperatura (SS) e espectros de PL resolvidos no tempo (TR) e, em seguida, analisados sistematicamente. Os resultados revelaram que as amostras liberadas por tensão de tração tiveram melhores desempenhos de PL, uma vez que tanto a recombinação não radiativa relacionada aos defeitos estruturais foram a supressão e a recombinação radiativa estão mais conectadas a estados de recombinação profunda dentro das camadas do poço InGaN, o que levou à recombinação radiativa que são mais estáveis com a temperatura .
Métodos
Conforme mostrado no esquema da Fig. 1, o crescimento epitaxial de InGaN / GaN MQWs foi realizado por deposição de vapor químico orgânico de metal que foi relatado em trabalho anterior [17]:camada de AlN de 100 nm, camada de AlGaN de 660 nm linearmente graduada e 200 A camada de GaN nominalmente não dopada de nm foi cultivada no substrato de Si (111) como o tampão a 1060, 1060 e 1020 ° C, respectivamente. Para as amostras S1, S3 e S4, camada de GaN uniformemente dopada com 1 μm de Si foi depositada no tampão com a concentração de átomos de Si estimada em torno de 10 18 cm −3 . Para as amostras S3 e S4, a camada inserida de 20 nm InGaN com In% ~ 10at% ou camada inserida de 20 nm AlGaN com Al% ~ 20% foi depositada após a camada de GaN uniformemente dopada com Si tipo n. Para a amostra S2, 20 períodos de planos dopados com Si δ, cada um seguido por GaN nominalmente não dopado de 50 nm com uma espessura total de 1 μm em vez de camada de GaN uniformemente dopada com Si foi cultivada no tampão. Depois disso, em cada amostra de S1-S4, 6 períodos de InGaN / GaN QWs foram cultivados a 800 ° C, em que a composição do índio é em torno de 22,0at%. A espessura média do poço / barreira foi estimada em 2,4 nm / 10 nm. Depois disso, camadas de GaN tipo p dopadas com Mg de 220 nm foram cultivadas a 1020 ° C. Para os testes de espectro PL, um sistema Zolix-750 PL com um laser pulsado de 10 mW, 377 nm foi usado como recurso de luz de excitação, e um CCD ANDOR Newton com resolução de 0,09 nm foi usado como fotodetector. Em medições TRPL, os decaimentos de PL foram registrados por um sistema de contagem de fóton único correlacionado com o tempo em 10–300 K.
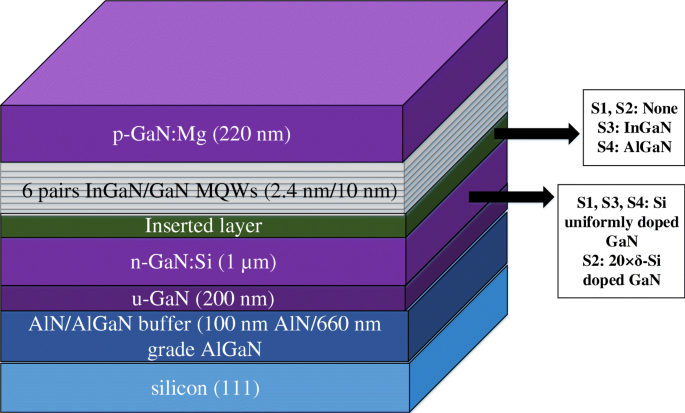
Estruturas das amostras de LED MQW cultivadas em substratos de Si. S1, S3 e S4 contêm 1 μm Si camada de GaN do tipo n uniformemente dopada. S3 contém uma camada inserida de InGaN de 20 nm. S4 contém camada inserida de AlGaN de 20 nm. S2 contém 20 períodos de planos dopados com Si-δ, cada um seguido por GaN nominalmente não dopado de 50 nm com uma espessura total de 1 μm em vez de camada de GaN tipo n uniformemente dopada com Si
Resultados e discussão
A visão geral das propriedades SSPL para cada amostra de MQW testada em 10 K é mostrada na Fig. 2. Como visto na inserção, o MQW original em S1 estruturado com Si exibe picos de emissão em torno de 500-650 nm com oscilação de Fabry-Perot. Os espectros de PL para todas as quatro amostras têm o mesmo caráter. Este fenômeno é comumente observado em LED baseado em GaN crescido em substratos de Si [28,29,30], pois a interface buffer / Si tem grande refletância, então uma fração notável para baixo da intensidade PL de MQWs é refletida e interfere diretamente com o fração. Esses picos de oscilação podem ser descritos simplesmente como sinais PL gaussianos multiplicados pelo item de oscilação (1 + Acos (4 πnd / λ )) (demonstrado como a curva vermelha na inserção da Fig. 1), em que A representa a força de oscilação, n é o índice de refração médio do filme MQW, d é toda a espessura do filme MQW, e λ é o comprimento de onda PL. De acordo com o modelo acima, o pico de PL gaussiano original pode ser ajustado e extraído dos picos de oscilação complexos (demonstrado como a curva azul na inserção da Fig. 1). O resultado SSPL revelou que S1 tem um pico de PL verde nítido em 531 nm, de acordo com a energia do bandgap do cristal InGaN com In% ~ 22at%. Como comparações, S2 com camada de GaN tipo n dopado com Si δ tem um pico PL notavelmente desviado para o vermelho em 579 nm, S3 com camada inserida InGaN tem um pico PL ligeiramente desviado para azul em 517 nm, e S4 com camada inserida com AlGaN tem um PL ligeiramente desviado para o vermelho pico a 545 nm. Considerando que a camada inserida de AlGaN desempenha o papel de liberar a tensão de tração familiarizada com a função de dopagem de Si δ, enquanto a camada inserida de InGaN agrava a tensão de tração, esses resultados indicam que a tensão de tração no substrato levará ao desvio para o azul da posição MQW PL ou alargamento do bandgap médio do poço InGaN. O efeito de liberação de tensão da camada de GaN dopada com Si δ é muito mais forte do que a introdução da camada inserida.
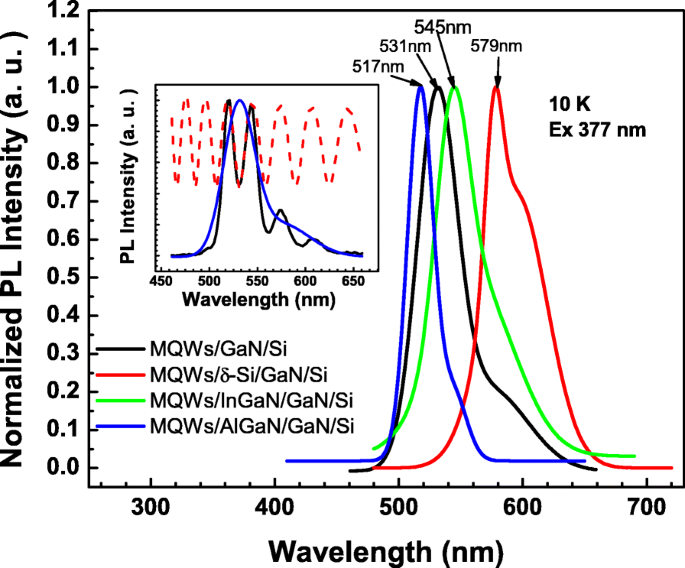
Visão geral de SSPL para S1 – S4 excitado por laser de 377 nm a 10 K. Os sinais PL originais contêm oscilação de Fabry-Perot que é mostrada como a curva preta na inserção (S1 como um exemplo). O item de oscilação (curva traço vermelha) e pico de PL gaussiano (curva azul) são divididos pelo ajuste dos sinais originais. Todos os dados de PL para S1-S4 são tratados pelo mesmo método e, em seguida, os PL Gaussianos divididos são mostrados na figura
Para compreender a natureza da recombinação em MQWs, é fundamental testar suas propriedades de decaimento de PL porque os tempos de vida de PL relacionados às taxas de recombinação radiativa / não radiativa podem ser extraídos diretamente das curvas de decaimento. Aqui, os decaimentos PL foram medidos com a fixação do comprimento de onda detectado nos valores de pico de S1-S4, e as medições foram feitas em diferentes temperaturas variando de 10 a 300 K. A Figura 3 mostra três curvas típicas de decaimento PL para S1 testado em 10, 100 e 300 K. Verificou-se que os decaimentos de PL para todos os S1-S4 tendem a variar com a temperatura. Este fenômeno reflete as dependências da temperatura de ambas as taxas de recombinação radiativa e taxas de recombinação não radiativa nas amostras. A seguinte função de decaimento exponencial única foi usada para ajustar cada curva de decaimento:
$$ I (t) ={I} _0 {e} ^ {- t / \ tau} $$ (1)
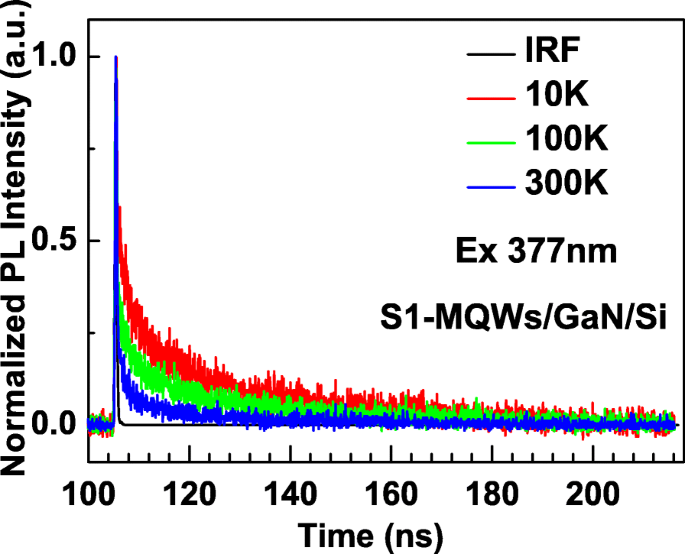
Curvas de decaimento PL para S1 excitadas por laser pulsado de 377 nm a 10 K, 100 K e 300 K
onde eu 0 representa a intensidade PL em t =0 e τ representa o tempo de vida PL. É importante notar que nem todas as curvas de decaimento podem ser perfeitamente ajustadas pela função de decaimento exponencial única acima. Isso foi amplamente discutido por vários grupos [31,32,33,34]. Uma suposição razoável era que existem vários centros de recombinação no sistema. Às vezes, a função de decaimento multi-exponencial era usada para ajustar as curvas. Aqui, para evitar a introdução de muitas suposições que são difíceis de serem verificadas no final, ou fazer a análise refletir incorretamente apenas nas partes menores de todas as propriedades de PL, usamos o modelo mais simples para extrair um tempo de vida médio de PL para cada amostra, que pode refletir as propriedades dinâmicas gerais de PL. Os tempos de vida obtidos para S1 – S4 foram colocados juntos na Fig. 4a. Para conectar os resultados dinâmicos de PL à probabilidade de recombinação, taxa de recombinação k foi definido como k =1 / τ . Pontos de k versus temperatura para S1 – S4 também são mostrados na Fig. 4b. Os resultados mostram claramente dois tipos diversos de evolução de k com a temperatura que as taxas de recombinação para as amostras liberadas por tensão de tração S2 e S4 são menores do que as da amostra original S1 ou amostra agravada por tensão de tração S3 em toda a faixa de temperatura e aumentam mais severamente com o aumento da temperatura. Observe que k = k r + k nr , em que k r representa a taxa de recombinação radiativa e k nr representa a taxa de recombinação não radioativa. Espera-se que k nr aumenta quando a temperatura sobe e domina k à temperatura ambiente, pois sempre se relaciona com processos de troca de energia com o calor [35]. Então, o k os resultados no lado de alta temperatura na Fig. 4b exibem a evidência sólida de que os processos de liberação de tensão, como Si δ-dopagem e inserção de AlGaN têm influências positivas na supressão da recombinação não radioativa em MQWs ao longo da redução de defeitos de deslocamento ou rachaduras que têm grande influência em k nr . Mas k r torna-se insignificante em condições de baixa temperatura. Portanto, informações adicionais e análises adicionais são necessárias para explicar o comportamento de k no lado da baixa temperatura.

a Vida útil do PL vs. temperatura para S1 – S4. O comprimento de onda detectado é mantido em cada posição de pico de acordo com os resultados de SSPL na Fig. 2. b Taxas de recombinação correspondentes para S1-S4, que são obtidas por k =1 / τ
Portanto, para dividir k r e k nr de cada k valor, espectros SSPL em várias condições de temperatura para cada amostra foram medidos. Em seguida, a intensidade de cada pico PL correspondente aos seus comprimentos de onda detectados em testes TRPL anteriores foram registrados como I ( T ) Depois disso, a eficiência relativa do PL foi definida como η = eu ( T ) / eu 0 , em que eu 0 representa a intensidade de PL a 0 K. As eficiências de PL obtidas para S1-S4 foram colocadas juntas na Fig. 5a. Pode-se verificar que as eficiências de PL para S2 e S4 são ambas em torno de 17%, que são 7 vezes maiores que a de S1. Sabe-se que apenas a recombinação radiativa contribui para a intensidade da PL; portanto, esta eficiência relativa PL reflete a razão da taxa de recombinação radiativa na taxa de recombinação total:
$$ \ eta ={k} _r / \ left ({k} _r + {k} _ {nr} \ right) ={k} _r / k $$ (2)

a Eficiências PL relativas vs. temperatura para S1 – S4. O comprimento de onda detectado é mantido em cada posição de pico de acordo com os resultados de SSPL na Fig. 2. b Taxa de recombinação total, taxa de recombinação radiativa e taxa de recombinação não radiativa vs. temperatura para S1
Assim, é capaz de resolver k r = kη e k nr = k (1 - η ) dos resultados TRPL combinados com η . O respectivo cálculo para k r e k nr de S2 foi mostrado na Fig. 5b como um exemplo. Os resultados revelaram que mesmo para S2 com modificação de dopagem com Si δ, a taxa de recombinação não radiativa é maior do que a taxa de recombinação radiativa até atingir uma temperatura muito baixa de 50 K. Isso explica o motivo pelo qual k continua aumentando quando a temperatura aumenta porque é dominante em k nr . Isso também indica a alta demanda por melhorias de qualidade cristalinas adicionais para MQW em estruturas de Si. A taxa de recombinação radiativa k r foi encontrado diminuindo monotonamente com o aumento da temperatura, o que não concorda com as propriedades típicas de PL originadas da recombinação do par elétron-buraco livre que k r está livre de temperatura. No entanto, é razoável se o processo PL for dominante na localização do exciton. Excitons tendem a se deslocar em faixas de temperatura mais altas; como resultado, o aumento da temperatura levará ao declínio da taxa de localização [32]. k nr e k r versus temperatura para S1 – S4 foram resumidos na Fig. 6a, b, respectivamente. Como mostrado, os resultados de k nr a 300 K para S2 e S4 são 2,5 × 10 −2 s −1 e 2,8 × 10 −2 s −1 , respectivamente, que são inferiores aos de S1 (3,6 × 10 −2 s −1 ) e S4 (4,7 × 10 −2 s −1 ) Estes verificam ainda que os processos de liberação de tensão suprimem a formação de deslocamento e rachaduras em MQWs e, consequentemente, diminuem as densidades de centros de recombinação não radiativa. Este efeito de supressão se torna mais sensível quando a temperatura desce. O k obtido r os resultados são mais complicados. Conforme mostrado, k r para S1 e S3 diminui muito mais severamente do que para S2 e S4 após o aumento da temperatura. Como resultado, obteve k r a 300 K para S2 (5,7 × 10 −3 s −1 ) e S4 (5,8 × 10 −3 s −1 ) são muito maiores do que para S1 (9 × 10 −4 s −1 ) e S3 (7 × 10 −4 s −1 ) É razoável atribuir este fenômeno aos processos de liberação de deformação:de acordo com a discussão acima, os processos radiativos nessas amostras MQW estão principalmente relacionados à recombinação de excitons em estados localizados. Aqui, k r é determinado principalmente pela taxa de localização de excitons k loc . O declínio dramático de k loc com temperatura crescente indica que a profundidade média dos estados localizados é relativamente pequena no sistema, tornando o exciton fácil de deslocar em alta temperatura. Em outras palavras, as profundidades médias de estados localizados em amostras com liberação de deformação como S1 e S3 são menores do que aquelas sem liberação de deformação. Com base nos trabalhos anteriores [36], os centros de recombinação radiativa localizada em InGaN / GaN MQWs são frequentemente oferecidos por defeitos estruturais em camadas de poço InGaN, como variações de espessura de poço e aglomerados ricos em índio, em que as variações de espessura de poço oferecem estados rasos, bem como clusters ricos em índio oferecem estados com profundidades muito mais profundas [33]. Aqui, o resultado de k r indica que a forte tensão de tração em interfaces MQW lideradas por substrato de Si e GaN dopado com Si pode melhorar a formação de defeitos estruturais rasos radiativos, de modo que a profundidade dos estados localizados para S1 e S3 é menor, pois as variações de espessura são dominantes nos processos de localização de exciton . Para S2 e S4, as variações de espessura do poço são suprimidas, então os processos de localização de excitons são dominantes nos estados profundos dentro dos poços InGaN, exibindo profundidades médias muito maiores de estados localizados e mais estáveis k r versus temperatura. Consequentemente, as amostras S1 e S3 demonstram maior k r do que S2 e S4 no lado da baixa temperatura, onde o efeito de deslocalização do exciton é fraco, mas muito menor k r à temperatura ambiente.

a Taxas de recombinação não radiativa vs. temperatura para S1 – S4. b Taxas de recombinação radiativa vs. temperatura para S1 – S4
Conclusões
Em resumo, os espectros de SSPL e TRPL com variação de temperatura foram estudados para diferentes InGaN / GaN MQWs em estruturas de Si com ou sem tratamentos de liberação de tensão de tração. Verificou-se que a amostra com camada de Si δ-dopagem GaN ou camada inserida de AlGaN tinha menor taxa de recombinação e maior eficiência de PL (até 17%) do que a amostra regular (2,5%) ou amostra com camada inserida de InGaN (1,6%). Uma análise mais aprofundada esclareceu que as taxas de recombinação menores foram conduzidas principalmente por taxas de recombinação não radiativa dominantes menores (2,5 × 10 −2 s −1 para amostra de dopagem δ, 3,6 × 10 −2 s −1 para AlGaN inserido amostra em comparação com 3,6 × 10 −2 s −1 para amostra regular e 4,7 × 10 −2 s −1 para InGaN inserido amostra), que foram atribuíveis à supressão à formação de luxações ou fissuras. Além das menores taxas de recombinação não radiativa, os melhores desempenhos de PL também foram liderados pelas taxas de recombinação radiativa que eram mais estáveis e mais altas à temperatura ambiente (5,7 × 10 −3 s −1 para amostra de dopagem δ, 5,8 × 10 −3 s −1 para AlGaN inserido amostra em comparação com 9 × 10 −4 s −1 para amostra regular e 7 × 10 −4 s −1 para amostra inserida InGaN). Eles também foram atribuídos à supressão das variações da espessura do poço nas interfaces MQW, deixando os centros de localização radiativa profundos dentro das camadas InGaN dominarem o processo de recombinação radiativa. Os resultados acima mostraram uma imagem clara dos processos de recombinação dos dispositivos LED MQW InGaN / GaN em substratos de silício, o que pode orientar a fabricação do dispositivo no futuro.
Abreviações
- IQE:
-
Eficiência quântica interna
- LD:
-
Diodo laser
- LED:
-
Diodo emissor de luz
- MQW:
-
Poço quântico múltiplo
- PL:
-
Fotoluminescência
- SSPL:
-
Fotoluminescência em estado estacionário
- TRPL:
-
Fotoluminescência resolvida pelo tempo
Nanomateriais
- Transporte quântico torna-se balístico
- Construindo qubits de átomo único sob um microscópio
- Nanossilício para produzir hidrogênio
- Revestimento Nano para várias cores
- Nano grafema, memória transparente flexível à base de silício
- O rearranjo atômico de poços quânticos múltiplos baseados em GaN em gás misto H2 / NH3 para melhorar propriedades estruturais e ópticas
- Emissão multicolor da estrutura ultravioleta de nanopiramida quasicristal fotônica baseada em GaN com InxGa1 semipolar − xN / GaN vários poços quânticos
- Desgaste Triboquímico Dependente da Velocidade de Silício Livre de Óxido
- Pontos quânticos de bismuto em poços quânticos de GaAsBi / AlAs recozidos
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo



