Pontos quânticos de bismuto em poços quânticos de GaAsBi / AlAs recozidos
Resumo
É relatada a formação de nanocristais de bismuto em camadas de GaAsBi crescidas por epitaxia de feixe molecular a 330 ° C de temperatura do substrato e recozido pós-crescimento a 750 ° C. Superredes contendo camadas alternadas de GaAsBi e AlAs de 10 nm de espessura foram cultivadas em substrato de GaAs semi-isolante. Camadas de AlAs serviram como barreiras de difusão para átomos Bi, e o tamanho dos nanoaglomerados que se nuclearam após o recozimento da amostra foi correlacionado com a espessura das camadas de bismídeo. Espectroscopia de dispersão de energia e medidas de espalhamento Raman evidenciaram que as nanopartículas são predominantemente constituídas de átomos Bi. Sinal forte de fotoluminescência com comprimentos de onda de fótons variando de 1,3 a 1,7 μm foi observado após o recozimento; sua amplitude aumentava com o aumento do número de camadas GaAsBi. A banda de fotoluminescência observada pode ser devido à emissão de nanocristais Bi. As estimativas teóricas realizadas suportam o pressuposto. Eles mostram que, devido ao efeito do tamanho quântico, as nanopartículas Bi passam por uma transição para o estado semicondutor de bandgap direto.
Histórico
Heteroestruturas baseadas em GaAsBi têm um grande potencial para aplicações optoeletrônicas em uma ampla faixa espectral que se estende da região do infravermelho próximo a médio. GaAsBi é um composto semicondutor do grupo III – V que é ativamente investigado para emissores de radiação infravermelha baseados em GaAs [1] e detectores [2,3,4,5]. Diodos emissores de luz com camadas ativas de GaAsBi irradiando nos comprimentos de onda de ~ 987 nm (com conteúdo de Bi de 1,8%) foram descritos por Lewis et al. [6]; o laser bismeto eletricamente injetado com ~ 6% Bi em um poço multiquântico GaAsBi / GaAs (MQW) foi relatado na Ref. [7]. A principal dificuldade neste campo é um aumento da densidade do centro de recombinação não radiativa devido às baixas temperaturas do substrato necessárias para um crescimento de epitaxia de feixe molecular (MBE) de camadas de GaAsBi com conteúdo de Bi acima de 5%. Um dos procedimentos tecnológicos padrão que permitem uma redução da taxa de recombinação não radiativa é um recozimento pós-crescimento em temperaturas mais altas do que aquelas usadas para o crescimento de MBE. No entanto, no caso do GaAsBi, o efeito do recozimento não é inequívoco. Foi demonstrado anteriormente por nosso grupo [8, 9] que o recozimento em temperaturas acima de 600 ° C leva a várias novas características, a mais não trivial das quais é um início em algumas das amostras de fotoluminescência (PL) bastante intensa. na faixa de comprimento de onda de 1,35 a 1,5 μm, este processo sendo acompanhado por mudanças substanciais na camada epitaxial de GaAsBi - uma redução do conteúdo de Bi na rede cristalina e um aparecimento de aglomerados de tamanho nanométrico [9].
O crescimento de nanoestruturas - nanofios, poços quânticos tensos ou pontos quânticos (QDs) - é uma maneira popular de evitar a incompatibilidade de rede entre um substrato e a camada epitaxial crescida nele. Os exemplos mais amplamente estudados de QDs baseados em compostos III-V são os QDs baseados em InGaAs- [10] e InGaN- [11] cultivados pela técnica de Stranski-Krastanow [12]. No caso do GaAsBi, tal mecanismo de crescimento ainda não foi realizado. A nucleação de clusters Bi-relacionados em camadas epitaxiais de GaAsBi recozidas e suas características estruturais foram sistematicamente estudadas na Ref. [13]. Foi demonstrado que os nanoaglomerados de diferentes estruturas e composições cristalinas - romboédrico As e Bi, bem como nano aglomerados de zinco-blenda GaAsBi - estão nucleando nas camadas de bismídeo após o recozimento; seu tamanho varia entre 5 e 20 nm. Aglomerados romboédricos de bismuto puro foram observados em GaAsBi com conteúdo de Bi relativamente grande (4,7%) cultivado em baixa temperatura (200 ° C) [13]. Em nosso estudo anterior [9], uma formação de aglomerados de Bi de tamanho nanométrico foi relatada no GaAsBi recozido em alta temperatura com conteúdo de Bi acima de 6%. Além disso, foi assumido que, devido aos efeitos de quantização de tamanho, os nanoclusters de bismuto tornam-se semicondutores em vez de semimetálicos (como é o caso nos cristais Bi em massa), e que a recombinação radiativa que ocorre nos aglomerados Bi pode ser responsável pela emissão de longo comprimento de onda observada em amostras de GaAsBi recozidas [9].
O presente trabalho relata a formação de nanocristais Bi em poços quânticos de GaAsBi / AlAs recozidos. As camadas de AlAs estavam servindo como barreiras para o confinamento do portador de carga e para evitar a difusão externa de Bi das camadas de GaAsBi durante um procedimento de recozimento. A presença de camadas de AlAs garantiu a nucleação de nanopartículas Bi de uma forma mais controlada - sua distribuição de tamanho era mais estreita e sua densidade era maior do que em camadas volumosas recozidas [9]. As amostras obtidas foram caracterizadas por medidas de microscopia eletrônica de transmissão de alta resolução (HRTEM), espectroscopia PL e Raman. Os resultados desses experimentos indicam a presença de nanocristais Bi puros nas heteroestruturas recozidas. As estimativas teóricas realizadas confirmam que os nanocristais Bi podem ser transformados pelos efeitos da quantização de tamanho em semicondutores de gap direto.
Métodos
Estruturas de GaAsBi / AlAs MQW foram cultivadas em substratos GaAs (100) semisolantes usando reator SVT-A MBE equipado com fontes metálicas de Ga, Al e Bi, bem como uma fonte de cracker de duas zonas para produzir As 2 . O seguinte esquema de crescimento de MBE foi usado. Em primeiro lugar, a camada tampão de GaAs (de cerca de 100 nm) e a primeira barreira AlAs foram cultivadas usando o modo de crescimento MBE padrão a alta temperatura de 600 ° C. Em seguida, o crescimento foi interrompido e a temperatura do substrato foi reduzida para um crescimento de barreiras QWs e AlAs de GaAsBi. O modo de epitaxia aprimorada por migração (MEE) foi usado para a deposição de AlAs na seguinte sequência de crescimento:uma monocamada (ML) de Al, interrupção de 5 s para uma migração de átomos do grupo III, em seguida, um fornecimento de 1 ML de As [14, 15 ] Finalmente, a estrutura MQW foi coberta por uma camada de cobertura de GaAs de 5 nm de espessura. O conteúdo de Bi nas camadas de GaAsBi foi determinado a partir do (200) -reflexo de varredura de XRD ω-2Θ e foi de cerca de 7% para as amostras conforme crescidas.
Duas amostras MQW diferentes foram escolhidas para as medições. A amostra MQW A contém três GaAsBi QWs de 10 nm de espessura e um de 20 nm de espessura (MBE-crescido a 330 ° C) separados por barreiras de AlAs de 20 nm de espessura (MEE-crescido à mesma temperatura). A amostra B MQW contém 20 QWs com camadas de GaAsBi de 10 nm de largura separadas por barreiras AlAs de 4 nm de espessura crescidas em condições semelhantes às usadas para o crescimento da amostra A. O tratamento em alta temperatura de ambas as amostras foi realizado em estufa de recozimento térmico rápido (RTA) na temperatura de 750 ° C por 180 s em ambiente de nitrogênio. Para evitar a perda de arsênio da camada superficial, durante o recozimento, as amostras foram cobertas por um wafer de GaAs sacrificial.
A análise de superfície de microscopia de força atômica demonstrou superfícies livres de gotículas de estruturas MQW conforme crescidas e recozidas. A rugosidade da superfície da camada de cobertura de GaAs estava abaixo de 1 nm. As medições estruturais de alta resolução das nanopartículas, que foram formadas em MQWs após o recozimento da amostra, foram realizadas pela FEI Tecnai G2 F20 X-TWIN TEM com módulo STEM, equipado com um detector de espectroscopia de energia dispersiva de raios-X (EDS) para elementais mapeamento e um detector de campo escuro anular de alto ângulo (HAADF) para imagens de contraste Z. O microscópio de duplo feixe FEI Helios Nanolab 650 equipado com um manipulador Omniprobe foi usado para preparar os espécimes para as medições de TEM.
A Figura 1 mostra a imagem STEM da amostra A. A imagem evidentemente revela numerosas nanopartículas, que foram formadas em camadas de poços quânticos GaAsBi (QW) após o recozimento. Uma correlação óbvia entre o tamanho das nanopartículas e a largura das camadas QW pode ser rastreada na imagem. A correlação evidencia que as camadas de AlAs (regiões mais escuras) estão efetivamente atuando como barreiras impedindo a difusão de átomos Bi das camadas de GaAsBi. O mapeamento elementar EDS da área selecionada da amostra obtido simultaneamente com a imagem HAADF mostra (Fig. 2) que os nanocristais formados são predominantemente constituídos de átomos de bismuto.
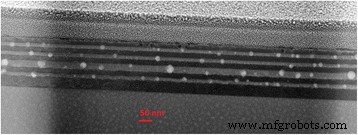
Imagem STEM da amostra A com três GaAsBi QWs de 10 nm de espessura e um de 20 nm de espessura crescidas por MBE e barreiras de AlAs crescidas por MEE de 20 nm após recozimento a 750 ° C de temperatura por 180 s

Imagem de contraste HAADF – STEM Z de nanocristais Bi em estruturas MQW GaAsBi / AlAs ( acima ) As imagens EDS ( abaixo ) representam o mapeamento elementar das intensidades de Ga, Al, Bi e As, medidas na área marcada da imagem STEM
Resultados
Espectroscopia Raman
Os espectros Raman das amostras GaAsBi MQW investigadas foram registrados na geometria de retroespalhamento pelo espectrômetro Via Raman (Renishaw) equipado com uma câmera CCD termeletricamente resfriada (-70 ° C) e um microscópio. A linha de radiação de 532 nm do laser de estado sólido com bombeamento de diodo foi usada para uma fotoexcitação. As lentes objetivas de 50 × / 0,75 NA e grade de 1800 linhas / mm foram usadas para registrar os espectros Raman. O tempo de acumulação foi de 400 s. Para evitar o dano da amostra, a potência do laser na amostra foi restrita a 0,06 mW. As frequências Raman foram calibradas usando o padrão de silício (linha em 520,7 cm −1 ) Os parâmetros dos modos vibracionais foram determinados ajustando os espectros experimentais com componentes de forma gaussiana-lorentziana usando o software GRAMS / A1 8.0 (Thermo Scientific).
Os espectros Raman da amostra de GaAsBi / AlAs MQW A conforme crescido e recozido são apresentados na Fig. 3. Um dubleto intenso observado na amostra conforme crescido (Fig. 3, curva verde) em 269 e 290 cm -1 corresponde aos modos de fônon óptico transversal tipo GaAs (TO) e óptico longitudinal (LO), respectivamente [16,17,18]. Na geometria de retroespalhamento, a banda TO é simetricamente proibida para o cristal de GaAs ideal [17, 18], mas a desordem da estrutura cristalina bi-induzida quebra a simetria da rede cristalina de GaAs e ativa o modo TO. Dois outros modos vibracionais bi-induzidos amplos visíveis perto de 227 e 181 cm −1 pode ser atribuído a modos vibracionais do tipo GaBi [18]. A presença de barreiras AlAs pode ser reconhecida no espectro Raman de um modo LO acentuado a 402 cm −1 [19].
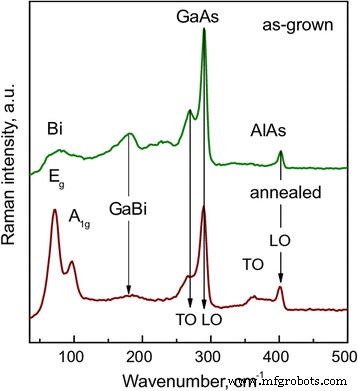
Espectros Raman do conforme crescido ( curva verde ) e recozido ( curva vermelha ) GaAsBi MQW A-sample
O recozimento térmico relativamente curto (180 s) da amostra a 750 ° C induz mudanças essenciais no espectro Raman:(i) bandas de baixa frequência intensas aparecem em 72 e 96 cm −1 , (ii) intensidade das bandas perto de 269, 227 e 181 cm −1 diminui, e (iii) uma característica ampla perto de 361 cm −1 aparece no espectro da amostra recozida. As duas bandas de baixa frequência em 72 e 96 cm −1 corresponde bem a E g e A 1g modos do bismuto cristalino [20,21,22,23,24]. O aparecimento dessas bandas junto com uma diminuição na intensidade das bandas tipo GaBi induzidas por Bi em 269 e 181 cm −1 mostra que o recozimento térmico causa a retirada do bismuto dos locais da rede GaAsBi e sua aglomeração em nanocristais Bi. Além disso, a formação de nanocristais de bismuto também afeta a estrutura cristalina das camadas de AlAs, como é aparente a partir do aumento de um amplo recurso de TO induzido por defeito próximo a 361 cm −1 [25].
Medições de fotoluminescência
As medições de fotoluminescência dependente da temperatura (PL) foram realizadas usando um monocromador de distância focal de 500 mm (Andor SR-500i) junto com o fotodetector InGaAs resfriado por nitrogênio líquido. Um laser de estado sólido com bomba de diodo emitindo no comprimento de onda de 532 nm foi usado como uma fonte de excitação na potência de excitação de 38 mW. As amostras foram montadas no dedo frio de um criostato de hélio de ciclo fechado acoplado a controlador de temperatura, permitindo medições na faixa de temperatura de 3–300 K.
Os espectros PL da amostra A recozida, que contém três GaAsBi QWs de 10 nm de espessura e um de 20 nm de espessura, medidos em diferentes temperaturas, são apresentados na Fig. 4a. Dois conjuntos principais de características espectrais abaixo do bandgap de GaAs podem ser distinguidos. O forte pico de alta energia situado em cerca de 1,35 eV pode ser atribuído a transições radiativas em GaAsBi QWs. A posição do pico é próxima à observada em GaAs 0,979 Bi 0,021 / GaAs poços quânticos [26] e se correlaciona com dados de XRD que indicaram o conteúdo de Bi de 2,1% nas camadas GaAsBi QW da amostra A após seu recozimento. Os recursos espectrais no lado de baixa energia, 0,6-1,05 eV, aparecem em espectros PL após um recozimento térmico da amostra e, portanto, podem ser atribuídos a transições ópticas em nanocristais Bi. A banda PL de baixa energia possui uma estrutura interna que se revela em baixas temperaturas. Ou seja, em T =3 K, os componentes PL posicionados em 0,67, 0,88 e 0,98 eV podem ser distinguidos. Como pode ser visto na Fig. 4a, na temperatura do hélio líquido, o sinal PL de GaAsBi QWs é duas ordens de magnitude mais forte do que a banda PL de baixa energia. No entanto, o pico de PL de alta energia diminui rapidamente com um aumento da temperatura e o pico de PL de baixa energia começa a dominar em T > 100 K.

Espectros de PL dependentes da temperatura do a recozido Amostra A composta por três QWs GaAsBi / AlAs de 10 nm de largura e um de 20 nm de largura GaAsBi / AlAs e b Amostra B composta por 20 QWs de GaAsBi / AlAs de 10 nm de largura
Os espectros de PL da amostra B, que contém vinte poços quânticos GaAsBi de 10 nm de espessura separados por barreiras de AlAs de 4 nm de espessura, são apresentados na Fig. 4b. Antes do recozimento térmico, como foi o caso para a amostra A, a amostra B manifestou apenas a banda PL relacionada com QW de maior energia. O forte pico de PL de baixa energia em cerca de 0,85 eV foi observado após o recozimento térmico e, portanto, assumimos, pode ser atribuído à emissão de nanocristais Bi. A intensidade do pico de baixa energia na amostra B é mais forte do que na amostra A e aumenta com um número maior de QWs. Em baixas temperaturas, três componentes do pico, que foram bem resolvidos na amostra A, podem ser rastreados. No entanto, na amostra B, o pico de PL de baixa energia é dominado por seu componente de 0,85 eV em toda a faixa de temperatura investigada. A posição do pico PL relacionado com QW de alta energia é ligeiramente deslocada para energias mais baixas em relação à sua posição na amostra A de acordo com os dados de XRD, que indicaram 2,8% Bi em camadas de poços quânticos da amostra B após seu recozimento térmico. Na amostra B, o pico de PL relacionado a QW revela sua estrutura interna. O pico é constituído a partir do componente relacionado ao exciton ligado a cerca de 1,27 eV, que domina a baixas temperaturas, e do componente relacionado ao exciton deslocado, que está situado a cerca de 1,35 eV e domina a temperaturas mais altas. A estrutura interna do pico relacionado ao QW resulta em uma dependência característica da temperatura do tipo S da posição do pico PL (pontos cheios na Fig. 5), que foi observada anteriormente tanto em GaAsBi em massa [27] e em poços quânticos GaAsBi / GaAs [26]. O pico PL posicionado em energias de fótons baixas mostra dependência de temperatura muito mais fraca (pontos abertos e curva na Fig. 5), que pode ser ajustada pela função Varshni E ( T ) = E (0) - αT 2 / ( β + T ) com os parâmetros α e β iguais a 10 −4 eV / deg e 100 K, respectivamente. Deve-se notar que o valor do parâmetro α, responsável pela variação do gap de energia com a temperatura, é muito menor do que seus valores padrão para a maioria dos semicondutores, 3 ° 10 −4 –5 ° 10 −4 eV / deg. Isso torna a matriz nanocristal Bi um sistema potencial importante para as fontes de luz emitidas em comprimentos de onda de telecomunicações e com baixa sensibilidade à temperatura.

Dependências de temperatura das posições espectrais das bandas PL de alta e baixa energia para a amostra B recozida composta de vinte GaAsBi / AlAs QWs de 10 nm de largura
Discussão
As medições de espectroscopia HRTEM, EDS e Raman realizadas no presente estudo indicam que os nanocristais Bi (pontos quânticos) precipitam em camadas de GaAsBi após um recozimento térmico das amostras de GaAsBi / AlAs MQW crescidas em MBE de baixa temperatura. Pode-se supor que esses nanocristais sejam responsáveis pela banda de fotoluminescência de longo comprimento de onda que se revela nas amostras recozidas. Embora o bismuto em massa seja semimetálico, as pequenas massas efetivas de portadores de carga Bi resultam em um início precoce dos efeitos de confinamento quântico em nanoestruturas baseadas em Bi. Na verdade, uma das primeiras observações experimentais dos efeitos da quantização do tamanho foi relatada para camadas Bi finas [28]. Transição de semimetal para semicondutor em filmes Bi finos, d <30 nm, foi experimentalmente observado na Ref. [29]. A transição também foi revelada em nanofios Bi com diâmetros menores que 65 nm [30, 31]. Em ambos os casos, o estado semicondutor foi identificado a partir de medições das características elétricas dependentes da temperatura. O efeito do tamanho quântico em nanopartículas de bismuto foi estudado pela primeira vez por espectroscopia de perda de energia de elétrons [32], e a transição de semimetal para semicondutor foi encontrada em nanopartículas Bi com diâmetros abaixo de 40 nm. A transição para o estado de semicondutor direto foi relatada recentemente [33] para nanopartículas coloidais de Bi de 3,3 nm.
Em Bi puro, os principais vales de elétrons e lacunas estão localizados no L e T pontos da zona de Brillouin e correspondem às superfícies isoenergéticas elipsoidais (Tabela 1). O estado fundamental dos elétrons do vale elipsoidal (buracos) em um ponto quântico esférico pode ser estimado aproximadamente como
$$ W =\ frac {\ pi ^ 2 {\ hslash} ^ 2} {2 \ overline {m} {r} _0 ^ 2} \. $$ (1)
Aqui r 0 é o raio QD e \ (\ overline {m} \) é a massa efetiva inversa média,
$$ \ frac {1} {\ overline {m}} =\ frac {1} {3} \ left (\ frac {1} {m_1} + \ frac {1} {m_2} + \ frac {1} { m_3} \ right), $$ (2)
m 1 , m 2 , e m 3 são as principais massas efetivas do vale elipsoidal.
A fórmula fenomenológica (1) fornece uma estimativa aproximada do nível de energia do solo ε 1 em um QD esférico infinitamente profundo em razões arbitrárias das massas efetivas. Na verdade, é exato, ε 1 = W , no caso de uma superfície isoenergética esférica ( m 1 = m 2 = m 3 ), prevê o ε 1 energia com uma precisão de 12%, ε 1 ≈ 0,88 W , e 25%, ε 1 =0,75 W , nos casos limites de vale esferoidal fortemente prolato ( m 1 = m 2 , m 3 → ∞) e um esferoidal fortemente achatado ( m 1 = m 2 , m 1 → ∞), respectivamente. Portanto, em valores arbitrários das massas efetivas principais, a fórmula (1) se aproxima da energia do solo QD com precisão melhor do que 25%.
A Fórmula (1) permite uma avaliação simples e direta das lacunas de energia eficazes em pontos quânticos de bismuto, E g, eff = E g + W e + W h , onde E g é uma lacuna de energia em um cristal em massa e W e e W h são as energias de quantização do elétron e do tamanho do buraco (1). O efetivo calculado T e L lacunas de energia são apresentadas graficamente na Fig. 6. (As massas do elétron e do buraco em ambos T e L pontos foram considerados iguais.)

Evolução com o espectro de energia Bi QD com uma diminuição de seu tamanho ( r 0 e d são o raio e diâmetro QD)
No bismuto semimetálico, a banda de condução mínima do L vale é 38 meV abaixo do T banda de valência máxima. Quando o tamanho das partículas Bi é reduzido, o intervalo de energia efetiva no L o ponto aumenta mais rápido do que no T ponto devido a massas efetivas menores do L -valley, o que está eventualmente levando à transição de semimetal para semicondutor (o i -ponto cruzado na Fig. 6). No início, um nanocristal de bismuto se torna o semicondutor indireto com o mínimo de banda de condução mais baixo no L ponto e o máximo da banda de valência mais alta no T ponto. Com uma redução adicional do tamanho do QD, ambas as bordas da banda de valência e condução emergirão no T pontos que fazem o Bi QD se tornar um semicondutor de gap direto (o d -ponto cruzado na Fig. 6).
Deve-se notar que a Fig. 6 apresenta apenas um esquema aproximado do espectro de energia, pois o esquema desconsidera os efeitos de não parabolicidade e assume as barreiras de energia infinitas para QDs. Um desvio da lei de dispersão parabólica é essencial para o L -valley (ver por exemplo, [34]). Na verdade, as massas efetivas no L - o centro do vale são aproximadamente cinco vezes menores do que seus valores na energia de Fermi (que foram usados para cálculos do espectro de energia apresentado na Fig. 6). Por outro lado, os efeitos de não parabolicidade são mais fracos no T pontos, onde o bandgap de energia é maior e, portanto, o T efetivo apresentado gap de energia (Fig. 6) pode ser considerado como sua estimativa relevante.
Acima, presumimos que o pico de PL de baixa energia em ~ 0,85 eV seja devido às transições ópticas que estão ocorrendo em nanocristais Bi com diâmetros de cerca de 10 nm. Os cálculos apresentados para o d =10 nm QDs prevêem o E g, eff =0,76 eV gap de energia efetiva, o que está de acordo com o experimento e, portanto, apóia a hipótese hipotética da origem do pico de PL de baixa energia.
Conclusões
Em resumo, múltiplas estruturas de poços quânticos em camadas de GaAsBi / AlAs foram cultivadas por um processo misto de MBE / MEE em substratos de GaAs. Após o recozimento térmico pós-crescimento das estruturas a 750 ° C, numerosas nanopartículas de dispersão relativamente baixa foram nucleadas dentro de poços quânticos GaAsBi. Medidas de espectroscopia HRTEM, EDS e Raman mostram que os nanocristais são compostos predominantemente de bismuto. As medições de fotoluminescência realizadas revelam um pico adicional de baixa energia, ± 0,85 eV, PL que aparece nas amostras recozidas. O pico de PL de baixa energia provavelmente pode ser devido a transições ópticas em nanocristais Bi, que pelos efeitos do tamanho quântico são transformados no estado semicondutor de gap direto. As estimativas realizadas do espectro de energia dos pontos quânticos Bi suportam a suposição. É necessário trabalho experimental e teórico adicional e mais detalhado para uma resposta definitiva.
Abreviações
- EDS:
-
Espectroscopia de energia dispersiva
- HAADF:
-
Campo escuro anular de alto ângulo
- HRTEM:
-
Microscopia eletrônica de transmissão de alta resolução
- MBE:
-
Epitaxia de feixe molecular
- MEE:
-
Epitaxia aprimorada pela migração
- PL:
-
Fotoluminescência
- QD:
-
Ponto quântico
- QW:
-
Bem quântico
- RTA:
-
Recozimento térmico rápido
- STEM:
-
Microscopia eletrônica de transmissão de varredura
- TO e LO:
-
Modos de fônon óptico transversal e óptico longitudinal, respectivamente
Nanomateriais
- N, N-Dimetilformamida regulando a fluorescência de pontos quânticos MXene para a determinação sensível de Fe3 +
- Síntese de pontos quânticos de carbono co-dopados com N, S ricos em piridínicos como imitações de enzimas eficazes
- Síntese verde de pontos quânticos InP / ZnS Core / Shell para aplicação em diodos emissores de luz livres de metais pesados
- Uma abordagem simples para sintetizar pontos quânticos de carbono fluorescentes de águas residuais de Tofu
- Síntese de pontos quânticos de sulfeto de antimônio solúvel em água e suas propriedades fotoelétricas
- Síntese sonoquímica fácil de uma etapa e propriedades fotocatalíticas de compostos de pontos quânticos de grafeno / Ag3PO4
- Eliminação do tamanho bimodal em pontos quânticos InAs / GaAs para preparação de lasers de pontos quânticos de 1,3 μm
- Dependência da espessura da casca da transferência de energia entre as partículas em pontos quânticos ZnSe / ZnSe Core-Shell Dopagem com európio
- Fotocondutividade entre bandas de pontos quânticos InAs / InGaAs metamórficos na janela de 1,3-1,55 μm
- Síntese e propriedades de pontos quânticos de CdTe com liga de Mn com emissão de azul solúvel em água



