Litografia de difração baseada em máscara de uma etapa para a fabricação de estruturas suspensas 3D
Resumo
Propomos um novo método de exposição em uma etapa para a fabricação de estruturas suspensas tridimensionais (3D), utilizando a difração de padrões de máscara com largura de linha pequena. Um modelo óptico do processo de exposição é construído e a distribuição da intensidade da luz 3D no fotorresiste é calculada com base na formulação de difração de Fresnel-Kirchhoff. Várias estruturas fotorresistentes suspensas em 3D foram alcançadas, como feixes, malhas, padrões de palavras e estruturas multicamadas. Após a pirólise das estruturas SU-8, obtêm-se ainda estruturas de carbono 3D suspensas e autônomas, que apresentam grande potencial na aplicação de eletrodos transparentes, células solares semitransparentes e dispositivos de armazenamento de energia.
Introdução
As estruturas do sistema microeletromecânico de carbono 3D (C-MEMS) têm atraído cada vez mais as atenções devido à sua excelente estabilidade química, atividade eletroquímica e biocompatibilidade [1,2,3,4,5]. Estruturas de carbono suspensas são as estruturas 3D C-MEMS típicas livres de qualquer intermolecularidade [2], apresentando vantagens significativas em sensores [6, 7], microeletrodos [8, 9] e aplicações de armazenamento de energia [9]. Várias microestruturas C-MEMS foram obtidas através da pirólise do polímero, em que SU-8 é o precursor mais amplamente utilizado para estruturas pirolíticas de carbono [10, 11]. Com relação à sua baixa absorção de luz, é fácil fabricar microestruturas de alta razão de aspecto com SU-8 [12]. No entanto, ainda é um grande desafio obter gabaritos de polímero em suspensão.
Diversas abordagens foram desenvolvidas para fabricar microestruturas suspensas, como gravador de feixe E [13,14,15], raio-X [10, 16] e litografia de dois fótons [17,18,19]. A litografia de dois fótons é uma forma viável de se obter estruturas suspensas complexas, como microtubos ocos suspensos, com grande precisão, mas baixa eficiência [17]. Levando em consideração a eficiência e o custo, a litografia UV pode ser uma escolha melhor para a fabricação de precursores fotorresistentes. O processo de litografia em várias etapas com dose de exposição controlada para a fabricação de estruturas suspensas foi demonstrado [3, 6, 7, 20]. Lim et al. [21] fabricaram nanofios e nanomashes suspensos usando um processo de litografia UV de duas etapas e obtiveram nanoestruturas de carbono vítreo por meio de um processo de pirólise. Alguns métodos de litografia de uma etapa também foram propostos. No et al. [22] alcançaram microestruturas suspensas por um único processo de exposição, durante o qual um filme difusor óptico foi colocado nas máscaras de Cr. O filme difusor teve um impacto significativo no processo de exposição, levando à deformação dos padrões fotoresistentes. Long et al. [2] fabricou com sucesso estruturas suspensas 3D controlando a dose de exposição e o intervalo de ar entre o fotorresiste e a fotomáscara durante o processo de exposição de proximidade, enquanto o modo de exposição de proximidade limitou a resolução de fabricação. A fotolitografia em tons de cinza também tem sido aplicada na fabricação de estruturas suspensas com máscaras em tons de cinza ou sistemas de litografia sem máscara [11, 23]. Como o SU-8 é quase transparente quando o comprimento de onda da luz está acima de 350 nm [12], é muito difícil controlar a precisão da espessura da camada suspensa ajustando a dose de exposição [8, 10]. Hemanth et al. [10] otimizou o comprimento de onda UV no processo de exposição de acordo com as propriedades do SU-8. Eles escolheram o comprimento de onda UV de 405 nm para as microestruturas de alta razão e 313 nm para a camada suspensa. No entanto, a combinação da exposição com diferentes comprimentos de onda de luz ultravioleta aumenta os custos e as dificuldades de todo o processo de fabricação.
Neste estudo, demonstramos um novo processo de litografia de difração baseado em máscara de uma etapa que é compatível com a maioria dos tipos de fotorresiste para fabricar estruturas suspensas 3D. Uma distribuição de intensidade de luz 3D é simulada no fotorresiste de acordo com a teoria de difração de Kirchhoff e posteriormente verificada por experimentos. A espessura das estruturas suspensas é controlada pela largura dos padrões e as vigas suspensas são ampliadas pelo empilhamento de vários padrões de linha lado a lado com espaçamento adequado. Estruturas 3D suspensas complexas, como vigas com espessura de gradiente e malhas suspensas completas com padrões de palavras, podem ser obtidas pelo processo de litografia de uma etapa. Finalmente, as vigas de carbono suspensas, malhas e malhas de carbono autônomas também foram obtidas por meio de um processo de pirólise.
Métodos e Experimentos
Modelo óptico de litografia por difração
Durante o processo de litografia UV, o fenômeno de difração será muito óbvio quando o tamanho do padrão for muito pequeno. Aqui, utilizamos a difração de padrões estreitos com várias larguras de comprimento de onda para fabricar feixes suspensos. Para analisar a distribuição espacial da intensidade da luz no fotorresiste, construímos um modelo óptico (Fig. 1) para litografia por difração baseado na difração de Fresnel. O intervalo de ar entre o fotorresiste e a fotomáscara pode ser ignorado, uma vez que a exposição é realizada em um modo de contato rígido. A máscara é iluminada com uma onda plana em um comprimento de onda típico de 365 nm, e o fotorresiste é tratado como um material transparente com índice de refração de 1,659 (o índice de refração de SU-8 em 365 nm, medido por um elipsômetro). P 0 é um ponto na máscara com uma coordenada de ( x 0 , y 0 , 0) e P 1 é um ponto arbitrário no fotorresiste com uma coordenada de ( x 1 , y 1 , z 1 )
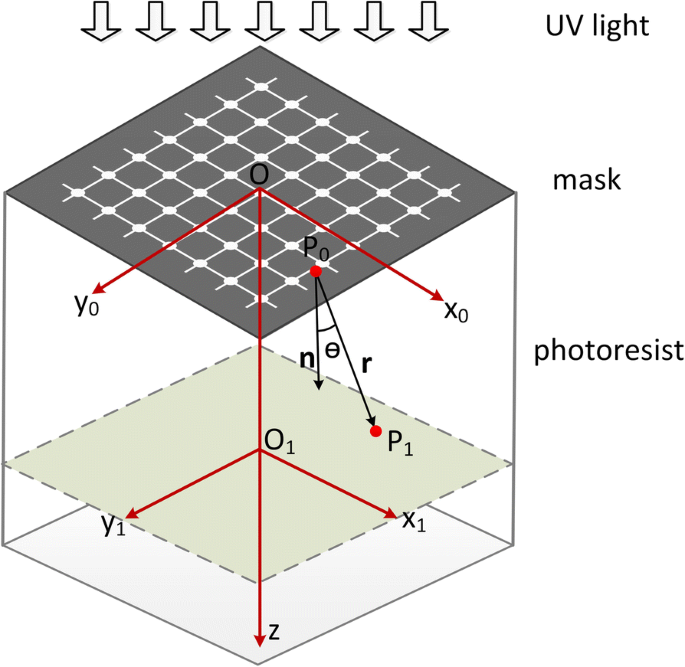
O modelo óptico da litografia de difração
De acordo com a formulação de difração de Fresnel-Kirchhoff [24], a amplitude no ponto P 1 no fotorresiste é
$$ E \ left ({P} _1 \ right) =\ frac {1} {2 j \ lambda} \ underset {\ sum} {\ iint} E \ left ({P} _0 \ right) \ frac {\ exp (jkr)} {r} \ left (1+ \ cos \ theta \ right) ds $$ (1)
onde k =2 π / λ , λ representa o comprimento de onda da luz ultravioleta no fotorresiste, E ( P 0 ) é a amplitude da onda de luz no ponto P 0 , θ é o ângulo entre P 0 P 1 e o z eixo, r é a distância entre P 1 e P 0 e Σ representa o domínio integral do padrão de máscara. De acordo com a relação geométrica na Fig. 1, podemos obter
$$ r =\ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1- {y} _0 \ right)} ^ 2+ {z_1} ^ 2} $$ (2) $$ \ cos \ theta ={z} _1 / r $$ (3)
E ( P 0 ) é uma constante no modelo. Assim, a fórmula de cálculo torna-se:
$$ E \ left ({P} _1 \ right) =\ frac {E \ left ({P} _0 \ right)} {2 j \ lambda} \ underset {\ sum} {\ iint} \ frac {\ exp \ Big (jk \ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1- {y} _0 \ right)} ^ 2+ {z_1} ^ 2 \ Big)}} {\ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1- {y} _0 \ right)} ^ 2 + {z_1} ^ 2}} \ left (1+ \ frac {z_1} {\ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1 - {y} _0 \ right)} ^ 2+ {z_1} ^ 2}} \ right) {dx} _0 {dy} _0 $$ (4)
Em seguida, as integrais são calculadas usando o software Matlab, e a distribuição da intensidade da luz no fotorresiste pode ser expressa como:
$$ I \ left (x, y, z \ right) ={\ left | E \ left ({P} _1 \ right) \ right |} ^ 2 $$ (5)
onde ( x , y , z ) é igual à coordenada de P 1 .
Para investigar melhor a absorção do fotorresiste, modificamos os cálculos da intensidade da luz ao considerar o coeficiente de absorção. Quando um feixe de luz passa pelo fotorresiste de P 0 para P 1 , a intensidade da luz pode ser calculada pela seguinte fórmula [25].
$$ \ frac {I _ {\ alpha}} {I_0} =\ exp \ left (- \ alpha r \ right) $$ (6)
onde eu 0 é a intensidade da luz inicial no ponto P 0 , eu α é a intensidade da luz no ponto P 1 , α é o coeficiente de absorção do fotorresiste, e r é a distância entre P 0 e P 1 . Nós definimos eu α = 0 como a intensidade da luz no ponto P 1 quando α =0 μm −1 . É fácil obter que eu α = 0 = eu 0 de acordo com a fórmula (6). As relações entre E ( P α = 0 ) (a amplitude correspondente a I α = 0 ) e E ( P α ) (a amplitude correspondente a I α ) pode ser expresso por:
$$ \ frac {E \ left ({P} _ {\ alpha} \ right)} {E \ left ({P} _ {\ alpha =0} \ right)} =\ exp \ left (- \ alpha r / 2 \ direita) $$ (7)
Assim, ao considerar a absorção do fotoresiste na litografia de difração, a amplitude no ponto P 1 (definido como E ( P 1α )) pode ser calculado por:
$$ E \ left ({P} _ {1 \ alpha} \ right) =\ frac {1} {2 j \ lambda} \ underset {\ sum} {\ iint} \ exp \ left (- \ alpha r / 2 \ right) E \ left ({P} _0 \ right) \ frac {\ exp (jkr)} {r} \ left (1+ \ cos \ theta \ right) ds $$ (8)
E a intensidade da luz pode ser obtida pelas fórmulas (2), (3), (5) e (8).
Detalhes Experimentais
Máscaras com padrões de linha foram usadas para fabricar estruturas suspensas, enquanto círculos ou quadrados foram projetados para fabricar pilares para sustentar a camada suspensa. Dois tipos de fotoresiste de negativo espesso foram empregados nos experimentos, incluindo SU-8 2100 (Microchem Co., Ltd.) com espessura de ~ 50 μm e NR26-25000P (Futurrex Co., Ltd.) com espessura de ~ 30 μm. O processo de exposição foi realizado com um alinhador de máscara MJB4, onde o comprimento de onda da luz ultravioleta iluminante era de 365 nm. As estruturas suspensas podem ser obtidas após as amostras serem imersas no revelador por um certo tempo. Aqui, acetato de éter metílico de propilenoglicol (PGMEA, Aladdin Co., Ltd.) foi usado como o revelador para as amostras SU-8 2100 e o revelador RD6 (Futurrex Co., Ltd.) foi escolhido para as amostras NR26-25000P. Finalmente, um processo de pirólise [16, 26, 27] contendo uma etapa de cozimento duro e uma etapa de cozimento de carbonização foi realizado em um forno de quartzo (MTI GAL 1400X) para obter microestruturas de carbono 3D. Todo o processo é ilustrado na Fig. 2a, e as variações de temperatura durante o processo de pirólise são ilustradas na Fig. 2b. As amostras foram duramente cozidas a 300 ° C durante 30 min e depois pirolisadas a 900 ° C durante 60 min. Durante o processo de pirólise, as amostras foram mantidas no H 2 (5%) / Ar (95%) atmosfera com uma taxa de aquecimento de 10 ° C / min. As microestruturas obtidas foram caracterizadas em microscópio eletrônico de varredura (MEV, Helios NanoLab G3, FEI).
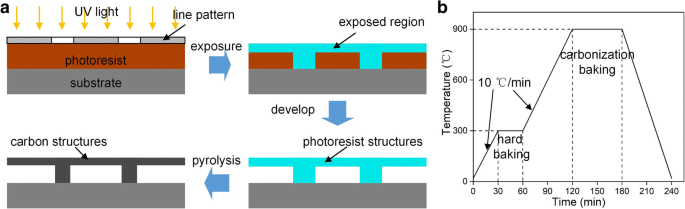
a O processo de fabricação de estruturas suspensas de carbono 3D. b A curva de temperatura da pirólise
Resultados e discussões
Distribuição da intensidade da luz
A Figura 3a mostra a seção transversal da distribuição de intensidade de luz 3D sob uma máscara em forma de linha com a largura da linha d =1 μm, 1,5 μm, 2 μm, 2,5 μm, 3 μm, 3,5 μm e 4 μm, respectivamente. Aqui, a intensidade relativa é adotada e a intensidade da luz incidente é definida como 1. A luz na parte inferior do fotorresiste se dispersará gradualmente devido ao efeito de difração de luz. Quando a intensidade da luz atinge um valor limite, o fotorresiste obterá energia suficiente para liberar a reação e ficar sólido; caso contrário, ele será removido no processo de desenvolvimento. A espessura da região acima do limiar (0,75 neste estudo) é definida como a profundidade de exposição, que é muito sensível à largura do padrão. A profundidade de exposição é de 5,3 μm sob d =1 μm e 18,2 μm sob d =2 μm. Ele aumentará ainda mais para 33,5 μm sob d =3 μm e 47,5 μm sob d =4 μm. Se a largura da linha for mais estreita que 1 µm, a profundidade de exposição será muito pequena para a fabricação, porque o espaço de ar entre a máscara e o fotorresiste causado pela irregularidade do fotorresiste espesso fará com que a exposição falhe. A Figura 3b, c mostra os padrões de máscara para a fabricação de estruturas suspensas e a distribuição de intensidade de luz correspondente em z =5, 10, 15 e 20 μm, onde a largura da linha é definida como 2 μm. A profundidade de exposição dos padrões de linha e malha está entre 15 e 20 μm, enquanto a dos grandes quadrados e círculos é grande o suficiente para formar pilares durante a litografia. Assim, podem ser fabricadas vigas e malhas suspensas, apoiadas nos pilares. Uma vez que é difícil fabricar estruturas suspensas quando a largura da linha é maior que 5 μm, os padrões de linha são empilhados lado a lado para fabricar vigas suspensas largas ou malhas, como mostrado na Fig. 3d.
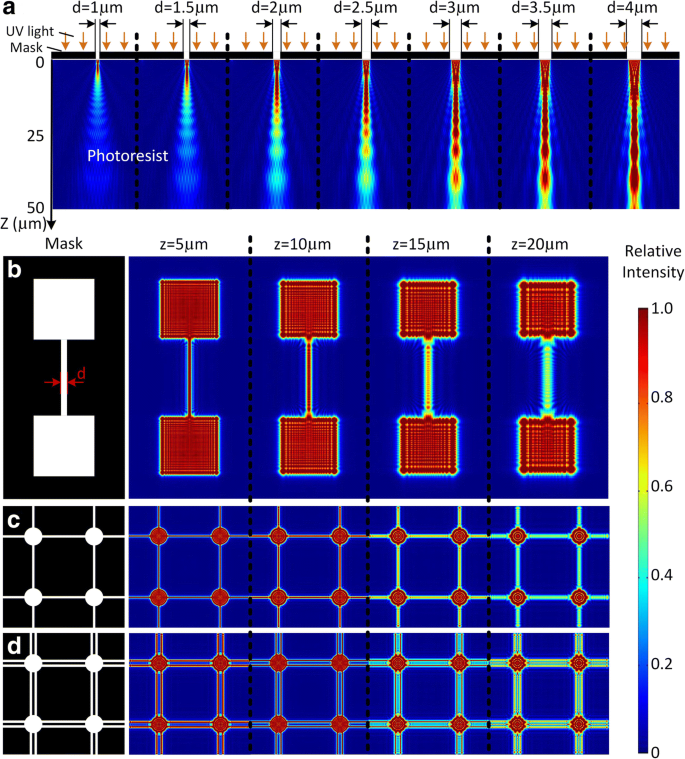
Os padrões de máscara e os resultados da simulação no fotorresiste. a As distribuições de intensidade de luz abaixo da máscara de foto em d =1 μm, 1,5 μm, 2 μm, 2,5 μm, 3 μm, 3,5 μm e 4 μm, onde d é a largura do padrão de linha. O padrão de máscara para b vigas suspensas, c malhas e d malhas com padrões de linhas empilhadas e as distribuições de intensidade de luz correspondentes em z =5 μm, 10 μm, 15 μm e 20 μm no fotorresiste. Aqui, z é a distância entre o plano da seção e a máscara fotográfica
Estruturas fotorresistentes suspensas
Experimentos foram realizados para fabricar estruturas suspensas. Testamos o tempo mínimo de exposição para obter os pilares fotoresiste e o definimos como o limite de exposição. Em seguida, adotou-se como dose de exposição quatro ou três vezes o valor do limiar e avaliou-se o limiar da intensidade relativa da luz em 0,75, de acordo com a simulação. A Figura 4 mostra os feixes fotoresistentes suspensos sob diferentes d valor. Verifica-se que a espessura da camada suspensa h está positivamente relacionado com d . Para fotorresiste NR26-25000P, h é 10,9 μm sob d =2 μm (Fig. 4a) e aumenta para 25,5 μm sob d =4 μm (Fig. 4e). Como d chega a 5 μm, a profundidade de exposição é grande o suficiente para atingir o substrato, e nenhuma estrutura suspensa é obtida (Fig. 4f). A Figura 4g – k mostra as estruturas suspensas do SU-8. A função de h vs. d para experimentos e simulações é ilustrado na Fig. 4l, onde as linhas retas são ajustadas pelo método dos mínimos quadrados. O coeficiente de correlação linear R das linhas ajustadas são R 2 =0,963, 0,988 e 0,858 para simulações sem contar a absorção, NR26-25000P e SU-8, respectivamente. Pode-se observar que os resultados dos experimentos do SU-8 estão muito próximos dos resultados da simulação. Em contraste, a camada suspensa de NR26-25000P é muito mais fina do que a da simulação sem absorção. Isso pode ser atribuído principalmente à propriedade transparente do SU-8 e à alta capacidade de absorção do NR26-25000P. É também por isso que a exposição cinza pode ser usada para fabricar estruturas suspensas para alguns fotoresiste, mas não é adequado para SU-8.
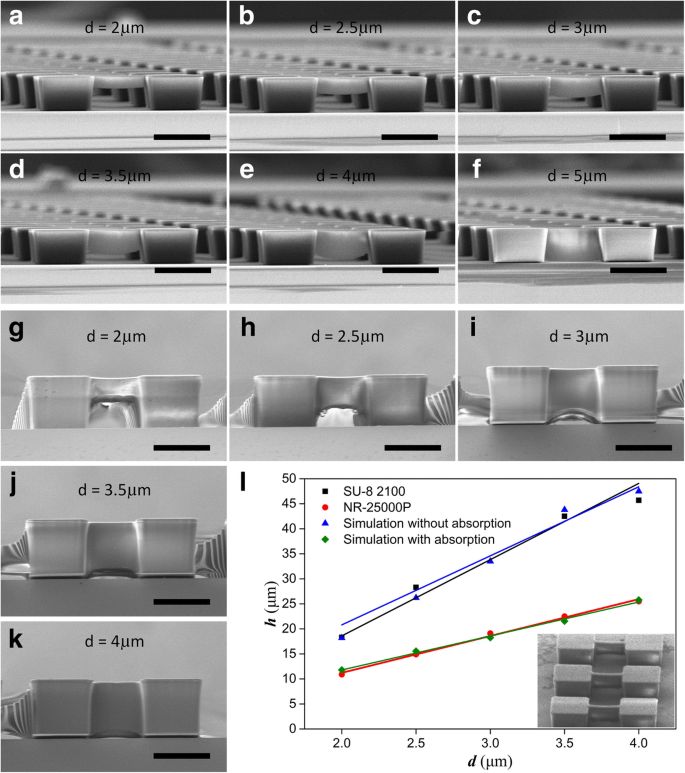
Os feixes de fotoresiste suspensos resultaram de litografia de difração de uma etapa com diferentes larguras de linha d usando o padrão de máscara na Fig. 3b. Feixes fotoresistentes NR26-25000P sob a d =2 μm, b 2,5 μm, c 3 μm, d 3,5 μm, e 4 μm e f 5 μm; Feixes fotoresistentes SU-8 2100 sob g d =2 μm, h 2,5 μm, i 3 μm, j 3,5 μm e k 4 μm; l as funções de espessura de exposição vs. largura de linha em simulação sem absorção, NR26-25000P e SU-8 2100 e simulações com coeficiente de absorção α =0,0374 μm −1 , onde a inserção mostra a visão inclinada das vigas suspensas do SU-8. A espessura dos feixes aumenta com a largura da linha do padrão de máscara. As barras de escala são 50 μm
Em seguida, introduzimos o coeficiente de absorção α no modelo óptico e realizar os cálculos com a fórmula (8). Os resultados em α =0,0374 μm −1 (o coeficiente de absorção de NR21-25000P a 365 nm, testado por um espectrofotômetro UV-visível, UV 2600, Shimadzu Co., Ltd.) são mostrados na Fig. 4l, onde a linha ajustada com R 2 =0,986 concorda bem com os resultados experimentais de NR26-25000P. Assim, nosso método está disponível para quase todos os tipos de fotoresiste de negativo espesso para fabricar estruturas suspensas com exposição de uma etapa, nas quais a profundidade de exposição pode ser guiada por meio de simulações.
A Figura 5a-c exibe os diversos padrões de conexão cruzada e os resultados de simulação correspondentes em z =15 μm. Três linhas são empilhadas lado a lado para fabricar uma viga suspensa ampla, onde a largura da linha e a largura do intervalo são de 2 μm. O padrão de conexão cruzada com um círculo de 20 μm é usado para fabricar um pilar para apoiar as vigas suspensas (Fig. 5a). Os padrões de conexão cruzada ocos são projetados para fabricar malhas suspensas, como mostrado na Fig. 5b, c. As conexões fotoresistentes NR26-25000P obtidas são mostradas na Fig. 5d-f, onde as texturas superficiais nas ligações cruzadas junto com os feixes podem ser claramente observadas, em boa concordância com as simulações (Fig. 5a-c). Malhas suspensas com os três tipos de conexões cruzadas são mostradas na Fig. 5g – i, e os pilares de suporte também são obtidos como esperado (Fig. 5g). A Figura 5h ilustra os pilares delgados sob as ligações cruzadas, devido aos padrões densos com razão elevada. O padrão de conexão cruzada na Fig. 5c possui uma relação de trabalho mais baixa, onde a intensidade da luz é fraca, resultando em uma malha totalmente suspensa (Fig. 5f). Assim, a proporção dos padrões de conexão cruzada pode ser reduzida para fabricar estruturas totalmente suspensas, enquanto os pilares de suporte podem ser facilmente formados com uma conexão sólida. Enquanto isso, a largura do feixe também pode ser controlada ajustando o número de padrões de linha empilhados.
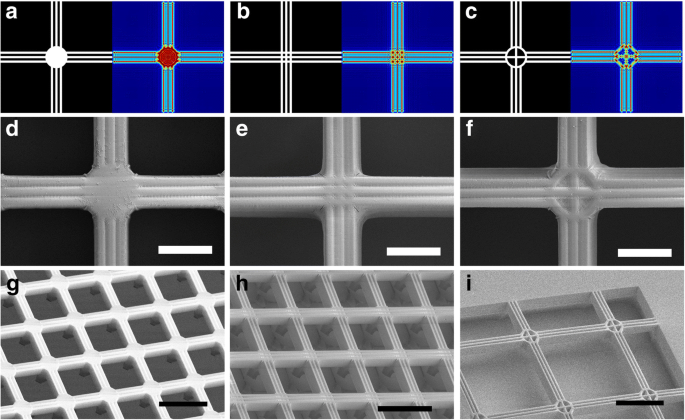
Diferentes padrões de conexão cruzada com NR26-25000P. a - c Três padrões de conexão cruzada na máscara e os resultados de simulação correspondentes em z =15 μm, onde a largura da linha é 2 μm com espaçamento de 2 μm e z é a distância entre o plano de seção e a fotomáscara. d - f As texturas na conexão cruzada fotoresiste obtida e os feixes largos, onde as barras de escala são de 20 μm. g As malhas suspensas com pilares de sustentação. h As malhas suspensas com pilares de suporte delgados, onde os pilares resultam dos padrões de ligações cruzadas densas com elevada proporção. eu Os padrões de malha totalmente suspensos. As barras de escala em g - i são 100 μm
Algumas microestruturas 3D complexas também foram fabricadas por meio de um método de exposição única (Fig. 6a-c, e, f) ou de duas etapas (Fig. 6d). Vigas suspensas com espessura de gradiente são mostradas na Fig. 6a, onde a largura dos padrões de linha varia de 2 a 4 μm e 4 a 6 μm nas duas regiões. A espessura da camada suspensa aumenta com o aumento da largura da linha, em linha com os resultados exibidos na Fig. 4. Anéis concêntricos suspensos e padrões de palavras suspensas também podem ser facilmente preparados (Fig. 6b, c). Combinando os dois processos de exposição, duas camadas suspensas foram integradas ao NR26-25000P, conforme mostrado na Fig. 6d. Após a conclusão da primeira exposição, a segunda camada é então revestida por centrifugação na primeira camada e exposta. As malhas empilhadas são obtidas após os dois processos de exposição seguidos de um processo de revelação. Uma vez que a segunda exposição pode causar danos à primeira camada, as estruturas precisam ser cuidadosamente otimizadas para fabricar estruturas suspensas multicamadas mais excelentes. As malhas suspensas fotoresistentes SU-8 com padrões de palavras também foram alcançadas com sucesso (Fig. 6d-f), embora seja mais difícil do que o NR26-25000P controlar os parâmetros de exposição devido à alta transparência.
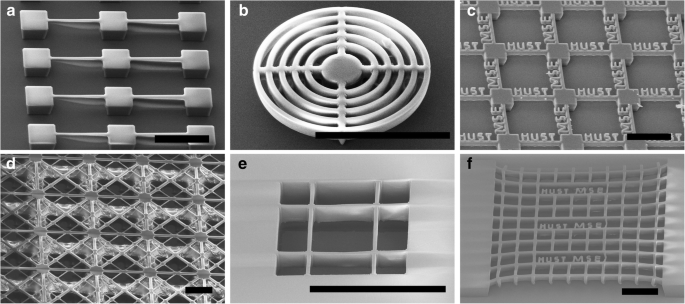
Estruturas fotorresistentes suspensas 3D. a Vigas suspensas com espessura gradiente, b anéis concêntricos suspensos, c estruturas de palavras suspensas e d malhas suspensas multicamadas, onde o fotorresiste é NR26-25000P. e Malha SU-8 suspensa. f Malhas SU-8 suspensas com padrões de palavras. As barras de escala são 100 μm. As estruturas suspensas em d é obtido por uma exposição de duas etapas, e os outros são fabricados com uma exposição de uma etapa
Comparado com trabalhos anteriores [2, 11, 22, 23], formamos um modelo de distribuição de intensidade de luz 3D no fotorresiste, utilizando a difração dos pequenos padrões de máscara. As estruturas suspensas 3D podem ser bem controladas e previstas por simulações. O coeficiente de absorção do fotorresiste também é levado em consideração aqui. Estruturas suspensas com várias espessuras, como vigas gradientes, são formadas facilmente por meio da exposição em uma etapa. Além disso, o processo de exposição é realizado com uma máscara comum em um modo de exposição por contato típico, e nenhuma máscara ou equipamento especial é necessário, exibindo excelente compatibilidade com alta resolução de fabricação.
Estruturas de carbono pirolítico
SU-8 é um precursor típico para a fabricação de microestruturas de carbono, enquanto outros fotorresistentes como o NR26-25000P não são capazes de sustentar as estruturas sob alta temperatura. A Figura 7a-c mostra as estruturas SU-8 suspensas enquanto as estruturas de carbono pirolíticas correspondentes são apresentadas na Fig. 7d-f. Grande retração ocorre durante o processo de pirólise devido às múltiplas reações concorrentes, incluindo desidrogenação, ciclização, condensação, transferência de hidrogênio e isomerização [8, 28]. Assim, existirá uma tensão residual considerável nas estruturas pirolíticas, especialmente nas estruturas assimétricas. Os feixes de carbono pirolítico encolherão e puxarão os pilares em ambas as extremidades, causando rachaduras na parte inferior (Fig. 7d). Quanto às malhas em grande escala, a tensão mantém um equilíbrio relativo em cada direção e nenhuma rachadura óbvia é encontrada nas estruturas de carbono pirolítico (Fig. 7e, f). São obtidas malhas de carbono autônomas com o tamanho de 12 mm × 20 mm, conforme mostrado na Fig. 7g – i. A resistência da folha das malhas de carbono é de cerca de 182 Ω / sq, e a transmitância de luz atinge ~ 67% em todo o comprimento de onda. As malhas de carbono preparadas com condutividade e transparência superiores podem ser aplicadas em células solares de perovskita como eletrodo [29,30,31], oferecendo um método disponível para a fabricação de células solares semitransparentes. Além disso, as malhas de carbono preparadas possuem excelente flexibilidade, demonstrando grande potencial nas aplicações de eletrodos transparentes flexíveis.

Malhas SU-8 suspensas e malhas de carbono pirolítico. a Vigas SU-8 suspensas. b , c Malhas SU-8 suspensas com pilares de apoio. d Vigas de carbono suspensas, onde grandes deformações permaneceram nas estruturas de carbono e rachaduras ocorreram na parte inferior do pilar. e , f Malhas de carbono suspensas. g Malha de carbono autônoma após pirólise. h Ampliação da malha de carbono autônoma. eu Malha de carbono autoportante de 12 mm × 20 mm, que apresenta boa flexibilidade e transparência. As barras de escala são 100 μm
Conclusões
Em resumo, demonstramos a fabricação de estruturas suspensas por meio de um novo método de litografia de difração baseado em máscara de uma etapa. A distribuição da intensidade da luz 3D no fotorresiste foi simulada, mostrando que a profundidade de exposição aumentou com o aumento da largura dos padrões de linha sob d <5 μm. Este fenômeno poderia ser utilizado para fabricar estruturas suspensas com espessura definida de fotoresiste SU-8, que era quase transparente e difícil de formar estruturas suspensas com litografia em tons de cinza. Os experimentos correspondentes também foram realizados aqui. Descobrimos que a espessura dos feixes SU-8 suspensos estava muito próxima dos resultados da simulação, enquanto a do NR26-25000P era muito mais fina do que a profundidade de exposição nas simulações. Isso foi causado pela alta propriedade de absorção de luz do NR26-25000P. Em seguida, o coeficiente de absorção do fotoresiste foi introduzido no modelo óptico, e os resultados da simulação concordaram bem com os experimentos. Três diferentes padrões de conexão cruzada foram projetados para a fabricação de malhas 3D suspensas com ou sem pilares de apoio, e as texturas de superfície foram bem replicadas. Malhas com pilares e malhas totalmente suspensas também foram realizadas com sucesso. Outras estruturas fotorresistentes suspensas 3D complexas, incluindo feixes suspensos com espessura de gradiente, anéis concêntricos suspensos e estruturas de palavras suspensas, foram obtidas por meio da litografia de difração baseada em máscara em uma etapa.
Estruturas suspensas de carbono e malhas de carbono independentes foram posteriormente fabricadas com um processo típico de pirólise em duas etapas. As estruturas de carbono 3D suspensas podem ser aplicadas em eletrodo eletroquímico, supercapacitor e sensores devido à sua grande área de superfície. As malhas independentes exibiram excelente condutividade, flexibilidade e alta transparência. Assim, desenvolvemos um método simplificado e promissor para a fabricação de estruturas suspensas 3D e malhas de carbono, que apresentou grande potencial nas aplicações de eletrodo transparente, células solares semitransparentes e dispositivos de armazenamento de energia.
Abreviações
- 3D:
-
Tridimensional
- C-MEMS:
-
Sistemas microeletromecânicos de carbono
Nanomateriais
- VISÃO:Para cegos
- Cientistas da IBM inventam um termômetro para nanoescala
- A importância dos modelos CAD para projetos de fabricação de metais
- Quais são as vantagens do aço inoxidável para projetos de fabricação?
- Quais são as vantagens do revestimento em pó para projetos de fabricação de metal?
- 5 dicas para escolher a empresa de fabricação personalizada certa
- As melhores maneiras de preparar sua oficina para uma nova máquina
- Obrigado pelas lembranças!
- Como selecionar os materiais de placa apropriados para fabricação de PCB flexível?
- Um foco em diretrizes de design importantes para a facilidade de fabricação de PCB



