Influência dominante da dispersão da rugosidade da interface no desempenho de lasers em cascata quântica GaN Terahertz
Resumo
O efeito da rugosidade da interface de poços quânticos, dopagem não intencional e desordem de liga no desempenho de lasers de cascata quântica de terahertz baseados em GaN (QCL) foi investigado pelo formalismo das funções de Green de não-equilíbrio. Verificou-se que a influência da desordem da liga no ganho óptico é insignificante e o doping não intencional deve ficar abaixo de uma concentração razoável de 10 17 cm −3 a fim de evitar a degradação do espalhamento de impurezas de elétrons e a absorção de portadores livres. Mais importante ainda, o espalhamento da rugosidade da interface é considerado o fator dominante na degradação do ganho óptico. Portanto, seu controle preciso durante a fabricação é fundamental. Finalmente, um ganho de 60 cm −1 pode ser obtido a 300 K, mostrando a possibilidade de fabricação de GaN Terahertz QCL à temperatura ambiente.
Introdução
A região espectral de Terahertz (THz) é um assunto de intensa pesquisa por causa de suas aplicações potenciais em controle de qualidade e segurança, diagnóstico médico e telecomunicações. No entanto, seu desenvolvimento tem sido prejudicado pela falta de dispositivos compactos disponíveis. O laser em cascata quântica (QCL) é um candidato promissor para o desenvolvimento de fontes de estado sólido THz poderosas [1, 2]. Até agora, o melhor THz QCL é baseado em GaAs, cuja temperatura máxima de operação é em torno de 200 K devido à baixa energia de LO-fônon (36 meV) do GaAs [3, 4]. Com a ajuda de um campo magnético, esta temperatura pode ser elevada até 225 K. No entanto, este método é inadequado para aplicações generalizadas [5, 6]. Quando a temperatura aumenta, os elétrons no estado de nível superior podem adquirir energia térmica suficiente para ativar relaxamentos não radiativos via emissão de fônon LO em direção ao estado de nível inferior, destruindo assim a inversão da população. Em comparação com GaAs, GaN tem energia LO-fônon muito maior (92 meV) e, portanto, fornece a possibilidade de produzir THz QCL operando em temperatura ambiente [7,8,9]. Além disso, QCLs baseados em GaAs não podem ser operados na faixa de frequência de 4,6–12 THz por causa de sua banda Reststrahlen, a região espectral onde o material é completamente opaco devido à absorção por fônons ópticos. A maior energia dos fônons ópticos em GaN abre perspectivas para dispositivos em cascata quântica THz, que podem operar em uma faixa espectral muito mais ampla entre 1 e 15 THz.
O primeiro passo de estudo em GaN THz QCLs foi o ajuste da transição intersubband (ISB) para o domínio do infravermelho distante. A absorção de ISB em frequências THz foi observada em poços quânticos baseados em nitreto polar [10, 11] e não polar (QWs) [12,13,14,15,16,17]. THz operando detectores baseados em ISB GaN foram demonstrados em 13 THz [18] e 10 THz [19], respectivamente. Nenhuma demonstração de eletroluminescência nesta faixa foi alcançada até agora, exceto por algum relatório controverso do grupo de Hirayama sobre a eletroluminescência espontânea de uma estrutura QCL [20, 21]. Vários estudos teóricos foram publicados [7, 9, 22,23,24,25,26], entre eles, alguns investigam os fatores limitantes do desempenho do GaN THz QCL, como o ganho de alargamento do espectro devido a interações muito fortes entre elétrons e fônons LO em GaN [23].
Neste artigo, propomos completar esses estudos analisando outros fatores que podem danificar o ganho óptico de THz GaN QCL, como rugosidade de interface de poços quânticos, dopagem não intencional e desordem de liga. Verificou-se que a influência da desordem da liga no ganho óptico é insignificante e o doping não intencional deve ficar abaixo de uma concentração razoável de 10 17 cm −3 a fim de prevenir a degradação do espalhamento de impurezas de elétrons e absorção de portadores livres [27]. Finalmente, descobrimos que o espalhamento da rugosidade da interface é o fator dominante na degradação do ganho óptico. E um ganho de 60 cm −1 pode ser obtido a 300 K, o que está bem acima da perda teórica de um guia de ondas de metal duplo, mostrando a possibilidade de fabricar GaN THz QCL à temperatura ambiente.
Métodos
É sabido que a fabricação de dispositivos GaN THz QCL precisa crescer em regiões ativas espessas com baixas densidades de deslocamento. Esta tarefa é desafiadora por causa da incompatibilidade de rede entre GaN e AlGaN [28]. Outros fatores indesejáveis provenientes da epitaxia também podem aparecer:rugosidade da interface (IFR) dependendo da condição de crescimento, dopagem não intencional tipo n (nid) proveniente da incorporação de impurezas (principalmente oxigênio) durante o crescimento e distúrbio da liga (DA) originado da superfície de Ga segregação e baixa mobilidade Al adatom. Para investigar como esses fenômenos influenciam o desempenho do THz GaN QCL, usamos o formalismo das funções de Green de não-equilíbrio (NEGF). Os cálculos são realizados usando o software Nextnano QCL [29,30,31]. Este modelo inclui relaxamento induzido pela rugosidade da interface, impurezas ionizadas, desordem de liga, fônon LO, fônon acústico ou interação elétron-elétron. Empregamos um QCL de três poços quânticos com um esquema de despovoamento de fônons ressonantes, uma vez que o projeto THz QCL fornece a maior temperatura de operação até agora [3, 32]. A Figura 1a mostra a estrutura da região ativa projetada. A sequência de camadas para uma estrutura quântica AlGaN / estrutura quântica AlGaN é 1,6 /6.2/1.6 /3.4/1.0 /3,4 nm, onde os itálicos mostram a espessura das barreiras. A Figura 1b mostra o diagrama da banda de condução da estrutura QCL projetada em uma polarização de - 84,5 kV / cm. Do período anterior à direita, os elétrons são injetados por tunelamento ressonante no estado lasing superior, marcado por 1. Em seguida, eles passam por uma transição radiativa para o estado lasing inferior 2. Este estado lasing inferior é despovoado através do tunelamento para o estado 3. Finalmente, os elétrons relaxam no estado 4 pela emissão de fônons LO. O processo é repetido para cada período.
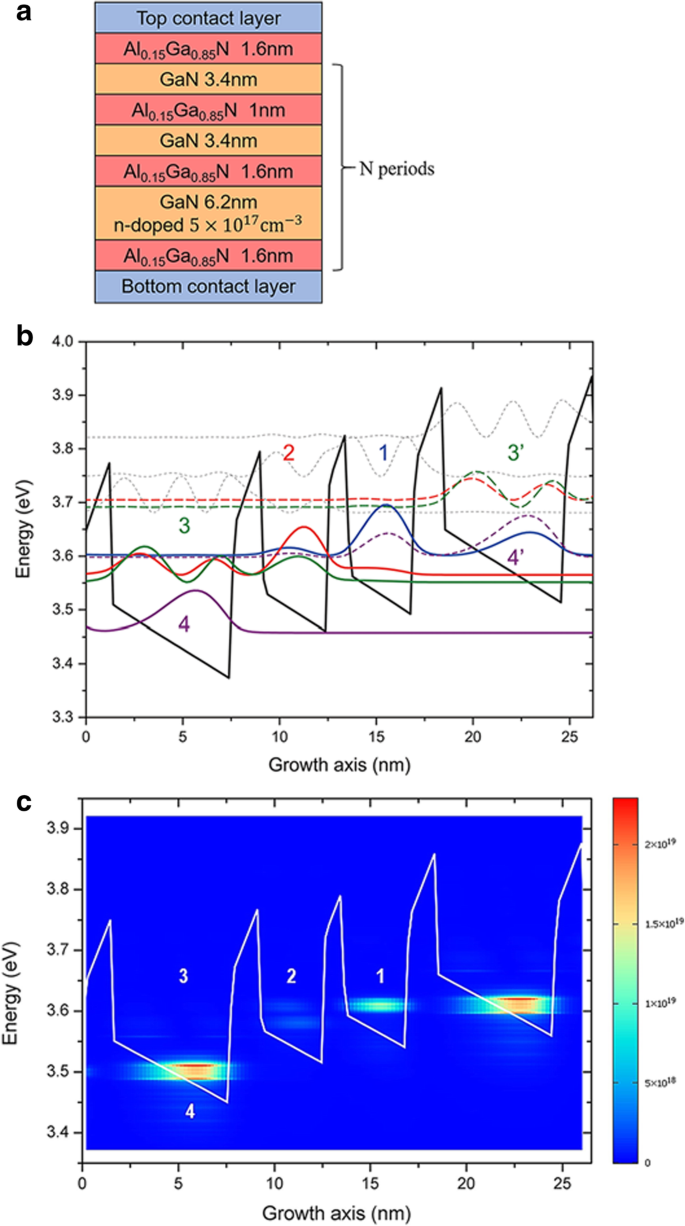
Estrutura de região ativa projetada, perfil de banda de condução, funções de envelope quadrado e densidades de portadores. a A sequência de camadas para um período é 1,6 /6.2/1.6 /3.4/1.0 / 3,4 nm. As barreiras são indicadas em fonte itálica. O poço de 6,2 nm de espessura é n-dopado com n =5 × 10 17 cm −3 . b Perfil de banda de condução e funções de envelope quadrado do GaN / Al 0,15 Ga 0,85 N QCL considerado neste estudo. Um campo elétrico de - 84,5 kV / cm é aplicado. c Densidades de portadora e banda de condução do QCL calculadas no modelo NEGF. O campo elétrico aplicado é - 84,5 kV / cm. A temperatura é fixada em 10 K.
No cálculo, usamos os parâmetros normalmente encontrados na estrutura crescida de GaN / AlGaN com epitaxia de feixe molecular assistido por plasma (PAMBE):uma rugosidade de interface de 0,25 nm [33] com um comprimento de correlação de 1 nm e um n- não intencionalmente dopagem com uma concentração de portador de 10 17 cm −3 . O espalhamento de desordem de liga também está incluído na simulação.
Resultados e discussão
A Figura 1c mostra as densidades de portadores calculadas desta estrutura na polarização operacional de - 84,5 kV / cm. Observamos o anti-cruzamento entre o período anterior e o estado lasing superior 1. Vemos também que o estado lasing inferior 2 é despovoado por fônon ressonante nos estados 3 e 4. Para analisar e comparar a influência do IFR, nid, e AD, calculamos nosso ganho óptico GaN THz QCL e características de corrente para várias configurações:a configuração de referência levando IFR, nid e AD em consideração, uma configuração sem IFR, outra sem nid e uma última sem AD. A Figura 2 mostra o ganho óptico máximo vs frequência (a) e densidades de corrente vs campo elétrico aplicado (b) para cada configuração calculada a uma temperatura de 10 K. A estrutura de referência mostra um ganho de pico de 142 cm −1 a 8,7 THz, frequência inacessível para material de arsenetos. Vamos ver como n.i.d influencia nosso desempenho de QCL. Sem n.i.d, o ganho de pico é de 127 cm −1 em 8.46 THz. A queda de ganho se deve ao fato de que a concentração de portadores diminui no estado de laser superior após a retirada de elétrons vindos de n.i.d. De fato, na configuração de referência, a concentração de elétrons do estado laser superior e inferior é ∆N = N 1 - N 2 =5,43 × 10 12 cm −2 , enquanto sem n.i.d torna-se ∆N = N 1 - N 2 =5,06 × 10 12 cm −2 . O campo elétrico aplicado muda de -84,5 para -81,6 kV / cm. O limite de corrente cai e muda de 25,11 kA / cm 2 a - 84,49 kV / cm a 17,11 kA / cm 2 em - 93,24 kV / cm. A queda na densidade da corrente pode ser atribuída à redução do espalhamento de impurezas de elétrons, que aumenta o transporte de elétrons no cálculo sem n.i.d. Outra sugestão desta hipótese é o pico a -64 kV / cm que vemos no caso sem as características das densidades de corrente n.i.d. Este é um túnel ressonante entre períodos entre 4 'e 3 (não mostrado aqui). Este fenômeno é oculto pelo espalhamento de impurezas de elétrons nas características da corrente levando em consideração n.i.d. O limite de corrente e o deslocamento do campo elétrico aplicado são atribuídos ao desalinhamento da banda de condução entre a configuração com ou sem n.i.d. Curiosamente, embora o pico de ganho seja maior no caso n.i.d, observamos um alargamento do espectro de ganho, a assinatura da influência de impurezas carregadas [31] O doping não intencional deve permanecer em uma concentração razoável de 10 17 cm −3 para evitar a degradação do espalhamento de impurezas de elétrons e a absorção de portadores livres. Na configuração sem espalhamento AD, o ganho de pico é 147 cm −1 em 8,7 THz. Observamos que o ganho de pico está na mesma frequência com ou sem espalhamento AD. O ganho óptico só obtém um aumento marginal de 3% quando o espalhamento AD não é incluído no cálculo. As características atuais também são quase idênticas. Como nosso projeto usa um baixo teor de alumínio de 15% e barreiras bastante finas (1–1,5 nm), a influência do espalhamento AD neste QCL é desprezível.

Simulado ganho óptico máximo vs simulações de campo elétrico de frequência e corrente para diferentes processos de espalhamento. a Ganho óptico simulado vs frequência levando em consideração diferentes processos de espalhamento. b Simulações de campo elétrico de corrente do GaN THz QCL levando em consideração diferentes parâmetros de espalhamento. A temperatura é definida em 10 K
Pelo contrário, a influência do espalhamento IFR no desempenho do dispositivo é importante. Sem espalhamento IFR, observamos um ganho de pico de 191 cm −1 em 8,7 THz. O limite de densidade da corrente é 24,08 kA / cm 2 . Este aumento de ganho de 34% e a queda do limiar de densidade de corrente refletem o fato de que muitos elétrons são transportados por espalhamento IFR. Quanto mais espalhamento IFR, menos espalhamento radiativo existe para lasing. Ao comparar a população de elétrons de configuração de referência do estado laser superior e inferior ∆N = N 1 - N 2 =6,6 × 10 12 - 1,27 × 10 12 =5,43 × 10 12 cm −2 para aquele sem IFR ∆N = N 1 - N 2 =7,4 × 10 12 - 1,17 × 10 12 =6,23 × 10 12 cm −2 , pode-se ver que a população de elétrons do estado superior é maior. Isso se deve ao tempo de vida do estado de laser superior, que aumenta devido à ausência de espalhamento IFR. Em comparação ao caso sem nid, nas características das densidades de corrente do dispositivo sem espalhamento IFR, observamos um pico em - 67 kV / cm, assinatura do túnel ressonante interperíodo entre 4 'e 3. Este fenômeno é mais visível no caso, sem levar em consideração o processo de espalhamento IFR. Esta é uma prova de sua predominância sobre o tunelamento ressonante. Com essas observações, destacamos a predominância da influência do espalhamento IFR no desempenho do THz GaN QCL.
Depois de notar a importância do espalhamento IFR no desempenho do THz. Investigamos mais detalhadamente, variando o tamanho do IFR. Adicionamos ao nosso estudo o caso de IFR =0,5 nm e 0,75 nm. O comprimento de correlação é mantido em 1 nm. Na figura 3, mostramos o ganho máximo vs frequência (a) e densidades de corrente vs características do campo elétrico aplicado (b). Primeiro, observamos que para IFR =0,5 nm, o ganho óptico máximo diminui para 47,9 cm −1 e até mesmo cai drasticamente para - 8,8 cm −1 perder ganho óptico para IFR =0,75 nm. O aumento do ganho em função do comprimento IFR também é evidente. Como podemos ver nas características do I-V, conforme o tamanho do IFR aumenta, seu papel no espalhamento de elétrons aumenta, aumentando as densidades de corrente e diminuindo o túnel ressonante e o processo de espalhamento radiativo nos dispositivos. Este efeito se torna evidente ao comparar a configuração de referência de IFR =0,25 nm com o caso extremo de IFR =0,75 nm, população de elétrons do estado de laser superior e inferior caindo de ∆N =5,43 × 10 12 cm −2 para ∆N = N 1 - N 2 =3,71 × 10 12 cm −2 .
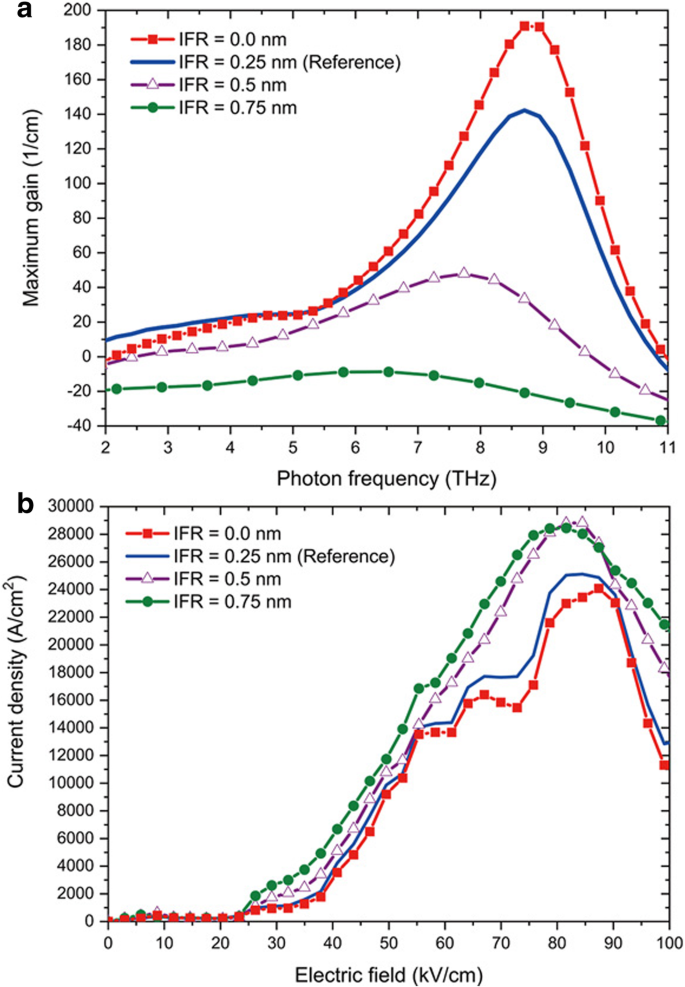
Ganho óptico máximo simulado vs simulações de frequência e campo elétrico de corrente para diferentes IFR. a Ganho óptico máximo simulado vs frequência para diferentes IFR. b Simulações de campo elétrico de corrente do GaN THz QCL levando em consideração diferentes IFR. A temperatura é definida em 10 K
Este último diminui ao ponto que não podemos mais ver lasing nos dispositivos. Como já apontado em estudos anteriores usando THz QCL baseado em GaAs [25, 34,35,36], destacamos a importância de considerar o tamanho do IFR durante a epitaxia e de mantê-lo menor que 0,5 nm para a fabricação de GaN THz QCL para ser capaz de para fornecer ganho óptico positivo.
Uma vantagem do GaN THz QCL é seu potencial de operar a uma temperatura mais alta do que o THz QCL baseado em GaAs. Nesta parte, analisamos o desempenho do nosso dispositivo em função da temperatura operacional. Continuamos usando nossos dispositivos de referência com IFR =0,25 nm, n.i.d e AD incluído no cálculo. A Figura 4 mostra o ganho óptico máximo para diferentes temperaturas de rede. O valor de ganho é estável de 10 a 150 K em cerca de 142 cm −1 , começa a diminuir entre 150 e 250 K, para cair para 61 cm −1 a 300 K. De fato, conforme a temperatura aumenta, a inversão da população diminui devido ao preenchimento térmico e o aumento do espalhamento de fônon LO induz o alargamento do ganho. Este valor de ganho óptico de 61 cm −1 ainda é maior do que a perda de um guia de onda de metal duplo GaN THz QCL (30 cm −1 ), mostrando que este projeto GaN THz QCL deve ser capaz de operar em temperatura ambiente. Também mencionamos que além de ser capaz de operar em temperatura ambiente, o THz QCL baseado em GaN tem outra vantagem:por causa de sua maior concentração de dopagem, menor índice de refração e menor duração do período, eles têm o potencial de fornecer ganho óptico muito maior do que em sua contraparte GaAs. Nosso projeto fornece um valor de ganho óptico razoavelmente alto de 142 cm −1 a 10 K, que é um bom exemplo.
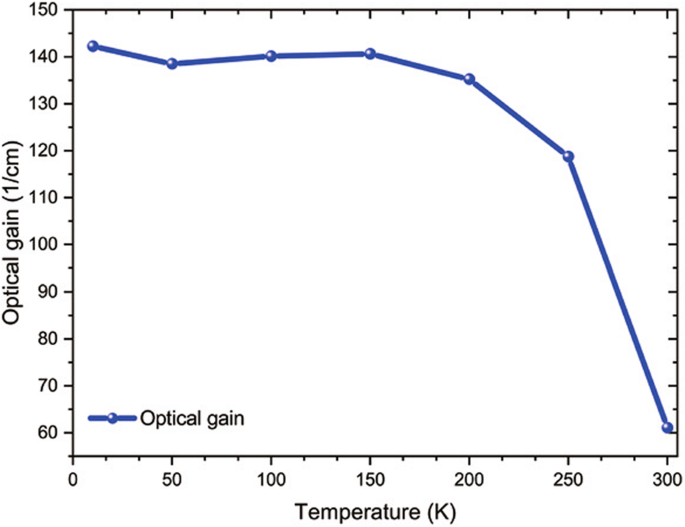
Características do ganho máximo calculado vs temperatura da rede
Conclusões
Em conclusão, relatamos um projeto GaN THz QCLs operando a 8,7 THz. A simulação mostra um ganho óptico de 142 cm −1 a 10 K e 60 cm −1 à temperatura ambiente. Dentre os fenômenos indesejados originados da epitaxia, calculamos a influência da rugosidade da interface, dopagem não intencional e desordem da liga no desempenho do ganho de GaN THz QCL. A influência da desordem da liga é desprezível:o ganho óptico cai apenas de 147 para 142 cm −1 ao adicionar dispersão de desordem de liga na simulação. O doping não intencional deve ser levado em consideração no projeto para evitar o desalinhamento da banda de condução. Observamos o deslocamento do campo elétrico aplicado de -84,5 para -81,6 kV / cm induzido por n.i.d em nosso estudo. Finalmente, observamos uma grande disparidade no ganho óptico para diferentes valores de rugosidade da interface:191, 142, 47,9 e - 8,8 cm −1 para rugosidade da interface igual a 0, 0,25, 0,5 e 0,75 nm, respectivamente. É por isso que identificamos a influência dominante do espalhamento da rugosidade da interface na degradação do ganho óptico. Este trabalho fornece rotas para a otimização do desempenho da futura fabricação de GaN THz QCL.
Disponibilidade de dados e materiais
Os conjuntos de dados gerados durante e / ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente mediante solicitação razoável.
Abreviações
- AD:
-
Desordem de liga
- IFR:
-
Rugosidade da interface
- ISB:
-
Intersubband
- n.i.d:
-
Doping não intencional
- NEGF:
-
Funções de nenhumquilibrium Green
- QCL:
-
Laser em cascata quântica
Nanomateriais
- Influência do molibdênio no desempenho do aço inoxidável
- Introdução à banda Terahertz
- O desempenho da fibra de vidro
- Influência da Água na Estrutura e Propriedades Dielétricas da Microcristalina e Nano-Celulose
- Lasers de cascata quântica DFB emissores de substrato de baixo consumo de energia
- Camadas ótimas de dopagem de silício de barreiras quânticas na sequência de crescimento, formando potencial de confinamento suave de oito períodos em 0,2Ga0,8N / GaN poços quânticos de azul LED…
- Desempenho fotovoltaico de uma célula solar nanofio / ponto quântico híbrido de nanoestrutura
- Fotocondutividade entre bandas de pontos quânticos InAs / InGaAs metamórficos na janela de 1,3-1,55 μm
- Compreendendo o mecanismo de crescimento de camadas epitaxiais de GaN em grafite esfoliado mecanicamente
- Matrizes cônicas de laser Quantum Cascade Integradas com Cavidades Talbot



