Fotocondutividade entre bandas de pontos quânticos InAs / InGaAs metamórficos na janela de 1,3-1,55 μm
Resumo
Propriedades fotoelétricas do metamórfico InAs / In x Ga 1 - x As nanoestruturas como ponto quântico (QD) foram estudadas em temperatura ambiente, empregando espectroscopias de fotocondutividade (PC) e fotoluminescência, medidas elétricas e modelagem teórica. Quatro amostras com diferente estequiometria de In x Ga 1 - x À medida que a camada de revestimento cresceu:conteúdo de índio x foi 0,15, 0,24, 0,28 e 0,31. InAs / In 0,15 Ga 0,85 Como a estrutura QD foi considerada fotossensível na faixa de telecomunicações a 1,3 μm. Como x aumenta, um desvio para o vermelho foi observado para todas as amostras, a estrutura com x =0,31 foi considerado sensível perto de 1,55 μm, ou seja, na terceira janela de telecomunicações. Simultaneamente, apenas uma ligeira diminuição no QD PC foi registrada para aumentar x , confirmando assim uma boa fotorresposta comparável com a de In 0,15 Ga 0,75 Como estruturas e de nanoestruturas QD baseadas em GaAs. Além disso, a redução do PC está correlacionada com a redução semelhante da intensidade da fotoluminescência. Simulando teoricamente o sistema quântico de energia e a localização dos portadores em QDs, pudemos entender o mecanismo do PC e sugerir razões para a redução da fotocorrente, associando-as a comportamentos peculiares de defeitos em tal tipo de estruturas. Tudo isso implica que QDs metamórficos com um alto x são estruturas válidas para dispositivos optoeletrônicos sensíveis à luz infravermelha.
Histórico
InAs / In metamórfico x Ga 1 - x As nanoestruturas como QD têm atraído muito interesse na última década devido a muitos benefícios [1,2,3,4,5,6,7]. Sua característica mais atraente é que, ao aumentar os QDs em um buffer metamórfico InGaAs (MB), pode-se obter uma redução significativa da energia de transição entre os níveis de QD [8] em relação às estruturas QD de In (Ga) As / GaAs convencionais . Isso ocorre devido à diminuição do bandgap de InAs QD como resultado da redução da incompatibilidade de rede entre InAs QDs e InGaAs buffer e, portanto, a deformação em QDs [9,10,11]. Assim, a aplicação de um MB como um material de confinamento permite deslocar o valor do comprimento de onda de emissão mais profundamente na faixa do infravermelho (IR), em particular, nas janelas de telecomunicações em 1,3 e 1,55 μm, mantendo uma alta eficiência [4, 12, 13]. Além disso, os QDs metamórficos têm mostrado propriedades interessantes, como (i) uma alta densidade de QD [14], (ii) a possibilidade de ajustar amplamente os níveis de QD e camada de umedecimento (WL) [10, 15], e (iii) bons desempenhos de elementos ativos em dispositivos emissores de luz [16]. No entanto, as investigações recentes de níveis profundos em QDs metamórficos mostraram que, apesar de InAs / In 0,15 Ga 0,85 Como estruturas QD tendo uma densidade total de defeitos perto da camada QD comparável àquela dos QDs pseudomórficos de InGaAs / GaAs, estruturas metamórficas com maior x demonstrou maiores densidades de defeito [17, 18].
Estruturas de QD de InAs metamórficas encontraram aplicações bem-sucedidas no projeto e fabricação de dispositivos fotônicos infravermelhos e sensíveis à luz, como lasers [19, 20], fontes de fóton único [3, 7, 21, 22] e células solares [23 , 24,25]. Os fotodetectores In (Ga) As QD baseados em transições interbanda e interbanda são atualmente investigados ativamente para detecção aprimorada de faixas de infravermelho próximo a infravermelho de onda longa devido à sua resposta à irradiação em incidência normal [26,27,28,29,30] . Por exemplo, as transições intersubband de elétrons entre níveis confinados quânticos e estados contínuos podem ser projetadas incorporando QDs InAs em camadas InGaAs [29,30,31,32], pois este projeto permite ajustar o comprimento de onda do pico de detecção, para controlar o resposta por uma polarização aplicada externamente e para reduzir a corrente escura [33, 34]. Até o momento, não há trabalhos sobre a implementação de estruturas QD metamórficas em fotodetectores.
O papel fundamental para o desenvolvimento desta área é a preservação de uma alta eficiência de emissão e fotossensibilidade de estruturas QD metamórficas que precisam ser pelo menos comparáveis com aquelas de estruturas QD InAs / GaAs convencionais [1, 5, 35]. Muitos estudos foram realizados nos campos fundamental e de aplicação para desenvolver projetos de estruturas [6, 14, 21], para melhorar as propriedades fotoelétricas [5, 13] e para controlar / reduzir defeitos relacionados à deformação nas heteroestruturas [4, 36, 37].
Portanto, InAs / In x Ga 1 - x As nanoestruturas QD metamórficas são nanoestruturas interessantes, que permitem ter emissão ou fotorresposta nas faixas de infravermelho 1,3 e 1,55 µm [1,2,3,4,5,6,7]. Além disso, foi relatado por nós anteriormente que InAs / In verticais 0,15 Ga 0,75 As estruturas QD podem manter a fotossensibilidade comparável às baseadas em GaAs [5]. No entanto, tais estruturas metamórficas são raramente estudadas em medições fotoelétricas com uma geometria lateral, onde a fotocorrente prossegue através do transporte no plano de portadoras através dos canais entre dois contatos superiores. Comumente, as camadas QD junto com o WL associado formam esses canais de condutividade nas estruturas baseadas em GaAs projetadas em geometria lateral [38]. Devido a este tipo peculiar de condutividade, acredita-se que os fotodetectores QD com o transporte lateral tenham potencial para uma alta fotorresponsividade [39, 40]. Um estudo aprofundado das nanoestruturas metamórficas InAs / InGaAs QD na configuração lateral pode fornecer um conhecimento fundamental sobre o mecanismo de fotocondutividade (PC) e a eficiência do transporte de portadores em plano. Em nosso recente artigo dedicado aos defeitos em estruturas QD metamórficas [17], relatamos medições laterais de PC em baixas temperaturas, considerando apenas as bordas dos espectros de IV originadas dos defeitos. No entanto, acreditamos que uma caracterização adequada e investigação fundamental da estrutura em temperatura ambiente pode fornecer insights preciosos para novas melhorias de novos dispositivos sensíveis à luz como fotodetectores infravermelhos próximos, matrizes lineares e matrizes de câmeras, implementando QDs metamórficos.
No presente trabalho, estudamos propriedades fotoelétricas em plano do metamórfico InAs / In x Ga 1 - x As nanoestruturas QD crescidas por epitaxia de feixe molecular com diferentes Em composição x , empregando espectroscopias de PC e fotoluminescência (PL), medições elétricas laterais e cálculos de modelagem. Em particular, nos concentramos na observação de um possível desvio para o vermelho da fotorresposta da camada QD em direção ao IR além de 1,3 μm, preservando a fotossensibilidade para In 0,15 Ga 0,85 Estruturas sensíveis à luz As e GaAs QD. Uma alta fotossensibilidade na faixa de comprimento de onda do infravermelho próximo à temperatura ambiente é uma indicação de que essas nanoestruturas podem ser úteis não apenas para dispositivos baseados em transições entre bandas, mas também para fotodetectores entre bandas trabalhando além de 10 μm.
Métodos
Preparação e descrição da amostra
As estruturas estudadas esquematicamente mostradas na Fig. 1 foram cultivadas por epitaxia de feixe molecular. Em primeiro lugar, um substrato semi-isolante (100) GaAs foi coberto por um tampão GaAs de 100 nm de espessura a 600 ° C, seguido pela deposição de um InGaAs MB não dopado de 500 nm de espessura a 490 ° C. Então, após a interrupção prévia do crescimento de 210 s para resfriar o substrato, 3,0 MLs (monocamadas) de InAs foram cultivadas a 460 ° C. Finalmente, esses QDs auto-montados foram cobertos por 20 nm de In x não dopado Ga 1 - x Tal como acontece com a mesma estequiometria MB. Quatro amostras com diferente estequiometria de In x Ga 1 - x Como a camada de revestimento foi fabricada:No conteúdo x foi 0,15, 0,24, 0,28 e 0,31.
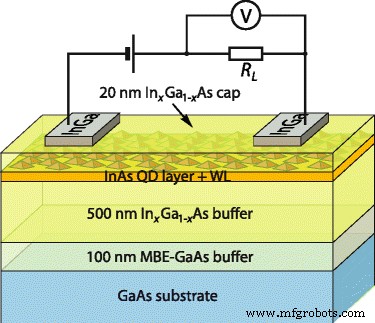
Color online. Esquema do metamórfico InAs / In x Ga 1 - x Como estruturas QD e sua conexão para as medições fotoelétricas
Modelagem Teórica
Para o projeto da estrutura metamórfica, bem como a compreensão do perfil de energia, os cálculos do sistema de energia quântica composto por In (Ga) As QDs, MB não dopado e camada de cobertura foram realizados usando o software Tibercad [41] que demonstramos ser adequado para simular as propriedades ópticas de nanoestruturas semicondutoras de baixa dimensão [2, 15, 42].
Consideramos um InAs QD com forma cônica truncada e tamanhos retirados de dados experimentais de microscopia de força atômica [14]; incluímos a presença de InAs WL, cujos parâmetros dependem do In x Ga 1 - x Como propriedades da camada metamórfica [15].
Em primeiro lugar, são feitos cálculos de deformação para a estrutura, calculando os componentes do tensor de deformação do QD, induzida pela incompatibilidade f QD entre o QD e o MB, definido como
$$ {f} _ {\ mathrm {QD}} =\ left [{a} _ {\ mathrm {InAs}} \ hbox {-} {a} _ {\ mathrm {MB}} (x) \ right ] / {a} _ {\ mathrm {MB}} (x) $$ (1)
onde a MB ( x ) é o parâmetro de rede de In x Ga 1 - x Como MB e a InAs é o parâmetro de rede do InAs. Então, os perfis de banda para QDs e camadas de incorporação dependem dos potenciais de deformação dos materiais relevantes (InAs para QDs e WLs e InGaAs relaxado para MB).
Finalmente, a equação de Schrödinger
$$ \ boldsymbol {H} \ psi =E \ psi $$ (2)
é resolvido na aproximação da função de envelope por uma abordagem de banda única e massa efetiva para elétrons e abordagem de 6 bandas k • p para buracos, onde o Hamiltoniano 3D é
$$ \ widehat {H} =- \ frac {\ upeta ^ 2} {2} {\ nabla} _ {\ mathbf {r}} \ left (\ frac {1} {m \ left (E, \ mathbf { r} \ direita)} \ direita) {\ nabla} _ {\ mathbf {r}} + V \ esquerda (\ mathbf {r} \ direita), $$ (3)
com V ( r ) sendo o potencial 3D.
Tal aproximação é considerada satisfatória ao realizar o cálculo do estado fundamental do QD [2]. Níveis de solo para elétrons e buracos pesados são assim obtidos, juntamente com suas densidades de probabilidade. As energias de emissão da fotoluminescência foram derivadas tomando a diferença de energia entre níveis confinados para elétrons e buracos pesados, reduzida em 20 meV para levar em consideração os efeitos excitônicos.
Uma descrição mais detalhada dos cálculos do modelo pode ser encontrada na Ref. [2].
Caracterização fotoelétrica
Para as medidas fotoelétricas laterais, dois contatos de superfície eutética InGa foram depositados sobre pedaços de 5 × 2 mm das estruturas. Medido linear I - V as características dadas na Fig. 2 confirmaram a ohmicidade do contato. A corrente que flui através das amostras foi medida por um multímetro Siglent SDM3055, usando uma técnica DC padrão [43, 44] como uma queda de tensão através de uma resistência de carga em série R L de 1 MΩ, que era muito menor do que a resistência da amostra. A fotocorrente foi excitada por uma lâmpada de halogênio de 250 W dispersa com um monocromo de prisma, e os espectros de PC foram registrados na faixa de 0,6 a 1,6 eV [44,45,46]. Os espectros foram normalizados para o número de quanta de excitação da fonte de luz. Os espectros de PL foram obtidos usando um laser de 532 nm como fonte de excitação com uma densidade de potência de 5 W / cm 2 . Todas as medições foram realizadas à temperatura ambiente (300 K).

Color online. eu - V características do InAs / In x Ga 1 - x Como estruturas com x =0,15 ( a ), 0,24 ( b ), 0,28 ( c ), e 0,31 ( d ) para o escuro (preto) e sob uma iluminação de 350 μW / cm 2 (cor) em energias de pico do espectro PL (excitação QD) e 1,3 eV (absorção efetiva em InGaAs). Inserções:dependências da fotocorrente na tensão de polarização
Resultados e discussão
Espectros de PC dos InAs / In metamórficos estudados x Ga 1 - x As estruturas QD à temperatura ambiente são apresentadas na Fig. 3 juntamente com as bandas PL, que mostram as transições ópticas entre os estados fundamentais QD. As intensidades e posições relativas das bandas PL também são mostradas na Fig. 4b. Características devido aos QDs, camadas confinantes de InGaAs e camadas inferiores de GaAs são observadas nas curvas de PC. O sinal de fotocorrente nas energias abaixo dos onsets da banda PL pode estar relacionado aos defeitos de estrutura detectados anteriormente [17].

Color online. Espectros de PC dos InAs / In metamórficos x Ga 1 - x Como estruturas à temperatura ambiente e uma polarização de 11 V para x =0,15 ( a ), 0,24 ( b ), 0,28 ( c ), e 0,31 ( d ) As intensidades de excitação para as curvas preta, vermelha e azul a 1,3 eV correspondem a 88, 350 e 1400 μW / cm 2 , respectivamente. Os espectros PL em unidades arbitrárias são dados para o posicionamento de energia das transições de estado fundamental QD. As setas verticais marcam os bandgaps InGaAs (ε g ) calculado de acordo com Paul et al. [48] e posições espectrais, onde as dependências de PC na intensidade de excitação foram medidas (dado na Fig. 5)

Color online. Cálculos de modelagem para os InAs / In metamórficos x Ga 1 - x Como estruturas QD: a perfis de banda nas estruturas com diferentes x ao longo do eixo de crescimento; b as bandas QD PL reais e suas posições de pico calculadas (verticais tracejadas); e c densidades de probabilidade dos elétrons confinados e lacunas para o InAs / In 0,15 Ga 0,85 Como QD. Todos os cálculos das estruturas modeladas foram realizados para 300 K
O InAs / In metamórfico investigado 0,15 Ga 0,85 Como a estrutura QD foi considerada fotossensível na faixa de telecomunicações a 0,95 eV (1,3 μm) (Fig. 3a). Como x aumentou, um desvio para o vermelho foi observado para todas as amostras:a estrutura com x =0,31 foi encontrado para ser sensível perto de 0,8 eV (1,55 μm) (Fig. 3d), ou seja, na terceira janela de telecomunicações [47]. A mudança está relacionada à redução da incompatibilidade de rede entre os materiais de InAs QD e In x Ga 1 - x Como buffer com um aumento em x e, portanto, uma diminuição na tensão em QDs. Isso leva a um estreitamento do bandgap InAs QD e, por sua vez, ao redshift da banda PL, bem como ao início da fotorresposta em direção a IR [1,2,3,4,5,6, 19, 35].
Simultaneamente, apenas uma ligeira diminuição no sinal de fotocorrente QD foi registrada, confirmando assim a preservação de uma boa fotorresposta, comparável com a de In 0,15 Ga 0,75 Como amostra. Como discutimos recentemente [5], estruturas QD metamórficas com x =0,15 mostram uma fotorresposta muito semelhante àquelas de nanoestruturas pseudomórficas InAs / GaAs QD. Além disso, a redução de PC se correlaciona com a de PL, como pode ser visto na Fig. 3.
Tal efeito para nossas amostras acabou sendo mais notável na Fig. 2, onde o I - V as dependências no escuro e sob iluminação em diferentes pontos espectrais característicos da tensão de polarização são mostradas, junto com as dependências de fotocorrente nas inserções. Como na Fig. 3, o valor da fotocorrente implica apenas a parte fotoinduzida da corrente obtida da corrente total sob iluminação subtraindo o valor da corrente escura. Esses pontos espectrais são os máximos da banda PL e 1,3 eV, onde ocorre uma absorção banda a banda efetiva em InGaAs MB. Bem como para o escuro eu - V características, essas dependências são lineares dentro do erro experimental.
A melhor fotorresposta foi medida na estrutura com o conteúdo mínimo de In nas camadas confinantes. Ele também tinha a corrente escura mais baixa. O valor da fotocorrente no nível de excitação aplicado (350 μW / cm 2 ) no InAs / In 0,15 Ga 0,85 A estrutura estava duas a três vezes acima da corrente escura quando o MB foi bombeado. A fotorresposta na excitação QD foi comparável à corrente escura; entretanto, deve-se considerar que nossas estruturas possuíam apenas uma camada QD. A fabricação das estruturas QD multicamadas certamente levaria a um aumento significativo na fotorresposta IR. Outras estruturas com x maiores revelou sinais de fotocorrente mais baixos; as magnitudes detectadas em ambos os pontos espectrais foram aproximadamente uma ordem inferior aos valores da corrente escura em uma ampla faixa da voltagem aplicada. A menor fotorresposta foi encontrada para InAs / In 0,31 Ga 0,69 Como estrutura com o conteúdo máximo de MB In.
Muito provavelmente, esta diminuição da fotorresponsividade está relacionada a um aumento na densidade do defeito MB com x , que foi determinada anteriormente para essas estruturas, empregando espectroscopia de corrente estimulada termicamente de nível profundo [17], que se correlacionou bem com a análise estrutural de tais nanoestruturas [1]. Relatamos que o InAs / In 0,15 Ga 0,85 Como a estrutura QD tinha uma densidade total de defeitos próxima à camada QD comparável aos de InGaAs / GaAs, enquanto outras estruturas com maiores teores de In demonstraram maiores densidades de defeitos, como os conhecidos complexos de defeitos pontuais relacionados a GaAs EL2, EL6, EL7, EL9 e EL10 perto da camada QD e três níveis atribuídos a defeitos estendidos que se propagam através do buffer.
Em relação à forma do espectro (Fig. 3), acima da excitação QD, a absorção de luz e, portanto, a geração de portadores ocorrem principalmente no MB em energias acima do bandgap da camada confinante de InGaAs ε g , que valoriza para diferentes x foram estimados por uma fórmula empírica [48]. No entanto, é digno de nota que um aumento na energia do fóton acima de ε g leva a uma ligeira diminuição da fotorresposta. Naturalmente, isso confirma que os QDs metamórficos, apesar de serem centros de recombinação eficazes [1, 2, 12, 22], são contribuintes mais eficientes para a fotocorrente do que os MB [5, 6, 23].
Para entender o mecanismo de PC desta peculiaridade, deve-se olhar a Fig. 4a, onde mostramos os perfis de banda QD calculados ao longo da direção de crescimento para nossas amostras. Os cálculos são validados pelo resultado dos níveis de energia quântica para elétrons e lacunas:as energias de emissão PL esperadas estão de acordo com a transição de estado fundamental PL QD medida experimentalmente (Fig. 4b). Na Fig. 4c, mostramos as densidades de probabilidade simuladas para elétrons confinados e lacunas, obtidas pelas funções de onda portadora calculadas com a modelização Tibercad, que indicam um maior nível de localização para buracos pesados em comparação com elétrons.
A fim de contribuir para o sinal de fotocorrente, os pares elétron-buraco gerados pela absorção interband QD têm que escapar dos QDs por emissão térmica. Em um estudo anterior [49], foi estabelecido que em QDs metamórficos e buracos pesados escapam simultaneamente de QDs como pares correlacionados. Além disso, também foi demonstrado que a energia de ativação para tal processo corresponde à soma das energias de ativação para as duas partículas [50].
Ao estudar a extinção térmica da emissão PL de QDs metamórficos [10, 51], provamos que tais energias de ativação são iguais à soma da distância de energia dos níveis WL e estados QD e vão de 250 meV para x =0,15 até 150 meV para x =0,31. Conforme amplamente discutido na Ref. [51], esses valores causam uma forte extinção da emissão de PL em temperatura ambiente por meio do escape térmico de portadores confinados.
Com base nisso, podemos inferir que os portadores excitados em QDs podem escapar termicamente para WL e MB:lá, elétrons e buracos pesados são separados pela curvatura de banda na vizinhança de QD (Fig. 4a), o que promove o aprisionamento de buraco de volta para QDs e, embora seja uma barreira para elétrons, suprime efetivamente sua recombinação radiativa. Como consequência, buracos pesados estão concentrados na periferia QD (Fig. 4c), enquanto os elétrons estão livres para se mover ao longo do poço de potencial de WL e MB, contribuindo para a condutividade. É importante notar que na Ref. [49], discute-se que, embora correlacionados durante o processo de escape, os portadores não podem ser considerados como excitons à temperatura ambiente; doravante, eles podem ser facilmente separados pela curvatura da banda na vizinhança dos QDs.
Caso contrário, ao excitar o MB, buracos de não equilíbrio são gerados nas camadas confinantes e se recombinar com os elétrons. Deve ser mencionado aqui que o WL é conhecido por ser um canal de condutividade para nanoestruturas baseado em GaAs [52] e, em nossas estruturas laterais projetadas com contatos de superfície, não há heterojunção, então os portadores são eficientemente coletados próximo ao plano da superfície.
Na Fig. 3, a queda do sinal do PC logo acima de ε g transformou-se no aumento em energias mais altas, por exemplo, acima de 1,3 ou 1,1 eV para amostra com x de 0,15 ou 0,31, respectivamente. Isso foi possivelmente causado pela absorção óptica mais perto da superfície e da camada QD, envolvendo armadilhas mais rasas. Conforme estabelecido para essas estruturas por espectroscopia de corrente estimulada termicamente e espectroscopia transiente de nível profundo [17, 18], as armadilhas de elétrons mais profundas estão localizadas principalmente na camada InGaAs MB, enquanto as mais rasas estão concentradas perto da superfície (em relação a essas amostras, perto da camada QD). Os elétrons presos nas armadilhas mais rasas podem escapar mais facilmente de volta para a banda de condução em temperatura ambiente. Assim, elétrons livres próximos à camada QD são mais móveis do que aqueles excitados mais profundamente no MB e, portanto, dão uma contribuição maior para a transferência de carga. Além disso, os elétrons, sendo gerados perto da superfície, podem se transferir livremente para o canal de condutividade WL.
Uma queda semelhante de fotocorrente após um aumento acima do bandgap de GaAs (próximo a 1,4 eV) foi observada. Este efeito pode ser devido à geração de portadores perto da interface InGaAs / GaAs, que é conhecida por ter uma maior densidade de estados de defeito sendo armadilhas e centros de recombinação.
A contribuição relativa de diferentes transições ópticas para a fotorresposta da estrutura variou com a intensidade de bombeamento. Isso é melhor observado na Fig. 5, que mostra os valores de fotocorrente em função da intensidade de excitação em diferentes pontos espectrais característicos:o início da banda PL (excitação ressonante do conjunto QD) ou absorção banda a banda eficiente em InGaAs (1,3 eV) e GaAs (1,5 eV).
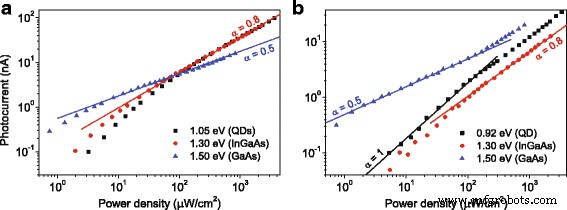
Color online. Intensidade de fotocorrente vs excitação para o InAs / In x Ga 1 - x Como estruturas com a x =0,15 e b 0,31. As linhas são ajustadas por funções f ( x ) ~ x α
As estruturas com diferentes conteúdos de In nas camadas confinantes demonstraram dependências semelhantes em faixas espectrais equivalentes. Portanto, a excitação banda a banda em GaAs (1,5 eV) mostra uma dependência quadrática na maioria dos valores de intensidade. Isso é típico para a recombinação banda-a-banda de portadores de carga fora do equilíbrio, por exemplo, quando eles são altamente predominantes sob os portadores de equilíbrio [53]:isso é esperado em nossas estruturas não dopadas. As dependências no caso de excitação nas camadas confinantes de QD e InGaAs são muito semelhantes entre si, mas diferentes daquelas para GaAs. Eles são lineares em baixas intensidades de excitação e tornam-se sublineares em intensidades mais altas. Esse comportamento obviamente aponta para a recombinação de portadoras envolvendo centros Shockley-Read:a dependência linear torna-se sublinear, pois alguns dos centros estão saturados em taxas de geração de portadoras mais altas [54]. Estes resultados de medições dependentes de intensidade indicam distintamente uma geração eficiente de portadores de carga principal a uma taxa de recombinação relativamente baixa em camadas de incorporação de QD e uma densidade muito maior de centros de recombinação em camadas de GaAs. Por exemplo, durante a excitação QD em caracterizações semelhantes, as estruturas fotossensíveis InGaAs / GaAs QD mostraram uma dependência da intensidade como PC ( eu ) ~ Eu 0,25 , que ocorreu devido a uma alta taxa de recombinação não radiativa através dos níveis de defeito junto com a recombinação radiativa QD [40, 55]. Porém, é importante notar que a estrutura do InGaAs / GaAs foi multicamadas com sete camadas QD.
A partir dessas medições e sua interpretação, algumas indicações para o uso de QDs metamórficos para detecção de IV podem ser destacadas:(i) ao usar x > 0,15, projetos avançados que permitem controlar defeitos relacionados à deformação devem ser usados, semelhante ao que foi feito para o desenvolvimento de QDs metamórficos [19, 20, 37]; (ii) pilhas multicamadas de QDs (com um mínimo de 10 camadas) são necessárias para obter um QD PC acima da corrente escura [27, 56]; e (iii) como um confinamento mais alto de buracos pesados é benéfico para a fotocorrente obtida ao excitar QDs, projetos avançados com barreiras de lacuna mais alta para buracos pesados podem ser considerados [51, 57]. Portanto, esses achados podem ser muito úteis para o projeto de QDs metamórficos visando a detecção de infravermelho e o desenvolvimento de fotodetectores QD metamórficos.
Conclusões
Propriedades fotoelétricas do metamórfico InAs / In x Ga 1 - x As nanoestruturas como QD foram estudadas em temperatura ambiente, empregando espectroscopias PC e PL, medições elétricas e simulações de modelos teóricos. Os InAs / In metamórficos estudados x Ga 1 - x Como as nanoestruturas QD foram consideradas fotossensíveis nas janelas de telecomunicações em 1,3 ( x =0,15) e 1,55 μm ( x =0,31). No entanto, o QD PC, bem como as eficiências PL das estruturas com maiores teores de In em MB foram estimadas como menores e, no entanto, comparáveis àquelas do InAs / In 0,15 Ga 0,85 Como estrutura, que tem sensibilidade semelhante às estruturas QD de InGaAs / GaAs. Esta redução da fotorresponsividade está relacionada a um aumento na densidade do defeito MB com x . Além disso, graças aos cálculos de modelagem, fornecemos insights sobre o mecanismo de PC no tipo investigado de estruturas QD. Tudo isso implica que QDs metamórficos com um alto x são estruturas válidas para dispositivos optoeletrônicos sensíveis à luz IR, desde que alguns pontos de preocupação sejam abordados pela otimização do projeto da nanoestrutura.
Abreviações
- ε g :
-
Bandgap da camada confinante InGaAs
- E c e E v :
-
Energia das bandas de condutividade e valência
- IR:
-
Infravermelho
- MB:
-
Tampão metamórfico
- ML:
-
Monocamada
- PC:
-
Fotocondutividade
- PL:
-
Fotoluminescência
- QD:
-
Ponto quântico
- R L :
-
A resistência de carga
- WL:
-
Camada de umedecimento
Nanomateriais
- N, N-Dimetilformamida regulando a fluorescência de pontos quânticos MXene para a determinação sensível de Fe3 +
- Fonte de fóton único brilhante a 1,3 μm com base no ponto quântico InAs Bilayer no micropilar
- Síntese de pontos quânticos de carbono co-dopados com N, S ricos em piridínicos como imitações de enzimas eficazes
- Detectando Exciton Espacialmente Localizada em Superredes de Pontos Quânticos Auto-Organizados InAs / InGaAs:Uma Forma de Melhorar a Eficiência Fotovoltaica
- Pontos quânticos de bismuto em poços quânticos de GaAsBi / AlAs recozidos
- Efeitos bipolares na fotovoltagem de heteroestruturas de pontos quânticos de InAs / InGaAs / GaAs metamórficos:soluções de caracterização e design para dispositivos sensíveis à luz
- Uma abordagem simples para sintetizar pontos quânticos de carbono fluorescentes de águas residuais de Tofu
- Síntese de pontos quânticos de sulfeto de antimônio solúvel em água e suas propriedades fotoelétricas
- Síntese sonoquímica fácil de uma etapa e propriedades fotocatalíticas de compostos de pontos quânticos de grafeno / Ag3PO4
- Uma visão geral completa do barramento de dados:conecte os pontos!



