Estratégia de Otimização da Carga de Absorção Separada 4H-SiC e Estrutura de Fotodiodo de Avalanche de Multiplicação para Eficiência de Detecção de Ultravioleta Alta
Resumo
Neste trabalho, investigações paramétricas sobre otimização estrutural são sistematicamente feitas para o fotodiodo ultravioleta de avalanche de avalanche (UV APD) baseado em 4H-SiC, carga de absorção separada e multiplicação (SACM). De acordo com nossos resultados, a tensão de ruptura pode ser fortemente afetada pela espessura da camada de multiplicação e pela concentração de dopagem da camada de controle de carga. A espessura para a camada de contato ôhmica tipo n, a camada de absorção e a camada de controle de carga podem afetar notavelmente a profundidade de penetração da luz, o que influencia correspondentemente o número de pares de elétrons-orifícios fotogerados e, portanto, a espessura da camada acima mencionada tem um forte impacto na responsividade para SACM APD. Para aumentar a responsividade do APD, exigimos uma altura de barreira de banda de energia reduzida na interface da camada de absorção óptica e a camada de controle de carga, de modo que o transporte de portador promovido para a camada de multiplicação possa ser favorecido. Além disso, investigamos mesas chanfradas positivas com ângulos menores de forma a reduzir o campo elétrico na borda da mesa. Assim, a corrente escura é correspondentemente suprimida.
Introdução
Como um material semicondutor de amplo bandgap, o carboneto de silício (SiC) e o nitreto de alumínio e gálio (AlGaN) exibem excelentes características de material, como campo elétrico altamente crítico, melhor efeito anti-radiação e boa condutividade térmica, o que o torna adequado para ultravioleta (UV) detecção [1,2,3]. O intervalo de banda ajustável entre 3,4 e 6,2 eV para os fotodetectores baseados em AlGaN permite o comprimento de onda de resposta de corte controlável variando de 365 a 200 nm. No entanto, devido à dificuldade em cultivar compostos AlGaN ricos em Al de alta qualidade, a corrente escura para os fotodetectores baseados em AlGaN é maior do que em contrapartes baseadas em SiC [4]. Portanto, os fotodetectores baseados em SiC ganharam amplo interesse em pesquisas. Até o momento, os detectores ultravioleta de estado sólido baseados em 4H-SiC compreendem diodo de barreira Schottky, fotodiodo de metal semicondutor de metal (MSM), fotodiodo p-i-n e fotodiodo de avalanche (APD) [5,6,7,8,9]. Devido ao alto ganho de avalanche, a pequena corrente escura e o baixo ruído, os APDs ultravioleta 4H-SiC têm grandes perspectivas de aplicação em muitos campos de ponta que requerem detecção de sinal ultravioleta fraco, como aviso de incêndio, comunicação quântica e detecção de mísseis [ 10,11,12]. No entanto, o material de SiC tem um baixo coeficiente de absorção de luz, portanto, uma estrutura de fotodiodo comum com uma fina camada de multiplicação é difícil de alcançar alta eficiência quântica. O problema não é resolvido até que a estrutura APD de carga de absorção e multiplicação separada (SACM) seja proposta. Por um lado, a luz ultravioleta pode ser efetivamente absorvida pela camada de absorção e, por outro lado, o alto ganho interno pode ser obtido na camada de multiplicação de alto campo por meio do processo de ionização por impacto. O processo de ionização por impacto na camada de multiplicação pode ser encerrado pela camada de controle de carga [13, 14]. A vantagem para a estrutura do SACM decorre do ruído reduzido, pois apenas um único tipo de portadores fotogerados com maior taxa de ionização pode ser injetado na camada de multiplicação [15, 16]. Para obter uma alta detectividade para sinal ultravioleta fraco, SACM APDs com grande área de detecção ativa devem ser fabricados [17]. No entanto, o tamanho aumentado do dispositivo é acompanhado pela corrente de fuga de superfície significativamente melhorada e corrente de fuga em massa. Portanto, isso não apenas impõe uma exigência estrita sobre a qualidade do wafer epitaxial de SiC, mas também reflete um grande desafio para o processo de fabricação do dispositivo e design do dispositivo. Nas últimas décadas, a Cree Company promoveu bastante a tecnologia de crescimento epitaxial para filmes de SiC, o que, portanto, levou ainda mais à melhoria contínua da qualidade cristalina. Mais recentemente, Zhou et al. propuseram uma técnica de refluxo fotoresiste de temperatura variável para criar paredes laterais muito lisas para a mesa APD 4H-SiC chanfrada [18], que permite um alto ganho de multiplicação de mais de 10 6 e uma corrente escura baixa de ~ 0,2 nA / cm 2 . No entanto, a pesquisa anterior concentrou-se mais na melhoria da qualidade do material e na otimização da tecnologia de fabricação para SACM APDs [19,20,21], enquanto o impacto do projeto estrutural no transporte de portadores fotogerados e na detectividade da fotocorrente raramente foi discutido até agora . Portanto, nesta carta, investigamos sistematicamente o desempenho optoeletrônico para APDs ultravioleta SACM baseados em 4H-SiC de área grande com diferentes designs estruturais. Enquanto isso, imagens físicas perspicazes e discussões também são fornecidas. Acreditamos que os resultados deste trabalho são úteis para os pesquisadores otimizarem os APDs 4H-SiC a um custo menor.
Como se sabe, a multiplicação dos portadores em larga escala é gerada quando ocorre a ionização por impacto, que, no entanto, é fortemente influenciada pela espessura da camada de multiplicação e pela concentração de dopagem da camada de controle de carga. O campo elétrico muito forte é produzido na camada de multiplicação para possibilitar a ionização por impacto. O campo elétrico pode ser encerrado pela camada de controle de carga por causa da maior concentração de dopagem nela. Além disso, também descobrimos que, ao modular a banda de energia entre a camada de absorção e a camada de controle de carga, somos capazes de ajustar a responsividade espectral. Uma adoção razoável de uma mesa chanfrada positiva pode alcançar uma redução significativa no campo elétrico da superfície da parede lateral, o que é útil para suprimir a corrente escura e a quebra da borda. Análise detalhada e discussões serão conduzidas posteriormente.
Métodos de pesquisa e modelos de física
A Figura 1a mostra a vista esquemática em corte transversal para um APD 4H-SiC SACM padrão empregado neste trabalho, que possui n + -tipo de camada 4H-SiC como substrato. Então, a pilha arquitetônica compreende um p + de 3 μm de espessura -tipo camada ( N a =1 × 10 19 cm −3 ) servindo como camada de contato ôhmico tipo p, um n - de 0,5 μm de espessura -tipo camada de multiplicação ( N d =1 × 10 15 cm −3 ) para multiplicação de portadores, uma camada de controle de carga do tipo n com 0,2 μm de espessura ( N d =5 × 10 18 cm −3 ) para encerrar o processo de ionização por impacto e um n - de 0,5 μm de espessura - tipo camada de absorção ( N d =1 × 10 15 cm −3 ) para absorver os fótons que chegam. No topo da estrutura do dispositivo, há um n + de 0,3 μm de espessura - tipo camada de contato ôhmica ( N d =1 × 10 19 cm −3 ) Um ângulo de bisel positivo ( θ =8 °) é criado para a estrutura da mesa para suprimir a quebra da aresta [22, 23]. O diâmetro dos APDs SACM 4H-SiC é 800 μm. Ambos os contatos cátodo e ânodo são considerados contatos ôhmicos ideais em nossos cálculos. De acordo com as Fig. 1c e d, nossos resultados ilustram que os resultados calculados para a estrutura de APD 4H-SiC SACM padrão acima mencionada exibem a corrente escura de 2,5 nA / cm 2 , a tensão de ruptura de 161,6 V e a responsividade de pico de 0,11 A / W no comprimento de onda de 280 nm. As características de corrente-tensão calculadas e responsividade para 4H-SiC SACM APD padrão são consistentes com os dados experimentais. Isso prova plenamente que a ionização de impacto, coeficiente de absorção de material 4H-SiC, equação de Poisson, equação de continuidade de corrente e equações de deriva-difusão usadas neste trabalho são razoáveis. Aqui, tomamos a estrutura da Fig. 1a como referência de pesquisa, enquanto as variáveis investigadas incluem o ângulo da mesa chanfrada, a espessura e a concentração de dopagem para cada camada.
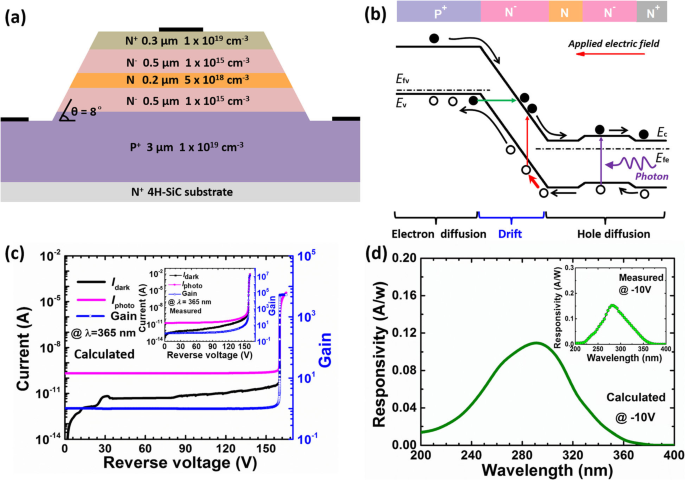
a Estrutura esquemática em corte transversal (não desenhada em escala), b diagrama esquemático da banda de energia sob polarização reversa para 4H-SiC SACM APD padrão, c calculou as características de corrente-tensão e o ganho de multiplicação, e d calculou as características de resposta espectral na tensão reversa de 10 V para o APD 4H-SiC SACM padrão. Figura inserida em c mostra as características de corrente-tensão medidas e o ganho de multiplicação. Figura inserida em d mostra características de resposta espectral medidas para 4H-SiC SACM APD padrão polarizado em - 10 V
Para melhor compreender o impacto de diferentes variáveis estruturais nas propriedades fotoelétricas para 4H-SiC SACM APDs, a Fig. 1b mostra o diagrama esquemático da banda de energia sob polarização reversa. Os pares de elétron-buraco foto-gerados na camada de absorção irão se difundir na camada de multiplicação por meio da camada de controle de carga. Depois que os pares de elétrons-lacunas foto-gerados atingirem a região de multiplicação, eles serão separados pelo campo elétrico esgotado. Os furos irão, então, experimentar o processo de multiplicação na camada de multiplicação, o que dá origem ao ganho de corrente interno. Enquanto isso, os elétrons fotogerados retornarão ao cátodo e serão convertidos em corrente sem sofrer ionização por impacto. Fatores importantes que influenciam a fotocorrente incluem os perfis de campo elétrico na camada de multiplicação, o alinhamento da banda de energia na camada de controle de carga, a camada de absorção e a camada de contato ôhmica do tipo n, na qual qualquer barreira de energia pode impedir o transporte do portador. Também é importante notar que os perfis de campo elétrico na camada de multiplicação podem ser determinados pelas concentrações de dopagem tanto para a camada de multiplicação quanto para a camada de controle de carga. Enquanto isso, o ângulo da mesa chanfrado também está substancialmente associado à distribuição do campo elétrico. Devemos também prestar atenção à espessura de cada camada para garantir o processo de difusão de portadores de alta eficiência. Portanto, é importante estudar sistematicamente esses parâmetros estruturais chave para otimizar o desempenho do dispositivo.
As investigações numéricas são conduzidas pela APSYS, que pode resolver equações de continuidade de corrente, equações de Poisson e equações de deriva-difusão de forma consistente com as condições de contorno adequadas. Ambos os processos de ionização de impacto e tunelamento Zener foram incluídos nas equações de difusão de deriva. O espalhamento de portadora-portadora para o processo de transporte de portadora também foi incluído no modelo de mobilidade de baixo campo. O tempo de vida da recombinação Shockley-Read-Hall (SRH) é assumido em 1 μs [24]. Especificamente, o campo ( E ) dependência dos coeficientes de ionização de impacto para elétrons ( α n ) e orifícios ( β p ) para camadas baseadas em 4H-SiC podem ser expressas pelas fórmulas de Chynoweth (1) e (2) como segue, respectivamente [25]:
$$ {\ alpha} _n =1,98 \ times {10} ^ 6 \ exp \ left [- {\ left (\ frac {9,46 \ times {10} ^ 6} {E} \ right)} ^ {1,42} \ direita] {\ mathrm {cm}} ^ {- 1} $$ (1) $$ {\ beta} _p =4,38 \ vezes {10} ^ 6 \ exp \ left [- {\ left (\ frac {1,14 \ vezes {10} ^ 7} {E} \ right)} ^ {1.06} \ right] {\ mathrm {cm}} ^ {- 1} $$ (2)
O coeficiente de absorção (∂) em termos de diferentes comprimentos de onda (λ) para material 4H-SiC é calculado pela seguinte Eq. (3) [26]:
$$ \ partial =-790,3 + 18,2 \ uplambda -0,17 {\ uplambda} ^ 2 + 8,57 \ vezes {10} ^ {- 4} {\ uplambda} ^ 3-2,39 \ vezes {10} ^ {- 6} { \ uplambda} ^ 4 + 3,53 \ vezes {10} ^ {- 9} {\ uplambda} ^ 5-2,16 \ vezes {10} ^ {- 12} {\ uplambda} ^ 6 $$ (3)
Os outros parâmetros de materiais usados nos modelos numéricos podem ser encontrados em outro lugar [27]. Os cálculos são baseados no método dos elementos finitos, que requer que os usuários ajustem adequadamente as distribuições da malha para fazer cálculos precisos.
Resultados e discussões
Impacto dos parâmetros estruturais para a camada de contato ôhmico tipo n no desempenho fotoelétrico
A fim de investigar o efeito da espessura e da concentração de dopagem para a camada de contato ôhmica do tipo n no desempenho fotoelétrico, projetamos dispositivos de referência, dispositivos L1 a L4 e dispositivos A1 a A4, respectivamente. Observe que o dispositivo de referência é a estrutura SACM APD básica, conforme mostrado na Fig. 1a. Outros APDs propostos são idênticos ao dispositivo de referência, exceto a camada de contato ôhmica SiC tipo n, a informação estrutural detalhada para a qual é apresentada na Tabela 1.
Em primeiro lugar, mostramos a tensão de ruptura em termos da espessura para a camada de contato ôhmica SiC tipo n na Fig. 2a, isto é, dispositivos L1 a L4. A inserção da Fig. 2a demonstra seletivamente a corrente escura, a fotocorrente sob a iluminação de 365 nm e o ganho para o dispositivo L1. Para o dispositivo L1, a tensão de ruptura é de ~ 161,6 V e a densidade de corrente escura permanece no nível de ~ 2,5 nA / cm 2 quando a polarização é inferior a 161,6 V. Observe que a tensão de ruptura é obtida na corrente de 10 −5 A. A corrente escura aumenta quando ocorre o processo de ionização por impacto. O nível de fotocorrente torna-se alto na região linear quando a iluminação de 365 nm brilha no dispositivo, e isso mostra que o ganho de multiplicação pode ser superior a 10 3 para o dispositivo L1 na tensão reversa de 161,6 V. A tensão de ruptura de avalanche para os cinco APDs investigados está resumida na Fig. 2a. Na Fig. 2a, podemos obter que a espessura da camada de contato ôhmica do tipo n tem efeito desprezível na tensão de ruptura. Para revelar o mecanismo subjacente para as observações, calculamos e mostramos a distribuição do campo elétrico vertical para o dispositivo de referência e os dispositivos L1 a L4 na Fig. 2b, que ilustra que a camada de controle de carga confina o limite para a região de depleção e o campo elétrico em a camada de multiplicação. Portanto, podemos especular que a camada de contato ôhmica do tipo n não afetará os perfis do campo elétrico na camada de multiplicação e isso é comprovado na Fig. 2b. As observações na Fig. 2b também interpretam a tensão de ruptura idêntica na Fig. 2a para o dispositivo de referência e os dispositivos L1 a L4. A seguir, mostramos a corrente fotogerada para os cinco dispositivos da Fig. 2c. Para melhor resolução, coletamos a corrente foto-gerada na polarização de 100 V, que é mostrada na inserção da Fig 2c. Podemos ver que a corrente fotogerada diminui com o aumento da espessura da camada de contato ôhmica do tipo n. Uma camada de contato ôhmica do tipo n muito espessa fará com que os portadores fotogerados tenham recombinação não radiativa e, de forma correspondente, reduz a corrente de difusão. Com a corrente fotogerada, podemos obter a responsividade espectral para o dispositivo de referência e os dispositivos L1 a L4 na tensão reversa de 100 V na Fig. 2d. O comprimento de onda de resposta de pico para os cinco dispositivos investigados é centrado em 280 nm. A responsividade diminui com o aumento da espessura da camada de contato do tipo n, o que está de acordo com a inserção da Fig. 2c. Portanto, resumimos aqui que a espessura da camada de contato ôhmico 4H-SiC tipo n deve ser adequadamente fina para evitar o aumento da recombinação não radiativa e a redução da corrente de difusão.

a Tensão de ruptura, b distribuição vertical do campo elétrico dos APDs do SACM polarizados em - 160 V, c características de fotocorrente-tensão sob iluminação de 280 nm, e d características de resposta espectral dos APDs SACM polarizados em - 100 V para o dispositivo de referência e dispositivos L1 a L4 com diferentes espessuras de camada de contato ôhmico tipo n, respectivamente. Figura inserida em a mostra as características de corrente-tensão calculadas e o ganho de multiplicação para o dispositivo L1. Figura inserida em c mostra a fotocorrente para o dispositivo de referência e os dispositivos L1 a L4 polarizados em - 100 V
Em seguida, investigamos a tensão de ruptura como uma função da concentração de dopagem na camada de contato ôhmica do tipo n, analisando o dispositivo de referência e os dispositivos A1 a A4 na Fig. 3a. A inserção na Fig. 3a apresenta a corrente escura, a corrente fotogerada e o ganho em termos da polarização aplicada para o dispositivo A1. A tensão de ruptura é definida quando a corrente atinge 10 −5 A. De acordo com a Fig. 3a, a tensão de ruptura dificilmente depende da concentração de dopagem na camada de contato ôhmica 4H-SiC tipo n. Como foi demonstrado anteriormente, a camada de controle de carga pode confinar eficazmente a região de depleção e o campo elétrico na camada de multiplicação. Portanto, a variação da concentração de dopagem na camada de contato ôhmica do tipo n não afeta a distribuição do campo elétrico dentro do dispositivo [ver Fig. 3b]. Em seguida, calculamos e mostramos a corrente gerada por foto em termos de polarização aplicada para o dispositivo de referência e os dispositivos A1 a A4 na Fig. 3c. Pode ser visto na Fig. 3c que a concentração de dopagem da camada de contato ôhmica do tipo n tem efeito desprezível na polarização da fotocorrente. A responsividade espectral em diferentes comprimentos de onda para os cinco dispositivos investigados é mostrada na Fig. 3d. Os dados são calculados na voltagem reversa de 100 V. O comprimento de onda com responsividade máxima de ~ 0,11 A / W é 280 nm. Sendo consistente com a Fig. 3c, a responsividade é menos dependente da concentração de dopagem na camada de contato ôhmica do tipo n. Portanto, concluímos que a responsividade é mais influenciada pela espessura do que a concentração de dopagem para a camada de contato ôhmica tipo n para 4H-SiC SACM APDs. Também sugerimos aumentar o comprimento de difusão do portador com o objetivo de aumentar a responsividade.

a Tensão de ruptura, b distribuição vertical do campo elétrico dos APDs do SACM polarizados em - 160 V, c características de fotocorrente-tensão sob iluminação de 280 nm, e d características de resposta espectral dos APDs SACM polarizados em - 100 V para o dispositivo de referência e os dispositivos A1 a A4 com diferentes concentrações de dopagem de camada de contato ôhmica do tipo n, respectivamente. Figura inserida em a mostra as características de corrente-tensão calculadas e o ganho de multiplicação para o dispositivo A1. Figura inserida em c mostra a fotocorrente para o dispositivo de referência e os dispositivos A1 a A4 polarizados em - 100 V
Impacto dos parâmetros estruturais da camada de absorção no desempenho fotoelétrico
Nesta seção, o impacto da espessura e da concentração de dopagem para a camada de absorção no desempenho fotoelétrico para APDs SACM baseados em 4H-SiC é estudado. As informações estruturais detalhadas da camada de absorção para SACM APDs são resumidas e mostradas na Tabela 2. Os dispositivos M1 a M4 e os dispositivos B1 a B4 são estruturalmente idênticos ao dispositivo de referência, exceto a camada de absorção. Os dispositivos M1 a M4 têm espessuras diferentes, enquanto os dispositivos B1 a B4 possuem várias concentrações de dopagem para a camada de absorção.
Ao usar o dispositivo de referência e os dispositivos M1 a M4, a Fig. 4a mostra a tensão de ruptura em termos de diferentes espessuras para a camada de absorção. Para fins de demonstração, calculamos e apresentamos a corrente escura, a corrente fotogerada e o ganho como uma função da polarização aplicada para o dispositivo M1 no detalhe da Fig. 4a. A tensão de ruptura é coletada quando a corrente é 10 −5 A. Podemos ver que a tensão de ruptura dificilmente depende da espessura da camada de absorção. Sabe-se que a tensão de ruptura está fortemente sujeita à intensidade do campo elétrico na camada de multiplicação levemente dopada e, portanto, a Fig. 4b mostra a distribuição do campo elétrico vertical para os cinco dispositivos estudados na polarização reversa de -160 V. as distribuições de campo para o dispositivo de referência e os dispositivos M1 a M4 são exatamente as mesmas, o que confirma a conclusão da Fig. 4a. Subseqüentemente, demonstramos a corrente gerada pela foto e a responsividade nas Figs. 4c e d, respectivamente. Tanto a corrente foto-gerada [ver o detalhe da Fig. 4c] e a responsividade mostram a tendência de diminuição com o aumento da espessura da camada de absorção. Para abordar ainda mais o mecanismo subjacente, também calculamos e mostramos a distribuição da portadora dentro da camada de multiplicação na Fig. 4e quando a polarização reversa é de 100 V para os cinco dispositivos investigados. Podemos ver que tanto os níveis de concentração de elétrons quanto de lacunas diminuem com o aumento da espessura da camada de absorção, o que é atribuído à recombinação não radioativa intensificada quando a camada de absorção torna-se espessa. A recombinação não radiativa consome portadores, suprimindo a corrente de difusão e a responsividade. Aqui, a fim de evitar o consumo de portadores por recombinação não radiativa, sugerimos que a camada de absorção não pode ser muito espessa para a obtenção de APDs SACM 4H-SiC com alta detectividade.

a Tensão de ruptura, b distribuição vertical do campo elétrico dos APDs do SACM polarizados em - 160 V, c características de fotocorrente-tensão sob iluminação de 280 nm, d características de resposta espectral e e perfis de concentração de portador na camada de multiplicação dos APDs SACM polarizados em - 100 V para o dispositivo de referência e dispositivos M1 a M4 com diferentes espessuras de camada de absorção, respectivamente. Figura inserida em a mostra as características de corrente-tensão calculadas e o ganho de multiplicação para o dispositivo M1. Figura inserida em c mostra a fotocorrente para o dispositivo de referência e os dispositivos M1 a M4 polarizados em - 100 V
Além da espessura da camada de absorção, a concentração de dopagem para a camada de absorção também tem um impacto significativo no desempenho do dispositivo. Em seguida, calculamos e mostramos a tensão de ruptura para o dispositivo de referência e os dispositivos B1 a B4 na Fig. 5a. A tensão de ruptura é definida quando a corrente é 10 −5 A, como mostrado na inserção da Fig 5a. Pode ser visto na Fig. 5a que a concentração de dopagem para a camada de absorção não tem efeito significativo na tensão de ruptura. Pode ser ainda comprovado pelas distribuições verticais de campo elétrico unidimensional na Fig. 5b, de modo que a concentração de dopagem para a camada de absorção não altera significativamente os perfis de campo elétrico na camada de multiplicação. Apresentamos também a corrente foto-gerada no comprimento de onda de 280 nm para os dispositivos estudados na Fig. 5c, que indica a corrente foto-gerada melhorada quando a concentração de dopagem na camada de absorção aumenta. Concordando bem com a Fig. 5c, a responsividade dependente do comprimento de onda na Fig. 5d também é favorecida à medida que a concentração de dopagem para a camada de absorção aumenta, por exemplo, o dispositivo B4.

a Tensão de ruptura, b distribuição vertical do campo elétrico dos APDs do SACM polarizados em - 160 V, c características de fotocorrente-tensão sob iluminação de 280 nm, e d características de resposta espectral dos APDs SACM polarizados em - 100 V para o dispositivo de referência e os dispositivos B1 a B4 com diferentes concentrações de dopagem da camada de absorção, respectivamente. Figura inserida em a mostra as características de corrente-tensão calculadas e o ganho de multiplicação para o dispositivo B1. Figura inserida em c mostra a fotocorrente para o dispositivo de referência e os dispositivos B1 a B4 polarizados em - 100 V
A fim de mostrar a origem em profundidade para a responsividade aprimorada para o dispositivo B4, mostramos os perfis da banda de energia para a camada de controle de carga, a camada de absorção e a camada de contato ôhmica do tipo n para os dispositivos B1 e B4 nas Figs. 6a e b, respectivamente. Aqui, vale a pena mencionar que as concentrações de dopagem para a camada de controle de carga e a camada de contato ôhmica tipo n são 5 × 10 18 cm −3 e 1 × 10 19 cm −3 , respectivamente. Portanto, a concentração de dopagem mais baixa para a camada de absorção pode gerar um campo elétrico embutido e criar as barreiras de energia nas interfaces da camada de controle de carga / camada de absorção / camada de contato ôhmico tipo n [28]. As barreiras de energia podem retardar a difusão dos portadores fotogerados na camada de multiplicação. Um método muito conveniente para reduzir as barreiras é aumentar a concentração de dopagem na camada de absorção. Como resultado, os valores de barreira da banda de valência efetiva ψ v para a camada de controle de carga são 513 meV e 480 meV para os dispositivos B1 e B4, respectivamente. É testemunhado que o aumento da concentração de dopagem para a camada de absorção promove o transporte para os orifícios fotogerados [ver Fig. 6c]. A ionização de impacto se tornará forte uma vez que mais orifícios fotogerados possam ser injetados na região de multiplicação, o que resulta, de maneira correspondente, no aumento da corrente fotogerada e na responsividade.
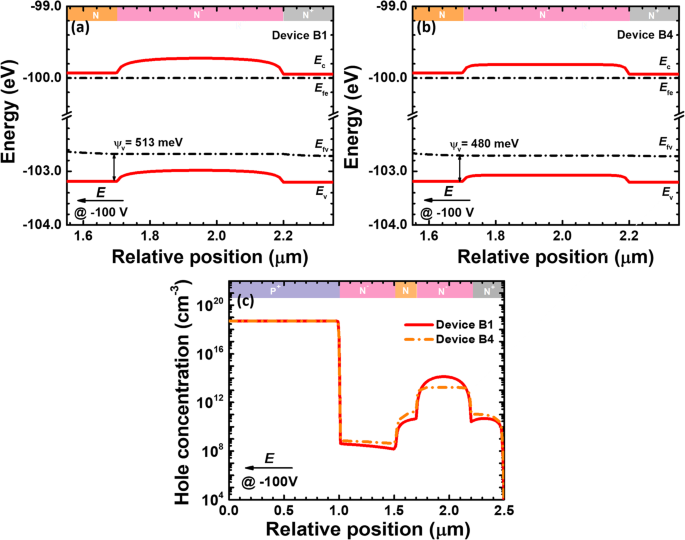
Diagramas de banda de energia da camada de controle de carga, camada de absorção e camada de contato ôhmica tipo n para a dispositivo B1 e b dispositivo B4, c perfis de concentração de orifícios sob iluminação de 280 nm para os dispositivos B1 e B4. Os dados são calculados na tensão reversa de 100 V
Impacto dos parâmetros estruturais da camada de controle de carga no desempenho fotoelétrico
Para sondar o impacto da espessura e concentração de dopagem da camada de controle de carga no desempenho fotoelétrico, definimos diferentes informações arquitetônicas para a camada de controle de carga, conforme mostrado na Tabela 3. Dispositivos N1 a N4 e dispositivos C1 a C4 são diferentes apenas do dispositivo de referência na camada de controle de carga. Diferentes concentrações de dopagem e espessuras de camada são adotadas para os dispositivos N1 a N4 e C1 a C4.
Como foi mencionado anteriormente, o campo elétrico que permite a ionização por impacto e a quebra da avalanche está confinado principalmente na camada de multiplicação. A tensão de ruptura em função da espessura da camada de controle de carga na Fig. 7a infere que a espessura da camada de controle de carga tem um efeito muito leve no processo de multiplicação do portador. Isso é comprovado ainda mais pela Fig. 7b. A Figura 7c demonstra a corrente foto-gerada em termos de polarização aplicada para o dispositivo de referência e os dispositivos N1 a N4. A corrente foto-gerada torna-se baixa quando a espessura da camada de controle de carga aumenta, o que também traduz a menor responsividade com o aumento da espessura da camada de controle de carga. Também atribuímos à recombinação não radiativa intensificada que consome portadores e suprime a corrente de difusão.

a Tensão de ruptura, b distribuição vertical do campo elétrico dos APDs do SACM polarizados em - 160 V, c características de fotocorrente-tensão sob iluminação de 280 nm, e d características de resposta espectral dos APDs SACM polarizados em - 100 V para o dispositivo de referência e os dispositivos N1 a N4 com diferentes espessuras de camada de controle de carga, respectivamente. Figura inserida em a mostra as características de corrente-tensão calculadas e o ganho de multiplicação para o dispositivo N1. Figura inserida em c mostra a fotocorrente para o dispositivo de referência e os dispositivos N1 a N4 polarizados em - 100 V
O papel da camada de controle de carga é confinar o campo elétrico forte e o processo de multiplicação do portador dentro da camada de multiplicação. No entanto, a largura da região de depleção pode ser estendida ainda mais, desde que a concentração de dopagem na camada de controle de carga diminua. Os perfis de campo elétrico podem, então, afetar substancialmente a tensão de ruptura, a corrente foto-gerada, o ganho e a responsividade. Portanto, projetamos os dispositivos C1 a C4 na Tabela 3. De acordo com a Fig. 8a, conforme a concentração de dopagem diminui, a tensão de ruptura inicialmente permanece a mesma e, em seguida, a tensão de ruptura aumenta quando a concentração de dopagem para a camada de controle de carga está abaixo de 2 × 10 18 cm −3 . A inserção da Fig. 8a indica que a tensão de ruptura é de ~ 315 V para o dispositivo C1, enquanto a corrente escura também aumenta para 3,5 × 10 −11 A em comparação com o dispositivo N1. Para revelar a origem das observações na Fig. 8a, calculamos a distribuição vertical do campo elétrico na Fig. 8b, o que demonstra que o campo elétrico está concentrado principalmente na camada de multiplicação para os dispositivos de referência e os dispositivos C3 e C4. No entanto, o campo elétrico e a região de depleção penetram na camada de controle de carga quando a concentração de dopagem para a camada de controle de carga é inferior a 2 × 10 18 cm −3 . A expansão da região de depleção para os dispositivos C1 e C2 ajuda a reduzir a intensidade do campo elétrico e, assim, a tensão de ruptura é correspondentemente aumentada para os dispositivos C1 e C2. O aumento da largura da região de depleção renderá mais corrente de geração de carga espacial, o que resulta em um aumento da corrente escura, ou seja, 3,5 × 10 - 11 A e 5 × 10 - 11 A para dispositivos C1 e C2, respectivamente. Em seguida, mostramos a corrente foto-gerada no comprimento de onda de 280 nm na Fig. 8c. As curvas de responsividade espectral polarizada de 100 V em diferentes comprimentos de onda para os cinco dispositivos investigados são ilustradas na Fig. 8d. Excelente concordância é obtida entre as Figs. 8c e d, de modo que a corrente gerada por foto aumentada dê origem à responsividade aprimorada, isto é, dispositivos C1 e C2. Outros dispositivos mostram nível de foto-corrente e responsividade semelhantes.

a Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices C1 to C4 with different doping concentration of charge control layer, respectively. Inset figure in a shows the calculated current-voltage characteristics and the multiplication gain for device C1. Inset figure in c shows photocurrent-voltage characteristics for reference device and devices C1 to C4
As has been interpreted previously, the energy band barrier height at the interface of multiplication layer/charge control layer can soundly affect the carrier diffusion. Due to the expansion of the depletion region for devices C1 and C2, the electric field in the depletion region will annihilate the energy barrier at the interface of multiplication layer/charge control layer [e.g., the inset for device C1 in Fig. 9a]. Meanwhile, we observe the valence band barrier at the interface of multiplication layer/charge control layer for device C4 according to the inset for Fig. 9b. The energy barrier will correspondingly retard the hole diffusion into the multiplication layer from the charge control layer. We also selectively compute and show the hole concentration profiles for device C1 and C4 in Fig. 9c. Because the interface of multiplication layer/charge control layer for device C1 no longer hinders the injection of photo-generated holes into the multiplication layer, more holes are limited in the charge control layer and the absorption layer for device C4. As a result, the hole concentration in the multiplication layer for device C1 is higher than that for device C4. Thus, the enhanced photo-generated current and the responsivity for device C1 are obtained when compared with device C4.
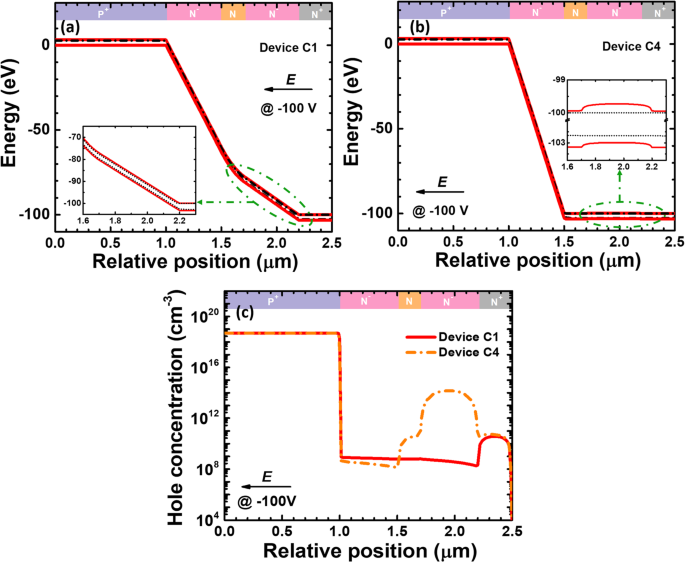
Energy band diagrams for a device C1 and b device C4, c hole concentration profiles for device C1 and C4. Data are calculated at the reverse voltage of 100 V. Insets for a e b show the local energy band diagrams for multiplication layer/charge control layer for devices C1 and C4, respectively
Impact of the Structural Parameters for the Multiplication Layer on the Photoelectric Performance
The impact ionization and the carrier multiplication process take place in the multiplication layer, making the design for the multiplication layer essentially vital for 4H-SiC SACM APDs. Therefore, we look into the impact of the thickness and doping concentration for the multiplication layer on the photoelectric performance for SACM APDs. The detailed structural information of the multiplication layer for different SACM APDs are summarized and presented in Table 4. The only difference for the devices in Table 4 lies on the multiplication layer.
As Fig. 10a presents, the breakdown voltage is enhanced from 110 to 210 V when the multiplication layer thickness is increased from 0.3 to 0.7 μm. For the purpose of demonstration, the inset of Fig. 10a demonstrates the current in terms of the voltage for reference device and devices P1 to P4. This indicates that a thick multiplication layer helps to reduce the electric field intensity [see Fig. 10b] and increase the breakdown voltage. We then show the photo-generated current for the five devices in Fig. 10c. The photo-generated current increases slightly with increasing the thickness of the multiplication layer for devices P2 to P4, except that device P1 has the highest photocurrent. The spectral responsivity characteristics for the five investigated devices at the reverse voltage of 100 V are provided in Fig. 10d. The peak responsivity for reference device and devices P2 to P4 improves slightly as the thickness of the multiplication layer increases, and this is because the number of carriers generated by impact ionization increases when the depletion region width increases. Note that device P1 with the thinnest multiplication layer owns the highest peak responsivity at the wavelength of 280 nm. This is because the − 100 V applied voltage is close to Geiger mode for device P1, and the avalanche gain is more likely to occur than that for other devices.

a Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices P1 to P4 with different thicknesses of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices P1 to P4. Inset figure in c shows photocurrent-voltage characteristics under 280 nm illumination for reference device and devices P1 to P4
Then, we show the breakdown voltage in terms of the multiplication layer doping concentration for reference device and devices D1 to D4 in Fig. 11a. It seems that when the doping concentration for the multiplication layer is lower than 10 16 cm −3 , the breakdown voltage is less affected. We believe the breakdown voltage can be significantly decreased if the doping concentration in the multiplication layer exceeds 10 18 cm −3 . The dark current as a function of the applied bias for the five APDs are shown in the inset of Fig. 11a. The dark current increases with increasing doping concentration of the multiplication layer due to the enhanced space charge generation in the depletion region. Therefore, for the purpose of significantly decreasing the dark current and promoting the carrier multiplication process, we rarely have the multiplication layer heavily doped. Then, we calculate the vertical one-dimensional electric field profiles for the five studied devices, which are demonstrated in Fig. 11b. We can see that the electric field profiles of the five devices are mainly confined in the multiplication layer. In addition, Figs. 11c and d demonstrate the photo-generated current and the wavelength-dependent responsivity for the five devices. We can see that the photo-generated current for reference device and devices D1 and D2 are almost the same under the 280 nm illumination, while that the photon-generated current for the devices D3 and D4 is slightly increased. Therefore, the responsivity at the wavelength of 280 nm in Fig. 11d for devices D3 and D4 is slightly higher than the others.

a Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent-voltage characteristics under 280 nm illumination, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices D1 to D4 with different doping concentration of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices D1 to D4. Inset figure in c shows photocurrent for reference device and devices D1 to D4 biased at − 100 V
Impact of the Beveled Mesa Angle on the Photoelectric Performance
In order to eliminate premature breakdown and suppress leakage current that are caused by the junction termination, positive beveled mesas with a small inclination angle are usually adopted when fabricating 4H-SiC APDs [13,14,15,16, 18]. However, the angles of the positive beveled mesa adopted in previous reports are various. Thus, to get systematic insight into the influence of different mesa inclination angles on the electric field profiles for 4H-SiC SACM APDs, we design the devices that are shown in Table 5.
We firstly calculate and show the dark current-voltage characteristics for the six investigated devices with the various bevel angles in Fig. 12a. We can see that the dark current increases as the positive beveled angle becomes large [see Fig. 12a]. The breakdown voltages for the investigated devices are ~ 161.6 V except that device E5 is slightly less than 161.6 V. The premature breakdown is observed as the beveled mesa angle increase in the dark condition. Meanwhile, we calculate and show photo-generated current in terms of the applied bias for reference device and devices E1 to E5 in Fig. 12b. We also see that the photo-generated current also increases as the positive bevel increases according to the inset for Fig. 12b. The premature breakdown is also observed as the beveled mesa angle increase in Fig. 12b. Therefore, the responsivity of solar-blind waveband at − 100 V slightly enhances as the positive bevel angle increases according to Fig. 12c.
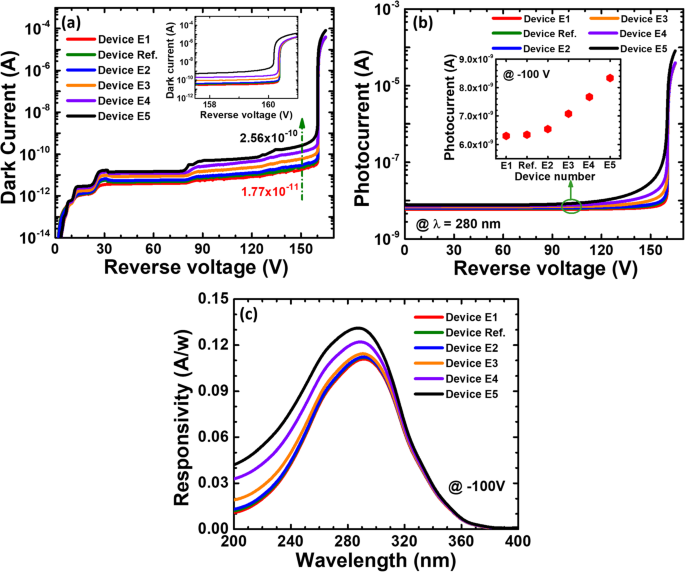
a Numerically calculated dark current-voltage characteristics, b photocurrent-voltage characteristics under 280 nm illumination, and c spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices E1 to E5, respectively
To reveal the origin for the observations in Figs. 12a and b, we calculate the lateral electric field distribution in the multiplication layer at the reverse bias of − 100 V in Fig. 13a, which demonstrates that, when the beveled mesas are utilized, the electric field decreases from the mesa center to the mesa edge. Moreover, the edge electric field intensity drops as the angle further decreases for the investigated devices. As has been mentioned, the junction termination will cause a large number of surface imperfections, which may cause the premature breakdown and the strongly leakage current, and the adopting of the beveled mesa shifts the premature breakdown from the mesa surface to the bulk [29]. Moreover, to get a full picture for the electric field profiles, the two-dimensional electric field distributions at the reverse bias of − 100 V for reference device and devices E1 to E5 are presented in Figs. 13b-g. We can see that the area of the high electric field in the entire multiplication layer gets narrowed, and this simultaneously causes the carriers that regenerated by impact ionization to decrease. As can be seen from Table 6, as the beveled mesa angle decreases, the surface electric field at the relative position of 700 μm decreases from 2.03 × 10 6 V/cm to 2.90 × 10 5 V/cm. As a result, the surface leakage and bulk leakage can be further suppressed as the beveled mesa angle get further decreased as shown in Fig. 12a. Although a small beveled mesa angle is preferred, this sacrifices the active detection area for APDs, and therefore, the responsivity is the lowest for device E1 according to Fig. 12c. Thus, one shall properly optimize beveled mesa angles depending on the crystalline quality for the 4H-SiC epitaxial layers and the surface conditions after junction termination. The suggested beveled angle in this works is in the range of 10–20°.
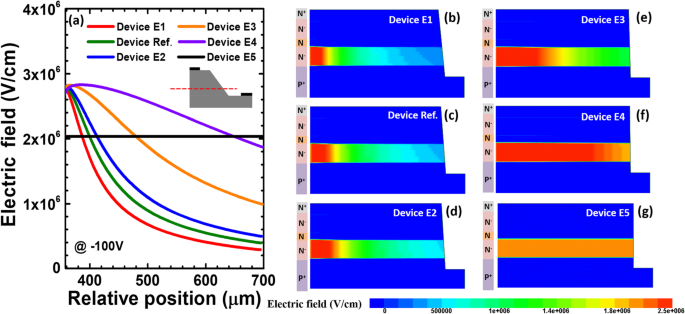
a Lateral electric field distribution of the multiplication layer at − 100 V, and numerically calculated two-dimensional electric field distribution at − 100 V for b device E1, c reference device, d device E2, e device E3, f device E4 and g device E5
Conclusões
To summarize, we have numerically investigated and demonstrated the impact of the thickness and doping concentration of each layer on photoelectric performance for 4H-SiC SACM APDs. The obtained conclusions are as follows:(1) for n-type ohmic contact layer with a properly high doping concentration (N d ≈ 1 × 10 19 cm −3 ) to enable ohmic contact, the thickness and doping concentration hardly affect the breakdown voltage. Nevertheless, the responsivity decreases as the thickness of the n-type ohmic contact layer increases. The thickness shall be controlled to about 0.2 μm; (2) the doping concentration for the absorption layer is vitally important, which can modulate the photo-generated carrier transport and affect the responsivity. The doping concentration is generally controlled at the intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (3) the doping concentration for the charge control layer regulates the electric field distribution and affects the depletion region width for 4H-SiC SACM APDs. The depletion region width increases as the doping concentration of the charge control layer decreases. According to our results, when the doping concentration is about 1 × 10 18 cm −3 , the depletion region can be completely terminated by the charge control layer; (4) the breakdown voltage can be strongly affected by the thickness of multiplication layer which is the main support region of the electric field. The dark current is sensitive to the doping concentration of multiplication layer, and a low doping concentration for the multiplication layer is required, since the doping concentration therein influences the space charge generation current. Thus, the suggested doping concentration in this works is intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (5) we also point out the advantage of beveled mesa for 4H-SiC SACM APDs, and the optimized beveled mesa angles shall be a compromise among the active detection area, the surface conditions for the mesa, and the crystalline quality for 4H-SiC epitaxial films. This work indicates that the optimum beveled mesa angle is in the range of 10–20°. We strongly believe that this work provides the physical insight for the device physics and hence the findings in this work are very important for 4H-SiC-based SACM APDs.
Disponibilidade de dados e materiais
Os dados e a análise no presente trabalho estão disponíveis com os autores correspondentes mediante solicitação razoável.
Abreviações
- AlGaN:
-
Aluminum gallium nitride
- APSYS:
-
Modelos Físicos Avançados de Dispositivos Semicondutores
- MSM:
-
Metal-semicondutor-metal
- SACM:
-
Separated absorption charge and multiplication
- SiC:
-
Carboneto de silício
- SRH:
-
Shockley-Read-Hall
- UV APD:
-
Avalanche ultraviolet photodiode
Nanomateriais
- Consertando uma estratégia de manutenção quebrada:Otimização de PM e FMEA
- Demonstração de um biossensor flexível à base de grafeno para detecção sensível e rápida de células cancerosas do ovário
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Engenharia de processo de revestimento por imersão e otimização de desempenho para dispositivos eletrocrômicos de três estados
- Metassuperfícies dielétricas de alta ordem para divisores de feixe de polarização de alta eficiência e geradores de vórtice ópticos
- Melhoria de modulação e absorção de frequência do microbolômetro THz com estrutura de microponte por antenas tipo espiral
- Diodos emissores de luz ultravioleta baseados em AlGaN quase isentos de eficiência com uma camada de bloqueio de elétrons tipo p de superrede especificamente projetada para alta eficiência de dopag…
- Cinética da Carga de Direção de Fotocatalisadores de Niobato de Estanho:Principais Funções da Estrutura de Fase e Estrutura Eletrônica
- Materiais e design de PCB para alta tensão
- Máquinas VMC para produção e eficiência



