Diodos emissores de luz ultravioleta baseados em AlGaN quase isentos de eficiência com uma camada de bloqueio de elétrons tipo p de superrede especificamente projetada para alta eficiência de dopagem de Mg
Resumo
Este trabalho relata um diodo de emissão de luz ultravioleta profunda (LED DUV) quase livre de queda de eficiência, com base em AlGaN, emitindo no comprimento de onda de pico de 270 nm. O LED DUV utiliza uma camada de bloqueio de elétrons tipo p superrede (p-EBL) projetada especificamente. A superrede p-EBL permite uma alta concentração de orifício no p-EBL, o que aumenta correspondentemente a eficiência de injeção do orifício nos poços quânticos múltiplos (MQWs). A concentração de buraco aprimorada dentro da região MQW pode mais eficientemente recombinar com elétrons no caminho de favorecer a recombinação radiativa, levando a um nível de corrente de fuga de elétrons reduzido. Como resultado, a eficiência quântica externa para a estrutura de LED DUV proposta é aumentada em 100% e a estrutura de LED DUV quase sem queda de eficiência é obtida experimentalmente.
Histórico
Os feixes ultravioleta no regime de comprimento de onda de 200 nm ~ 280 nm encontraram aplicações potenciais no sistema de purificação de água [1, 2]. Considerando a baixa tensão de alimentação DC e a maior compatibilidade com o sistema de purificação de água, os diodos emissores de luz ultravioleta profunda à base de AlGaN (LEDs DUV) são selecionados como excelentes candidatos. Vale ressaltar que tratar a água com grande volume exige que o sistema de purificação forneça a fonte de luz UVC de alta potência. No entanto, a eficiência quântica externa (EQE) para LEDs DUV baseados em AlGaN com o comprimento de onda de emissão menor que 280 nm não é satisfeita neste momento [3]. O principal fator limitante para o EQE pobre surge, em parte, da grande densidade de deslocamento de segmentação (TDD) nos poços quânticos ricos em Al [2, 3]. A eficiência quântica interna (IQE) diminui rapidamente uma vez que o TDD está na ordem de 10 9 cm −2 [3]. Mesmo que o TDD seja reduzido para a ordem de 10 8 cm −2 que pode habilitar o IQE de 60 ~ 80%, o efeito da queda de eficiência pode fazer com que o EQE seja inferior a 5% para os LEDs UVC nus quando a densidade da corrente de injeção excede 80 A / cm 2 [4]. Observe que a eficiência de extração de luz (LEE) para chips de LED UVC nus é de ~ 10% de acordo com cálculos de FDTD [5]. Uma das principais interpretações para a queda da eficiência dos LEDs baseados em nitreto III é o transbordamento de elétrons para a camada de injeção do buraco do tipo p [6]. A camada de injeção de buraco do tipo p de AlGaN rica em Al possui uma concentração de buraco livre ainda menor do que 1 × 10 17 cm −3 [7], tendendo a causar um nível de vazamento de elétrons mais severo. Mehnke et al. mediram a emissão parasitária que ocorre na camada de injeção do buraco do tipo p e a emissão parasitária é bem atribuída ao vazamento de elétrons [8]. Para reduzir o escape de elétrons dos poços quânticos múltiplos (MQWs), pode-se aumentar a taxa de captura de elétrons inserindo camadas de pico único nas barreiras quânticas [9]. As camadas de pico possuem uma composição de Al maior do que a barreira quântica, de modo que o campo elétrico induzido por polarização nas camadas de pico pode reduzir a velocidade de deriva dos elétrons. A eficiência de captura aprimorada é, portanto, ativada apenas se o LED DUV for aumentado ao longo da orientação [0001]. Outro método eficaz para aumentar a taxa de captura de elétrons é aumentar o deslocamento da banda de condução entre a barreira quântica e o poço quântico, o que pode ser realizado aumentando-se adequadamente a composição de Al [10], enquanto a arquitetura da barreira quântica pode ser mais evoluída por ter a composição do Al foi graduada [11]. Como foi mencionado anteriormente, a concentração de orifício livre para a camada de injeção de orifício de AlGaN do tipo p rica em Al é baixa, o que leva à capacidade de injeção de orifício pobre na região MQW. A injeção de buraco pobre também é considerada como a causa do vazamento de elétrons [12]. Um método promissor para aumentar a emissão termiônica do buraco através da camada de bloqueio de elétrons do tipo p (p-EBL) é energizar os buracos adotando o reservatório de campo elétrico [13]. O transporte do furo também pode ser favorecido se a camada de injeção do furo à base de p-AlGaN com a composição de Al em escada for utilizada para LEDs DUV [14]. A composição de Al com revestimento em escada pode ser posteriormente substituída pela composição de Al graduado para a camada de AlGaN para aumentar a concentração do orifício [15,16,17]. Além de projetar a camada de injeção do orifício, p-EBLs alternativos também foram sugeridos para reduzir o efeito de bloqueio do orifício, por exemplo, inserir uma camada fina de AlGaN com uma composição de Al inferior [18]. Uma estrutura muito importante para o candidato p-EBL é a superrede p-EBL. Enormes esforços de pesquisa foram feitos para explorar o impacto da superrede GaN / AlGaN para LEDs azuis baseados em GaN [19,20,21]. No entanto, o AlGaN p-EBL para LEDs azuis tem a composição AlN inferior a 20%, tornando o efeito de bloqueio de orifício para LEDs azuis não tão severo quanto para LEDs DUV. Portanto, a melhoria do EQE é menor que 20% e a queda da eficiência ainda é óbvia, mesmo se a superrede GaN / AlGaN p-EBL for adotada para LEDs azuis. Os LEDs DUV empregam p-EBLs ricos em Al, dando origem a um problema de injeção de orifício ainda mais desafiador [1]. Para resolver o efeito de bloqueio de orifício causado por p-EBL rico em Al, a superrede p-EBL também é sugerida para LEDs DUV, por exemplo, superrede p-EBL AlINGaN / AlGaN [22] e superrede p-EBL AlGaN / AlGaN [23]. No entanto, a prova experimental da superrede p-EBL que ajuda a obter EQE alta e quase sem droop-eficiência falta para LEDs DUV neste estágio. Portanto, este trabalho demonstra experimentalmente a eficácia de uma superrede AlGaN / AlGaN p-EBL projetada especificamente para aumentar o EQE e suprimir significativamente a queda de eficiência para LEDs DUV. O EQE aprimorado é bem atribuído à injeção de orifício aprimorada na região MQW, enquanto o nível de vazamento de elétrons reduzido ajuda a suprimir notavelmente a queda de eficiência. O mecanismo detalhado será apresentado neste trabalho posteriormente.
Métodos / Experimental
As duas arquiteturas de LED DUV (LEDs A e B como mostrado na Fig. 1) neste trabalho são cultivadas no modelo AlN por um sistema de deposição de vapor químico orgânico de metal (MOCVD). O modelo de AlN de 4 μm de espessura é cultivado no substrato de safira orientado para [0001] usando o método Hydride Vapor Phase Epitaxy (HVPE). Nós cultivamos AlN / Al de 20 períodos 0,50 Ga 0,50 Superrede N no modelo AlN, que serve como camada de alívio de tensão para a epi-camada subsequentemente desenvolvida. Um n-Al de 2 μm de espessura 0,60 Ga 0,40 Camada N que tem uma concentração de elétrons de 1 x 10 18 cm −3 é cultivado para fornecer elétrons. Os fótons DUV são gerados por cinco períodos Al 0,45 Ga 0,55 N / Al 0,56 Ga 0,44 N MQWs que têm Al 0,45 de 3 nm de espessura Ga 0,55 N poços quânticos e Al de 12 nm de espessura 0,56 Ga 0,44 N barreiras quânticas. Os MQWs são então limitados por um p-EBL baseado em AlGaN de 10 nm de espessura. Em nosso experimento, projetamos e desenvolvemos dois tipos de p-EBLs para LEDs A e B, respectivamente. LED A possui um Al 0,60 Ga 0,40 P-EBL baseado em N e LED B tem um Al de 1 nm de cinco períodos 0,45 Ga 0,55 N / 1 nm Al 0,60 Ga 0,40 P-EBL baseado em N. Observe, nosso loop de superrede p-EBL começa no Al 0,45 Ga 0,55 N camada fina após o crescimento do último Al 0,56 Ga 0,44 Barreira quântica N. Ao fazer isso, a interface da última barreira quântica / superrede p-EBL é polarizada produzindo cargas de folha induzidas por polarização negativa, o que ajuda a esgotar o acúmulo de elétrons na última barreira quântica e suprime ainda mais o vazamento de elétrons. O p-EBL é então seguido por um p-Al de 50 nm 0,40 Ga 0,60 Fornecedor de orifícios de p-GaN N / 50 nm. Por último, a camada de p-GaN é revestida com um p + fortemente dopado com Mg com 10 nm de espessura Camada -GaN. Os wafers de LED DUV são termicamente recozidos in situ na temperatura de 800 ° C no N 2 ambiente por 15 min para dividir as ligações H – Mg. A concentração do orifício é então estimada aproximadamente em 1 × 10 17 cm −3 e 3 × 10 17 cm −3 para a camada p-AlGaN rica em Al e a camada p-GaN, respectivamente.
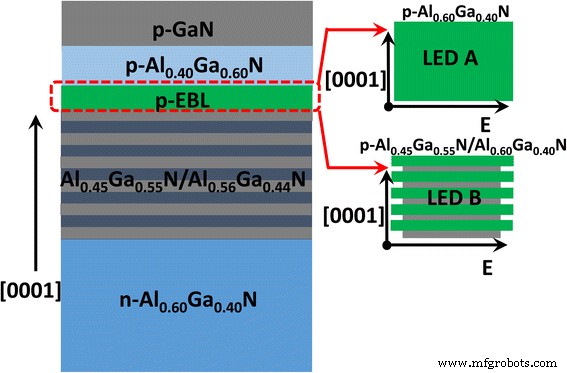
Estruturas arquitetônicas esquemáticas para os LEDs estudados. Os diagramas de banda de energia esboçados para os dois p-EBLs também são fornecidos:LED A tem o p-Al 0,60 Ga 0,40 EBL baseado em N e LED B tem o p-Al 0,45 Ga 0,55 N / Al 0,60 Ga 0,40 N superrede EBL. O p-Al 0,45 Ga 0,55 N / Al 0,60 Ga 0,40 A superrede EBL N é especificamente projetada de modo que inicie o fino p-Al 0,45 Ga 0,55 Camada N para que a interface para o p-Al 0,45 Ga 0,55 N / Al 0,56 Ga 0,44 A última barreira quântica possui cargas de interface de polarização negativa. E significa nível de energia.
Os wafers DUV LED são fabricados em chips DUV LED seguindo um processo de microfabricação padrão. A mesa é obtida através da condução de corrosão por plasma indutivamente acoplado (ICP) e o tamanho da mesa é 650 × 320 μm 2 . Uma pilha de metal Ti / Al é depositada no n-Al 0,60 Ga 0,40 Camada N, que é então recozida em N 2 durante 1 min à temperatura de 900 ° C. Um espalhamento de corrente de Ni / Au é revestido na superfície da mesa e então recozido em O 2 por 5 min à temperatura de 550 ° C. Por último, depositamos metais Ti / Al / Ni / Au simultaneamente na liga de Ti / Al e na camada de espalhamento de corrente de Ni / Au servindo como o eletrodo n e o eletrodo p reflexivo, respectivamente. Os chips LED DUV são dispositivos flip-chip e os fótons DUV são coletados do lado safira por uma esfera de integração.
Para revelar melhor a origem em profundidade para o EQE aprimorado e a queda de eficiência suprimida, cálculos numéricos são realizados usando o pacote APSYS [13, 18]. Parâmetros físicos importantes que são usados para calcular os eventos de recombinação de portadora e a perda de portadora incluem vida útil de recombinação Shockley-Read-Hall (SRH), coeficiente de recombinação Auger, a razão de deslocamento de banda de energia para interfaces AlGaN / AlGaN e o nível de polarização para [0001 ] estruturas de nitreto III orientadas para 10 ns, 1 × 10 −30 cm 6 s −1 , 50:50 e 40%, respectivamente [13, 18]. O LEE é definido como 10% para chips DUV LED com camada absorvente de p-GaN de 50 nm de espessura [5].
Resultados e discussões
Os espectros de eletroluminescência (EL) medidos experimentalmente em um nível de densidade de corrente diferente para os LEDs A e B são apresentados na Fig. 2a. Os espectros de EL são coletados na condição pulsada com o ciclo de trabalho de 0,1% para evitar o efeito de autoaquecimento. A Figura 2a mostra que o comprimento de onda de emissão de pico para ambos os dispositivos LED DUV é de ~ 270 nm. O comprimento de onda de emissão de pico é estável dentro da faixa de corrente testada devido à eliminação do efeito de autoaquecimento. A intensidade EL para o LED B é mais forte do que para o LED A. A Figura 2b demonstra a potência óptica e o EQE como a função da densidade da corrente de injeção, o que ilustra que o EQE é aumentado em ~ 90%. Além disso, os níveis de queda de eficiência são de ~ 24 e ~ 4% para LEDs A e B no nível de densidade de corrente de 110 A / cm 2 , respectivamente [droop =( EQE máximo - EQE J ) / EQE máximo , em que EQE máximo e EQE J denotam o EQE máximo e o EQE na densidade de corrente de J ] A Figura 2c apresenta a densidade de potência óptica calculada numericamente e o EQE em termos da densidade de corrente de injeção. Os resultados calculados numericamente e os medidos experimentalmente concordam bem uns com os outros, de modo que o LED B mostra o EQE aprimorado e um nível de queda de eficiência substancialmente reduzido. A concordância entre as Fig. 2b e 2c valida bem os modelos físicos e os parâmetros que definimos para os cálculos.
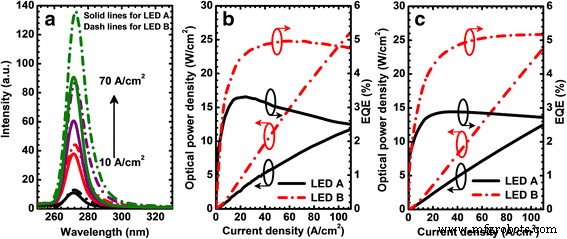
a Espectros EL medidos na densidade de corrente de 10, 30, 50 e 70 A / cm 2 . b Potência óptica medida e EQE. c Potência óptica calculada e EQE para LEDs A e B, respectivamente
Os dois LEDs DUV diferem um do outro apenas no p-EBL. Portanto, é necessário investigar o papel da superrede p-EBL na melhoria do desempenho óptico do LED B. A Figura 3a apresenta os perfis de concentração do orifício na região MQW para os LEDs A e B na densidade de corrente de 50 A / cm 2 . É mostrado que o nível de concentração do buraco dentro dos MQWs para o LED B é maior do que para o LED A. Como foi relatado, o p-EBL reduz o nível de vazamento de elétrons enquanto simultaneamente impede a injeção do buraco [24]. Uma abordagem útil para reduzir o efeito de bloqueio do orifício é aumentar a concentração do orifício na região do p-EBL, o que ajuda a diminuir a altura da barreira da banda de valência [25]. A Figura 3b mostra então os níveis de concentração do orifício nos p-EBLs e no p-Al 0,40 Ga 0,60 Camadas N para LEDs A e B na densidade de corrente de 50 A / cm 2 . A concentração média do orifício na superrede p-EBL para o LED B é muito maior do que para o LED A em duas ordens de magnitude. A maior concentração do furo na superrede p-EBL é bem atribuída ao excelente transporte do furo. Curiosamente, se olharmos mais para a Fig. 3b, descobrimos que a concentração do buraco no p-EBL / p-Al 0,40 Ga 0,60 A interface N torna-se mais baixa para o LED A, o que também reflete a eficiência de injeção de orifício mais suave através da superrede p-EBL para o LED B.

Perfis de concentração de orifícios calculados numericamente a nos MQWs e b nas camadas de injeção de furo tipo p para LEDs A e B, respectivamente; c espectros EL medidos experimentalmente em escala semi-logarítmica na densidade de corrente de 10, 30, 50 e 70 A / cm 2 para LEDs A e B, respectivamente; d níveis de concentração de elétrons calculados numericamente nas camadas de injeção de buraco de tipo p para LEDs A e B. Dados calculados numericamente são coletados na densidade de corrente de 50 A / cm 2
Como já foi mencionado, a eficiência dos LEDs está intimamente associada ao nível de vazamento de elétrons. Portanto, mostramos os espectros de EL medidos para os LEDs A e B em uma escala semilogista (ver Fig. 3c) para indicar as informações detalhadas sobre a luminescência parasitária. O pico de comprimento de onda de emissão para a luminescência parasitária está centrado em ~ 425 nm, que pode surgir dos níveis profundos associados aos dopantes de Mg [26]. A intensidade da luminescência parasitária para o LED B é mais forte do que para o LED A, e especula-se que mais portadores se recombinem em níveis profundos. Em nosso experimento, as camadas de injeção de furo tipo p para ambas as arquiteturas de LED DUV não são projetadas e o nível de concentração de furo nas camadas de injeção de furo deve ser semelhante. Portanto, é identificado que os elétrons que escapam da região MQW possuem uma concentração maior na camada de injeção do buraco para o LED B do que para o LED A. Nossas sugestões são posteriormente apoiadas pela Fig. 3d que mostra os perfis de concentração de elétrons no p- tipo camadas de injeção de furo para LEDs A e B na densidade de corrente de 50 A / cm 2 . Isso também significa que a corrente de fuga de elétrons foi significativamente reduzida graças à superrede p-EBL para LED B.
Em seguida, apresentamos os perfis computados da taxa de recombinação radiativa para os LEDs A e B na Fig. 4, que são coletados no nível de densidade de corrente de 50 A / cm 2 . Infere-se que a taxa de recombinação radiativa para o LED B é mais forte do que para o LED A graças à superrede proposta p-EBL, que favorece ainda mais a injeção de orifícios na região MQW e suprime o nível de vazamento de elétrons nesse ínterim.
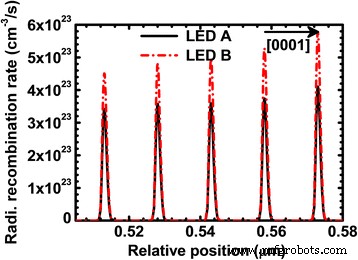
Perfis numericamente computados da taxa de recombinação radiativa para LEDs A e B. Os dados são coletados no nível de densidade atual de 50 A / cm 2
As Figuras 5a e 5b mostram a banda de energia na vizinhança dos p-EBLs para ambos os dispositivos LED DUV. As bandas de energia são calculadas na densidade de corrente de 50 A / cm 2 . Conforme relatado por Zhang et al. [27], a forte polarização induzida por cargas positivas na última barreira quântica / interface p-EBL pode atrair elétrons significativamente, dando origem à alta concentração local de elétrons. A alta concentração local de elétrons pode reduzir a altura da barreira da banda de condução efetiva ( Ø e ) para o p-EBL que é ~ 295 meV para o LED A. Se o p-EBL baseado em AlGaN em massa for substituído pela superrede específica p-EBL neste trabalho (ou seja, o loop de superrede p-EBL começa a partir da camada fina de AlGaN com uma lacuna de banda de energia menor do que a última barreira quântica AlGaN), a banda de condução para a última barreira quântica é titulada para cima (ver Fig. 5b), e isso favorece uma depleção de elétrons na última barreira quântica que, então, aumenta o Ø e para ~ 391 meV e permite um menor escape de elétrons por meio de emissão termiônica [28]. Além disso, a superrede p-EBL facilita o processo de tunelamento intra-banda para orifícios, como resultado do qual a concentração de orifícios no p-EBL também se torna maior (ver Fig. 3b). A concentração de orifícios aumentada no p-EBL para LEDs tende a reduzir a altura efetiva da barreira da banda de valência ( Ø h ) [25], ou seja, os valores de Ø h são ~ 324 meV e ~ 281 meV para LEDs A e B, respectivamente na densidade de corrente de 50 A / cm 2 . O ainda menor Ø h já o LED B favorece a emissão termiônica por orifícios. É importante notar que a superrede p-EBL também pode causar o tunelamento intra-banda para elétrons. Felizmente, a concentração de buraco melhorada no MQW pode melhor consumir elétrons por recombinação radiativa, o que também contribui para aliviar o vazamento de elétrons [12]. Por causa da injeção de orifício mais favorecida e da corrente de recombinação ainda mais forte que é produzida pelo processo de recombinação radiativa que ocorre na região MQW, a tensão direta torna-se menor para o LED B do que para o LED A de acordo com a Fig. 5c.
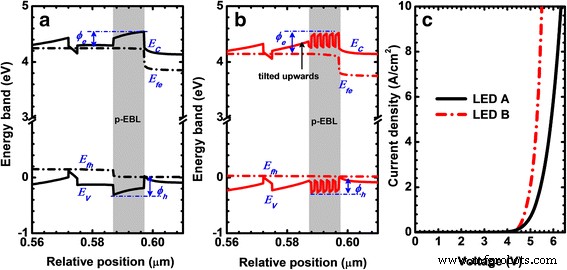
Perfis de banda de energia computados numericamente nas proximidades de a bulk AlGaN-based p-EBL para LED A, b superrede p-EBL para LED B e c densidade de corrente medida em termos de polarização aplicada para LEDs A e B. Dados para a e b são calculados na densidade de corrente de 50 A / cm 2 . E C , E V , Ø e , e Ø h denotam a banda de condução, a banda de valência e as alturas de barreira efetiva para banda de condução e banda de valência, respectivamente
Conclusões
Para resumir, este trabalho relatou uma superrede específica p-EBL para LEDs DUV, que pode manter a eficiência de injeção de orifício promovida e a diminuição do vazamento de elétrons na camada de injeção de orifício tipo p passiva. Portanto, tanto numericamente quanto experimentalmente, o EQE melhorado e a queda de eficiência notavelmente suprimida são obtidos. Acreditamos fortemente que a estrutura de LED DUV proposta é muito promissora para a realização de LEDs DUV de alta eficiência e a física do dispositivo revelada por este trabalho introduz mais compreensão para a comunidade optoeletrônica baseada em nitreto III.
Abreviações
- APSYS:
-
Modelos Físicos Avançados de Dispositivos Semicondutores
- DUV:
-
Diodos emissores de luz ultravioleta profundos
- EL:
-
Eletroluminescência
- EQE:
-
Eficiência quântica externa
- HVPE:
-
Epitaxi de fase de vapor de hidreto
- ICP:
-
Plasma indutivamente acoplado
- IQE:
-
Eficiência quântica interna
- LEE:
-
Eficiência de extração leve
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- MQWs:
-
Múltiplos poços quânticos
- p-EBL:
-
camada de bloqueio de elétrons tipo p
- TDD:
-
densidade de deslocamento de rosca
Nanomateriais
- O Projeto da Camada de Emissão para Multiplicadores de Elétrons
- PEDOT Altamente Condutivo:Camada de Transporte de Furo Transparente PSS com Tratamento Solvente para Células Solares Híbridas Orgânicas / Silicone de Alto Desempenho
- Síntese verde de pontos quânticos InP / ZnS Core / Shell para aplicação em diodos emissores de luz livres de metais pesados
- Células solares de perovskita invertida altamente eficientes com camada de transporte de elétrons CdSe QDs / LiF
- Composto nanofibroso TPU eletricamente condutivo com alta elasticidade para sensor de deformação flexível
- Diodos emissores de luz perovskita de alta luminância com solvente de álcool de alta polaridade tratando PEDOT:PSS como camada de transporte de orifício
- Tratamento UV de camadas de transporte de elétrons de SnO2 processado em baixa temperatura para células solares de perovskita planar
- Na camada de propagação de corrente p-AlGaN / n-AlGaN / p-AlGaN para diodos emissores de luz ultravioleta profunda à base de AlGaN
- Sistema Teórico de Nanogeradores Triboelétricos em Modo de Contato para Eficiência de Conversão de Alta Energia
- Influência da largura do poço quântico nas propriedades de eletroluminescência de diodos emissores de luz ultravioleta profunda de AlGaN em diferentes temperaturas



