Transistor de memória ferroelétrica 2D MoS2 em operação de baixa tensão com estrutura de porta Hf1-xZrxO2
Resumo
O transistor de efeito de campo ferroelétrico (FeFET) surge como uma tecnologia de memória não volátil intrigante devido à sua promissora velocidade de operação e durabilidade. No entanto, inverter a polarização requer uma alta tensão em comparação com a da leitura, prejudicando o consumo de energia de gravação de uma célula. Aqui, relatamos uma célula FeFET compatível com CMOS com baixa tensão operacional. Nós projetamos o ferroelétrico Hf 1-x Zr x O 2 (HZO) filme fino para formar dielétricos de porta de capacitância negativa (NC), que gera um loop de histerese de contra-relógio do domínio de polarização no dissulfeto de molibdênio de poucas camadas (MoS 2 ) FeFET. O capacitor negativo não estabilizado suporta inerentemente a taxa de oscilação subtermiônica e, portanto, permite alternar a polarização ferroelétrica com a janela de histerese muito menos da metade da tensão de operação. O FeFET mostra uma alta proporção de corrente liga / desliga de mais de 10 7 e uma janela de memória no sentido anti-horário (MW) de 0,1 V em um programa mínimo (P) / apagar (E) voltagem de 3 V. Resistência robusta (10 3 ciclos) e retenção (10 4 s) propriedades também são demonstradas. Nossos resultados demonstram que o HZO / MoS 2 O transistor de memória ferroelétrica pode alcançar novas oportunidades em aplicações de memória não volátil escalável por tamanho e voltagem.
Histórico
O mercado de memória integrada de sistema em chip (SoC) está atualmente em uma era de tremendo crescimento, o que requer que a memória seja capaz de atingir uma operação mais rápida, menor tamanho de célula e menor consumo de energia [1,2,3,4,5,6 ] A memória ferroelétrica, um dos candidatos mais promissores, foi reconsiderada, devido à descoberta do óxido de háfnio ferroelétrico em 2011 [7].
Nas últimas décadas, o FeFET não teve um bom desempenho em todos esses aspectos, incluindo requisitos de baixa voltagem para operação de memória, simplicidade da etapa do processo e processo de integração de semicondutor de óxido metálico (CMOS) minimamente complementar e preocupações com contaminação limitada [8,9,10, 11]. Para resolver isso, recentemente, uma grande investigação sobre a memória não volátil (NVM) FeFET 2D foi realizada com base em vários materiais ferroelétricos, incluindo PbZrTiO 3 (PZT) e [P (VDF-TrFE)] polímero [12,13,14,15,16,17,18], que se deve às propriedades promissoras do material 2D em "mais do que a era de Moore". No FeFET, os dois estados de polarização espontânea estáveis de um material ferroelétrico incorporado em uma pilha de portas de transistor são utilizados para armazenamento de dados por meio da tensão de limite controlável ativada por tensões de porta P / E reduzidas aplicadas. É relatado que os comportamentos de histerese reproduzíveis, uma alta proporção liga / desliga de 10 4 , boas propriedades de retenção de até 10 4 s, e a operação de comutação estável foi alcançada em PZT / MoS 2 FeFET [19]. Visivelmente, uma mobilidade máxima de 625 cm 2 / V ∙ s, um grande MW de 16 V para uma porta de ± 26 V - faixa de tensão e uma alta relação liga / desliga de 8 × 10 5 também foram demonstrados por um polímero tipo n [P (VDF-TrFE)] / MoS 2 FeFET [15]. No entanto, existem tantos problemas fundamentais que podem impedir sua aplicação prática, como compatibilidade de CMOS, capacidade de dimensionamento e os estados de interface entre Fe e material 2D. O óxido de háfnio ferroelétrico, um tipo de novo material ferroelétrico, tem excelente compatibilidade CMOS e capacidade de escalonamento, o que poderia servir para o FeFET NVM avançado em nó de tecnologia sub-5 nm nos próximos 5-10 anos [20]. Consequentemente, um lote de HfO 2 Pilhas dielétricas com base foram incorporadas em FeFETs 2D, que são direcionados para alcançar transistores de efeito de campo de capacitância negativa (NCFET) com comutação ON / OFF acentuada via inclinação sub-60 mV / década e características sem histerese [21,22,23 , 24,25,26], Embora os experimentos de massa baseados em dielétrico NC com materiais de canal 2D alternativos tenham tirado conclusões fantásticas, eles destacaram os requisitos de pico para distinguir entre NCFETs e FeFETs. Ainda há uma falta de investigação sistemática sobre a física e a viabilidade da tecnologia do dispositivo em memória ferroelétrica de um transistor baseada em MoS 2 e HZO ferroelétrico.
Neste trabalho, um FeFET com algumas camadas HZO MoS 2 transistor foi proposto. Ele é capaz de dimensionar a tensão P / E por meio do efeito NC induzido pela engenharia da pilha de portas sob uma tensão P / E reduzida. Demonstramos experimentalmente que um MW no sentido anti-horário de 0,1 V com inclinação de sub-60 mV / década foi alcançado em HZO MoS 2 FeFET, que pode ser atribuído à modulação da densidade da portadora local no canal 2D pela inversão rápida do dipolo ferroelétrico. Atribuímos a diminuição da histerese do HZO / MoS 2 FeFET como tensão de dreno aumentando para efeito de redução da barreira induzida por dreno negativo (DIBL). Além disso, também foi estudada sistematicamente a retenção, as características de resistência e a dependência da tensão de limiar na tensão de drenagem do HZO MoS 2 FeFET, abrindo um caminho viável para projetar HZO MoS 2 FeFET NVM e suas aplicações práticas.
Métodos
6 nm Hf 1-x Zr x O 2 filme e 2 nm Al 2 O 3 foi depositado em p + Substrato de Si usando ALD a 300 ° C, com [(CH 3 ) 2 N] 4 Hf (TDMAHf), [(CH 3 ) 2 N] 4 Zr (TDMAZr) e H 2 O vapor como o precursor Hf, precursor Zr e precursor oxidante, respectivamente. Posteriormente, o substrato foi submetido a um recozimento térmico rápido (RTA) a 450 ° C por 30 s em N 2 ambiente. Depois disso, algumas camadas de MoS 2 os flocos foram esfoliados mecanicamente e transferidos para o substrato. O diâmetro de p + Substrato de Si usado para depositar HZO (6 nm) / AI 2 O 3 (2 nm) é de 6 polegadas. Empregamos litografia por feixe de elétrons (EBL) para padronizar as almofadas de contato em poli (metacrilato de metila) (PMMA) resistente A5. Os parâmetros de rotação, parâmetros de cozimento e parâmetros de imagem são 500 r / min (9 s) + 4000 r / min (40 s), 170 ° C (5 min), MIBK:IPA =1:3 (15 s), respectivamente . Em seguida, os eletrodos fonte / dreno (Ti / Au, 5/65 nm de espessura) foram evaporados usando um sistema de evaporação por feixe de elétrons (EBE) e atacados por solução de acetona. Após a decolagem, o dispositivo foi recozido a 300 ° C por 2 h para aumentar o contato. Realizamos a caracterização elétrica de nosso MoS fabricado 2 / HZO transistores de efeito de campo usando uma estação de teste com um micromanipulador. A tensão da porta traseira ( V GS ) foi aplicado no substrato de Si fortemente dopado de tipo p. Um sistema de caracterização de semicondutor (PDA) foi usado para medir a tensão fonte-dreno ( V DS ), a tensão da porta traseira ( V GS ), e a corrente fonte-dreno ( I DS )
Resultados e discussão
Preparamos algumas camadas de MoS 2 por esfoliação mecânica do cristal em massa e transferido o MoS 2 nanoflake no Al de 2 nm 2 O 3 / 6 nm HZO / p + Substrato de Si (veja mais detalhes na seção “Experimental”). As Figuras 1a eb exibem uma vista esquemática 3D e seção transversal do HZO / MoS 2 Estrutura FeFET, respectivamente. Uma imagem de microscopia eletrônica de varredura (SEM) de vista superior do HZO / MoS 2 O FeFET é mostrado na Fig. 1c. A largura e o comprimento do MoS 2 canal são 2 μm e 12 μm, respectivamente. Conforme mostrado na Fig. 1d, a espessura do MoS 2 canal foi confirmado usando microscopia de força atômica (AFM). A espessura medida de 1,57 nm indica a presença de 4 camadas de MoS 2 [26].
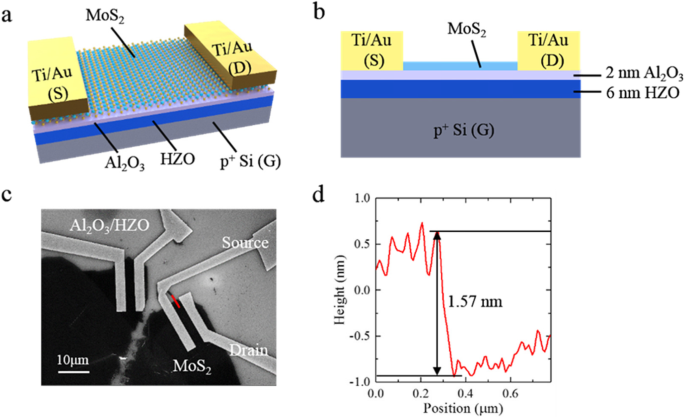
Estrutura do dispositivo e propriedades básicas do MoS 2 / HZO FeFET. a Representação esquemática tridimensional do MoS 2 / HZO FeFET. b Seção transversal esquemática do MoS 2 / HZO FeFET. c Imagem SEM de vista superior do MoS fabricado 2 / HZO FeFET com eletrodos de fonte / dreno de Ti / Au, isoladores de porta ferroelétrica HZO e MoS 2 canais. d Perfil de altura usando AFM de modo de contato ao longo da linha vermelha em c , validando a altura do MoS 2 canal.
Como mostrado na Fig. S1c e d, a composição elementar e de ligação de HZO foi examinada pelas medições de fotoelétrons de raios-X (XPS). Os picos encontrados são 19,05 eV, 17,6 eV, 185,5 eV e 183,2 eV, que correspondem ao Hf 4f 5/2 , Hf 4f 7/2 , Zr 3d 3/2 e Zr 3d 5/2 , respectivamente [27]. A concentração atômica ao longo do perfil de profundidade na Fig. S1e confirma ainda mais a distribuição do Al 2 O 3 / HZO / p + Estrutura de três camadas de Si. Todos os itens acima confirmam que o filme de HZO crescido por meio de nosso sistema de deposição de camada atômica (ALD) é altamente cristalino.
Antes de investigar a caracterização de HZO / MoS 2 FeFET, o comportamento ferroelétrico do Au / 2 nm Al 2 O 3 / 6 nm HZO / p + A pilha de portas de Si usando medição de tensão de polarização é mostrada na Fig. 2a. Claramente, nosso fabricado 6 nm HZO / 2 nm Al 2 O 3 capacitores exibem loops de histerese de voltagem de polarização (medido a 1 kHz). Enquanto isso, a polarização remanescente P r e a tensão coercitiva V c aumentar com o aumento da tensão máxima de varredura, implicando o P-V os loops de histerese se transformam de um loop menor em um loop principal. À medida que a tensão máxima de varredura aumenta de 2 para 4 V, P r atinge 0,66 μC / cm 2 , 0,86 μC / cm 2 e 1,1 μC / cm 2 , respectivamente e V c atinge 1,12 V, 1,9 V e 2,04 V, respectivamente. Extraído P r e V c dentro de 10 5 os ciclos de varredura DC duradouros são mostrados nas Fig. 2b e c. Obviamente, efeitos significativos de despertar e fadiga em até 10 5 ciclos são observados em 6 nm HZO / 2 nm Al 2 O 3 capacitor. O despertar e a fadiga podem ser atribuídos à difusão e redistribuição das lacunas de oxigênio sob o campo elétrico. O efeito da fadiga está geralmente associado ao aprisionamento de carga nos locais de defeito relacionados às vacâncias de oxigênio [28]. Os comportamentos de histerese para a PRphase e loop em forma de borboleta para o PRampl usando microscopia de força de resposta piezoresposta (PFM) são exibidos na Fig. S1b e c, indicando uma comutação de polarização como uma função da tensão de polarização de varredura. Considerando as diferentes resistências de contato entre a medição da tensão de polarização e a medição da tensão de resposta piezoelétrica, o V medido c na Fig. S1b e c não é tão consistente com os valores obtidos na Fig. 2a.

a Loops de histerese P-V para o HZO (6 nm) / Al 2 O 3 (2 nm) capacitor com diferentes faixas de varredura de tensão. Dependência de ( b ) P r e c V c no ciclismo para o HZO (6 nm) / Al 2 O 3 (2 nm) capacitor com ciclagem de ± 4 V / 1 kHz
Além disso, observa-se que há um aumento do MW acompanhado da elevação da faixa de tensão de varredura da porta ( V GS, alcance ) Normalmente, o filme HZO policristalino existe como estado de multi-domínio [29], e a distribuição de campo coercitiva desses domínios satisfaz a distribuição Gaussiana. Assim, deve haver um aumento da dependência dos elevados V GS, alcance . A ação coerciva E C corresponde ao valor do campo elétrico externo que pode reduzir a polarização remanente a zero. Portanto, o V GS , intervalo usado para mudar a polarização no filme HZO torna-se maior com maior tensão coercitiva relacionada V C . Esta é a razão pela qual os loops de voltagem de polarização do filme HZO são estendidos com um V maior GS, alcance , que foi demonstrado na Fig. 2a. Em outras palavras, a intensidade de polarização aumentada e a comutação ferroelétrica ocorrem com o V elevado GS, alcance , levando aos fenômenos mencionados acima do MW estendido no sentido anti-horário produzido pelo V aumentado GS, alcance . Em V GS, alcance =(-2, 2 V), os MW estão quase desaparecidos e surgem características quase livres de histerese, o que significa a compensação quase completa entre os efeitos da comutação ferroelétrica e o aprisionamento / retirada de carga.
A fim de investigar mais a fundo o efeito da comutação ferroelétrica, o V GS, alcance foi aumentado continuamente para (−6, 6 V) e (−6,5, 6,5 V). O medido eu DS - V GS curvas do HZO MoS 2 FeFET em V GS, alcance =(−6, 6 V) e (−6,5, 6,5 V) são mostrados na Fig. 3a. Da mesma forma, a janela de memória no sentido anti-horário é aumentada com o V estendido GS, alcance . Em V GS, alcance =(−6,5, 6,5 V), o MW no sentido anti-horário está acima de 4 V e a relação liga / desliga também aumenta para 10 7 , que é devido à comutação de polarização aprimorada sob uma tensão externa aplicada maior. Geralmente, o mecanismo subjacente aos comportamentos de histerese mostrado no I DS - V GS curvas durante a varredura bidirecional de V GS é a mudança de tensão de limiar, que pode ser modificada pelos efeitos predominantes de comutação de polarização, ou seja, o efeito NC [30,31,32], resultando em histerese no sentido anti-horário. Um estudo adicional das características de sublimiar aprimoradas foi realizado no outro dispositivo sob um V encolhido GS, alcance . O medido eu DS - V GS e extraiu o ponto SS— I DS curvas do outro dispositivo em V GS, alcance =(−3, 3 V) são plotados na Fig. 3b. É demonstrado que em V GS, alcance =(-3, 3 V), HZO / MoS 2 FeFET exibe SS Para =51,2 mV / década e SS Rev =66,5 mV / década, respectivamente. Ou seja, o SS de sub-60 mV / década e um MW de 0,48 V podem ser alcançados simultaneamente em HZO / MoS 2 FeFET à temperatura ambiente, o que será uma dica para distinguir entre NCFET e FeFET.
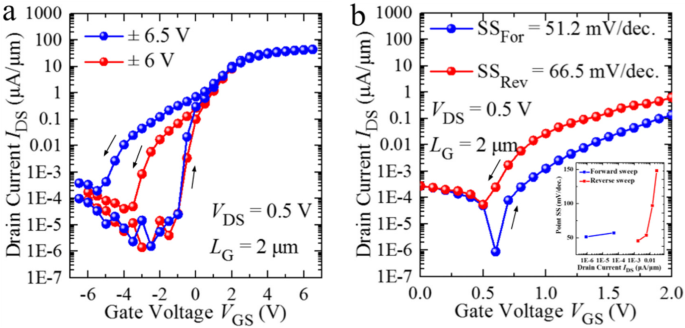
O teste de corrente contínua (DC) do HZO / MoS 2 FeFET ao drenar a tensão ( V DS ) é 0,5 V. a A comparação entre as curvas de transferência com 6 V e 6,5 V como máximo da tensão de porta traseira. b Visão ampliada das curvas de transferência no intervalo de 0 a −2 V de V GS, alcance =(-3, 3 V). Declive sublimiar do ponto (SS) em função da corrente de drenagem ( I DS ) do HZO / MoS 2 FeFET é ( b ) inserido. O dispositivo exibe SS Para =51,2 mV / dec
Como se sabe, no NCFET, o SS pode ser menor que 60 mV / década à temperatura ambiente devido à incorporação da capacitância dielétrica da porta negativa ( C ins ), que pode ser obtido por meio do segmento de inclinação negativa de d P / d E <0 induzido pelo filme ferroelétrico, contribuindo para o fator de gate stack (m) <1. O mecanismo subjacente ao efeito NC [33] é o campo de despolarização gerado pelo filme ferroelétrico [34,35,36,37,38]. É experimentalmente relatado que, devido à blindagem incompleta na interface do filme ferroelétrico [39], a carga de polarização residual poderia produzir um campo elétrico interno através do filme ferroelétrico, que tem direção oposta à tensão aplicada externamente, levando ao retorno distribuição da tensão através do gate stack e do potencial de superfície do canal amplificado, denominado “efeito de amplificação de tensão” [40,41,42]. A amplificação da tensão geralmente pode ser dividida em duas partes, a variação acelerada do potencial de superfície do canal e o valor subsequente aumentado, proporcionando a comutação LIGA / DESLIGA acentuada e I melhorado LIGADO / eu DESLIGADO , respectivamente. No entanto, para o FeFET, há outra história. De acordo com o conceito de casamento de capacitância entre capacitância ferroelétrica ( C FE ) e capacitância de semicondutor de óxido metálico ( C MOS ) [43,44,45], quando | C FE |> C MOS , a capacitância total teórica ( C total ) é positivo e o sistema é estável, resultando nos mesmos comportamentos de polarização durante a varredura bidirecional de V GS e o NCFET livre de histerese estável. No entanto, uma boa correspondência resultando em SS e transcondutância melhorados é muito difícil de conseguir, uma vez que ambos C MOS e C FE são capacitores muito não lineares e dependentes de polarização. Além disso, | C FE |> C MOS precisa ser garantido para toda a faixa de tensão de operação para evitar histerese. Em vez disso, uma vez | C FE | < C MOS , o teórico C total é negativo e o sistema é instável, um comportamento de polarização separada deve ocorrer durante a bi-comutação de V GS para manter o C total positivo, o que poderia produzir a histerese anti-horária em FeFET para aplicação NVM. Aqui, é mencionado que o comportamento histerético é o efeito subsequente da comutação de polarização separada, o que significa que a largura da janela de histerese pode ser facilmente modificada com base no conceito de correspondência de capacitância, tal como, que pode ser manipulada pela variação de V DS . Com uma combinação de capacitância apropriada, mesmo com um V muito encolhido GS, alcance =(-3, 3 V), HZO / MoS 2 FeFET ainda exibe uma janela de histerese óbvia, e a mudança acentuada de SS Para =51,2 mV / dec ao mesmo tempo, o que sugere ainda a existência do efeito NC (efeito de polarização ferroelétrica) na região subliminar. Embora NCFET e FeFET sejam diferentes, FeFET também pode ser adotado como dispositivos lógicos com um MW menor comparável, mantendo um SS profundo abaixo de 60 mV / dec e um I superior LIGADO / eu DESLIGADO razão também devido ao efeito NC.
O impacto de V DS na largura do MW foi cuidadosamente investigado. O eu DS - V GS curvas em escalas logarítmicas sob diferentes V DS são caracterizados na Fig. S3. É exibido que, em um V fixo GS, alcance =(−2, 2 V), os valores de V GS extraído em I DS =70 nA para a varredura bidirecional de V GS todos mudam para a direção negativa. Enquanto isso, também é demonstrado que a variação na varredura para frente de V GS é muito mais óbvio do que a varredura reversa, indicando os fenômenos significativos de DIBL negativo. Deve-se notar que o efeito DIBL negativo sempre ocorre com um efeito NC [46, 47].
Após o teste de corrente contínua (DC) acima do HZO / MoS 2 FeFET, realizamos ainda os MWs medidos para diferentes P / E V GS pulsos com largura de 10 ms na Fig. 4a. MW é definido como a variação máxima Δ V TH depois de P / E V GS pulsos. Durante o V pulsado GS aplicativo, os outros terminais foram fixados em V S = V D =0 V. Para a operação de leitura (R), V GS foi variado de -1 V a 1 V com V D =0,5 V e V S =0 V. Conforme mostrado na Fig. 4a, os MWs extraídos tornam-se maiores à medida que P / E V GS pulsos aumentam. Quando o P / E imposto V GS pulso é ± 3 V, o MW extraído é 0,1 V. Quando o P / E imposto V GS pulso é ± 5,5 V, o MW extraído é 0,275 V. Comparado com os MWs no sentido anti-horário de 4 V e 0,48 V na Fig. 3a e b, os MWs extraídos após P / E V GS o pulso é bastante reduzido. Isso é possivelmente devido a uma maior densidade de estados de aprisionamento induzidos por alta umidade no ar [48]. Assim, o mecanismo de captura / remoção de carga é aprimorado e o ciclo de histerese no sentido anti-horário é diminuído eventualmente. Além disso, estudamos a resistência ao ciclismo e a retenção de dados do HZO / MoS 2 FeFET sob pulsos P / E com ± 5,5 V de altura na Fig. 4b. O programa V GS pulso tinha 10 ms de largura com V S = V D =0 V. A Figura 4b ilustra os MWs medidos em função dos ciclos de resistência. O ciclo de resistência é formado por pulsos P / R / E / R periódicos de tensão back-gate. As tensões aplicadas à porta traseira da altura de P, E, R foram + 5,5 V, −5,5 V e 0 V, respectivamente. E a largura de pulso de P e E foi de 10 ms. Claramente, um MW de 0,3 V pode ser mantido sem degradação significativa após 10 3 Ciclos P / E. À medida que o número do ciclo de resistência aumenta, o MW aumenta para 0,38 V após 10 ciclos e, em seguida, diminui de volta para 0,28 V após 600 ciclos. O primeiro MW alargado é denominado efeito de despertar e o MW encolhido posterior é denominado efeito de fadiga. O efeito wake-up corresponde ao de-pinning da parede de domínio, levando a um aumento dos domínios de polarização comutáveis do filme HZO [49]. O efeito da fadiga corresponde a novas cargas injetadas que fixam as paredes do domínio após um grande número de ciclos P / E [50]. A retenção de dados em temperatura ambiente é mostrada na Fig. 4c. Aqui, a degradação do MW é insignificante após 10 4 s. Portanto, pode-se esperar que um MW de cerca de 0,3 V seja sustentável ao longo de 10 anos pelas linhas de extrapolação pontilhadas. Conforme apresentado na Fig. 4d, o dispositivo é estável após 10 3 ciclos sob os pulsos P / E com alturas de ± 3 V. A estabilidade do HZO / MoS 2 FeFET mostra uma grande perspectiva de aplicações em tecnologia de memória não volátil.

Desempenhos de memória do HZO / MoS 2 FeFET sob pulsos P / E. a MWs extraídos (MWs) sob pulsos P / E com alturas de ± 3 V, ± 4 V, ± 5 V, ± 5,5 V e ± 6 V. b Medições de resistência sob condições de pulso P / E. c Característica de retenção do HZO / MoS 2 FeFET. d Resistência do HZO / MoS 2 FeFET para 10 3 ciclos sob os pulsos P / E com alturas de ± 3 V
Uma comparação da figura de mérito com dispositivos baseados em FeFET combinando MoS 2 e dielétricos de porta ferroelétrica são fornecidos na Tabela 1. Aqui, a estrutura do dispositivo, polarização remanescente, campo elétrico coercitivo, direção do loop de histerese, MW, tensão de trabalho, ciclos de resistência e tempo de retenção são listados. É óbvio que o dispositivo que fabricamos exibe a camada ferroelétrica mais fina de 6 nm HZO e a menor tensão de trabalho em comparação com outros trabalhos [12,13,14,15,16,17,18], o que é importante para o futuro 2 nm. ou nó de processo de 3 nm da memória de fim de linha (BEOL). Ao dimensionar a espessura da camada ferroelétrica, um MW de cerca de 0,1 V foi alcançado sob uma baixa tensão de trabalho de ± 3 V. Essa baixa tensão de trabalho pode ser atribuída às características intrínsecas da camada de HZO em comparação com suas contrapartes, como P (VDF-TrFE) ou HfO 2 , que tem uma espessura muito maior. Além disso, nosso dispositivo possui polarização remanescente inferior P r de 1,1 μC / cm 2 em comparação com outros FeFETs relatados. O rápido declínio da perda de retenção em um FeFET é devido à existência do campo de despolarização E dep , que vem da compensação de cobrança incompleta devido à existência do Al 2 O 3 camada. Aqui, E dep é diretamente proporcional à polarização remanescente P r [51]. Assim, o alto E c e baixo P r faça a proporção E dep / E c no MoS 2 / HZO FeFET muito pequeno, levando a uma perda de retenção muito pequena associada ao efeito de campo de despolarização. Embora os desempenhos de retenção do MoS 2 FeFETs baseados em HZO e P (VDF-TrFE) são ambos cerca de 10 4 s, o filme P (VDF-TrFE) precisa ter 150 nm [17].
Conclusões
Em conclusão, investigamos algumas camadas, MoS 2 dispositivos de transistor de memória ferroelétrica baseados em um dielétrico HZO back gate. Nossos dispositivos fabricados apresentam histerese no sentido anti-horário induzida por polarização ferroelétrica. Além disso, nosso HZO / MoS 2 o transistor de memória ferroelétrica exibiu excelentes desempenhos do dispositivo:uma alta relação de corrente liga / desliga de mais de 10 7 e um MW no sentido anti-horário de 0,1 V a uma tensão P / E de 3 V, que tem a resistência (10 3 ciclos) e retenção (10 4 s) desempenho. Assim, acreditamos que os resultados do nosso MoS 2 transistores de memória ferroelétrica não volátil com base em apresentam perspectivas promissoras para o futuro das aplicações de memória não volátil 2D de baixa potência.
Disponibilidade de dados e materiais
Os autores declaram que os materiais, dados e protocolos associados estão à disposição dos leitores, e todos os dados usados para a análise estão incluídos neste artigo.
Nanomateriais
- Classificações e pacotes de transistores (BJT)
- Alguns exemplos com circuitos CA
- American Control Electronics:drive DC de baixa tensão com opção de placa programável snap-on
- MoS2 com Espessura Controlada para Evolução Eletrocatalítica de Hidrogênio
- Nanoesferas de carbono monodispersas com estrutura porosa hierárquica como material de eletrodo para supercapacitor
- Eletrodo de porta de prata impresso a jato de tinta curado por UV com baixa resistividade elétrica
- Melhoria de modulação e absorção de frequência do microbolômetro THz com estrutura de microponte por antenas tipo espiral
- Morfologia, estrutura e propriedades ópticas de filmes semicondutores com Nanislands GeSiSn e camadas deformadas
- Transistores de efeito de campo ferroelétricos baseados em padrões de faixa de micron-largas dominadas por nanotubo de carbono de parede única com camada de controle de defeito de HfO2
- Crescimento do mercado de controle de baixa tensão



