Estudo teórico e experimental sobre AlGaN / GaN Schottky Barrier Diode em substrato de Si com dupla heterojunção
Resumo
Um diodo de barreira Schottky AlGaN / GaN (SBD) com dupla heterojunção é teoricamente e experimentalmente investigado no GaN / AlGaN / GaN / Si-sub. O gás de buraco bidimensional (2DHG) e o gás de elétron (2DEG) são formados na interface GaN-top / AlGaN e AlGaN / GaN, respectivamente. No estado desligado, o 2DEH e o 2DHG são parcialmente esgotados e, em seguida, desaparecem completamente. Restam as cargas fixas de polarização positiva e negativa, formando a junção de polarização. Portanto, um campo elétrico plano na região de deriva e uma alta tensão de ruptura (BV) são obtidos. Além disso, o ânodo é rebaixado para reduzir a tensão de ativação ( V LIGADO ) O processo de corrosão ICP de baixo dano resulta em contatos Schottky aprimorados e uma baixa corrente de vazamento e um baixo V LIGADO é obtido. O SBD fabricado exibe um BV de 1109 V com distância anodo-catodo ( L AC ) de 11 μm. Os SBDs fabricados alcançam um baixo V LIGADO de 0,68 V com boa uniformidade, uma alta relação de corrente liga / desliga ∼ 10 10 à temperatura ambiente, uma baixa resistência específica sobre ( R ON, SP ) de 1,17 mΩ cm 2 e uma figura de mérito de Baliga (FOM) elevada de 1051 MW / cm 2 .
Introdução
Diodo lateral baseado em heteroestrutura AlGaN / GaN é um dispositivo atraente devido à alta mobilidade de elétrons do gás de elétron bidimensional (2DEG), alta velocidade de saturação de elétrons e campo elétrico de alta degradação [1,2,3]. Esforços extensos foram feitos para alcançar uma tensão de ativação baixa ( V LIGADO ), uma baixa corrente de fuga reversa e uma alta tensão de ruptura (BV) para os diodos GaN usados em conversores e inversores para fontes de alimentação e correções de fator de potência [4,5,6,7,8,9,10,11,12] . Várias abordagens têm sido propostas para resolver a distribuição não uniforme do campo elétrico. Um deles é a tecnologia de placa de campo (FP) [5, 13]. Um ânodo SBD totalmente rebaixado com uma placa de campo dupla atinge uma alta tensão de ruptura de 1,9 kV com 25 μm L AC [5] . Ele também pode reduzir significativamente a tensão de ativação, ao mesmo tempo que mantém a alta tensão de ruptura. Além disso, o conceito convencional de Reduced SURface Field (RESURF) comumente empregado na tecnologia do silício foi demonstrado no GaN HEMT [14]. Além disso, a junção de polarização (PJ) que consiste no gás de furo bidimensional (2DHG) acima do 2DEG é proposta para melhorar a relação entre a resistência específica ( R ON, SP ) e BV [15,16,17,18]. Dispositivos baseados em GaN baseados no conceito PJ foram demonstrados em substratos Sapphire e SiC, enquanto o alto custo e pequenos diâmetros do GaN em substratos SiC vão contra a aplicação comercial em massa. GaN-sobre-Si com grande diâmetro é considerado uma escolha promissora devido ao baixo custo [19,20,21,22]. Portanto, o desempenho do diodo PJ em substratos de silício é digno de estudo.
Neste trabalho, propusemos e demonstramos experimentalmente um diodo de barreira Schottky GaN / AlGaN / GaN-on-Si com dupla heterojunção (DJ). O efeito de polarização-junção é confirmado por simulações e experimentos. O campo elétrico plano (campo E) entre os eletrodos ânodo e cátodo é alcançado. O processo de ICP para decapagem da trincheira Schottky é otimizado para alcançar uma corrente de fuga reversa baixa e um baixo V LIGADO com excelente uniformidade de corrosão. O processo de contato ôhmico também é otimizado para atingir uma baixa resistência de contato (para 2DEG) com base na camada epitaxial personalizada (com 45 nm GaN-top). Portanto, uma tensão de ruptura de 1109 V é alcançada para os SBDs com 11 μm L AC e a figura de mérito de Baliga (FOM) é 1051 MW / cm 2 . A dependência da temperatura e dinâmica R ON, SP desempenho também são investigados.
Método e Experiência
A camada epitaxial foi cultivada por deposição de vapor químico orgânico de metal em 6-in de silício tipo p, consistindo em camada tampão de GaN de 3,5 μm, camada de canal de GaN de 150 nm, camada intermediária de AlN de 1 nm, Al de 45 nm 0,25 Ga 0,75 Camada de barreira N e camada superior de GaN de 45 nm de baixo para cima. A camada superior de GaN inclui a camada de p-GaN de 35 nm e a camada de GaN não dopada de 10 nm. Para uma dada espessura de AlGaN de 45 nm, a densidade 2DHG aumenta com o aumento da espessura do topo de GaN [22]. A camada superior espessa de GaN é vital para o 2DHG de alta densidade, embora vá contra a baixa resistência de contato ôhmico (para 2DEG). As vistas esquemáticas do diodo de barreira Schottky de dupla heterojunção proposto (DJ SBD) são mostradas na Fig. 1a. A fabricação do SBD começou com o isolamento da mesa por Cl 2 / BCl 3 de plasma indutivamente acoplado (ICP) com base em corrosão a uma profundidade de 300 nm. Em seguida, a trincheira ôhmica e a trincheira anódica Schottky foram formadas com o processo de corrosão ICP de baixo dano. A profundidade da trincheira ôhmica e da trincheira anódica Schottky foi de 50 nm e 90 nm, respectivamente, o que foi confirmado usando microscopia de força atômica (AFM). Solução de hidróxido de tetrametilamônio (TMAH) a 85 ° C por 15 min foi introduzida para remover os resíduos pós-condicionamento e para modificar a parede lateral da vala após o término do processo de condicionamento [23]. Então, o recozimento a 400 ° C por 10 min em N 2 ambiente foi realizado. O cátodo ôhmico foi subsequentemente formado por feixe e evaporado de Ti / Al / Ni / Au (20/140/55/45 nm), recozido a 870 ° C por 35 s em N 2 ambiente, com uma resistência de contato ( R C ) de 0,49 Ω · mm. Finalmente, o metal do ânodo e as interconexões foram depositados por Ni / Au para completar o fluxo de fabricação. Os dispositivos apresentavam vários L AC de 7 a 11 μm. A Figura 1b mostra a imagem TEM de seção transversal de alta resolução do ânodo após ICP e deposição de metal, e a estrutura da camada foi observada claramente.
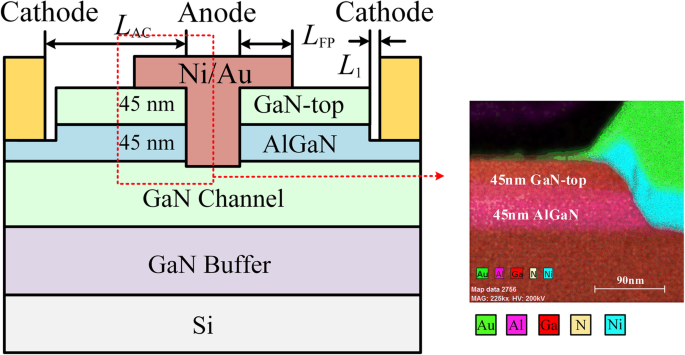
a Seção transversal da proposta de dupla heterojunção AlGaN / GaN SBD e processo de fabricação principal. L AC é o comprimento do ânodo ao cátodo. L FP e L 1 são 1 μm e 2 μm, respectivamente. b Imagem HR-TEM do ânodo após ICP e deposição de metal
O 2DEG é induzido pelas cargas de polarização positiva ao longo da interface AlGaN / GaN. A interface GaN / AlGaN superior tem cargas de polarização negativas e, portanto, gera 2DHG na interface superior [15]. A lacuna entre a região de deriva e o cátodo ( L 1 ) é usado para cortar o caminho da corrente do furo, conforme mostrado na Fig. 2. Nós investigamos apenas a influência de L 1 de 2 a 3 μm nas características de bloqueio direto e reverso devido ao limite do projeto do layout original. O V LIGADO e R ON, SP não mostrar mudanças porque L 1 não afeta o contato Schottky e o caminho da corrente de elétrons. Além disso, o BV diminui ligeiramente com o aumento em L 1 por causa da região de deriva encurtada. O mecanismo de operação dos DJ SBDs sob polarização direta é quase o mesmo que os SBDs convencionais, o que significa que 2DHG dificilmente afeta o caminho da corrente de elétrons do cátodo ao ânodo. Com o aumento da tensão de polarização reversa, o 2DEG e o 2DHG estão totalmente esgotados. Permanecem cargas de polarização positivas e negativas fixas, que formam a junção de polarização. Como resultado, uma distribuição plana do campo E entre o cátodo e o ânodo é obtida (Fig. 3).
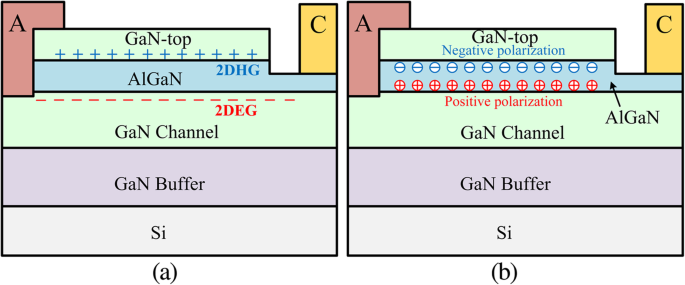
Análise do mecanismo de operação de DJ SBDs a polarização zero e b polarização inversa

Distribuição do campo elétrico ao longo da heterointerface do canal AlGaN / GaN por simulação TCAD. A fração de Al é definida como 0,25. A densidade do aceitador líquido (nível profundo) na camada de buffer é definida como 1,5 × 10 16 cm −3 e o nível de energia é 0,45 eV abaixo do mínimo da banda de condução. A densidade do aceitador da interface AlGaN / GaN é definida como 6 × 10 12 cm −3 e o nível de energia é 0,23 eV abaixo do mínimo da banda de condução
Como mostrado na Fig. 3, a característica de ruptura e o mecanismo de junção de polarização foram confirmados por 2-D Sentaurus TCAD da Synopsys. Levamos em consideração vários fenômenos físicos importantes na simulação, incluindo estreitamento do bandgap, polarização, mobilidade elétron / buraco, ionização por impacto e recombinação SRH.
A medição do efeito Hall foi adotada para determinar os valores de densidade e mobilidade 2DHG ou 2DEG [22]. As medidas foram realizadas pelo método de Van der Pauw em temperatura ambiente. Para medir 2DHG de acordo com a Ref. [17], as amostras de medição Hall foram fabricadas com contatos ôhmicos de Ni / Au. A densidade e mobilidade do 2DHG eram 9 × 10 12 cm −2 e 15 cm 2 / V s, respectivamente. O 2DEG foi medido pelas amostras com recesso de GaN-top e parcialmente AlGaN fabricado com contatos ôhmicos Ti / Al / Ni / Au (para 2DEG). A densidade e mobilidade do 2DEG eram 8,5 × 10 12 cm −2 e 970 cm 2 / V s, respectivamente. As medições de Hall mostraram que a mobilidade do buraco ainda era muito menor do que a mobilidade em massa acima de 100 cm 2 / V s. A degradação da mobilidade foi atribuída à difusão de Mg do p-GaN para o GaN não dopado durante o crescimento do MOCVD.
Resultados e discussão
O I-V medido características avançadas dos SBDs com vários L AC são plotados na Fig. 4a e b. A tensão de ativação ( V LIGADO ) é 0,68 V com uma pequena variação de 0,02 V. O fator de idealidade e a altura da barreira dos SBDs são calculados como 1,44 ± 0,15 e 0,76 ± 0,04 eV, respectivamente. A Figura 4a mostra que a alta densidade de corrente direta de 183 mA / mm e 144 mA / mm (@ polarização direta de 2,5 V) e a resistência de 0,642 e 1,17 mΩ cm 2 são alcançados em L AC =7 e 11 μm, respectivamente. Além disso, uma excelente relação de corrente liga / desliga ∼ 10 10 é obtido como mostrado na Fig. 4b. A inclinação subliminar (SS) é de 63,0 mV / dec, que está próxima do SS ideal (59,6 mV / dec).
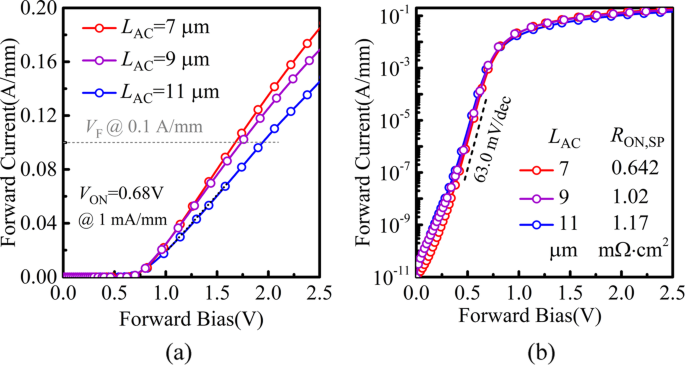
Polarização para frente medida I-V características de DJ SBDs em a linear e b escala semi-logarítmica com diferentes L AC
A Figura 5a mostra o bloqueio reverso medido I-V características dos SBDs com vários L AC a 300 K. A tensão de ruptura dos dispositivos com diferentes L AC é 803 V, 940 V e 1109 V, respectivamente, a uma corrente de fuga de 1 mA / mm. As densidades de 2DEG e 2DHG são consideradas iguais durante a simulação. No entanto, os resultados experimentais mostram que as densidades de 2DHG (9 × 10 12 cm −2 ) são ligeiramente superiores aos de 2DEG (8,5 × 10 12 cm −2 ) A diferença entre as cargas fixas de polarização positiva e negativa durante o estado desligado afeta o equilíbrio da carga e, portanto, degrada a tensão de ruptura. A influência do L AC no BV e no R ON, SP é mostrado na Fig. 5b. Uma relação quase linear entre BV e L AC é obtido, implicando o campo E lateral plano relativo na região de deriva. Devido ao efeito de junção de polarização, o dispositivo demonstra uma figura de mérito de Baliga alta (FOM =BV 2 / R ON, SP ) de 1051 MW / cm 2 (@ L AC =11 μm).
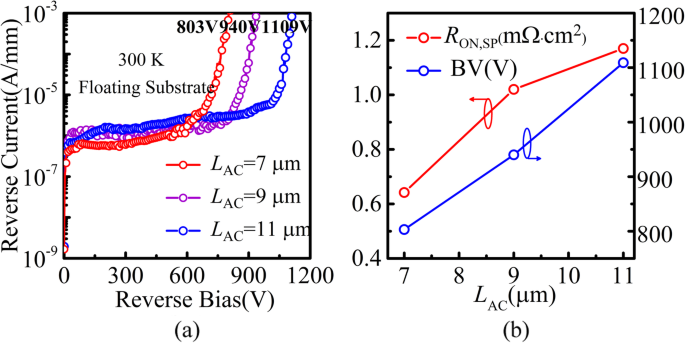
a Bloqueio reverso medido I-V características de DJ SBDs com diferentes L AC ( b ) R ON, SP e BV como as funções de L AC
O processo de corrosão é vital para a interface Schottky de alta qualidade e o contato ôhmico. A Figura 6a mostra a morfologia da superfície da vala recuada após o ataque químico ICP (@ 5 ° C) e a solução TMAH. A taxa de corrosão é de aproximadamente 4,9 nm / min, e a receita final selecionada é com um Cl 2 de 4 sccm, uma potência de ICP de 50 W e uma potência de RF de 15 W. A rugosidade quadrada média (RMS) é de 0,244 nm com a área de varredura de 2 × 2 μm 2 .
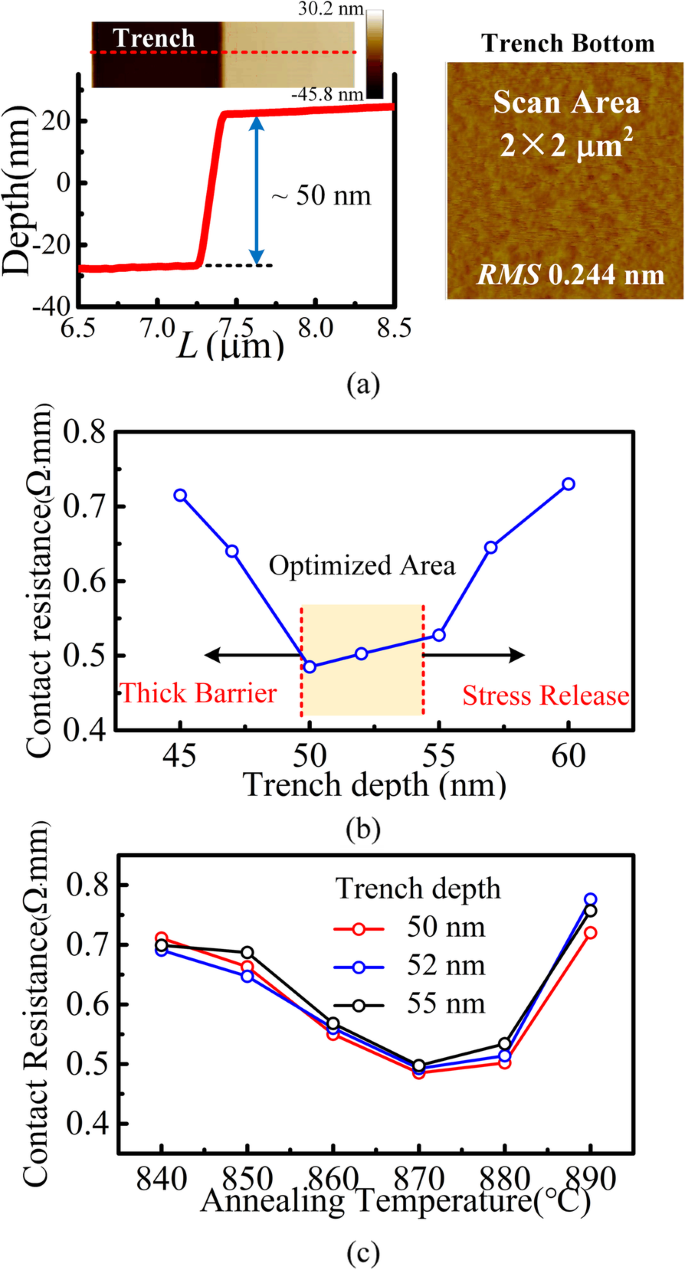
a Morfologia AFM da trincheira após ataque ICP. b Influência da profundidade de corrosão na resistência de contato ôhmico pelo teste TLM. c Resistência de contato em função da temperatura de recozimento com a profundidade da vala de 50 a 55 nm. O tempo de recozimento foi de 35 s
Como a camada epitaxial personalizada inclui a camada superior de GaN de 45 nm e a camada de AlGaN de 45 nm, o processo de contato ôhmico (para 2DEG) é diferente dos SBDs convencionais. Sem recuar as camadas de barreira GaN-top e AlGaN, baixa resistência de contato é difícil de ser alcançada por recozimento por causa da barreira de potencial entre o metal ôhmico e o 2DEG. No entanto, se a barreira for rebaixada, a liberação de tensão leva a uma redução na concentração de 2DEG. Os processos extras são adotados para reduzir a resistência ôhmica de contato. As superfícies das amostras são tratadas pela solução de HCl para remover a camada de óxido nativo antes da deposição. Além disso, o tratamento de superfície de plasma é adotado (ICP power 50 W BCl 3 10 sccm 3 min) para introduzir estados doadores de superfície [24]. A Figura 6b demonstra a dependência da resistência de contato com a profundidade da vala. A profundidade otimizada é obtida de 50 a 55 nm. O recozimento térmico rápido de alta temperatura (RTA) para o contato Ti / Al / Ni / Au é investigado na Fig. 6c. A temperatura de recozimento é de 840 a 890 ° C, e 870 ° C resulta na menor resistência de contato. O recozimento em alta temperatura, isto é, 870 ° C, é propício à formação de TiN na interface Ti / nitreto. No entanto, a temperatura mais elevada (por exemplo, 890 ° C) aumenta a interdifusão de Au e Al, o que é desvantajoso para a formação de bons contatos ôhmicos.
A Figura 7a-c exibe os gráficos estatísticos das características estáticas, incluindo V LIGADO , V F e BV. Os dados são extraídos de 72 SBDs com L AC de 7, 9 e 11 μm fabricados em 3 execuções de processo separadas. Os dispositivos exibem características de ativação direta estáveis e V LIGADO é independente com L AC , porque V LIGADO é determinado principalmente pelo contato Schottky. O processo de corrosão ICP de baixo dano, a profundidade da trincheira precisamente controlada e a interface Schottky de alta qualidade contribuem para a excelente uniformidade do V LIGADO e V F . Além disso, com o aumento de L AC (de 7 para 11 μm), há um aumento monotônico (∼ 100 V / μm) na VB observada nas estruturas propostas. A Figura 7d mostra as estatísticas do histograma do V LIGADO para 72 dispositivos, e o valor médio é 0,68 V com uma pequena derivação padrão de 0,02 V.

Gráficos estatísticos de a tensão de ativação, b tensão direta e c tensão de ruptura extraída de 72 SBDs com L AC de 7, 9 e 11 μm fabricados em 3 execuções de processo separadas. d Distribuição de V LIGADO para 72 dispositivos
A dependência das características reversa e direta com a temperatura é avaliada na Fig. 8. Como mostrado na Fig. 8a, um aumento na temperatura ambiente de 300 para 475 K resulta em um aumento no R ON, SP por um fator de 1,94.
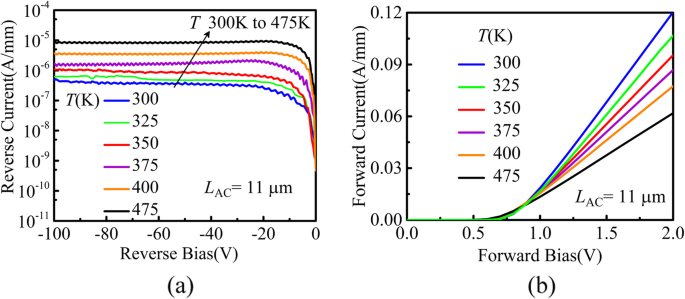
a Corrente de fuga reversa e b características avançadas para os DJ SBDs em diferentes temperaturas
As características dinâmicas dos DJ SBDs são medidas pelo analisador de dispositivo de energia Agilent B1505A. Os pontos de polarização quiescente do pulso do ânodo são ajustados para ser - 10 V, - 20 V, - 30 V, - 40 V, - 70 V e - 100 V, com a largura do pulso do ânodo e período de 0,5 ms / 500 ms. A Figura 9b mostra o R dinâmico ON, SP em função da tensão de estresse. O dinâmico R ON, SP mesmo com tensão de reserva de 100 V, a tensão é apenas 1,18 vezes daquela sem tensão reversa, que é comparável à Ref. [8]. O aumento limitado na dinâmica R ON, SP contribui para a redução do estado da interface. A degradação do R dinâmico ON, SP precisa de mais trabalho.
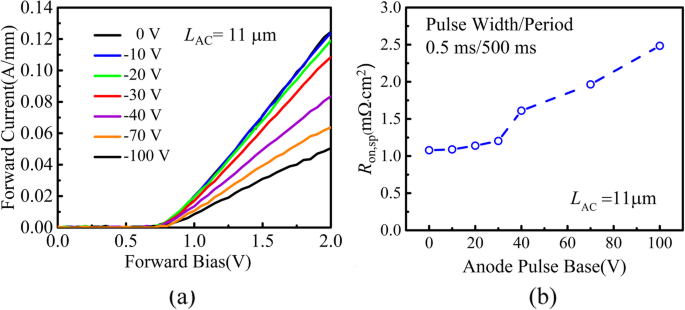
a I-V características sob medição de pulso. b Extraído R ON, SP versus base de pulso anódico com largura / período de pulso =0,5 ms / 500 ms
A Figura 10 apresenta o gráfico de benchmark de BV versus R ON, SP para diodo de potência GaN em substratos de Si / SiC / safira [8, 10, 22, 25,26,27,28,29,30,31]. O dispositivo proposto com L AC de 11 μm demonstra um BV de 1109 V com um R correspondente ON, SP de 1,17 mΩ cm 2 , levando a um alto FOM de Baliga de 1051 MW / cm 2 . Este valor é o melhor resultado entre o diodo de potência GaN lateral em substrato de Si.
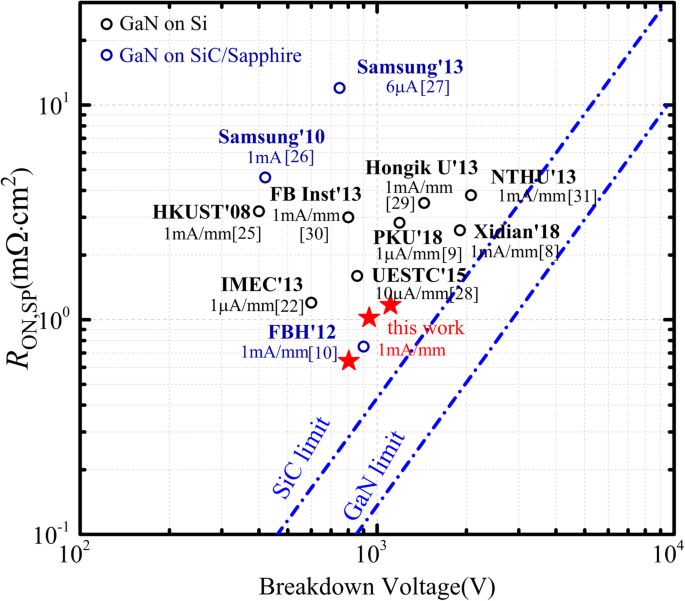
Gráfico de referência de BV versus R ON, SP de diodo de potência de GaN em substratos de SiC / safira / Si. O vazamento reverso usado para definir a quebra também é dado
Conclusão
Uma dupla heterojunção GaN / AlGaN / GaN-on-Si SBD com uma alta figura de mérito é fabricada. O processo de corrosão ICP de baixo dano resulta nos contatos ôhmicos e Schottky otimizados para o dispositivo proposto. Portanto, um baixo V LIGADO de 0,68 V com boa uniformidade e baixo R ON, SP de 1,17 mΩ cm 2 são obtidos no dispositivo com L AC de 11 μm. Um alto FOM de Baliga de 1051 MW / cm 2 é alcançado devido ao efeito de junção de polarização. O alto desempenho junto com a tecnologia GaN-on-Si de baixo custo exibe um grande potencial para futuras aplicações de energia.
Disponibilidade de dados e materiais
Todos os dados gerados ou analisados durante este estudo estão incluídos neste artigo.
Abreviações
- SBD:
-
Diodo barreira Schottky
- 2DEG / 2DHG:
-
Gás de elétron / buraco bidimensional
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- ICP:
-
Plasma indutivamente acoplado
- TEM:
-
Microscopia eletrônica de transmissão
- AFM:
-
Microscópio de força atômica
- BV:
-
Queda de tensão
- R ON, SP :
-
Resistência específica
- V LIGADO :
-
Tensão de ativação
- FOM:
-
Figura de mérito
Nanomateriais
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Pesquisa Experimental sobre Estabilidade e Convecção Natural de Nanofluido de TiO2-Água em Compartimentos com Diferentes Ângulos de Rotação
- Investigação sobre polarização de superfície de heteroestrutura GaN / AlGaN / GaN capeada por Al2O3 por espectroscopia de fotoelétrons de raios-X com resolução de ângulo
- RGO e redes de grafeno tridimensionais TIMs co-modificados com alto desempenho
- Estudo experimental sobre as características de fluxo e transferência de calor de nanofluidos de TiO2-água em um tubo espiralado
- Aerogel de Grafeno / Polianilina com Superelasticidade e Alta Capacitância como Eletrodo de Supercapacitor Altamente Tolerante à Compressão
- Estudo experimental de etossomos encapsulados com 5-fluorouracil combinados com laser fracionado de CO2 para tratar cicatriz hipertrófica
- Uma Visão Geral do Diodo de Barreira Schottky Baseado em Semicondutor Ga2O3 Ultrawide para Aplicação de Eletrônica de Potência
- Estudos experimentais e teóricos do contato de Mo / Au Schottky em filme fino β-Ga2O3 mecanicamente esfoliado
- Benefícios e desvantagens dos ângulos de alta e baixa hélice



