Na camada de propagação de corrente p-AlGaN / n-AlGaN / p-AlGaN para diodos emissores de luz ultravioleta profunda à base de AlGaN
Resumo
Neste relatório, diodos emissores de luz ultravioleta profunda à base de AlGaN (LEDs DUV) com diferentes camadas de propagação de corrente estruturadas de p-AlGaN / n-AlGaN / p-AlGaN (PNP-AlGaN) foram descritos e investigados. De acordo com nossos resultados, a estrutura PNP-AlGaN adotada pode induzir uma barreira de energia na camada de injeção do orifício que pode modular a distribuição de corrente lateral. Também descobrimos que o efeito de espalhamento da corrente pode ser fortemente afetado pela espessura, a concentração de dopagem, o loop PNP e a composição de AlN para a camada n-AlGaN inserida. Portanto, se a estrutura PNP-AlGaN for adequadamente projetada, a tensão direta, a eficiência quântica externa, a potência óptica e a eficiência da tomada para os LEDs DUV propostos podem ser significativamente melhorados em comparação com o LED DUV convencional sem o PNP -AlGaN structure.
Introdução
Desde a primeira ocorrência em 2003, os diodos emissores de luz ultravioleta profunda à base de AlGaN (LEDs DUV) têm atraído muito interesse devido à sua ampla gama de aplicações, como esterilização de água e purificação do ar [1,2,3,4,5, 6,7]. No entanto, a eficiência quântica externa (EQE) para LEDs DUV é inferior a 10% quando o comprimento de onda de emissão é menor que 300 nm [8], o que limita significativamente sua posterior aplicação. O baixo EQE decorre parcialmente da baixa eficiência quântica interna (IQE). Foi dada atenção substancial ao fato de que o IQE é notavelmente influenciado pela injeção do portador e pelas luxações estendidas [8]. Os LEDs DUV baseados em AlGaN que crescem em substratos de safira isolante empregam a estrutura flip-chip para a melhor eficiência de extração de luz. No entanto, a estrutura flip-chip do DUV LED requer que o eletrodo n e o eletrodo p estejam no mesmo lado. Portanto, ocorre facilmente a distribuição não homogênea da corrente lateral, ou seja, o efeito crowding da corrente [9]. O efeito de aglomeração atual pode facilmente causar o efeito de aquecimento Joule local e a emissão de luz desigual [10,11,12]. Vale ressaltar que o superaquecimento local deteriora seriamente a vida útil dos LEDs DUV. Além disso, a eficiência de dopagem de Mg muito pobre para a camada de injeção de orifício à base de p-AlGaN rica em Al leva à má condutividade elétrica [13], o que manifesta ainda mais a importância para melhorar o espalhamento de corrente para LEDs DUV. Embora Khan et al. apontaram que o crowding atual deve ser levado em consideração em seu artigo de revisão [14], análises detalhadas sobre o crowding atual e as soluções para ele são menos discutidas para LEDs DUV até agora.
Extensas técnicas para promover a propagação de corrente foram relatadas para LEDs azuis baseados em GaN, e a propagação de corrente pode ser melhorada, por exemplo, implantando seletivamente a camada p-GaN [15, 16], inserindo uma camada de bloqueio de corrente (CBL) [17,18,19], produzindo seletivamente vacâncias de nitrogênio para compensar os furos na camada p-GaN [20], otimizando o processo de recozimento para contato ôhmico [21]. Além de usar as abordagens de pós-fabricação, a camada de espalhamento atual também pode ser obtida por crescimento epitaxial in situ no sistema de deposição de vapor químico orgânico de metal (MOCVD). Exemplos importantes são os seguintes:a estrutura de super-rede p-GaN / i-InGaN de curto período entre a estrutura de poços quânticos múltiplos (MQWs) e a camada p-GaN [22, 23], as junções do túnel [24, 25] e a barreira junções [10]. No entanto, relatórios sobre epi-estruturas para melhorar a propagação atual para LEDs DUV podem ser encontrados raramente. Nesta carta, propomos o uso da camada p-AlGaN / n-AlGaN / p-AlGaN (PNP-AlGaN) para melhor espalhar a corrente lateral para LEDs DUV. A estrutura PNP-AlGaN pode gerar a barreira de energia na banda de valência da camada de injeção do orifício do tipo p. A barreira de energia pode modular a resistividade elétrica para a camada de injeção de furo tipo p e, portanto, o caminho do fluxo de corrente pode ser ajustado. Projetando adequadamente a camada de espalhamento de corrente PNP-AlGaN, o EQE, a eficiência do plugue de parede (WPE) e a tensão direta podem ser melhorados. Além disso, este trabalho também investiga de forma abrangente a sensibilidade do espalhamento de corrente, o EQE, o WPE e a tensão direta para o loop PNP-AlGaN, a concentração de dopagem de Si, a espessura e a composição de AlN para a camada n-AlGaN inserida da arquitetura PNP-AlGaN.
Métodos de pesquisa e modelos de física
Para esclarecer melhor os mecanismos de propagação atuais para LEDs DUV baseados em AlGaN, diferentes dispositivos LED DUV são projetados (ver Fig. 1a). Todos os LEDs DUV consistem em um Al tipo n de 4 μm de espessura 0,60 Ga 0,40 Camada N com a concentração de dopagem de Si de 5 × 10 18 cm −3 . A seguir, cinco períodos de Al de 3 nm 0,45 Ga 0,55 N / 12 nm Al 0,56 Ga 0,44 Seguem N MQWs. Em seguida, limitamos os MQWs com um Al do tipo p de 18 nm de espessura 0,60 Ga 0,40 Camada de bloqueio de elétrons N (p-EBL), na qual um Al tipo p de 198 nm de espessura 0,40 Ga 0,60 A camada N e uma camada de cobertura de GaN do tipo p com 50 nm de espessura são empregadas como a camada de injeção do orifício. A concentração do orifício para as camadas do tipo p é definida como 3 × 10 17 cm −3 . Para os LEDs DUV com as estruturas PNP-AlGaN propostas, o tipo p convencional Al 0,40 Ga 0,60 A camada N é substituída por p-Al 0,40 Ga 0,60 N / n-Al x Ga 1- x N / p-Al 0,40 Ga 0,60 Camada N. A Figura 1b apresenta o diagrama de estrutura esquemática para a camada PNP-AlGaN. A Figura 1c mostra o diagrama esquemático da banda de valência para a estrutura PNP-AlGaN, de onde podemos ver a barreira para orifícios. A barreira é gerada devido ao esgotamento dos dopantes Si no n-Al fino x Ga 1- x Camada N [26]. Essa barreira é muito importante para determinar o caminho do fluxo da corrente e o desempenho do dispositivo para LEDs DUV. Uma análise detalhada será dada posteriormente.
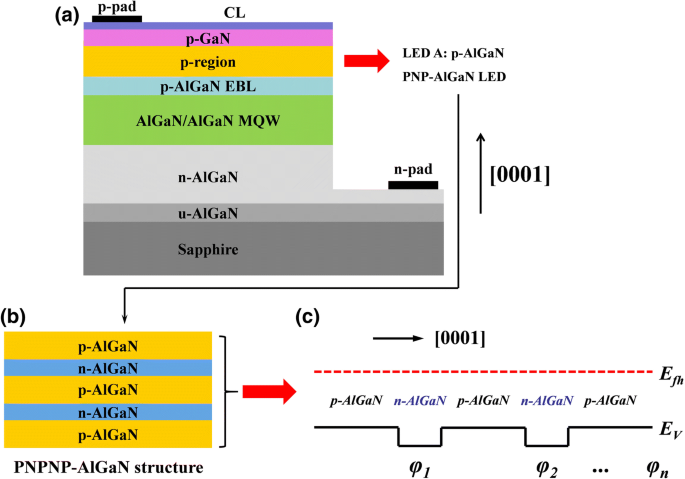
a Diagramas esquemáticos dos dispositivos estudados (LED de referência A e LED PNPNP-AlGaN), b diagramas esquemáticos para a estrutura PNP-AlGaN com duas junções PNP-AlGaN, c diagrama esquemático da banda de valência para a estrutura PNP-AlGaN com múltiplas junções PNP-AlGaN, em que φ 1 , φ 2 e φ n denotam a altura da barreira para cada junção PNP-AlGaN ao longo da orientação [0001] e n representa o número da junção PNP-AlGaN
Para ilustrar ainda mais o mecanismo da estrutura PNP-AlGaN em espalhar a corrente, mostramos o circuito equivalente simplificado e os caminhos de fluxo de corrente para o LED DUV crescido em substratos de safira na Fig. 2a. A corrente flui verticalmente e lateralmente da região p-AlGaN para a região n-AlGaN. Normalmente, a espessura da camada de espalhamento atual (CL) (ou seja, 200 nm para nossos dispositivos) é muito menor do que a da camada n-AlGaN (ou seja, 4 μm para nossos dispositivos). Portanto, a resistência elétrica para o CL é muito maior do que para a camada de injeção de elétrons n-AlGaN. Então, a corrente tende a se aglomerar sob o eletrodo p, ou seja, J 1 > J 2 > J 3 > J 4 > .....> J n , que é conhecido como o efeito de aglomeração atual [27]. Felizmente, o efeito de aglomeração de corrente pode ser suprimido incorporando a junção PNP-AlGaN na camada de injeção do orifício tipo p, e o mecanismo subjacente pode ser interpretado usando a Fig. 2b, de modo que dividamos a corrente total em uma parte vertical ( J 1 ) e uma parte horizontal ( J 2 ) De acordo com a Ref. [27], a relação entre J 1 e J 2 pode ser vinculado pela Eq. (1) como segue,
$$ \ frac {J_1} {J_2} \ cong \ frac {l} {\ frac {\ rho_p} {\ rho _ {\ mathrm {CL}}} {t} _p + \ frac {N \ cdot {\ rho} _ {\ mathrm {PNP}}} {\ rho _ {\ mathrm {CL}}}}, $$ (1)
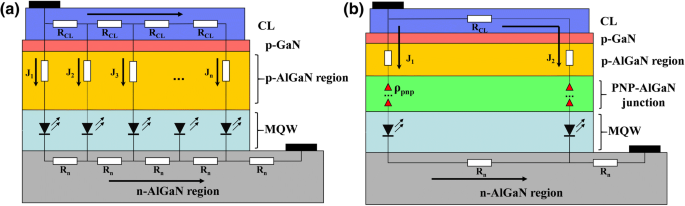
a Circuito equivalente de LEDs DUV com esquema de injeção de corrente lateral ( J 1 > J 2 > J 3 > J 4 > ……> J n ) e b circuito equivalente simplificado do LED com estrutura PNP-AlGaN, os caminhos atuais ( J 1 e J 2 ) também são mostrados
onde l é o comprimento do caminho horizontal atual, t p é a espessura, ρ p representa a resistividade vertical para a camada de injeção de furo tipo p, ρ CL denota a resistividade da camada de espalhamento de corrente depositada ex situ, ρ PNP significa a resistividade interfacial específica induzida em cada junção PNP-AlGaN, e N representa o número da junção PNP-AlGaN. Com base na Eq. (1), inferimos que podemos aumentar J 2 reduzindo ρ CL . A equação (1) também indica que o aumento adequado da resistência vertical (ou seja, ρ p × t p ) também ajuda a aprimorar J 2 . Alternativamente, a resistência vertical pode se tornar maior incluindo o N · ρ PNP . No entanto, o valor de N · ρ PNP pode ser afetado pelo número de junção PNP-AlGaN. Além disso, o valor de ρ PNP está sujeito à concentração de dopagem, a espessura e a composição de AlN do n-Al x Ga 1- x Camada N. Assim, os detalhes sobre as diferentes junções PNP-AlGaN serão discutidos posteriormente.
As investigações na física do dispositivo são conduzidas usando APSYS [28]. A relação de deslocamento da banda de energia entre o deslocamento da banda de condução e o deslocamento da banda de valência para a heterojunção AlGaN / AlGaN é definida como 50:50 [29]. O nível de polarização é definido como 40% para o cálculo das cargas induzidas por polarização nas interfaces mal combinadas de rede [30, 31]. O coeficiente de recombinação Auger e o tempo de vida de recombinação Shockley-Read-Hall (SRH) são definidos como 1,0 × 10 −30 cm 6 / s [27] e 10 ns [32], respectivamente. A eficiência de extração de luz é definida em ~ 8% para LEDs DUV [33]. Outros parâmetros em semicondutores III-V contendo nitrogênio podem ser encontrados em outro lugar [34].
Resultados e discussões
Prova da eficácia da junção PNP-AlGaN na propagação da corrente para LEDs DUV
Para mostrar a eficácia da estrutura PNP-AlGaN em espalhar a corrente para o LED DUV, o LED DUV de referência (ou seja, LED A) sem estrutura PNP-AlGaN e o LED DUV com a estrutura PNP-AlGaN (ou seja, LED B) são estudou. Observe que as informações arquitetônicas para os LEDs DUV foram fornecidas na seção de Métodos de Pesquisa e Modelos de Física, exceto a configuração PNP-AlGaN para LED B. LED B tem dois loops PNP-AlGaN, ou seja, estrutura PNPNP-AlGaN. Cada junção PNP-AlGaN compreende o p-Al 0,40 Ga 0,60 N / n-Al 0,40 Ga 0,60 N / p-Al 0,40 Ga 0,60 Estrutura N, para a qual a concentração de dopagem de Si no n-Al de 20 nm de espessura 0,40 Ga 0,60 A camada de inserção N é 5,3 × 10 17 cm −3 . Calculamos e mostramos o diagrama da banda de energia para o LED B na densidade de corrente de 170 A / cm 2 na Fig. 3a. Podemos ver que, quando comparados ao LED A (a banda de energia não é mostrada aqui), os furos encontrarão duas barreiras antes de serem injetados nos MQWs. As barreiras na banda de valência aqui podem efetivamente espalhar a corrente e homogeneizar melhor os furos lateralmente. Para abordar ainda mais nosso ponto e para o propósito da demonstração, mostramos o perfil de concentração do orifício lateral no poço quântico mais próximo do p-EBL [isto é, o último poço quântico (LQW)] na Fig. 3b, que descobre que o a distribuição de orifícios no LED B mostra, de fato, um perfil mais uniforme no LQW. As observações na Fig. 2b concordam bem com os diagramas de banda de energia na Fig. 3a e nossa análise anterior, de modo que a estrutura PNP-AlGaN se mostra útil na melhoria do efeito de espalhamento atual.
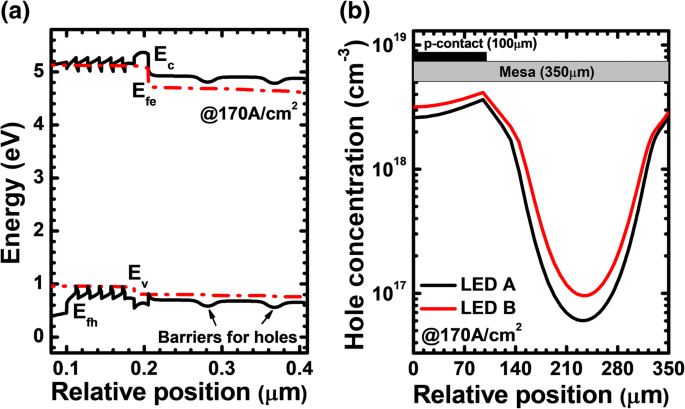
a Diagrama de banda de energia para LED B na densidade de corrente de 170 A / cm 2 . E c , E v , E fe , e E fh denotam a banda de condução, a banda de valência e os níveis de quase-Fermi para elétrons e lacunas, respectivamente, b distribuição lateral do buraco no último poço quântico para LEDs A e B na densidade de corrente de 170 A / cm 2 , respectivamente
A seguir, mostramos os perfis para a concentração do buraco e a taxa de recombinação radiativa na região MQW para os LEDs A e B na Fig. 4a, b, respectivamente. Observe que para monitorar o efeito de espalhamento da corrente, os dados na Fig. 4a, b são coletados na posição de 230 μm além da borda esquerda da mesa. Verificou-se que o espalhamento de corrente aprimorado para LED B também permite a injeção de orifício promovida nos MQWs. A melhoria da concentração do orifício nos MQWs gera a taxa de recombinação radiativa aprimorada para o LED B de acordo com a Fig. 4b.

a Perfis de concentração de furo e b taxa de recombinação radiativa na região MQW para LEDs A e B na densidade de corrente de 170 A / cm 2 , respectivamente
A Figura 5a então demonstra o EQE e a densidade de potência óptica em termos do nível de densidade de corrente de injeção para LEDs A e B. Os níveis de EQE para LEDs A e B são 3,38% e 4,13%, respectivamente, mostrando uma melhoria de desempenho de 22,2% em a densidade de corrente de 170 A / cm 2 . Essas melhorias observadas são atribuídas ao melhor efeito de espalhamento de corrente e à injeção de orifício aprimorada na região MQW para LED B. Como foi mencionado anteriormente, a adoção da estrutura PNP-AlGaN pode levar à barreira de energia na banda de valência, que pode influenciar a tensão direta. A especulação é comprovada quando se refere à Fig. 5b que demonstra a tensão direta ligeiramente aumentada para o LED B. Apesar da tensão direta mais alta para o LED B, a eficiência do plugue de parede para o LED é ainda maior do que para o LED A de acordo com a Fig. 5c , de forma que os números sejam 3,56% e 4,27% para os LEDs A e B no nível de densidade de corrente de 170 A / cm 2 , respectivamente. Se compararmos ainda as Fig. 5a, c, podemos descobrir que o WPE tem uma queda mais pronunciada para o LED B, e isso é atribuído à queda de tensão adicional na junção PNP-AlGaN. Portanto, é essencialmente importante conduzir um estudo mais abrangente revelando a sensibilidade do EQE, da tensão direta e do WPE para diferentes projetos PNP-AlGaN.
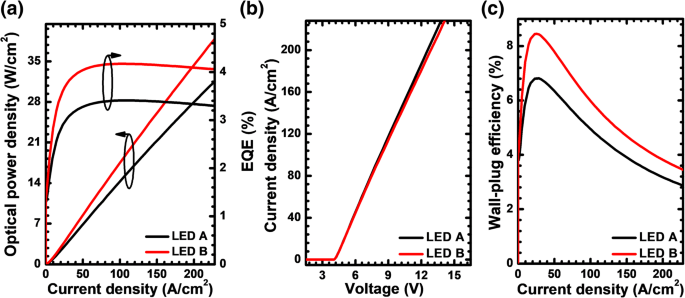
a Densidade de potência de saída óptica e EQE em função da corrente de injeção, b característica corrente-tensão, c WPE em termos de corrente de injeção para LEDs A e B, respectivamente
Impacto da espessura da camada n-AlGaN no desempenho do dispositivo
De acordo com a Eq. (1), podemos concluir que um fluxo de corrente horizontal aumentado pode ser obtido aumentando o valor de N · ρ PNP . A altura da barreira na junção PNP-AlGaN aumenta quando o n-Al 0,40 Ga 0,60 A camada N torna-se espessa de modo que um ρ maior PNP pode ser obtido, o que é benéfico para o efeito de espalhamento de corrente aprimorado. No entanto, uma vez que o n-Al 0,40 Ga 0,60 A camada N é muito espessa, mais buracos no p-Al 0,40 Ga 0,60 A camada N pode estar esgotada, o que pode sacrificar a condutividade elétrica. Portanto, para ilustrar melhor a relação entre a espessura de n-Al 0,40 Ga 0,60 Camada N e desempenho para LEDs DUV, é necessário investigar o impacto do n-Al 0,40 Ga 0,60 Espessura da camada N para a junção PNP-AlGaN no espalhamento de corrente, a injeção do orifício, o EQE, a tensão direta e o WPE. Para isso, variamos os valores de n-Al 0,40 Ga 0,60 Espessura da camada N entre 6, 13, 20, 27 e 34 nm, e os dispositivos são chamados de LEDs T1, T2, T3, T4 e T5, respectivamente. A Tabela 1 resume a altura da barreira da banda de valência para cada junção PNP-AlGaN, que mostra que a altura da barreira aumenta conforme o n-Al 0,40 Ga 0,60 A espessura da camada N aumenta, provando que o aumento do n-Al 0,40 Ga 0,60 A espessura da camada N permite o grande N · ρ PNP , aumentando assim a corrente horizontal J 2 . A Figura 6a mostra os perfis de concentração do orifício lateral no último poço quântico para o LED A sem a camada de espalhamento de corrente estruturada PNP-AlGaN e os LEDs com vários n-Al 0,40 Ga 0,60 Espessuras da camada N na densidade atual de 170 A / cm 2 . Pode ser visto aparentemente que os buracos se tornam mais uniformemente distribuídos no último quantum, bem como a espessura do n-Al 0,40 Ga 0,60 A camada de inserção N aumenta.
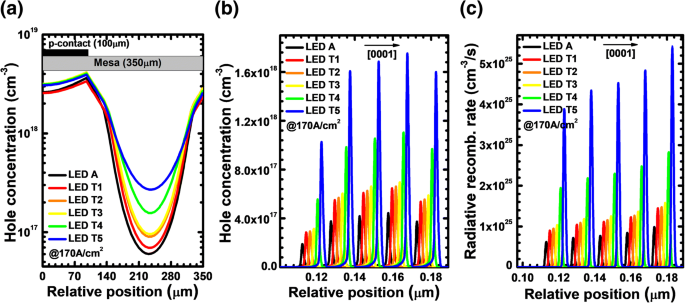
a Distribuição lateral do buraco no último poço quântico, b perfis de concentração de furo e c perfis de taxa de recombinação radiativa na região MQW para LEDs A, T1, T2, T3, T4 e T5 na densidade de corrente de 170 A / cm 2 . As curvas traçadas para os painéis b e c são deslocados propositalmente em 2 nm para melhor resolução
Em seguida, mostramos os perfis de concentração de buraco e perfis de taxa de recombinação radiativa na região MQW para todos os dispositivos estudados na densidade de corrente de 170 A / cm 2 na Fig. 6b, c, respectivamente. Os perfis de concentração de furo e taxa radiativa são coletados na posição de 230 μm além da borda esquerda da mesa. Para a melhor resolução visual, os perfis de concentração de buraco e taxa de recombinação radiativa para LEDs A, T1, T2, T3, T4 e T5 são espacialmente deslocados em 2 nm na Fig. 6b, c, respectivamente. É claramente mostrado que o LED A tem a concentração de orifício mais baixa e, portanto, a taxa de recombinação radiativa mais baixa na região MQW. A concentração do buraco e a taxa de recombinação radiativa na região MQW aumentam com o aumento da espessura do n-Al 0,40 Ga 0,60 Camada N.
Os resultados observados mostrados na Fig. 6c concordam bem com o EQE e a densidade de potência óptica que são apresentados na Fig. 7a, de modo que o aumento da espessura do n-Al 0,40 Ga 0,60 A camada N na junção PNP-AlGaN pode melhorar o EQE e a densidade de potência óptica. No entanto, a altura da barreira da banda de valência para orifícios em cada junção PNP-AlGaN torna-se grande uma vez que o n-Al 0,40 Ga 0,60 A camada N é espessada de acordo com a Tabela 1, o que aumenta correspondentemente a tensão direta para os LEDs DUV propostos, conforme mostrado na Fig. 7b. Portanto, o impacto do n-Al 0,40 Ga 0,60 A espessura da camada N para a propagação da corrente PNP-AlGaN no desempenho do LED deve ser avaliada demonstrando a relação entre o WPE e a densidade da corrente de injeção (ver Fig. 8). Podemos ver que o WPE não aumenta monotonicamente com o aumento de n-Al 0,40 Ga 0,60 Espessura da camada N. O EQE e o WPE em termos de n-Al 0,40 Ga 0,60 A espessura da camada N está ilustrada no detalhe da Fig. 8. Para as arquiteturas de dispositivo propostas neste trabalho, o WPE atinge o valor mais alto quando o n-Al 0,40 Ga 0,60 A camada de inserção N tem 20 nm de espessura e diminui conforme o n-Al 0,40 Ga 0,60 A camada de inserção N torna-se mais espessa. Atribuímos esse fenômeno ao aumento da resistência vertical quando o n-Al 0,40 Ga 0,60 A espessura da camada N está ficando mais espessa, e isso consome mais energia elétrica. Portanto, a espessura da camada de inserção n-AlGaN para a junção PNP-AlGaN deve ser cuidadosamente otimizada. Nesta seção, definimos a composição de AlN de 40%, ou seja, n-Al 0,40 Ga 0,60 N para fins de demonstração, e acreditamos que a espessura otimizada para a camada de inserção de n-AlGaN se tornará menor se aumentarmos a composição de AlN.
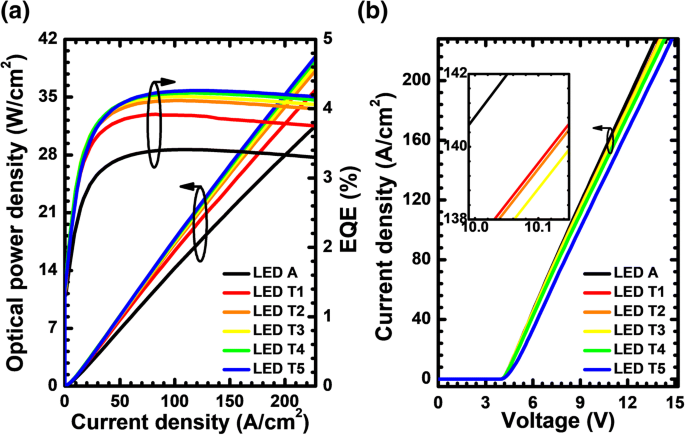
a Densidade de potência de saída óptica, b características de corrente-tensão para LEDs A, T1, T2, T3, T4 e T5. A figura inserida mostra as curvas de corrente-tensão ampliadas
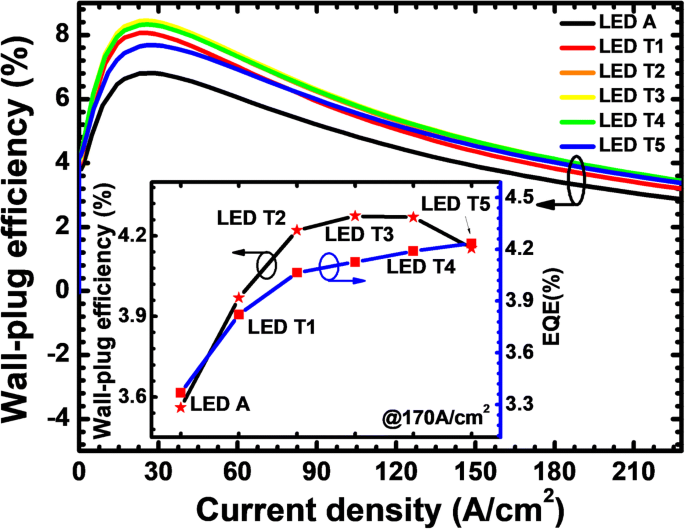
WPE em função da corrente de injeção para os LEDs A, T1, T2, T3, T4 e T5. A figura inserida mostra o WPE e EQE para os LEDs estudados com várias espessuras de n-Al 0,40 Ga 0,60 Camada N para a junção PNP-AlGaN na densidade de corrente de 170 A / cm 2
Impacto da concentração de dopagem da camada n-AlGaN no desempenho do dispositivo
Além da espessura da camada n-AlGaN, a concentração de dopagem para a camada n-AlGaN também pode modificar a altura da barreira da banda de valência para os orifícios, afetando assim N · ρ PNP . Para estudar com mais precisão o impacto da concentração de dopagem para a camada n-AlGaN no efeito de espalhamento atual e o desempenho óptico para LEDs DUV com as junções PNP-AlGaN, definimos a concentração de dopagem de 1,3 × 10 17 , 5,3 × 10 17 , 9,3 × 10 17 , 1,33 × 10 18 e 1,73 × 10 18 cm −3 das camadas n-AlGaN para LEDs D1, D2, D3, D4 e D5, respectivamente. A espessura da camada n-AlGaN é definida como 20 nm e duas junções PNP-AlGaN são adotadas. A composição de AlN é de 40%, ou seja, n-Al 0,40 Ga 0,60 N.
A Tabela 2 mostra que a altura da barreira da banda de valência para orifícios aumenta quando a concentração de dopagem de Si para o n-Al 0,40 Ga 0,60 A camada N da junção PNP-AlGaN torna-se alta. O aumento da altura da barreira da banda de valência indica o grande N · ρ PNP , que simultaneamente produz a alta corrente horizontal de J 2 . De acordo com a Eq. (1), o espalhamento de corrente aumentado é acompanhado por um perfil de concentração de orifício lateral mais uniforme e, portanto, mostramos, na Fig. 9a, que a distribuição de orifício lateral no último poço quântico torna-se mais homogeneizada uma vez que o PNP-AlGaN junção é dopada para LEDs DUV em comparação com LED A. Além disso, os orifícios laterais tornam-se mais uniformemente distribuídos uma vez que a concentração de dopagem de Si para o n-Al 0,40 Ga 0,60 A camada N da junção PNP-AlGaN aumenta.
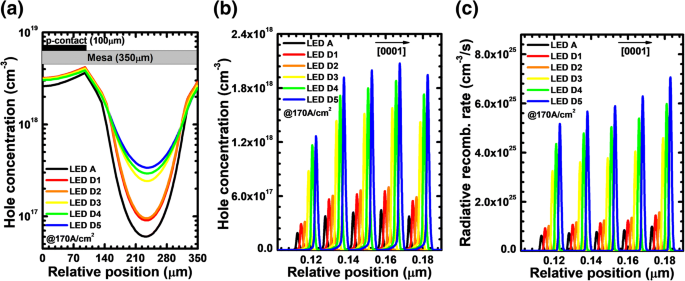
a Distribuição lateral do buraco no último poço quântico, b perfis de concentração de furos e c perfis de taxa de recombinação radiativa na região MQW ou LEDs A, D1, D2, D3, D4 e D5 na densidade de corrente de 170 A / cm 2 . As curvas traçadas para os painéis b e c são deslocados propositalmente em 2 nm para melhor resolução
Em seguida, mostramos os perfis de concentração de buraco e perfis de taxa de recombinação radiativa na região MQW para todos os dispositivos estudados na densidade de corrente de 170 A / cm 2 na Fig. 9b, c, respectivamente, que são coletados na posição de 230 μm além da borda esquerda da mesa. É claramente mostrado que o LED A tem a concentração de orifício mais baixa e a taxa de recombinação radiativa mais pobre na região MQW. A concentração do buraco e a taxa de recombinação radiativa na região MQW aumentam com o aumento das concentrações de dopagem do n-Al 0,40 Ga 0,60 N camadas para os LEDs com junções PNP-AlGaN. O nível de concentração de orifício aprimorado no MQW para LEDs D1, D2, D2, D3, D4 e D5 é atribuído ao melhor efeito de espalhamento de corrente, graças à junção PNP-AlGaN.
Em seguida, calculamos e apresentamos o EQE e a densidade de potência óptica em termos da densidade de corrente de injeção para os dispositivos investigados na Fig. 10a. O EQE observado é consistente com os resultados na Fig. 9b, c, de modo que o EQE pode ser melhorado uma vez que a junção PNP-AlGaN é empregada. Mais do que isso, como a concentração de dopagem de Si no n-Al 0,40 Ga 0,60 A camada N para a junção PNP-AlGaN aumenta, o EQE pode ser ainda mais promovido, graças ao melhor espalhamento da corrente. A Figura 10b compara a tensão operacional direta para os dispositivos investigados. É mostrado que a tensão de operação direta aumenta com o aumento da concentração de dopagem no n-Al 0,40 Ga 0,60 Camada N. Observe que, como as concentrações de doping de Si são 1,33 × 10 18 e 1,73 × 10 18 cm −3 , a tensão de ativação mostra um aumento significativo, o que indica que a junção interna PNP-AlGaN se comporta como um diodo parasita quando o doping de Si no n-Al 0,40 Ga 0,60 A camada N aumenta para um nível muito alto. Para avaliar com mais precisão o desempenho dos LEDs DUV com diferentes junções PNP-AlGaN, a Fig. 11 exibe WPE como uma função da densidade de corrente de injeção para LED A, D1, D2, D3, D4 e D5. Claramente, podemos ver que o WPE é o mais baixo para o LED D5, devido ao maior consumo de tensão direta. A inserção da Fig. 11 também indica que o WPE é mais sensível à concentração de dopagem de Si do n-Al 0,40 Ga 0,60 Camada N do que o EQE. Vale a pena concluir que a alta concentração de dopagem de Si do n-Al 0,40 Ga 0,60 A camada N pode de fato melhorar a camada de espalhamento atual e aumentar a taxa de geração de fótons. No entanto, a queda de tensão direta adicional nas junções PNP-AlGaN consome mais energia elétrica, limitando assim o WPE. As descobertas nesta seção também ilustram que a concentração de dopagem de Si no n-Al x Ga 1- x A camada N deve ser adequadamente reduzida se aumentar a composição de AlN e / ou a espessura do n-Al x Ga 1- x Camada N para a junção PNP-AlGaN, uma vez que, ao fazê-lo, pode-se obter tanto o EQE melhorado quanto o WPE decente.
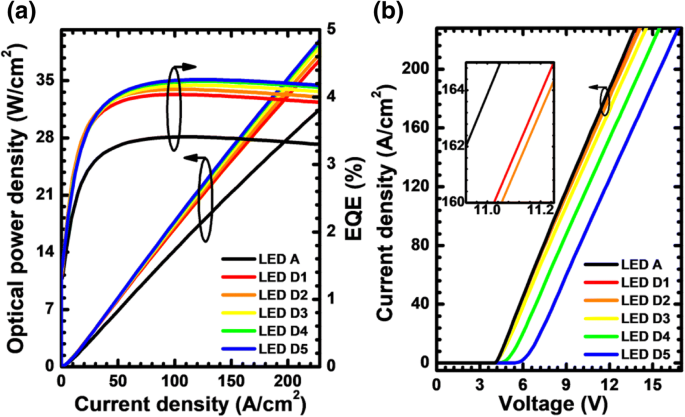
a Densidade de potência de saída óptica e EQE em função da corrente de injeção, b características de tensão de corrente para LEDs A, D1, D2, D3, D4 e D5. A figura inserida mostra as curvas de corrente-tensão ampliadas
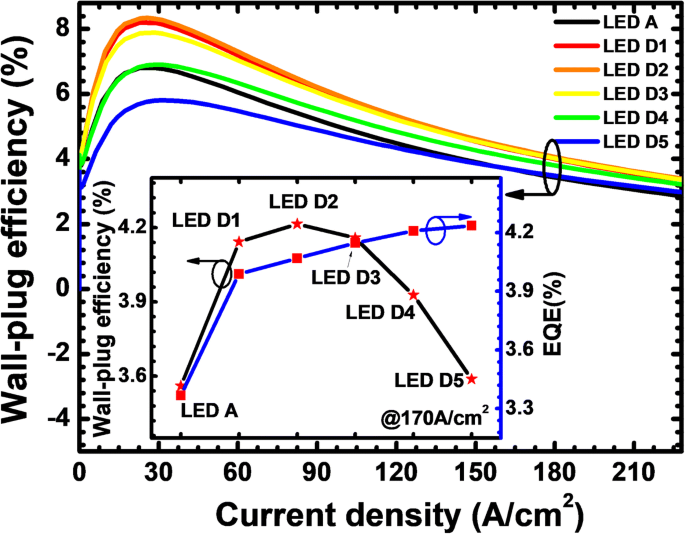
WPE em função da corrente de injeção para os LEDs A, D1, D2, D3, D4 e D5. A figura inserida mostra o WPE e EQE para os LEDs estudados com várias concentrações de dopagem do n-Al 0,40 Ga 0,60 Camada N na densidade atual de 170 A / cm 2
Impacto do número de junção PNP-AlGaN no desempenho do dispositivo
Nesta seção, o impacto do número da junção PNP-AlGaN no desempenho elétrico e óptico dos LEDs DUV é estudado. Para fins de demonstração, fixamos a concentração de dopagem e a espessura da camada n-AlGaN em 5,3 × 10 17 cm −3 e 20 nm, respectivamente. A composição de AlN é selecionada para 0,40, como n-Al 0,40 Ga 0,60 N. Adotamos loops diferentes para a junção PNP-AlGaN, ou seja, os números do loop são definidos como 1, 2, 3 e 4 para os LEDs N1, N2, N3 e N4, respectivamente. Em primeiro lugar, calculamos e apresentamos a altura da barreira da banda de valência para cada junção PNP-AlGaN na Tabela 3. Pode-se ler obviamente que o aumento do número da junção PNP-AlGaN torna o N · ρ geral PNP Alto. Em seguida, calculamos e demonstramos a distribuição lateral para os orifícios no último poço quântico para LEDs A, N1, N2, N3 e N4 na densidade de corrente de 170 A / cm 2 (ver Fig. 12a). Isso mostra que a distribuição de orifícios no último poço quântico se torna mais uniforme à medida que mais junções PNP-AlGaN são incorporadas. Os resultados na Fig. 12a suportam ainda mais as previsões feitas pela Eq. (1).
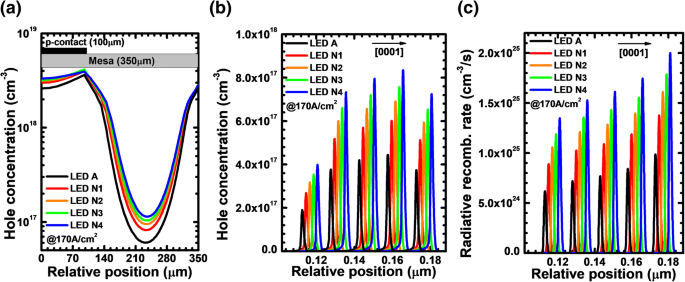
a Distribuição lateral do buraco no último poço quântico, b perfis de concentração de furos e c perfis de taxa de recombinação radiativa na região MQW para LEDs A, N1, N2, N3 e N4 na densidade de corrente de 170 A / cm 2 . As curvas traçadas para os painéis b e c são deslocados propositalmente em 2 nm para melhor resolução
Em seguida, mostramos os perfis de concentração de buraco e taxa de recombinação radiativa na região MQW para LEDs A, N1, N2, N3 e N4 na densidade de corrente de 170 A / cm 2 na Fig. 12b, c, respectivamente. Os perfis de buraco e taxa de recombinação radiativa são sondados na posição de 230 μm além da borda esquerda da mesa. É indicado que a concentração do orifício e a taxa de recombinação radiativa aumentam se o número da junção PNP-AlGaN for maior. Vale a pena mencionar aqui que não aumentamos o valor de N além de 4, desde quando o N é aumentado ainda mais, a espessura do p-Al restante 0,40 Ga 0,60 A camada N torna-se tão fina que os orifícios podem ser esgotados pelos dopantes de Si ionizados e o fornecimento do orifício pode ser insuficiente.
Graças ao efeito de espalhamento de corrente aprimorado, a concentração de orifício aprimorada na região MQW, os LEDs N1, N2, N3 e N4, consequentemente, promovem o EQE e a densidade de potência óptica em comparação com o LED A (ver Fig. 13a). A Figura 13b demonstra que a tensão operacional direta para os LEDs DUV sugeridos também aumenta se mais junções PNP-AlGaN forem incorporadas. Felizmente, o aumento da tensão direta para LEDs N1, N2, N3 e N4 não reduz o WPE de acordo com a Fig. 14. Investigações adicionais na inserção da Fig. 14 podem ilustrar que tanto o EQE quanto o WPE tendem a se aproximar de um nível de saturação conforme o número da junção PNP-AlGaN aumenta. Portanto, acreditamos que, como também foi apontado anteriormente, um aumento adicional do número para a junção PNP-AlGaN pode esgotar os furos e, de forma correspondente, degradar a capacidade de fornecimento do furo, portanto, contribuindo pouco para aumentar o EQE e o WPE para o arquiteturas de dispositivos propostas neste trabalho.
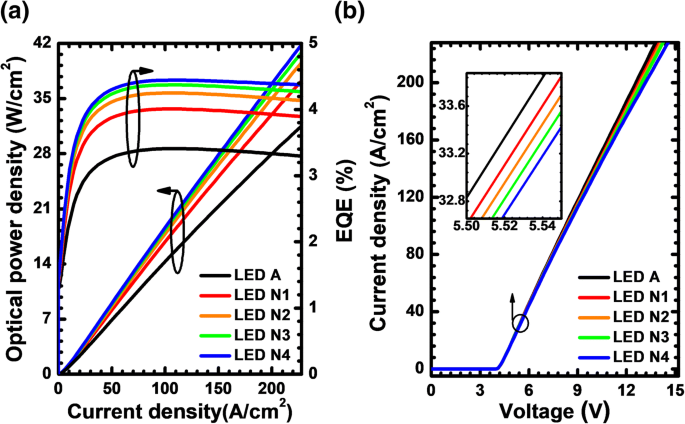
a Densidade de potência de saída óptica e EQE em função da corrente de injeção, b característica corrente-tensão para LEDs A, N1, N2, N3 e N4. A figura inserida mostra as curvas de corrente-tensão ampliadas
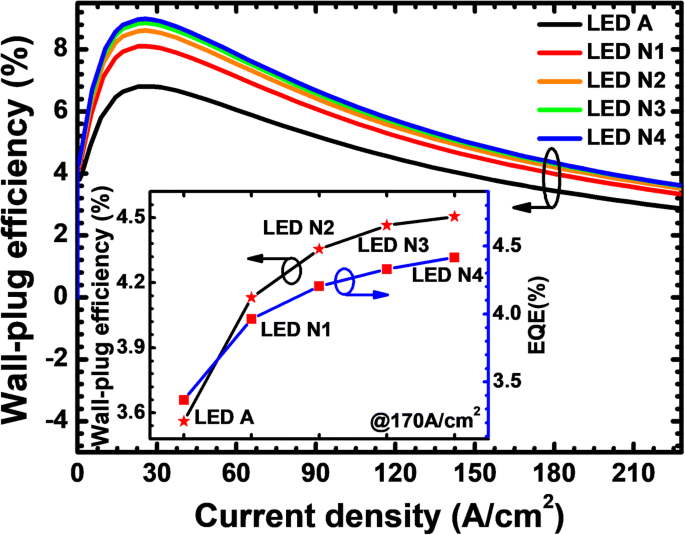
WPE em função da corrente de injeção para os LEDs A, N1, N2, N3 e N4. A figura inserida mostra o WPE e EQE para LEDs com vários números de junção PNP-AlGaN na densidade de corrente de 170 A / cm 2
Impacto da composição AlN para camada n-AlGaN no desempenho do dispositivo
Por último, modificamos o ρ PNP variando a composição de AlN da camada n-AlGaN para a junção PNP-AlGaN. Os valores para a composição de AlN da camada n-AlGaN são definidos como 0,40, 0,43, 0,46, 0,49 e 0,51 para LEDs C1, C2, C3, C4 e C5, respectivamente. A espessura e a concentração de dopagem de Si da camada n-AlGaN são definidas em 20 nm e 5,3 × 10 17 cm −3 , respectivamente. Adotamos duas junções PNP-AlGaN para LEDs C1, C2, C3, C4 e C5. A composição de AlN para as camadas restantes de p-AlGaN é fixada em 0,40. A Tabela 4 demonstra a altura da barreira da banda de valência para a junção PNP-AlGaN com diferentes composições de AlN na camada de inserção n-AlGaN. É facilmente compreensível que o aumento da composição de AlN na camada n-AlGaN dá origem a uma maior altura de barreira de banda de valência para orifícios. A Figura 15a exibe as distribuições laterais para orifícios no último poço quântico para LEDs A, C1, C2, C3, C4 e C5 na densidade de corrente de 170 A / cm 2 . O efeito de espalhamento atual é significativamente melhorado conforme a composição de AlN da camada n-AlGaN aumentou até 0,43. Parece que os buracos não podem ser mais bem espalhados quando a composição de AlN da camada n-AlGaN excede 0,43 para nossas estruturas, porque uma composição muito alta de AlN no n-AlGaN pode bloquear a injeção do buraco.

a Distribuição lateral do buraco no último poço quântico, b perfis de concentração de furos e c perfis de taxa de recombinação radiativa na região MQW para LEDs A, C1, C2, C3, C4 e C5 na densidade de corrente de 170 A / cm 2 . As curvas traçadas para os painéis b e c são deslocados propositalmente em 2 nm para melhor resolução
Os perfis de concentração de buraco e taxa de recombinação radiativa na região MQW para LEDs A, C1, C2, C3, C4 e C5 na densidade de corrente de 170 A / cm 2 são apresentados na Fig. 15b, c, respectivamente. Os dados também são coletados na posição de 230 μm além da borda esquerda da mesa. As conclusões aqui são semelhantes às da Fig. 6b, Fig. 9b e Fig. 12b, ou seja, a adoção da camada de espalhamento de corrente PNP-AlGaN aumenta a injeção do orifício e a concentração do orifício na região MQW torna-se ainda mais aprimorada uma vez a composição de AlN na camada n-AlGaN aumenta. Em seguida, calculamos e apresentamos o EQE e a densidade de potência óptica em termos da corrente de injeção para os dispositivos investigados na Fig. 16a. Claramente, podemos ver que o EQE pode ser melhorado uma vez que a junção PNP-AlGaN é empregada. Além disso, à medida que a composição de AlN na camada n-AlGaN para a junção PNP-AlGaN aumenta, o EQE pode ser promovido ainda mais, graças ao melhor espalhamento de corrente, que homogeneiza a concentração de orifícios em cada plano de poço quântico, como foi mostrado anteriormente .
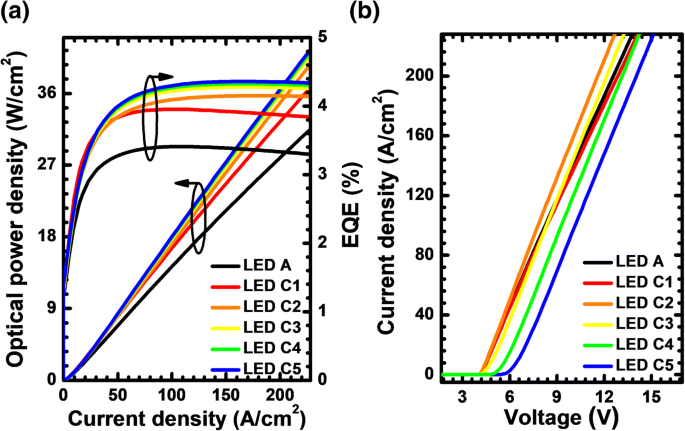
a Densidade de potência de saída óptica e EQE em função da corrente de injeção e b características de tensão de corrente para LEDs A, C1, C2, C3, C4 e C5
A Figura 16b investiga as características de corrente-tensão para LEDs A, C1, C2, C3, C4 e C5. O dispositivo exibe um ligeiro aumento na tensão de operação direta para LED C1 com o PNP-Al 0,40 Ga 0,60 Junção N quando comparada ao LED A. Enquanto isso, o dispositivo consome mais tensão direta para os LEDs C4 e C5. A observação aqui é consistente com aquela na Fig. 7b, Fig. 10b e Fig. 13b, de modo que a adoção da junção PNP-AlGaN faz com que a altura de barreira de banda de valência adicional para orifícios, o que, como resultado, aumenta a tensão direta e até mesmo a tensão de ativação (por exemplo, LEDs C4 e C5). No entanto, vale a pena mencionar que a tensão de operação direta para os LEDs C2 e C3 diminui quando comparada ao LED A. O mecanismo subjacente não está claro neste momento. No entanto, tentamos atribuir a redução da tensão direta para os LEDs C2 e C3 ao efeito de aceleração do furo [35].
A Figura 17 mostra a relação entre o WPE e a densidade de corrente de injeção para os LEDs testados. Podemos obter que o WPE pode ser aprimorado para todos os LEDs propostos, especialmente quando a densidade de corrente de injeção está além de 89 A / cm 2 . Um estudo perspicaz do LED C5 mostra que o WPE para o LED C5 é inferior ao do LED A quando a densidade de corrente é menor que 89 A / cm 2 . No entanto, o WPE para o LED C5 supera o do LED A quando a densidade da corrente de injeção torna-se maior (ou seja,> 89 A / cm 2 ) Como é bem conhecido, a corrente fica facilmente sobrecarregada quando o dispositivo LED é polarizado em um nível de corrente alto. O WPE para LED C5 reflete que o PNP-Al 0,51 Ga 0,49 A junção N é de fato eficaz em melhorar o efeito de espalhamento atual. No entanto, considerando o consumo de tensão adicional na junção PNP-AlGaN, deve-se ter muito cuidado ao definir a composição de AlN para a camada n-AlGaN de modo que o WPE possa ser maximizado de acordo com o inset na Fig. 17.
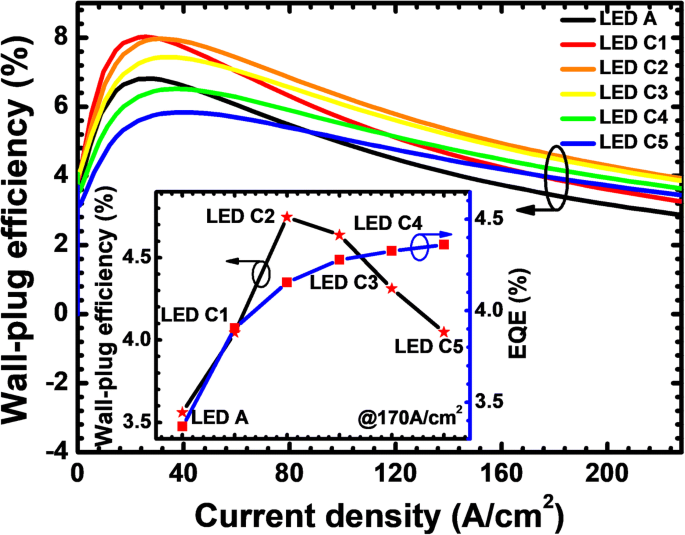
WPE em função da corrente de injeção para os LEDs A, C1, C2, C3, C4 e C5. A figura inserida mostra o WPE e o EQE para os LEDs estudados com várias composições de AlN para a camada n-AlGaN na densidade de corrente de 170 A / cm 2
Conclusões
Para resumir, a junção PNP-AlGaN para LEDs DUV é explorada e demonstrada. Auxiliado pelas junções PNP-AlGaN propostas, o efeito de espalhamento atual pode ser melhorado. O efeito de espalhamento de corrente aprimorado é bem atribuído ao aumento da resistência vertical e ao fluxo de corrente horizontal aprimorado. Além disso, também conduzimos o estudo paramétrico para revelar diferentes junções PNP no efeito de espalhamento atual, o EQE e o WPE. Descobrimos que ao aumentar adequadamente a espessura, a concentração de dopagem, a composição de AlN para a camada de inserção n-AlGaN e o número para a junção PNP-AlGaN, o efeito de espalhamento atual pode ser melhorado. Por outro lado, também descobrimos que o efeito de espalhamento atual pode de fato melhorar o EQE. No entanto, a tensão direta pode ser aumentada se a junção PNP-AlGaN não estiver totalmente otimizada, cujo custo é o WPE reduzido. Também é importante ressaltar que a característica de espalhamento atual é a função cooperativa da espessura, da concentração de dopagem, da composição de AlN para a camada de inserção n-AlGaN e do número para a junção PNP-AlGaN. Como resultado, não há uma resposta única para o melhor design da camada de difusão de corrente PNP-AlGaN para LEDs DUV. No entanto, acreditamos fortemente que as descobertas neste trabalho introduzem o entendimento físico adicional para a camada de espalhamento de corrente PNP-AlGaN e o efeito de espalhamento de corrente para LEDs DUV. Portanto, este trabalho é muito útil para a comunidade de dispositivos semicondutores ópticos.
Abreviações
- APSYS:
-
Modelos Físicos Avançados de Dispositivos Semicondutores
- CBL:
-
Camada de bloqueio atual
- CL:
-
Camada de espalhamento atual
- LEDs DUV:
-
Diodos emissores de luz ultravioleta profundos
- EQE:
-
Eficiência quântica externa
- IQE:
-
Eficiência quântica interna
- LQW:
-
Ultimo quantum bem
- MOCVD:
-
Deposição de vapor químico orgânico de metal
- MQWs:
-
Múltiplos poços quânticos
- PNP-AlGaN:
-
p-AlGaN / n-AlGaN / p-AlGaN
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Eficiência de tomada de parede
Nanomateriais
- Argumentando sobre chips neuromórficos para computação IA
- Cientistas da IBM inventam um termômetro para nanoescala
- O Projeto da Camada de Emissão para Multiplicadores de Elétrons
- Síntese verde de pontos quânticos InP / ZnS Core / Shell para aplicação em diodos emissores de luz livres de metais pesados
- O precursor de titânio ideal para a fabricação de camada compacta de TiO2 para células solares de perovskita
- Diodos emissores de luz ultravioleta baseados em AlGaN quase isentos de eficiência com uma camada de bloqueio de elétrons tipo p de superrede especificamente projetada para alta eficiência de dopag…
- Diodos emissores de luz perovskita de alta luminância com solvente de álcool de alta polaridade tratando PEDOT:PSS como camada de transporte de orifício
- Influência da largura do poço quântico nas propriedades de eletroluminescência de diodos emissores de luz ultravioleta profunda de AlGaN em diferentes temperaturas
- Integração de Perovskitas ecologicamente corretas para diodos emissores de luz branca de alta eficiência
- Quais são as aplicações mais comuns para corrente CA?



