Investigação da banda de energia em ZnO / β-Ga2O3 depositado na camada atômica (\ (\ overline {2} 01 \)) Heterojunções
Resumo
O alinhamento da banda de energia de ZnO / β-Ga 2 O 3 (\ (\ overline {2} 01 \)) heterojunção foi caracterizada por espectroscopia de fotoelétrons de raios-X (XPS). Os filmes de ZnO foram cultivados usando deposição de camada atômica em várias temperaturas. Um alinhamento de banda tipo I foi identificado para todos os ZnO / β-Ga 2 O 3 heterojunções. O deslocamento da banda de condução (valência) variou de 1,26 (0,20) eV a 1,47 (0,01) eV com a temperatura de crescimento aumentando de 150 a 250 ° C. O aumento do deslocamento da banda de condução com a temperatura é principalmente contribuído por intersticiais Zn no filme ZnO. Enquanto isso, o defeito complexo do tipo aceitador V zn + OH poderia ser responsável pelo deslocamento reduzido da banda de valência. Estas descobertas irão facilitar o design e a análise física de ZnO / β-Ga 2 O 3 dispositivos eletrônicos relevantes.
Introdução
Óxido de gálio (Ga 2 O 3 ) foi amplamente investigado como um material semicondutor de bandgap ultra amplo promissor para dispositivos eletrônicos de energia de próxima geração devido às suas propriedades únicas [1]. Entre vários polimorfos (α, β, γ, δ e ε), β-Ga monoclínico 2 O 3 tem a maior estabilidade térmica [2]. Além disso, β-Ga 2 O 3 tem um bandgap à temperatura ambiente de 4,5 ~ 4,9 eV e excelente estabilidade química [3]. Especialmente, β-Ga 2 O 3 tem uma grande mobilidade de elétrons de ∼100 cm 2 / V · s, campo de decomposição muito maior de 8 MV / cm do que o de SiC (3,18 MV / cm) ou GaN (3 MV / cm) [4], e a concentração de portadores pode ser facilmente modulada por dopagem de Sn e Si [ 5, 6]. Portanto, β-Ga 2 O 3 dispositivos baseados em energia, incluindo fotodetectores cegos à luz solar [7] e transistores de efeito de campo semicondutores de óxido metálico (MOSFETs) [8], foram relatados. No entanto, ainda existem limitações em β-Ga 2 O 3 dispositivos baseados em, como o contato ôhmico precário entre o metal e β-Ga 2 O 3 [9]. No ano recente, a inserção de uma camada intermediária de metal-óxido-semicondutor de alta concentração de elétrons, ou seja, camada semicondutora intermediária (ISL) entre o metal e Ga 2 O 3 , tem se mostrado uma resolução eficaz devido à modulação da barreira de energia na interface [10,11,12].
O óxido de zinco (ZnO) atraiu muita atenção porque tem uma grande energia de ligação de excitons de 60 meV, uma alta concentração de elétrons de> 10 19 cm −3 , e uma forte energia coesiva de 1,89 eV. [13, 14] Além disso, a incompatibilidade de rede entre ZnO e Ga 2 O 3 está dentro de 5% [15]. Várias técnicas de deposição foram desenvolvidas para preparar o filme de ZnO, incluindo método hidrotérmico [16, 17] e deposição química de vapor (CVD). [18] No entanto, o método hidrotérmico precisa de um processo complicado e a taxa de crescimento é muito lenta, e o CVD geralmente requer alta temperatura de crescimento silenciosa acima de 900 ° C. Essas desvantagens tornam sua aplicação em dispositivos um desafio. Recentemente, a deposição de camada atômica (ALD) surgiu como uma técnica promissora, que exibe excelente cobertura de etapas, capacidade de controle da espessura da escala atômica, boa uniformidade e uma temperatura de deposição relativamente baixa. Conseqüentemente, o ZnO depositado na camada atômica em semicondutores de largura de banda larga pode reduzir a desordem da interface e produzir uma amostra mais controlável para examinar o alinhamento da banda de energia, que desempenha um papel importante no processo de transporte de portadora [19]. Até agora, o alinhamento da banda entre Ga 2 O 3 e o ZnO depositado na camada atômica não foi estudado por experimentos, embora existam alguns relatórios sobre o alinhamento teórico das bandas de ZnO e Ga 2 O 3 . [20] Portanto, compreender o alinhamento da banda de energia de ZnO / β-Ga depositado na camada atômica 2 O 3 a heterojunção é altamente desejável para o projeto e análise física de dispositivos relevantes no futuro. Neste trabalho, o alinhamento da banda de energia do ZnO depositado na camada atômica em β-Ga 2 O 3 foi caracterizado por espectroscopia de fotoelétrons de raios-X (XPS). Além disso, a influência da temperatura de crescimento do ZnO no alinhamento das bandas também foi abordada.
Métodos
β-Ga 2 O 3 (\ (\ overline {2} 01 \)) substratos com uma concentração de dopagem Sn de ~ 3 × 10 18 / cm 3 foram cortados em pedaços pequenos com o tamanho de 6 × 6 mm 2 . As amostras cortadas foram limpas alternadamente em acetona, isopropanol por ultra-som a cada 10 min, posteriormente enxaguadas com água deionizada para remoção de solventes orgânicos residuais. Depois disso, Ga 2 O 3 substratos foram transferidos para um reator ALD (Wuxi MNT Micro Nanotech co., LTD, China). A taxa de crescimento dos filmes de ZnO foi de ~ 1,6 Å / ciclo. Ambos os filmes de ZnO de 40 e 5 nm foram cultivados em β-Ga 2 limpo O 3 usando Zn (C 2 H 5 ) 2 (DEZ) e H 2 O em cada temperatura de 150, 200 e 250 ° C, respectivamente. A espessura dos filmes de ZnO preparados foi medida por elipsômetro (Sopra GES-5E). O ZnO (40 nm) / β-Ga 2 O 3 foi usado como padrão em massa, e o ZnO (5 nm) / β-Ga 2 O 3 foi usado para determinar o alinhamento da banda, entretanto, a massa nua β-Ga 2 O 3 foi usada como amostra de controle. Medidas de XPS (AXIS Ultra DLD, Shimadzu) com um passo de 0,05 eV foram realizadas para medir os espectros de banda de valência máxima (VBM), Ga 2p e Zn 2p. Para evitar a interferência da oxidação e contaminação da superfície, todas as amostras foram condicionadas pelo íon Ar por 3 min com uma voltagem de 2 kV antes da medição XPS. Observe que todos os espectros XPS foram calibrados pelo pico C 1s em 284,8 eV para compensar o efeito de carregamento. Para identificar o bandgap, o espectro de transmitância óptica de Ga 2 O 3 e ZnO foram medidos por espectroscopia ultravioleta-visível (UV-VIS) (Lambda 750, PerkinElmer, EUA).
Resultados e discussão
A Figura 1 mostra a variação de (α hv ) 1 / n como uma função da energia do fóton para β-Ga em massa 2 O 3 e o filme de ZnO conforme crescido depositado a 200 ° C. O gap óptico de banda ( E g ) do filme ZnO e β-Ga 2 O 3 pode ser determinado pela relação de Tauc [21]:(α hv ) 1 / n = A ( hv - E g ), onde α é o coeficiente de absorção, A é uma constante, hv é a energia do fóton incidente, E g é o bandgap de energia óptica, n é 1/2 para o bandgap direto e 2 para o bandgap indireto. Aqui, tanto ZnO quanto β-Ga 2 O 3 têm uma lacuna de banda direta típica que torna o valor de n é 1/2. Posteriormente, E g pode ser extraído extrapolando a porção da linha reta para o viés de energia em α =0. Portanto, o E extraído g de ZnO e β-Ga 2 O 3 são 3,20 eV e 4,65 eV, respectivamente, em boa concordância com o relatado. [22, 23]

O enredo de (α hv ) 2 versus hv para a Filme de ZnO crescido em vidro de quartzo b β-Ga 2 O 3 substrato. A inserção mostra os espectros de transmissão óptica de ZnO e β-Ga 2 O 3 , respectivamente
O deslocamento da banda de valência (VBO) pode ser determinado pelo método de Kraut usando a seguinte fórmula [24]
$$ \ Delta {E} _V =\ left ({E} _ {Ga \ 2p} ^ {Ga_2 {O} _3} - {E} _ {VBM} ^ {Ga_2 {O} _3} \ right) - \ esquerda ({E} _ {Zn \ 2p} ^ {Zn O} - {E} _ {VBM} ^ {Zn O} \ direita) - \ esquerda ({E} _ {Ga \ 2p} ^ {Ga_2 {O } _3} - {E} _ {Zn \ 2p} ^ {Zn O} \ direita), $$ (1)
onde \ ({E} _ {Ga \ 2p} ^ {Ga_2 {O} _3} - {E} _ {VBM} ^ {Ga_2 {O} _3} \) \ (\ Big ({E} _ {Zn \ 2p} ^ {Zn O} - {E} _ {VBM} ^ {Zn O} \)) representa a diferença de energia entre Ga 2p (Zn 2p) nível de núcleo (CL) e VBM de massa β-Ga 2 O 3 (ZnO), e \ ({E} _ {Ga \ 2p} ^ {Ga_2 {O} _3} - {E} _ {Zn \ 2p} ^ {Zn O} \) denota como a diferença de energia entre Ga 2p e Níveis principais de Zn 2p. A Figura 2 mostra todos os espectros de CL incluindo Zn 2p de ZnO (40 nm) / β-Ga 2 O 3 e ZnO (5 nm) / β-Ga 2 O 3 , Ga 2p de Ga 2 em massa O 3 e ZnO (5 nm) / β-Ga 2 O 3 , bem como espectros de banda de valência de Ga 2 O 3 e ZnO (40 nm) / β-Ga 2 O 3 . A Figura 2a apresenta os espectros CL de Zn 2p no ZnO (40 nm) / β-Ga 2 O 3 , que é silencioso simétrico indicando o estado de ligação uniforme, e o pico localiza-se em 1021,09 eV corresponde à ligação Zn-O [25]. O VBM pode ser determinado usando um método de extrapolação linear [26]. O VBM do ZnO está localizado em 2,11 eV. Na Fig. 2b, o pico localizado em 1117,78 eV corresponde à ligação Ga-O [27] e o VBM de Ga 2 O 3 é deduzido como 2,74 eV de acordo com o método mencionado acima. Os CLs de Zn 2p e Ga 2p no ZnO (5 nm) / β-Ga 2 O 3 são mostrados na Fig. 2c. De acordo com a Eq. (1), o VBO na interface de ZnO / Ga 2 O 3 é determinado como sendo 0,06 eV.
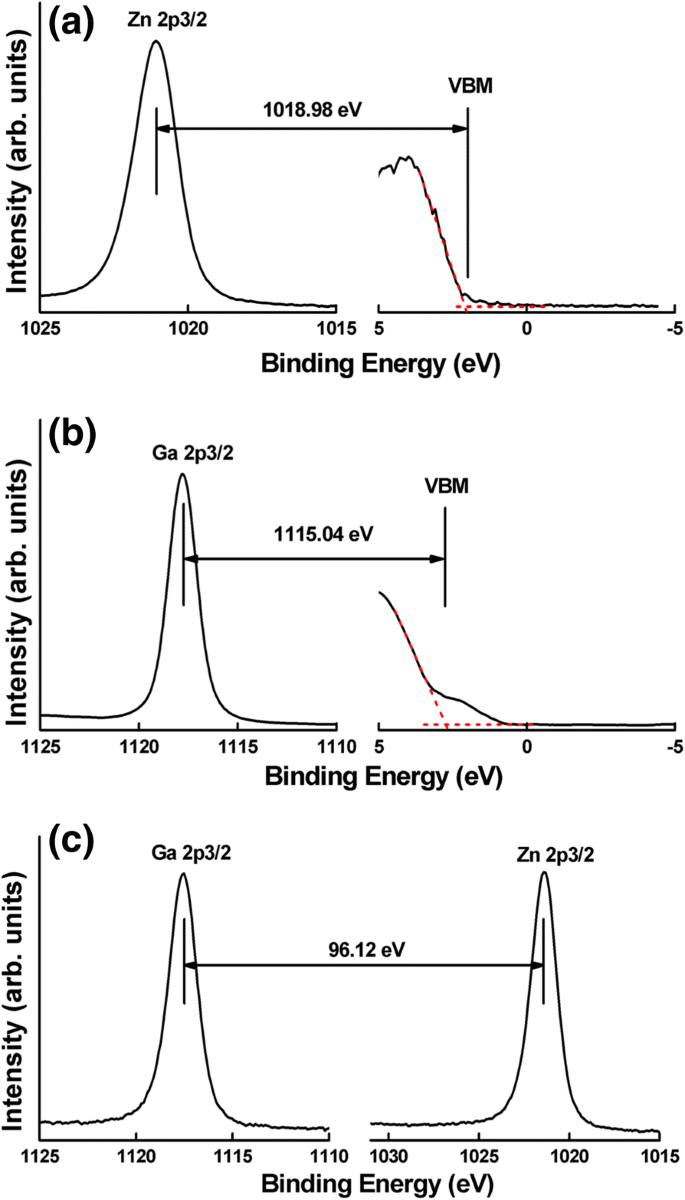
Espectros XPS de alta resolução para nível de núcleo e banda de valência máxima (VBM) de a Espectro de nível de núcleo Zn 2p e VBM de 40 nm ZnO / β-Ga 2 O 3 , b Espectro de nível central Ga 2p e VBM de β-Ga 2 nua O 3 , e c os espectros de nível de núcleo de Ga 2p e Zn 2p obtidos a partir de espectros XPS de alta resolução de 5 nm ZnO / β-Ga 2 O 3
Com base no E calculado g e ∆E V , o deslocamento da banda de condução (CBO) no ZnO / Ga 2 O 3 interface pode ser facilmente deduzida a partir da seguinte equação:
$$ \ Delta {E} _C ={E} _g ^ {Ga_2 {O} _3} - {E} _g ^ {ZnO} - \ Delta {E} _V, $$ (2)
onde \ ({E} _g ^ {Ga_2 {O} _3} \) e \ ({E} _g ^ {ZnO} \) são o intervalo de energia para β-Ga 2 O 3 e ZnO, respectivamente. O diagrama de banda de energia detalhado para ZnO / β-Ga 2 O 3 é representado na Fig. 3. A interface tem um alinhamento de banda do tipo I, onde ambas as bordas da banda de condução e valência de ZnO estão localizadas dentro do intervalo de banda de β-Ga 2 O 3 .

Diagrama esquemático de alinhamento de banda do ZnO (200 ° C) / β-Ga 2 O 3 heterojunção
Para examinar melhor o efeito da temperatura de crescimento no alinhamento da banda entre ZnO e β-Ga 2 O 3 , os filmes de ZnO também são cultivados a 150 e 250 ° C. Observe que os filmes de ZnO preparados por ALD nas temperaturas de 150–250 ° C têm natureza policristalina. A Figura 4 mostra os espectros de O 1s XPS de alta resolução dos filmes de ZnO cultivados em diferentes temperaturas. Cada espectro de O 1s pode ser bem separado em três componentes usando a função Gaussiana-Lorentziana. Os picos centrados em 530,0 (O1), 531,6 (O2) e 532,4 (O3) eV correspondem às bandas Zn-O, vacâncias de oxigênio e grupo –OH [28, 29], respectivamente. A porcentagem relativa de diferentes componentes também é calculada de acordo com a área do pico, digerida na Fig. 4. Ela mostra que o conteúdo relativo de vacâncias de oxigênio aumenta de 10,7 para 15,0% devido à decomposição de precursores e ao aumento de intersticiais Zn. No entanto, a contraparte –OH reduz de 5,1 para 1,9% por causa de reações mais completas entre os precursores DEZ e grupos –OH de superfície nesta faixa de temperatura [30].

Espectros O 1 s XPS de alta resolução dos filmes ZnO crescidos em a 150 ° C, b 200 ° C e c 250 ° C, respectivamente
A Figura 5 mostra os deslocamentos de banda de ZnO / β-Ga 2 O 3 heterojunções em função da temperatura de crescimento. O CBO aumenta de 1,26 a 1,47 eV com a temperatura de crescimento variando de 150 a 250 ° C. Os defeitos do doador nativo incluem a anti-posição de Zn, lacunas de oxigênio e intersticiais de Zn. No entanto, a energia de formação dos átomos de anti-posição é tão alta que sua concentração é extremamente baixa. Os intersticiais Zn têm mais influência no mínimo da banda de condução (CBM) do que na vacância de oxigênio porque o CBM é dominado principalmente pela órbita 4s do átomo de Zn. [31] Como resultado, o CBO aumentado de 0,21 eV pode ser contribuído principalmente por intersticiais Zn. Por outro lado, o VBO reduz de 0,20 para 0,01 eV com a temperatura de crescimento aumentando de 150 para 250 ° C. Os defeitos aceitadores nativos incluem a anti-posição O, vacâncias de Zn e intersticiais de oxigênio [32], cujas energias de formação são altas e seu número pode ser até insignificante. Além disso, a maioria dos níveis de aceitadores nativos estão profundamente dentro do bandgap de ZnO, portanto, eles têm pouco efeito sobre o VBM [33]. No entanto, V zn + OH é favorável a ser apresentado duo à baixa energia de formação, [34] V zn + OH pode ocorrer com um elétron pertencente a ligações OH. A rede de hidrogênio H + íon atua como um centro de compensação e pode se ligar ao V Zn em torno do núcleo das falhas de deslocamento e empilhamento, garantindo o defeito complexo do tipo aceitador para a condutividade do tipo p [35]. Mais grupos -OH residuais no filme de ZnO são obtidos a uma temperatura de crescimento mais baixa, ou seja, 150 ° C [36]. O nível do aceitador perto do VBM reduz com a temperatura, levando a um deslocamento efetivamente para baixo em E V de ZnO, portanto, o ∆E V torna-se mais baixo. Portanto, o ZnO depositado em temperatura mais baixa poderia ser mais eficiente para reduzir a altura da barreira na interface entre o metal e Ga 2 O 3 .

Os deslocamentos da banda de condução e valência de ZnO / β-Ga depositado na camada atômica 2 O 3 heterojunções fabricadas em diferentes temperaturas
Conclusões
Em resumo, o alinhamento da banda de energia no ZnO / β-Ga depositado na camada atômica 2 O 3 (\ (\ overline {2} 01 \)) foi caracterizado por XPS. Um alinhamento de banda tipo I formado no ZnO / β-Ga 2 O 3 interface. O deslocamento da banda de condução aumentou de 1,26 para 1,47 eV, enquanto o deslocamento da banda de valência diminuiu de 0,20 para 0,01 eV com a temperatura aumentando de 150 para 250 ° C. Estas observações sugerem que o ZnO depositado em temperatura mais baixa é favorável a ser um ISL promissor para reduzir a altura da barreira de elétrons no ZnO / β-Ga 2 O 3 interface.
Abreviações
- ALD:
-
Deposição de camada atômica
- CBM:
-
Banda de condução mínima
- CBO:
-
Deslocamento da banda de condução.
- CVD:
-
Deposição de vapor químico
- DEZ:
-
Zn (C 2 H 5 ) 2
- Ga 2 O 3 :
-
Óxido de gálio
- GaN:
-
Nitreto de gálio
- ISL:
-
Camada semicondutora intermediária
- MOSFETs:
-
Transistores de efeito de campo semicondutores de óxido metálico
- OH:
-
Hidroxila
- SiC:
-
Carboneto de silício
- UV-VIS:
-
Espectroscopia ultravioleta-visível
- VBM:
-
Banda de valência máxima
- VBO:
-
Deslocamento da banda de valência
- XPS:
-
Espectroscopia de raios X
- ZnO:
-
Óxido de zinco
Nanomateriais
- Amplificadores
- Teoria da banda dos sólidos
- Elástico
- Usando ângulos para melhorar o futuro da eletrônica
- Investigação teórica de nanofios de germânio deformados biaxialmente por tração
- Entendendo a energia solar
- Entendendo a energia térmica
- Entendendo a energia das marés
- Entendendo as energias renováveis
- Entendendo a energia geotérmica



