Densidade de corrente de curto-circuito induzida por captura de luz em células solares de heterojunção III-nitreto / Si (111)
Resumo
Uma eficiência fotovoltaica de área efetiva de 1,27% na conversão de energia, excluindo a área de contato do metal da grade e sob 1 sol, condições AM 1.5G, foi obtida para os arranjos de diodos p-GaN / i-InGaN / n-GaN epitaxialmente crescidos em (111) -Si. A densidade de corrente de curto-circuito é 14,96 mA / cm 2 e a tensão de circuito aberto é de 0,28 V. O aprisionamento de luz aprimorado adquirido através de múltiplas reflexões dentro das estruturas de arranjo de nanorod de nitreto III livre de deformação e defeitos e as respostas de comprimento de onda curto impulsionadas pelos constituintes de nitreto III de amplo gap contribuem para o melhorias observadas no desempenho do dispositivo.
Introdução
O desenvolvimento da energia verde tornou-se cada vez mais essencial e as indústrias de diodos emissores de luz (LED), bem como de células solares, desenvolveram-se em um ritmo acelerado devido a uma crise energética cada vez maior. Nas últimas décadas, semicondutores de nitreto III foram aplicados com sucesso a dispositivos LED [1,2,3], o que resultou em benefícios comerciais substanciais. Atualmente, muitos cientistas procuram explorar o potencial de pesquisa em III-nitretos para aplicações fotovoltaicas [4, 5]. Materiais de nitreto dos grupos III-V têm muitas vantagens para sistemas fotovoltaicos, como um bandgap direto com um grande coeficiente de absorção [4, 6], uma ampla faixa de bandgap cobrindo a maior parte do espectro solar via engenharia de banda [4, 6, 7], alta mobilidade de portadores [7] e resistência à radiação superior [8]. Com base nessas propriedades excelentes, vários projetos de estrutura de dispositivo são simulados, como células tandem InGaN / Si [9,10,11,12,13,14], células solares portadoras quentes [15], células solares baseadas em Schottky [16, 17,18], células solares de junção única [19,20,21,22,23,24] e múltiplas [25, 26], bem como efeitos de polarização no desempenho da célula solar [9, 23, 27]. As simulações previram que as células em tandem heteroestruturais InGaN / Si poderiam ter eficiências de até 21-36% [10, 11, 13] com base em diferentes modelos de simulação. A eficiência de conversão de energia (PCE) da célula solar tandem homoestrutural InGaN com quatro composições diferentes de In é proposta como sendo 51% sob irradiância de 1 sol e 58% sob condição de concentração de 250 sol [26]. No entanto, os problemas de impurezas e recombinação não radiativa tornam-se cada vez mais significativos sob condições de crescimento de filme fino InGaN de baixa temperatura [28,29,30]. As falhas de empilhamento significativas e densidades de deslocamento devido à incompatibilidade de rede levam à diminuição do comprimento de difusão do portador e à limitação do PCE da célula solar [31,32,33,34]. Portanto, numerosos desafios permanecem para a realização das capacidades potenciais dos dispositivos fotovoltaicos de nitreto III de alta eficiência.
Na última década, muitos tópicos de pesquisa relevantes, como métodos de crescimento de cristal InGaN de alto InGaN em substrato GaN autônomo [34], dopagem InGaN tipo p [35], projetos de poços quânticos [36,37,38,39,40], eletrodo projetos [41,42,43,44], concentradores fotovoltaicos [37, 41, 45], células solares de banda intermediária [46] e estruturas de reflexão reduzida [47,48,49] foram estudados. Além disso, as células solares baseadas em nitreto não polar foram investigadas no efeito de polarização [50, 51]. Dahal et al. demonstraram uma operação de célula solar de poços quânticos múltiplos em InGaN superior a 30% em comprimentos de onda mais longos (> 420 nm) [38] e ilustraram uma eficiência de 3,03% sob intensidade de iluminação aumentada até 30 sóis [37]. Mori et al. investigaram células solares baseadas em nitreto de concentrador [45] e abordaram o PCE mais alto de 4% operado em alta intensidade de luz até 300 sóis [41]. Embora vários grupos de pesquisa tenham fornecido designs estruturais ou ópticos diferentes e melhorado as técnicas de crescimento, o PCE das células solares de nitreto III não avançou muito. Por outro lado, Reichertz et al. demonstraram que as células solares em tandem são viáveis pelo crescimento epitaxial da junção p-n GaN no substrato de Si da junção p-n [14]. Seus resultados indicaram que o substrato de Si contribuiu com a eficiência do comprimento de onda longo, enquanto o nitreto contribuiu com a eficiência do comprimento de onda curto. Substratos de silício fornecem não apenas uma solução de baixo custo, mas também aprimoramento de PCE e boa condutividade térmica [52].
Normalmente, para o crescimento de células solares, camadas de filme contínuo crescem umas sobre as outras e isso resulta em alta densidade de deslocamento. No entanto, quando os nitretos III são cultivados em nanoestruturas, a área inferior em contato com o substrato é pequena, portanto, os deslocamentos de rosca são reduzidos e a tensão também pode ser mínima. Tessarek et al. relataram que os deslocamentos de nanobastões de GaN desapareceram conforme o diâmetro desce para 200 nm [53]. Portanto, como uma alternativa para o crescimento de filme em substratos de silício, seria uma escolha preferida cultivar células solares de nanorod de nitreto III para reduzir o custo, melhorar a qualidade do cristal e aumentar a eficiência da célula. Além disso, nanorod / nanofio tem uma grande capacidade para aplicações fotovoltaicas porque os elétrons foto-gerados podem ser coletados de forma mais eficaz antes de se recombinarem com buracos devido a um caminho direto para os eletrodos e as estruturas de nanobast podem melhorar o aprisionamento de luz para aumentar a absorção de fótons [54, 55]. Vários grupos demonstraram os fotodetectores [56, 57], nanolasers [58, 59], nano-LEDs [60, 61] e aplicações fotoeletroquímicas de separação de água [62] com base em nanobastões de nitreto III [55]. No entanto, o demérito das células solares de nanobastões é que os pares de elétrons-buracos fotogerados se recombinam em abundantes centros de captura de portadores devido a defeitos de superfície. Além disso, os processos de fabricação de dispositivos de células solares de nanobastões são mais complicados do que os de dispositivos de película fina. No entanto, a superação desses problemas mencionados acima resultou em um aumento de quase três vezes no PCE, conforme mostrado por Wallentin et al. onde a matriz de nanobastões InP tem um PCE de 13,8% de otimização do diâmetro do nanobastão e o comprimento do segmento n superior [54, 63]. Krogstrup et al. indicou que alta densidade de corrente de curto-circuito (J sc ) foi obtido nas estruturas de nanofio GaAs de camada única de núcleo devido a mais de uma ordem de magnitude de absorção de luz aumentada pela concentração de luz [64]. Wierer et al. [65], Cansizoglu et al. [66] e Nguyen et al. [31] demonstraram diferentes tipos de células solares de nanorod-array de nitreto no modelo de GaN e substrato de Si. A comparação da pesquisa fotovoltaica de nanorod / nanofio recente está listada em Informações suplementares:Tabela S1. No entanto, as contribuições de conversão fotoelétrica de diferentes dispositivos fotovoltaicos de conjunto de nanorod InGaN em conteúdo em substratos de Si (111) de baixo custo não foram discutidas sistematicamente até agora.
Neste estudo, conjuntos de nanorods de nitreto de Mg:GaN / InGaN / Si:GaN III com concentração de índio de 8% e 11% foram cultivados em substratos de Si dopado com n (111) por epitaxi de feixe molecular assistido por plasma (PA-MBE, Veeco EPI930). As propriedades estruturais e o conteúdo de índio foram estimados por difração de raios-X de alta resolução (HR-XRD, Bede D1). A estrutura fina dos nanobastões foi analisada por microscopia eletrônica de transmissão de alta resolução (HR-TEM, FEI E.O Tecnai F20 G2). As propriedades de densidade de corrente versus voltagem (J-V) de células solares de nitreto foram discutidas sob 1 sol, iluminação AM 1.5G (Newport 94023A). A eficiência quântica externa (EQE, Enli Technology Co., Ltd., QE-R3018) foi medida para estudar a resposta espectral. Os alinhamentos e simulações do diagrama de bandas também foram investigados para explicar o transporte de elétrons e lacunas.
Método Experimental
Técnica de crescimento
O crescimento de nanobastões de Si:GaN e Mg:GaN / InGaN / Si:GaN é baseado na técnica de epitaxia de feixe molecular assistido por plasma (PA-MBE). Todas as amostras foram cultivadas por um sistema Veeco GEN930 PA-MBE equipado com uma fonte de plasma de nitrogênio 6N (Veeco, UNI-Bulb). O substrato de Si tipo n (111) com uma resistividade de 0,001–0,005 Ω cm foi limpo com acetona, isopropanol e água desionizada em um banho ultrassônico por 5 min em cada etapa para remover a contaminação orgânica residual e, em seguida, gravado em um 48–51% HF:H 2 O =solução 1:5 por 5 min para remover o óxido nativo. Após o processo de limpeza / corrosão química, o substrato de Si foi seco com gás nitrogênio. O substrato de Si foi introduzido na câmara tampão e então transferido para a câmara de crescimento por um braço de transferência acoplado magneticamente. Antes do crescimento do nanorod, o substrato foi limpo termicamente a 900 ° C por 30 min para remover o óxido nativo residual e obter uma superfície de Si reconstruída 7 × 7 limpa e ordenada. Os átomos de nitrogênio ativados foram gerados por uma pistola de plasma e seu fluxo e pureza foram controlados por meio de um controlador de fluxo de massa de alta resolução (HORIBA STEC, SEC-7320 M) e um purificador de nitrogênio (Entegris, CE35KFI4R). As fontes de Ga, In, Si e Mg de alta pureza (6N ou superior) foram fornecidas por células de efusão de fonte sólida. O metal do grupo III e N 2 A pressão equivalente do feixe de plasma (BEP) foi medida com um medidor de fluxo do feixe. Ao controlar as razões de fluxo III / V para condição rica em N, nanobastões podem ser obtidos. Primeiro, nanobastões de Si:GaN auto-montados foram cultivados a 760 ° C por 82 min. A dessorção de InN é crítica em temperaturas elevadas porque o índio evaporará da superfície da amostra. Para reter índio nos nanobastões, a técnica de epitaxia modulada por metal (MME) foi utilizada [67, 68]. O MME envolve a abertura e o fechamento periódico das venezianas de metal para modular os fluxos de metal, enquanto o N 2 o obturador é mantido aberto. Para ajustar a concentração em, dois tempos de ciclo diferentes de átomos In e Ga colidiram com o substrato alternadamente por 20 s / 30 s (amostra B) e 30 s / 30 s (amostra C) com 50 períodos a 550 ° C. Finalmente, a camada de Mg:GaN foi cultivada a 600 ° C. As amostras foram cultivadas sob 9,25 × 10 −6 torr de nitrogênio ativo BEP com potência de plasma 450 W, 2,42 × 10 −8 torr em BEP e 1,93 × 10 −8 torr Ga BEP. Além disso, os nanobastões de Si:GaN de camada única (amostra A) também foram preparados como um grupo controlado nas mesmas condições.
Fabricação de dispositivos
Após o crescimento do nanobastão, o processo de fabricação do dispositivo incluiu as seguintes etapas. (1) A área do dispositivo de 350 × 350 μm 2 mesa foi definida por corrosão até o tipo n Si com tetrafluorometano (CF 4 ) com base na técnica de corrosão de íons reativos (Advanced System Technology, Cirie-200) usando fotorresiste (Microchemicals GmbH, AZ1400) como máscara. (2) Um banho ultrassônico com água desionizada foi usado para limpar os nanobastões soltos do dispositivo, exceto aqueles da área da mesa. (3) Mergulhe a amostra em (NH 4 ) 2 S a 60 ° C por 1 min para passivar a superfície de nitreto para supressão de óxido nativo e redução de recombinação não radiativa [69,70,71,72,73]. (4) Um filme fino de óxido de índio e estanho (ITO) de 100 nm foi depositado no topo dos nanobastões para servir como o contato transparente ôhmico Mg:GaN por pulverização catódica (Advanced System Technology, Psur-100HB) acompanhado por fotolitografia (M&R Nano Technology , AG350-6B) e técnicas de levantamento. (5) Os contatos de grade de metal multicamadas Ti / Al / Ti / Au (20 nm / 300 nm / 20 nm / 50 nm) no filme ITO e nos substratos de Si tipo n foram fabricados por evaporação de feixe eletrônico (Advanced System Technology , Peva-600E) usando fotolitografia e técnicas de levantamento. (6) Todos os contatos de metal da grade foram recozidos por um sistema de recozimento térmico rápido (Advanced System Technology, FA04) por 30 s em nitrogênio a 800 ° C para obter contatos ôhmicos.
Preparação da amostra para TEM
Para estudar mais a estrutura cristalina, nanobastões individuais das amostras B e C foram extraídos por sonicação em etanol. Após 30 min de sonicação, algumas gotas da solução de etanol foram aplicadas a uma grade de cobre (Ted Pella) e o etanol foi evaporado à temperatura ambiente. Antes das medições, a amostra foi cozida a 150 ° C para remover os solventes orgânicos livres.
Resultados e discussão
Propriedades morfológicas e estruturais
As vistas superiores e as vistas em seção transversal de imagens de microscopia eletrônica de varredura (SEM) são mostradas na Fig. 1a-f ilustrando a morfologia dos nanobastões conforme crescidos. Da esquerda para a direita, a Fig. 1 a – c representa a variação na morfologia da superfície de Si:GaN (amostra A) e Mg:GaN / InGaN / Si:GaN com tempo de ciclo de impacto de átomos In / Ga variados de 20 s / 30 s (amostra B) e 30 s / 30 s (amostra C) durante o crescimento InGaN de 50 ciclos, respectivamente. Os diâmetros de Si:GaN e Mg:GaN / InGaN / Si:GaN nanobastões são 30-100 nm e 80-150 nm, respectivamente, enquanto as densidades de área são ~ 7 × 10 9 cm −2 . As imagens de seção transversal dos nanobastões são mostradas na Fig. 1d-f e indicam o comprimento dos nanobastões em cerca de 700 nm para as amostras de A a C. A estrutura esquemática das amostras de Mg:GaN / InGaN / Si:GaN é mostrada na Fig. 1g.
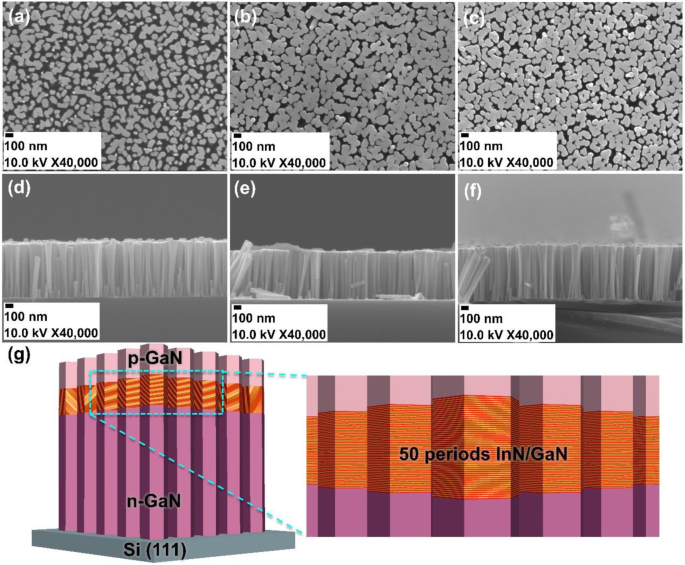
As principais visualizações de SEM de a n-GaN (amostra A), p-GaN / InGaN / n-GaN com os tempos de ciclo dos átomos In e Ga impingidos de b 20 s / 30 s (amostra B) e c 30 s / 30 s (amostra C). As visualizações de seção transversal SEM de d amostra A, e amostra B e f amostra C. g Um diagrama esquemático da estrutura de nanorod p-GaN / InGaN / n-GaN
A Figura 2a registrou a medição de difração de raios-x teta-2 teta com foco em diferentes fontes de amostras de tempo de ciclo de impacto. O pico mais forte localizado a 28,44 ° origina-se do substrato de Si. Um pico claro nítido em 34,56 ° corresponde à difração de GaN (0002) e indica uma boa inibição da mistura de fases da camada InGaN. Um pico no lado 2-teta inferior do pico de GaN (0002) a 34,22 ° para a amostra B e a 34,13 ° para a amostra C é InGaN (0002). O c constantes de rede de InN e GaN são 5,760 Å e 5,185 Å respectivamente [74]. Seguindo a lei de Bragg, o c constantes de rede de InGaN (0002) são calculadas como 5,23 Å para a amostra B e 5,25 Å para a amostra C. Importando o c constante de rede de InGaN (0002) à lei de Vegard, a concentração de In pode ser estimada como 8% para a amostra B e 11% para a amostra C sem consideração de deformação. A Figura 2b mostra a imagem TEM de baixa ampliação da amostra C e o diagrama esquemático de sua estrutura. A área 1 e a área 2 são regiões n-GaN e InGaN, respectivamente. O padrão de difração de elétrons de área seletiva (SAED) obtido na área 1 demonstra que a direção [0001] é paralela ao eixo longo do nanobastão e uma direção de crescimento comum dos nanobastões de nitreto. Além disso, nenhum deslocamento é encontrado no cristal. Na Figura 2 c e d, as imagens TEM de resolução atômica produzem o c constantes de rede de GaN e InGaN como 5,19 Å e 5,25 Å, respectivamente, o mesmo que os resultados calculados pela lei de Bragg via varredura de XRD teta-2-teta. Além disso, o c A constante de rede de InGaN para a amostra B é 5,23 Å por meio de imagens TEM de resolução atômica mostradas nas Informações Suplementares:Figura S1. Além disso, imagens de campo escuro anular de alto ângulo (HAADF) e varredura de linha de espectroscopia de raios-X dispersiva (EDS), indicando a distribuição de índio, estão incluídas nas Informações Suplementares:Figura S2.
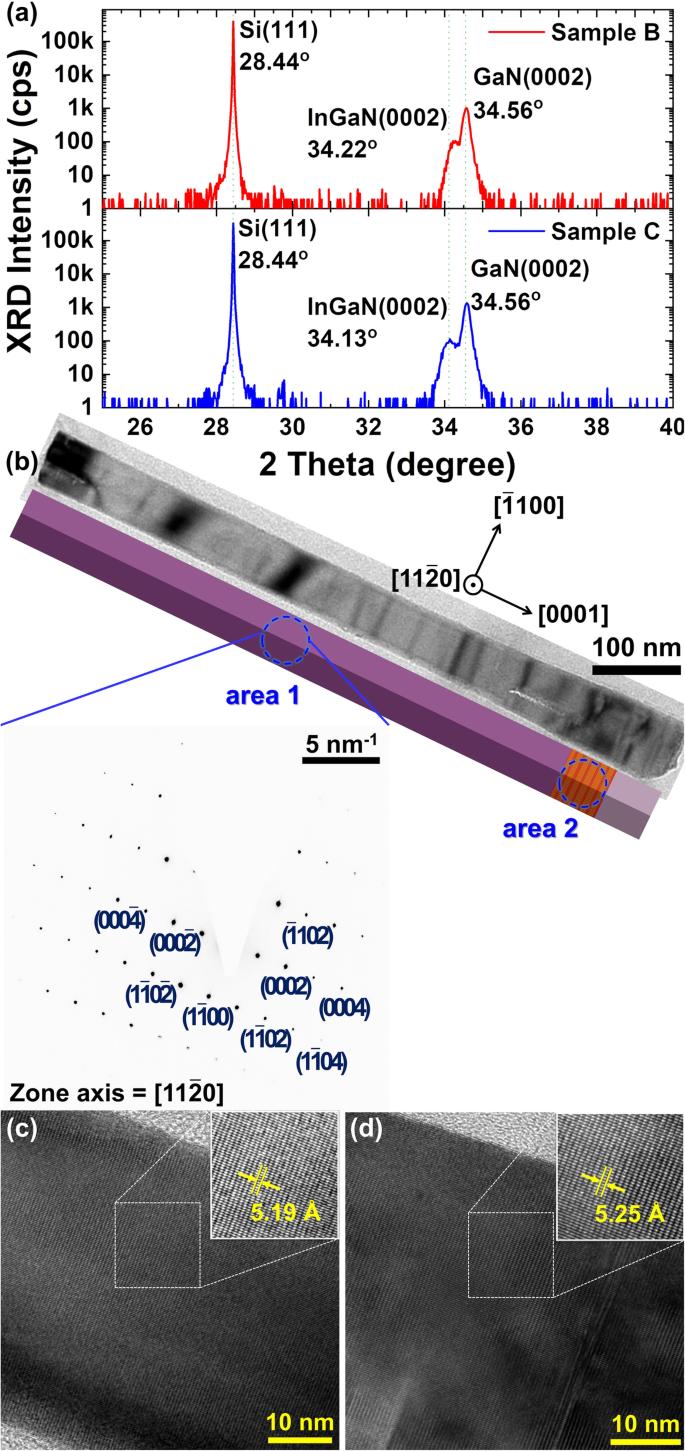
a Espectros HR-XRD para as varreduras teta-2theta. O conteúdo de índio do material InGaN foi estimado em 8% para a amostra B (curva vermelha) e 11% para a amostra C (curva azul) usando a lei de Vegard. b A imagem TEM de nanorod de nitreto livre de deslocamento e o padrão SAED da região n-GaN. O diagrama esquemático de nanorod único abaixo da imagem obedece à escala relativa estrutural. As imagens TEM de resolução atômica de c n-GaN na área 1 e d InGaN na área 2 mostra deslocamento livre e seu c constantes de rede
Análise de características elétricas e ópticas
As medições de densidade de corrente versus tensão foram realizadas por um medidor de fonte Keithley 2400. A Figura 3a mostra o diagrama esquemático de células solares de montagem de nanobastões. A área total do dispositivo é 0,12 mm 2 e a área efetiva sob a iluminação excluindo o metal de contato é 0,0924 mm 2 . Para coletar elétrons gerados por fótons, um filme de ITO condutor transparente de 100 nm é depositado no topo do p-GaN para conectar os nanobastões e o Ti / Al / Ti / Au (20 nm / 300 nm / 20 nm / 50 nm ) eletrodo de dedo. Análises fotoelétricas características do dispositivo também foram conduzidas com simulador solar sob 1 sol, condição AM 1.5G como mostrado na Fig. 3b – d. A resistência em série R s os valores determinados a partir da Fig. 3b-d são 83 Ω, 250 Ω e 2,5 kΩ e a resistência shunt R sh os valores são 413 kΩ, 550 kΩ e 2 MΩ para as amostras A, B e C, respectivamente. A densidade da fotocorrente em tensão zero, J sc , de em 0,08 Ga 0,92 Dispositivo N (amostra B) e em 0,11 Ga 0,89 Dispositivo N (amostra C) é 7,77 mA / cm 2 e 14,96 mA / cm 2 respectivamente. O aumento da fotocorrente sobre o aumento da concentração de In foi demonstrado via J sc comparação. Além disso, Krogstrup et al. ilustrou que a propriedade de concentração de luz em células solares de nanobastões pode aumentar a absorção de luz e fornecer alta fotocorrente [64]. A tensão de circuito aberto (V oc ) e o fator de preenchimento (FF) da amostra C são 0,28 V e 30%, respectivamente. Vários grupos também demonstraram estruturas de nanobastões com baixo V oc [72, 75, 76]. Para elucidar o desempenho fotovoltaico real em uma área realmente iluminada, PCE de área efetiva, PCE eff , estabelece uma eficiência com base na área efetiva que exclui a área do eletrodo da grade, enquanto a área total PCE, PCE tot , considera toda a área do dispositivo. É notável que o PCE tot e PCE eff os valores são 0,98% e 1,27%, o que indica um PCE mais alto de célula solar de nitreto nanobast já relatado. A principal contribuição vem do alto J sc , embora o V oc é menor do que outra célula solar de nanorod de nitreto III [65, 77]. Existem duas razões possíveis para baixo V oc , incluindo o nível quase-Fermi limitado na junção p-n Si que o intervalo de banda de Si é 1,12 eV com base no diagrama de banda e um caminho de corrente confinado pode ser criado devido à fixação do nível de Fermi na superfície [66]. A Tabela 1 resume J sc , V oc , FF e comparação PCE de três amostras.
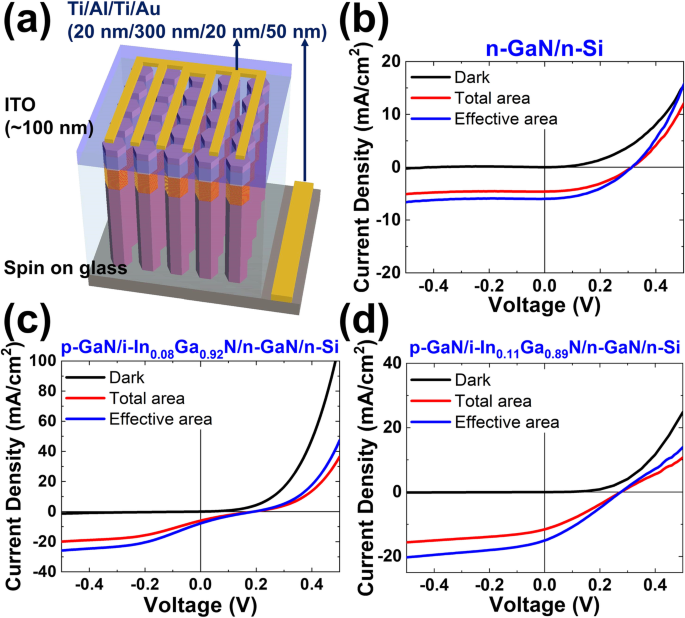
a O diagrama esquemático de células solares de montagem de nanobastões. As curvas de densidade-voltagem de corrente de b n-GaN / n-Si, c p-GaN / In 0,08 Ga 0,92 N / n-GaN / n-Si e d p-GaN / In 0,11 Ga 0,89 N / n-GaN / n-Si nanobastão para montar células solares medidas sob 1 sol, simulador solar AM 1.5G
Para entender as propriedades físicas e elétricas, os diagramas de banda são calculados usando um programa 1D-DDCC (One Dimensional Poisson, Drift-Diffusion e Schrodinger Solver) [78]. As afinidades eletrônicas de ITO, Si e GaN usadas são 4,40 eV, 4,05 eV e 4,1 eV, respectivamente. A Figura 4 aeb mostra o diagrama da banda ITO / n-GaN / n-Si sem polarização de tensão e a curva J-V no escuro, respectivamente. Ele ilustra que a estrutura ITO / n-GaN / n-Si não tem efeito retificador e mostra um perfil J-V linear. A barreira potencial da hetero-interface pode ser ignorada para as portadoras transportarem porque o deslocamento da banda de condução entre Si e GaN deve ser um pequeno valor de 50 meV. Esta curva J-V linear semelhante a um resistor está em contradição com os resultados experimentais.

a Diagrama de banda ITO / n-GaN / n-Si, b Curva J-V ITO / n-GaN / n-Si, c Diagrama de banda ITO / n-GaN / p-Si / n-Si e d Curvas J-V de ITO / n-GaN / p-Si / n-Si simuladas pelo programa 1D-DDCC
Uma possível explicação dos resultados da curva J-V é que a difusão de Ga induz um p-Si na interface GaN / Si e cria uma junção p-n. Reichertz et al. [14] e Neplokh et al. [76] verificaram a difusão do Al no substrato de silício durante o crescimento das camadas de nitreto. Boro, Al e Ga são elementos do grupo IIIB que podem ser um contaminante para a formação da camada de p-Si. No entanto, a taxa de difusão de Ga é de 8 nm / dia a 700 ° C [79]. A Figura 4c mostra um diagrama de banda que inclui uma camada de p-Si muito fina (1 nm) entre a interface n-GaN e n-Si. Um pequeno campo elétrico embutido é criado na junção p-n Si que pode conduzir os elétrons para o substrato n-Si e buracos para a camada de contato ITO. As curvas J-V dependentes da espessura demonstram que a tensão de ativação do diodo diminui quando a espessura das camadas de p-Si se torna mais fina na Fig. 4d. O p-Si ultrafino será uma limitação para a separação de nível quase Fermi e reduzirá o V oc de desempenho solar. A propriedade elétrica simulada com a camada de p-Si incluída está mais próxima do resultado desta pesquisa. Portanto, o diagrama de banda da estrutura de Mg:GaN / InGaN / Si:GaN / p-Si / n-Si pode ser construído como um modelo como na Fig. 5. A iluminação da luz AM 1.5G do topo leva à absorção de fótons com energia maior do que o bandgap InGaN. Quando a luz é irradiada para o Si através das hastes e do espaço intermediário entre as hastes, os fótons com energia maior do que o bandgap de Si também podem ser absorvidos pelo substrato de p-n Si e a fotocorrente é produzida. Simultaneamente, os pares elétron-buraco gerados nas regiões de nitreto pela luz de comprimento de onda curto são separados pelo campo elétrico interno da junção p-i-n. No final, os portadores fotogerados poderiam ser coletados através do contato superior de óxido de índio e estanho (ITO) com o contato de Mg:GaN e o Si n inferior. Com base neste modelo de estrutura e considerando a barreira de Schottky introduzida pelo contato ITO, a simulação da curva J-V é mostrada na Fig. 5b. A curva J-V simulada indica que a forma de S é causada pelo comportamento não ôhmico do contato p. Essa é uma possível razão para explicar que a forma de S existia para Mg:GaN / u-InGaN / Si:GaN (amostras B e C) na Fig. 3 c e d. Portanto, as densidades de corrente na polarização negativa (J polarização negativa (- 0,5 V) ) onde a forma de S é achatada são anotados na Tabela S2. J polarização negativa pode ser um ponto de verificação para maior otimização e um valor direcionado.
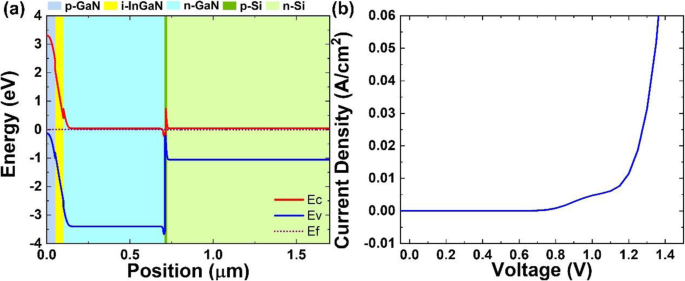
a O nanorod de nitreto p-i-n no diagrama da banda da célula solar de Si p-n simulado pelo programa 1D-DDCC. b Simulação da curva J-V de nanorod de nitreto p-i-n em célula solar de Si p-n
Os resultados da medição EQE sem polarização de luz (luz não modulada adicional) são mostrados na Fig. 6a, que compara os EQEs de Si:GaN / n:Si (amostra A), Mg:GaN / u-In 0,08 Ga 0,92 N / Si:GaN (amostra B), e Mg:GaN / u-In 0,11 Ga 0,89 N / Si:GaN (amostra C). A amostra C tem maior concentração de In, o que pode ser responsável pelos maiores valores no comprimento de onda curto devido à absorção na camada InGaN. Os EQEs máximos nas amostras A, B e C são 32%, 55% e 63%, respectivamente. Comparado com os espectros de refletância da pastilha de Si, amostras A, B e C mostradas na Fig. 6b, as oscilações de EQEs e espectros de refletância são devido à interferência de diferentes camadas. A pastilha de Si nua tem a maior refletância devido à sua superfície plana. As amostras A, B e C têm refletância mais baixa porque as estruturas dos nanobastões têm um efeito de captura de luz. A amostra C tem o EQE mais alto em comprimentos de onda longos e a refletância mais baixa devido ao maior efeito de captura de luz. Este resultado pode explicar a fotocorrente mais alta gerada na amostra C. Os espectros de fotoluminescência (PL) à temperatura ambiente (RT, 300 K) da amostra B e da amostra C são mostrados na Fig. 6c. O pico mais alto localizado em 3,40 eV é a emissão de GaN perto da borda da banda (NBE). Os picos localizados em 3,09 eV e 3,03 eV são devidos a In 0,08 Ga 0,92 N e em 0,11 Ga 0,89 Emissão de N NBE. Os resultados são semelhantes aos valores do cálculo da equação de arqueamento de 3,1 eV e 3,0 eV no RT [4]. Ele também mostra as mesmas fortes oscilações Fabry-Perot (marcadas por sinais de estrelas) como os EQEs e os espectros de refletância, representando as interfaces suaves entre cada camada / superfície.

a Espectros externos de eficiência quântica de três amostras de nanobastões de nitreto / Si. b Os espectros de refletância de wafer de Si nua e três amostras de nanobastões de nitreto / Si. c Os espectros de fotoluminescência à temperatura ambiente de duas amostras InGaN
Conclusão
Nanobastões de Mg:GaN / InGaN / Si:GaN e Si:GaN de alta qualidade crescidos em n-Si por epitaxia de feixe molecular assistido por plasma são demonstrados com sucesso. Medições fotovoltaicas exibem um PCE eff de 1,27% e um PCE tot de 0,98% sob 1 sol, iluminação AM 1,5G para Mg:GaN / u-In 0,11 Ga 0,89 N / Si:GaN que possui uma maior concentração de In e um maior efeito de captura de luz induzindo uma alta fotocorrente. Embora os nanobastões de Si:GaN no dispositivo n-Si possam não ter um campo integrado de junção p-n proeminente, o projeto de uma estrutura de heterojunção adequada ajuda a conduzir os fototransportadores aos contatos superior e inferior e melhora o desempenho da célula.
Disponibilidade de dados e materiais
Os autores declaram que os materiais e dados estão disponíveis aos leitores, e todas as conclusões tiradas neste manuscrito são baseadas nos dados que são apresentados e mostrados neste artigo.
Abreviações
- LED:
-
Diodo emissor de luz
- PCE:
-
Eficiência de conversão de energia
- J sc :
-
Densidade de corrente de curto-circuito
- PA-MBE:
-
Epitaxia de feixe molecular assistida por plasma
- HR-XRD:
-
Difração de raios-x de alta resolução
- HR-TEM:
-
Microscopia eletrônica de transmissão de alta resolução
- EQE:
-
Eficiência quântica externa
- BEP:
-
Pressão equivalente do feixe
- MME:
-
Epitaxia modulada por metal
- ITO:
-
Óxido de índio estanho
- V oc :
-
Voltagem de circuito aberto
- RT:
-
Temperatura do quarto
- PL:
-
Fotoluminescência
- NBE:
-
Perto da borda da banda
Nanomateriais
- Célula solar
- Nano árvores para células solares sensibilizadas com corante
- Células solares de grafeno de alta eficiência
- Nano-heterojunções para células solares
- Características fotovoltaicas de dispositivos de heterojunção GaSe / MoSe2
- Absorção de luz aprimorada por plasma em células solares nanowire de GaAs de junção (p-i-n):um estudo de método de simulação FDTD
- Um breve relatório de progresso sobre células solares de perovskita de alta eficiência
- PEDOT Altamente Condutivo:Camada de Transporte de Furo Transparente PSS com Tratamento Solvente para Células Solares Híbridas Orgânicas / Silicone de Alto Desempenho
- Eletrodeposição de SnO2 em FTO e sua aplicação em células solares de perovskita de heterojunção planar como uma camada de transporte de elétrons
- Tungstênio



