Modelo analítico para a temperatura máxima do canal em Ga2O3 MOSFETs
Resumo
Neste trabalho, propomos um modelo analítico preciso para a estimativa da temperatura máxima do canal de Ga 2 O 3 MOSFETs com substratos nativos ou de alta condutividade térmica. A condutividade térmica de Ga 2 O 3 é anisotrópico e diminui significativamente com o aumento da temperatura, os quais são importantes para o comportamento térmico de Ga 2 O 3 MOSFETs e, portanto, considerados no modelo. Simulações numéricas são realizadas via COMSOL Multiphysics para investigar a dependência da temperatura máxima do canal na densidade de potência, variando os parâmetros geométricos do dispositivo e a temperatura ambiente, o que mostra boas concordâncias com o modelo analítico, fornecendo a validade deste modelo. O novo modelo é instrutivo no gerenciamento térmico eficaz de Ga 2 O 3 MOSFETs.
Histórico
Óxido de gálio (Ga 2 O 3 ) transistores de efeito de campo de semicondutor de óxido de metal (MOSFETs) baseados em metal são excelentes candidatos para eletrônica de potência de próxima geração, que se beneficiam de duas vantagens principais de Ga 2 O 3 :o bandgap significativamente alto (~ 4,8 eV) e cristais a granel de alta qualidade produzidos a baixo custo [1]. Esforços tremendos têm sido dedicados a melhorar suas propriedades elétricas em todos os aspectos, como densidade de corrente [2], tensão de ruptura [3] e figura de mérito de potência [4]. Com a confirmação experimental de seu potencial sem precedentes para dispositivos eletrônicos de potência [5,6,7,8,9], agora é de suma importância explorar o desempenho e a confiabilidade do Ga 2 O 3 MOSFETs, como a questão dos efeitos de autoaquecimento e, portanto, a temperatura máxima do canal ( T máximo ), devido à sua condutividade térmica relativamente baixa ( κ , 0,11–0,27 Wcm −1 K −1 à temperatura ambiente) [1].
Nos últimos anos, vários métodos para estimar o T máximo de Ga 2 O 3 Os MOSFETs foram propostos teórica e experimentalmente [10,11,12,13]. Em geral, as simulações numéricas podem estimar quantitativamente T máximo de um determinado dispositivo. No entanto, isso é demorado [14]. Por outro lado, a extração de T máximo por meio de experimentos é sempre subestimado [15]. Portanto, um modelo analítico deve ser feito a fim de modelar adequadamente o T máximo em Ga 2 O 3 MOSFETs, que podem fornecer precisão suficiente com eficiência de tempo e avaliações qualitativas [14].
Neste artigo, propomos um modelo analítico de T máximo para Ga 2 O 3 MOSFETs empregando a transformação de Kirchhoff, considerando a dependência de κ na temperatura e direções cristalográficas para Ga 2 O 3 . O modelo proposto pode ser aplicado para Ga 2 O 3 MOSFETs com substratos nativos ou de alta condutividade térmica. A validade e a precisão do modelo analítico são verificadas metodicamente por comparação com as simulações numéricas via COMSOL Multiphysics.
Métodos e desenvolvimento de modelo
O modelo analítico para T máximo em Ga 2 O 3 Os MOSFETs são propostos com base na estrutura mostrada na Fig. 1. Os principais parâmetros da estrutura estão listados na Tabela 1. De fato, foi demonstrado que o aquecimento Joule está concentrado na borda do dreno da porta em Ga 2 O 3 MOSFETs [13]. Para simplificar o modelo, assume-se que o efeito de aquecimento da porta é uniforme [12] e pode penetrar completamente através do óxido da porta devido à sua espessura desprezível. Diferentes materiais de substrato sob Ga 2 O 3 canal são considerados neste modelo, como bulk Ga 2 O 3 e alto κ materiais, visando a viabilidade e compatibilidade da placa. Assim, o dispositivo é visto como um problema de duas camadas. O substrato entra em contato com um dissipador de calor ideal para que a superfície inferior seja isotérmica e sua temperatura seja igual à da temperatura ambiente ( T amb , 300 K por padrão). Condições de contorno adiabáticas foram impostas em outra superfície da estrutura. Essas condições de contorno podem ser resumidas como [14, 16]

O diagrama esquemático de Ga 2 O 3 MOSFET
$$ {\ kappa} _ {y} {\ left. \ frac {\ partial T} {\ partial y} \ right |} _ {y ={t} _ {ch} + {t} _ {sub}} =\ left \ {\ begin {array} {c} \ frac {P} {{L} _ {g}} \ left | x \ right | \ le \ frac {{L} _ {g}} {2} \\ 0 \ left | x \ right |> \ frac {{L} _ {g}} {2} \ end {array} \ right., $$ (1) $$ {\ left.T \ right |} _ {y =0} ={T} _ {amb}, $$ (2) $$ {\ left. \ frac {\ partial T} {\ partial x} \ right |} _ {x =- \ frac { L} {2}} ={\ esquerda. \ Frac {\ parcial T} {\ parcial x} \ direita |} _ {x =\ frac {L} {2}} =0, $$ (3)
onde P , T e κ y denotam a densidade de dissipação de potência, temperatura e condutividade térmica da direção [010] para Ga 2 O 3 , respectivamente. Deve-se enfatizar que a unidade de P é W / mm neste artigo.
O κ valor de Ga 2 O 3 , um dos parâmetros-chave para a característica térmica do material, desempenha um papel importante na difusão do efeito de aquecimento, bem como na precisão do modelo. Ou seja, uma descrição cuidadosa de κ valor é necessário, devido à sua grave anisotropia e dependência da temperatura [17]. Em geral, a dependência de κ de Ga 2 O 3 na temperatura ( T ) ao longo de duas orientações de cristal diferentes ([001] e [010]) é dado por
$$ {\ kappa} _ {\ left [001 \ right]} \ left (T \ right) =0,137 \ times {\ left (\ frac {T} {300} \ right)} ^ {- 1,12}, $ $ (4) $$ {\ kappa} _ {\ left [010 \ right]} \ left (T \ right) =0,234 \ vezes {\ left (\ frac {T} {300} \ right)} ^ {- 1,27}. $$ (5)
O estudo de comparação de T máximo em P diferente foi realizado por COMSOL Multiphysics, considerando constante e realista κ , respectivamente. Descobrimos isso em um P de 1 W / mm, T máximo valores de 533 K e 622 K são obtidos, respectivamente (não mostrado). Portanto, é absolutamente necessário levar em consideração os impactos de T e direção cristalográfica no κ de Ga 2 O 3 no modelo.
O comportamento da temperatura é governado pela equação de condução de calor. A equação de condução de calor em estado estacionário em Ga 2 O 3 domínio é
$$ \ frac {\ partial} {\ partial x} \ left ({\ kappa} _ {x} \ left (T \ right) \ frac {\ partial T} {\ partial x} \ right) + \ frac { \ parcial} {\ parcial y} \ esquerda ({\ kappa} _ {y} \ esquerda (T \ direita) \ frac {\ parcial T} {\ parcial y} \ direita) =0, $$ (6)
onde κ x denota a condutividade térmica da direção [001] para Ga 2 O 3 . A equação de condução de calor não linear pode ser resolvida empregando a transformação de Kirchhoff. No entanto, a aplicação da transformação de Kirchhoff pode ser restrita devido ao altamente anisotrópico κ em Ga 2 O 3 , que é válido, estritamente falando, apenas para materiais com isotrópico κ [14]. Dada a limitação acima, não se deve considerar κ x e κ y ser duas variáveis independentes. A Figura 2 mostra a relação entre a resistividade térmica, ou seja, 1 / κ , e T para as direções de [001] e [010] sobre um grande T intervalo, respectivamente. Pode ser visto que 1 / κ y pode ser substituído por 1 / ( cκ x ) e c é escolhido para ser igual a 1,64. Consequentemente, a Eq. (6) pode ser transformado para a seguinte equação:

A relação entre a resistividade térmica e T para as direções de [001] e [010]. Os símbolos verdes e as linhas vermelhas denotam os valores reais e ajustados, respectivamente. A linha azul representa a hipótese de 1 / κ y ≈ 1 / ( cκ x ), onde c =1,64
$$ \ frac {\ partial} {\ partial \ mathrm {x}} \ left ({\ kappa} _ {x} \ left (T \ right) \ frac {\ partial T} {\ partial x} \ right) + \ frac {\ partial} {\ partial \ mathrm {y}} \ left ({c \ kappa} _ {x} \ left (T \ right) \ frac {\ partial T} {\ partial y} \ right) =0. $$ (7)
Com base nas aproximações anteriores de κ x e κ y , a transformação de Kirchhoff pode ser empregada sem quaisquer restrições. Além disso, também pode ser visto que a recíproca de κ espera-se que seja proporcional a T. Assim, a fim de reduzir a complexidade computacional, a expressão de 1 / κ x pode ser simplificado como 1 / κ x = aT + b , conforme mostrado na Fig. 2. A razão para o uso de a , b e c é apenas uma conveniência em escrever as equações que se seguem.
Pela aplicação da transformação de Kirchhoff e do método de separação de variáveis, a expressão de T máximo pode ser derivado como
$$ \ begin {alinhados} T _ {{max}} =&\\ &\, \ left ({T _ {{amb}} + \ frac {b} {a}} \ right) exp \ left ({\ frac {{aP \ left ({t _ {{ch}} + t _ {{sub}}} \ right)}} {{cL}} + \ frac {{aPSL}} {{\ sqrt c \ pi ^ {2} L_ {g}}}} \ direita) - \ frac {b} {a}, \\ \ end {alinhado} $$ (8)
Onde
$$ S =\ sum_ {n =1} ^ {\ infty} \ frac {\ mathrm {sin} n \ pi \ frac {{L} _ {g}} {L}} {{n} ^ {2} } \ frac {\ mathrm {sinh} 2n \ pi \ frac {{t} _ {ch} + {t} _ {sub}} {\ sqrt {c} L}} {\ mathrm {cosh} 2n \ pi \ frac {{t} _ {ch} + {t} _ {sub}} {\ sqrt {c} L}}. $$ (9)
Deve-se ressaltar que S é uma série infinita convergente e seu valor aproximado, que pode ser facilmente obtido, é usado no cálculo em vez de seu valor real.
No caso de Ga 2 O 3 MOSFETs com alto κ substratos, a transformação de Kirchhoff não pode ser diretamente aplicada teoricamente. Na verdade, para que a transformação seja válida, as condições de contorno devem ser isotérmicas (constante T superfície), ou ter uma densidade de fluxo de calor fixa. No entanto, devido aos diferentes κ de Ga 2 O 3 e material de substrato, ambas as condições de limite não são completamente atendidas no Ga 2 O 3 interface / substrato. Considerando que o κ de Ga 2 O 3 é muito mais baixo do que alto κ substrato, uma hipótese, a interface isotérmica entre o Ga 2 O 3 e o substrato, é introduzido. Esta hipótese é fundamental para derivar a expressão T máximo e sua validade será verificada posteriormente. Neste caso, a resistência térmica ( R TH ) de alto κ substrato, uma proporção da diferença entre o T int e T amb e o PW , ou seja, R TH =( T int - T amb ) / ( PW ), pode ser calculado como R TH = LW / ( κt sub ), onde W é a largura do substrato [19]. Assim, a expressão da temperatura de Ga 2 O 3 interface / substrate ( T int ) é
$$ {T} _ {int} =\ frac {P {t} _ {sub}} {{\ kappa} _ {sub} L} + {T} _ {amb}, $$ (10)
onde κ sub é a condutividade térmica do substrato heterogêneo, que é considerada constante. Além disso, deve ser apontado que a resistência térmica do limite entre Ga 2 O 3 e substratos heterogêneos não estão incluídos no modelo. Portanto, com a ajuda da Eq. (8), a expressão de T máximo para Ga 2 O 3 MOSFETs com substrato heterogêneo podem ser derivados como
$$ \ begin {alinhados} T _ {{max}} =&\\ &\; \ left ({T _ {{int}} + \ frac {b} {a}} \ right) exp \ left ({\ frac {{aPt _ {{ch}}}} {{cL}} + \ frac {{aPSL}} {{\ sqrt c \ pi ^ {2} L_ {g}}}} \ right) - \ frac {b} {a}, \\ \ end {alinhado} $$ (11)
Onde
$$ S =\ sum_ {n =1} ^ {\ infty} \ frac {\ mathrm {sin} n \ pi \ frac {{L} _ {g}} {L}} {{n} ^ {2} } \ frac {\ mathrm {sinh} 2n \ pi \ frac {{t} _ {ch}} {\ sqrt {c} L}} {\ mathrm {cosh} 2n \ pi \ frac {{t} _ {ch }} {\ sqrt {c} L}}. $$ (12)
Resultados e discussão
A validade do modelo analítico para o T máximo em Ga 2 O 3 Os MOSFETs foram sistematicamente verificados nesta seção, considerando tanto o substrato nativo quanto a contraparte com maior condutividade térmica. A melhor maneira de testar a validade de um modelo é com base em dados experimentais. No entanto, alguns parâmetros geométricos importantes não puderam ser encontrados em literaturas experimentais, como t sub e L na Ref. [12]. Portanto, a simulação de elementos finitos, um dos meios mais precisos, é usada para verificar nosso modelo. A Figura 3 mostra a dependência de T máximo na densidade de potência P obtido do COMSOL Multiphysics e do modelo analítico, para Ga 2 O 3 MOSFET com substrato nativo. Vários parâmetros-chave são considerados, incluindo o comprimento do dispositivo L , espessura do substrato t sub , e temperatura ambiente T amb . Conforme mostrado na Fig. 3a, o T máximo é naturalmente aumentado com a densidade de potência elevada e a taxa de aumento é aumentada com o menor L . Isso é atribuído ao dispositivo com maior L permite a dissipação de calor da região ativa e, portanto, sua temperatura geral é menor do que com menor L ao mesmo tempo P [11]. Ou seja, é R TH , a inclinação das curvas, é menor do que a última . Além disso, uma vez que o κ de Ga 2 O 3 diminuirá com o aumento da temperatura geral, seu R TH também aumentará mais lentamente do que com L menores conseqüentemente, o que é óbvio na Fig. 3a [19]. Da mesma forma, a investigação de dependência de T máximo em t sub foi realizada, conforme ilustrado na Fig. 3b. Observa-se que a tendência de T máximo com respeito a P é igual ao da Fig. 3a. O substrato mais fino sempre produz o aumento atenuado em T máximo sobre a densidade de potência aumentada, o que é compreensível que quanto mais fino o substrato, menor a temperatura geral, menor R TH e sua taxa de aumento, assim como a análise da Fig. 3a. A Figura 3c compara a influência de T amb em T máximo como P aumenta. É evidente que a diferença entre as duas curvas aumenta lentamente, o que é diferente daquelas nas Fig. 3a, b. Normalmente, R TH é dominado pelos parâmetros geométricos do dispositivo e o κ valor do material. No entanto, considerando que a estrutura é fixa neste caso, o aumento em R TH é apenas induzido pela diminuição em κ de Ga 2 O 3 . Por outro lado, um alto nível de concordância é observado para o modelo proposto, que considera o T - e relação dependente da direção para o κ de Ga 2 O 3 , confirmando a natureza escalonável do modelo. Em média, a diferença entre o modelo proposto e a simulação é <1 K. A excelente concordância geral observada sugere que o modelo proposto é altamente eficaz e preciso.

Dependência de T máximo em a o comprimento do dispositivo L , b a espessura da camada de substrato t sub , e c temperatura ambiente T amb em potência diferente P . Símbolos e linhas denotam os resultados do modelo proposto e simulação, respectivamente
Da mesma forma, como mostrado na Fig. 4, as comparações semelhantes são repetidas para Ga 2 O 3 MOSFETs em alta κ substrato, SiC. Aqui, as etapas para L e T amb que escolhemos são maiores do que aqueles na Fig. 3, e a espessura do canal variada t ch é considerado em vez de t sub nesse caso. Caso contrário, a diferença entre duas curvas de T máximo com respeito a P em cada figura será indistinguível, devido à capacidade de dissipação de calor eficiente do substrato de SiC. O κ de SiC (3,7 Wcm −1 K −1 ) aplicado é um parâmetro padrão no software COMSOL Multiphysics. Graças a alta κ de SiC, pode-se ver claramente em todas as cifras que o aumento em T máximo é aproximadamente linear como P aumenta, o que significa que a influência da temperatura no R TH do dispositivo é insignificante. Deve ser apontado que nosso modelo pode descrever esta relação linear com sucesso. No entanto, é óbvio que o T máximo calculado pelo modelo atual é inferior ao previsto pela simulação, e essa diferença fica mais evidente com o aumento do consumo de energia. Para mostrar este mecanismo, simulado T int são extraídos com o aumento da potência e comparados com os T calculados int pela Eq. (10) conforme plotado na Fig. 5. Verifica-se que o aquecimento Joule se torna mais concentrado no meio do dispositivo como P aumenta. Existem 0,5 K e 4 K Δ T entre o modelo e a simulação neste local quando P =0,25 e 1 W / mm, respectivamente. Esta é a razão pela qual nosso modelo falha em prever com precisão T máximo . Portanto, uma hipótese mais razoável de T int é necessário para obter maior precisão no futuro. No entanto, o T máximo é previsto pelo modelo ser apenas <4 K menor do que pela simulação, mesmo sob densidade de dissipação de potência de 1 W / mm. Ou seja, embora a hipótese de uniforme T int é inconsistente com o fato, nosso modelo pode fornecer uma estimativa de T máximo com precisão suficiente.
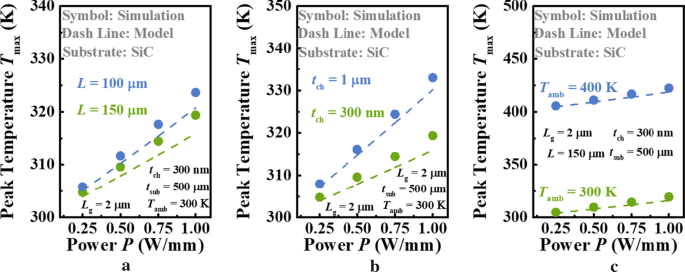
Dependência de T máximo de Ga 2 O 3 MOSFETs com substrato SiC em a o comprimento do dispositivo L , b a espessura de Ga 2 O 3 camada t ch , e c temperatura ambiente T amb em potência diferente P . Símbolos e linhas denotam os resultados do modelo proposto e simulação, respectivamente
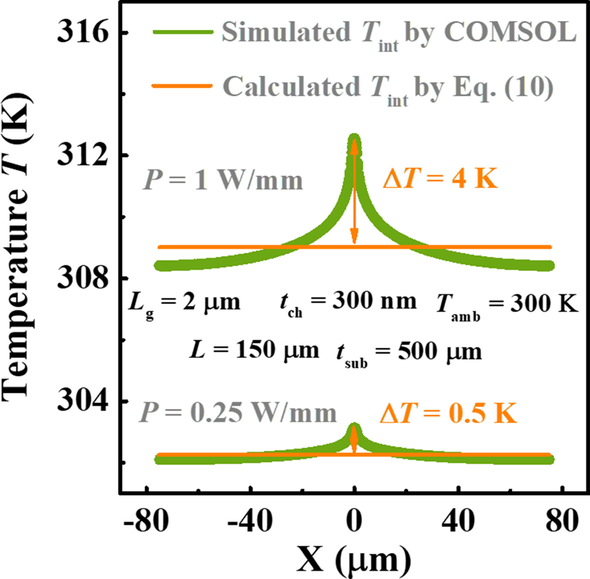
Comparação de T int entre simulado e calculado pela Eq. (10) em P diferente
Conclusões
Um modelo analítico preciso para estimar o T máximo de Ga 2 O 3 MOSFETs envolvendo a condutividade térmica dependente da temperatura e da direção são apresentados. Uma expressão simples com base na geometria do dispositivo e parâmetros de material foi derivada. Um excelente acordo foi obtido entre o modelo e as simulações numéricas do COMSOL Multiphysics, variando diferentes consumos de energia. O modelo proposto para o T máximo é de grande importância para dispositivos de energia de gerenciamento térmico eficaz, especialmente Ga 2 O 3 MOSFETs.
Disponibilidade de dados e materiais
Os conjuntos de dados que suportam as conclusões deste artigo estão incluídos no artigo.
Abreviações
- Ga 2 O 3 :
-
Óxido de gálio
- MOSFETs:
-
Transistores de efeito de campo de metal-óxido-semicondutor
- AlGaN:
-
Nitreto de Gálio de Alumínio
- GaN:
-
Nitreto de gálio
- SiC:
-
Carboneto de silício
Nanomateriais
- Uma taxonomia para o IIoT
- Compreendendo a Ciência da Dispersão de Pigmentos para Máxima Eficiência!
- Monitoramento de temperatura no Raspberry Pi
- Os melhores acessórios para o seu Raspberry Pi
- VISÃO:Para cegos
- Windows 10 IoT Core para Raspberry Pi 3 Modelo B +
- Cientistas da IBM inventam um termômetro para nanoescala
- A pandemia está gerando um novo modelo para tomada de decisão na cadeia de suprimentos
- O desafio do método 5S para a indústria 4.0
- Obrigado pelas lembranças!



